Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
Resumen
Las características del dispositivo de los láseres semiconductores de puntos cuánticos se han mejorado con el progreso de las estructuras de capas activas. Los puntos cuánticos de InAs formados por autoensamblaje cultivados en GaAs se habían promovido intensamente para lograr láseres de puntos cuánticos con un rendimiento superior del dispositivo. En el proceso de crecimiento de puntos cuánticos de InAs / GaAs de alta densidad, el tamaño bimodal se produce debido a un gran desajuste y otros factores. El tamaño bimodal en el sistema de puntos cuánticos de InAs / GaAs se elimina mediante el método de recocido a alta temperatura y se optimiza la temperatura de recocido in situ. La temperatura de recocido se toma como los parámetros clave de optimización y se obtuvo la temperatura de recocido óptima de 680 ° C. En este proceso, la temperatura de crecimiento de puntos cuánticos, la deposición de InAs y la presión de arsénico (As) se optimizan para mejorar la calidad de los puntos cuánticos y la longitud de onda de emisión. Un láser de punto cuántico F-P de 1,3 μm de alto rendimiento con una densidad de corriente de umbral de 110 A / cm 2 fue demostrado.
Introducción
Hace diez años, se desarrolló el láser de punto cuántico (QD) de 1,3 μm; sin embargo, no ha habido un desarrollo o progreso distintivo en el crecimiento de puntos cuánticos desde entonces hasta ahora. El láser de punto cuántico de 1,3 μm se ha convertido una vez más en un tema candente de estudio. Se ha convertido en uno de los fuertes competidores de la fuente de luz de red de área local (LAN) de comunicación óptica de alta velocidad. La alta densidad de puntos cuánticos es un factor importante que da como resultado un bajo consumo de energía, estabilidad a alta temperatura y alta velocidad. Como es bien sabido, se espera que el láser de punto cuántico InAs / GaAs de 1,3 μm muestre un rendimiento excelente en el umbral de corriente, estabilidad de temperatura y características de modulación debido a los confinamientos cuánticos tridimensionales [1]. En los últimos 10 años, una gran cantidad de laboratorios han logrado su objetivo en todo el mundo de mejorar en gran medida el rendimiento de los láseres QD [2, 3, 4, 5]. Sin embargo, el tamaño bimodal en el sistema de puntos cuánticos InAs / GaAs todavía existe [6, 7]. La calidad del punto cuántico se puede aumentar si se puede eliminar el tamaño bimodal.
Se ha prestado mucha atención a las heteroestructuras de InAs / GaAs que crecen mediante epitaxia de haz molecular (MBE) para fabricar nanoestructuras de baja dimensión, como QD autoensambladas debido a un gran desajuste de celosía (~ 7%) entre las capas de InAs y el sustrato de GaAs [8] . El crecimiento de InAs en el sustrato de GaAs (001) da como resultado la formación de una forma de isla tridimensional (3D) en los InAs con el modo de crecimiento de Stranski-Krastanov (SK). Se espera que la técnica de crecimiento SK sea un método de fabricación conveniente de QD coherentes de alta densidad y sigue siendo un desafío abierto [9, 10]. Sin embargo, los SK QD tienen algunos problemas, como el gran ensanchamiento no homogéneo de los niveles de energía QD y el problema del tamaño bimodal [11,12,13,14,15]. Para los puntos cuánticos de alta densidad en crecimiento de MBE, la forma convencional es aumentar la tasa de deposición de InAs y reducir la temperatura de crecimiento. El propósito de este enfoque es reducir la tasa de migración que puede hacer que la formación de la isla sea rápida. Sin embargo, el crecimiento a baja temperatura puede reducir la calidad de la red del material epitaxial. Por otro lado, el crecimiento rápido puede aumentar la densidad de puntos cuánticos, pero también crea más dislocaciones. En consecuencia, la intensidad de fotoluminiscencia de los QD de InAs se debilitó cuando logramos una alta densidad de QD de InAs utilizando el enfoque convencional.
En esta carta, el recocido de alta temperatura de una sola capa puede eliminar efectivamente los defectos del material de la tapa y cambiar la dirección de crecimiento de las dislocaciones. El tamaño y la forma de los puntos cuánticos de InAs SK muestran un alto grado de uniformidad mediante el recocido de una sola capa que crecieron en sustratos de GaAs (001). Hubo un aumento en la deposición de InAs que mejoró la saturación de cada QD al mismo tiempo. Los espectros PL de los QD uniformes de InAs revelaron un ancho de línea estrecho de menos de 26 meV. Se fabrican láseres QD de InAs / GaAs de 1.3 μm que exhiben una corriente de umbral láser I th de 220 mA y una densidad de corriente de umbral de 110 A / cm 2 .
Optimización de materiales
En este estudio, la estructura de puntos cuánticos se cultiva en sustratos de GaAs (001) (N +) en un sistema Veeco Gen 930 MBE. Se ha investigado la temperatura de recocido y las temperaturas de recocido para estas cuatro muestras (N170813, N170824A-N17084C) son 630, 680, 730 y 780 ° C, respectivamente. Los parámetros de crecimiento de los puntos cuánticos de estas cuatro muestras tienen exactamente los mismos (Tabla 1).
Se realizaron mediciones de fotoluminiscencia (PL) para las cuatro muestras. Con el aumento de la temperatura de recocido, se logró la intensidad PL más fuerte a la temperatura de recocido de 680 ° C (como se muestra en la Fig. 1). Esto se debe a que el arsénico (As) y el Ga se desorben a medida que aumenta la temperatura de recocido. Ese proceso puede crear más defectos, y la red de puntos cuánticos de InAs ha cambiado a alta temperatura.
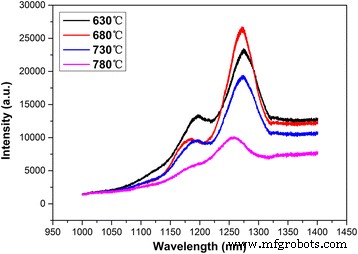
Comparación de espectros de fotoluminiscencia (PL) de obleas epitaxiales a diferentes temperaturas de recocido
El área activa del láser de punto cuántico se ha optimizado a la baja presión de arsénico de 4 × 10 - 7 Torr [16] y baja tasa de crecimiento de 0.025 ML / s. Después del recocido, encontramos que la longitud de onda era inferior a 1300 nm; por lo tanto, ajustamos las condiciones de crecimiento. Se cultivó un InAs de 2,5 monocapa (ML) de espesor a 520 ° C y se tapó con un InA de 5 nm de espesor 0.15 Ga 0,85 Como capa reductora de deformaciones a la misma temperatura. Esta capa fue seguida por una capa de GaAs de 15 nm que se depositó a una temperatura más baja (LT) de 520 ° C. Luego, hicimos crecer la capa final de GaAs de 20 nm a una temperatura más alta (HT) de 630 ° C (como se muestra en la Fig. 2a).
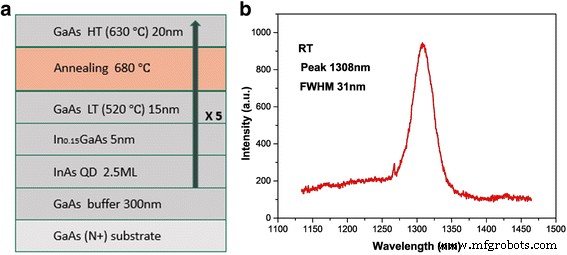
La estructura de la región activa y el espectro PL. un La estructura de la región activa del láser QD sin dopar. b Espectro PL de la región activa del láser QD a temperatura ambiente (RT). El pico de emisión es de 1305 nm y el FWHM es de aproximadamente 31 nm
Se midieron el espectro PL y las imágenes de microscopía de fuerza atómica (AFM) de la superficie de los QD para la muestra de prueba. El pico de emisión de 1308 nm se debe a la transición del estado fundamental, y el ancho total de la mitad del máximo (FWHM) del pico es de aproximadamente 31 nm (como se muestra en la Fig. 2b). Crecimos una capa de puntos cuánticos desnudos en la capa enterrada de cinco capas en la muestra de prueba para llevar a cabo la medición de AFM. Las condiciones de crecimiento son exactamente las mismas que las de los puntos cuánticos enterrados descritos anteriormente. La imagen AFM de la superficie de los QD muestra que la densidad QD de la muestra recocida es de aproximadamente 3,2 × 10 10 cm - 2 (como se muestra en la Fig. 3a). El punto cuántico tiene una altura media de 8 nm. Por el contrario, el tamaño y la distribución de la muestra de puntos cuánticos no recocidos no son uniformes. Se puede ver el tamaño bimodal y la densidad QD es de aproximadamente 2.9 × 10 10 cm - 2 . El punto cuántico tiene una altura de 5-7 nm (como se muestra en la Fig. 3b).
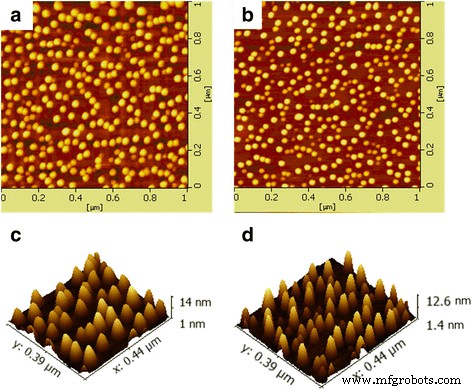
Imágenes AFM de los QD de InAs / GaAs. un Recocido de alta temperatura de una sola capa. b Sin recocido. c Imagen de distribución de tamaño de área pequeña en 3D con recocido a alta temperatura. d Imagen de distribución de tamaño de área pequeña en 3D sin recocido
Durante el crecimiento epitaxial de un láser de punto cuántico de 1,3 μm, el tamaño bimodal de los puntos cuánticos de InAs puede eliminarse bien mediante el recocido de una sola capa para el área activa del láser. En comparación con la muestra cultivada sin recocido (como se muestra en la Fig. 3c), la muestra crecida con una temperatura de recocido a 680 ° C (como se muestra en la Fig. 3d) tiene una mayor densidad de puntos cuánticos y un tamaño de punto cuántico uniforme. Eso se puede atribuir a las siguientes razones. Al principio, la capa superior de GaAs crece inmediatamente después del crecimiento de los puntos cuánticos de InAs, por lo que solo puede crecer a baja temperatura, lo que reduce la calidad de la red de GaAs e introduce defectos. El recocido a alta temperatura puede eliminar los defectos y puede hacer crecer la capa superior de GaAs de alta calidad que se utiliza para seguir aumentando los puntos cuánticos de InAs. Además, las dislocaciones se generan durante la heteroepitaxia de InAs / GaAs, el recocido de una sola capa in situ puede eliminar la dislocación o cambiar la dirección de crecimiento de la dislocación y luego mejorar la calidad de los puntos cuánticos de InAs.
Diseño y preparación del dispositivo
La estructura del láser consistía en una capa de GaAs incrustada con cinco capas de capas centrales de InAs QD autoensambladas. La capa de guía de ondas n de 200 nm y la capa de guía de ondas p se cultivaron en la parte superior e inferior de la estructura QD. La región activa de QD y la capa de guía de ondas se intercalaron con dos Al 0.45 tipo p (Be:4E18) y tipo n (Si:2E18) de 1,8 μm Ga 0,55 Como capas. Se depositó una capa de 200 nm p + GaAs (Be:3E19) para contacto eléctrico (como se muestra en la Fig. 4a).
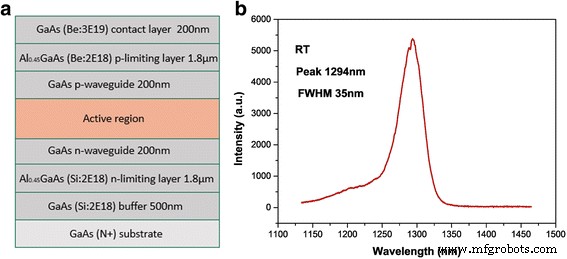
Estructura del dispositivo. un Estructura epitaxial del láser de área amplia F-P de punto cuántico de 1,3 μm. b Espectro PL de la estructura epitaxial del láser QD en RT. La longitud de onda central es 1294 nm
Una pequeña parte de la oblea se graba mediante grabado químico para adelgazar la capa de revestimiento superior con H 3 PO 4 -H 2 O 2 -H 2 O (1:1:4) después de que se completó la estructura epitaxial del láser [17, 18]. Puede verse que el espectro PL de esta muestra tiene una longitud de onda central de 1294 nm (como se muestra en la Fig. 4b). El desplazamiento al azul de la longitud de onda central en comparación con la muestra de prueba mencionada anteriormente (como se muestra en la Fig.2a) se debe al crecimiento a alta temperatura (650 ° C) durante la etapa de crecimiento del revestimiento superior con un tiempo de crecimiento superior a 2 h. . También puede ser del componente indio (In) del In 0.15 Deriva de rocas de la capa de capa de GaAs.
La oblea láser InAs / GaAs QD se revistió con fotorresistencia para definir el patrón de la superficie. La primera edición de fotolitografía forma un patrón de cresta de 100 μm. La guía de ondas de cresta se fabricó mediante grabado con plasma acoplado inductivamente (ICP) con una profundidad de grabado de 2 μm, seguido de Deposición de vapor químico mejorada con plasma (PECVD) para formar SiO 2 aislamiento. En el siguiente paso, hicimos una ventana de contacto de 90 μm de ancho en la cresta para la inyección de corriente. A continuación, se depositó Ti / Pt / Au 51 nm / 94,7 nm / 1122 nm como un electrodo de tipo p con pulverización catódica con magnetrón (como se muestra en la Fig. 5). La oblea se adelgaza a 120 μm, y se deposita AuGeNi de 50 nm de espesor (80:10:10% en peso de aleación) con una capa de Au de 300 nm de espesor en la parte posterior de la oblea, utilizando evaporación térmica para el electrodo tipo n [19, 20]. Se recoció toda la muestra a 460 ° C durante 10 s para formar un contacto óhmico. Durante todo el proceso de fabricación, la muestra se limpió secuencialmente con acetona y alcohol isopropílico y se enjuagó con agua desionizada.
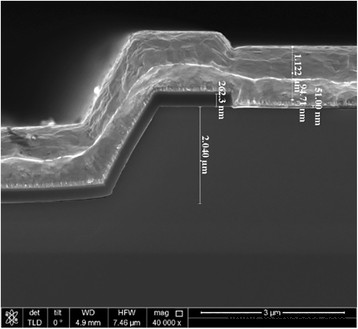
Imagen SEM de la sección transversal del láser. El láser de área amplia F-P con un proceso de fabricación láser estándar. La profundidad de grabado de GaAs / AlGaAs es de aproximadamente 2 μm. El PECVD formó SiO 2 es de 260 nm
Las propiedades eléctricas y ópticas del dispositivo se midieron cuando se terminó el láser. Potencia-corriente-voltaje ( P - I − V ) Las características de los láseres de área amplia se probaron en onda continua (CW) a RT. La densidad de corriente umbral del láser es 110 A / cm 2 (como se muestra en la Fig. 6a), y la longitud de onda central del espectro láser es de 1,3 μm (como se muestra en la Fig. 6b). Puede verse en el espectro láser que la longitud de onda central del láser a temperatura ambiente está desplazada al rojo debido al efecto de calentamiento de la operación del láser. En este estudio, el láser puede disparar de forma continua a temperatura ambiente y alcanzar una buena densidad de corriente umbral, así como una buena potencia de salida sin recubrimiento de facetas y deshacer en la región activa, lo que indica la alta calidad de cristal del láser. El método de recocido de una sola capa tiene cierto efecto sobre el sistema de puntos cuánticos de tamaño bimodal. La investigación de nivel más profundo se estudiará más a fondo en función de esto para mejorar aún más la densidad de QD, con el fin de lograr un umbral de corriente más bajo, menor consumo de energía, mayor potencia de salida y alta temperatura característica.
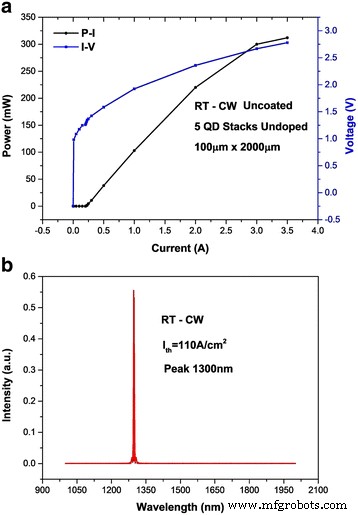
Medidas del dispositivo. un Curvas P-I-V de un láser QD. b La longitud de onda láser es de 1,3 μm
Conclusiones
Se investigó una serie de optimizaciones de los parámetros de crecimiento de puntos cuánticos de alta densidad. El método de recocido de una sola capa se utilizó para suprimir con éxito la formación del sistema de puntos cuánticos de tamaño bimodal. Estudiamos en detalle la temperatura de recocido y la posición de la capa de recocido. Se obtuvo una temperatura de recocido optimizada de 680 ° C y una distancia de la capa de puntos cuánticos de 20 nm. Una densidad de corriente de umbral de 110 A / cm 2 se ha logrado para un láser InAs / GaAs QD F-P de 1,3 μm a temperatura ambiente y funcionamiento de onda continua con una longitud de onda láser de 1,3 μm.
Abreviaturas
- AFM:
-
Microscopio de fuerza atómica
- Recocido T:
-
Temperatura de recocido
- CW:
-
Onda continua
- F-P:
-
Fabry – Perot
- FWHM:
-
Ancho completo a la mitad del máximo
- Crecimiento T:
-
Temperatura de crecimiento
- HT:
-
Alta temperatura
- LT:
-
Baja temperatura
- MBE:
-
Epitaxia de haz molecular
- PL:
-
Fotoluminiscencia
- QD:
-
Punto cuántico
- RT:
-
Temperatura ambiente
- SEM:
-
Microscopio electrónico de barrido
- WPE:
-
Eficiencia del enchufe de pared
Nanomateriales
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- S, N Co-Doped Graphene Quantum Dot / TiO2 Composites para la generación eficiente de hidrógeno fotocatalítico
- Fuente brillante de fotón único a 1,3 μm basada en punto cuántico bicapa InAs en micropilar
- Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- Un enfoque simple para sintetizar puntos cuánticos de carbono fluorescente de aguas residuales de tofu
- Preparación de molienda de bolas en un solo paso de óxido de grafeno / CL-20 a nanoescala para una sensibilidad y un tamaño de partículas significativamente reducidos
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Diseño de puntos cuánticos GeSn / GeSiSn con ingeniería de deformación para la emisión directa de banda prohibida en el infrarrojo medio en el sustrato de Si



