Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
Resumen
Se estudió el efecto bipolar del sustrato de GaAs y las capas cercanas sobre el fotovoltaje de InAs / InGaAs metamórficos verticales en comparación con estructuras pseudomórficas (convencionales) de InAs / GaAs de punto cuántico (QD). Tanto las estructuras metamórficas como las pseudomórficas se cultivaron mediante epitaxia de haz molecular, utilizando contactos inferiores en el n crecido + -tampones o el sustrato de GaAs. Las características relacionadas con las QD, las capas humectantes y los tampones se han identificado en los espectros fotoeléctricos de ambas estructuras en contacto con el tampón, mientras que los espectros de las muestras en contacto con el sustrato mostraron el inicio adicional atribuido a los centros de defectos EL2. Las muestras en contacto con el sustrato demostraron fotovoltaje bipolar; Se sugirió que esto ocurriera como resultado de la competencia entre los componentes relacionados con los QD y sus capas de revestimiento con los defectos relacionados con el sustrato y la capa de crecimiento más profundo. No se encontraron efectos de sustrato directo en los espectros de las estructuras en contacto con el tampón. Sin embargo, una notable influencia negativa del n + -Se observó una capa tampón de GaAs en la señal de fotovoltaje y fotoconductividad en la estructura InAs / InGaAs. Analizando los resultados obtenidos y los cálculos realizados, hemos podido proporcionar conocimientos sobre el diseño de estructuras QD metamórficas, que pueden ser útiles para el desarrollo de nuevos dispositivos fotónicos eficientes.
Antecedentes
En las últimas dos décadas, los materiales compuestos que contienen nanoestructuras semiconductoras han encontrado un gran uso en aplicaciones fotónicas debido a la sensibilidad a la luz, la facilidad y el bajo costo de fabricación, la sintonización espectral y la emisión altamente eficiente con una vida útil corta [1,2,3,4,5 ]. En (Ga) As, las heteroestructuras de puntos cuánticos (QD) son una clase importante de nanoestructuras sensibles al infrarrojo, que se ha empleado ampliamente en varios dispositivos fotónicos, como láseres [2, 6], fuentes de fotón único [7, 8], fotodetectores [9,10,11,12,13] y células solares [14,15,16]. Se han dedicado numerosas investigaciones a mejorar las propiedades fotoeléctricas de tales dispositivos sensibles a la luz. Por ejemplo, el rango de fotosensibilidad se puede extender a través de la excitación a través de banda prohibida intermedia [17, 18] o generación de excitones múltiples [19, 20], de modo que las eficiencias de conversión de energía de las células solares basadas en QD pueden exceder en teoría los límites de una sola -células solares de banda prohibida [21]. Los métodos como el balanceo de deformaciones [22] y la técnica de manejo de desajustes [23], así como el recocido térmico [24], se utilizan para reducir las deformaciones en estas estructuras, operando el rango de trabajo [25] y aumentando la fotorrespuesta debido a la supresión de defectos relacionados con la cepa [26] que pueden actuar como centros de recombinación.
Un método eficaz para la reducción de la tensión se basa en el crecimiento de un tampón metamórfico (MB) de InGaAs en lugar del convencional de GaAs. Como resultado, las estructuras QD de InAs / InGaAs han atraído mucho interés en la última década [27, 28, 29]. Al hacer crecer las QD en el MB de InGaAs, se pueden observar diferencias esenciales en el proceso de formación y las propiedades ópticas de QD en comparación con las convencionales en la matriz de GaAs [25, 30,31,32,33]. Por ejemplo, la capa de confinamiento de InGaAs reduce el desajuste de la red entre los QD y el búfer y, por lo tanto, las tensiones en los QD. Como resultado, la banda prohibida de InAs se reduce y se observa un aumento significativo en la longitud de onda de emisión [34]. La aplicación del MB como material de confinamiento permite cambiar su valor a la ventana de telecomunicaciones a 1,3 y 1,55 μm [28, 29, 35, 36].
Además, ha habido intentos esperanzadores de aplicar las propiedades fotoeléctricas de las estructuras metamórficas de QD de InAs en el diseño de dispositivos sensibles a la luz como fotodetectores infrarrojos metamórficos [11,12,13] y células solares [37,38,39]. Se realizaron algunos estudios para desarrollar el diseño de estructuras [25, 31,32,33] y otros para mejorar las propiedades fotoeléctricas [39, 40]. Se están realizando investigaciones para reducir las deformaciones en las heteroestructuras [34, 41], ya que esto conduce a una mejora sustancial en la densidad de fotocorriente y la respuesta espectral de las células solares [39, 40], así como en la eficiencia de fotoemisión de tales estructuras [ 29, 32, 42].
El desarrollo de los dispositivos sensibles a la luz requiere un estudio en profundidad de las propiedades fotoeléctricas. Los estudios de fotovoltaje (PV) o fotoconductividad (PC) son una herramienta ideal para la determinación de la fotorrespuesta en función de la energía lumínica, las transiciones entre niveles, el transporte de portadores y el rango operativo del dispositivo [10, 43, 44]. Sin embargo, a pesar de que en los últimos años se han realizado algunos estudios de las propiedades fotoeléctricas de estructuras con QD de InAs metamórficos [37,38,39, 43], los aspectos completos del mecanismo de fotorrespuesta siguen sin estar claros, así como la influencia de la MB sobre las propiedades de las nanoestructuras. En particular, los efectos del sustrato de GaAs y las interfaces relacionadas en los espectros fotoeléctricos de las estructuras QD de InAs / InGaAs / GaAs no se han explorado en detalle. Aunque se dedican esfuerzos significativos para evitar la influencia del sustrato, la fotorrespuesta se ve afectada tanto por el sustrato como por las capas cercanas que crecen mediante epitaxia de haz molecular (MBE). Por lo tanto, mientras que la geometría de contacto aplicada es para retener las capas inferiores y el sustrato eléctricamente inactivo, hemos detectado un efecto negativo notable de ellos sobre la fotovoltaica y la fotocorriente en una investigación previa [43]. Muy recientemente, comparamos las propiedades fotoeléctricas de los metamórficos InAs / In 0.15 Ga 0,85 Como estructura QD con las de un InAs / GaAs QD estándar y encontró que la fotocorriente de InAs / In metamórficos 0.15 Ga 0,85 Dado que las heteroestructuras no se vieron afectadas por los niveles relacionados con defectos en las proximidades de QD [45]. Además, se ha concluido que se pueden desarrollar dispositivos fotónicos eficientes a 1,3 μm con nanoestructuras similares como material activo.
En este trabajo, continuamos el estudio de las propiedades fotoeléctricas de las heteroestructuras con InAs QDs incrustados en el metamórfico In 0.15 Ga 0,85 Como tampones de GaAs convencionales, centrándose en el efecto del sustrato de GaAs y las capas de MBE cercanas. Para llegar a una comprensión clara del papel del sustrato y las capas de amortiguación, consideramos las estructuras con contactos inferiores en (i) el In 0.15 Ga 0,85 Como capa tampón o (ii) el sustrato inferior de GaAs (ver Fig. 1). Por lo tanto, dependiendo de la selección del contacto inferior, la corriente fluyó a través de (i) solo las QD y las capas de amortiguación y (ii) la estructura completa, incluidos los sustratos y sus interfaces con las capas MBE. El análisis de los resultados y los cálculos nos permitió proporcionar una idea del mejor diseño de sensores de luz en estructuras QD metamórficas.
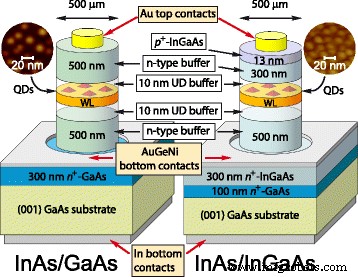
(Color en línea) esquemas de los InAs / In metamórficos 0.15 Ga 0,85 Como / si -GaAs (derecha) e InAs / GaAs / si -Muestras QD de GaAs (izquierda) investigadas; Se muestran imágenes AFM de las estructuras descubiertas
Métodos
Las estructuras fueron preparadas por MBE en (001) semi-aislante ( si ) Sustratos de GaAs. Los sustratos eran n -tipo, con valores de 3 × 10 7 cm −3 concentración de portador residual, espesor de 500 μm y resistividad de 2 × 10 7 Ω × cm. Las estructuras metamórficas de QD de InAs / InGaAs consisten en (i) 100 nm n + -Capa tampón de GaAs cultivada a 600 ° C, (ii) n de 300 nm de espesor + -En 0.15 Ga 0,85 Como MB con n =5 × 10 18 cm −3 cultivado a 490 ° C, (iii) n de 500 nm de espesor -En 0.15 Ga 0,85 Como MB con n =3 × 10 16 cm −3 cultivado a 490 ° C, (iv) 3.0 monocapas (ML) de QD de InAs autoensambladas incrustadas en un In 0.15 sin dopar de 20 nm Ga 0,85 Como capa cultivada a 460 ° C, (v) 300 nm n -En 0.15 Ga 0,85 Como capa de remate superior con n =3 × 10 16 cm −3 cultivado a 490 ° C, y (vi) 13 nm p + -doped en 0.15 Ga 0,85 Como gorra con p =2 × 10 18 cm −3 cultivado a 490 ° C (Fig. 1). La tasa de crecimiento fue de 1.0 ML / s, excepto para los QD que se cultivaron con una tasa de crecimiento de 0.15 ML / s. Las capas sin dopar son necesarias para separar los QD de n -regiones dopadas y, por lo tanto, para reducir la influencia de los centros de recombinación no radiativa, maximizando así la eficiencia de emisión de luz QD [30, 46]. Las estructuras QD estándar de InAs / GaAs consisten en (i) 300 nm n + -Capa de búfer de GaAs con n =5 × 10 18 cm −3 cultivado a 600 ° C, (ii) n de 500 nm de espesor -GaAs MB con n =3 × 10 16 cm −3 cultivado a 600 ° C, (iii) 3,0 ML de InAs QD incrustados en una capa de GaAs sin dopar de 20 nm cultivada a 460 ° C, y (iv) n de 500 nm -Capa de cobertura superior de GaAs con n =3 × 10 16 cm −3 cultivado a 600 ° C. La tasa de crecimiento fue de 1.0 ML / s, excepto para las QD que se cultivaron con una tasa de crecimiento de 0.15 ML / s.
Las imágenes de microscopía de fuerza atómica (AFM) de las estructuras descubiertas se muestran en la Fig. 1. Mediante el análisis de los datos de AFM en estructuras similares, los valores más frecuentes de los tamaños de QD se estimaron en 20 nm (diámetro) y 4.9 nm (altura) para metamórficos. QD y 21 nm (diámetro) y 5,0 nm (altura) para QD estándar [30, 31, 45].
Para las mediciones fotoeléctricas, se grabaron mesas circulares de 500 μm de espesor en las estructuras hasta la zona de amortiguación inferior n + capas; Los contactos superiores rectificadores de Au con un diámetro de 400 µm y un grosor de 70 nm se evaporaron luego en la parte superior de las mesas. Para obtener contactos óhmicos en la parte inferior n + -InGaAs y n + -Capas de búfer de GaAs, respectivamente, Au 0.83 Ge 0.12 Ni 0.05 La aleación se depositó a 400 ° C durante 1 min en atmósfera de nitrógeno. Se hicieron contactos óhmicos de indio grueso en la parte inferior de los sustratos en otras piezas de las mismas muestras, para tener mediciones también con la corriente que fluye a través del búfer de GaAs y si -Sustrato de GaAs. La ohmicidad de los contactos ha sido verificada por el I - V medidas, contactando con una pieza de sustrato; Se encontró que las características de corriente-voltaje eran lineales (datos no mostrados).
Siguiendo el enfoque propuesto en la Ref. [47] y utilizado en otros trabajos [48, 49], el delgado p + -Capa InGaAs entre el contacto Au y el n -La capa de InGaAs se utilizó para mejorar la altura de la barrera Schottky, ya que la estructura obtenida por la simple deposición de un metal sobre n -InGaAs exhibió una altura de barrera Schottky relativamente baja. Por lo tanto, la deposición de p delgadas + -La capa de InGaAs agranda la altura de la barrera de Schottky para que sea similar a la del contacto de Au-GaAs, manteniendo la semejanza del perfil de la barrera para las estructuras metamórficas y de InAs / GaAs.
Para el diseño de estructuras y contactos, así como la comprensión del perfil energético de ambas estructuras compuestas por In 0.15 Ga 0,85 As o GaAs MB, In (Ga) As QD, capa de protección sin dopar y contactos Au / AuGeNi, los cálculos se llevaron a cabo utilizando el software Tibercad [50]. Los perfiles de banda se modelaron en la aproximación de deriva-difusión, teniendo en cuenta las condiciones de deformación, las densidades de las trampas relacionadas con los defectos en la región de la interfaz InGaAs / GaAs, las capas de agotamiento cerca de los contactos y las alturas apropiadas de la barrera Schottky. Para el cálculo de los perfiles de bandas QD metamórficas, se consideraron los tamaños de los datos de AFM y se incluyeron los efectos de deformación, siguiendo un enfoque ya validado en las Refs. [42, 51]. El cálculo de los niveles cuánticos de QD está fuera del alcance de este documento, y el modelado de QD se ha realizado previamente en la Ref. [45]. En este trabajo, sin embargo, calculamos los perfiles de banda de toda la heteroestructura, incluido el sustrato.
La fotocorriente vertical y los espectros de PV se midieron en el rango de 0,6 a 1,8 eV utilizando geometría de excitación de incidencia normal a temperatura ambiente (RT) (300 K) y la misma intensidad de fuente de luz (1,5 mW / cm 2 ). La fotocorriente se midió utilizando un amplificador de corriente y una técnica de corriente continua [10, 43, 44, 45], con un sesgo de 1 V. La corriente se midió como una caída de la señal de voltaje a través de una resistencia de carga en serie de 100 kΩ (consulte el recuadro en la Fig. 5). La fotoluminiscencia (PL) excitada a 532 nm se midió a 300 K. Alguna información sobre estructuras y métodos se describe con más detalle en la Ref. [45].
Resultados y discusión
A. Caracterización fotoeléctrica
Los espectros fotovoltaicos de ambos InAs / In 0.15 Ga 0,85 Las muestras de As e InAs / GaAs se presentan en la Fig. 2. Contactadas solo con las capas MBE, de espesor n -InGaAs, o n -GaAs tampones, las características de los espectros se han descrito en otra parte [45]. El umbral de espectro de InAs / In 0.15 Ga 0,85 Como en 0.88 eV está relacionado con la absorción del estado fundamental en el conjunto QD, que corresponde al inicio de la banda QD en el espectro PL en RT medido anteriormente [45] (Fig. 2a). El espectro de emisión de QD metamórfico muestra una banda ancha a 0,94 eV que está en el rango de las telecomunicaciones a 1,3 μm (0,95 eV), mientras que el QD PL demuestra una buena eficiencia, como se ha señalado en artículos anteriores [30, 45, 46, 52]. La banda ancha del espectro fotovoltaico alcanzó un máximo de 1,24 eV y con un borde de 1,11 eV se debe a la generación de portadora en el In 0,15 Ga 0,85 Como MB y capa humectante (WL) incluido el paso a través de los niveles poco profundos. Cabe agregar que el In 0.15 Ga 0,85 Como la banda prohibida calculada para la capa desarrollada con MBE es de 1,225 eV [53], y la WL PL se observa a 1,2 eV [45]. Además, se observa una caída brusca significativa por encima de 1,36 eV probablemente causada por un efecto indirecto de la capa de amortiguación de GaAs fuertemente dopada ubicada fuera de la región de intercontacto que se ha mencionado en la Ref. [43]. La capa amortiguadora está llena de numerosos niveles poco profundos y no uniformidades de bandas originadas por defectos de crecimiento de MBE y centros de dopaje que desplazan al rojo la absorción de GaAs entre bandas [33, 46, 54, 55]. Para la nanoestructura convencional de InAs / GaAs en contacto con búfer, el inicio a 1.05 eV del espectro fotovoltaico en la Fig.2b se origina en el estado fundamental QD, como lo confirma el espectro PL, mientras que el paso brusco en 1.3 eV puede estar relacionado con el transiciones en la WL [56]. La característica después de 1,39 eV está obviamente relacionada con la absorción de la capa de amortiguación superior de GaAs dopada. Un mecanismo para este efecto se discutirá en detalle a continuación.

(Color en línea) espectros fotovoltaicos de temperatura ambiente de a InAs / In metamórficos 0.15 Ga 0,85 Como y b Estructuras QD de InAs / GaAs; La PV se midió en contacto con solo capas de MBE [45] (curvas negras) y a través del si semi-aislante -Sustrato de GaAs (azul). Los espectros fotovoltaicos medidos a través de si -El sustrato de GaAs se invierte por signos de voltaje por debajo de 1,68 y 1,44 eV respectivamente para a y b . Las partes de las curvas de baja energía se muestran en los recuadros; las bandas QD PL medidas antes [45] para ambas estructuras se presentan para el posicionamiento de energía del estado fundamental QD (rojo)
Como se mencionó anteriormente, la fuerte caída de la señal PV por encima de 1.36 eV en InAs / In 0.15 Ga 0,85 Como la estructura está relacionada con n + -Capa inferior de GaAs que remata el sustrato. Para eliminar los efectos de las capas debajo del contacto inferior de AuGeNi en la fotorrespuesta, hemos estudiado las propiedades fotoeléctricas de las estructuras utilizando un contacto de indio en la parte posterior del sustrato. A diferencia de la geometría de contacto anterior de Au y AuGeNi que permite el PV unipolar, se ha observado la señal bipolar para las estructuras en contacto con la parte superior de la muestra y la parte posterior del sustrato (Fig. 2). Es necesario notar que el signo de PV cambia a lo largo del eje de energía del fotón, y en la Fig.2, los espectros de ambas muestras están invertidos por el signo de voltaje por debajo de 1.68 y 1.44 eV para InAs / In 0.15 Ga 0,85 Estructuras As e InAs / GaAs QD respectivamente. Aquí, PV se considera positivo cuando, como en el caso del contacto con las capas MBE, el potencial positivo se aplica al contacto superior de Au mientras que el negativo se aplica al contacto inferior.
Todas las transiciones ópticas mencionadas anteriormente contribuyen a la señal PV de las estructuras en la geometría de contacto entre el sustrato y la parte superior. Sin embargo, cuando se mide PV a través del sustrato, el inicio de la señal para las estructuras metamórficas y convencionales se produce a aproximadamente 0,72 eV. El inicio en 0,72 eV se atribuye a la transición desde el centro de defectos EL2 ubicado en si -Sustrato de GaAs e interfaces relacionadas cerca de 0,75 eV por debajo de la banda de conducción de GaAs [57], teniendo en cuenta la posibilidad de transición a través de los niveles superficiales de defectos [46, 54, 55]. Los aspectos relacionados con su ubicación, así como el desplazamiento al rojo de la aparición de EL2 PC, se han discutido en detalle en otro lugar [10, 45]. Como no se observó ninguna señal debajo de las bandas relacionadas con QD en los espectros de las muestras en contacto con los búferes de InGaAs o GaAs (Fig.2), concluimos que el sustrato y las interfaces relacionadas no tienen una influencia sustancial en las propiedades de las heteroestructuras cultivadas con MBE .
Para comprender la apariencia de la señal PV en nuestras muestras, uno debe mirar la Fig. 3 donde mostramos los perfiles de banda calculados a lo largo de la dirección de crecimiento. En el artículo anterior [45] se ofrece una explicación detallada del origen fotovoltaico entre los contactos Au y AuGeNi. En resumen, los electrones (huecos) excitados por la luz se desplazan predominantemente hacia el sustrato (superficie), dando un potencial positivo en el contacto de Au y uno negativo en el contacto de AuGeNi.

(Color online) perfil de banda calculado en el InAs / In metamórfico 0.15 Ga 0,85 As (arriba) y estructuras pseudomórficas de InAs / GaAs (abajo), para explicar el mecanismo de PV. La flexión de la banda de las capas más profundas debajo del contacto AuGeNi se indica en gris. Las transiciones ópticas observadas en los espectros PV se indican mediante flechas verticales; las flechas en negrita muestran las direcciones de deriva de los portadores de carga ópticamente excitados bajo el campo interno (creación de PV); E F es la energía de Fermi. Los cálculos se realizaron utilizando el software Tibercad [50]
Explicando el PV bipolar de las estructuras con el si eléctricamente activo -Sustratos de GaAs, se pueden considerar sus estructuras de bandas calculadas en la Fig. 3. Como antes, los portadores generados en las capas superiores, así como en las QD y WL podrían dar “+” en la parte superior y “-” en el sustrato. El nivel de Fermi en el sustrato semiaislante se encuentra mucho más bajo que el de la n -capas MBE dopadas. Por lo tanto, la banda que se dobla cerca del n + -La interfaz GaAs / sustrato es opuesta a la del resto de la estructura desarrollada con MBE (ver la Fig. 3). Por lo tanto, la excitación en el n + -La capa y el sustrato de GaAs (por encima de 1,36 eV) dan una señal de PV opuesta a la de los QD, WL y los búferes. Lo mismo se aplica a la excitación de los defectos EL2 (por encima de 0,72 eV) del sustrato de GaAs y especialmente a los defectos similares a EL2 en n + -Región tensada de GaAs / GaAs [46, 57]. Contribución del sustrato y n + -GaAs a la señal de PV total es esencialmente más fuerte que la de las capas superiores de MBE, y la señal negativa de PV se observa generalmente a energías de excitación más bajas, mientras que el impacto de las capas y nanoestructuras de InGaAs aparece como valles en las respectivas curvas espectrales en la Fig. 2. Esto se ve claramente comparando las bandas espectrales de QD, WL y tampón en las curvas PV de las estructuras en contacto con tampones MBE con los valles en los espectros de las muestras en contacto con la parte superior del sustrato. Sin embargo, para las energías más altas, la excitación se absorbe más cerca de la superficie de la muestra y no alcanza las capas más profundas de MBE y el sustrato, que es la principal fuente de señal negativa. Por tanto, la señal PV se vuelve positiva a energías mayores. Entonces, la presencia de si eléctricamente activo -sustrato conduce a la competencia entre los componentes espectrales relacionados con las capas superiores de MBE crecidas y los defectos relacionados con el sustrato y el n + -Absorción de GaAs.
De lo contrario, se ha observado un rasgo característico similar por encima de 1,35 eV mediante espectroscopía fotovoltaica de superficie en un estudio detallado reciente de p -doped InAs / GaAs QD e InAs / InGaAs dot-in-well estructuras basadas en si -Sustratos de GaAs [58]. La drástica caída de la amplitud fotovoltaica se ha explicado, a diferencia de nuestro caso, por diferentes portadores de carga generados por debajo y por encima de 1,35 eV. Sin embargo, teniendo en cuenta la drástica diferencia en las estructuras referidas y presentes, así como las particularidades de los métodos aplicados, seguimos nuestra interpretación de los propios resultados.
Basado en el concepto de flexión de la banda por debajo del contacto AuGeNi, se puede explicar la fuerte caída de la señal PV en la estructura metamórfica de InAs / InGaAs en contacto con el búfer por encima de 1,36 eV observada en la Fig. 2a. Esta característica espectral se debe al efecto del sustrato y el MBE más profundo n + -Capa de GaAs. De hecho, los electrones generados allí se mueven bajo el campo intrínseco al contacto AuGeNi evocando un campo eléctrico adicional allí, con lo que una barrera debido a la flexión de la banda en la heterounión InGaAs / GaAs es obviamente demasiado baja para ser un obstáculo esencial para los portadores de carga. Esto alinea la flexión de la banda en las capas superiores, que contribuyen directamente al PV y, por lo tanto, reduce el suministro de los portadores fotoexcitados por encima del n + -La capa de GaAs y, como consecuencia, la señal PV total.
En la figura 2b se observa una pequeña característica cercana a 1,39 eV en el espectro de la muestra pseudomórfica en contacto con los búferes MBE, aunque se debe esperar una caída drástica de la señal como en la estructura metamórfica por encima de 1,36 eV, teniendo en cuenta una flexión de banda similar cerca de n + -Interfaz GaAs / sustrato. Tal característica no es un atributo de solo sustrato y n + -GaAs dopado; tales transiciones se detectaron en estructuras QD de In (Ga) As / GaAs basadas en p -dopado [58] y sin dopar GaAs [10, 55]. Obviamente, estas transiciones también ocurren en las capas superiores de GaAs de nuestra estructura pseudomórfica, compensando principalmente el efecto negativo de las capas cercanas al sustrato en la señal PV. Como resultado, solo se puede observar una influencia insignificante de la capa cercana al sustrato en la curva negra para la muestra de InAs / GaAs en la Fig.2b en lugar de la caída en la curva de la metamórfica originada en las capas más profundas de GaAs, a pesar de un bipolar similar efecto observado con la participación directa del sustrato en la formación de PV.
La razón de la pequeña característica después de 1,39 eV en el espectro de la muestra de InAs / GaAs contactada con los tampones MBE puede ser diferente de la mencionada anteriormente para la muestra de InAs / InGaAs metamórficos. En nuestra opinión, se debe a la ligera caída de la señal causada por el borde de absorción del búfer superior de GaAs de 500 nm de grosor desarrollado en MBE que sombrea los QD y WL, que son contribuyentes más eficientes a PV en esas energías de fotones. De hecho, los electrones y huecos generados en QD y WL se llevan a lados diferentes y evitan la recombinación, a diferencia de la generación de volumen, donde la recombinación es mucho más probable. Ésta es la razón principal de la detección eficaz de fotoportadores que provienen incluso de una sola capa de QD y WL. Los fotones de energías más altas se absorben banda a banda cerca de la superficie n -La capa amortiguadora de GaAs y los electrones escapan al volumen de la muestra lejos de los orificios, lo que lleva a un aumento brusco de PV por encima de 1,4 eV. La exactitud de la razón sugerida para la característica de 1.36 eV en la estructura de InAs / GaAs en contacto con el búfer en lugar de la supuesta para una metamórfica se confirma mediante estudios de células solares basadas en estructuras de InAs / GaAs con los contactos inferiores en el n + -Sustratos de GaAs [18, 24, 59], es decir, con una banda monótona que atraviesa toda la muestra de contacto a contacto. Sus espectros fotovoltaicos revelan la misma característica sin una barrera relacionada con la interfaz de la capa MBE con el sustrato. Además, se observó una caída estrecha en el mismo rango espectral en los espectros de PC de estructuras de InGaAs / GaAs con geometría de contacto lateral y sin campo intrínseco [10, 55].
Los espectros de PC de las estructuras obtenidas a 1 V de polarización dirigidos como el campo intrínseco en las capas superiores de las estructuras (“-” en la parte superior y “+” en el contacto inferior) se presentan en la Fig. 4. Los espectros de PC para las estructuras en contacto con las capas MBE son muy similares a las PV en la Fig. 2. Los componentes de los búferes QD, WL, InGaAs o GaAs, así como n + -Las capas de GaAs se observan a las mismas energías. Respecto a las estructuras con el contacto inferior en el s i -Ga Como sustrato, los espectros de PC tienen umbrales cercanos a 0,72 eV relacionados con la absorción del centro de defectos EL2.
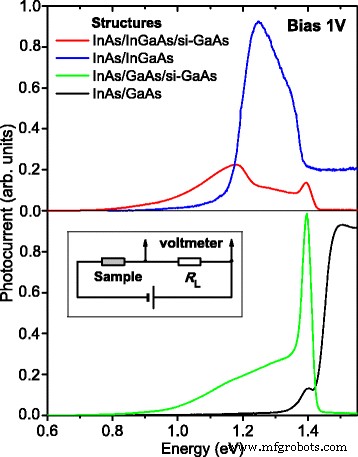
(Color en línea) espectros de fotocorriente a temperatura ambiente de los InAs / In metamórficos 0.15 Ga 0,85 Como / si -GaAs e InAs / GaAs / si convencionales -Estructuras GaAs QD. Recuadro:esquema eléctrico de conexión de la muestra para mediciones de PC
Las características de los espectros de PC para las estructuras en contacto con las capas MBE presentadas en la Fig. 4 corresponden principalmente a las de los espectros de PV en la Fig. 2 considerados anteriormente. Respecto a las estructuras con el contacto inferior en el s i -GaA como sustrato con el componente central EL2, existe una competencia entre la señal de absorción en las capas MBE y los niveles relacionados con EL2, como se discutió anteriormente. Sin embargo, las formas de las curvas permiten concluir que no hay portadores de carga excitados dentro de las capas por encima de n + -GaAs participan en PC; esto es particularmente relevante para el espectro de la estructura QD metamórfica. Obviamente, los electrones no llegan al fondo debido a la barrera de alto potencial (ver Fig. 3) inducida por si -sustrato. El sustrato tiene una resistencia demasiado alta y la principal caída del sesgo aplicado se produce sobre él, por lo que no se produce ninguna reducción de la barrera.
Por lo tanto, se puede notar que la fotovoltaica y la fotocorriente se ven afectadas negativamente por la n relacionada con el sustrato + -Capa de GaAs:la absorción por encima de 1,36 eV provoca una reducción drástica de la señal. La principal causa de la barrera debajo del contacto AuGeNi es el si -Sustrato de GaAs con un posicionamiento bastante bajo del nivel de Fermi que da como resultado que la banda se doble en sentido opuesto al de la parte superior de la estructura. Este es el único efecto del sustrato observado en el PV en tal geometría de contacto, y se manifiesta incluso en una capa intermedia bastante gruesa (400 nm) entre el contacto del fondo y el sustrato.
B. Soluciones de diseño de capa intermedia de sustrato-heteroestructura
Desde un punto de vista práctico, se puede concluir que dicho diseño de estructura InAs / InGaAs con si -El sustrato de GaAs no es útil en la ingeniería de dispositivos sensibles a la luz verticales, especialmente junto con una n relativamente delgada + tampón dopado, incluso cuando la configuración de contacto elimina el flujo de corriente a través del sustrato. El área de carga espacial formada en el n + -La región de interfaz GaAs / sustrato obliga a los portadores de carga excitados aquí a moverse en sentido opuesto a los excitados en la estructura metamórfica, como en las Figs. 3 y 5a, generando así una señal PV opuesta y reduciendo la eficiencia cuántica total de la muestra.
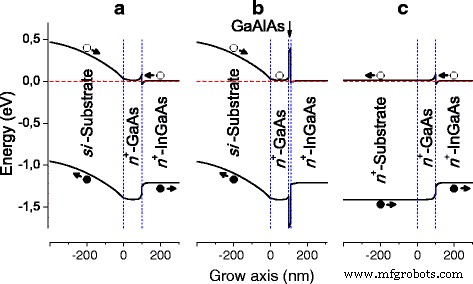
(Color en línea) perfiles de banda calculados cerca de In 0.15 Ga 0,85 Interfaces As / GaAs de la estructura metamórfica desarrollada en un si -sustrato con n + -Espesor de capa de GaAs de a 100 nm (muestra actual), b 100 nm y un delgado Ga 0.3 de 10 nm Al 0,7 Como capa de barrera y c estructura como la actual pero crecida en un n + -sustrato dopado similar al n de 100 nm de espesor + -Capa de GaAs arriba. Los cálculos se realizaron utilizando el software Tibercad [50]
Por lo tanto, para los dispositivos basados en la absorción de luz, se debe considerar un diseño de estructura diferente. Creemos que es necesario sugerir una mejora de este tipo porque muchos grupos de investigación consideran si -Sustrato de GaAs como base para la nueva p - n -tipo tanto fotodetectores de infrarrojos QD [11,12,13] como células solares [15].
Engrosamiento simple de n + El búfer -GaAs bajo estructura metamórfica parece no ser una muy buena idea. Aunque tal tampón podría absorber más cuantos de excitación por encima de 1,37 eV y ensombrecer la interfaz y el sustrato de abajo, su espesor tiene que ser muy alto, porque 800 nm de material InGaAs de banda ancha más estrecha arriba son insuficientes para suprimir por completo los efectos bipolares negativos. Además, incluso una n muy gruesa + El tampón -GaAs no puede excluir el efecto negativo de los centros de tipo EL2 que se encuentran principalmente en el sustrato y cerca de su interfaz con la capa MBE. No obstante, dado que los portadores de carga tienen un camino libre medio limitado, el engrosamiento de n + -La capa de GaAs puede debilitar el campo negativo inducido en el contacto AuGeNi de arriba.
Se podría proporcionar una mejor mejora haciendo crecer una capa de barrera delgada para los electrones provenientes del sustrato como se muestra en la Fig. 5b. Para los cálculos, un Ga 0.3 delgado sin dopar de 10 nm Al 0,7 Como capa barrera se ha elegido. Tal barrera podría confinar fuertemente los electrones excitados en el sustrato dentro del n + -Capa de GaAs. Se han utilizado capas de alta resistencia similares que crecen con materiales de banda ancha como InAlAs, GaAlAs y AlAs en estructuras láser para evitar la fuga del portador de carga de la región activa del dispositivo optoelectrónico [60]. Sin embargo, para el caso de GaAs-In 0.15 Ga 0,85 Como dispositivo basado, Ga 0.3 Al 0,7 As best matches due to the wide bandgap and small lattice mismatch between the epitaxial layer. Decreasing the carrier-induced field on the AuGeNi contact, it can suppress the negative effect of the substrate region on the photoresponse, especially in combination with increase in the n + -InGaAs layer thickness.
Yet, a more optimal design of the vertical structures seems to be in use of a monotonous gradient of doping, including an n + -doped GaAs substrate as it is proposed in Refs [14, 39, 40]. This design is the most efficient and at the same time simplest. If the substrate is doped similar to the capping n + -layer or heavier, this causes the band bending depicted in Fig. 5c. Furthermore, an essential advantage of such a substrate could manifest itself in solar cell design. A low-resistive substrate allows for utilization of the configuration with the “–” contact on the sample bottom [24, 38,39,40, 59], non-shadowing the MBE structure from the sunlight.
Conclusiones
We have shown that photoelectrical characterization evidences a critical influence of the deep levels on the photoelectrical properties of vertical metamorphic InAs/In0.15 Ga0.85 As and pseudomorphic (conventional) InAs/GaAs QD structures in the case of electrically active si -GaAs substrate. Both nanostructures manifest a bipolar PV caused by a competition of the components originated from the oppositely sloped band profiles near the GaAs substrate and bottom MBE n + -GaAs layer on one side and the rest of MBE-grown structure on the other side. An alternative contact configuration, which allows to avoid the current flow through the bottom layers, demonstrates the unipolar PV. The last configuration together with thick buffers on substrate strongly suppresses the influence of the photoactive deep levels originated from interfaces with the si -GaAs substrate on photoelectric properties of the nanostructures. However, a notable negative indirect effect of the substrate on the photovoltage and photocurrent signal from the InAs/InGaAs structure is observed when the excitation is absorbed in the substrate and near-substrate n + -GaAs MBE layer. Analyzing the obtained results and the performed calculations, we have been able to provide insights on the design of metamorphic QD structures, which can be useful for the development of novel efficient photonic devices.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- MB:
-
Metamorphic buffer
- MBE:
-
Epitaxia de haz molecular
- ML:
-
Monolayer
- PC:
-
Photoconductivity
- PL:
-
Photoluminescence
- PV:
-
Photovoltage
- QD:
-
Quantum dot
- R L :
-
Load resistance
- si :
-
Semi-insulating
- WL:
-
Wetting layer
Nanomateriales
- Diseño y desarrollo de dispositivos 5G:rangos de rendimiento 5G
- S, N Co-Doped Graphene Quantum Dot / TiO2 Composites para la generación eficiente de hidrógeno fotocatalítico
- Ingeniería del proceso de recubrimiento por inmersión y optimización del rendimiento para dispositivos electrocrómicos de tres estados
- Fuente brillante de fotón único a 1,3 μm basada en punto cuántico bicapa InAs en micropilar
- Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
- Un diseño eficiente y eficaz de nanocables de InP para la máxima captación de energía solar
- Evaluación de estructuras de grafeno / WO3 y grafeno / ceO x como electrodos para aplicaciones de supercondensadores
- Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Directrices para el diseño de RF y microondas
- Retrocesos y soluciones en el diseño de PCB RF



