Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
Resumen
Este artículo informa sobre las investigaciones experimentales y teóricas de las propiedades de fotoluminiscencia dependientes de la temperatura atípicas de los puntos cuánticos de InAs apilados múltiples en las proximidades del pozo cuántico subyacente de alivio de tensión de InGaAs. La heteroestructura de InAs / InGaAs / GaAs QD se hizo crecer mediante epitaxia de haz molecular de fuente sólida (SS-MBE) y se investigó mediante fotoluminiscencia (PL), elipsometría espectroscópica (SE) y fotoluminiscencia resuelta en el tiempo de picosegundos. Se observan picos distintivos de doble emisión en los espectros PL de la muestra. A partir de las mediciones de PL dependientes de la potencia y de la temperatura de excitación, estos picos de emisión se asocian con la transición del estado fundamental de los QD de InAs con dos poblaciones de tamaño diferente. Las mediciones de luminiscencia se llevaron a cabo en función de la temperatura en el rango de 10 a 300 K mediante la técnica PL. El PL de baja temperatura ha mostrado una emisión anormal que apareció en el lado de baja energía y se atribuye a la recombinación a través de los niveles profundos. La energía pico PL presenta un comportamiento anómalo como resultado del proceso de competencia entre portadoras localizadas y deslocalizadas. Proponemos el modelo de conjunto de estados localizados para explicar los comportamientos habituales de fotoluminiscencia. El estudio cuantitativo muestra que los estados continuos del pozo cuántico actúan como un canal de tránsito para la redistribución de portadores activados térmicamente. Hemos determinado la profundidad de localización y su efecto sobre la aplicación de la heteroestructura investigada para células fotovoltaicas. El modelo ofrece una descripción general de una posible mejora de las propiedades de SC de InAs / InGaAs / GaAs QDs basado en los cálculos teóricos.
Antecedentes
Los puntos cuánticos autoensamblados (QD) se han investigado ampliamente para posibles aplicaciones en optoelectrónica debido a la naturaleza del confinamiento de portadores tridimensionales y la densidad de estados similar a δ. Recientemente, se propusieron estructuras QD para realizar las células solares de banda intermedia (IBSC), que introducen fotoportadores adicionales a través de las absorciones de las bandas de conducción de valencia-IB e IB [1]. Los IBSC basados en GaAs con QD que tienen un intervalo de banda de energía más pequeño que los GaAs forman estructuras en tándem que son capaces de absorber fotones a energías más bajas que el intervalo de energía de GaAs, lo que da como resultado una mayor eficiencia de conversión de energía [2]. La formación de la banda intermedia QD necesita una estructura compacta de capas múltiples de QD de alta densidad [3, 4]. Sin embargo, la calidad del cristal de los QD de InAs se degrada a medida que aumenta el número de capas de QD y el espaciado de las capas disminuye debido a la acumulación de tensión de compresión interna. La tensión excesiva inducirá dislocaciones y defectos que se enroscan desde los QD hacia la superficie. Por lo tanto, el rendimiento de un QD SC de InAs / GaAs también se degrada a medida que aumenta el número de capas QD [5]. Para superar estos problemas, se ha demostrado una técnica de crecimiento de compensación de deformación con la capa amortiguadora GaAsN, GaAsP y GaP para sistemas de materiales InAs / GaAs [6, 7, 8]. Otra técnica para superar estos problemas es cubrir la capa QD de InAs / GaAs con una capa delgada de InGaAs de reducción de deformación. En comparación con los QD de InAs / GaAs, esta capa provoca un corrimiento al rojo en la foto-respuesta debido a la presencia de un pequeño desajuste de celosía entre InAs e InGaAs. El estudio de fotoluminiscencia dependiente de la temperatura proporciona información útil sobre el SC de InAs / GaAs QDs de múltiples apilados, que es de considerable interés práctico y teórico. Clásicamente, la banda prohibida de un material semiconductor se reduce monótonamente al aumentar la temperatura. Los materiales especiales, como los QD de InAs / GaAs, han mostrado una anomalía en el PL a bajas temperaturas debido a los mecanismos de transferencia de portadores activados térmicamente dentro del conjunto de puntos cuánticos. Sin embargo, estas anomalías desaparecen progresivamente después de los procesos de entremezclado posteriores al crecimiento en las heteroestructuras de InAs / InGaAs / GaAs QD, como muestran Ilahi et al. [9]. Las heteroestructuras similares a las del presente estudio han sido investigadas por su eficiencia en aplicaciones fotovoltaicas por Sayari et al. [10]. Se han propuesto muchos modelos durante las últimas décadas, como el de Passler, Vina y Varshni. Para producir dispositivos confiables, el comportamiento de la temperatura de este tipo de heteroestructuras de InAs / InGaAs / GaAs QD debe entenderse bien y esto es mediante el uso del modelo de mejor ajuste. Por la presente utilizamos el modelo clásico de Passler corregido al coeficiente de redistribución térmica, con el fin de comprender mejor la dependencia observada de la temperatura en forma de S de la banda prohibida excitónica. Nuestro estudio da lugar a una imagen precisa y autoconsistente para la localización y transferencia de portadores en una heteroestructura de InAs / InGaAs / GaAs QD, que es un material energético extremadamente importante desde el punto de vista tecnológico para la fabricación de dispositivos fotovoltaicos de alta eficiencia.
Detalles experimentales
La Figura 1 ilustra un diagrama esquemático de la heteroestructura de InAs / InGaAs / GaAs QD investigada en nuestro estudio. La heteroestructura consta de cinco pilas de InAs / In 0.11 Ga 0,89 Capas de As / GaAs QD intercaladas por una capa intrínseca de GaAs de 80 nm. Las capas epitaxiales se cultivaron en epiready n + -Sustrato de GaAs (100) que utiliza epitaxia de haz molecular de fuente sólida (SS-MBE) con sistema Riber MBE 32P. Después de la desorción de óxido, un n + de 250 nm búfer de GaAs dopado con una densidad de dopaje de 2 × 10 18 cm −3 se cultivó a 520 ° C seguido de una capa base de GaAs dopado n de 1000 nm con una densidad de dopaje de 10 17 cm −3 . Luego, la temperatura del sustrato se reduce y se estabiliza a 500 ° C para la deposición de la región intrínseca. Como se muestra en la Fig. 1, las capas repetidas consisten en 2.5 monocapas (ML) de cobertura de InAs, In 0.11 de 5 nm de espesor Ga 0,89 As y GaAs de 33 nm de espesor. La formación de los QD se controló in situ mediante el seguimiento del patrón de difracción de electrones de alta energía (RHEED). El propósito del In 0.11 de 5 nm de espesor Ga 0,89 Al igual que para desplazar al rojo los espectros de emisión y absorción, mientras que el GaAs de 33 nm de espesor actúa como una capa espaciadora. Las tasas de crecimiento de InAs, en 0,11 Ga 0,89 Las capas de As, y GaAs fueron de 0,08 ML / s, 0,78 ML / sy 0,7 ML / s, respectivamente, medidas mediante oscilaciones de puntos especulares RHEED. Al final, una capa emisora de GaAs dopado p de 500 nm (2 × 10 17 cm −3 ) seguido de un GaAs de 100 nm p + -capa de contacto dopado (5 × 10 18 cm −3 ) se cultivaron sobre la heteroestructura. Se utilizaron silicio (Si) y berilio (Be) como dopantes de tipo ny p, respectivamente. Durante el crecimiento, la temperatura fue calibrada por un pirómetro.
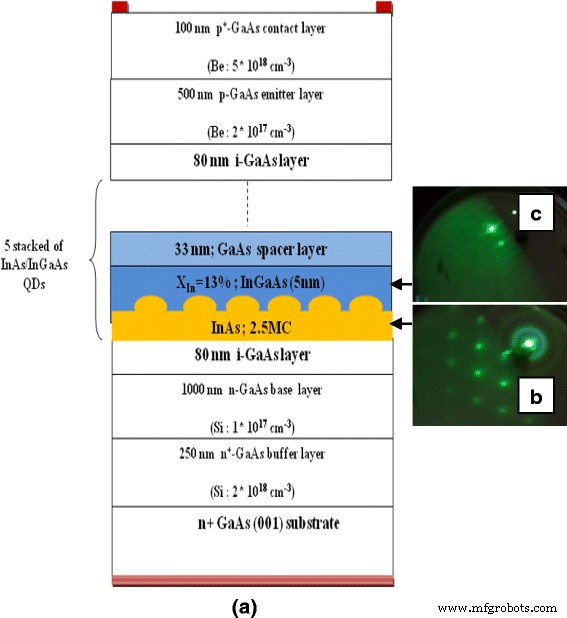
un Estructura de capa esquemática de los QD de InAs / InGaAs apilados de cinco capas SC crecidos en (001) n + -Sustrato de GaAs. b Modelo RHEED según el crecimiento de 2,5 ml de InAs (crecimiento tridimensional). c Patrón RHEED durante el crecimiento de InGaAs de 5 nm (crecimiento bidimensional) [10]
Se realizó elipsometría espectroscópica (EE) a temperatura ambiente entre 1 y 6 eV, utilizando un J.A. Elipsómetro espectroscópico de ángulo variable Woollam (VASE) M-2000. Las mediciones de SE se realizaron en ángulos de incidencia que van desde 45 ° a 60 °. En las mediciones de PL, un ion argón (Ar + ) se utilizó un láser con una longitud de onda de 514,5 nm como fuente de excitación para generar pares de electrones y huecos. La luz de luminiscencia de las muestras se dispersó mediante un espectrómetro de alta resolución y se detectó mediante un fotodetector de Ge enfriado termoeléctricamente con un amplificador incorporado. Para las mediciones de PL dependientes de la temperatura y de la potencia de excitación, las muestras se montaron en un criostato de helio de ciclo cerrado con temperatura controlada. Los espectros PL se tomaron en el rango de potencia de salida nominal de 1,5–350 mW y el rango de temperatura de 11–300 K. Las mediciones PL resueltas en el tiempo se realizaron en un helio de ciclo cerrado de temperatura variable (10–240 K) criostato. La línea de 514 nm se utilizó como longitud de onda de excitación, procedente de un láser de pulso de picosegundo Ti:zafiro bloqueado en modo a una frecuencia de repetición de 80 MHz con un ancho de pulso de 1,2 ps.
Resultados y discusiones
La Figura 2 muestra las partes reales (a) e imaginarias (b) medidas de la función dieléctrica de la heteroestructura InAs / InGaAs / GaAs QD a 300 K para el rango de energía 1-6 eV. Las partes reales e imaginarias siguen patrones diferentes. La variación de la función dieléctrica con la energía de los fotones indica que algunas interacciones entre los fotones y los electrones en las películas se producen en el rango de energía de 1 a 6 eV. Las dos características espectrales principales son la E 1 y E 2 estructuras de puntos críticos (CP) a ~ 3 y ~ 4,5 eV, respectivamente [11, 12]. Para determinar cuantitativamente la posición energética de las diferentes transiciones entre bandas, se tomó el cruce por cero del espectro de la segunda derivada de la parte imaginaria de la función pseudodieléctrica. Las diferentes energías de transición obtenidas se resumen en la Tabla 1.
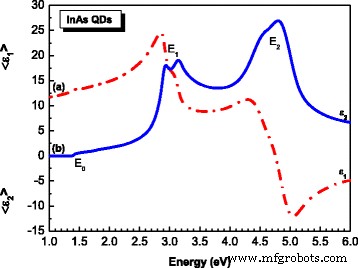
Real ( ϵ 1 ) ( línea roja discontinua ) e imaginario ( ϵ 2 ) ( línea azul continua ) partes de funciones dieléctricas de la heteroestructura de InAs / InGaAs QD obtenidas a partir de mediciones de SE [10]
La figura 3 muestra el segundo espectro derivado de energía de la parte imaginaria de la función pseudodieléctrica mostrada en la figura 2. Los dos picos a 2.9 y 3.1 eV corresponden, respectivamente, a la E 1 y E 1 + Δ 1 , transiciones entre bandas en GaAs. Sin embargo, los dos picos situados cerca de 4,4 y 4,7 eV son causados por las transiciones de CP E 0 ’Y E 2 , respectivamente, en capas de InAs QD [12]. Observamos que la contribución de la E 1 + Δ 1 Energía CP (2,74 eV) [12] de InAs al E 1 uno (2,91 eV) [11] de GaAs no puede excluirse debido a la pequeña diferencia entre los dos valores de energía. A baja energía, la banda prohibida de GaAs se distingue claramente en el ε espectro a aproximadamente 1,4 eV. Además, el segundo espectro derivado de energía (Fig. 3) muestra una transición entre bandas a 1,75 eV que corresponde al E 0 + Δ 0 Energía CP de GaAs [11]. Se sabe que ε 2 es un indicador y una medida de la calidad del material; el valor más alto implica la interfaz más abrupta [13]. Según la literatura, ε 2 valores de alrededor de 25, siendo el valor más alto 26,8 en nuestro caso, obtenido en la región de la E 2 banda prohibida cerca de 4,7 eV, indica la alta calidad de los materiales que forman la heteroestructura de InAs / InGaAs / GaAs QD cultivada por SS-MBE.
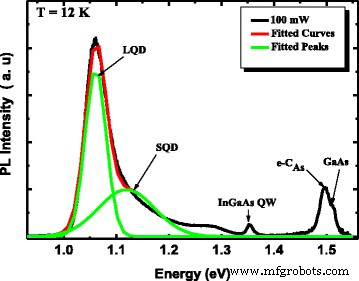
Espectro de la segunda derivada de la parte imaginaria ( ϵ 2 ) de la función dieléctrica en función de la energía del fotón para la heteroestructura InAs / InGaAs QD. Las energías de transición que surgen de las capas de InAs QD y las capas de GaAs se indican [10]
La Figura 4 muestra el espectro PL de la región activa en la heteroestructura InAs / InGaAs / GaAs QD con una potencia de excitación de 100 mW a baja temperatura (12 K). Obviamente, el espectro presenta una forma asimétrica ubicada en el lado de alta energía y que puede deconvolucionarse en dos subbandas mediante ajuste gaussiano [14]. Teniendo en cuenta la dependencia de los potenciales de confinamiento cuántico del tamaño del punto, el pico más intenso ubicado en 1.06 eV se atribuye a la emisión de los estados fundamentales de QD más grandes (LQD), mientras que el pico de energía más alto en 1.11 eV se refiere a la emisión de los estados fundamentales de los QD más pequeños (SQD) [15]. Así, a muy baja potencia de excitación y baja temperatura, deducimos que la forma asimétrica se debe a la luminiscencia que se origina a partir de una distribución de tamaño bimodal de puntos [16]. Además, los picos que se originan en la capa de pozo cuántico de InGaAs, la recombinación entre los electrones en la banda de conducción de GaAs y los huecos en el nivel del aceptor de carbono (e-C As ) [17] y la banda prohibida de GaAs se observan alrededor de 1,35, 1,49 y 1,51 eV, respectivamente. Para confirmar esta atribución a la forma asimétrica, llevamos a cabo mediciones de PL a diferentes potencias de láser que van desde 10 a 100 mW. También realizamos mediciones de AFM en una estructura descubierta similar a la investigada. De la Fig. 5, está claro que la heteroestructura tiene una forma PL independiente de la potencia. Aparte del espectro de excitación más alto, la intensidad de PL y el ancho de línea del pico de PL de alta energía de heteroestructura no se modifican significativamente. Además, la separación de energía entre los dos picos PL (Fig. 5) es de alrededor de 50 meV. Como se esperaba, la imagen de AFM demuestra que los QD en la quinta capa poseen una distribución de tamaño bimodal con una densidad de QD total de 7 × 10 10 cm ^ (-2). Suponiendo que los picos laterales de baja energía de la heteroestructura corresponden al estado fundamental de grandes QD (LQD), podemos decir que los picos de alta energía a alta potencia parecen ser el resultado de los estados fundamentales de QD relativamente pequeños (SQD ).
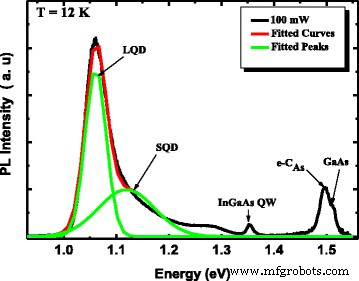
Espectro PL medido a baja temperatura (12 K) de la heteroestructura de InAs / InGaAs QD apilada de cinco capas. Un análisis de espectros de forma de línea demuestra que la señal QD PL es una convolución de dos picos en forma de Gauss como se muestra con líneas continuas

Espectros PL normalizados dependientes de la potencia de excitación de la heteroestructura QD de InAs / InGaAs medida a 12 K
Para tener una idea de los mecanismos de recombinación de PL, se realizan mediciones de PL dependientes de la temperatura en la heteroestructura de 10 a 300 K y se muestran en la Fig. 6. La Figura 7 muestra la posición de energía PL del pico principal asociado con la emisión de LQD. Este pico muestra una dependencia anormal de la temperatura entre 10 y 100 K en comparación con otras aleaciones ternarias III-V como las GaAlAs convencionales [18]. En este rango de temperatura (región (i)), se observa un corrimiento al rojo de alrededor de 12 meV. Este cambio se debe a la recombinación de excitones a través de los estados localizados dentro del conjunto de LQD distribuidos de manera no homogénea. A medida que aumenta la temperatura dentro de este rango de temperaturas, los portadores se activan térmicamente y se transfieren de los QD más pequeños a los más grandes dentro del conjunto, donde finalmente se recombinan radiativamente. Esto hace que los fenómenos observados probablemente se originen a partir de la gran dispersión del tamaño de los puntos en nuestra estructura (ver recuadro AFM). La temperatura característica en la que los dos procesos de recombinación (portadores localizados y deslocalizados) participan igualmente en la señal PL se denota como T loc / deloc . Entonces, entre 100 y 120 K (región (ii)), la energía pico aumenta. Esto se debe al escape de los portadores de los estados menos profundos a los más altos. La temperatura característica se denota como T escapar . Incluso a alta temperatura (región (iii)), los excitones se deslocalizan totalmente y se recupera una recombinación de banda a banda.

Espectros PL dependientes de la temperatura de la heteroestructura de InAs / InGaAs QD medidos a una potencia de excitación de 100 mW

Energías máximas de LQD PL de la heteroestructura QD de InAs / InGaAs investigada medida a varias temperaturas
Para comprender mejor el proceso de recombinación en QD de apilamiento múltiple de InAs / InGaAs / GaAs, hemos estudiado el PL resuelto en el tiempo utilizando la técnica de fotoconteo de tiempo correlacionado. Teóricamente se predijo que la vida útil de la desintegración del excitón de los QD es sensible a la temperatura [19]. Las mediciones experimentales han demostrado que los tiempos de vida son de hecho una constante de temperatura por debajo de una temperatura crítica [20]. Markus y col. [21] informó una vida útil constante de aproximadamente 950 ps en un amplio rango de temperatura dentro del error experimental.
La Figura 8a presenta el espectro de desintegración PL, entre 17 y 240 K para una energía de detección fijada en 1.06 eV y una energía de excitación ( λ exc =514 nm). Estos espectros están bien ajustados teóricamente por una función mono-exponencial, con un tiempo de decaimiento de ~ 1000 ps en temperaturas más bajas. Este lento tiempo de desintegración, en comparación con las películas delgadas de semiconductores III-V [22], es una señal de la presencia de estados localizados [23], y la recombinación de los portadores en el pico de LQD debería ser puramente radiativa. De hecho, a baja temperatura, los electrones y huecos fotogenerados, antes de recombinarse, necesitan tiempo para formar excitones y relajar su energía para ser capturados por los estados localizados poco profundos. Estos fenómenos conducen a un tiempo de descomposición lento. Se ha estudiado el efecto de la temperatura sobre el tiempo de caída de PL y muestra la presencia de dos regímenes diferentes como se representa en la Fig. 8b [24]. Observamos que el tiempo de caída asociado a la menor energía de la banda PL (LQDs (1.06 eV)) es casi constante (1000 ps) hasta 140 K, y luego, disminuye a medida que aumenta la temperatura.

un Tiempo de caída del pico de LQD frente a la temperatura de la muestra para una excitación de longitud de onda de 514 nm. b Intensidad de disminución de fotoluminiscencia típica frente a la temperatura del pico LQD medido a una longitud de onda de excitación de 514 nm
Enfoque teórico
Para comprender la dependencia anómala de la temperatura de PL, se investigó la posición del pico de PL utilizando el modelo LSE desarrollado por Li et al. [25, 26]. De hecho, este modelo cuantitativo proporciona una explicación satisfactoria de las características espectrales anómalas de la luminiscencia de estado localizado previamente observada en varios materiales III-V, como las aleaciones B (In) GaAs / GaAs [27, 28] basadas en boro y las InGaAs / GaAs MQW [29, 30]. El modelo asumió que el estado localizado tiene una distribución de energía de tipo gaussiano para la densidad de estados dada por:
$$ \ rho (E) ={\ rho} _o {e} ^ {- {\ left (\ frac {E- {E} _ {\ mathrm {ch}}} {2 {\ sigma} ^ 2} \ derecha)} ^ 2} $$ (1)Donde σ y E ch son el parámetro de ampliación para la distribución de los estados localizados (profundidad de localización) y el nivel de barrera que los portadores deben superar para transferir, respectivamente. En estado cuasi estacionario, la dinámica de los excitones localizados se puede describir mediante las siguientes ecuaciones de velocidad:
$$ \ frac {dN \ left (E, T \ right)} {dt} =G (E) + \ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E) } {\ Lambda} - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {tr}}} {e} ^ {\ frac {E- {E} _a} {K_B T} } - \ frac {N \ left (E, T \ right)} {\ tau _ {\ mathrm {r}}} =0 $$ (2)Los parámetros τ r , τ tr , γ c , K B , Λ y N 'representan, respectivamente, el tiempo de recombinación de la portadora (vida útil radiativa), el tiempo de transferencia de la portadora (vida útil no radiativa), el coeficiente de recaptura, la constante de Boltzmann, el número total de estados localizados y el número total de portadores que se activan térmicamente lejos del estados localizados. G ( E ) representa la tasa de generación de portadoras. La cantidad \ (\ frac {\ gamma_c N \ hbox {'} \ left (E, T \ right) \ rho (E)} {\ Lambda} \) es el número de portadores recapturados por los estados localizados por unidad hora. El tercer término a la derecha da la tasa de escape térmico de los portadores localizados. El último representa la tasa de despoblación de portadores debido a la recombinación radiativa. La densidad de población de portadores de portadores localizados es proporcional a la función de distribución y la densidad de estados de portadores localizados. De hecho, la solución de la ecuación. (2) puede describirse mediante la ecuación. (3).
$$ N \ left (E, T \ right) =\ frac {\ rho_o {e} ^ {- {\ left (\ frac {E- {E} _0} {2 {\ sigma} ^ 2} \ right) } ^ 2}} {\ left [\ frac {\ tau _ {\ mathrm {tr}}} {\ tau _ {\ mathrm {r}}} + exp \ left (\ frac {\ left (E- {E} _ {\ mathrm {ch}} \ right)} {K _ {\ mathrm {B}} T} \ right) \ right]} $$ (3)donde E 0 es la energía central. Matemáticamente, la dependencia de la temperatura de la posición del pico debido a la redistribución térmica de la portadora dentro de los estados localizados determinada a partir de \ (\ frac {\ parcial N \ left (E, T \ right)} {\ partial t} =0 \) está dada por :
$$ E (T) ={E} _0- x (T) {K} _B T $$ (4)Donde x ( T ) es la solución numérica de la ecuación no lineal. (5):
$$ x {e} ^ x =\ left [{\ left (\ frac {\ sigma} {K_b T} \ right)} ^ 2- x \ right] \ left (\ frac {\ tau _ {\ mathrm {r }}} {\ tau _ {\ mathrm {tr}}} \ right) exp \ left [\ frac {\ left ({E} _0- {E} _ {\ mathrm {ch}} \ right)} {K_ { \ mathrm {B}} T} \ right] $$ (5)
La ecuación 5 tiene solo una solución para \ (0
Se sabe que la banda prohibida de un material semiconductor idealizado suele describirse mediante la fórmula empírica de Passler [32]. Teniendo en cuenta la corrección debida al coeficiente de redistribución térmica, la variación de la posición de pico de luminiscencia utilizando el modelo LSE descrito por Eq. (7):
donde θ es un parámetro de temperatura característico que se esperaba que fuera comparable con la temperatura de Debye θ D . Para T >> θ , vemos que α representa solo el límite de la magnitud de la primera derivada, \ ({\ frac {dEg (T)} {dT}} _ {T \ to \ infty} \). El exponente “p” está relacionado con la forma de la función espectral subyacente electrón-fonón [33]. El modelo proporciona un buen ajuste a la evolución experimental que se confirma en la Fig. 9. Los parámetros de ajuste se resumen en la Tabla 2.
Evolución de la fotoluminiscencia dependiente de la temperatura del pico LQD ( cuadrados negros sólidos ) ajustado utilizando la ley empírica de Passler ( línea sólida azul ) y la verdad de la relación de Passler modificada con el modelo LSE ( línea sólida roja )
La energía pico PL depende en gran medida de la redistribución térmica representada en la Fig. 10. Esto último indica un rápido aumento en el rango de temperatura criogénica. El máximo de redistribución térmica corresponde al máximo de corrimiento al rojo en la evolución de la energía (~ 50–100 K). En la región de alta temperatura PL, la redistribución térmica disminuye exponencialmente y tiende a anularse a partir de los 150 K se inicia el proceso de deslocalización y el retorno a las transiciones banda a banda. Así mismo, lo podemos observar cuando se superponen las curvas clásica y modificada (Fig. 9). El exponente “p” indica que la contribución de los fonones acústicos longitudinales (LA) es más significativa que la contribución de los ópticos longitudinales (LO ) fonones. Esta contribución parece ser dominante en la región de alta temperatura PL donde la emisión es asistida por fonones. El proceso de distribución bimodal abre un canal de acoplamiento entre QD que está representado por electrones deslocalizados y estados de huecos separados por una energía E ch . El origen de este canal de acoplamiento sigue siendo objeto de controversia [34,35,36]. Sin embargo, el canal de acoplamiento puede verse como los estados intermedios que existen entre los estados WL bidimensionales y QD de dimensión cero [37]. Por lo tanto, se puede imaginar que los portadores en los estados QD pueden excitarse térmicamente más fácilmente al canal de acoplamiento que el WL debido a la menor energía de activación necesaria, y luego transferirse a sus QD vecinos dentro de una distancia finita. Aparece como el nivel de Fermi-Dirac en la distribución de Fermi-Dirac. Esta energía E ch es menor que la energía de activación E a extraído del diagrama de Arrhenius (Fig. 11). La razón por la que E a es mayor puede explicarse por el hecho de que los portadores necesitan mayor energía para alcanzar la capa humectante (WL) como se muestra esquemáticamente en la Fig. 12. Además, la magnitud de la diferencia Δ E = E ch - E 0 juega un papel más significativo en la determinación de la dependencia anormal de la temperatura de la luminiscencia de los portadores localizados. Debemos señalar que los dos casos, E ch - E 0 > 0 y E ch - E 0 <0, existen desde un punto de vista físico, pero generalmente se asigna como energía de activación térmica "positiva". En nuestro caso, esto implica que E ch es 4 meV por debajo de E 0 en el que los portadores localizados se activan térmicamente a estados (o sitios en el espacio real) con energías más altas. Disminuye en comparación con una sola capa de InAs QD con In 0.15 Ga 0,85 Como capa subyacente reductora de tensión [10]. La profundidad de fluctuación potencial asignada por σ es el resultado de la falta de homogeneidad en la distribución del tamaño de los QD. Se encuentra que la profundidad potencial es de 19 meV. Disminuye al aumentar el número de pilas de InAs / In 0.11 Ga 0,89 As / GaAs QDs. Como resultado, podemos deducir que la disminución de la profundidad potencial aumenta la eficiencia de la estructura en comparación con una capa de QD de InAs / InGaAs / GaAs estudiada por Ilahi et al. y Helmi et al. [10, 36].
Redistribución térmica dependiente de la temperatura determinada numéricamente. Las temperaturas características ( T loc / deloc y T escapar ) se indican con respecto al proceso de localización-deslocalización
Ajuste de Arrhenius de la muestra investigada. La intensidad integrada normalizada ( círculos negros ) está equipado con tres energías de activación ( línea sólida roja )
Esquema de la distribución QD de estados localizados de electrones / huecos (excitones) ( WL capa humectante, CH canal de transferencia del operador)
En conclusión, hemos fabricado con éxito SC basado en GaAs con una pila múltiple de QD de InAs al limitar una capa de InGaAs en los QD e insertar capas espaciadoras de GaAs. Las dos principales características espectrales observadas en los espectros de función dieléctrica de la heteroestructura de InAs / InGaAs / GaAs QD a 3 y 4,5 eV se atribuyen a la E 1 y E 2 Estructuras CP de GaAs e InAs, respectivamente. El espectro PL de los QD de InAs en la matriz de GaAs es intenso y presenta una forma asimétrica, lo que indica el crecimiento de una estructura QD de InAs de alta calidad y apilada múltiple. También se demuestra la contribución de QD más grandes y relativamente más pequeños al espectro PL. Las medidas de luminiscencia se modelaron y reinterpretaron con éxito utilizando el modelo LSE desarrollado. El estudio teórico ha interpretado cuantitativamente los espectros dependientes de la temperatura observados y ha arrojado luz sobre los complicados mecanismos de emisión espontánea en QD de InAs / InGaAs / GaAs apilados múltiples, según los parámetros de ajuste. Este estudio sugiere una forma de mejorar la eficiencia de las estructuras QD de InAs / GaAs para su uso en aplicaciones fotovoltaicas. Estos resultados ayudan a mejorar la comprensión de la dinámica del portador dependiente de la temperatura en QD de ingeniería de deformaciones para mejorar la eficiencia de la estructura investigada. Además de este trabajo, estudiaremos el efecto de la orientación, así como el aumento en el número de QD de InAs / GaAs de la estructura de pila múltiple en la profundidad de localización. 

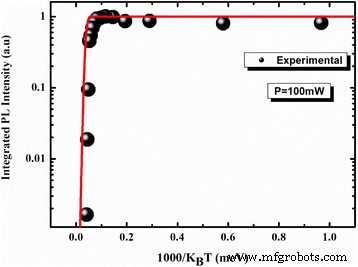
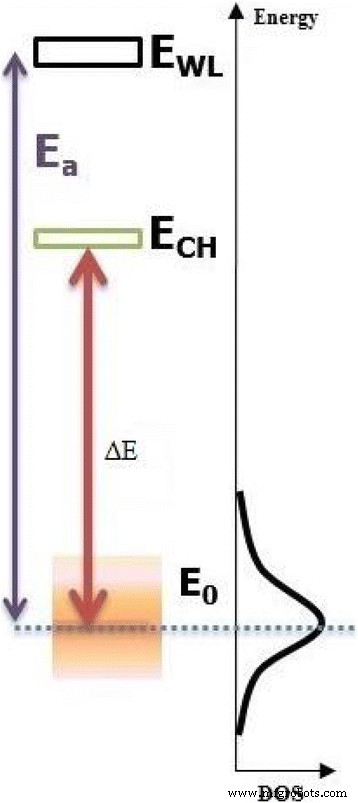
Conclusión
Nanomateriales
- Uso de ángulos para mejorar el futuro de la electrónica
- Detección del magnetismo del núcleo de un solo átomo
- Componentes de plástico:allanando el camino para la eficiencia automotriz
- Fuente brillante de fotón único a 1,3 μm basada en punto cuántico bicapa InAs en micropilar
- Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
- Control electroquímico reversible sobre la luminiscencia fotoexcitada de la película de puntos cuánticos de núcleo / carcasa CdSe / ZnS
- Rendimiento fotovoltaico de una célula solar de matriz de nanoestructura híbrida de nanocables / puntos cuánticos
- Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- El calentamiento global reducirá la eficiencia de las células solares
- Fresado CNC de 5 ejes liderando el camino hacia un mecanizado de mayor eficiencia



