Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
Resumen
Propiedades fotoeléctricas de los InAs / In x metamórficos Ga 1 - x Como punto cuántico (QD) se estudiaron nanoestructuras a temperatura ambiente, empleando fotoconductividad (PC) y espectroscopias de fotoluminiscencia, medidas eléctricas y modelado teórico. Cuatro muestras con diferente estequiometría de In x Ga 1 - x Como capa de revestimiento se han cultivado:contenido de indio x fue 0,15, 0,24, 0,28 y 0,31. InAs / In 0.15 Ga 0,85 Como se descubrió que la estructura QD es fotosensible en el rango de las telecomunicaciones a 1,3 μm. Como x aumenta, se observó un corrimiento al rojo para todas las muestras, la estructura con x =0,31 resultó ser sensible cerca de 1,55 μm, es decir, en la tercera ventana de telecomunicaciones. Simultáneamente, solo se registró una ligera disminución en el QD PC para aumentar x , confirmando así una buena fotorrespuesta comparable a la de In 0.15 Ga 0,75 Como estructuras y de nanoestructuras QD basadas en GaAs. Además, la reducción de PC se correlaciona con la reducción similar de la intensidad de la fotoluminiscencia. Al simular teóricamente el sistema de energía cuántica y la localización de portadores en QD, obtuvimos una idea del mecanismo de la PC y pudimos sugerir las razones de la reducción de la fotocorriente, asociándolas con un comportamiento peculiar de defectos en este tipo de estructuras. Todo esto implica que las QD metamórficas con un x alto son estructuras válidas para dispositivos optoelectrónicos sensibles a la luz infrarroja.
Antecedentes
InAs / In metamórficos x Ga 1 - x Como las nanoestructuras QD han atraído mucho interés en la última década debido a sus muchos beneficios [1, 2, 3, 4, 5, 6, 7]. Su característica más atractiva es que, al hacer crecer los QD en un búfer metamórfico (MB) de InGaAs, se puede lograr una reducción significativa de la energía de transición entre los niveles de QD [8] con respecto a las estructuras QD de In (Ga) As / GaAs convencionales . Esto ocurre debido a la disminución de la banda prohibida de InAs QD como resultado de la reducción del desajuste de la red entre las QD de InAs y el tampón de InGaAs y, por lo tanto, la tensión en las QD [9,10,11]. Por lo tanto, la aplicación de un MB como material de confinamiento permite desplazar el valor de la longitud de onda de emisión más profundamente en el rango de infrarrojos (IR), en particular, en las ventanas de telecomunicaciones a 1.3 y 1.55 μm, mientras se mantiene una alta eficiencia [4, 12, 13]. Además, las QD metamórficas han mostrado propiedades interesantes como (i) una alta densidad de QD [14], (ii) la posibilidad de ajustar ampliamente los niveles de QD y de la capa humectante (WL) [10, 15] y (iii) buenos rendimientos de elementos activos en dispositivos emisores de luz [16]. Sin embargo, las investigaciones recientes de niveles profundos en QD metamórficos mostraron que, a pesar de InAs / In 0.15 Ga 0,85 Como estructuras QD que tienen una densidad de defectos total cercana a la capa QD comparable a la de QD pseudomórficos de InGaAs / GaAs, estructuras metamórficas con x más alto demostraron densidades de defectos más altas [17, 18].
Las estructuras metamórficas de InAs QD han encontrado aplicaciones exitosas en el diseño y fabricación de dispositivos fotónicos y sensibles a la luz IR, tales como láseres [19, 20], fuentes de fotón único [3, 7, 21, 22] y células solares [23 , 24,25]. Los fotodetectores de In (Ga) As QD basados en transiciones entre bandas y entre subbandas se están investigando actualmente de forma activa para mejorar la detección de los rangos de IR cercano a IR de onda larga debido a su respuesta a la irradiación con una incidencia normal [26,27,28,29,30] . Por ejemplo, las transiciones entre subbandas de electrones entre niveles cuánticos confinados y estados continuos pueden diseñarse incorporando QD de InAs en capas de InGaAs [29,30,31,32], ya que este diseño permite ajustar la longitud de onda máxima de detección, para controlar el respuesta mediante un sesgo aplicado externamente y para reducir la corriente oscura [33, 34]. Hasta la fecha, no hay artículos sobre la implementación de estructuras QD metamórficas en fotodetectores.
El papel clave para el desarrollo de esta área es la preservación de una alta eficiencia de emisión y fotosensibilidad de estructuras QD metamórficas que deben ser al menos comparables con las de estructuras QD convencionales de InAs / GaAs [1, 5, 35]. Se llevaron a cabo muchos estudios en los campos fundamentales y de aplicación para desarrollar el diseño de estructuras [6, 14, 21], mejorar las propiedades fotoeléctricas [5, 13] y controlar / reducir los defectos relacionados con la deformación en las heteroestructuras [4, 36, 37].
Por lo tanto, InAs / In x Ga 1 - x Como nanoestructuras QD metamórficas son nanoestructuras interesantes, que permiten tener emisión o fotorrespuesta en los rangos de IR de 1,3 y 1,55 μm [1,2,3,4,5,6,7]. Además, informamos anteriormente que InAs / In 0.15 verticales Ga 0,75 Como las estructuras QD pueden mantener una fotosensibilidad comparable a las basadas en GaAs [5]. Sin embargo, estas estructuras metamórficas rara vez se estudian en mediciones fotoeléctricas con una geometría lateral, donde la fotocorriente procede a través del transporte en el plano de portadores a través de canales entre dos contactos superiores. Comúnmente, las capas QD junto con el WL asociado forman estos canales de conductividad en las estructuras basadas en GaAs diseñadas con geometría lateral [38]. Debido a este tipo peculiar de conductividad, se cree que los fotodetectores QD con transporte lateral tienen potencial para una alta fotorrespuesta [39, 40]. Un estudio en profundidad de nanoestructuras metamórficas de InAs / InGaAs QD en la configuración lateral puede proporcionar un conocimiento fundamental sobre el mecanismo de fotoconductividad (PC) y la eficiencia del transporte de portadores en plano. En nuestro artículo reciente dedicado a los defectos en las estructuras QD metamórficas [17], informamos de las mediciones de PC lateral a bajas temperaturas, considerando solo los bordes del espectro IR que se originan a partir de defectos. Sin embargo, creemos que una caracterización adecuada y una investigación fundamental de la estructura a temperatura ambiente pueden proporcionar información valiosa para futuras mejoras de nuevos dispositivos sensibles a la luz como fotodetectores de infrarrojos cercanos, matrices lineales y matrices de cámaras, mediante la implementación de QD metamórficos.
En el presente trabajo, estudiamos las propiedades fotoeléctricas en plano de las metamórficas InAs / In x Ga 1 - x Como nanoestructuras QD cultivadas por epitaxia de haz molecular con diferente composición x , empleando PC y espectroscopias de fotoluminiscencia (PL), mediciones eléctricas laterales y cálculos de modelado. En particular, nos enfocamos en la observación de un posible corrimiento al rojo de la fotorrespuesta de la capa QD hacia el IR más allá de 1.3 μm mientras preservamos la fotosensibilidad por igual para In 0.15 Ga 0,85 Estructuras sensibles a la luz de As y GaAs QD. Una alta fotosensibilidad en el rango de longitud de onda del infrarrojo cercano a temperatura ambiente es una indicación de que estas nanoestructuras pueden ser útiles no solo para dispositivos basados en transiciones entre bandas sino también para fotodetectores entre subbandas que trabajan más allá de 10 μm.
Métodos
Preparación y descripción de la muestra
Las estructuras estudiadas que se muestran esquemáticamente en la Fig. 1 se cultivaron mediante epitaxia de haz molecular. En primer lugar, se cubrió un sustrato de GaAs semi-aislante (100) con un tampón de GaAs de 100 nm de espesor a 600 ° C, seguido de la deposición de un MB de InGaAs sin dopar de 500 nm de espesor a 490 ° C. Luego, después de la interrupción del crecimiento anterior de 210 s para enfriar el sustrato, se cultivaron 3,0 ml (monocapas) de InAs a 460 ° C. Finalmente, estos QD autoensamblados fueron cubiertos por 20 nm de In x sin dopar Ga 1 - x Como ocurre con la misma estequiometría de MB. Cuatro muestras con diferente estequiometría de In x Ga 1 - x Como capa de revestimiento se ha fabricado:En contenido x fue 0,15, 0,24, 0,28 y 0,31.
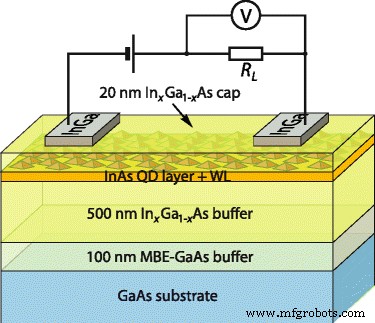
Colorea online. Esquema de los InAs / In x metamórficos Ga 1 - x Como estructuras QD y su conexión para las medidas fotoeléctricas
Modelado teórico
Para el diseño de estructuras metamórficas, así como la comprensión del perfil de energía, los cálculos del sistema de energía cuántica compuesto por In (Ga) As QDs, MB sin dopar y capa cap se llevaron a cabo utilizando el software Tibercad [41] que demostramos para Ser adecuado para simular las propiedades ópticas de nanoestructuras semiconductoras de baja dimensión [2, 15, 42].
Consideramos un InAs QD con forma cónica truncada y tamaños tomados de datos experimentales de microscopía de fuerza atómica [14]; incluimos la presencia de InAs WL, cuyos parámetros dependen del In x Ga 1 - x Como propiedades de capa metamórfica [15].
Primero, se realizan cálculos de deformación para la estructura, mediante el cálculo de los componentes del tensor de deformación de la QD, inducida por el desajuste f QD entre QD y MB, definido como
$$ {f} _ {\ mathrm {QD}} =\ left [{a} _ {\ mathrm {InAs}} \ hbox {-} {a} _ {\ mathrm {MB}} (x) \ right ] / {a} _ {\ mathrm {MB}} (x) $$ (1)donde a MB ( x ) es el parámetro de celosía de In x Ga 1 - x Como MB y a InAs es el parámetro de celosía de InAs. Luego, los perfiles de banda para QD y las capas de incrustación dependen de los potenciales de deformación de los materiales relevantes (InAs para QD y WL e InGaAs relajados para MB).
Finalmente, la ecuación de Schrödinger
$$ \ boldsymbol {H} \ psi =E \ psi $$ (2)se resuelve en la aproximación de la función envolvente mediante un enfoque de masa efectiva de una sola banda para electrones y un enfoque k • p de 6 bandas para huecos, donde el hamiltoniano 3D es
$$ \ widehat {H} =- \ frac {\ upeta ^ 2} {2} {\ nabla} _ {\ mathbf {r}} \ left (\ frac {1} {m \ left (E, \ mathbf { r} \ derecha)} \ derecha) {\ nabla} _ {\ mathbf {r}} + V \ izquierda (\ mathbf {r} \ derecha), $$ (3)con V ( r ) siendo el potencial 3D.
Esta aproximación se considera satisfactoria cuando se realiza el cálculo del estado fundamental de QD [2]. Se obtienen así niveles de suelo para electrones y huecos pesados, junto con sus densidades de probabilidad. Las energías de emisión de fotoluminiscencia se obtuvieron tomando la diferencia de energía entre los niveles confinados de electrones y los agujeros pesados, reducidos en 20 meV para tener en cuenta los efectos excitónicos.
Se puede encontrar una descripción más detallada de los cálculos del modelo en la Ref. [2].
Caracterización fotoeléctrica
Para las mediciones fotoeléctricas laterales, se depositaron dos contactos superficiales eutécticos InGa sobre piezas de 5 × 2 mm de las estructuras. I lineal medido - V las características dadas en la Fig. 2 han confirmado la ohmicidad de contacto. La corriente que fluye a través de las muestras se midió con un multímetro Siglent SDM3055, utilizando una técnica de CC estándar [43, 44] como una caída de voltaje a través de una resistencia de carga en serie R L de 1 MΩ, que era mucho menor que la resistencia de la muestra. La fotocorriente se excitó mediante una lámpara halógena de luz de 250 W dispersada con un monocromador de prisma, y los espectros de PC se registraron en el rango de 0,6 a 1,6 eV [44,45,46]. Los espectros se normalizaron al número de cuantos de excitación de la fuente de luz. Los espectros PL se obtuvieron utilizando un láser de 532 nm como fuente de excitación con una densidad de potencia de 5 W / cm 2 . Todas las mediciones se realizaron a temperatura ambiente (300 K).

Colorea online. yo - V características de los InAs / In x Ga 1 - x Como estructuras con x =0.15 ( a ), 0,24 ( b ), 0,28 ( c ) y 0,31 ( d ) para la oscuridad (negro) y bajo una iluminación de 350 μW / cm 2 (color) a energías de pico del espectro PL (excitación QD) y 1.3 eV (absorción efectiva en InGaAs). Recuadros:dependencias de la fotocorriente en el voltaje de polarización
Resultados y discusión
Espectros de PC de los InAs / In x metamórficos estudiados Ga 1 - x Como las estructuras QD a temperatura ambiente se muestran en la Fig. 3 junto con las bandas PL, que muestran las transiciones ópticas entre los estados fundamentales de QD. Las intensidades relativas y las posiciones de las bandas PL también se muestran en la Fig. 4b. Las características debidas a las QD, las capas de confinamiento de InGaAs y las capas inferiores de GaAs se observan en las curvas de PC. La señal de fotocorriente a las energías por debajo de los inicios de la banda PL podría estar relacionada con los defectos de estructura detectados anteriormente [17].

Colorea online. Espectros de PC de los InAs / In x metamórficos Ga 1 - x Como estructuras a temperatura ambiente y una polarización de 11 V para x =0.15 ( a ), 0,24 ( b ), 0,28 ( c ) y 0,31 ( d ). Las intensidades de excitación para las curvas negra, roja y azul a 1,3 eV corresponden a 88, 350 y 1400 μW / cm 2 , respectivamente. Los espectros PL en unidades arbitrarias se dan para el posicionamiento de energía de las transiciones del estado fundamental QD. Las flechas verticales marcan los huecos de banda de InGaAs (ε g ) calculado siguiendo a Paul et al. [48] y positones espectrales, donde se midieron las dependencias de PC sobre la intensidad de excitación (que se muestran en la Fig. 5)

Colorea online. Cálculos de modelado para los InAs / In x metamórficos Ga 1 - x Como estructuras QD: a perfiles de banda en las estructuras con diferentes x a lo largo del eje de crecimiento; b las bandas reales de QD PL y sus posiciones pico calculadas (verticales discontinuas); y c densidades de probabilidad de los electrones confinados y huecos para el InAs / In 0.15 Ga 0,85 Como QD. Todos los cálculos de estructuras modeladas se realizaron para 300 K
Los InAs / In 0.15 metamórficos investigados Ga 0,85 Como se descubrió que la estructura QD era fotosensible en el rango de las telecomunicaciones a 0,95 eV (1,3 μm) (Fig. 3a). Como x aumentado, se observó un corrimiento al rojo para todas las muestras:la estructura con x =0,31 resultó ser sensible cerca de 0,8 eV (1,55 μm) (Fig. 3d), es decir, en la tercera ventana de telecomunicaciones [47]. El cambio está relacionado con la reducción del desajuste de la red entre los materiales de InAs QD e In x Ga 1 - x Como búfer con un aumento en x y, por tanto, una disminución de la deformación en QD. Esto conduce a un estrechamiento de la banda prohibida de InAs QD y, a su vez, al desplazamiento al rojo de la banda PL, así como al inicio de la fotorrespuesta hacia IR [1,2,3,4,5,6, 19, 35].
Simultáneamente, solo se registró una leve disminución en la señal de fotocorriente QD, lo que confirma la preservación de una buena fotorrespuesta, comparable con la de In 0.15 Ga 0,75 Como muestra. Como comentamos recientemente [5], las estructuras QD metamórficas con x =0,15 muestran una fotorrespuesta muy similar a la de las nanoestructuras pseudomórficas de InAs / GaAs QD. Además, la reducción de PC se correlaciona con la de PL como se puede ver en la Fig. 3.
Tal efecto para nuestras muestras resultó ser más notable en la Fig.2, donde el I - V Se muestran las dependencias en la oscuridad y bajo iluminación en diferentes puntos espectrales característicos de la tensión de polarización, junto con las dependencias de la fotocorriente en las inserciones. Como en la Fig. 3, el valor de la fotocorriente implica solo la parte fotoinducida de la corriente obtenida de la corriente total bajo iluminación restando el valor de la corriente oscura. Estos puntos espectrales son los máximos de la banda PL y 1.3 eV, donde ocurre una absorción banda a banda efectiva en InGaAs MB. Así como para el yo oscuro - V características, estas dependencias son lineales dentro del error experimental.
La mejor fotorrespuesta se midió en la estructura con el mínimo contenido de In en las capas de confinamiento. También tenía la corriente oscura más baja. El valor de fotocorriente al nivel de excitación aplicado (350 μW / cm 2 ) en InAs / In 0.15 Ga 0,85 La estructura estaba dos o tres veces por encima de la corriente oscura cuando se bombeó MB. La fotorrespuesta en la excitación QD fue comparable a la corriente oscura; sin embargo, debe tenerse en cuenta que nuestras estructuras solo tenían una capa QD. La fabricación de las estructuras QD multicapa seguramente conduciría a un aumento significativo en la fotorrespuesta IR. Otras estructuras con x más alto reveló señales de fotocorriente más bajas; las magnitudes detectadas en ambos puntos espectrales fueron aproximadamente un orden más bajo que los valores de la corriente oscura en un amplio rango de voltaje aplicado. La respuesta fotográfica más baja se encontró para InAs / In 0.31 Ga 0,69 Como estructura con el contenido máximo de MB en.
Lo más probable es que esta disminución de la fotorreactividad esté relacionada con un aumento en la densidad de defectos de MB con x , que se determinó anteriormente para estas estructuras, empleando espectroscopía de corriente estimulada térmicamente de nivel profundo [17], que se correlacionó bien con el análisis estructural de tales nanoestructuras [1]. Hemos informado que el InAs / In 0.15 Ga 0,85 Como la estructura QD tenía una densidad de defectos total cercana a la capa QD comparable a las de InGaAs / GaAs, mientras que otras estructuras con mayor contenido de In demostraron mayores densidades de defectos como los conocidos complejos de defectos puntuales relacionados con GaAs EL2, EL6, EL7, EL9 y EL10 cerca de la capa QD y tres niveles atribuidos a defectos extendidos que se propagan a través del búfer.
Con respecto a la forma del espectro (Fig.3), por encima de la excitación QD, la absorción de luz y, por lo tanto, la generación de portadores ocurren principalmente en el MB a energías por encima de la banda prohibida de la capa de confinamiento de InGaAs ε g , cuyos valores para diferentes x se estimaron mediante una fórmula empírica [48]. Sin embargo, es digno de mención que un aumento en la energía de los fotones por encima de ε g conduce a una ligera disminución de la fotorrespuesta. Naturalmente, esto confirma que los QD metamórficos, a pesar de ser centros de recombinación efectivos [1, 2, 12, 22], son contribuyentes más eficientes a la fotocorriente que MB [5, 6, 23].
Para comprender el mecanismo de PC de esta peculiaridad, uno debe mirar la Fig. 4a, donde mostramos los perfiles de banda QD calculados a lo largo de la dirección de crecimiento para nuestras muestras. Los cálculos son validados por el resultado de los niveles de energía cuántica para electrones y huecos:las energías de emisión PL esperadas están de acuerdo con la transición del estado fundamental PL QD medida experimentalmente (Fig. 4b). En la Fig. 4c, mostramos las densidades de probabilidad simuladas para electrones y huecos confinados, obtenidas por las funciones de onda portadora calculadas con la modelización de Tibercad, que indican un mayor nivel de localización para huecos pesados en comparación con los electrones.
Para contribuir a la señal de fotocorriente, los pares de agujeros de electrones generados por la absorción interbanda QD tienen que escapar de los QD por emisión térmica. En un estudio anterior [49], se estableció que en las QD metamórficas, los electrones y los huecos pesados escapan simultáneamente de las QD como pares correlacionados. Además, también se demostró que la energía de activación de dicho proceso corresponde a la suma de las energías de activación de las dos partículas [50].
Mientras estudiamos la extinción térmica de la emisión de PL a partir de QD metamórficos [10, 51], demostramos que tales energías de activación son iguales a la suma de la distancia de energía desde los niveles de WL y los estados de QD y van desde 250 meV para x =0,15 hasta 150 meV para x =0,31. Como se discutió ampliamente en la Ref. [51], estos valores provocan una fuerte extinción de la emisión de PL a temperatura ambiente a través del escape térmico de los portadores confinados.
Sobre esta base, podemos inferir que los portadores excitados en QD pueden escapar térmicamente a WL y MB:allí, los electrones y los agujeros pesados están separados por la curvatura de la banda en la vecindad de QD (Fig. 4a), lo que promueve que el agujero vuelva a atraparse en QD. y, aunque es una barrera para los electrones, suprime eficazmente su recombinación radiativa. Como consecuencia, los agujeros pesados se concentran en la periferia QD (Fig. 4c), mientras que los electrones son libres de moverse a lo largo del pozo potencial de WL y MB contribuyendo a la conductividad. Vale la pena señalar que en la Ref. [49], se discute que, aunque correlacionados durante el proceso de escape, los portadores no pueden considerarse como excitones a temperatura ambiente; de ahora en adelante, pueden separarse fácilmente mediante la flexión de la banda en las proximidades de los QD.
De lo contrario, al excitar el MB, se generan huecos de no equilibrio en las capas de confinamiento y se recombinan con los electrones. Cabe mencionar aquí que se sabe que el WL es un canal de conductividad para nanoestructuras basadas en GaAs [52] y, en nuestras estructuras laterales diseñadas con contactos de superficie, no hay heterounión, por lo que los portadores se recolectan de manera eficiente cerca del plano de superficie.
En la Fig.3, la caída de la señal de PC justo por encima de ε g se convirtió en un aumento a energías más altas, por ejemplo, por encima de 1.3 o 1.1 eV para la muestra con x de 0,15 o 0,31, respectivamente. Esto fue posiblemente causado por la absorción óptica más cercana a la superficie y la capa QD, involucrando así trampas menos profundas. Como se estableció para estas estructuras mediante espectroscopía de corriente estimulada térmicamente y espectroscopía transitoria de nivel profundo [17, 18], las trampas de electrones más profundas se encuentran principalmente en la capa MB de InGaAs, mientras que las menos profundas se concentran cerca de la superficie (en relación con estas muestras, cerca de la capa QD). Los electrones atrapados en las trampas menos profundas pueden escapar más fácilmente de regreso a la banda de conducción a temperatura ambiente. Por lo tanto, los electrones libres cerca de la capa QD son más móviles que los excitados más profundamente en la MB y, por lo tanto, dan una mayor contribución a la transferencia de carga. Además, los electrones, que se generan cerca de la superficie, pueden transferirse libremente al canal de conductividad WL.
Se observó una caída similar de la fotocorriente después de un aumento por encima de la banda prohibida de GaAs (cerca de 1,4 eV). Este efecto podría deberse a la generación de portadores cerca de la interfaz InGaAs / GaAs, que se sabe que tiene una mayor densidad de estados de defecto que son trampas y centros de recombinación.
La contribución relativa de las diferentes transiciones ópticas a la fotorrespuesta de la estructura varió con la intensidad de bombeo. Esto se observa mejor en la Fig.5, que muestra valores de fotocorriente en función de la intensidad de excitación en diferentes puntos espectrales característicos:el inicio de la banda PL (excitación resonante del conjunto QD) o la absorción banda a banda eficiente en InGaAs (1,3 eV) y GaAs (1,5 eV).
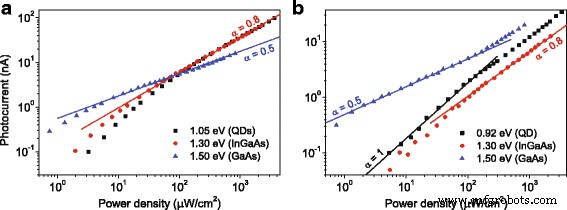
Colorea online. Fotocorriente frente a intensidad de excitación para InAs / In x Ga 1 - x Como estructuras con a x =0,15 y b 0,31. Las líneas son el ajuste por funciones f ( x ) ~ x α
Las estructuras con diferentes contenidos de In en las capas de confinamiento demostraron dependencias similares en rangos espectrales equivalentes. Entonces, la excitación de banda a banda en GaAs (1.5 eV) muestra una dependencia cuadrática en la mayoría de los valores de intensidad. Esto es típico de la recombinación banda a banda de portadores de carga que no están en equilibrio, por ejemplo, cuando son muy predominantes bajo los portadores de equilibrio [53]:esto es de esperar en nuestras estructuras no dopadas. Las dependencias en el caso de la excitación en las capas de confinamiento de QD e InGaAs son muy similares entre sí pero diferentes de las de GaAs. Son lineales a bajas intensidades de excitación y se vuelven sublineales a intensidades más altas. Este comportamiento obviamente apunta a la recombinación de portadoras que involucra centros de Shockley-Read:la dependencia lineal se vuelve sublineal, ya que algunos de los centros están saturados a tasas de generación de portadoras más altas [54]. Estos resultados de las mediciones dependientes de la intensidad indican claramente una generación eficiente de portadores de carga principales a una tasa de recombinación relativamente baja en las capas de inclusión QD y una densidad mucho mayor de centros de recombinación en las capas de GaAs. Por ejemplo, durante la excitación QD en caracterizaciones similares, las estructuras fotosensibles de InGaAs / GaAs QD mostraron una dependencia de la intensidad como PC ( Yo ) ~ Yo 0,25 , que se produjo debido a una alta tasa de recombinación no radiativa a través de niveles de defecto junto con la recombinación radiativa QD [40, 55]. Sin embargo, vale la pena notar que la estructura de InGaAs / GaAs era multicapa y tenía siete capas QD.
A partir de estas mediciones y su interpretación, se pueden destacar algunas indicaciones para el uso de QD metamórficas para la detección de IR:(i) cuando se usa x > 0.15, se deben utilizar diseños avanzados que permitan controlar los defectos relacionados con la deformación, similar a lo que se hizo para el desarrollo de QD metamórficas [19, 20, 37]; (ii) se necesitan pilas multicapa de QD (con un mínimo de 10 capas) para obtener una PC QD por encima de la corriente oscura [27, 56]; y (iii) como un mayor confinamiento de agujeros pesados es beneficioso para la fotocorriente obtenida cuando se excitan los QD, se podrían considerar diseños avanzados con barreras de mayor espacio para agujeros pesados [51, 57]. Por lo tanto, estos hallazgos pueden ser muy útiles para el diseño de QD metamórficas que tengan como objetivo la detección de IR y el desarrollo de fotodetectores QD metamórficos.
Conclusiones
Propiedades fotoeléctricas de los InAs / In x metamórficos Ga 1 - x Como las nanoestructuras QD se estudiaron a temperatura ambiente, empleando espectroscopias de PC y PL, medidas eléctricas y simulaciones de modelos teóricos. Los InAs / In x metamórficos estudiados Ga 1 - x Como se descubrió que las nanoestructuras QD eran fotosensibles en las ventanas de telecomunicaciones a 1,3 ( x =0,15) y 1,55 μm ( x =0,31). Sin embargo, se estimó que las eficiencias QD PC y PL de las estructuras con mayor contenido de In en MB eran menores y, no obstante, comparables a las de InAs / In 0.15 Ga 0,85 Como estructura, que tiene una sensibilidad similar a las estructuras QD de InGaAs / GaAs. Esta reducción de la fotorrespuesta está relacionada con un aumento en la densidad de defectos de MB con x . Además, gracias a los cálculos de modelado, proporcionamos información sobre el mecanismo de PC en el tipo investigado de estructuras QD. Todo esto implica que las QD metamórficas con un x alto son estructuras válidas para dispositivos optoelectrónicos IR sensibles a la luz, siempre que algunos puntos de interés se aborden mediante la optimización del diseño de la nanoestructura.
Abreviaturas
- ε g :
-
Bandgap de la capa de confinamiento de InGaAs
- E c y E v :
-
Energía de conductividad y bandas de valencia
- IR:
-
Infrarrojos
- MB:
-
Tampón metamórfico
- ML:
-
Monocapa
- PC:
-
Fotoconductividad
- PL:
-
Fotoluminiscencia
- QD:
-
Punto cuántico
- R L :
-
La resistencia de carga
- WL:
-
Capa humectante
Nanomateriales
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- Fuente brillante de fotón único a 1,3 μm basada en punto cuántico bicapa InAs en micropilar
- Síntesis de puntos cuánticos de carbono codopados N, S ricos en piridínicos como imitadores enzimáticos eficaces
- Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
- Un enfoque simple para sintetizar puntos cuánticos de carbono fluorescente de aguas residuales de tofu
- Síntesis de puntos cuánticos de sulfuro de antimonio solubles en agua y sus propiedades fotoeléctricas
- Síntesis sonoquímica de un solo paso y propiedades fotocatalíticas fáciles de compuestos de puntos cuánticos de grafeno / Ag3PO4
- Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
- Una descripción general completa del bus de datos:¡Conecte los puntos!



