Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
Resumen
Se informa de la formación de nanocristales de bismuto en capas de GaAsBi cultivadas por epitaxia de haz molecular a una temperatura del sustrato de 330 ° C y recocido después del crecimiento a 750 ° C. Se cultivaron superredes que contenían capas alternas de GaAsBi y AlAs de 10 nm de espesor sobre un sustrato de GaAs semiaislante. Las capas de AlAs han servido como barreras de difusión para los átomos de Bi, y el tamaño de los nanoclusters que se nuclearon después del recocido de la muestra se correlacionó con el grosor de las capas de bismido. La espectroscopia de dispersión de energía y las mediciones de dispersión Raman han demostrado que las nanopartículas están constituidas predominantemente por átomos de Bi. Después del recocido se observó una fuerte señal de fotoluminiscencia con longitudes de onda de fotones que variaban de 1,3 a 1,7 µm; su amplitud fue aumentando con el aumento del número de capas de GaAsBi. La banda de fotoluminiscencia observada puede deberse a la emisión de nanocristales Bi. Las estimaciones teóricas realizadas apoyan el supuesto. Muestran que debido al efecto de tamaño cuántico, las nanopartículas de Bi experimentan una transición al estado semiconductor de banda prohibida directa.
Antecedentes
Las heteroestructuras basadas en GaAsBi tienen un gran potencial para aplicaciones optoelectrónicas en un amplio rango espectral que se extiende desde la región del infrarrojo cercano a medio. GaAsBi es un compuesto semiconductor del grupo III – V que se investiga activamente para emisores de radiación infrarroja [1] y detectores [2, 3, 4, 5] basados en GaAs. Lewis et al. [6]; el láser de bismido inyectado eléctricamente con ~ 6% de Bi en un pozo multi-cuántico de GaAsBi / GaAs (MQW) se informó en la Ref. [7]. La principal dificultad en este campo es un aumento de la densidad del centro de recombinación no radiativa debido a las bajas temperaturas del sustrato necesarias para un crecimiento de epitaxia de haz molecular (MBE) de capas de GaAsBi con contenido de Bi superior al 5%. Uno de los procedimientos tecnológicos estándar que permite una reducción de la tasa de recombinación no radiativa es un recocido posterior al crecimiento a temperaturas más altas que las utilizadas para el crecimiento de MBE. Sin embargo, en el caso de GaAsBi, el efecto del recocido no es inequívoco. Nuestro grupo ha demostrado previamente [8, 9] que el recocido a temperaturas superiores a 600 ° C conduce a varias características nuevas, la más no trivial de las cuales es la aparición en algunas de las muestras de fotoluminiscencia bastante intensa (PL) en el rango de longitud de onda de 1,35 a 1,5 μm, este proceso va acompañado de cambios sustanciales en la capa epitaxial de GaAsBi:una reducción del contenido de Bi en la red cristalina y la aparición de grupos de tamaño nanométrico [9].
El crecimiento de nanoestructuras (nanocables, pozos cuánticos deformados o puntos cuánticos (QD)) es una forma popular de evitar el desajuste de la red entre un sustrato y la capa epitaxial que crece en él. Los ejemplos más ampliamente estudiados de QD basados en compuestos III-V son los QD basados en InGaAs- [10] e InGaN- [11] desarrollados mediante la técnica de Stranski-Krastanow [12]. En el caso de GaAsBi, dicho mecanismo de crecimiento aún no se ha realizado. En la ref. [13]. Se ha demostrado que los nanoclusters de diferentes estructuras y composiciones cristalinas (As y Bi romboédricos, así como nanoclusters de GaAsBi de mezcla de zinc) se nuclean en las capas de bismido tras el recocido; su tamaño varía entre 5 y 20 nm. Se observaron grupos romboédricos de bismuto puro en GaAsBi con un contenido de Bi relativamente grande (4,7%) cultivado a baja temperatura (200 ° C) [13]. En nuestro estudio anterior [9], se informó de una formación de grupos de Bi de tamaño nanométrico en el GaAsBi recocido a alta temperatura con un contenido de Bi superior al 6%. Además, se ha supuesto que debido a los efectos de cuantificación del tamaño, los nanoclusters de bismuto se vuelven semiconductores en lugar de semimetálicos (como es el caso de los cristales Bi a granel), y que la recombinación radiativa que tiene lugar en los racimos Bi puede ser responsable de la emisión de longitud de onda larga observada en muestras recocidas de GaAsBi [9].
El presente trabajo informa sobre la formación de nanocristales Bi en pozos cuánticos recocidos de GaAsBi / AlAs. Las capas de AlAs servían como barreras tanto para el confinamiento de un portador de carga como para evitar la difusión de Bi desde las capas de GaAsBi durante un procedimiento de recocido. La presencia de capas de AlAs ha asegurado una nucleación de nanopartículas de Bi de una manera más controlada:su distribución de tamaño era más estrecha y su densidad era más alta que en las capas a granel recocidas [9]. Las muestras obtenidas se caracterizaron mediante microscopía electrónica de transmisión de alta resolución (HRTEM), mediciones de espectroscopía PL y Raman. Los resultados de estos experimentos indican la presencia de nanocristales Bi puros en las heteroestructuras recocidas. Las estimaciones teóricas realizadas confirman que los nanocristales Bi pueden transformarse mediante los efectos de cuantificación del tamaño en semiconductores de brecha directa.
Métodos
Las estructuras de GaAsBi / AlAs MQW se cultivaron en sustratos semi-aislantes de GaAs (100) utilizando un reactor SVT-A MBE equipado con fuentes metálicas de Ga, Al y Bi, así como una fuente de craqueo de dos zonas para producir As 2 . Se utilizó el siguiente esquema de crecimiento de MBE. En primer lugar, la capa tampón de GaAs (de aproximadamente 100 nm) y la primera barrera de AlAs se cultivaron utilizando el modo de crecimiento MBE estándar a la temperatura alta de 600 ° C. Luego, se interrumpió el crecimiento y se redujo la temperatura del sustrato para un crecimiento de barreras GaAsBi QW y AlAs. Se utilizó el modo de epitaxia mejorada por migración (MEE) para la deposición de AlAs en la siguiente secuencia de crecimiento:una monocapa (ML) de Al, interrupción de 5 s para una migración de átomos del grupo III, luego un suministro de 1 ML de As [14, 15 ]. Finalmente, la estructura de MQW se cubrió con una capa de remate de GaAs de 5 nm de espesor. El contenido de Bi en las capas de GaAsBi se determinó a partir del reflejo (200) de la exploración XRD ω-2Θ y fue de aproximadamente el 7% para las muestras recién desarrolladas.
Se eligieron dos muestras de MQW diferentes para las mediciones. La muestra A de MQW contiene tres GaAsBi QW de 10 nm de espesor y uno de 20 nm de espesor (MBE cultivado a 330 ° C) separados por barreras de AlAs de 20 nm de espesor (MEE crecido a la misma temperatura). La muestra B de MQW contiene 20 QW con capas de GaAsBi de 10 nm de ancho separadas por barreras de AlAs de 4 nm de espesor cultivadas en condiciones similares a las utilizadas para el crecimiento de la muestra A. El tratamiento a alta temperatura de ambas muestras se llevó a cabo en el horno de recocido térmico rápido (RTA) a la temperatura de 750 ° C durante 180 sa ambiente de nitrógeno. Para evitar la pérdida de arsénico de la capa superficial, durante el recocido, las muestras se cubrieron con una oblea de GaAs de sacrificio.
El análisis de superficie por microscopía de fuerza atómica demostró superficies libres de gotas de estructuras MQW recién desarrolladas y recocidas. La rugosidad de la superficie de la capa superior de GaAs fue inferior a 1 nm. Las mediciones estructurales de alta resolución de nanopartículas, que se formaron en MQWs después del recocido de la muestra, fueron realizadas por FEI Tecnai G2 F20 X-TWIN TEM con módulo STEM, equipado con un detector de espectroscopía de dispersión de energía de rayos X (EDS) para elemental mapeo y un detector de campo oscuro anular de ángulo alto (HAADF) para imágenes de contraste Z. Se utilizó el microscopio de haz doble FEI Helios Nanolab 650 equipado con un manipulador Omniprobe para preparar las muestras para las mediciones de TEM.
La Figura 1 muestra la imagen STEM de la muestra A. Evidentemente, la imagen revela numerosas nanopartículas, que se formaron en capas de pozos cuánticos (QW) de GaAsBi después del recocido. En la imagen se puede rastrear una correlación obvia entre el tamaño de las nanopartículas y el ancho de las capas QW. La correlación evidencia que las capas de AlAs (regiones más oscuras) están actuando efectivamente como barreras que evitan la difusión de los átomos de Bi de las capas de GaAsBi. El mapeo elemental EDS del área seleccionada de la muestra obtenida simultáneamente con imágenes HAADF muestra (Fig. 2) que los nanocristales formados están constituidos predominantemente por átomos de bismuto.
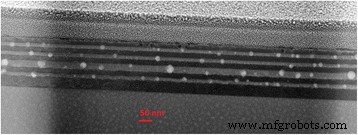
Imagen STEM de la muestra A con tres QW de GaAsBi de 10 nm de espesor y uno de 20 nm de espesor cultivados con MBE y barreras de AlAs de 20 nm de espesor crecidas con MEE después de recocido a una temperatura de 750 ° C durante 180 s

Imagen de contraste Z HAADF-STEM de nanocristales Bi en estructuras MQW de GaAsBi / AlAs ( arriba ). Las imágenes de EDS ( debajo ) representan el mapeo elemental de intensidades de Ga, Al, Bi y As, medidas en el área marcada de la imagen STEM
Resultados
Espectroscopia Raman
Los espectros Raman de las muestras de GaAsBi MQW investigadas se registraron en la geometría de retrodispersión mediante un espectrómetro Via Raman (Renishaw) equipado con una cámara CCD termoeléctricamente enfriada (-70 ° C) y un microscopio. La línea de radiación de 532 nm del láser de estado sólido bombeado por diodos se utilizó para una fotoexcitación. Se utilizaron lentes de objetivo de 50 × / 0,75 NA y una rejilla de 1800 líneas / mm para registrar los espectros Raman. El tiempo de acumulación fue de 400 s. Para evitar el daño de la muestra, la potencia del láser en la muestra se limitó a 0,06 mW. Las frecuencias Raman se calibraron utilizando el estándar de silicio (línea a 520,7 cm −1 ). Los parámetros de los modos vibracionales se determinaron ajustando los espectros experimentales con componentes de forma gaussiana-lorentziana utilizando el software GRAMS / A1 8.0 (Thermo Scientific).
Los espectros Raman de la muestra A de GaAsBi / AlAs MQW recién crecida y recocida se presentan en la Fig. 3. Se observa un doblete intenso en la muestra recién desarrollada (Fig. 3, curva verde) a 269 y 290 cm −1 corresponde a los modos de fonón óptico transversal (TO) y óptico longitudinal (LO) similares a GaAs, respectivamente [16,17,18]. En la geometría de retrodispersión, la banda TO está simétricamente prohibida para el cristal de GaAs ideal [17, 18], pero el desorden de la estructura cristalina inducido por Bi rompe la simetría de la red cristalina de GaAs y activa el modo TO. Otros dos amplios modos vibratorios bi-inducidos visibles cerca de 227 y 181 cm −1 puede atribuirse a modos vibracionales similares a GaBi [18]. La presencia de barreras de AlAs se puede reconocer en el espectro Raman desde un modo LO agudo a 402 cm −1 [19].
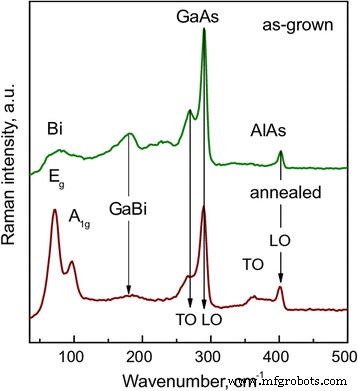
Espectros Raman del crecimiento ( curva verde ) y recocido ( curva roja ) Muestra A de GaAsBi MQW
El recocido térmico relativamente corto (180 s) de la muestra a 750 ° C induce cambios esenciales en el espectro Raman:(i) aparecen bandas de baja frecuencia intensas a 72 y 96 cm −1 , (ii) intensidad de las bandas cerca de 269, 227 y 181 cm −1 disminuye, y (iii) una característica amplia cerca de 361 cm −1 aparece en el espectro de la muestra recocida. Las dos bandas de baja frecuencia a 72 y 96 cm −1 corresponden bien a E g y A 1g modos del bismuto cristalino [20,21,22,23,24]. La aparición de estas bandas junto con una disminución en la intensidad de las bandas similares a GaBi inducidas por Bi a 269 y 181 cm −1 muestra que el recocido térmico provoca la extracción de bismuto de los sitios de la red de GaAsBi y su aglomeración en nanocristales Bi. Además, la formación de nanocristales de bismuto también afecta la estructura cristalina de las capas de AlAs, como se desprende del aumento de una característica TO amplia inducida por defectos cerca de 361 cm −1 [25].
Medidas de fotoluminiscencia
Las mediciones de fotoluminiscencia dependiente de la temperatura (PL) se llevaron a cabo utilizando un monocromador de longitud focal de 500 mm (Andor SR-500i) junto con el fotodetector de InGaAs enfriado con nitrógeno líquido. Se utilizó un láser de estado sólido bombeado por diodos que emitía a una longitud de onda de 532 nm como fuente de excitación a una potencia de excitación de 38 mW. Las muestras se montaron en el dedo frío de un criostato de helio de ciclo cerrado junto con un controlador de temperatura, lo que permitió realizar mediciones en el rango de temperatura de 3 a 300 K.
Los espectros PL de la muestra A recocida, que contiene tres GaAsBi QW de 10 nm de espesor y uno de 20 nm de espesor, medidos a diferentes temperaturas se presentan en la Fig. 4a. Se pueden distinguir dos conjuntos principales de características espectrales por debajo de la banda prohibida de GaAs. Un pico de energía superior fuerte situado en aproximadamente 1,35 eV se puede atribuir a las transiciones radiativas en los QW de GaAsBi. La posición del pico es cercana a la observada en GaAs 0.979 Bi 0.021 / Pozos cuánticos de GaAs [26] y se correlaciona con los datos XRD que indicaron el contenido de Bi del 2,1% en las capas GaAsBi QW de la muestra A después de su recocido. Las características espectrales en el lado de baja energía, 0.6–1.05 eV, aparecen en los espectros PL después de un recocido térmico de la muestra y, por lo tanto, pueden atribuirse a transiciones ópticas en nanocristales Bi. La banda PL de baja energía tiene una estructura interna, que se revela a bajas temperaturas. Es decir, en T =3 K, se pueden distinguir los componentes PL situados en 0,67, 0,88 y 0,98 eV. Como se ve en la Fig. 4a, a la temperatura del helio líquido, la señal PL de GaAsBi QWs es dos órdenes de magnitud más fuerte que la banda PL de baja energía. Sin embargo, el pico PL de alta energía disminuye rápidamente con un aumento de temperatura y el pico PL de baja energía comienza a dominar en T > 100 K.

Espectros PL dependientes de la temperatura del a recocido Muestra A compuesta por tres QW de GaAsBi / AlAs de 10 nm de ancho y uno de 20 nm de ancho y b Muestra B compuesta por 20 QW de GaAsBi / AlAs de 10 nm de ancho
Los espectros PL de la muestra B, que contiene veinte pocillos cuánticos de GaAsBi de 10 nm de espesor separados por barreras de AlAs de 4 nm de espesor, se presentan en la Fig. 4b. Antes del recocido térmico, como era el caso de la muestra A, la muestra B manifestaba solo la banda PL relacionada con QW de mayor energía. El fuerte pico de PL de baja energía a aproximadamente 0,85 eV se observó después del recocido térmico y, por lo tanto, suponemos, se puede atribuir a la emisión de nanocristales Bi. La intensidad del pico de baja energía en la muestra B es más fuerte que en la muestra A y se escala con un mayor número de QW. A bajas temperaturas, se pueden rastrear tres componentes del pico, que se resolvieron bien en la muestra A. Sin embargo, en la muestra B, el pico de PL de baja energía está dominado por su componente de 0,85 eV en todo el rango de temperatura investigado. La posición del pico PL de mayor energía, relacionado con QW, se desplaza ligeramente a energías más bajas con respecto a su posición en la muestra A de acuerdo con los datos de XRD, que indicaron el 2.8% de Bi en las capas de pozos cuánticos de la muestra B después su recocido térmico. En la muestra B, el pico PL relacionado con QW revela su estructura interna. El pico está constituido por el componente relacionado con el excitón unido a aproximadamente 1,27 eV, que domina a bajas temperaturas, y el componente relacionado con el excitón deslocalizado, que está situado a aproximadamente 1,35 eV y domina a temperaturas más altas. La estructura interna del pico relacionado con QW da como resultado una dependencia de temperatura de tipo S característica de la posición del pico PL (puntos completos en la Fig. 5), que se observó previamente tanto en GaAsBi a granel [27] como en pozos cuánticos de GaAsBi / GaAs [26]. El pico PL posicionado a bajas energías de fotones muestra una dependencia de la temperatura mucho más débil (puntos abiertos y curva en la Fig.5), que puede ajustarse mediante la función de Varshni E ( T ) = E (0) - αT 2 / ( β + T ) con los parámetros α y β iguales a 10 −4 eV / deg y 100 K, respectivamente. Cabe señalar que el valor del parámetro α, responsable de la variación de la brecha de energía con la temperatura, es mucho menor que sus valores estándar para la mayoría de los semiconductores, 3 ° 10 −4 –5 ° 10 −4 eV / deg. Esto hace que la matriz de nanocristales bi sea un sistema potencial importante para las fuentes de luz que emiten en longitudes de onda de telecomunicaciones y tienen una sensibilidad a baja temperatura.

Dependencias de temperatura de las posiciones espectrales de las bandas PL de alta y baja energía para la muestra B recocida compuesta por veinte QW de GaAsBi / AlAs de 10 nm de ancho
Discusión
Las mediciones de espectroscopía HRTEM, EDS y Raman llevadas a cabo en el presente estudio indican que los nanocristales Bi (puntos cuánticos) precipitan en capas de GaAsBi después de un recocido térmico de las muestras de MQW de GaAsBi / AlAs cultivadas con MBE a baja temperatura. Se puede suponer que estos nanocristales son responsables de la banda de fotoluminiscencia de longitud de onda larga que se revela en las muestras recocidas. Aunque el bismuto a granel es semimetálico, las pequeñas masas efectivas de los portadores de carga Bi dan como resultado un inicio temprano de efectos de confinamiento cuántico en nanoestructuras basadas en Bi. De hecho, se informó de una de las primeras observaciones experimentales de los efectos de cuantificación de tamaño para capas Bi delgadas [28]. Transición de semimetal a semiconductor en películas delgadas Bi, d <30 nm, se observó experimentalmente en la Ref. [29]. La transición también se ha revelado en nanocables Bi con diámetros inferiores a 65 nm [30, 31]. En ambos casos, el estado semiconductor se identificó a partir de mediciones de las características eléctricas dependientes de la temperatura. El efecto del tamaño cuántico en las nanopartículas de bismuto se estudió por primera vez mediante espectroscopia de pérdida de energía electrónica [32], y se descubrió que la transición de semimetal a semiconductor se produce en nanopartículas Bi con diámetros inferiores a 40 nm. La transición al estado de semiconductor directo se informó recientemente [33] para nanopartículas coloidales Bi de 3,3 nm.
En Bi puro, los principales valles de electrones y huecos se encuentran en L y T puntos de la zona de Brillouin y corresponden a superficies isoenergéticas elipsoidales (Cuadro 1). El estado fundamental de los electrones del valle elipsoidal (huecos) en un punto cuántico esférico se puede estimar aproximadamente como
$$ W =\ frac {\ pi ^ 2 {\ hslash} ^ 2} {2 \ overline {m} {r} _0 ^ 2} \. $$ (1)Aquí r 0 es el radio QD y \ (\ overline {m} \) es la masa efectiva inversa promedio,
$$ \ frac {1} {\ overline {m}} =\ frac {1} {3} \ left (\ frac {1} {m_1} + \ frac {1} {m_2} + \ frac {1} { m_3} \ derecha), $$ (2)m 1 , m 2 y m 3 son las principales masas efectivas del valle elipsoidal.
La fórmula fenomenológica (1) da una estimación cercana del nivel de energía del suelo ε 1 en una QD esférica infinitamente profunda en proporciones arbitrarias de las masas efectivas. De hecho, es exacto, ε 1 = W , en el caso de una superficie esférica isoenergética ( m 1 = m 2 = m 3 ), predice el ε 1 energía con una precisión del 12%, ε 1 ≈ 0,88 W y 25%, ε 1 =0,75 W , en los casos límite de valle esferoidal fuertemente alargado ( m 1 = m 2 , m 3 → ∞) y una esferoidal fuertemente achatada ( m 1 = m 2 , m 1 → ∞), respectivamente. Por lo tanto, a valores arbitrarios de las principales masas efectivas, la fórmula (1) se aproxima a la energía terrestre QD con una precisión mejor que el 25%.
La fórmula (1) permite una evaluación simple y directa de las brechas de energía efectivas en los puntos cuánticos de bismuto, E g, ef = E g + W e + W h , donde E g es una brecha de energía en un cristal a granel y W e y W h son las energías de cuantificación del tamaño de los huecos y los electrones (1). El T efectivo calculado y L Las brechas de energía se presentan gráficamente en la Fig. 6. (Las masas de los electrones y los huecos en T y L se asumió que los puntos eran iguales.)

Evolución con el espectro energético Bi QD con disminución de su tamaño ( r 0 y d son el radio y el diámetro QD)
En el bismuto a granel, semimetálico, la banda de conducción mínima de la L el valle está 38 meV por debajo de la T banda de valencia máxima. Cuando se reduce un tamaño de partículas Bi, la banda prohibida de energía efectiva en el L el punto aumenta más rápido que en la T punto debido a masas efectivas más pequeñas de la L -valle, lo que eventualmente conduce a la transición de semimetal a semiconductor (el i -punto de cruce en la Fig.6). Al principio, un nanocristal de bismuto se convierte en el semiconductor indirecto con el mínimo de banda de conducción más bajo en L punto y el máximo de banda de valencia más alto en la T punto. Con una disminución adicional del tamaño de QD, los bordes de la banda de conducción y de valencia emergerán en la T puntos que hacen que el Bi QD se convierta en un semiconductor de brecha directa (el d -punto de cruce en la Fig.6).
Cabe señalar que la Fig. 6 presenta solo un esquema aproximado del espectro de energía, porque el esquema ignora los efectos de no parabolicidad y asume las barreras de energía infinitas para QD. Una desviación de la ley de dispersión parabólica es esencial para la L -valle (ver por ejemplo, [34]). De hecho, las masas efectivas en el L -el centro del valle son aproximadamente cinco veces más pequeños que sus valores en la energía de Fermi (que se utilizaron para los cálculos del espectro de energía presentado en la Fig. 6). Por otro lado, los efectos de no parabolicidad son más débiles en el T puntos, donde la banda prohibida de energía es mayor y, por lo tanto, la T efectiva presentada La brecha de energía (Fig. 6) se puede considerar como su estimación relevante.
Arriba, habíamos asumido que el pico de PL de baja energía a ~ 0,85 eV se debía a las transiciones ópticas que tienen lugar en nanocristales Bi con diámetros de aproximadamente 10 nm. Los cálculos presentados para el d =QD de 10 nm predicen la E g, ef =0,76 eV de brecha de energía efectiva, que está en un acuerdo razonable con el experimento y, por lo tanto, apoya la suposición hipotética del origen del pico PL de baja energía.
Conclusiones
En resumen, se cultivaron múltiples estructuras de pozos cuánticos con capas de GaAsBi / AlAs mediante un proceso mixto MBE / MEE en sustratos de GaAs. Después del recocido térmico posterior al crecimiento de las estructuras a 750 ° C, se nuclearon numerosas nanopartículas de dispersión relativamente baja dentro de los pozos cuánticos de GaAsBi. Las mediciones de espectroscopía HRTEM, EDS y Raman muestran que los nanocristales están compuestos predominantemente de bismuto. Las mediciones de fotoluminiscencia realizadas revelan un pico PL adicional de baja energía, ≈0,85 eV, que aparece en las muestras recocidas. El pico de PL de baja energía presumiblemente puede deberse a transiciones ópticas en nanocristales Bi, que por los efectos de tamaño cuántico se transforman al estado semiconductor de banda prohibida directa. Las estimaciones realizadas del espectro de energía de Bi puntos cuánticos apoyan la suposición. Se requiere un trabajo experimental y teórico adicional y más detallado para obtener una respuesta definitiva.
Abreviaturas
- EDS:
-
Espectroscopía de dispersión de energía
- HAADF:
-
Campo oscuro anular de ángulo alto
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- MBE:
-
Epitaxia de haz molecular
- MEE:
-
Epitaxia mejorada por migración
- PL:
-
Fotoluminiscencia
- QD:
-
Punto cuántico
- QW:
-
Pozo cuántico
- RTA:
-
Recocido térmico rápido
- STEM:
-
Microscopía electrónica de barrido de transmisión
- TO y LO:
-
Modos de fonón óptico transversal y longitudinal, respectivamente
Nanomateriales
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- Síntesis de puntos cuánticos de carbono codopados N, S ricos en piridínicos como imitadores enzimáticos eficaces
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- Un enfoque simple para sintetizar puntos cuánticos de carbono fluorescente de aguas residuales de tofu
- Síntesis de puntos cuánticos de sulfuro de antimonio solubles en agua y sus propiedades fotoeléctricas
- Síntesis sonoquímica de un solo paso y propiedades fotocatalíticas fáciles de compuestos de puntos cuánticos de grafeno / Ag3PO4
- Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
- Dependencia del espesor de la cáscara de la transferencia de energía entre partículas en el dopaje de puntos cuánticos de ZnSe / ZnSe Core-Shell con europio
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Síntesis y propiedades de puntos cuánticos de CdTe de aleación de Mn emisor de azul soluble en agua
- Diseño de puntos cuánticos GeSn / GeSiSn con ingeniería de deformación para la emisión directa de banda prohibida en el infrarrojo medio en el sustrato de Si



