Un estudio comparativo sobre los rendimientos ferroeléctricos en películas delgadas de Hf0.5Zr0.5O2 depositadas en capas atómicas utilizando precursores de tetrakis (etilmetilamino) y tetrakis (dimetilamino)
Resumen
Las propiedades químicas, físicas y eléctricas de la capa atómica depositaron Hf 0.5 Zr 0.5 O 2 Se comparan películas delgadas que utilizan precursores de tetraquis (etilmetilamino) (TEMA) y tetraquis (dimetilamino) (TDMA). El ligando de los precursores organometálicos afecta fuertemente la concentración de C residual, el tamaño de grano y las propiedades ferroeléctricas resultantes. Depositando Hf 0.5 Zr 0.5 O 2 las películas con los precursores TDMA dan como resultado una menor concentración de C y un tamaño de grano ligeramente mayor. Estos hallazgos son beneficiosos para hacer crecer más película de fase dominante ferroeléctrica, lo que mitiga su efecto de activación. De la prueba de activación del TDMA-Hf 0.5 Zr 0.5 O 2 película con un campo cíclico de 2.8 MV / cm, el efecto de despertar adverso fue bien suprimido hasta 10 5 ciclos, con un valor de polarización remanente doble razonablemente alto de ~ 40 μC / cm 2 . La película también mostró cambios confiables de hasta 10 9 Ciclos con el campo de ciclismo de 2.5 MV / cm sin involucrar el efecto despertador pero con el típico comportamiento de fatiga.
Introducción
Capa atómica depositada Hf 1- x Zr x O 2 (HZO, x ~ 0,5) películas delgadas han sido el principal competidor como capa ferroeléctrica (FE) ultrafina en el campo de los dispositivos semiconductores para aplicaciones de memoria y lógica. Esto se debe a que la película FE HZO con estructura de fluorita se puede reducir a escala incluso por debajo de 10 nm y depositarse de manera homogénea en nanoestructuras tridimensionales utilizando técnicas de deposición de capa atómica madura (ALD). Además, es compatible con el electrodo de TiN convencional [1, 2], que difícilmente se puede conseguir con los ferroeléctricos convencionales con estructura de perovskita. A pesar de la mejora significativa en el procesamiento de películas de HZO y la fabricación de dispositivos utilizando películas delgadas basadas en ALD en los últimos años, existen varias deficiencias sin resolver. Especialmente, la confiabilidad de los ferroeléctricos con estructura de fluorita es incierta. Actualmente, el efecto despertador y el número limitado de resistencia se consideran los problemas más graves [3]. Generalmente, las curvas de polarización-campo eléctrico (P – E) están pinzadas en el estado prístino, lo que sugiere que el campo coercitivo (E c ) es espacialmente no uniforme y varios dominios FE están anclados [4]. Después de un ciclo de campo eléctrico con una intensidad de campo superior a E c , se pueden lograr curvas P – E más simétricas y cuadradas, un fenómeno conocido como efecto despertador. En algunos casos, este proceso de activación dura 10 4 –10 5 ciclos, que es un ciclo de resistencia típico de aprox. memoria flash, lo que complica el funcionamiento del dispositivo y del sistema [5]. El número limitado de resistencia es otro problema crítico si está destinado a utilizarse como memoria de trabajo (resistencia> 10 15 se requiere). Para la estructura del condensador de metal-ferroeléctrico-metal, la resistencia máxima informada es menos de 10 11 [6], y para la pila de puertas de semiconductores de metal ferroeléctrico en un transistor de efecto de campo ferroeléctrico, la resistencia está limitada a 10 5 veces [3, 7].
En la literatura se sugirieron varios orígenes del efecto despertador. Los mecanismos sugeridos son la fijación de límites de dominio por defectos, como impurezas, vacantes de oxígeno y presencia de la fase no ferroeléctrica (fase cúbica o tetragonal) en las interfaces adyacentes a los electrodos o canal semiconductor en el estado prístino [5, 8 , 9,10]. Se espera que la concentración del sitio de fijación disminuya durante el cambio de polarización repetitivo. Además, el ciclo del campo eléctrico transforma las fases interfaciales tetragonales o cúbicas en la fase ortorrómbica FE [5]. Este estudio se centró principalmente en mejorar el rendimiento eléctrico de la película de HZO o eliminar el efecto despertador mediante la adopción de precursores alternativos de Hf y Zr durante el proceso ALD, lo que puede resultar en una menor concentración de impurezas, especialmente impurezas de carbono.
Para los procesos ALD que utilizan precursores organometálicos, es casi inevitable inducir impurezas residuales, como C, N y H en la película desarrollada, que muy probablemente se originan a partir de ligandos orgánicos. Kim y col. [11, 12] mostró que al cambiar la temperatura de deposición de HfO 2 y película de HZO, el polimorfismo y las propiedades eléctricas resultantes podrían controlarse. De acuerdo con la espectroscopía electrónica de Auger (AES), la concentración de C en la película delgada de ALD HZO aumentó con la disminución de la temperatura de deposición, lo que podría resultar de las reacciones imperfectas de intercambio de ligandos [11, 12]. Además, el diámetro lateral del grano disminuyó al aumentar la concentración de C. La formación de fases inestables o metaestables (tetragonal, ortorrómbica y cúbica) en lugar de la fase monoclínica estable en tales películas con estructura de fluorita está estrechamente relacionada con el efecto del tamaño de grano [13,14,15,16]. Por lo tanto, controlar la concentración de impurezas es crucial para lograr la fase deseada (FE ortorrómbica), así como para mejorar la confiabilidad eléctrica de la película.
Para la ALD de las películas delgadas FE HZO, los precursores organometálicos de Hf y Zr más utilizados son el tetraquis [etilmetilamino] hafnio (TEMAH) y el tetraquis [etilmetilamino] circonio (TEMAZ) [11, 12, 17]. Estos precursores fueron desarrollados para la deposición de vapor químico orgánico metálico con la intención de una fácil descomposición del ligando a través de la transferencia de carga eléctrica entre los grupos metilo y etilo [18,19,20]. Sin embargo, este tipo de descomposición del ligando inducida térmicamente y la posterior eliminación de los (fragmentos de) ligandos orgánicos interfieren negativamente con la fácil reacción de ALD, lo que da como resultado la incorporación de impurezas (C, H y N) en la película [11, 17, 18, 19,20].
Por el contrario, los precursores de tetrakis [dimetilamino] hafnio (TDMAH) y tetraquis [dimetilamino] circonio (TDMAZ), que también se han utilizado para depositar las películas de FE HZO [21,22,23,24], solo tienen grupos metilo en su superficie. ligandos. Por lo tanto, tal efecto adverso podría no ser grave, aunque no se puede garantizar la supresión completa de la descomposición térmica.
Este estudio realizó un análisis comparativo entre las películas de HZO cultivadas por los procesos ALD con dos precursores de metales diferentes; TEMAH / TEMAZ y TDMAH / TDMAZ. El último proceso resultó en una menor concentración de C en la película, lo que mejoró significativamente el rendimiento eléctrico de la película de HZO. En las condiciones de ciclo de conmutación optimizadas, casi no se logró ningún efecto de activación mientras que la polarización conmutable se mantuvo en ~ 40 μC / cm 2 .
Métodos / Experimental
Preparación del Hf 0.5 Zr 0.5 O 2 Películas delgadas
Este trabajo examinó la influencia de los tipos de precursores organometálicos en la estructura y el rendimiento eléctrico del Hf 0.5 depositado en la capa atómica Zr 0.5 O 2 Peliculas delgadas. Las películas delgadas de HZO se depositaron utilizando un reactor ALD térmico a escala de 4 pulgadas de diámetro con TDMAH (o TEMAH), TDMAZ (o TEMAZ) y ozono (190 g / m 3 concentración) como precursor de Hf, precursor de Zr y fuente de oxígeno, respectivamente. El proceso de ALD optimizado con precursores de TEMAH / TEMAZ fue como en los estudios previos de los autores [5, 9, 11,12,13,14,15,16]. Las películas delgadas de HZO con precursores TDMAH / TDMAZ se prepararon mediante ALD térmico a una temperatura del sustrato de 260 ° C. Se eligió una relación Hf:Zr de 50:50 para la prueba eléctrica, ya que se ha informado que la composición muestra la mayor polarización remanente (P r ) valor en estudios anteriores [17, 25, 26]. Las películas delgadas de HZO con los precursores TDMAH / TDMAZ se depositaron con una relación de ciclo ALD 1:1 de precursores de Hf y Zr en TiN / Ti / SiO 2 / Sustrato de Si. Un ciclo de ALD se componía de alimentación de la fuente (2 s) - purga de la fuente (20 s) - alimentación de ozono (3 s) - proceso de purga de ozono (10 s). La tasa de crecimiento de la película de HZO fue de 0,13 nm por ciclo y las películas delgadas de HZO de 10 nm de espesor se prepararon mediante precursores TDMAH / TDMAZ para los experimentos. Las condiciones óptimas pueden variar según el volumen de la cámara ALD. La Tabla 1 muestra la comparación de propiedades físicas de las fuentes TEMA y TDMA. Las películas de TiN (50 nm) y Ti (5 nm) se depositaron utilizando pulverización catódica con una potencia de pulverización catódica de 5 kW sobre los sustratos de Si tipo p oxidados térmicamente utilizando una herramienta de pulverización catódica comercial (Endura, Applied Materials). Las películas de HZO depositadas son solo parcialmente cristalinas o amorfas en el estado de depósito, por lo que el recocido posterior para la cristalización se realizó mediante un proceso térmico rápido (RTP) a 450 ° C en N 2 atmósfera.
Caracterización de las propiedades químicas / físicas del Hf 0.5 Zr 0.5 O 2 Películas delgadas
Las estructuras cristalinas de las películas depositadas se analizaron mediante un difractómetro de rayos X (XRD, X’pert pro, Panalytical) dentro de una geometría de incidencia rasante con un ángulo de incidencia de 0,5 °. Las microestructuras de las muestras se analizaron utilizando un microscopio electrónico de barrido (SEM, S-4800, Hitachi), y la distribución del tamaño de grano se analizó utilizando un software Gwyddion [29] mediante un método de cuencas hidrográficas. Las composiciones químicas de la película de HZO depositada se analizaron mediante fluorescencia de rayos X (XRF, Quant'X, Thermo SCIENTIFIC), y las variaciones en profundidad de las composiciones químicas, incluidas las impurezas como el C, se analizaron mediante un tiempo de espectroscopía electrónica de vuelo Auger (AES, PHI-700, ULVAC-PHI).
Caracterización de las propiedades eléctricas del Hf 0.5 Zr 0.5 O 2 Películas delgadas
Para analizar las propiedades eléctricas de las películas de HZO, los electrodos superiores de TiN se depositaron reactivamente mediante un proceso de pulverización catódica con una potencia de 100 W por debajo del 92,6% -Ar / 7,4% -N 2 atmósfera. Los electrodos superiores de TiN se modelaron usando una máscara de sombra con orificios circulares que tenían un diámetro de 300 µm. Las características P – E se analizaron utilizando un probador ferroeléctrico (TF analizador 2000, sistemas Aixacct) a una frecuencia de medición de 1 kHz. La prueba de resistencia se realizó con pulsos bipolares rectangulares con alturas y ancho de 2.8 ~ 3.8 MV / cm y 10 μs, respectivamente, generados por un generador de pulsos (81110A, Agilent) y un probador ferroeléctrico (TF analyzer 2000, Aixacct systems). Las características de capacitancia-voltaje (C-V) se midieron usando un analizador de impedancia (4194A, Hewlett-Packard) bajo pulsos de CA sinusoidales con una frecuencia de 10 kHz y una altura de 50 mV combinados con polarización de CC. Las constantes dieléctricas de las películas de HZO se calcularon a partir de la capacitancia medida, así como el área del electrodo medida por microscopía óptica y el espesor medido usando elipsometría espectroscópica (ESM-300, J. A. Woollam). Las características del campo eléctrico de densidad de corriente (J-E) se analizaron utilizando un analizador de parámetros de semiconductores (4155B, Hewlett-Packard) con polarización de CC con un tiempo de retardo de 1 s.
Resultados y discusión
La Figura 1a muestra los patrones de difracción de rayos X de incidencia rasante (GIXRD) de Hf 0.5 de 10 nm de espesor Zr 0.5 O 2 películas delgadas depositadas utilizando TDMAH / TDMAZ (TDMA-HZO, curva negra) y TEMAH / TEMAZ (TEMA-HZO, curva roja) con un ángulo de incidencia de 0,5 °. Los patrones de referencia tomados de la literatura para las fases monoclínica, tetragonal y ortorrómbica se adjuntan en la parte inferior. De ambos patrones GIXRD de las películas TDMA y TEMA HZO, las intensidades de los picos de difracción de la fase monoclínica fueron despreciables y no se pudo identificar ninguna diferencia notable en las formas e intensidades de los picos. Por lo tanto, no se confirmó experimentalmente a partir de GIXRD diferencias significativas en la estructura cristalográfica entre TDMA y TEMA HZO.

(a) Los patrones GIXRD de películas delgadas de HZO depositadas usando TDMAH / TDMAZ (curva negra) y TEMAH / TEMAZ (curva roja), los patrones de referencia tomados de la literatura para las fases monoclínica, tetragonal y ortorrómbica se adjuntan en los paneles inferiores. ( b) La imagen plana SEM de películas TDMA HZO y ( c) la distribución del tamaño de grano de TEMA (rojo; reproducido de Ref. [15]), TDMA (negro) HZO. ( d) El perfil de profundidad de las películas delgadas TDMA HZO analizadas mediante espectroscopía electrónica Auger de tiempo de vuelo, y ( e) la región agrandada de baja concentración de la parte de película de HZO. Se presenta la concentración promedio de C de TDMA (línea de puntos y guiones negros), TEMA (línea de guiones rojos; reproducida de la Ref. [12]), HZO
La microestructura, incluido el tamaño de grano lateral, es otro factor crítico que puede afectar fuertemente las propiedades de FE de las películas delgadas de HZO [13, 14, 15, 16, 30]. Por tanto, las microestructuras de las películas TDMA y TEMA HZO se analizaron mediante microscopía electrónica de barrido (SEM). La Figura 1b muestra la imagen SEM plana de películas TDMA HZO. Varios estudios previos informaron que las películas delgadas de HZO depositadas usando ALD térmico mostraron una estructura de grano columnar, lo que sugiere que el tamaño de grano vertical es tan grande como el espesor de la película [1, 5, 11, 31]. La distribución del tamaño de grano lateral analizada utilizando el software mencionado anteriormente [29], se ajustó con la función gaussiana. La distribución del tamaño de grano de TEMA HZO (curva roja) se tomó de un estudio anterior [15] y se representó con la de TDMA HZO (curva negra) en la Fig. 1c. Como se muestra en la Fig. 1c, el diámetro de grano lateral medio del TDMA HZO (8,5 nm) era mayor que el del TEMA HZO (7,1 nm). Esta podría ser la razón principal de la mejora del rendimiento de FE del TDMA HZO. Según informes anteriores, la formación de las fases metaestables, como las fases ortorrómbica y tetragonal, es impulsada por los orígenes cinéticos, y las fases tetragonal y ortorrómbica se prefieren en la región de tamaño de grano pequeño [13, 16]. Los granos mucho más grandes prefieren ser fases monoclínicas, el tamaño de grano más pequeño prefiere la fase tetragonal y el tamaño de grano ligeramente mayor prefiere la fase ortorrómbica. La casi superposición de las posiciones de los picos de las dos fases (fases tetragonal y ortorrómbica) en los patrones de difracción no permitió una identificación inequívoca de la fase principal en las dos películas. Sin embargo, el SEM y el análisis de tamaño de grano que lo acompaña indicaron que la película TDMA HZO podría tener una porción más alta de la fase ortorrómbica en comparación con la película TEMA HZO.
Los diferentes tamaños de grano podrían originarse como resultado del diferente nivel de concentración de impurezas C en las dos películas. Las concentraciones de impurezas podrían afectar fuertemente la microestructura y las propiedades ferroeléctricas resultantes de las películas delgadas de HZO [11, 12, 32]. Por lo tanto, la composición química de las películas delgadas TDMA y TEMA HZO se analizó utilizando AES de tiempo de vuelo y las concentraciones en profundidad resultantes de varios átomos como Hf, Zr, O, C, Ti y N en TDMA HZO. las películas se trazaron en función del tiempo de pulverización catódica en la Fig. 1d. La figura 1e muestra la región de baja concentración ampliada de la figura 1d (cuadro de trazos rojos) en la parte de la película de HZO. La concentración promedio de C en la película TDMA HZO (cuadrado negro) fue ~ 2.4%, que es ~ 38% más pequeña que la (~ 3.9%) de la película TEMA HZO (triángulo rojo) [12], de los cuales los datos AES se informaron en el estudio anterior de los autores [12]. Todas las demás concentraciones, incluido el N, no mostraron diferencias notables.
Cho y col. sugirió que las impurezas residuales de C formadas durante el proceso ALD retardaron el crecimiento del grano y dieron como resultado el tamaño de grano pequeño de las películas finalmente depositadas [32]. Se observó una tendencia similar para ferroeléctricos Hf 0.5 Zr 0.5 O 2 películas delgadas y HfO 2 puro películas de Kim et al. cuando la temperatura de deposición disminuyó de 280 a 200 ° C [11, 12]. Jung y col. utilizaron simulaciones computacionales para mostrar que la diferencia de energía libre entre la fase tetragonal y monoclínica disminuye al aumentar la concentración de C en HfO 2 , lo que sugiere que la inclusión de la impureza C mejora la estabilidad de la fase tetragonal metaestable [33]. Kuenneth y col. también examinó el efecto de la concentración de C sobre los valores de energía libre de HfO 2 . Sin embargo, informaron que el aumento en la concentración de C no resultó en la disminución de la diferencia de energía libre entre la fase ortorrómbica y monoclínica [34]. En el trabajo de Kuenneth et al., Se consideraron los defectos de sustitución de C, aunque las impurezas de C se conocen generalmente como defectos intersticiales en HfO 2 [33, 35]. Por lo tanto, los cálculos teóricos no revelaron claramente que las impurezas de C pudieran disminuir la diferencia de energía libre entre las fases tetragonal y ortorrómbica. Sin embargo, los experimentos han confirmado que el aumento de las impurezas de C podría aumentar la fracción de fase tetragonal en las películas delgadas de ALD HZO [11, 12, 33].
La menor concentración de impurezas de C en la película TDMA HZO podría atribuirse a la diferente naturaleza de descomposición térmica de los ligandos TDMA y TEMA. Los átomos de carbono más externos en los ligandos TEMA son propensos a disociarse térmicamente y permanecer en la superficie de la película durante el proceso ALD [11, 12], lo que puede no ser el caso en el ligando TDMA.
Como siguiente paso, se discute el efecto de la concentración de C y la microestructura resultante sobre las propiedades ferroeléctricas. Las figuras 2a yb muestran las curvas P – E de los condensadores MFM con las películas TDMA HZO y TEMA HZO, respectivamente, medidas en un estado prístino y estados fatigados conmutados por 10 2 , 10 3 , 10 4 y 10 5 veces utilizando los pulsos rectangulares bipolares bipolares de 3,8 MV / cm de altura y 10 μs de ancho. De las curvas P – E en la Fig. 2a yb (estado prístino), la curva P – E del capacitor TEMA HZO (curva negra, Fig. 2b) está más fuertemente pinzada en el estado prístino en comparación con el capacitor TDMA HZO (negro curva, Fig. 2a). La Figura 2b muestra claramente las protuberancias en la curva P-E prístina del condensador TEMA HZO, que no es el caso de la curva P-E prístina del condensador TDMA HZO. Las protuberancias en la curva P – E se originan en la división de los picos de corriente de conmutación, que generalmente resulta de la falta de homogeneidad espacial en el campo eléctrico interno y / o campo coercitivo. La Figura 2c muestra los cambios en 2P r valores de los condensadores TDMA y TEMA HZO en función de los pulsos de fatiga. El 2P r valores después de 10 5 tiempos de pulsos eléctricos, en comparación con el prístino 2P r Los valores de los condensadores TDMA y TEMA HZO son ~ 80 y ~ 69%, respectivamente. Esto sugiere que la película TEMA HZO tiene un comportamiento de activación superior en comparación con la película TDMA HZO.

Las curvas de polarización-campo eléctrico (P – E) de ( a ) el TDMA HZO y ( b ) TEMA HZO (reproducido de Ref. [5]) condensadores medidos en estado prístino y estados fatigados pulsados por 10 2 , 10 3 , 10 4 y 10 5 veces a pulsos rectangulares bipolares bipolares de 3,8 MV / cm de altura y 10 μs de ancho. ( c) Los cambios en 2P r valores de los condensadores TDMA (negro) y TEMA (rojo) HZO en función de los pulsos de fatiga. Las curvas de campo eléctrico constante dieléctrico de ( d ) el TDMA HZO y ( e ) Condensadores TEMA HZO (reproducido de la Ref. [5]) con los electrodos superior e inferior de TiN medidos en estado prístino y fatigado. ( f) Los cambios en los valores de la constante dieléctrica con un número creciente de pulsos de fatiga para los condensadores TDMA (negro) y TEMA (rojo) HZO
Las figuras 2d y e muestran el campo eléctrico constante dieléctrico (ε r - E) curvas de los condensadores TDMA HZO y TEMA HZO medidos en un estado prístino y estados fatigados conmutados por 10 2 , 10 3 , 10 4 y 10 5 veces utilizando los pulsos rectangulares bipolares bipolares de 3,8 MV / cm de altura y 10 μs de ancho. El ε r Los valores del condensador TDMA HZO son significativamente más bajos que los de los condensadores TEMA HZO en todas las condiciones de prueba. La figura 2f muestra los cambios en ε r valores con el número creciente de ciclos de conmutación por fatiga para condensadores TDMA y TEMA HZO. El ε r los valores se calcularon promediando ε r valores medidos en los campos eléctricos más alto y más bajo en la Fig. 2d y e. A partir de los patrones GIXRD en la Fig. 1a, las fracciones de fase monoclínica en ambas películas fueron despreciables. Por lo tanto, la diferencia en ε r El valor podría estar determinado por las fracciones relativas de las fases tetragonal y ortorrómbica o la concentración del defecto, que se espera que disminuya la constante dieléctrica promedio con distorsiones de la red local. El ε r El valor de la fase tetragonal (35-40) fue mayor que el de la fase ortorrómbica (25-30). Por lo tanto, el alto ε r El valor del capacitor TEMA HZO indica que tiene una fracción de fase tetragonal más alta en comparación con los capacitores TDMA HZO. Con el creciente número de pulsos de fatiga, el ε r El valor de los capacitores TEMA HZO y TDMA HZO disminuye, como se muestra en la Fig. 2f. La magnitud de la disminución en ε r valor durante 10 5 veces la conmutación de polarización para el condensador TDMA HZO (26,8 a 25,3) fue menor que la del condensador TEMA-HZO (32,2 a 29,6) en ~ 42%. Esto es consistente con el comportamiento de despertar que se muestra en la Fig. 2c.
La diferencia en la fracción de fase tetragonal y la resultante diferente ε r El valor de las películas delgadas TDMA y TEMA HZO podría entenderse a partir de la diferencia en la concentración de C. Según Kim et al. [12], el aumento de la concentración de C disminuye la energía libre de la fase tetragonal en comparación con la de la fase ortorrómbica (la fase tetragonal es aún más favorable en comparación con la fase ortorrómbica). Como resultado, con el aumento de la concentración de C, se espera que aumente la fracción de fase tetragonal. Dado que la concentración de C de la película TDMA HZO es menor que la de la película TEMA HZO, se espera que la fracción de fase tetragonal en la película TDMA HZO sea menor que la de la película TEMA HZO. La diferencia en el tamaño de grano que se muestra en la Fig. 1c también apoya la misma tendencia en las fracciones relativas de la fase cristalina. Según Materlik et al. [30], la energía superficial libre de la fase tetragonal (2,5 J / m 2 ) es menor que eso (2,9 J / m 2 ) de la fase ortorrómbica, aunque estas energías de superficie libre se estimaron para explicar las observaciones experimentales en películas delgadas de HZO con varios espesores y concentraciones de Zr. Batra y col. [36] calculó la energía de la superficie libre de las diversas fases cristalinas con varias orientaciones y mostró que la energía de la superficie libre de la fase tetragonal es menor que la de la fase ortorrómbica y monoclínica. En general, se acepta que la energía de la frontera del grano de ángulo alto es aproximadamente 1/3 de la energía de la superficie libre [37]. Por lo tanto, la energía límite de grano de la fase tetragonal es la más baja en comparación con las fases ortorrómbica y monoclínica, lo que la convierte en la fase más estable con el tamaño de grano más pequeño. Estos son consistentes con la idea de que el tamaño de grano más pequeño del TEMA HZO tiende a incluir una porción más alta de la fase tetragonal no ferroeléctrica en comparación con la película TDMA HZO, que tenía un tamaño de grano promedio más grande. Por lo tanto, la concentración de C y el tamaño de grano observados experimentalmente respaldan consistentemente la diferente estructura cristalina y las propiedades eléctricas resultantes de las películas delgadas TDMA y TEMA HZO.
Para dilucidar el mecanismo detrás del efecto despertador, la medición de conmutación de pulsos, que puede estimar la capacitancia interfacial (C i ) procedente de la capa no ferroeléctrica cerca de los electrodos, se realizó en condensadores TDMA HZO y TEMA HZO [5]. Las figuras 3a yb muestran los cambios en C i , resistencia de contacto (R c ) y E c valores con el número creciente de pulsos de fatiga para los condensadores TDMA HZO y TEMA HZO, respectivamente. El método de medición detallado y los resultados se incluyen en la Información de respaldo en línea. Los datos del condensador TEMA HZO se tomaron del trabajo anterior de Kim et al. [5], donde el C i el valor aumenta con el número creciente de ciclos del campo eléctrico [5]. En estado prístino, el C i (37,6 μF / cm 2 ) El valor del condensador TDMA es superior a ese (21,1 μF / cm 2 ) del condensador TEMA HZO en ~ 75%, lo que sugiere que el grosor de la capa interfacial no ferroeléctrica en TDMA HZO es mucho menor que en la película TEMA HZO. Por otro lado, la diferencia en E c El valor en el estado prístino de los condensadores TDMA y TEMA HZO es solo del 13%, lo que sugiere que la razón principal de la diferencia en las características P-E prístinas de los condensadores TDMA y TEMA HZO es el diferente grosor de las capas interfaciales no ferroeléctricas. Desde R c El valor se ve fuertemente afectado por la resistencia de contacto para la configuración de la prueba eléctrica, puede tener menor importancia en comparación con los otros dos factores. Por lo tanto, las diferentes características P – E en el estado prístino de TDMA y el capacitor TEMA HZO podrían entenderse consistentemente en base al modelo de activación anterior sugerido por Kim et al. [5]. Según los estudios anteriores, la concentración de vacantes de oxígeno cerca de los electrodos de TiN es más alta que la de la región del volumen de la película en estado prístino. Según Hoffmann et al. [38], el aumento en la concentración de vacantes de oxígeno mejora la estabilidad de la fase tetragonal en comparación con la de la fase ortorrómbica. Durante el cambio de polarización repetitivo en la prueba de resistencia, la fase tetragonal interfacial pareció convertirse en la fase ortorrómbica FE mediante la difusión de las vacantes de oxígeno en la región de volumen de la película. El campo aplicado también indujo la transición de fase de la fase interfacial no FE a la fase FE. Dado que el grosor de la capa interfacial del capacitor TDMA-HZO es más pequeño que el de los capacitores TEMA-HZO en el estado prístino, el efecto de activación durante el ciclo de campo podría mitigarse.
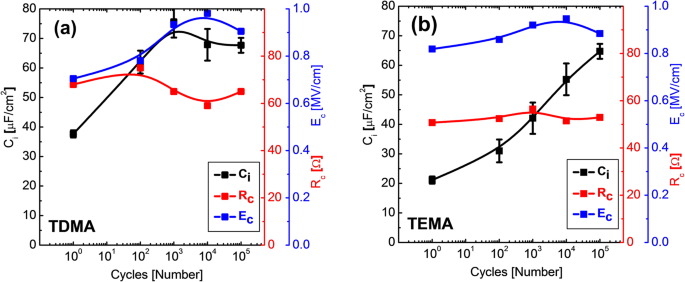
Los cambios de ( a ) TDMA HZO y ( b ) TEMA HZO (reproducido de Ref. [5]) en capacitancia interfacial (C i ), resistencia de contacto (R c ) y campo coercitivo (E c ) valores con un número creciente de pulsos de fatiga
Además, la amplitud del pulso de fatiga es otro factor crucial que puede afectar fuertemente los fenómenos de despertar de los ferroeléctricos con estructura de fluorita [6, 8]. Por lo tanto, se examinó el efecto de activación del condensador TDMA HZO utilizando pulsos de fatiga con diversas amplitudes de 2,8, 3,1, 3,5 y 3,8 MV / cm. Las Figuras 4a, byc muestran las curvas P – E medidas durante la prueba de despertar con alturas de pulso de fatiga de 2.8, 3.1 y 3.5 MV / cm, respectivamente. Los cambios en 2P r durante la prueba de despertar se resumen en la Fig. 4d. De manera similar al resultado de la prueba de despertar que se muestra en la Fig. 2a, la medición de P – E se llevó a cabo en el campo eléctrico de medición de 3.8 MV / cm, después de un cierto número de ciclos de despertar con la amplitud de campo dada. Los cambios en la histéresis P – E disminuyen al disminuir la amplitud de los pulsos de fatiga, como se muestra en la Fig. 4a – c. La Figura 4d muestra un resumen de los cambios en 2P r durante la prueba de resistencia con pulsos de fatiga de amplitud de 2,8, 3,1, 3,5 y 3,8 MV / cm. Como se ve en la Fig. 4d, la magnitud de 2P r aumentar después de 10 5 los tiempos de ciclo de campo fueron 0,41, 5,18, 9,93 y 9,94 μC / cm 2 para las diferentes amplitudes del campo de fatiga, que corresponden a cambios de ~ 1, ~ 13, ~ 26 y ~ 24%, respectivamente. Este resultado implica que el efecto de despertar es insignificante cuando se aplicó un pulso de fatiga de 2.8 MV / cm de amplitud, donde un 2P r razonablemente alto valor (~ 40 μC / cm 2 ) aún podría lograrse.
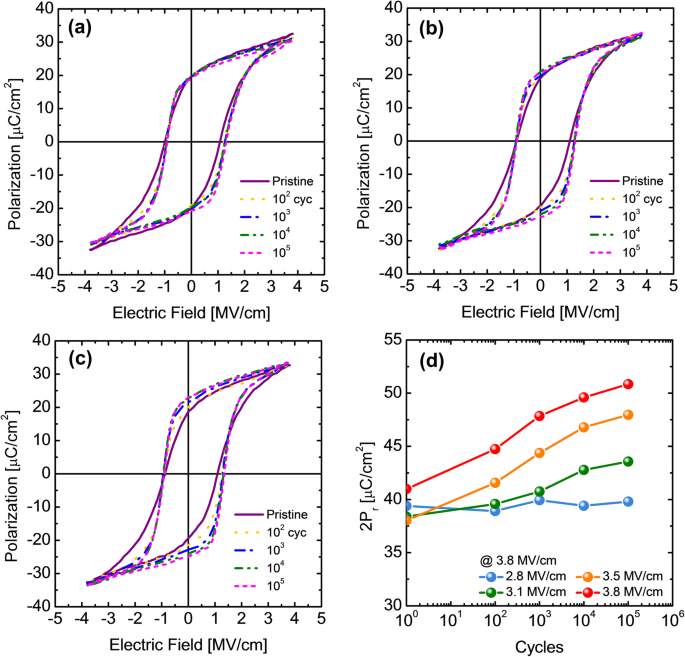
Las curvas de polarización-campo eléctrico (P – E) medidas durante la prueba de despertar con la altura del pulso de fatiga de ( a ) 2.8, ( b ) 3.1 y ( c ) 3,5 MV / cm. ( d) Los cambios en 2P r valor durante la prueba de resistencia con pulsos de fatiga de 2,8, 3,1, 3,5 y 3,8 MV / cm de altura
El efecto despertador está fuertemente relacionado con la deriva de las vacantes de oxígeno y la transición de fase resultante de la fase tetragonal a la fase ortorrómbica, principalmente en la capa interfacial [9, 10]. La deriva de las vacantes de oxígeno debe estar fuertemente influenciada por la amplitud de los pulsos de fatiga, y una amplitud de campo de prueba de fatiga apropiadamente más baja (2.8 MV / cm en este caso) puede mitigar en gran medida tal efecto adverso. Aunque el máximo alcanzable 2P r el valor se redujo de ~ 51 μC / cm 2 (a 3.8 MV / cm) a ~ 40 μC / cm 2 (a 2,8 MV / cm), ~ 40 μC / cm 2 sigue siendo un valor razonablemente alto para los dispositivos de memoria ferroeléctricos. Para el caso de la película TEMA HZO, se podría aplicar una estrategia similar para mitigar el problema del despertador, pero su 2P r inicialmente bajo valor (~ 30 μC / cm 2 ) podría ser el problema potencial de dicho método.
La influencia de la concentración de C se aclaró aún más mediante la prueba de resistencia hasta 10 9 ciclos, como se muestra en la Fig. 5a yb, que mostró las variaciones en P r bajo amplitud de campo de 2.5 y 3.0 MV / cm para las películas TEMA y TDMA HZO, respectivamente. En ambos casos, la P r Los valores fueron estimados por los bucles P – E con el campo eléctrico máximo de la misma fuerza que el campo cíclico, por lo que el P r estimado los valores son generalmente menores que los valores de la Fig. 4, donde las pruebas P – E se realizaron con 3.8 MV / cm. Cuando se utilizó el campo máximo (3.8 MV / cm) para la prueba P – E en la Fig. 4 para las pruebas de resistencia, las películas se rompieron temprano, prohibiendo las pruebas de resistencia hasta el número máximo de ciclos. Las dos películas mostraron tendencias consistentes en la evolución de la P r en comparación con el comportamiento del ciclo:la película TEMA HZO siguió aumentando la P r valores, mientras que la tendencia fue mucho menor para el caso de la película TDMA HZO. La película de TEMA HZO mostró una P r inestable cambios antes de descomponerse en ~ 10 7 y ~ 10 9 ciclos que utilizan ciclos de campo de 3,0 y 2,5 MV / cm, respectivamente. Por el contrario, la película TDMA HZO no mostró indicios de rotura hasta ~ 10 7 y ~ 10 9 ciclos a 3,0 MV / cm y 2,5 MV / cm de ciclo de campo, y se observó una ruptura repentina. El P r el valor disminuyó ligeramente después de ~ 10 7 bajo la intensidad del campo cíclico de 2,5 MV / cm, que corresponde al comportamiento de fatiga genuino. Decaimiento similar en el P r El rendimiento con los ciclos de conmutación se ha informado ampliamente para los ferroeléctricos de perovskita convencionales, que generalmente se atribuyen a la fijación de la pared de dominio por el aumento de la densidad de defectos [40, 41]. En los estudios previos sobre las películas delgadas ferroeléctricas basadas en HZO, estos comportamientos de fatiga genuinos apenas se han observado debido a la participación de un despertar significativo y una ruptura temprana, que también fue el caso en la Fig. 5a. Los datos que se muestran en la Fig. 5b revelan que la película de HZO también puede sufrir el efecto de fatiga, conocido en la película ferroeléctrica de perovskita, bajo la condición de que se aborden adecuadamente el despertar y la ruptura temprana.
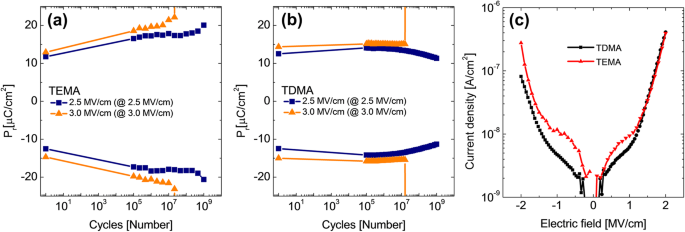
Los resultados de la prueba de resistencia de ( a ) TEMA HZO (reproducido de Ref. 39) y ( b ) TDMA HZO con el ciclo del campo eléctrico y la amplitud del campo de pulso de 2.5 y 3.0 MV / cm. La frecuencia del doble pulso rectangular para la prueba de resistencia se fijó en 100 kHz. ( c) Las curvas de densidad de corriente-campo eléctrico de TDMA HZO (negro) y TEMA HZO (rojo; reproducidas de Ref. [39])
La Figura 5c muestra la comparación en el rendimiento de la densidad de corriente de fuga de los dos tipos de películas. Debido a la menor concentración de C, la película TDMA HZO tenía una corriente de fuga más baja que la de la película TEMA HZO a una intensidad de campo <~ 1,5 MV / cm, donde la tunelización asistida por trampa puede dominar. Como resultado de la mejora de la corriente de fuga en TDMA HZO, la película no mostró la ruptura hasta 10 9 ciclos, con una intensidad de campo relativamente baja de 2,5 MV / cm.
Sin embargo, en la región de mayor intensidad de campo, la diferencia disminuye, lo que puede indicar que la corriente de fuga de campo alto está más dominada por la propiedad de barrera de Schottky de la interfaz, y dicha propiedad de barrera era menos sensible a la concentración de C. Se realizarán más investigaciones para identificar con mayor precisión el mecanismo de corriente de fuga en trabajos posteriores. Las corrientes de fuga similares en la región de campo alto coinciden con la diferencia no significativa en el número de ciclos de conmutación antes de la ruptura a 3.0 MV / cm, que se muestra en la Fig. 5a y b.
Conclusión
En conclusión, este trabajo examinó la influencia de los tipos de precursores organometálicos en la estructura y el rendimiento eléctrico del Hf 0.5 depositado en la capa atómica Zr 0.5 O 2 Peliculas delgadas. Los precursores de Hf y Zr adoptados tienen ligandos TEMA o TDMA, donde el primero es más propenso a la descomposición térmica en comparación con el segundo. El proceso de ALD que utiliza los precursores con ligandos TDMA dio como resultado una concentración de impureza de C más baja (~ 2.4% atómico frente a ~ 3.9% atómico) en la película de HZO, lo que indujo un tamaño de grano ligeramente mayor (~ 8.5 nm frente a ~ 7.1 nm) . Como el tamaño de grano ligeramente mayor prefiere tener la fase ortorrómbica ferroeléctrica en lugar de la fase tetragonal no ferroeléctrica, la película TDMA HZO superó a la película TEMA HZO, especialmente para el rendimiento de activación. Cuando el ciclo del campo de activación fue de 2,8 MV / cm, la película TDMA HZO no mostró casi ningún efecto de activación, mientras que una r alta de 2P valor de ~ 40 μC / cm 2 podría lograrse. Este es un mérito significativo sobre la propiedad de despertar severa de la película TEMA HZO. La película TDMA HZO también contenía una porción más baja de la fase interfacial no ferroeléctrica con los electrodos de TiN, en comparación con la película TEMA HZO. Debido a la menor concentración de C, la película TDMA HZO mostró una menor corriente de fuga en la región de campo bajo (<~ 1,5 MV / cm), pero los comportamientos de la corriente de fuga de campo alto fueron similares. Como resultado, el número de ciclos de conmutación antes de la avería fue similar cuando el campo de ciclismo fue tan alto como 3.0 MV / cm (~ 10 7 ciclos), pero podría extenderse más de 10 9 ciclos cuando el campo de ciclismo fue menor (2.5 MV / cm) para el caso de la película TDMA HZO. La película TDMA HZO reveló que el comportamiento de fatiga típico, es decir, la disminución de P r valor con los ciclos de conmutación crecientes, se pudo observar después de ~ 10 7 ciclos a 2,5 MV / cm, que podrían atribuirse al anclaje de la pared del dominio por los defectos acumulados, como ocurre con las películas ferroeléctricas de perovskita convencionales.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este artículo se incluyen dentro del artículo y su archivo adicional 1.
Abreviaturas
- TEMA:
-
Tetrakis (etilmetilamino)
- TDMA:
-
Tetrakis (dimetilamino)
- TEMAH:
-
Tetrakis [etilmetilamino] hafnio
- TEMAZ:
-
Tetrakis [etilmetilamino] circonio
- TDMAH:
-
Tetrakis [dimetilamino] hafnio
- TEMAZ:
-
Tetrakis [dimetilamino] circonio
- TDMA HZO:
-
Hf 0.5 Zr 0.5 O 2 películas delgadas depositadas usando TDMAH / TDMAZ
- TEMA HZO:
-
Hf 0.5 Zr 0.5 O 2 películas delgadas depositadas con TEMAH / TEMAZ
- ALD:
-
Deposición de la capa atómica
- AES:
-
Espectroscopía de electrones Auger
- RTP:
-
Proceso térmico rápido
- XRD:
-
Difractómetro de rayos X
- GIXRD:
-
Difracción de rayos X de incidencia rasante
- SEM:
-
Microscopía electrónica de barrido
- HZO:
-
Hf 1-x Zr x O 2 , x ~ 0.5
- FE:
-
Ferroeléctrico
- P r :
-
Polarización remanente
- E c :
-
Campo coercitivo
- P – E:
-
Polarización:campo eléctrico
- C – V:
-
Capacitancia-voltaje
- J – E:
-
Densidad de corriente:campo eléctrico
- C i :
-
Capacitancia interfacial
- R c :
-
Resistencia de contacto
Nanomateriales
- Presentación de la estructura atómica y electrónica de las nanofibras de carbono de copa apilada
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Estudio de los primeros principios sobre la estabilidad y la imagen STM del borofeno
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Fabricación de películas delgadas de SrGe2 en sustratos Ge (100), (110) y (111)
- Estudio de la fuerza de adhesión y la transición vítrea de películas delgadas de poliestireno mediante microscopía de fuerza atómica
- Un estudio de nanofibras de carbono y carbón activo como supercondensador simétrico en un electrolito acuoso:un estudio comparativo
- Preparación y características termoeléctricas de ITO / PtRh:termopar de película fina PtRh
- Estudios TEM y STEM sobre las morfologías transversales de películas antirreflectantes de SiO2 de banda ancha de doble / triple capa
- Estudio comparativo de las propiedades electroquímicas, biomédicas y térmicas de nanomateriales naturales y sintéticos
- Un método conveniente y eficaz para depositar película delgada nc-Si:H de baja densidad de defectos de PECVD



