Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
Resumen
Un nuevo proceso de deposición de capa atómica superciclada (ALD) que combina el proceso de ALD térmico con O 2 in situ En este trabajo se presenta el tratamiento con plasma para depositar películas delgadas de ZnO con propiedades eléctricas altamente sintonizables. Ambos O 2 El tiempo de plasma y el número de ciclos de ALD térmicos en un superciclo se pueden ajustar para lograr un ajuste fino de la resistividad de la película y la concentración del portador hasta seis órdenes de magnitud sin dopaje extrínseco. Se cree que la concentración de defectos de hidrógeno juega un papel importante en el ajuste de las propiedades eléctricas de las películas de ZnO. Los resultados de la microscopía de fuerza de la sonda Kelvin muestran evidentemente el cambio del nivel de Fermi en diferentes películas de ZnO y están bien asociados con el cambio de la concentración del portador. Esta técnica confiable y robusta informada aquí claramente apunta hacia la capacidad de usar este método para producir películas de ZnO con propiedades controladas en diferentes aplicaciones.
Antecedentes
Una vez definido como material futuro , el óxido de zinc (ZnO) ha atraído el interés de la comunidad científica durante más de medio siglo debido a sus propiedades ópticas y eléctricas superiores [1]. Recientemente, el rápido crecimiento de la industria del óxido conductor transparente ha revivido aún más su aplicación como electrodos transparentes en pantallas planas, pantallas táctiles, revestimientos de baja emisividad, células solares de película delgada, etc. [2, 3]. Además, el ZnO ha encontrado numerosas aplicaciones en dispositivos electrónicos, incluidos diodos emisores de luz, fotodetectores y dispositivos de potencia [4, 5]. Estos diferentes tipos de aplicaciones requieren que las películas de ZnO tengan varios parámetros eléctricos, y algunas aplicaciones incluso exigen películas de ZnO multicapa con diferentes propiedades eléctricas [6]. Por ejemplo, se han realizado numerosos esfuerzos para desarrollar una memoria de acceso aleatorio resistiva transparente (TRRAM) para la realización de electrónica transparente totalmente integrada [7, 8]. Como uno de los candidatos más prometedores, el TRRAM basado en ZnO utiliza una película de ZnO altamente resistiva como capa de conmutación activa, mientras que las películas de ZnO altamente conductoras se exigen idealmente para que actúen como electrodos transparentes [8,9,10]. Por tanto, la capacidad de controlar las propiedades eléctricas como la resistividad y la concentración de portadores de las películas de ZnO es un requisito clave. El dopaje se usa generalmente cuando se necesita la modificación de la propiedad y se han aplicado una variedad de dopantes para cambiar las propiedades de la película de ZnO [11,12,13]. Sin embargo, el dopaje es siempre complejo y podría dar lugar a la formación de una fase secundaria [14]. Por lo tanto, la modulación de las propiedades eléctricas del ZnO sin dopar mediante un solo proceso de deposición puede ser ventajosa.
La deposición de capa atómica (ALD) se ha convertido en una técnica popular para formar ZnO de alta calidad con un excelente control del espesor de la película hasta una escala nanométrica y uniformidad sobre un sustrato grande [15, 16]. La temperatura de crecimiento del ZnO suele ser inferior a 200 ° C, lo que lo hace compatible con una variedad de sustratos, incluidos el vidrio y los plásticos. El ALD ZnO normalmente se cultiva usando dietilzinc (DEZ) como precursor de Zn y vapor de agua (térmico) o plasma de oxígeno (mejorado con plasma) como precursor de oxígeno. La forma dominante de ajustar las propiedades de la película de ZnO sin dopar en el proceso de ALD térmico es cambiando la temperatura de crecimiento [17, 18]. Aunque esto permite la deposición de películas altamente conductoras, las películas de ZnO de alta calidad son difíciles de obtener con una baja concentración de portador. La ALD mejorada con plasma se usa preferiblemente cuando se requiere una concentración de portador baja de ZnO [19, 20]. Recientemente informamos sobre la capacidad de sintonizar ZnO usando un único proceso ALD mejorado con plasma que permite ajustar su resistividad y concentración de portador hasta tres órdenes usando diferentes O 2 tiempos de plasma [21]. Sin embargo, la ALD mejorada con plasma podría sufrir un crecimiento no autolimitado si un O 2 corto Se aplica tiempo de plasma para lograr la concentración de portador necesaria, lo que puede dar como resultado una uniformidad deficiente sobre un sustrato grande. Por lo tanto, sería deseable un proceso ALD ajustable dentro de la ventana autolimitante.
Aparte de la capacidad de ajustar las propiedades eléctricas del ZnO, la determinación de estas propiedades también sigue siendo un desafío. La medición del efecto Hall es la técnica más popular para medir las propiedades eléctricas de las películas delgadas de ZnO. Sin embargo, puede ser propenso a malas interpretaciones y tiene dificultades para detectar sin ambigüedades la causa real del dopaje [1]. La microscopía de fuerza de sonda Kelvin (KPFM) es una técnica de superficie no destructiva que se ha utilizado ampliamente para caracterizar propiedades estructurales, dinámicas y eléctricas a nanoescala de materiales y dispositivos semiconductores [22, 23]. Midiendo directamente la diferencia de potencial de contacto ( V CPD ), es decir, la diferencia entre las funciones de trabajo de la punta y la muestra, puede proporcionar una idea de los tipos de dopantes del material, las concentraciones de portadores y la resistividad, ya que afectan la posición del nivel de Fermi dentro de la banda prohibida. Sin embargo, los trabajos que correlacionan las propiedades de ZnO con los resultados de KPFM rara vez se informan, y hasta donde sabemos, no hay ninguno basado en películas de ZnO cultivadas con ALD [24, 25, 26].
En este trabajo, proponemos un novedoso proceso ALD superciclado para el ajuste de propiedades eléctricas en ZnO sin dopar. Combinando el proceso de ALD térmico con un O 2 in situ tratamiento con plasma, este proceso permite un ajuste amplio pero refinado de la resistividad de la película de ZnO y la concentración del portador. Más importante aún, los cambios de nivel de Fermi en las películas de ZnO pueden medirse directamente con KPFM y usarse para caracterizar las propiedades eléctricas del ZnO.
Métodos
Todas las películas delgadas de ZnO se prepararon en un sistema OIPT FlexAl ALD utilizando un precursor de dietilzinc (DEZ). Cada superciclo del proceso ALD consta de m ciclos de procesos térmicos ALD (DEZ y H 2 O) y un O 2 paso de plasma como se muestra en la Fig. 1a. Dentro del proceso de ALD térmico, el vapor DEZ se introdujo inicialmente en la cámara y luego se purgó mediante un flujo de argón, y H 2 Posteriormente se introdujo vapor de O y luego se purgó con argón. Después de m ciclos de procesos térmicos ALD, un O 2 La etapa de plasma se añadió como etapa de tratamiento con plasma in situ. El O 2 el paso de plasma se estableció usando un O 2 caudal de 60 sccm, potencia de RF de 300 W y presión de 15 mTorr. Ambos números ALD térmicos ( m ) y O 2 tiempo de plasma ( t 3 ) se utilizaron para el control de las propiedades de la película de ZnO. Los detalles específicos para un superciclo de crecimiento en el proceso ALD se dan en Archivo adicional 1:Tabla S1. Todas las películas de ZnO se depositaron en el SiO 2 -sustratos de Si recubiertos (1 cm × 1 cm) a una temperatura fija de 190 ° C, y todos los espesores de película se proyectaron en 40 nm.

un Ilustración del superciclo de crecimiento único del proceso de ALD superciclado propuesto. b Tasas de crecimiento de ZnO en función del O 2 tiempo de plasma para ALD superciclado con ciclo térmico fijo ( m =1) y procesos ALD mejorados con plasma; las curvas punteadas son guías del ojo. c Tasa de crecimiento de ZnO y ajuste lineal en función del ciclo del proceso térmico m con O 2 fijo tiempos de plasma ( t 3 =1 y 8 s)
El espesor y las constantes ópticas de las películas de ZnO depositadas se midieron mediante elipsometría (VASE, J.A. Woollam Co. M-2000) y se ajustaron con un modelo Tauc-Lorentz (TL). Las propiedades eléctricas se midieron mediante mediciones Hall (Nanometrics HL5500PC) a temperatura ambiente bajo un campo magnético de 0,5 T. Se tuvo especial cuidado para asegurar que se obtuviera un contacto lineal entre cada sonda de cobre y la muestra antes de cada medición. Se recopilaron patrones de difracción de rayos X (XRD) en incidencia de pastoreo ( θ 1 =1 °) usando un difractómetro Rigaku Smartlab con un Cu- K de 9 kW α fuente. Los datos de espectroscopía de fotoelectrones de rayos X (XPS) se obtuvieron utilizando un sistema de sonda Thermo Scientific Theta con Al- K α radiación (energía de fotones =1486,6 eV). Cuando fue necesario, la contaminación de la superficie se eliminó mediante el uso de una pistola de pulverización iónica. El Zn 2 p , O 1 s y C 1 s Se recogieron los espectros. Todos los datos fueron referenciados a los C 1 s pico, al que se le asignó una energía de enlace de 284,6 eV. Las mediciones de KPFM se realizaron en Nanonics CV2000 mediante una punta recubierta de Nanosensor ATEC Pt-Ir con una frecuencia de resonancia de 65 kHz. Para reducir la influencia del contaminante de la superficie, las mediciones se llevaron a cabo justo después de que las muestras se retiraron de la cámara de vacío.
Resultados y discusión
El proceso de ALD superciclado propuesto se ilustra en la Fig. 1a con un superciclo que consta de m ciclos de procesos térmicos ALD (DEZ y H 2 O) y un O 2 paso de plasma (O 2 plasma). Más detalles en la sección "Métodos". La Figura 1b compara las tasas de crecimiento de ZnO en nuestro proceso de ALD superciclado cuando m =1 y el proceso de ALD mejorado con plasma convencional en función de O 2 tiempo de plasma. Se encuentra que la tasa de crecimiento en el proceso ALD mejorado con plasma (rojo) es sensible al O 2 plasma a medida que aumenta desde aprox. 1,4 a 1,7 Å / ciclo con el tiempo de plasma cambiando de 2 a 4 s. Luego se satura al nivel de aprox. 1,7 Å / ciclo en tiempos de plasma más largos. La tasa de crecimiento insaturado en O 2 más corto El tiempo de plasma se atribuye a la deficiencia de oxígeno en el proceso. Aunque esto a veces se prefiere para obtener películas de ZnO con alta conductividad, no es autolimitante y podría resultar en una mala uniformidad en todo el sustrato. Por otro lado, se encontró que la tasa de crecimiento era estable en ca. 1,69 Å / superciclo en el proceso ALD superciclado (negro) y se acerca al del proceso ALD térmico ( t 3 =0 s) independientemente del tiempo de plasma aplicado. Además, aumento del ciclo térmico m en un superciclo con tiempo de plasma fijo conduce a un aumento lineal de la tasa de crecimiento como se muestra en la Fig. 1c. El gradiente ajustado se calcula en 1,67 para ambos crecimientos con diferente O 2 tiempos de plasma, que también está cerca de la tasa de crecimiento del proceso de ALD térmico. Esto sugiere que el crecimiento de ZnO en nuestra ALD superciclada está dominado por el proceso de ALD térmico y el posterior O 2 el paso de plasma sirve simplemente como un tratamiento.
Todas las películas de ZnO cultivadas mediante el proceso ALD superciclado ( m =1) cristalizan en la estructura hexagonal de wurtzita e ilustran una distribución similar de intensidades de pico independientemente del O 2 tiempo de plasma, como se muestra en la Fig. 2a. En comparación con la relación de intensidad teórica de 0,44 entre el pico (0 0 2) y (1 0 1) (calculado a partir de JCPDS-34-1451 para una orientación aleatoria de los cristalitos), estas películas demuestran una fuerte orientación preferida a lo largo de c -eje con la relación de intensidad máxima (0 0 2) y (1 0 1) entre 2 y 5, lo que sugiere una buena calidad cristalina de las películas. Se observa un ligero aumento de la relación de picos (0 0 2) a (1 0 1) con el aumento de O 2 tiempo de plasma (que se muestra en el archivo adicional 1:Figura S1). Esto sugiere un mayor grado de orientación preferida cuando se expone a plasma más largo. También se informó de un comportamiento similar [27, 28]. Sin embargo, cabe señalar que el cambio del ratio de intensidad en nuestro trabajo es bastante trivial en comparación con otros. Esto sugiere además la estabilidad de nuestro proceso ALD superciclado para producir películas de ZnO de alta calidad. El tamaño medio de los granos también se estimó sobre la base de la fórmula de Scherrer [29] y se encontró que eran ca. 11 nm, lo que sugiere que el tamaño de grano de ZnO apenas se vio afectado por el O 2 tiempo de plasma. También se observan patrones similares en películas de ZnO cultivadas a partir de varios ciclos térmicos de ALD ( m ) con un O 2 fijo tiempo de plasma (1 s) como se muestra en la Fig. 2b.
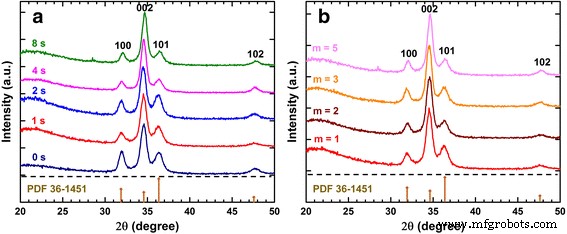
Patrones XRD de películas de ZnO cultivadas mediante el proceso ALD superciclado utilizando a diferente O 2 tiempos de plasma con ciclo térmico fijo ( m =1) y b diferentes ciclos térmicos con O 2 fijo tiempo de plasma ( t 3 =1 s)
Aparte de la cristalinidad, las propiedades ópticas de las películas de ZnO cultivadas con ALD supercicladas también se estudiaron usando elipsometría espectroscópica (SE). Constantes ópticas ( n y k ) se puede extraer de los resultados de elipsometría mediante un modelo Tauc-Lorentz que se utiliza comúnmente para ajustar películas de ZnO [28, 30, 31]. Similar a la cristalinidad análoga, las propiedades ópticas de las películas de ZnO depositadas con diferentes O 2 Los tiempos de plasma y los ciclos térmicos también permanecen sin cambios, como se muestra en el archivo adicional 1:Figura S2. Esto es consistente con los trabajos reportados de que un cambio de cristalinidad siempre está asociado con un cambio de propiedades ópticas [28, 32]. Las propiedades morfológicas de las películas de ZnO se caracterizan por AFM. Se encontró que todas las películas eran igualmente suaves con una rugosidad media entre aprox. 0.3 y 0.8 nm (archivo adicional 1:Figura S3).
Las propiedades eléctricas de las películas de ZnO cultivadas mediante el proceso de ALD superciclado se investigan mediante un sistema de efecto Hall. Se encontró que todas las películas eran n -tipo semiconductor, y la resistividad aumenta desde ca. 10 −3 a 10 3 Ω cm al aumentar O 2 tiempo de plasma y ciclo térmico fijo ( m =1) como se muestra en la Fig. 3a. Esto está asociado con la reducción de la concentración de portador de aprox. 10 21 a 10 15 cm −3 como el O 2 el tiempo de plasma aumenta de 0 a 8 s (Fig. 3b). Por el contrario, las movilidades de electrones de todas las películas de ZnO son bastante consistentes (aproximadamente 3,0 ± 1,0 cm 2 / V s) y no se ven afectados por la duración del plasma. El mecanismo de conducción detallado se abordará con más detalle en la sección siguiente. En comparación con el proceso ALD mejorado con plasma que informamos anteriormente [21], la magnitud del ajuste de resistividad se ha mejorado aún más en el proceso ALD superciclado a más de cinco órdenes. Además, este proceso ALD propuesto ofrece un control más refinado sobre estas propiedades eléctricas al variar el ciclo térmico ( m ) en un superciclo mientras repara el O 2 tiempo de plasma ( t 3 ). Esto es particularmente útil en el caso de t 3 =1 s donde la sintonización no se puede lograr reduciendo aún más el tiempo de plasma debido a la limitación del equipo ALD. Los puntos abiertos en la Fig. 3a, b representan las resistividades y concentraciones de portadores de películas de ZnO cultivadas por diferentes ciclos térmicos ( m =2, 3, 5) cuando t 3 =1 s (las barras de error están dentro de los puntos). Se puede observar que más ciclos térmicos dan como resultado películas menos resistivas con concentraciones de portador más altas. Esto proporciona un extra de tres resistividades dentro del rango de 10 −3 a 10 1 Ω cm.
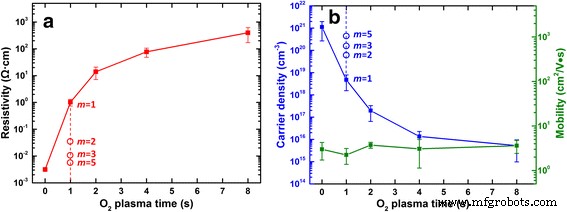
un Resistividad eléctrica de películas de ZnO cultivadas a partir de diferentes O 2 tiempos de plasma con ciclo térmico fijo m (puntos sólidos) y diferentes ciclos térmicos con O 2 fijo tiempo de plasma (puntos abiertos) por el proceso de ALD superciclado. b Concentración de portador (azul) de películas de ZnO cultivadas a partir de diferentes O 2 tiempos de plasma con ciclo térmico fijo (puntos sólidos) y diferentes ciclos térmicos con O 2 fijo tiempo de plasma (puntos abiertos). Movilidad (verde) de películas de ZnO cultivadas a partir de diferentes O 2 tiempos de plasma con un ciclo térmico fijo
Se realizaron mediciones de KPFM para obtener información sobre las posiciones del nivel de Fermi de las películas de ZnO con resistividad cambiante. Mide la diferencia de potencial de contacto V CPD entre una punta conductora y la muestra que se define como:
$$ {V} _ {\ mathrm {CPD}} =\ frac {\ phi _ {\ mathrm {tip}} - {\ phi} _ {\ mathrm {muestra}}} {q} $$ (1)donde q es la carga electrónica, mientras que ϕ consejo y ϕ muestra son la función de trabajo de la punta y la muestra respectivamente. Cuando dos materiales diferentes se ponen en contacto eléctrico, los niveles de Fermi se alinearán a través del flujo de corriente de electrones que, en consecuencia, induce una diferencia de potencial de contacto entre la punta y la muestra, como se muestra en el archivo adicional 1:Figura S4. El principio de funcionamiento detallado de KPFM se presenta en el archivo adicional 1. Las diferencias de potencial de contacto de las películas de ZnO cultivadas por el proceso ALD superciclado de diferentes O 2 tiempos de plasma con ciclo térmico fijo ( m =1) se muestran en la Fig. 4. Si bien cada V CPD la imagen parece ser uniforme y relativamente suave, diferencias sustanciales en la media V CPD Se pueden observar los valores (mostrados en la Fig. 4f). La función de trabajo de propina ϕ consejo permanece constante para todas las mediciones; la diferencia sustancial en V CPD es, por tanto, la consecuencia del cambio de nivel de Fermi dentro de diferentes películas de ZnO. Un turno total de ca. Se obtienen 0,32 eV entre la película de ZnO cultivada con 0 y 8 s O 2 tiempo de plasma que es significativo en comparación con el intervalo de banda de ZnO (ca. 3.22 eV basado en los resultados de SE en este trabajo, como se muestra en el archivo adicional 1:Figura S2c). Para películas de ZnO cultivadas a partir de diferentes ciclos térmicos ( m =2, 3, 5) en O 2 fijo tiempo de plasma ( t 3 =1 s), diferente V CPD Los valores también se detectaron como se muestra en la Fig. 4f. Las imágenes KPFM bidimensionales de estas películas se pueden encontrar en Archivo adicional 1:Figura S5. Esto implica que el cambio en el equilibrio entre electrones y huecos se produce en todas las películas, lo que podría tener un impacto considerable en la concentración del portador de ZnO.
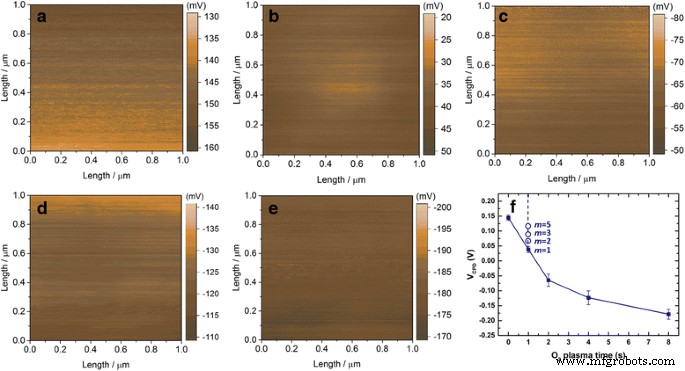
un - e Diferencia de potencial de contacto bidimensional V CPD imágenes de las mediciones del potencial de superficie de las películas de ZnO cultivadas con ALD supercicladas con O 2 tiempo de plasma ( t 3 ) que varía de 0 a 8 sy ciclo térmico fijo ( m =1). f V promedio CPD valores con O 2 variables tiempos de plasma (puntos sólidos) y ciclos térmicos (puntos abiertos)
Para investigar la relación entre el nivel de Fermi y la concentración de portadores, adoptamos el modelo de energía electrónica propuesto por Maragliano et al. para correlacionar la diferencia de potencial de contacto V CPD con la concentración de dopaje en el material [26]. Suponiendo la concentración efectiva de donantes n D es significativamente mayor que la concentración de portador intrínseco, se puede escribir como:
$$ {n} _ {\ mathrm {D}} \ approx {N} _ {\ mathrm {C}} \ exp \ left (\ frac {q {V} _ {\ mathrm {C} \ mathrm {PD} } - {\ phi} _ {\ mathrm {tip}} + \ chi} {K_BT} \ right) $$ (2)donde N C es la densidad efectiva de estados, χ es la afinidad electrónica del semiconductor, K B es la constante de Boltzmann y T es la temperatura. Aunque los valores de la densidad efectiva de estados N C , la función de trabajo de propina ϕ consejo , y la afinidad electrónica χ son difíciles de obtener, las diferencias relativas de concentración de portadores de diferentes películas de ZnO se pueden calcular ya que estos valores son los mismos en todas las mediciones. Por lo tanto, la relación de concentración de portador entre las películas cultivadas con 0 s de O 2 El tiempo de plasma para una película de ZnO determinada se puede expresar como:
$$ \ frac {n_0} {n_x} =\ exp \ left (\ frac {V _ {\ mathrm {CPD} 0} - {V} _ {\ mathrm {CPD} x}} {K_BT / q} \ right) $$ (3)en el que n 0 y n x son la concentración de portador de la película de ZnO cultivada con 0 y x s de O 2 tiempo de plasma, respectivamente, y V CPD0 y V CPD x son las correspondientes diferencias de potencial de contacto. Las relaciones de concentración de portador calculadas se representan en la Fig. 5 como una función de O 2 tiempo de plasma. La relación de concentración se calcula para aumentar con más O 2 tiempo de plasma (rojo). Más importante aún, la tendencia creciente coincide bien con los valores obtenidos de los resultados de la medición del efecto Hall (negro). También se observó una tendencia similar para las películas de ZnO cultivadas a partir de diferentes ciclos térmicos ( m =2, 3, 5) en O 2 fijo tiempo de plasma ( t 3 =1 s). Evidentemente, esto sugiere que el cambio del nivel de Fermi de la película de ZnO está directamente asociado con el nivel de concentración del portador.
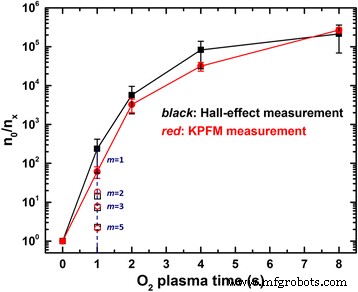
Resultados de la medición del efecto Hall y KPFM de las relaciones de concentración de portadores entre películas de ZnO cultivadas con O 2 variable tiempos de plasma (puntos sólidos) y ciclos térmicos (puntos abiertos)
Se llevaron a cabo mediciones de espectroscopía de fotoelectrones de rayos X (XPS) para arrojar luz sobre el mecanismo de conducción mediante el estudio de la unión y los estados químicos de las películas de ZnO cultivadas con ALD supercicladas. Los estados químicos de O 1 s se muestran en la Fig. 6 donde se pueden identificar dos picos después de los ajustes gaussianos. El pico de energía más bajo (A) colocado ca. Se sugiere que 530.3 eV sea el O 2− iones en la estructura de wurtzita de Zn hexagonal 2+ iones [33,34,35]. Las asignaciones del componente de energía de enlace más alto en ca. 532.2 (B) han sido controvertidos sobre la literatura [33,34,35,36,37,38]. Sin embargo, se ha informado ampliamente de que está asociado con el grupo hidroxilo (es decir, Zn-OH) [33, 37,38,39] en la película de ZnO. Por lo tanto, asignamos tentativamente la O B pico observado en la Fig. 6 a los enlaces Zn-OH. Por otro lado, el pico asociado a la vacante de oxígeno posicionado en ca. 531.2 eV [35] no se observa en este trabajo. Película de ZnO cultivada mediante el proceso de ALD térmico ( t 3 =0 s) caracteriza a un O B dominante pico en el espectro XPS (Fig. 6a). Esto implica la existencia de una gran cantidad de impurezas relacionadas con el hidrógeno en esta película. Este alto nivel de defectos sirve como mecanismo de autodopaje y conduce a una alta concentración de portadores. El O 2 extra paso de plasma ( t 3 ) disminuye las impurezas y el O B la intensidad máxima disminuye con un O 2 más largo tiempo de plasma (Fig. 6f). También se observó una tendencia similar para las películas de ZnO cultivadas a partir de ciclos térmicos variables en los que más ciclos térmicos conducen al aumento de O B intensidad máxima como se muestra en la Fig. 6f y archivo adicional 1:Figura S6.

un - e Espectros XPS y sus adaptaciones gaussianas de los O 1 s región de las películas de ZnO cultivadas con ALD supercicladas con O 2 tiempo de plasma ( t 3 ) que varía de 0 a 8 sy ciclo térmico fijo ( m =1). f Proporción de O B relacionado con el hidrógeno pico en películas de ZnO cultivadas con O 2 tiempos de plasma (puntos sólidos) y ciclos térmicos (puntos abiertos)
El origen de la n intrínseca La conductividad de tipo en las películas de ZnO sigue siendo controvertida. Aunque la sabiduría convencional ha atribuido esta conductividad a defectos nativos (es decir, vacantes de oxígeno e intersticiales de Zn) [18, 40,41,42,43,44], ha sido cuestionada por cálculos recientes de primeros principios [45]. También es poco probable que las vacantes de oxígeno contribuyan a un nivel de concentración tan alto, ya que numerosos estudios sugieren que son donantes profundos en lugar de superficiales y tienen altas energías de formación en n -tipo ZnO (y por lo tanto son diferentes a la forma) [41,42,43,44]. Además, los O 1 s relacionados con la vacante de oxígeno El pico tampoco se observa en nuestros datos de XPS que se muestran en la Fig. 6. Aunque los intersticiales de Zn son donantes poco profundos, se ha sugerido que tienen altas energías de formación y difusores más rápidos y, por lo tanto, es poco probable que sean estables [41]. Los espectros XPS del Zn 2 p 3/2 estado de las películas de ZnO cultivadas con ALD supercicladas con varios O 2 Los tiempos de plasma se muestran en la Fig. 7. Todos los espectros se caracterizan por un pico similar posicionado en ca. 1021.5 eV que se puede atribuir al Zn 2+ unión en ZnO [6, 34, 46]. Sin embargo, el componente intersticial de Zn con una energía de enlace ligeramente superior [6, 47] no se observa en todos los espectros. Esto sugiere que en este trabajo también se puede descartar la influencia del intersticial de Zn en la conductividad de la película de ZnO.

un - e Espectros XPS y sus adaptaciones gaussianas del Zn 2 p 3/2 región de las películas de ZnO cultivadas con ALD supercicladas con O 2 tiempo de plasma ( t 3 ) que varía de 0 a 8 sy ciclo térmico fijo ( m =1)
Recientemente, se propone que las impurezas / defectos relacionados con el hidrógeno desempeñen un papel en la n de tipo conductividad en ZnO [33, 48]. La evidencia de la existencia de enlaces de hidrógeno en ZnO ha sido demostrada por Janotti et al. [48], y se ha sugerido que esos enlaces pueden incorporarse en altas concentraciones y comportarse como donantes superficiales [49,50,51]. De hecho, el hidrógeno está presente en nuestro proceso de ALD superciclado como precursor y H 2 O contiene hidrógeno y se produce un enlace Zn-OH en cada semiciclo en el paso ALD térmico. Esto también está respaldado por la observación de O 1 s relacionados con el grupo hidroxilo pico en los espectros XPS (mostrado en la Fig. 6). La resistividad de la película de ZnO y la densidad del portador se representan frente a la proporción de este pico en la Fig. 8. Una alta proporción de estas impurezas de hidrógeno inducen altas concentraciones de portador, lo que conduce a bajas resistividades. El siguiente O 2 El paso de plasma dentro de cada superciclo reduce la concentración de portador al eliminar eficazmente los enlaces de hidrógeno. Esto va acompañado de la reducción de la concentración del portador y del aumento de la resistividad. También se informó el mismo comportamiento en los procesos ALD y CVD [33, 52].
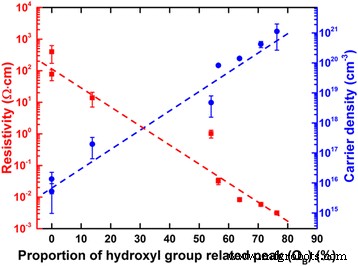
Resistividad eléctrica y concentración de portador en función del O B relacionado con el grupo hidroxilo proporción máxima (las líneas punteadas son guías del ojo)
Conclusiones
La deposición de películas de ZnO sin dopar con propiedades eléctricas altamente ajustables se informó aquí utilizando un proceso ALD superciclado que combina un proceso ALD térmico y O 2 in situ tratamiento con plasma. Se lograron más de cinco órdenes de ajuste de magnitud sobre la resistividad de la película y la concentración del portador ajustando el O 2 tiempos de plasma. También se puede realizar un ajuste más fino de las propiedades variando el número de ciclos térmicos ALD en un superciclo. Se cree que el ajuste de estas propiedades eléctricas está asociado con el cambio de concentración del defecto de hidrógeno en la película. Esto causa directamente el cambio de los niveles de Fermi dentro de las películas de ZnO, como lo revela la microscopía de fuerza de la sonda Kelvin. Al adoptar un modelo de energía electrónico simple, las concentraciones de portador calculadas a partir de los cambios de nivel de Fermi demuestran una buena correspondencia con los resultados de la medición del efecto Hall. Esta técnica confiable y robusta informada aquí claramente apunta hacia la capacidad de usar este método para producir películas de ZnO con propiedades controladas en diferentes aplicaciones.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- DEZ:
-
Dietilzinc
- KPFM:
-
Microscopía de fuerza de sonda Kelvin
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- XRD:
-
Difracción de rayos X
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Deposición en dos pasos de ZnO dopado con Al en p-GaN para formar contactos óhmicos
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Propiedades ópticas de películas de ZnO dopado con Al en la región infrarroja y sus aplicaciones de absorción
- Efecto de diferentes morfologías de CH3NH3PbI3 en las propiedades fotovoltaicas de las células solares de perovskita
- Preparación y propiedades antibiofilm de películas compuestas de óxido de zinc / alúmina anódica porosa
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN



