Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
Resumen
SiO 2 formado in situ se introdujo en HfO 2 dieléctricos de compuerta sobre sustrato de Ge como capa intermedia por deposición de capa atómica mejorada con plasma (PEALD). Las características de alineación interfacial, eléctrica y de banda del HfO 2 / SiO 2 Las pilas dieléctricas de puerta alta k en Ge han sido bien investigadas. Se ha demostrado que la capa intermedia de Si-O-Ge se forma en la superficie de Ge durante el PEALD SiO 2 in situ proceso de deposición. Esta capa intermedia muestra una estabilidad térmica fantástica durante el recocido sin la formación obvia de silicatos de Hf. Además, también puede suprimir el GeO 2 degradación. Las mediciones eléctricas muestran que la capacitancia de espesor equivalente de 1,53 nm y una densidad de corriente de fuga de 2,1 × 10 −3 A / cm 2 en el sesgo de puerta de V fb Se obtuvo + 1 V para la muestra recocida. La banda de conducción (valencia) se desplaza en el HfO 2 / SiO 2 La interfaz / Ge con y sin PDA es de 2,24 (2,69) y 2,48 (2,45) eV, respectivamente. Estos resultados indican que PEALD SiO 2 in situ puede ser una capa de control interfacial prometedora para la realización de dispositivos de transistores basados en Ge de alta calidad. Además, se puede demostrar que PEALD es una tecnología mucho más poderosa para la deposición de capas de control interfacial ultradelgada que MOCVD.
Antecedentes
Con la reducción continua de los transistores de efecto de campo semiconductores de óxido metálico (MOSFET), los MOSFET basados en Si se están acercando a su limitación física y técnica. Los materiales de canales alternativos como el germanio (Ge) [1, 2] y los materiales III-V [3-5] han atraído recientemente un gran interés para aplicaciones de dispositivos lógicos de alto rendimiento. Entre ellos, Ge tiene el potencial de reemplazar el silicio como material de canal en MOSFET debido a su mayor movilidad intrínseca del portador de orificios [6]. Sin embargo, la deposición directa de dieléctricos de puerta de alta k en sustratos de Ge a menudo causa una alta densidad de trampa de interfaz (D it ) y la formación no deseada de una capa interfacial entre las capas de dieléctricos de Ge y de alto k [7]. Por lo tanto, para lograr MOSFET basados en Ge de alta velocidad y baja potencia, es muy importante lograr una alta calidad de k / Ge interfaz. Afortunadamente, se han informado muchos métodos para mejorar la calidad de la interfaz de alta k / Ge [8], como la introducción de SiO 2 [9], Si [10], GeO 2 [11], Al 2 O 3 [12, 13], GeO x N y [14, 15] y óxidos de tierras raras [16, 17] como la capa de control interfacial entre el sustrato de Ge y el alto k dieléctricos de compuerta. En particular, el GeO 2 La estructura / Ge tiene propiedades de interfaz superiores, una densidad de estado de interfaz extremadamente baja (D it ) de menos de 1 × 10 11 cm −2 eV −1 puede lograrse [18]. Sin embargo, GeO 2 se descompondría por encima de 425 ° C y es soluble en agua. Como resultado, un D it inaceptable siempre se revela para el condensador Ge-MOS (MOSCAP) [6]. Afortunadamente, Kita et al. informó que la capa de cobertura en GeO 2 puede suprimir el GeO 2 degradación; sin embargo, la selección del material para la capa superior debería ser muy importante [19-21]. Por ejemplo, Si o Y 2 O 3 funciona de manera más eficiente que HfO 2 para retardar la desorción de Ge-O. Estos resultados indican la importancia de los materiales de alta k o la selección de la capa de control interfacial para inhibir la GeO 2 degradación. Nakashima y col. informó que un SiO 2 muy delgado / GeO 2 bicapa por deposición física de vapor (PVD) es una capa intermedia prometedora para la pasivación de Ge, un D it de 4 × 10 11 cm -2 eV −1 se logró cerca de la brecha media [22, 23]. Li y col. introdujo el SiO 2 capa intermedia de Ge por deposición de vapor químico orgánico metálico (MOCVD) y SiO 2 la capa intermedia puede suprimir eficazmente la difusión externa de Ge durante HfO 2 crecimiento y posterior proceso de recocido posterior a la deposición [9]. Por lo tanto, SiO 2 debería ser una maravillosa capa de control interfacial para el sustrato de Ge. Sin embargo, en comparación con PVD y MOCVD, PEALD puede proporcionar una capa de pasivación mucho más uniforme, especialmente para espesores ultrafinos. Por lo tanto, SiO 2 formado por PEALD puede ser una capa de control interfacial prometedora para lograr dispositivos de transistores basados en Ge de alto rendimiento.
Aquí, introducimos in situ SiO 2 formado por PEALD en HfO 2 / Ge se apila como capa interfacial. Las características de alineación interfacial, eléctrica y de banda de ALD HfO 2 Las películas sobre sustratos de tipo n Ge se han investigado cuidadosamente. El SiO 2 fue depositado por primera vez en los sustratos de Ge como capa de control interfacial por PEALD. Entonces, HfO 2 El dieléctrico de la puerta se depositó in situ mediante el modo ALD térmico. Recocido posterior a la deposición (PDA) a 500 ° C durante 60 s en N 2 se realizó para el HfO 2 / SiO 2 pilas dieléctricas de puerta alta k en Ge. Los análisis de espectroscopía de fotoelectrones de rayos X revelan que la capa intermedia de Si-O-Ge y GeO 2 La capa se forma en la superficie de Ge durante PEALD SiO 2 declaración. Esta capa intermedia de Si-O-Ge no solo muestra una estabilidad térmica fantástica, sino que también puede suprimir la descomposición térmica de GeO 2 . Por lo tanto, se lograron buenas propiedades eléctricas para el HfO 2 / Si-O-Ge / GeO 2 / Ge pilas. Comparado con MOCVD SiO 2 capa intermedia, in situ PEALD SiO 2 exhibe propiedades eléctricas muy mejoradas. Por lo tanto, PEALD es una tecnología mucho más poderosa que MOCVD en el área de fabricación de MOSFET, especialmente para la deposición de capas de control interfacial ultradelgadas.
Métodos
Como sustratos se utilizó Ge (100) dopado con Sb de tipo N con una resistividad de 0,2–0,3 Ω ∙ cm. Los sustratos se limpiaron en primer lugar mediante sonicación en acetona, etanol, isopropanol y agua desionizada durante 5 min, respectivamente. Luego, una solución diluida de HBr (H 2 O / HBr =3:1) para grabar los óxidos nativos de la superficie durante 5 min. Después de la limpieza química húmeda, los sustratos se enjuagaron con agua desionizada y se secaron con N 2 puro. . Posteriormente, los sustratos fueron transferidos inmediatamente al PEALD (Picosun SUNALE TM R-200) cámara. Antes del alto k HfO 2 deposición de películas, 10 ciclos SiO 2 PEALD depositó la película a 250 ° C como capa intermedia, donde un ciclo consistió en 1 s de inyección de fuente de Si, 10 s de N 2 purga, inyección de oxidante 13,5 sy 4 s N 2 purga. Tris- (dimetilamino) -silano (TDMAS) y O 2 El plasma se utilizó como precursor de Si y oxidante para SiO 2 deposición, respectivamente. TDMAS se mantuvo a temperatura ambiente. Pure O 2 se utilizó gas (99,999%) como O 2 fuente de plasma. El poder del plasma y O 2 el caudal de gas fue de 2500 W y 160 sccm, respectivamente. La tasa de crecimiento de PEALD SiO 2 se determinó que era ~ 0,7 Å / ciclo mediante elipsometría de espectroscopia ex situ. Entonces ~ 4 nm de espesor HfO 2 La película se depositó in situ a 250 ° C durante 40 ciclos mediante ALD térmico, donde un ciclo consistió en una dosificación de fuente de Hf de 0,1 s, 4 s N 2 purga, 0,1 s H 2 O dosificación y 4 s N 2 purga. Tetrakis- (etilmetilamino) -hafnio (TEMAH) y H 2 O se utilizaron como precursor de Hf y oxidante para HfO 2 deposición, respectivamente. TEMAH se evaporó a 150 ° C y H 2 O se mantuvo a temperatura ambiente. Pure N 2 (99,999%) se utilizó como gas portador y gas de purga. PDA se realizó en N 2 ambiente a 500 ° C durante 60 s bajo presión atmosférica utilizando recocido térmico rápido.
Las estructuras interfaciales y la unión química de las películas se investigaron mediante espectroscopía de fotoelectrones de rayos X ex situ (XPS, Thermo Fisher K-Alpha) con una fuente de rayos X estándar de Al Kα (1486,7 eV). Los espectros XPS se recogieron en un ángulo de despegue de 90 °. La escala de energía de enlace se calibró utilizando Ge 3d 5/2 pico a 29,4 eV. Además, los espectros XPS se ajustaron con funciones Gaussian-Lorentzian (G-L) después de la resta de fondo de tipo inteligente. Pt electrodos superiores de área 1,55 × 10 −4 cm 2 se depositaron en la superficie de HfO 2 películas utilizando una máscara de sombra mediante el método de pulverización catódica para mediciones eléctricas. Las características de capacitancia-voltaje (C-V) y corriente de fuga densidad-voltaje (J-V) se midieron con un sistema analizador de semiconductores Keithley 4200 con una plataforma de sonda (Cascade Summit 12000B-M).
Resultados y discusión
Para el PEALD SiO 2 delgado (~ 0,7 nm) en Ge, Si 2p exhibe un pico a 102,4 eV correspondiente al enlace Si-O (Fig. 1a), que es más pequeño que la energía de enlace del SiO 2 ideal [24]. Ambos subóxidos de silicio (SiO x ) La deposición y la formación de Si-O-Ge en la superficie de Ge durante el proceso PEALD pueden causar el cambio de Si 2p a una energía más baja. Por lo tanto, también se realizó el espectro de Si 2p de PEALD grueso (~ 7 nm) en Ge. Se puede encontrar que exhibe un pico principal a 103.6 eV correspondiente al SiO ideal 2 unión, como se muestra en la Fig. 1b. Entonces, el óxido de silicio depositado por PEALD aquí es SiO 2 ideal . Sin embargo, además del pico fuerte de Si-O-Si, hay un pico débil ubicado a ~ 102,4 eV, que debería corresponder a la unión de Si-O-Ge en la superficie de Ge. Por lo tanto, se puede concluir que Si-O-Ge se forma en la superficie de Ge en el PEALD SiO 2 inicial crecimiento. Después de in situ 4 nm HfO 2 deposición, la intensidad máxima de Si 2p disminuye sin un desplazamiento químico obvio (102,3 eV), como se muestra en la Fig. 1a. Además, el Si 2 p El pico tampoco muestra un cambio químico evidente (102,2 eV) después del PDA de 500 ° C en N 2 , lo que sugiere la buena estabilidad térmica del HfO 2 / SiO 2 interfaz durante HfO 2 proceso de deposición y PDA. En el espectro de Hf 4f del HfO 2 depositado / SiO 2 pilas de compuertas (Fig. 1c), el doblete a 16,5 y 18,2 eV se puede asignar a Hf 4f 7/2 y Hf 4f 5/2 picos de HfO 2 con la energía de división de la órbita de espín de 1.7 eV, consistente con el valor de la literatura de HfO 2 [25]. Después de 500 ° C PDA, el espectro de Hf 4f no muestra cambios obvios con solo 0.1 eV de cambio a una energía más alta. Implica que no se forman silicatos de Hf evidentes durante el proceso de PDA. En la Fig.1d, el espectro de Ge 3d de la muestra depositada muestra los picos de doblete a 29,4 y 30,0 eV, que se pueden asignar a los picos de Ge 3d5 / 2 y Ge 3d3 / 2 del sustrato Ge con la energía de división de la órbita de giro de 0,6 eV. Excepto la señal del sustrato Ge, hay un pico enorme a 32,7 eV para la unión Ge-O. El pico de Ge-O debe ser el resultado de la formación de Ge-O-Si y GeO 2 . El GeO 2 La capa se formó por oxidación de plasma de oxígeno superficial durante PEALD SiO 2 proceso de deposición. Por lo tanto, la estructura real fabricada aquí es HfO 2 / Si-O-Ge / GeO 2 / Ge pilas. Además, el espectro Ge 3d no muestra cambios evidentes después del tratamiento con PDA a 500 ° C, lo que indica la estabilidad térmica del HfO 2 / Si-O-Ge / GeO 2 / Ge se apila sin GeO 2 degradación. Ha sido informado por Kita et al. que algunas capas de cobertura en GeO 2 podría suprimir el GeO 2 descomposición, como Si o La 2 O 3 [19]. Por lo tanto, el PEALD indujo la capa intermedia de Si-O-Ge aquí también puede suprimir el GeO 2 descomposición. Sobre la base del análisis XPS anterior, se puede concluir que se forma una capa intermedia ultrafina de Si-O-Ge en la superficie de Ge. Además, esta capa intermedia exhibe una estabilidad térmica fantástica sin la formación de silicatos de Hf, también puede inhibir el GeO 2 degradación.
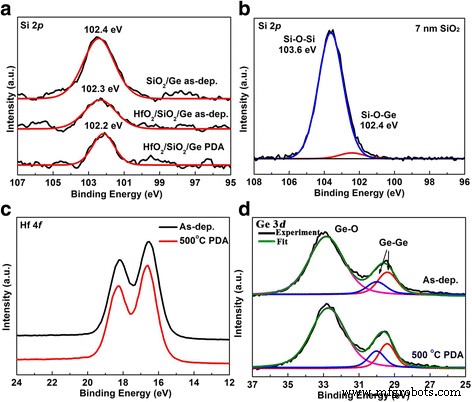
Espectros XPS de SiO 2 / Ge y HfO 2 / SiO 2 / Estructuras Ge. un Espectros de Si 2p de SiO 2 , tal como se ha depositado y recocido HfO 2 / SiO 2 en Ge. b Espectros de Si 2p de SiO grueso 2 (7 nm) en Ge. c, d Espectros Hf 4f y Ge 3d de HfO 2 recién depositado y recocido / SiO 2 / Estructuras Ge
La Figura 2a traza las curvas C-V de alta frecuencia (1 MHz) de HfO 2 / SiO 2 gate se apila en Ge antes y después de PDA. Se puede encontrar que el voltaje de banda plana ( V fb ) valores de HfO 2 / SiO 2 / Ge antes y después de PDA son 0,42 y 0,27 V, respectivamente. El V ideal calculado fb El valor es 0,55 V. El valor ligeramente negativo V fb el desplazamiento indica cargas fijas positivas, que pueden ser inducidas por las vacantes de oxígeno en los dieléctricos [26, 27]. Durante el proceso de recocido en atmósfera inerte, se pueden inducir más vacantes de oxígeno, lo que da como resultado un V ligeramente negativo. fb cambio. Se ha demostrado en muchas publicaciones que la GeO 2 la degradación durante el recocido provocará el V positivo fb cambio. Se cree que el proceso de desorción de Ge-O genera cargas negativas adicionales [28, 29]. Por tanto, también se puede concluir que GeO 2 la descomposición es suprimida por la capa intermedia de Ge-O-Si de V fb cambio. La capacitancia de acumulación aumenta evidentemente del 1,92 original a 2,25 μF / cm 2 después de PDA. Los valores correspondientes de espesor equivalente de capacitancia (CET) de los capacitores MOS se pueden calcular a partir de las capacitancias de acumulación de las curvas C-V usando ε 0 ε r acc de aire acondicionado [30]. Por lo tanto, se obtiene un CET más pequeño de 1,53 nm después de PDA en comparación con la muestra depositada de 1,80 nm. Se puede atribuir al hecho de que se puede adquirir una capa de alto k más densa y más delgada después del proceso de PDA. La Figura 2b muestra las características de la corriente de fuga de HfO 2 / SiO 2 películas en Ge antes y después de PDA. A la tensión de polarización de V fb + 1 V, la densidad de corriente de fuga es 2,1 × 10 −3 A / cm 2 y 2,2 × 10 −4 A / cm 2 para la muestra antes y después del PDA, respectivamente. El aumento de la densidad de corriente de fuga después del PDA también se puede atribuir a la disminución del espesor de los dieléctricos de la puerta.
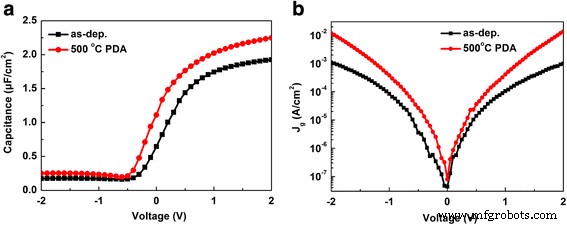
Características eléctricas de HfO 2 / SiO 2 compuerta apila sobre sustratos de Ge antes y después de 500 ° C PDA. un Curvas C-V de alta frecuencia (1 M Hz). b Curvas J-V
Para examinar la calidad de la interfaz de HfO 2 / SiO 2 / Ge cuantitativamente, la densidad del estado de la interfaz ( D eso ) se determinó mediante el método de conductancia [31]. La Figura 3 muestra la distribución de D eso debajo de E c en la banda prohibida extraída por el método de conductancia a temperatura ambiente para Pt / HfO 2 / SiO 2 / Ge antes y después de 500 ° C PDA. La D eso se puede calcular aproximadamente a partir de D eso =2,5 × ( G p / w ) max / A q, donde ( G p / w ) max es el valor máximo de las características de conductancia-voltaje, f (= w / 2π) es la frecuencia, A es el área del electrodo y q es la carga elemental. Por lo tanto, D eso valores de Pt / HfO 2 / SiO 2 / Se determina que las estructuras de Ge sin y con PDA son 4.05 × 10 12 eV −1 cm -2 y 5,37 × 10 12 eV −1 cm −2 en E-E v =0,38 eV, respectivamente. La D inferior eso valores de 2,03 × 10 12 cm −2 eV −1 y 2,67 × 10 12 cm −2 eV -1 cerca de la parte inferior de la banda de conducción se observan para las muestras sin y con PDA, respectivamente.
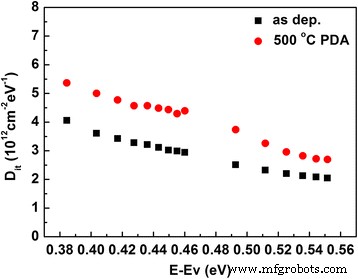
Distribución de D it debajo de E c en la banda prohibida a temperatura ambiente para Pt / HfO 2 / SiO 2 / Ge antes y después de 500 ° C PDA
La Figura 4 ilustra la densidad de corriente de fuga ( J g ) -Relación CET del condensador MOS basado en Ge con diferente capa de control interfacial [32, 33]. En comparación con el Ge pasivado S sin capa intermedia informado por nuestro trabajo anterior [34], el HfO 2 / SiO 2 / Ge en este trabajo exhibe propiedades mucho mejoradas con CET más pequeño (1.53 vs 2.18 nm), densidad de corriente de fuga (2.1 × 10 −3 frente a 3,1 A / cm 2 ) y D eso (4,37 × 10 12 frente a 8,61 × 10 12 eV −1 cm −2 ). Implica que el SiO 2 formado por PEALD in situ es una maravillosa capa de pasivación para Ge. Además, en comparación con el SiO 2 formado ex situ capa intermedia por MOCVD [9], la muestra con SiO 2 formado por PEALD in situ La capa intermedia de este trabajo muestra un mejor rendimiento eléctrico con CET más pequeño (1,53 frente a 1,75 nm) y densidad de corriente de fuga (2,1 frente a 3,9 mA / cm 2 ). Puede atribuirse al hecho de que SiO 2 depositados por PEALD son más uniformes que MOCVD especialmente para espesores ultrafinos.
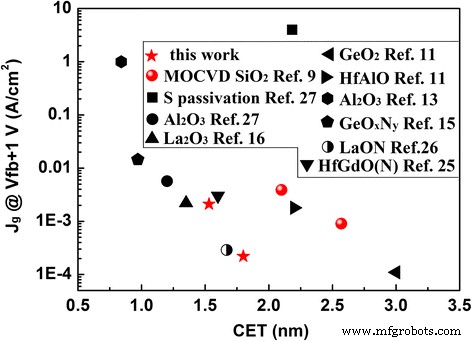
Relación de densidad de corriente de fuga (Jg) -CET para condensadores MOS basados en Ge con diferente capa de control interfacial
La alineación de la banda en HfO 2 / SiO 2 / Ge interfaz también se determinó midiendo el desplazamiento de la banda de valencia ∆E v (VBO) usando XPS. Los valores de VBO se pueden obtener basándose en el supuesto de que la diferencia de energía entre el nivel del núcleo y el borde de la banda de valencia (VB) del sustrato permanece constante con / sin la deposición de películas dieléctricas [35]. Aquí, el sustrato de Ge se eligió como referencia para determinar el VBO entre la pila de dieléctricos de la puerta y el sustrato de Ge. La Figura 5a presenta los espectros VB del sustrato de Ge limpio, tal como se depositó y recoció HfO 2 / SiO 2 / Pilas de Ge determinadas por el método de extrapolación lineal, respectivamente. Se ha determinado que el borde VB del sustrato Ge limpio es de 0,10 eV. Y los bordes VB de HfO 2 recocido y depositado / SiO 2 las muestras son de 2,55 y 2,79 eV, respectivamente. Se puede notar que hay una pequeña cola en los espectros VB para HfO 2 / SiO 2 / Ge pilas, que corresponde a la señal del sustrato Ge [36]. El borde de ataque de esta cola débil se mide en 0,10 eV y es el mismo que el borde VB del sustrato de Ge. Por lo tanto, los VBO en la interfaz de HfO 2 / SiO 2 / Ge con y sin PDA se estima en 2,69 y 2,45 eV, respectivamente. El desplazamiento de la banda de conducción ∆ E c (CBO) se puede obtener restando el VBO y la banda prohibida del sustrato de la banda prohibida de HfO 2 :
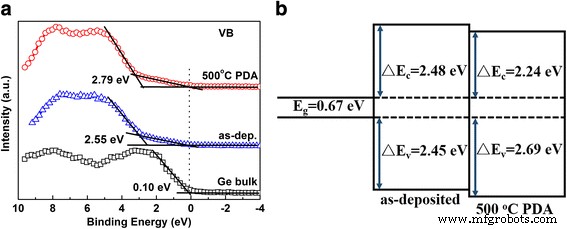
Alineación de bandas de HfO 2 recocido y recién depositado / SiO 2 película sobre Ge. un Espectros de banda de valencia del sustrato de Ge, depositado y recocido HfO 2 / SiO 2 Película (s. b Esquema de alineación de bandas de HfO 2 recocido y depositado / SiO 2 película en Ge
$$ \ varDelta {E} _c ={E} _g \ left ({\ mathrm {HfO}} _ 2 \ right) - {E} _g \ left (\ mathrm {Ge} \ right) - \ varDelta {E} _v , $$donde E g (HfO 2 ) y E g (Ge) son la banda prohibida de HfO 2 y Ge, respectivamente. La banda prohibida de Ge y HfO 2 son 0,67 y 5,6 eV, respectivamente. Por lo tanto, los valores de CBO en la interfaz de HfO 2 / SiO 2 / Ge con y sin PDA se estima en 2,24 y 2,48 eV, respectivamente. Los valores de CBO son consistentes con los datos previamente reportados de 1.8-2.6 eV [37]. La Figura 5b ilustra la alineación de banda correspondiente de HfO 2 como depositado y recocido / SiO 2 / Estructuras Ge. Evidentemente, el HfO 2 / SiO 2 Las pilas dieléctricas de puerta de alta k en Ge exhiben grandes valores de VBO y CBO con alturas de barrera enormes para inhibir la corriente de fuga.
Conclusiones
En resumen, SiO 2 la capa intermedia se introdujo en HfO 2 compuerta dieléctricos en sustratos n-Ge con éxito mediante PEALD in situ. Hemos investigado las propiedades eléctricas, interfaciales y la alineación de bandas de HfO 2 / SiO 2 / Ge MOS. Se ha demostrado que la capa intermedia Ge-O-Si y GeO 2 La capa se forma en la superficie de Ge durante el SiO 2 in situ declaración. Esta capa intermedia de Ge-O-Si muestra una estabilidad térmica fantástica durante el PDA sin formación de silicatos de Hf. Además, la capa intermedia de Ge-O-Si también puede inhibir el GeO 2 degradación durante el proceso de recocido. El HfO 2 / SiO 2 / La muestra de Ge después de PDA presenta un valor CET de 1,53 nm con una densidad de corriente de fuga baja de 2,1 × 10 −3 A / cm 2 en V fb + 1 V. Los valores de VBO en el HfO 2 / SiO 2 / Ge con y sin PDA se determina en 2,69 y 2,45 eV, y los valores de CBO en 2,24 y 2,48 eV, respectivamente. En comparación con el SiO 2 formado ex situ capa intermedia por MOCVD, la muestra con SiO 2 formado PEALD in situ La capa intermedia en este trabajo muestra un rendimiento eléctrico mejorado, atribuido al hecho de que SiO 2 depositados por PEALD son más uniformes que MOCVD. Por lo tanto, PEALD es una tecnología mucho más poderosa para la deposición de capas de control interfacial ultradelgada que MOCVD.
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Modelo de retención de TaO / HfO x y TaO / AlO x RRAM con características de interruptor autorrectificante
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Propiedades eléctricas de materiales compuestos con alineación asistida por campo eléctrico de rellenos de nanocarbono
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- Efectos de las variaciones de grabado en la formación de canales Ge / Si y el rendimiento del dispositivo



