Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atómica
Resumen
El HfO 2 / TiO 2 / HfO 2 Se han fabricado dispositivos de memoria de acceso aleatorio resistivo de estructura de tres capas (RRAM) sobre sustratos de Si recubiertos de Pt y TiN con electrodos superiores de Pt mediante deposición de capa atómica (ALD). Se ha investigado el efecto de los electrodos inferiores de Pt y TiN sobre las propiedades de conmutación resistiva de las unidades con estructura de tres capas. Ambos Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 / TiN exhibe un comportamiento típico de conmutación resistiva bipolar. Los mecanismos de conducción dominantes en los estados de baja y alta resistencia (LRS y HRS) de ambas células de memoria son el comportamiento óhmico y la corriente limitada por carga espacial, respectivamente. Se encuentra que los electrodos inferiores de Pt y TiN tienen una gran influencia sobre la preferencia de polaridad de electroformado, la relación de alta y baja resistencia y la dispersión de los voltajes operativos de las celdas de memoria con estructura de tres capas. En comparación con el uso de electrodos superior / inferior de Pt simétricos, las celdas RRAM que utilizan electrodos superior / inferior de Pt asimétricos muestran un voltaje de formación negativo más pequeño de −3,7 V, una distribución relativamente estrecha de los voltajes de ajuste / reinicio y una relación más baja de resistencias altas y bajas de 10 2 . La polaridad de electroformado dependiente del electrodo se puede interpretar considerando la actividad química de los electrodos con oxígeno, las reacciones relacionadas en el ánodo y la distribución no uniforme de la concentración de vacantes de oxígeno en la estructura de tres capas de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN. Además, para Pt / HfO 2 / TiO 2 / HfO 2 / TiN, el electrodo de TiN como depósito de oxígeno juega un papel importante en la reducción del voltaje de formación y en la mejora de la uniformidad de los parámetros de conmutación resistiva.
Antecedentes
La memoria resistiva de acceso aleatorio (RRAM) ha atraído una gran atención debido a su potencial para el reemplazo de la memoria flash en las memorias no volátiles de próxima generación [1, 2, 3]. El fenómeno de conmutación resistiva (RS) se ha descubierto ampliamente en óxidos de metales de transición, electrolitos sólidos y polímeros orgánicos [4, 5, 6, 7]. Los dispositivos RRAM basados en óxidos de metales de transición han sido ampliamente explorados debido a su composición simple y procesamiento compatible con la fabricación convencional de semiconductores de óxido de metal complementario (CMOS) [8, 9, 10]. El modelo de filamento de la migración de vacantes de oxígeno se utiliza para dilucidar el comportamiento de conmutación [1, 11]. Se propone un principio microscópico unificado para cuantificar las características de conmutación unipolar y bipolar de la RRAM basada en óxidos de metales de transición, que se correlacionan con la distribución de las vacantes de oxígeno localizadas en la capa de conmutación de óxido [12, 13].
Sin embargo, las celdas de memoria que utilizan óxidos de metales de transición adolecen de falta de uniformidad en los parámetros de conmutación resistiva, como valores de resistencia inestable de estados de baja y alta resistencia (LRS y HRS), tensiones de activación y desactivación dispersas, lo que dificulta las aplicaciones comerciales. Recientemente, se ha demostrado que los dispositivos RRAM basados en óxido de estructura de tres capas mejoran la dispersión de los parámetros de conmutación resistiva. Las células con una estructura de Al 2 O 3 / HfO 2 / Al 2 O 3 exhibió una uniformidad fantástica de los voltajes de ajuste y reinicio, y una excelente resistencia al cambio entre el LRS y el HRS [14]. El enlace o ruptura de los filamentos conductores ocurrió más fácilmente en dos capas interfaciales entre Al 2 O 3 / IL / HfO 2 / IL / Al 2 O 3 . Mientras tanto, la unidad de estructura de tres capas de TaO x / TiO 2 / TaO x mostró un buen rendimiento en matrices de resistencias de un selector-uno, que se atribuyó al hecho de que la banda de energía del TiO 2 la película se dobló simétricamente en la parte superior e inferior TaO x / TiO 2 interfaces y modificado como una barrera de óxido con cresta debido a la difusión de algunos átomos de Ta en TiO 2 película [15].
Además, el comportamiento de RS de un medio de almacenamiento de óxido dado puede verse significativamente afectado por los materiales de los electrodos [1, 16, 17]. Sin embargo, los modelos existentes basados en la energía libre de formación de óxido interfacial y las funciones de trabajo del metal son insuficientes para explicar completamente los resultados. Mientras tanto, el trabajo sobre el fenómeno RS dependiente de electrodos de la estructura de tres capas RRAM también es bastante escaso en la actualidad.
La deposición de capa atómica (ALD) es un nuevo tipo de tecnología de deposición de película delgada basada en reacciones secuenciales autolimitadas y complementarias de quimisorciones de superficie utilizando vapor precursor con control de espesor simple y preciso, uniformidad de área grande y excelente conformalidad tridimensional, especialmente para la deposición. de estructura nanolaminada [18, 19].
En este trabajo, el HfO 2 / TiO 2 / HfO 2 Los dispositivos RRAM de estructura de tres capas se han preparado en Si / SiO 2 / Sustratos de Ti / Pt y Si / TiN con electrodos de Pt top de ALD. El impacto de los electrodos inferiores de Pt y TiN en los comportamientos RS de HfO 2 / TiO 2 / HfO 2 dispositivos se ha investigado cuidadosamente. Se ha propuesto la explicación relacionada.
Métodos
En este experimento, usamos dos electrodos inferiores diferentes, incluido el Si / SiO 2 comercial / Ti / Pt y Si / SiO casero 2 /Estaño. El TiN conductor se depositó mediante deposición de capa atómica mejorada con plasma (PEALD) en nuestro laboratorio.
ALD se realizó en un Picosun SUNALE TM comercial Reactor avanzado R-200 (Picosun, Finlandia). P Se utilizaron obleas de tipo Si (100) con una resistividad de 1 ~ 10 Ω cm como sustratos de partida. Después de la limpieza RCA convencional de las obleas de Si sin eliminar el óxido nativo, se depositó TiN de 30 nm de espesor sobre Si como electrodo inferior a 400 ° C mediante PEALD, usando TiCl 4 a temperatura ambiente. y NH 3 gas de plasma como precursores de Ti y N, respectivamente. NH 3 líquido fue seleccionado como NH 3 fuente de plasma a temperatura ambiente. El poder del plasma y NH 3 el caudal de gas fue de 2500 W y 150 sccm, respectivamente.
Posteriormente, 5 nm HfO 2 / 10 nm TiO 2 / 5 nm HfO 2 Las estructuras de apilamiento se depositaron a su vez sobre sustratos de Si recubiertos de Pt y TiN a 250 ° C mediante ALD térmico utilizando Hf [N (C 2 H 5 ) CH 3 ] 4 (TEMAH), TiCl 4 y H 2 O como precursores de Hf, Ti y O, respectivamente, donde un ciclo de óxido constaba de 0,1 s inyección de fuente de metal, 4 s N 2 purga, 0,1 s H 2 O inyección y 4 s N 2 purga. TEMAH se evaporó a 150 ° C. Pure N 2 (99,999%) se utilizó como gas portador y gas de purga. Luego, electrodos superiores de Pt de 100 nm de espesor se pulverizaron con CC a través de una máscara de sombra con un diámetro de 150 μm utilizando el sistema Q150T.
El crecimiento por ciclo (GPC) de HfO 2 puro o TiO 2 sobre Si se determinó mediante elipsómetro espectroscópico (GES-5, Sopra). La topografía y la rugosidad de la superficie de las películas y los electrodos inferiores se analizaron mediante microscopía de fuerza atómica (AFM, Cypher, Asylum Research). Los valores de rugosidad de la raíz cuadrada media (RMS) se registraron en áreas de 1 μm × 1 μm. La composición y el estado químico de las estructuras de la pila se examinaron mediante espectroscopía de fotoelectrones de rayos X (XPS, Thermo Fisher K-Alpha) con un Al K α monocromático fuente (hν =1486,6 eV) para la excitación de fotoelectrones. El efecto de carga se calibró configurando el C 1 s fotoemisión a 284,6 eV. El perfil de profundidad XPS de HfO 2 / TiO 2 / HfO 2 sobre Si revestido con Pt y TiN se obtuvo mediante grabado con iones Ar. Las propiedades eléctricas del HfO 2 / TiO 2 / HfO 2 Los dispositivos RRAM de estructura de tres capas se midieron mediante el sistema de caracterización de semiconductores Keithely 4200 en la estación de la sonda (CasCade Summit 12000 B-M). Se impuso un cumplimiento de corriente de 10 mA para proteger las unidades de dispositivo fabricadas de daños por alta corriente durante los procesos establecidos. El voltaje de polarización se aplicó al electrodo superior de Pt con los electrodos inferiores conectados a tierra de Pt o TiN.
Resultados y discusión
El esquema del dispositivo RRAM de HfO 2 / TiO 2 / HfO 2 La estructura de tres capas por ALD se ilustra en la Fig. 1. La morfología de la superficie y la rugosidad de los electrodos inferiores y la estructura de tres capas de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto con Pt y TiN. El electrodo inferior de Pt tiene un valor eficaz más pequeño de 0,39 nm que el TiN derivado de PEALD de 0,87 nm. Por lo tanto, la muestra de HfO 2 / TiO 2 / HfO 2 en Si recubierto de Pt también exhibe una superficie relativamente más suave con RMS de 0.68 nm que en Si recubierto de TiN con 1.3 nm.
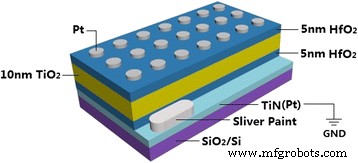
El esquema del dispositivo RRAM de HfO 2 / TiO 2 / HfO 2 estructura de tres capas por ALD
Las curvas DC I-V de Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 Los dispositivos / TiN que contienen el proceso de electroformado inicial se representan en la Fig. 2a, b, respectivamente, lo que indica una característica de conmutación resistiva bipolar típica. Para casi todas las muestras, se necesita un voltaje de formación mayor para formar filamentos conductores antes de la prueba de conmutación. Al aplicar un voltaje de polarización positivo en el electrodo superior de Pt, el Pt / HfO 2 / TiO 2 / HfO 2 / La unidad del dispositivo Pt muestra un voltaje de formación de +7 V en la Fig. 2a. Continuando con el barrido de voltaje, se mide un voltaje de reinicio de −0,8 V para la celda unitaria de LRS a HRS y un voltaje establecido de 2,0 V de HRS a LRS. La relación correspondiente de resistencias altas y bajas es de aproximadamente 10 5 . El proceso de electroformado y reposo también se puede completar aplicando un voltaje negativo de −11 V y uno positivo de +4 V, respectivamente, que son mucho más grandes que los voltajes de formación positivo y restablecimiento negativo. Además, la celda del dispositivo solo cambia de LRS a HRS durante varios ciclos después del proceso de formación negativo y luego no se restablece a HRS debido a la ruptura irreversible (no se muestra aquí). En la figura 2b, en comparación con los electrodos superior e inferior de Pt simétricos, los dispositivos RRAM de estructura de tres capas con electrodo inferior de TiN asimétrico y electrodo superior de Pt muestran un voltaje de formación inferior opuesto de aproximadamente −3,7 V, voltaje de ajuste de −1,5 V , voltaje de reinicio de +1.5 V y una relación relativamente menor de resistencias altas y bajas de 10 2 . Al imponer el voltaje de electroformado positivo, el fenómeno RS no se puede observar en el Pt / HfO 2 / TiO 2 / HfO 2 / TiN y el dispositivo se descompone permanentemente a +14 V sin el siguiente restablecimiento eficiente de LRS a HRS a voltaje negativo (no se muestra aquí).
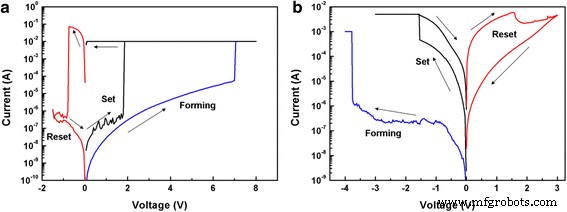
Las características típicas de conmutación resistiva bipolar de los dispositivos RRAM. un Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Los dispositivos RRAM de estructura de tres capas con electrodos superior / inferior de Pt simétricos y electrodo inferior de TiN asimétrico / electrodos superiores de Pt exhiben una preferencia de polaridad de electroformado tan diferente. El electrodo inferior de Pt químicamente inerte o TiN relativamente activo parece jugar un papel clave. La razón relacionada con la polaridad de electroformado dependiente del electrodo se discutirá más adelante después de considerar los perfiles de profundidad XPS de las estructuras de tres capas de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN.
Para la aplicación de memoria de alta densidad, la uniformidad de los parámetros RS es muy importante. La Figura 3a, b traza los resultados estadísticos de la distribución de los voltajes de ajuste y reinicio medidos desde una sola unidad de dispositivo del Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 / TiN para pruebas de 200 veces, respectivamente. La Figura 3c, d registra las curvas I – V de 10 unidades de dispositivo seleccionadas al azar del Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 / TiN, respectivamente. Las unidades del dispositivo RRAM de estructura de tres capas con electrodos superior e inferior de Pt simétricos muestran una amplia distribución para el voltaje establecido de 1.2 a 2.8 V y el voltaje de restablecimiento de −0.5 a −1 V (Fig. 3a) y curvas I – V dispersivas (Fig. 3c). Considerando que, las unidades del dispositivo con electrodos asimétricos TiN inferior y Pt superior muestran un mejor comportamiento RS, como una distribución relativamente concentrada del voltaje establecido de −0,8 a −1,8 V y restablecimiento del voltaje de 1,3 a 1,8 V, y reproducibilidad estable en curvas I – V (Figura 3b, d). Simultáneamente, en comparación con las del Si recubierto de Pt, diferentes unidades de dispositivo en Si recubierto de TiN también se comportan en una mejor monodispersión en los parámetros de RS, beneficioso para las aplicaciones prácticas de RRAM.

Los resultados estadísticos de la distribución de los voltajes de ajuste y reinicio medidos desde una sola unidad de dispositivo para pruebas de 200 veces. un Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b Pt / HfO 2 / TiO 2 / HfO 2 /Estaño. Las curvas I – V de 10 unidades de dispositivo seleccionadas al azar. c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. d Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Las propiedades de resistencia y retención de las unidades de dispositivo de Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 Se han examinado / TiN, como se ve en las Fig. 4a-d, respectivamente. En Pt / HfO 2 / TiO 2 / HfO 2 / Pt, el voltaje de barrido se aplicó de 0 a 3 V para el ajuste y de 0 a -1,5 V para el reinicio. En Pt / HfO 2 / TiO 2 / HfO 2 / TiN, el voltaje de barrido se aplicó de 0 a -2 V para el ajuste y de 0 a 2 V para el reinicio. Los valores de resistencia de ENCENDIDO y APAGADO se leyeron usando 0.2 V a temperatura ambiente. Las pruebas de retención se midieron a temperatura ambiente con un voltaje de lectura de 0,2 V. Después de 200 ciclos de programa / borrado, Pt / HfO 2 / TiO 2 / HfO 2 Las unidades de dispositivo / Pt muestran una relación de resistencia relativamente estable de los estados APAGADO / ENCENDIDO por encima de 10 5 (Figura 4a); sin embargo, la característica de resistencia de Pt / HfO 2 / TiO 2 / HfO 2 / Las celdas de memoria TiN parecen no ser tan buenas como las de Pt / HfO 2 / TiO 2 / HfO 2 / Pt (figura 4b). Los estados ON y OFF en dispositivos con electrodos Pt-TiN no son muy estables con una relación de resistencia más pequeña de los estados OFF / ON de aproximadamente 10 2 durante la prueba del ciclo de conmutación, fluctuación HRS especialmente significativa que la de LRS. Basado en el modelo físico en Ref. [12], la resistencia se mejorará aumentando la energía de formación de la vacante de oxígeno y la interfaz O 2− Monto. Especulamos con una explicación plausible. En nuestro trabajo anterior [14], excelentes propiedades de conmutación resistiva bipolar del Al 2 derivado de ALD O 3 / HfO 2 / Al 2 O 3 Se han demostrado estructuras de tres capas con electrodos asimétricos de TiN en la parte inferior y Pt en la parte superior, incluida una mejor resistencia al cambio de hasta 10 3 ciclos con relación estable de resistencia ON / OFF. Aquí, adoptamos HfO 2 / TiO 2 / HfO 2 configurar en lugar de Al 2 O 3 / HfO 2 / Al 2 O 3 . Los iones metálicos en HfO 2 y TiO 2 tienen la misma valencia química idéntica de +4, lo que lleva a defectos con menos carga de interfaz, como las vacantes de oxígeno entre dos capas interfaciales (IL) de la tricapa HfO 2 / TiO 2 / HfO 2 . Considerando que, los iones metálicos en Al 2 O 3 y HfO 2 tienen diferente valencia química de Al 3+ y Hf 4+ , produciendo más defectos cargados de interfaz de vacantes de oxígeno entre dos IL de Al 2 O 3 / HfO 2 / Al 2 O 3 . Se puede deducir que la interfaz O 2− cantidad agregando dos IL entre Al 2 O 3 / HfO 2 / Al 2 O 3 debe ser mayor que entre HfO 2 / TiO 2 / HfO 2 . Además, la energía de formación de oxígeno vacante en la capa de almacenamiento de Al 2 O 3 / HfO 2 / Al 2 O 3 también es más alta que la de HfO 2 / TiO 2 / HfO 2 (energía de formación de oxígeno vacante 7,08 eV (Al 2 O 3 ), 6,53 eV (HfO 2 ) y 4,35 eV (TiO 2 ) [20, 21]). Después de considerar estos factores, la celda de memoria de Pt / HfO 2 / TiO 2 / HfO 2 / TiN exhibe una degeneración de la resistencia, en comparación con Pt / Al 2 O 3 / HfO 2 / Al 2 O 3 / TiN.

Las características de resistencia y retención de las unidades del dispositivo. un , c Pt / HfO 2 / TiO 2 / HfO 2 / Pt. b , d Pt / HfO 2 / TiO 2 / HfO 2 / TiN.
Para Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 / TiN, el nivel de resistencia de los estados ON y OFF no tiene cambios evidentes después del tiempo de espera acumulativo de 10 4 s a temperatura ambiente en la Fig. 4c-d, lo que indica una mejor propiedad de retención de ambas celdas de memoria durante 10 años según el método de extrapolación.
Pt / HfO 2 / TiO 2 / HfO 2 Los dispositivos / TiN tienen una relación de resistencia de los estados OFF / ON mucho más baja que Pt / HfO 2 / TiO 2 / HfO 2 / Pt, que se puede atribuir a la diferencia de los electrodos inferiores en función de trabajo y conductividad. La función de trabajo de los electrodos inferiores de Pt y TiN es de 5,65 y 4,5 eV, respectivamente; por lo tanto, la barrera de interfaz entre TiN y HfO 2 subyacente es relativamente menor en Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivo TiN. Durante un proceso de reinicio, la energía necesaria para que el electrón cruce la barrera también es menor. Entonces Pt / HfO 2 / TiO 2 / HfO 2 / TiN manifiesta un valor de resistencia más bajo en estado APAGADO que Pt / HfO 2 / TiO 2 / HfO 2 / Pt correspondientemente. Durante un proceso establecido, el dispositivo RRAM cambia de HRS a LRS debido a la formación de los canales conductores. El electrodo inferior de Pt tiene una conductividad más alta que el electrodo inferior de TiN; en consecuencia, el valor de resistencia en estado ON para Pt / HfO 2 / TiO 2 / HfO 2 / TiN es más alto que el de Pt / HfO 2 / TiO 2 / HfO 2 / Pt. Como resultado, Pt / HfO 2 / TiO 2 / HfO 2 / Los dispositivos TiN muestran una relación de resistencia más pequeña de los estados APAGADO / ENCENDIDO de 10 2 . Sin embargo, la relación de resistencia de 10 2 ya ha cumplido con el requisito de las aplicaciones RRAM.
Para aclarar el mecanismo conductor durante la conmutación resistiva, las curvas I – V típicas se vuelven a trazar en escala logarítmica doble. La Figura 5a, b muestra el ajuste lineal de las curvas I – V para las regiones de barrido de voltaje de Pt / HfO 2 / TiO 2 / HfO 2 / Pt y Pt / HfO 2 / TiO 2 / HfO 2 / Dispositivos TiN. Ambas células de memoria se comportan con un mecanismo conductor similar. Cuando el dispositivo se cambia al LRS, las curvas de log (I) -log (V) son lineales con pendiente cercana a 1 (0.94 en la Fig. 5a, 0.98 en la Fig. 5b), lo que indica que la I – V en el LRS está dominado por la ley óhmica. El modelo de filamento de la migración de vacantes de oxígeno se puede utilizar para explicar el comportamiento de conmutación. Para el HRS, en la región de bajo voltaje (valor absoluto <0.11 V), el I – V está dominado por la ley óhmica con la relación lineal de corriente y voltaje (pendiente 1.05 en la figura 5a, 1.09 en la figura 5b). En una región de voltaje más alto (6,8 V> valor absoluto> 0,11 V en la figura 5a, 1,85 V> valor absoluto> 0,11 V en la figura 5b), la pendiente de las líneas log (I) -log (V) es de alrededor de 2 y la corriente depende del cuadrado aproximado del voltaje aplicado (I / V 2 ). A voltaje crítico (valor absoluto 6,8 V en la figura 5a, 1,85 V en la figura 5b), aparece repentinamente un fuerte aumento de corriente con una pendiente muy grande. Este resultado consta de tres regiones en HRS, básicamente obedeciendo a la típica inyección de conducción limitada por carga espacial controlada por trampa (SCLC) [11].
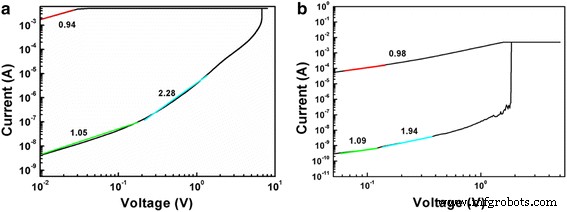
Las curvas I – V típicas trazadas en una escala logarítmica doble de a Pt / HfO 2 / TiO 2 / HfO 2 / Pt y b Pt / HfO 2 / TiO 2 / HfO 2 / TiN
Para comprender mejor el mecanismo de conmutación resistiva subyacente de HfO 2 / TiO 2 / HfO 2 en Si recubierto de Pt y TiN recubierto, realizamos exploraciones estrechas XPS y análisis de profundidad en estructuras de tres capas con electrodos inferior / superior simétricos y asimétricos. Los espectros XPS se ajustaron con funciones Gaussian-Lorentzian (G-L) después de la resta de fondo de tipo inteligente.
La Figura 6a – d ilustra los espectros XPS de barrido estrecho de Hf 4 f , Ti 2 p y O 1 s picos en HfO 2 y TiO 2 capas sobre Si recubierto de TiN. El Hf 4 f y espectros de Ti 2p de HfO 2 y TiO 2 las capas se pueden deconvolucionar en dos picos de grupo. El Hf 4 f más fuerte 5/2 y Hf 4 f 2/7 Los picos de 18,4 y 16,7 eV con una división de giro-órbita de 1,7 eV se asignan a la unión Hf-O (Hf 4+ ) de HfO 2 (Figura 6a). Los picos de doblete de espín-órbita más débiles a una energía de enlace más baja de 17,6 y 14,8 eV posiblemente sean el resultado del estado de valencia química baja de Hf n + –O ( n <4), que indica la presencia de vacantes de oxígeno en HfO 2 capa. La concentración porcentual calculada de Hf n + ( n <4) es aproximadamente 3,7% en iones Hf. En la Fig. 6b, un doblete más fuerte corresponde a Ti 2 p 3/2 y 2 p 1/2 características a 458,8 y 464,5 eV, pertenecientes al enlace Ti – O (Ti 4+ ) de TiO 2 . Un doblete más débil se ubica en 456.1 y 462.0 eV, asignando a Ti 3+ –O vinculación. La concentración porcentual calculada de Ti 3+ es aproximadamente el 21% en iones Ti. Esto implica la existencia de vacantes de oxígeno en TiO 2 capa.
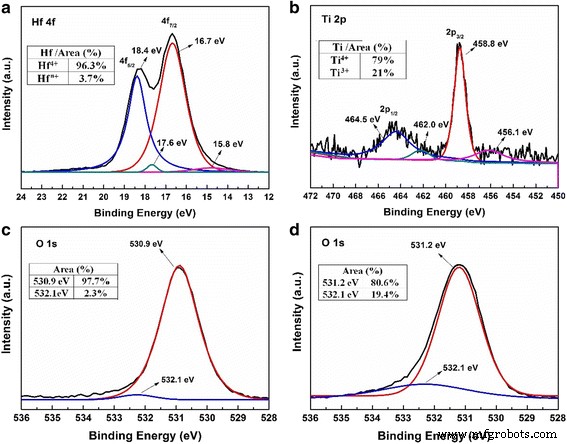
Espectros XPS de barrido estrecho de la estructura de tres capas de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de TiN. un Hf 4f, b Ti 2 p picos de HfO 2 / TiO 2 / HfO 2. O 1 s picos de c HfO 2 y d TiO 2 capas
Los O 1 s espectros de HfO 2 y TiO 2 las capas también se pueden deconvolucionar en dos picos, como se ve en la Fig. 6c, d. Las energías de enlace relativamente más bajas de los O 1 s picos a ~ 530,9 y 531,2 eV se asignan a la unión de Ti-O y Hf-O en TiO 2 y HfO 2 capas, respectivamente, pertenecientes a la red de oxígeno sin vacantes de oxígeno. Mientras que la energía ligeramente superior de 532,1 eV en el O 1 s Los espectros de la Fig. 6c, d se atribuyen a los átomos de oxígeno cerca de las vacantes de oxígeno en HfO 2 y TiO 2 capas basadas en los informes de la literatura [22,23,24,25]. La concentración relativa de vacantes de oxígeno en la capa de óxido se puede evaluar de forma aproximada calculando la proporción de área de cada pico [22, 23]. La concentración porcentual calculada de vacante de oxígeno en HfO 2 y TiO 2 capas es aproximadamente 2,3 y 19,4%, respectivamente, de acuerdo con los resultados de Hf n + y Ti 3+ .
La Figura 7a, b muestra los perfiles de profundidad XPS de HfO 2 / TiO 2 / HfO 2 muestras en Si recubierto con Pt y TiN mediante grabado con iones Ar, respectivamente. La estructura de tres capas de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN se puede reconocer fácilmente, aunque la importante difusión interfacial entre HfO 2 / TiO 2 y HfO 2 / Se ha observado TiN. Por lo general, el modelo de filamento de la migración de vacantes de oxígeno domina el comportamiento de RS en dispositivos RRAM basados en óxidos de metales de transición [11]. Sin embargo, simplemente aumentar el contenido de vacantes de oxígeno no es completamente efectivo. Cómo controlar eficazmente la distribución de los filamentos vacantes de oxígeno es una cuestión clave para finalmente mejorar la uniformidad de RS [20]. Mucho trabajo ha demostrado que, por lo general, una distribución no uniforme de las vacantes de oxígeno es beneficiosa para los comportamientos de RS, incluida la disminución del voltaje de formación, la mejora de la estabilidad de conmutación y la capacidad de resistencia [1, 14, 20, 26, 27, 28, 29]. Una distribución inicial no uniforme de las vacantes de oxígeno en una capa de óxido de almacenamiento a menudo se obtiene mediante el uso de un electrodo químicamente activo con una afinidad de oxígeno relativamente alta (p. Ej., Ta, Ti, Al o TiN) o mediante la introducción deliberada de una fuente de oxígeno rica en vacantes. capa interfacial por ingeniería de interfaz [1, 17, 30].
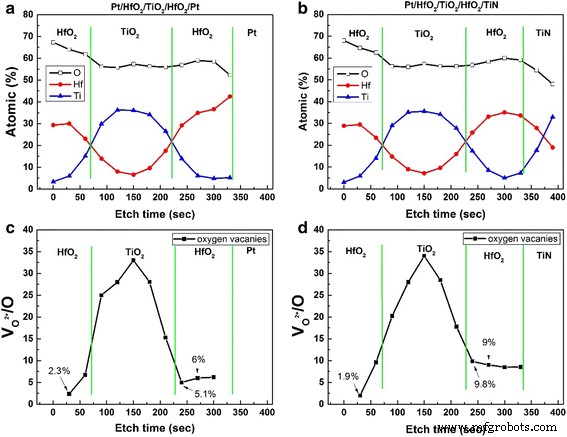
Perfiles de profundidad XPS de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN mediante grabado con iones de Ar. un HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt. b HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de TiN. La distribución de profundidad de la concentración de vacantes de oxígeno ( V O 2+ / O) determinado a partir de los espectros XPS para HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN. c HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt. d HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de TiN
La Figura 7c, d presenta las curvas de distribución de la concentración de vacantes de oxígeno de HfO 2 / TiO 2 / HfO 2 sobre Si recubierto de Pt y TiN basado en los perfiles XPS de profundidad anteriores, respectivamente. La concentración de vacantes de oxígeno se evaluó utilizando el método mencionado anteriormente. Se puede encontrar que la concentración de vacantes de oxígeno más alta (~ 34%) aparece en TiO 2 capa intermedia. Otra característica digna de mención es que el HfO 2 subyacente La capa cercana a los electrodos inferiores de Pt o TiN tiene una mayor concentración de vacantes de oxígeno que el HfO 2 superior capa (~ 2%). Además, la concentración de vacantes de oxígeno (~ 9%) del HfO 2 subyacente La capa sobre Si revestido con TiN es obviamente más alta que la (~ 6%) sobre Si revestido con Pt.
La Figura 8 muestra los diagramas esquemáticos de electroformado y reinicio de Pt / HfO 2 / TiO 2 / HfO 2 / Pt en voltajes de polarización positiva y negativa. Para los electrodos superior e inferior de Pt químicamente inertes, los fenómenos de electroconformado dependientes de la polaridad de polarización están relacionados con el O 2 gas liberado de la capa de óxido en el ánodo como producto de la electro-reducción. Como se sabe, durante el proceso de electroformado, las vacantes de oxígeno son creadas por un campo eléctrico alto y migran al cátodo, formando filamentos conductores localizados en la capa de óxido, es decir, O O → V O 2+ + O 2− , V O 2+ + 2 e - → V O [12] (Fig. 8b, e). Simultáneamente, O 2− Los iones se desplazan hacia el ánodo, liberando su carga y evolucionando O 2 gas, es decir, O 2− → 1/2 O 2 + 2 e - (Fig. 8b, e), que posiblemente provoquen una deformación física de la celda e incluso la formación de grietas u orificios [31]. Al aplicar voltaje de formación positivo al electrodo superior de Pt, postulamos el O 2 gas liberado por encima del HfO superior 2 la película se escapa fácilmente por el borde superior del electrodo oa través de un pequeño nanoporo en el electrodo superior de Pt (Fig. 8b), lo que provoca una deformación física débil. Mientras tanto, considerando la concentración de vacantes de oxígeno relativamente más alta en el HfO 2 subyacente (~ 6%) electrodo inferior de Pt cercano que el HfO 2 superior capa (~ 2,3%) (Fig. 7c), el filamento conductor se forma fácilmente, lo que lleva a un voltaje de formación positivo más pequeño de +7 V.Con un voltaje inverso de −0,8 V, la reacción inversa conduce a la ruptura del filamento, y el dispositivo es volvió fácilmente al estado HRS (Fig. 8d).

Diagramas esquemáticos de electroformado y reinicio de estructura de tres capas de HfO 2 / TiO 2 / HfO 2 con electrodos superior e inferior simétricos de Pt. un - d Electroformado a voltaje positivo y reinicio a voltaje negativo. e - g Electroformado a voltaje negativo y reinicio a voltaje positivo
Por el contrario, con un voltaje de formación negativo en el electrodo superior, se forma gas oxígeno debajo del HfO 2 subyacente capa y encima de Pt el electrodo inferior (Fig. 8e). El O 2 la liberación se vuelve más difícil, lo que impedirá la formación de filamentos conductores. Además, debido a que la concentración de vacantes de oxígeno del HfO 2 superior La capa (~ 2.3%) es más baja que la del HfO 2 subyacente (~ 6%) (Fig. 7c), se necesita el voltaje de formación negativo más alto de −11 V para formar filamentos. Cuando más O 2 se acumula a una cierta presión bajo HfO 2 subyacente , it possibly erupts from the mechanically weakest part of the thin films, leading to the hole in oxide films or separation between oxide films and the bottom electrode induced by bubble cracking. Although the device can be reset to HRS at applied +4 V bias (Fig. 8g), the memory cell is degraded after several switching cycles. In our samples, a part of top electrode was blown off after the forming process. Similar electroforming polarity preference scenario has also been observed in Pt/TiO2−x /Pt bipolar RRAM cells with various physical deformation evidences of the junctions [31, 32].
Pt/HfO2 /TiO2 /HfO2 /TiN devices exhibit quite different electroforming polarity from Pt/HfO2 /TiO2 /HfO2 /Pt. The LRS caused by electroforming can be observed at both negative and positive bias voltage; however, the effective reset from LRS to HRS can be achieved only at positive bias voltage in Pt/HfO2 /TiO2 /HfO2 /TiN device. Similar electroforming preference with asymmetric Pt and TiN electrodes has been observed in some literatures with various storage oxide layers such as HfO2 [33, 34], TiO2 [35], ZrO x /HfO y bilayer [22], and Al2 O 3 /HfO2 / Al 2 O 3 trilayer [14]. However, the related explanations are divergent or lacking.
After considering the TiN electrode’s chemical activity with oxygen [1, 30, 36] and the nondistribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 based on the XPS depth profiles (Fig. 7), a possible mechanism on electroforming polarity preference of Pt/HfO2 /TiO2 /HfO2 /TiN cells is proposed. Figure 9 shows the schematic diagrams of electroforming and reset of Pt/HfO2 /TiO2 /HfO2 /TiN at negative and positive bias voltages. The TiN bottom electrode plays a key role in the electroforming polarity. Kwak et al. reported that the relatively active TiN electrode would easily absorb oxygen ions from oxide films to form TiO x N1−x (TiON) interfacial layer [36]. The severe oxygen diffusion of underlying HfO2 layer into TiN bottom electrode has been confirmed in our sample by the XPS depth profile (Fig. 7b). For Pt/HfO2 /TiO2 /HfO2 /TiN device, the TiN electrode with high oxygen affinity [34, 36] produces a lot of oxygen vacancies in the underlying HfO2 layer near the TiN bottom electrode. The oxygen vacancies concentration of ~9% of underlying HfO2 layer is much higher than that of ~6% in the Pt/HfO2 /TiO2 /HfO2 /Pt device.
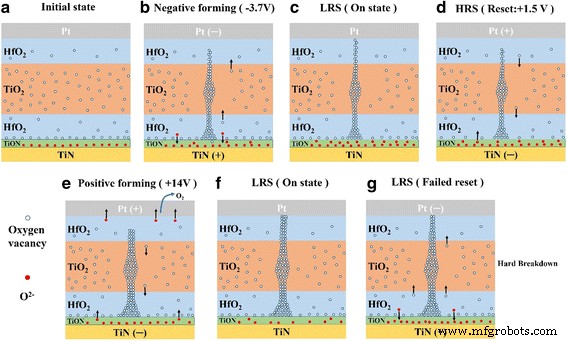
Schematic diagrams of electroforming and reset of trilayer-structure of HfO2 /TiO2 /HfO2 with asymmetric Pt top electrode and TiN bottom electrode. un - d Electroforming at negative voltage and reset at positive voltage. e –g Electroforming at positive voltage and reset at negative voltage
For chemically inert Pt top electrode and relatively active TiN bottom electrode, when applying negative forming voltage, O 2− ions drift towards the TiN anode and are absorbed to form TiO x N1−x layer (Fig. 9b), i.e., TiN + x O 2− →TiO x N 1−x + x 2e , avoiding the O2 release and possible damage to cells. The TiN electrode might act as a reservoir for oxygen ions drifting under an applied voltage [1, 36]. Simultaneously, due to the higher oxygen vacancy in the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%) than the upper HfO2 layer (~1.9%), the migration of the rich oxygen vacancies from the underlying HfO2 layer through TiO2 layer towards the the upper HfO2 layer, directly producing conductive oxygen vacancy filaments with a smaller forming voltage of −3.7 V (Fig. 9b). When performing reverse reset process at +1.5 V, the bottom electrode of TiN layer acting as oxygen reservoir supplies oxygen ions to react with oxygen vacancy, i.e., O 2− + V O 2+ →O O (lattice oxygen), which is beneficial to the reset operation from LRS to HRS with rupture of conductive filament (Fig. 9d). Above all, the oxygen reservoir effect of TiN bottom electrode contributes the forming voltage reduction as well as better set/reset voltage variation [1, 29, 36].
On the other hand, when imposing the positive forming voltage on top electrode Pt, the oxygen vacancies migrate from the upper HfO2 into the underlying HfO2 on TiN, accumulate in its vicinity, and develop into filaments. Owing to the lower oxygen concentration in the upper HfO2 (~1.9%) than the underlying HfO2 layer (~9%) and intermediate TiO2 layer (~10–34%), this leads to further increase of the oxygen vacancy concentration in underlying HfO2 and intermediate TiO2 layer. In the same time, due to slight oxygen existence in PEALD-derived TiN films (about 10%), some oxygen ions in TiN drift into underlying HfO2 layer to form insulate lattice oxygen with nearby oxygen vacancy, preventing from the growth of conductive filaments (Fig. 9e). Finally, when the bias voltage attains +14 V, the coarsening conductive filaments in oxides is formed. However, when a negative voltage is applied on the device, the conductive filament in trilayer structure is too large to be ruptured (Fig. 9g). Therefore, the device cannot switch to HRS by applying a negative voltage, indicating that an irreversible hard breakdown occurs in Pt/HfO2 /TiO2 /HfO2 /TiN device.
Finally, on account of the fact that the inserted TiO2 layer stores more oxygen vacancies than HfO2 layer, the distribution of oxygen vacancies in trilayer structure is not uniform, especially in the two interfacial layers between HfO2 /IL/TiO2 /IL/HfO2 , which might affect the growth position, direction, and overlapping of conductive filaments. The linkage or rupture of the conductive filaments corresponds to the set process from HRS to LRS or the reset process from LRS to HRS, respectively, which more easily happens in two interfacial layers. Further, the shape and position of the conductive filaments in HfO2 and TiO2 layers change less in the set and reset processes.
Conclusiones
In summary, RRAM devices based on trilayer-structure of Pt/HfO2 /TiO2 /HfO2 /Pt and Pt/HfO2 /TiO2 /HfO2 /TiN have been prepared by ALD. Both memory cells show typical bipolar resistive switching characteristics, and Ohmic and SCLC dominant conduction mechanisms in LRS and HRS, respectively. It is found that the bottom electrodes of Pt and TiN have great influence on the electroforming polarity preference, the ratio of high and low resistances and dispersion of the operating voltage of trilayer-structure memory cells. Compared to with symmetric Pt top/bottom electrodes, the RRAM cells with asymmetric Pt top/TiN bottom electrodes show smaller negative forming voltage of −3.7 V, relatively narrow distribution of the set/reset operation voltages and lower ratio of high and low resistances of 10 2 . The electrode-dependent electroforming polarity can be explained by considering electrodes’ chemical activity with oxygen, the related reactions at anode, and the nonuniform distribution of oxygen vacancy concentration in trilayer-structure of HfO2 /TiO2 /HfO2 on Pt- and TiN-coated Si. Furthermore, the TiN electrode as oxygen reservoir plays an important role in forming voltage reduction and better dispersion of RS parameters for Pt/HfO2 /TiO2 /HfO2 /TiN devices. Considering the modulation effect of electrode and trilayer-structure on resistive switching performance, this work provides a new device design route for future RRAM applications.
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Modelo de retención de TaO / HfO x y TaO / AlO x RRAM con características de interruptor autorrectificante
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Una SRAM 4T integrada de RRAM con carga de conmutación resistiva autoinhibida mediante un proceso lógico CMOS puro
- Efecto de la distribución de nanopartículas de oro en TiO2 sobre las características ópticas y eléctricas de las células solares sensibilizadas por colorante
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Un estudio colectivo sobre modelado y simulación de memoria resistiva de acceso aleatorio
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- Deposición de capa atómica de SiO2 mejorada con plasma a baja temperatura utilizando dióxido de carbono



