Co-dosificación de ozono y agua desionizada como precursores oxidantes del crecimiento de película delgada de ZnO por deposición de capa atómica
Resumen
Características de las películas delgadas de ZnO cultivadas por depósito de capa atómica (ALD) sobre sustratos de zafiro con y sin ozono de tres pulsos (O 3 ) como precursor de oxidante y se investigan el recocido térmico (TA) posterior a la deposición. La temperatura de deposición y el grosor de las depiladoras de ZnO son 180 ° C y 85 nm, respectivamente. El recocido térmico posterior a la deposición se realiza a 300 ° C en el ambiente de oxígeno (O 2 ) durante 1 h. Con agente oxidante fuerte O 3 y TA posterior a la deposición en el crecimiento de ZnO, la deformación y el estrés intrínsecos se reducen a 0,49% y 2,22 GPa, respectivamente, con una concentración de electrones de fondo extremadamente baja (9,4 × 10 15 cm −3 ). Esto se origina a partir de una menor densidad de defectos activados térmicamente en los análisis de extinción térmica de los espectros de intensidad integrada de fotoluminiscencia (PL). TA facilita aún más la recristalización formando granos más libres de defectos y luego reduce la tensión y el estado de tensión, lo que provoca una disminución notable de la concentración de electrones y la mejora de la rugosidad de la superficie.
Introducción
Se utilizan varios agentes oxidantes en el crecimiento de ZnO. Incluyen agua (H 2 O), peróxido de hidrógeno (H 2 O 2 ), oxígeno (O 2 ) y ozono (O 3 ) [1,2,3,4,5,6]. H 2 O es un oxidante de uso común en el crecimiento de ZnO con deposición de capa atómica (ALD). ALD es un mecanismo de crecimiento autolimitante capa por capa. Reacciones de intercambio de ligandos de superficie específicos con pulsaciones secuenciales de los respectivos precursores. Las reacciones de la superficie se detienen y se saturan cuando los sitios reactivos de la superficie se agotan por completo. El crecimiento de ALD de películas delgadas tiene ventajas tales como una deposición conformada superior en superficies y regiones laterales, excelentes coberturas escalonadas de los bordes, alta uniformidad en un área grande, precisión en el control del espesor de la capa y adecuada para bajas temperaturas de deposición [7,8,9] .
Los agentes oxidantes fuertes influyen no solo en las estructuras del material sino también en las características optoeléctricas del ZnO depositado con ALD. H 2 O 2 El oxidante proporciona condiciones más ricas en oxígeno que el H 2 de uso común O precursor para pasivar defectos vacantes de oxígeno (V O ) e intersticiales de zinc (Zn i ) en películas de ZnO cultivadas con ALD a bajas temperaturas de crecimiento de 80 a 150 ° C. Las morfologías de la superficie columnar con (002) orientación preferencial del plano de crecimiento ocurrieron cuando el uso de oxidante se altera de H 2 O a H 2 O 2 [2]. H 2 O 2 El oxidante aumenta las tasas de crecimiento en aproximadamente un 70% en comparación con el uso de O 3 reactivo gaseoso de ZnO crecido con ALD a 200 ° C. El aumento de la densidad del grupo hidroxilo (OH) en la superficie de crecimiento de las películas es responsable del aumento de las tasas de crecimiento [3]. El aumento de la tasa de crecimiento de ZnO alrededor del 60% para el uso de O 2 puro en lugar de H 2 O como oxidante también se informa [4].
O 3 es un oxidante eficaz en materiales de óxido cultivados con ALD. El alto potencial electroquímico del O 3 da lugar a velocidades de reacción rápidas a una temperatura de crecimiento baja. O 3 es más volátil que H 2 O, H 2 O 2 y O 2 y es más fácil de purgar. Por lo tanto, los tiempos de purga en cada ciclo se pueden acortar. La ausencia de hidrógeno en O 3 molécula conduce a una menor contaminación por hidrógeno e hidroxilo en el crecimiento. Se muestra un espesor menos uniforme debido a la pérdida de superficie recombinativa de ZnO durante 10 s de O 3 tiempos de exposición cuando el crecimiento está a 200 ° C [5]. Películas de ZnO sin dopar preparadas con ALD con O 3 Los agentes oxidantes muestran un doble factor de potencia termoeléctrica en comparación con las muestras con H 2 O oxidante. H 2 O- y O 3 -Las películas de ZnO cultivadas tienen los mismos niveles de defectos de V O pero diferentes niveles de defectos relacionados con el Zn. Suficiente poder de oxidación del O 3 da como resultado un contenido más bajo de Zn nativo i y por tanto un factor de potencia termoeléctrica mayor. Fuerte efecto oxidante de O 3 eleva el rendimiento termoeléctrico de las películas de ZnO sin dopar [6]. Co-dosificación de O 3 y H 2 O podría mejorar la uniformidad y conformalidad de la película delgada de ZnO para procesos adecuados de ALD [5].
Existen cepas intrínsecas y extrínsecas en la película de ZnO cultivada en un sustrato de zafiro de forma natural. La deformación intrínseca se origina a partir de imperfecciones cristalográficas de alta densidad en ZnO. Las imperfecciones cristalográficas incluyen complejos de hidrógeno, intersticiales de zinc (Zn i ), vacantes de oxígeno (V O ), dislocaciones de subprocesos (TD) y límites de grano (GB) [10,11,12,13,14,15,16,17,18,19,20,21]. La deformación extrínseca se genera a partir de un gran desajuste de las constantes de celosía y los coeficientes de expansión térmica entre la epicapa de ZnO y el sustrato de zafiro. Se ejercen diversas formas para disminuir la tensión intrínseca y extrínseca de los materiales de ZnO en los zafiros. La capa fina de amortiguación de MgO puede disminuir la deformación extrínseca, reducir la rugosidad de la superficie en un 58.8% y suprimir las grietas de la superficie de la película delgada de ZnO en el zafiro [22]. La cepa extrínseca de ZnO en zafiro se relaja completamente con un espesor que alcanza los 30 nm preparada por deposición de magnetrón a 550 ° C [23]. Se exhibe la relajación de la tensión de compresión de 1,77 a 1,47 GPa de películas de ZnO depositadas por el método de pirólisis por aspersión con el aumento de la temperatura del sustrato de vidrio de 350 a 450 ° C [24].
ALD ZnO cultivado a 180 ° C con precursores de un solo pulso (DEZn y H 2 O) muestra una concentración de electrones de fondo de hasta ~ 10 18 cm −3 incluso con TA posterior a la deposición [25]. H 2 de un solo pulso de uso común Los precursores de los procesos ALD no generan una monocapa ideal de átomos de oxígeno. Precursores de tres pulsaciones (DEZn y H 2 O) podría generar múltiples impactos o colisiones de moléculas precursoras con ligando de superficie para promover la probabilidad de reacción para el ALD ZnO cultivado a baja temperatura de 100 ° C. La elección de "tres" pulsos ayuda a asegurar que los reactivos ubiquen correctamente el sitio de reacción o quimisorción abierta. Concentración de electrones de fondo extremadamente baja 8,4 × 10 14 cm −3 , alta movilidad de deriva de electrones 62,1 cm 2 / Vs, y se adquiere una mejora pronunciada de la fotoluminiscencia (PL) del borde de banda prohibida (NBE) de precursores de tres pulsos ZnO con una capa tampón adecuada y condiciones de RTA [26]. Varios informes muestran una mejora de la calidad del material de películas delgadas de ZnO y múltiples pozos cuánticos de ZnO / ZnMgO con recocido térmico [27, 28]. En este informe, O 3 de tres pulsos y el subsiguiente H 2 de un solo pulso O como oxidantes por ciclo de ALD se utilizan para cultivar películas delgadas de ZnO a 180 ° C. Se aplica recocido térmico (TA) posterior a la deposición para mejorar la calidad cristalina de las muestras. Se exploran las características micro y nanoestructurales del material, la fotoluminiscencia y el efecto Hall de las películas delgadas de ZnO cultivadas con ALD.
Métodos experimentales
Las depiladoras de ZnO se depositan sobre zafiro c-face convencional (c-Al 2 O 3 ) sustratos por el sistema Cambridge NanoTech Savannah 100 ALD. En el crecimiento de películas delgadas de ALD ZnO, precursores que incluyen (DI) H 2 desionizado O, O 3 y dietil zinc (DEZn, Zn (C 2 H 5 ) 2 ) se utilizan. La Tabla 1 demuestra las condiciones del número de pulsos de O 3 y TA posterior a la deposición de tres muestras denominadas A, B y C. En la Fig. 1 se muestra un diagrama esquemático de la secuencia de pulsos con el tiempo por ciclo ALD de muestras. En esta figura, un ciclo ALD contiene seis pasos secuenciales. El primer paso es la inyección de H 2 desionizado (DI) de un solo pulso O en un reactor a escala de un metro para hacer una superficie terminada con hidroxilo (OH) en zafiro o para reaccionar con los grupos etilo colgantes (C 2 H 5 ) formando puentes de zinc-oxígeno (Zn – O) en la superficie de Zn con grupos de superficie de hidroxilo. Se produce una capa atómica de oxígeno (O). El segundo paso es la purga de gas nitrógeno de alta pureza (N 2 ) para eliminar el exceso de moléculas precursoras y subproductos volátiles y evitar la mezcla de precursores posteriores después de cada exposición de reactivos. El tercer paso es la inyección de O 3 de tres pulsos en reactores para facilitar la reducción de defectos nativos. El cuarto paso es la purga de la cámara con N 2 gas. El quinto paso es la inyección de DEZn de un solo pulso en reactores para producir una capa atómica de zinc (Zn) sobre la capa de oxígeno. El paso final también es la purga de la cámara con N 2 gas. Precursores pulsados en la cámara de reacción a través del gas portador N 2 con una presión de la cámara de 4 × 10 −1 Torr. La condición óptima de tiempo de exposición para los reactivos DI H 2 O, O 3 , y DEZn es 0.01, 0.5 y 0.015 s, respectivamente. El tiempo de impulso de la evacuación de la cámara es de 5 s. El espesor de las películas delgadas de ZnO es de 85 nm con 500 ciclos ALD de cada muestra. Otras condiciones favorables de los parámetros de deposición se muestran en los informes anteriores [29]. TA posterior a la deposición a 300 ° C en el ambiente de O 2 durante 1 h en un horno se procesa en la muestra C.
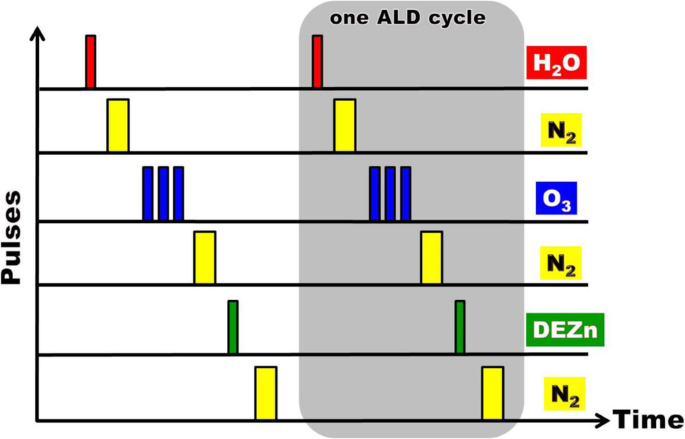
Películas de ZnO cultivadas con ALD sobre sustratos de zafiro con secuencia de pulsos H 2 O / N 2 / O 3 / N 2 / DEZn / N 2 usando agua desionizada, O 3 y Zn (C 2 H 5 ) 2 como los precursores
Las propiedades estructurales, ópticas y eléctricas de los materiales de las muestras se llevan a cabo mediante las siguientes mediciones. Los patrones de difracción de rayos X (XRD) se miden con un ángulo de difracción (2 θ ) oscilan entre 33 y 38 ° y una longitud de onda de 0,154 nm de radiación de cobre Kα mediante el uso del instrumento D2 phaser (Bruker Corporation). La medición del efecto Hall utiliza el sistema Ecopia HMS-3000 y las muestras se cortan en cuadrados con un tamaño de área de 0,7 × 0,7 cm 2 . Cuatro esquinas de las muestras están soldadas por pequeñas gotas de indio que muestran contactos óhmicos en configuración de van der Pauw. Se miden la densidad del portador de hojas, la movilidad y la resistividad de las películas. Los espectros de fotoluminiscencia (PL) se llevan a cabo de 10 a 300 K con una longitud de onda de excitación de 325 nm y una potencia de 55 mW de láser de He-Cd. Se analiza la extinción térmica de la intensidad integrada de los espectros PL con el aumento de temperatura. La textura de la superficie y la rugosidad de las muestras examinadas a partir de imágenes de alta resolución del microscopio de fuerza atómica (AFM) se toman con el instrumento de Veeco Dimension 3100.
Resultados y discusión
La Figura 2 demuestra la naturaleza cristalina de las muestras mediante las mediciones de los patrones XRD. Dos picos de difracción de Bragg (002) y (101) corresponden a la estructura hexagonal de wurtzita de ZnO. La intensidad de pico más fuerte de los patrones de XRD se normaliza para comparar la intensidad de pico entre muestras. Dos flechas verdes indicadas en el eje horizontal superior muestran ángulos de difracción de 34,4 ° y 36,2 ° de (002) y (101), respectivamente, de ZnO a granel libre de deformaciones adquirido de los conjuntos de datos de materiales publicados por la organización del Comité Conjunto sobre Difracción de Polvo Estándares (JCPDS). En la figura, se pueden observar los picos (002) y (101) en las muestras B y C acercan y acercan aún más los ángulos de difracción de (002) y (101) de ZnO a granel libre de deformaciones.

Patrones XRD de películas de ZnO con orientaciones cristalinas a lo largo de las direcciones (002) y (101) de las muestras. Las flechas indican los ángulos de difracción 34,4 ° y 36,2 ° de (002) y (101) de ZnO a granel, respectivamente
Deformación biaxial a lo largo de la c El eje de las capas epitaxiales se puede obtener mediante el desplazamiento de los patrones de DRX a lo largo de (002) en contraste con el ZnO en masa libre de deformaciones. Deformación media ( ε z ) en la red de películas de ZnO se estima a partir de los parámetros de la red utilizando la siguiente expresión.
$$ {\ varepsilon} _z =\ frac {c- {c} _0} {c_0} \ times 100 \% $$ (1)donde c y c 0 son las constantes de celosía a lo largo de c -Eje calculado a partir de los ángulos de difracción de Bragg de (002) picos de películas de ZnO y volumen. La tensión media ( σ ) en el plano de las películas se puede calcular utilizando el modelo de deformación biaxial:
\ (\ sigma =\ frac {2 {c} _ {13} ^ 2- {c} _ {33} \ left ({c} _ {11} + {c} _ {12} \ right)} {c_ {13}} \ times {\ varepsilon} _z =-453.6 \ times {\ varepsilon} _z \ left (\ mathrm {GPa} \ right) \) (2) donde c 11 =209,7 GPa, c 12 =121,1 GPa, c 13 =105,1 GPa y c 33 =210,9 GPa son las constantes de rigidez elástica del ZnO a granel. En la Tabla 1, las deformaciones / tensiones ( ε z / σ ) de las muestras A, B y C son 1,08% / 4,90 GPa, 0,74% / 3,37 GPa y 0,49% / 2,22 GPa, respectivamente. La deformación / tensión se reduce y se reduce aún más en las muestras B y C.
Los espectros PL a varias temperaturas de 10 a 300 K de muestras se muestran en la Fig. 3. La recombinación radiativa fuerte cerca del borde de la banda de excitones con un pico de energía espectral alrededor de 3.34 eV es dominante en los espectros PL de todas las muestras. La emisión óptica asistida por fonón óptico longitudinal (LO) se observa en el hombro de energía inferior de los espectros PL de las muestras. En la Fig. 4a-c, muestra la gráfica de Arrhenius de la intensidad integrada de los espectros PL frente a la inversa de la temperatura. La extinción térmica de la intensidad integrada de PL con el aumento de temperatura se puede ajustar mediante la siguiente fórmula de Arrhenius.
$$ I (T) =\ frac {A} {1+ {D} _ {nr1} \ exp \ left (\ frac {- {E} _ {A1}} {k _ {\ mathrm {B}} T} \ right) + {D} _ {nr2} \ exp \ left (\ frac {- {E} _ {A2}} {k _ {\ mathrm {B}} T} \ right)} $$ (3)donde yo ( T ) representa la intensidad PL integrada. A es una constante. D nr 1 y D nr 2 son constantes relacionadas con la densidad de centros de recombinación no radiativa. E A 1 y E A 2 son las energías de activación correspondientes al proceso de recombinación no radiativa de excitones unidos al donante a baja temperatura y excitones libres a alta temperatura, respectivamente. k B es la constante de Boltzmann. El método de mínimos cuadrados en el análisis de regresión se utiliza para ajustar los datos que muestran los parámetros de D nr 1 , D nr 2 , E A 1 y E A 2 con curvas de ajuste rojas en la Tabla 2 y la Fig. 4a – c. El resultado de ajuste muestra que las variaciones de D nr 1 , E A 1 y E A 2 entre las muestras hay luz. D nr 2 son 132,7, 153,6 y 110,8 de las muestras A, B y C, respectivamente, lo que muestra una gran diferencia en la cantidad de densidad de defectos. El valor más pequeño de D nr 2 sugiere la densidad más baja de defectos activados térmicamente en la muestra C.
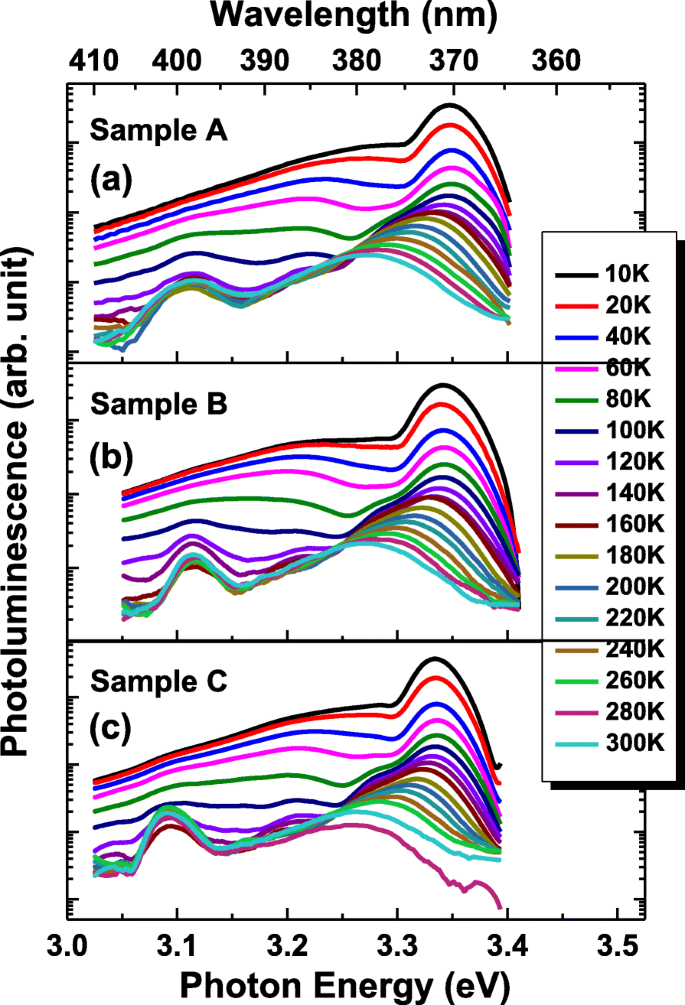
un - c Espectros PL de muestras dependientes de la temperatura
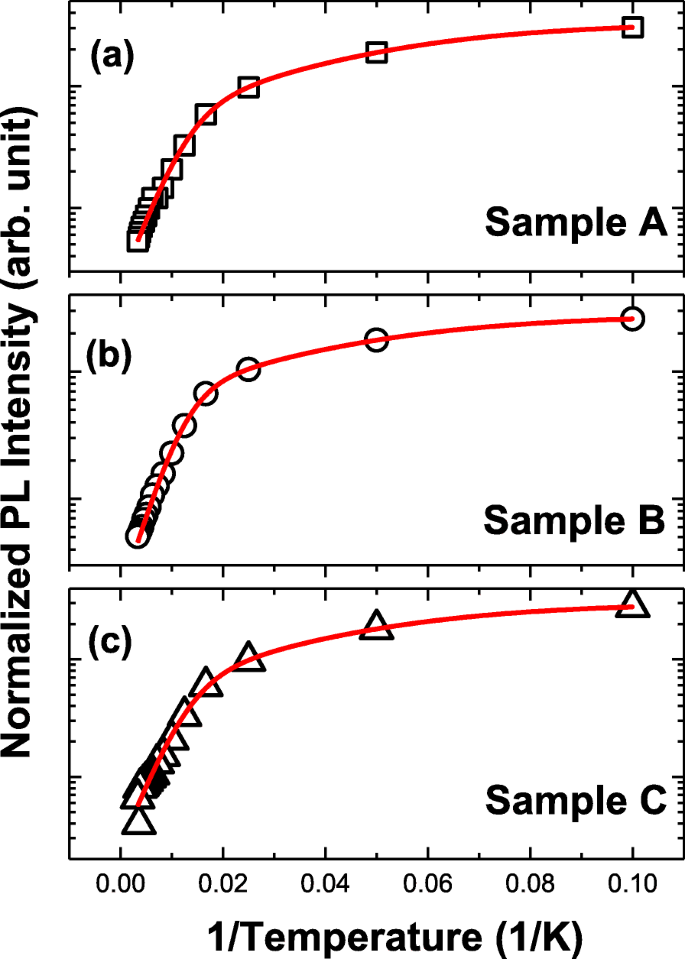
un - c Gráficos de Arrhenius de extinción térmica de intensidad integrada de espectros PL y curvas de ajuste rojo de muestras
La concentración de electrones de fondo, la movilidad y la resistividad de las mediciones de efecto Hall de las muestras se enumeran en la Tabla 2. En la muestra B, se muestran dos órdenes de magnitud de disminución de la concentración del portador con reducción de la movilidad en comparación con la muestra A. Mayor disminución inmensa de la concentración del portador al valor más bajo de 9,4 × 10 15 cm −3 y el aumento de la movilidad a un valor de 6,1 cm 2 / Vs se observan en la muestra C en comparación con la muestra B. La menor cantidad de concentración de electrones se debe a la mayor relajación de los estados de tensión / tensión y una reducción notable de la densidad de defectos nativa en la muestra C.
Las figuras 5a – c y d – f son imágenes AFM 2D y 3D de muestras. La rugosidad cuadrática media (RMS) de A, B y C es 1,92, 4,30 y 2,18 nm, respectivamente, como se muestra en la Tabla 2. La rugosidad de textura superficial más baja ocurrió en la muestra A. Con el uso de O 3 precursor en la muestra B, aumenta la rugosidad de la superficie. La reducción de la uniformidad espacial de las películas de ALD ZnO se debe a la pérdida de superficie de O 3 [21]. Pérdida superficial de O 3 está relacionado con la transición del crecimiento limitado por reacción al crecimiento limitado por recombinación y puede constituir el canal de pérdida atómica principal para destruir las películas, lo que da como resultado una uniformidad de espesor deficiente. Esto se correlaciona con la reducción de la intensidad del pico de difracción a lo largo de (002) en la muestra B en la Fig. 2. Con el tratamiento de TA posterior a la deposición en la muestra C, se mejora la uniformidad de la superficie. Mientras tanto, se logra una disminución drástica de la concentración de electrones de fondo y un aumento de la movilidad. El recocido térmico provoca la migración en la red cristalina; por tanto, tiene lugar la recristalización metalúrgica. La recristalización acompaña a la reducción de la fuerza de deformación / tensión y las imperfecciones intrínsecas de la red cristalina; por lo tanto, se logra una mejor calidad de película delgada de ZnO. Este resultado es consistente con la mejora de dos intensidades de pico de difracción en el patrón XRD en la muestra C. Es digno de notar que la movilidad de los electrones puede verse afectada por fuentes de dispersión como impurezas, rejillas y defectos. Que las fuentes de dispersión podrían alterar la velocidad promedio de los electrones. En general, la reducción de la densidad de defectos y, por tanto, la disminución de la concentración de electrones conduce a un aumento de la movilidad. En este informe, un aumento de la rugosidad de la textura de la superficie debido a la acción de dosificar el precursor de ozono podría causar una menor movilidad de electrones en la muestra C que en A. condiciones de procesamiento para lograr depiladoras ALD ZnO de alta calidad en este informe.
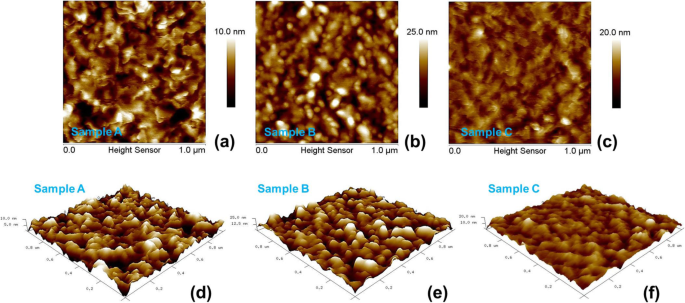
un - c 2D y d - f Imágenes 3D AFM de muestras. La escala de altura en imágenes 2D se presenta en la barra de color derecha

Un diagrama piramidal. En la pirámide, se ilustran cuatro triángulos en diferentes colores. Tres triángulos en los bordes de la pirámide muestran las condiciones clave de crecimiento y procesamiento del ZnO. La combinación de estos tres componentes cruciales en el crecimiento promueve la calidad de las depiladoras de ALD ZnO mostradas por el triángulo en el centro de la pirámide
Conclusiones
H 2 de un solo pulso O y oxidante fuerte de tres pulsaciones O 3 Los precursores en los procesos ALD pueden disminuir la deformación / tensión y, por lo tanto, reducir notablemente la concentración de electrones en la película delgada de ZnO pero aumentar la rugosidad de la superficie. TA posterior a la deposición a 300 ° C en el ambiente de oxígeno (O 2 ) durante 1 h puede facilitar aún más la formación de más granos sin defectos con menor deformación / tensión, menor concentración de electrones de fondo y mejora de la rugosidad de la superficie después del crecimiento del uso de O 3 de tres pulsos precursores. La deformación / tensión más baja y la concentración de electrones de fondo que son 0.49% / 2.22 GPa y 9.4 × 10 15 cm −3 , respectivamente, debido a la dramática disminución del defecto nativo intrínseco de las películas delgadas de ZnO cultivadas con ALD se logran.
Disponibilidad de datos y materiales
Los datos que respaldan los hallazgos de este estudio están disponibles del autor correspondiente (Yung-Chen Cheng) a solicitud razonable.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- O 3 :
-
Ozono
- TA:
-
Recocido térmico
- O 2 :
-
Oxígeno
- PL:
-
Fotoluminiscencia
- H 2 O:
-
Agua
- H 2 O 2 :
-
Peróxido de hidrógeno
- OH:
-
Hidroxilo
- Zn i :
-
Intersticiales de zinc
- V O :
-
Vacantes de oxígeno
- TD:
-
Subprocesos dislocaciones
- GB:
-
Límites de grano
- NBE:
-
Cerca del borde de la banda prohibida
- c-Al 2 O 3 :
-
zafiro c-face
- DI:
-
Desionizado
- C 2 H 5 :
-
Grupos etílicos
- N 2 :
-
Gas nitrógeno
- Zn:
-
Zinc
- XRD:
-
Difracción de rayos X
- AFM:
-
Microscopio de fuerza atómica
- RMS:
-
Raíz cuadrada media
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Estudio de la fuerza de adhesión y la transición vítrea de películas delgadas de poliestireno mediante microscopía de fuerza atómica
- Preparación y características termoeléctricas de ITO / PtRh:termopar de película fina PtRh
- Un método conveniente y eficaz para depositar película delgada nc-Si:H de baja densidad de defectos de PECVD
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN



