Efecto de resistencia diferencial negativo en dispositivo RRAM basado en Ru fabricado por deposición de capa atómica
Resumen
En este trabajo, los dispositivos RRAM basados en Ru con capa atómica depositaron AlO y / HfO x Se fabricaron y estudiaron capas funcionales. Se observó un comportamiento de resistencia diferencial negativa (NDR) durante el proceso de ajuste de voltaje y se exploró su origen físico. Según la comprensión física de la conmutación resistiva, se cree que el comportamiento de NDR medido está asociado con el efecto de reinicio parcialmente unipolar, que se debe a la recombinación entre las vacantes de oxígeno y los iones de oxígeno liberados térmicamente de RuO 2 capa de interfaz. Las características eléctricas medidas y los resultados de la espectroscopia de fotoelectrones de rayos X (XPS) verificaron la interpretación física.
Introducción
Como una de las memorias no volátiles emergentes más prometedoras, la memoria resistiva de acceso aleatorio (RRAM) ha sido ampliamente estudiada con respecto a la optimización de materiales, la mejora del rendimiento y la integración de dispositivos [1, 2, 3, 4]. Debido a las ventajas significativas como la estructura celular simple, la velocidad operativa rápida, el bajo consumo de energía y el potencial de miniaturización incomparable [5], RRAM se ha aplicado ampliamente en la computación neuromórfica inspirada en el cerebro y la lógica booleana reconfigurable [6,7,8,9 , 10] y también exhibe un gran potencial para aplicaciones de memoria de clase de almacenamiento (SCM) [11]. Sin embargo, como se indica en la Hoja de ruta internacional para dispositivos y sistemas 2017 (https://irds.ieee.org/images/files/pdf/2017/2017IRDS_ES.pdf), los desafíos que incluyen la escalabilidad, la confiabilidad del dispositivo y la compatibilidad de procesos siguen obstaculizando Desarrollos de RRAM. Por lo tanto, la construcción de dispositivos RRAM compatibles con CMOS con un rendimiento superior es de gran importancia para las aplicaciones que se basan en la estructura 1T1R de la celda RRAM [12,13,14]. Según un estudio anterior [15], un dispositivo RRAM basado en Ru muestra un gran potencial en comparación con los basados en Pt, mientras que la resistencia diferencial negativa (NDR) se demostró durante un proceso de ajuste de voltaje. Los fenómenos NDR acompañados de conmutación resistiva se han investigado en otras estructuras de RRAM, que se debieron principalmente a la trampa / detrap de los portadores electrónicos entre estados profundamente localizados inducidos por nanopartículas metálicas implantadas [16, 17], o la acumulación de defectos causados por la reinstalación de la unión. [18]. Si bien la aparición de NDR en una celda RRAM basada en Ru bajo una gran corriente todavía está pendiente, en este trabajo se evaluó el rendimiento eléctrico de un dispositivo RRAM basado en Ru fabricado mediante la técnica de deposición de capa atómica (ALD). Basado en la caracterización por espectroscopía de fotoelectrones de rayos X (XPS) y mediciones eléctricas con diferentes estímulos, el fenómeno NDR en el RRAM basado en Ru se puede explicar en el marco del modelo de filamento conductor de vacancia de oxígeno.
Métodos
El diagrama esquemático de la estructura del dispositivo y la matriz RRAM fabricada se muestran en la Fig. 1a, b, respectivamente. El Ru / AlO y / HfO x / El dispositivo TiN RRAM se fabricó en un SiO 2 de 300 nm oxidado térmicamente sustrato. Se depositó una película delgada de Ru de 80 nm sobre una capa de adhesión de Ti de 20 nm como electrodo inferior mediante pulverización catódica con magnetrón de CC (Angstrom Engineering NEXDEP) utilizando un objetivo metálico de Ru. SiO 2 cultivado por deposición química de vapor mejorada con plasma (PECVD) sirve como dieléctrico para aislar los electrodos y forma las vías. Luego, la capa resistiva de 2 nm AlO y y 3 nm HfO x se depositó mediante un sistema de deposición de capa atómica (PICOSUN R200) a 300 ° C con precursores de trimetilaluminio (TMA) y tetraquis [etilmetilamino] hafnio (TEMAH). Después de eso, se pulverizó reactivamente TiN de 80 nm usando un objetivo de Ti y se grabó para formar los patrones de electrodos superiores. También se realizó otro grabado en seco para exponer el electrodo inferior al contacto eléctrico.
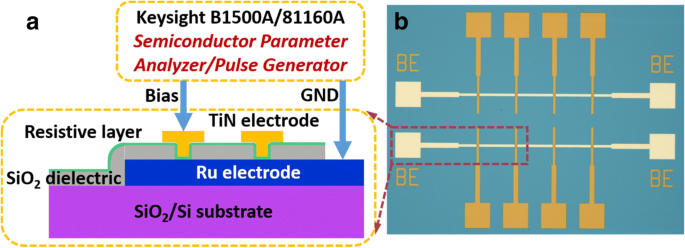
un Diagrama esquemático de un dispositivo basado en Ru. b Matriz RRAM fabricada
El análisis de elementos se realizó mediante un sistema de espectroscopía de fotoelectrones de rayos X (XPS) (Thermo Scientific ESCALAB 250Xi) utilizando la muestra fresca sin un electrodo superior. Antes de la medición, se llevó a cabo una limpieza de la superficie con plasma de Ar antes de la medición para eliminar la influencia de C. La posición del pico de Al 2p se utilizó para la calibración. Las mediciones eléctricas se realizaron a temperatura ambiente mediante un analizador de dispositivos semiconductores (Agilent B1500A) y un generador arbitrario de función de pulso (Agilent 81160A).
Resultados y discusión
Las características IV típicas de los dispositivos RRAM basados en Ru se muestran en la Fig. 2a. Después del electroformado, se aplicó un voltaje positivo (2.5 V) para que el proceso de configuración cambiara la celda del estado de alta resistencia (HRS) al estado de baja resistencia (LRS) con una corriente de cumplimiento de 1 mA para evitar la ruptura permanente durante la conducción. formación de filamentos (CF). Después de la transición establecida, se usó un voltaje negativo (-2,3 V) para cambiar el dispositivo de LRS a HRS con una corriente decreciente gradual. Para evaluar la variabilidad de la resistencia de un dispositivo a otro, se eligieron arbitrariamente 10 celdas RRAM basadas en Ru. Como se muestra en la Fig. 2b, los resultados estadísticos demuestran la excelente uniformidad de HRS y LRS con una ventana de resistencia superior a 10 3 , que podría ser un candidato prometedor para aplicaciones lógicas basadas en NVM. En comparación con los dispositivos basados en Pt reportados anteriormente [2], vale la pena señalar que se observó un fenómeno NDR durante el proceso de ajuste, donde la corriente disminuye con el aumento de voltaje (fase de ajuste 1) en una escala de voltaje limitada seguida de un aumento a la corriente de cumplimiento (fase de configuración 2).

un Características DC. b Distribuciones estadísticas HRS / LRS de 10 dispositivos RRAM basados en Ru
La variabilidad de ciclo a ciclo de los dispositivos RRAM basados en Ru también se investigó en el modo de pulso para estudiar la uniformidad del ciclo. Los pulsos de ajuste (2,4 V, 15 ns) y pulso (- 3 V, 100 ns) se utilizan para cambiar el dispositivo entre LRS y HRS con un voltaje de lectura de 0,1 V después de cada pulso. Como se muestra en la Fig. 3a, el dispositivo de 1000 ciclos tiene una distribución uniforme con desviaciones estándar de 379 Ω y 3 × 10 5 Ω para LRS y HRS, lo que da como resultado una ventana de memoria estable superior a 100. No se produce ninguna degradación de la resistencia incluso después de 10 6 ciclos de conmutación como se informó anteriormente en la Ref. [15]. Además, el dispositivo también demuestra una excelente propiedad de retención como se muestra en la Fig. 3b. Tanto la resistencia LRS como la HRS mantienen un valor constante superior a 10 5 sa 120 ° C sin fallas.

un 1000 ciclos de resistencia. b Comportamiento de retención de alta temperatura de un Ru / AlO y / HfO x / Dispositivo TiN RRAM
Para explorar el fenómeno NDR, el I – V Las curvas se midieron tanto en el modo de barrido de voltaje como en el modo de barrido de corriente. La Figura 4a muestra el proceso de formación de cinco células RRAM frescas seleccionadas al azar. La corriente aumenta gradualmente seguida de un desprendimiento, lo que indica la formación de FQ, mientras que no se observó NDR. Después del electroformado, las operaciones de ajuste en diferentes modos de barrido se llevan a cabo en la misma celda para observar la variación de corriente, como se muestra en la Fig. 4b. Para el conjunto impulsado por corriente, la corriente aumenta lentamente con una disminución repentina del voltaje, lo que demuestra la transición de la resistencia de HRS a LRS. Este comportamiento es distinto de la característica impulsada por el voltaje, que podría deberse al calentamiento Joule inducido por diferentes estímulos a través de la FC. Además, se realizaron operaciones consecutivas de activación / desactivación con diferentes sesgos para investigar el estado de resistencia intermedia en la región NDR. Se aplicó un voltaje de parada apropiado de 1 V durante el proceso de fraguado, como se muestra en la Fig. 4c, para terminar el barrido en el fondo del valle. Se obtuvo un estado de resistencia no volátil después de que se eliminó el voltaje, que exhibió un comportamiento de conmutación resistiva unipolar. Por lo tanto, este fenómeno NDR se atribuye tentativamente a un segundo reinicio del CF durante el proceso de configuración.
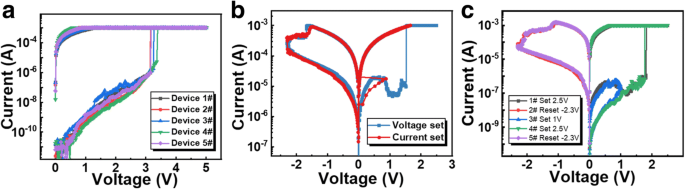
un Formación de voltaje de cinco dispositivos RRAM basados en Ru. b Procesos de ajuste impulsados por voltaje y por corriente en la misma celda RRAM. c Proceso de configuración incompleto con el voltaje de parada en la parte inferior del valle actual
Combinado con las mediciones en diferentes modos y procesos de fabricación de dispositivos, así como las propiedades de RuO 2 , se propuso el origen físico del fenómeno NDR, como se ilustra en la Fig. 5. Un estudio anterior [19, 20] sugirió que la generación y recombinación de la vacante de oxígeno empobrecido en electrones ( V o ) e iones de oxígeno (O 2− ) bajo diferentes polaridades eléctricas son responsables del HfO x convencional bipolares basados en RRAM, que es similar a los procesos de configuración de fase 2 y reinicio. Sin embargo, a diferencia del proceso de fraguado convencional, se produce una segunda ruptura del CF desconectando el electrodo Ru y el CF y conduciendo al NDR. En general, los átomos de oxígeno se disocian en V o y O 2− bajo campo eléctrico con la deriva del O 2− al electrodo superior, dejando la V o para formar el CF que se utiliza para el transporte de electrones. Pero debido al calentamiento de Joule causado por el campo eléctrico, el RuO 2 formado la capa de interfaz se descompondría lentamente a ~ 600 ° C y liberaría O 2− que podría recombinarse con el electrón empobrecido V o ( V o 2+ ) cerca del electrodo Ru (fase de ajuste 1) [21], lo que da como resultado una disminución de la corriente. Este proceso también puede verse como un proceso de reinicio unipolar parcial. Con el voltaje en aumento adicional, la CF entre TE y BE se reconstruirá mediante una acumulación de V o como se muestra en la fase de ajuste 2 y la celda RRAM cambia a LRS. Durante el reinicio, dos procesos tienen lugar simultáneamente:(1) el O 2− liberados del electrodo de TiN se recombinan rápidamente con el V cargado positivamente o debido a la sección de captura mejorada, (2) el O 2− la deriva hacia BE reacciona con Ru y reforma el RuO 2 capa de interfaz debido al calentamiento local Joule [22]. En esta condición, la celda RRAM cambia a HRS.

Procesos físicos de conmutación resistiva en RRAM basada en Ru. un Efecto NDR (fase de ajuste 1). b Procesos SET comunes (fase de ajuste 2). c RESET proceso del dispositivo
Análisis XPS del RuO 2 La capa de interfaz, que se formó durante el proceso de fabricación del dispositivo, también respalda la explicación propuesta del efecto NDR. La Figura 6a muestra el espectro completo de XPS de la muestra, que incluye los niveles centrales de O 1s, Ru 3d, Al 2p y Hf 4f. Los otros picos sin marcar corresponden todos a estos elementos con diferentes órbitas de electrones. La curva de ajuste en la Fig. 6b encaja perfectamente con los datos experimentales y se divide en cuatro picos, que corresponden a la Ru 3d 5/2 (280,01 eV para Ru y 280,75 eV para RuO 2 ) y Ru 3d 3/2 (284,3 eV para Ru y 285,26 eV para RuO 2 ) niveles básicos, lo que demuestra la coexistencia de Ru y RuO 2 en la película delgada [23]. La baja intensidad de Ru 3d 5/2 pico indica que el RuO 2 formado La capa de interfaz es muy delgada como esperábamos.

Espectros XPS de a Ru / AlO y / HfO x película fina y b Nivel básico Ru 3d. El RuO 2 película delgada entre Ru y AlO y formularios durante el proceso ALD [18]
Conclusión
En este estudio, el Ru / AlO y compatible con CMOS / HfO x / Se fabricó el dispositivo TiN RRAM. El excelente rendimiento de conmutación se logró con una resistencia uniforme de dispositivo a dispositivo y una gran ventana de resistencia, así como una buena propiedad de retención a alta temperatura. Según las mediciones eléctricas y el análisis XPS, el fenómeno NDR en el proceso establecido se puede explicar por la recombinación de las vacantes de oxígeno y los iones de oxígeno liberados por el RuO 2 capa de interfaz debido al calentamiento Joule inducido eléctricamente.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- CF:
-
Filamento conductor
- HRS:
-
Estado de alta resistencia
- LRS:
-
Estado de baja resistencia
- NDR:
-
Resistencia diferencial negativa
- PECVD:
-
Deposición de vapor químico mejorada por plasma
- RRAM:
-
Memoria resistiva de acceso aleatorio
- SCM:
-
Memoria de clase de almacenamiento
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- ¿Qué es el efecto piel?
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- El efecto de los aniones sulfato en la nucleación de titania ultrafina
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Efectos de las variaciones de grabado en la formación de canales Ge / Si y el rendimiento del dispositivo
- Efecto de la temperatura sobre las propiedades mecánicas de las nanofibras de PU electrohiladas
- Deposición de capa atómica de SiO2 mejorada con plasma a baja temperatura utilizando dióxido de carbono



