Mecanismo de conducción y resistencia mejorada en RRAM basado en HfO2 con tratamiento de nitruración
Resumen
Una tecnología de tratamiento de nitruración con una fuente de nitrógeno de complejo de urea / amoníaco mejoró la propiedad de conmutación resistiva en HfO 2 -memoria resistiva de acceso aleatorio (RRAM). El tratamiento de nitruración produjo un dispositivo confiable y de alto rendimiento que da como resultado una resistencia superior (más de 10 9 ciclos) y un efecto de autocumplimiento. Por lo tanto, el mecanismo de conducción actual cambió debido a un defecto de pasivación por átomos de nitrógeno en el HfO 2 película delgada. En un estado de alta resistencia (HRS), se transfirió a la emisión Schottky de Poole-Frenkel en HfO 2 -RRAM basado en. En el estado de baja resistencia (LRS), el mecanismo de conducción de corriente fue la corriente de carga espacial limitada (SCLC) después del tratamiento de nitruración, lo que sugiere que los átomos de nitrógeno forman grupos de vacantes Hf-N-Ox (V o + ) que limitan el movimiento de los electrones a través de la capa de conmutación.
Antecedentes
Recientemente, la memoria de acceso aleatorio de resistencia (RRAM) compuesta por una capa aislante intercalada por dos electrodos se ha estudiado ampliamente como un candidato prometedor para la memoria no volátil de próxima generación debido a sus propiedades superiores, como estructura simple, bajo consumo de energía y operación a alta velocidad. (<300 ps) y lectura no destructiva [1–9]. Aunque la mayoría de los dispositivos RRAM tienen muchas propiedades superiores a la memoria no volátil, la alta corriente de funcionamiento de RRAM y la degradación del rendimiento son problemas importantes en la memoria no volátil en términos de la aplicación de productos electrónicos portátiles.
El Pt / HfO 2 / La estructura de TiN puede suministrar una ruta de conducción que induce un comportamiento de conmutación resistiva [10-19]. Sin embargo, los defectos del HfO 2 amorfo aumentará el número de vías de fuga, lo que provocará un consumo de energía y una degradación por calentamiento joule. En este trabajo, la capa de conmutación resistiva de HfO 2 fue tratado con una solución con una fuente de nitrógeno del complejo urea / amoníaco como tratamiento de nitruración para mejorar sus propiedades de conmutación eléctrica.
Métodos
El patrón TiN / Ti / SiO 2 El sustrato de Si se fabricó con un proceso estándar de deposición y grabado, después del cual se pueden formar orificios de paso (recuadro de la Fig. 1a). Luego, un HfO 2 de 23 nm de espesor Se depositó una película fina en los orificios del sustrato mediante pulverización catódica con magnetrón de RF utilizando un HfO 2 puro. objetivo. La potencia de pulverización catódica se fijó a una potencia de RF de 150 W y se llevó a cabo en ambiente de argón (Ar =30 sccm) con una presión de trabajo de 4 mtorr a temperatura ambiente. El HfO 2 Se colocó un dispositivo semiacabado de TiN en la cámara reactiva y se sumergió en la solución con una fuente de nitrógeno del complejo urea / amoníaco para el tratamiento de nitruración. Durante el tratamiento de nitruración, la solución se calentó a 160 ° C en la cámara de acero inoxidable del sistema durante 30 min. Luego, el electrodo superior de Pt de 110 nm de espesor se depositó mediante pulverización catódica con magnetrón de CC en el HfO 2 película delgada para formar dispositivos eléctricos con Pt / HfO 2 / Estructuras sándwich de TiN. Finalmente, todas las características eléctricas se midieron con el analizador de parámetros de semiconductores Agilent B1500. La polarización de barrido de pulso y CC se aplicaron al electrodo inferior (TiN) mientras que el electrodo superior (Pt) estaba conectado a tierra durante las mediciones eléctricas. Además, la espectroscopia infrarroja por transformada de Fourier (FTIR) se midió con un espectrómetro Bruker VERTEX 70v en la región del infrarrojo medio.

un Las curvas de corriente de formación de HfO 2 -dispositivos RRAM basados en. b Comparación de los ciclos de barrido de CC a una corriente de cumplimiento de 5 mA entre el tratamiento de nitruración inicial y posterior de HfO 2 -RRAM basado en. c Ciclos de barrido de CC sin cumplimiento de corriente externa del HfO 2 dispositivo después del tratamiento de nitruración. d Tiempo de retención del HfO 2 dispositivos RRAM basados en 85 ° C con y sin corriente de cumplimiento después del tratamiento de nitruración
Resultados y discusión
Se requiere un proceso de electroformado para activar todos los dispositivos RRAM utilizando una polarización de CC con una corriente de cumplimiento de 10 μA, como se muestra en la Fig. 1a. Después del proceso de formación, las propiedades de corriente-voltaje (I-V) del HfO 2 Los RRAM basados en la técnica se compararon al inicio y después del tratamiento de nitruración. En LRS, la corriente se redujo obviamente en comparación con la del HfO 2 sin tratar película delgada, como se muestra en la Fig. 1b. La reducción actual se puede atribuir a los defectos pasivados por el NH 3 molécula en la solución de tratamiento. Encontramos que la distribución de HRS es mucho más estable después del tratamiento de nitruración, como en el recuadro de la Fig. 1b. Los estados de resistencia se extraen con un voltaje de lectura de 0.1 V durante los 100 ciclos de barrido con operación de CC (recuadro de la Fig. 1b). La relación de resistencia activada / desactivada se redujo ligeramente después del tratamiento de nitruración. Curiosamente, se observó una propiedad de conmutación resistiva de autocumplimiento en estos HfO 2 dispositivos RRAM basados en el tratamiento después del tratamiento, como se muestra en la Fig. 1c. Después de más de 10 3 ciclos de barrido, se observó una característica de autoprotección repetible del dispositivo sin avería severa. El tiempo de retención se evaluó a 85 ° C y se mantuvo estable incluso después de 10 4 s tanto en HRS como en LRS.
Para evaluar aún más el rendimiento del dispositivo, las pruebas de resistencia de HfO 2 Se realizaron RRAM basados en el tratamiento inicial y posterior al tratamiento de nitruración, como se muestra en la Fig. 2. En el dispositivo sin tratar después de 10 6 ciclos de barrido, la relación HRS / LRS se degrada significativamente de 100:1 a 5:1, como se muestra en la Fig. 2a. Sin embargo, después del tratamiento de nitruración, incluso después de más de 10 9 ciclos de barrido, el dispositivo mostró una relación HRS / LRS estable, como en la Fig. 2b. Estos resultados indican que el proceso de nitruración mejoró HfO 2 RRAM basado en para funcionar con características de conmutación y confiabilidad superiores. Para investigar más a fondo estos resultados, se utilizó el análisis FTIR para observar las alteraciones químicas del HfO 2 película delgada, como se muestra en la Fig. 3. Un pico agudo a 1589 y 1311 cm −1 apareció después del tratamiento de nitruración, correspondiente al pico de vibración de estiramiento simétrico y asimétrico de un enlace N – O [20]. Además, la intensidad máxima de los enlaces N – H a 1471 cm −1 [21] aumentó debido al proceso de nitruración por la fuente de nitrógeno del complejo urea / amoníaco (recuadro de la Fig. 3). Por lo tanto, podemos inferir la formación de compuestos que contienen nitrógeno después del tratamiento de nitruración.
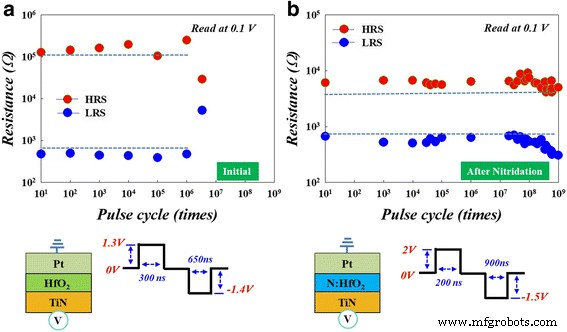
Comparación de tiempos de resistencia en HfO 2 RRAM basado en: a inicial y b después del tratamiento de nitruración. Los diagramas inferiores son las estructuras del dispositivo correspondientes y las condiciones de pulso de resistencia

La comparación de los espectros FTIR de HfO 2 películas delgadas entre el tratamiento de nitruración inicial y posterior
Para aclarar el mecanismo de conmutación resistiva, analizamos el mecanismo de conducción de corriente del HfO 2 película delgada con y sin el tratamiento de nitruración, que se muestra en la Fig. 4a y d. Para el HfO 2 sin tratar capa delgada, los electrones se transfirieron a través de los defectos, de modo que el mecanismo de conducción de corriente estuvo dominado por la conducción de Poole-Frenkel de acuerdo con la relación lineal entre ln (I / V) y la raíz cuadrada del voltaje aplicado (V 1 / 2 ) en HRS, como se muestra en la Fig. 4b [22].
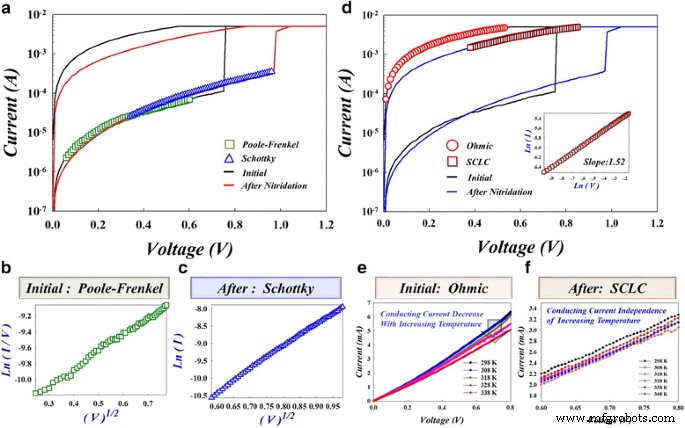
un Análisis del mecanismo de conducción de corriente de HRS a partir de curvas I-V en HfO 2 -RRAM basado en el tratamiento inicial y posterior a la nitruración. b El mecanismo de conducción de corriente de Poole-Frenkel de HRS en HfO 2 -RRAM basado en. c El mecanismo de conducción de corriente de emisión de Schottky de HRS en HfO 2 -RAM basada en después del tratamiento de nitruración. d Análisis del mecanismo de conducción de corriente de LRS que se transforma en SCLC de conducción óhmica después del tratamiento de nitruración en HfO 2 -basada en RRAM; la figura insertada muestra el resultado del ajuste de corriente SCLC. e El mecanismo de conducción óhmica de LRS en HfO 2 -RAM basada en la característica de la correlación negativa actual con la temperatura. f El mecanismo SCLC de LRS en HfO 2 -RAM basado en que es independiente de la temperatura después del tratamiento de nitruración
Por el contrario, HfO 2 RRAM basado en exhibió el mecanismo de emisión de Schottky de acuerdo con la relación lineal entre ln (I / T 2 ) y la raíz cuadrada del voltaje aplicado (V 1/2 ) de HRS, como se muestra en la Fig. 4c [23, 24]. Esto se debe a la disminución de defectos y enlaces colgantes, ya que los enlaces se pasivan por los átomos de nitrógeno después del tratamiento de nitruración. Además, también analizamos el mecanismo de conducción actual con y sin tratamiento en LRS en HfO 2 -RRAM basado en. En LRS, el mecanismo de transporte del portador del HfO 2 sin tratar La RRAM basada en la tecnología estaba dominada por la conducción óhmica, donde la corriente disminuye al aumentar la temperatura, como se muestra en la Fig. 4e. Después del tratamiento de nitruración, el mecanismo de conducción de corriente se transfiere a la corriente limitada de carga espacial (SCLC) con una pendiente de 1,52. La curva I-V no es relativa a la temperatura, con una relación lineal entre ln (I) y el cuadrado del voltaje aplicado V 2 en LRS, como se muestra en la Fig. 4f [25].
Propusimos un modelo para explicar las características del mecanismo de conducción de corriente, y se muestra en la Fig. 5. Por lo tanto, hay dos dipolos de compensación asociados con átomos de N y O y un átomo de Hf (es decir, la secuencia O – Hf – O se reemplaza por O – Hf – N – O) después de dopar N átomos en HfO 2 película delgada. Debido a que la negatividad de los electrones de nitrógeno es menor que la del oxígeno, el dipolo del enlace Hf-N es menor que el enlace Hf-O, lo que crea una región de constante dieléctrica más baja. Cuando se aplica un sesgo positivo durante el proceso SET, se forman una serie de vacantes Hf-N-Ox debido a su constante dieléctrica más baja, y luego se forman grupos de vacantes (Vo + ). La ruta conductora generalmente se forma junto con los grupos de vacantes Hf-N-Ox (Vo + ) a medida que los átomos de nitrógeno capturan iones de oxígeno alrededor de los cúmulos, como se muestra en la Fig. 5b. La presencia de estos grupos de vacantes aislantes Hf-N-Ox (Vo + ) da como resultado una reducción de la corriente y el efecto de autocumplimiento encontrado en HfO 2 RRAM basado en.

Un esquema de la migración de iones de oxígeno a través del proceso establecido en HfO 2 RRAM basado en a inicial y b después del tratamiento de nitruración, que forma grupos de vacantes Hf-N-Ox (V o + )
Conclusiones
En resumen, se observó una propiedad de conmutación resistiva de autocumplimiento en un Pt / HfO 2 / Dispositivo TiN RRAM después del tratamiento de nitruración. Los tiempos de resistencia alcanzaron 10 9 ciclos y un tiempo de retención de más de 10 4 s se logró a 85 ° C. Debido a la menor negatividad electrónica del átomo de nitrógeno en comparación con el átomo de oxígeno, el dipolo del enlace Hf-N es más pequeño que el del enlace Hf-O, lo que crea una región de constante dieléctrica más baja. Durante el proceso SET, los grupos de vacantes Hf – N – Ox (Vo + ) forman el camino conductor. Los grupos de vacantes aislantes Hf-N-Ox (Vo + ) protegen el dispositivo de averías y realizan una propiedad de autocumplimiento.
Abreviaturas
- FTIR:
-
Espectroscopía infrarroja por transformada de Fourier
- HRS:
-
Estado de alta resistencia
- LRS:
-
Estado de baja resistencia
- RRAM:
-
Memoria resistiva de acceso aleatorio
- SCLC:
-
Carga espacial de corriente limitada
Nanomateriales
- Mantequilla y margarina
- Entrevista con un experto:Spencer Wright de pencerw.com y nTopology
- Ganando tracción con Markforged:sobremoldeo y fundición de ruedas impresas en 3D
- Materiales:Espuma EPP con propiedades de superficie mejoradas y comportamiento de relleno optimizado
- Nanomaterial inteligente y nanocompuesto con actividades agroquímicas avanzadas
- Modelo de retención de TaO / HfO x y TaO / AlO x RRAM con características de interruptor autorrectificante
- Nanopartículas de albúmina cargadas con resveratrol con circulación sanguínea prolongada y biocompatibilidad mejorada para una terapia de tumores pancreáticos dirigida altamente eficaz
- Eficacia antitumoral y farmacocinética mejoradas de la bufalina mediante liposomas pegilados
- Toxicidad de nanopartículas de CoFe2O4 recubiertas de PEG con efecto de tratamiento de curcumina
- Resistencia de contacto reducida entre el metal y n-Ge mediante la inserción de ZnO con tratamiento con plasma de argón
- El papel de los nanomateriales y las nanotecnologías en el tratamiento de aguas residuales:un análisis bibliométrico



