Resistencia de contacto reducida entre el metal y n-Ge mediante la inserción de ZnO con tratamiento con plasma de argón
Resumen
Investigamos los contactos metal-aislante-semiconductor en n-Ge utilizando una capa interfacial (IL) de ZnO para superar el efecto de fijación de nivel de Fermi (FLP) en la interfaz metal / Ge y reducir la altura de la barrera para los electrones. Se obtiene una pequeña compensación de banda de conducción de 0.22 eV en la interfaz entre ZnO y n-Ge, y el IL de ZnO conduce a una resistencia de contacto significativamente reducida ( R c ) en metal / ZnO / n-Ge en comparación con el dispositivo de control sin ZnO, debido a la eliminación de FLP. Se observa que el tratamiento con argón (Ar) plasma de ZnO puede mejorar aún más el R c características en el dispositivo Al / ZnO / n-Ge, que se debe a que el tratamiento con plasma de Ar aumenta la concentración de oxígeno vacante V o , actuando como dopantes de tipo n en ZnO. El contacto óhmico se demuestra en el Al / ZnO / n-Ge con una concentración de dopante de 3 × 10 16 cm −3 en Ge. Sobre el n + fuertemente dopado -Ge con un ion fósforo (P + ) implantación, una resistividad de contacto específica de 2,86 × 10 - 5 Ω cm 2 se logra en Al / ZnO / n + -Ge con tratamiento con plasma Ar.
Antecedentes
El germanio (Ge) ha atraído mucha atención por los transistores de efecto de campo de semiconductores de óxido metálico avanzados (MOSFET) debido a sus mayores movilidades de portadora en comparación con el Si [1, 2]. Para los MOSFET de canal p de Ge, se ha logrado un gran progreso en el crecimiento del canal de Ge deformado [3, 4, 5], la pasivación de la superficie [6, 7, 8, 9] y los contactos de fuente / drenaje (S / D) [ 10], y los Ge pFinFETs ultraescalados [11] han demostrado el rendimiento eléctrico superior a los dispositivos de Si. Los transistores de canal Ge, por el contrario, todavía enfrentan desafíos, que producen el obstáculo para la integración de Ge CMOS, incluida la mala calidad de la interfaz, lo que resulta en la baja movilidad de los electrones y la alta resistencia S / D debido a la activación limitada. tasa de dopantes de tipo n en Ge [12] y la fijación a nivel de Fermi (FLP) en la interfaz metal / n-Ge [13]. FLP conduce a una altura de barrera de Schottky de aproximadamente 0.5 eV para los electrones para la mayoría de los metales en n-Ge, produciendo una resistencia de contacto muy grande R c [13, 14, 15].
El depinado a nivel fermi se puede realizar insertando una capa interfacial delgada (IL), por ejemplo, TiO 2 [16] y ZnO [17], entre los metales y n-Ge [18], debido a que el IL delgado puede bloquear la función de onda del metal en Ge para reducir los estados de separación inducidos por el metal [19, 20]. ZnO tiene una pequeña compensación de banda de conducción (CBO) con respecto a Ge, lo que puede conducir a una R más pequeña. c en metal / ZnO / n-Ge, en comparación con metal / TiO 2 / n-Ge con TiO 2 / Ge que tiene la CBO positiva [16]. La constante dieléctrica de ZnO es menor que la de TiO 2 , por lo que ZnO IL puede obtener una región de agotamiento más delgada entre el metal y n-Ge en comparación con TiO 2 . Además, es fácil realizar el dopaje de tipo n en ZnO mediante la introducción de defectos no estequiométricos, como las vacantes de oxígeno V o [21, 22], lo que da lugar a una región de agotamiento de ZnO aún más pequeña entre el metal y n-Ge. Hasta ahora, en contactos de metal / ZnO / n-Ge, el dopaje de ZnO por V o se llevó a cabo por recocido en atmósfera de nitrógeno [16], que sin embargo, podría resultar en la interdifusión de ZnO y Ge durante el recocido [23], y la difusión de átomos dopantes en n-Ge durante el recocido [24, 25], provocando la degradación del rendimiento actual del dispositivo. Desde entonces, es necesario desarrollar un proceso de baja temperatura para depositar y dopar ZnO.
En este trabajo, investigamos el nivel de Fermi depinning en la interfaz entre el metal y n-Ge mediante la inserción de ALD depositado ZnO IL. Se estudian los efectos de mejora del tratamiento con plasma de argón (Ar) de la capa de ZnO sobre las características de resistencia al contacto de Al / ZnO / n-Ge.
Métodos
Se formaron contactos metálicos en obleas de n-Ge (001) tanto ligeramente como muy dopadas. Las muestras de Ge ligeramente dopadas tienen una concentración de dopaje de aproximadamente 3 × 10 16 cm −3 . Para lograr el n-Ge fuertemente dopado, un ion fósforo (P + ) implante con una dosis de 1 × 10 15 cm −2 y se realizó una energía de 30 keV en el n-Ge (001), que fue seguido por un recocido térmico rápido a 600 ° C durante 60 s. Después de limpiar las obleas con varios ciclos de agua desionizada y HCl diluido, las obleas de Ge se cargaron inmediatamente en la cámara de ALD (Beneq TSF-200) para depositar ZnO, y luego los contactos de aluminio (Al) se depositaron mediante pulverización catódica sobre Ge mediante un proceso de despegue. . Aquí, se utilizaron tres espesores de ZnO de 1, 2 y 3 nm, que fueron confirmados por elipsometría espectroscópica (SE) (J. A. Woollam M2000). Durante la deposición de ZnO, el dietil zinc (DEZn) y el agua desionizada (H 2 O) como precursores de Zn y O, respectivamente, y la temperatura del sustrato se mantuvo a 150 ° C para eliminar la formación de GeO x . El proceso detallado de deposición de ZnO utilizando ALD se informó en nuestros trabajos anteriores en la ref. [26, 27]. Para mejorar aún más la conductividad de la película de ZnO, algunas muestras de ZnO en Ge se trataron con plasma de argón (Ar). También se fabricó una muestra de control de Al / n-Ge sin ZnO IL. La R c de Al sobre ZnO / Ge se extrajo mediante el método de línea de transmisión circular (CTLM), que se formó por despegue. El ZnO expuesto se grabó por completo mediante grabado con plasma para garantizar un aislamiento completo entre los dispositivos adyacentes [16].
Se utilizó Keithley 4200 SCS para medir las características eléctricas de los contratos de Al / ZnO / n-Ge y las estructuras CTLM, microscopio electrónico de transmisión de alta resolución (HRTEM) y espectroscopía de fotoelectrones de rayos X (XPS) para determinar la microestructura y la interfaz. propiedades de las muestras, y se utilizó un espectrofotómetro UV-VIS (LAMBDA 950, PerkinElmer) para determinar la banda prohibida E g de película de ZnO depositada.
Resultados y discusión
Caracterización del material de Al / ZnO / n-Ge
Los espectros de banda de valencia XPS de Ge / ZnO y el espectro de transmitancia de ZnO se presentan en las Figs. 1 y 2, respectivamente, que se utilizaron para investigar el mecanismo del efecto de depilación a nivel de Fermi en la interfaz Al / ZnO / n-Ge. Realizamos las mediciones de XPS para la muestra gruesa de ZnO, la muestra de interfaz ZnO / n-Ge y la muestra de Ge puro, para obtener el desplazamiento de la banda de valencia (VBO) de ZnO / Ge, como se muestra en la Fig. 1. El Zn 2 p la posición del pico y el VBM para la muestra gruesa de ZnO son 1021,9 eV y 2,59 eV, respectivamente. El Zn 2 p y Ge 3 d la posición máxima para la muestra de interfaz ZnO / Ge es 1021,7 eV y 29,1 eV, respectivamente. El Ge 3 d la posición máxima y el VBM para la muestra de Ge puro son 29 eV y 0,06 eV, respectivamente. Esto indica que el VBO de ZnO / Ge es 2,33 eV [30].

Espectros XPS para bandas de valencia de muestra de ZnO / Ge. un Zn 2 p y b espectros de bandas de valencia para una muestra de ZnO espesa c ZnO 2 p y d Ge 3 d espectros para la muestra de interfaz ZnO / Ge, y e Ge 3 d y f espectros de bandas de valencia para muestras de Ge a granel
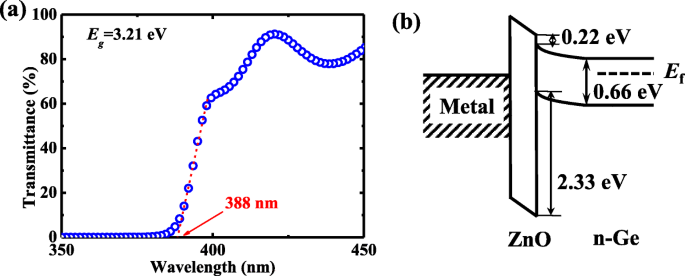
un Espectro de transmitancia para la película de ZnO depositada que demuestra el E g de 3,21 eV. b La alineación de la banda para el contacto Al / ZnO / Ge
La Figura 2a muestra el gráfico de transmitancia obtenido de la espectroscopía UV-VIS para una muestra de ZnO espesa y la E g de ZnO se determina que es 3.21 eV, consistente con los valores reportados en [28, 29]. Utilizando el E obtenido g de ZnO y VBO anteriores, se determina un CBO de 0,22 eV entre ZnO y Ge, como se muestra en la Fig. 2b. Esto indica que se puede lograr un depinning a nivel de Fermi en la interfaz Al / n-Ge utilizando la capa de inserción de ZnO, que puede producir el bajo R c para contacto Al / ZnO / n-Ge.
La Figura 3 muestra la imagen TEM de la estructura Al / ZnO / n-Ge con el espesor de ZnO de 3 nm. Se observa una capa de ZnO uniforme y conforme entre Al y n-Ge. El recuadro en la esquina superior derecha ilustra la imagen HRTEM de la vista ampliada de la interfaz Al / ZnO / n-Ge. El espesor de la película de ZnO se mide en 3 nm, lo cual es consistente con el resultado obtenido por la medición de SE, y la película de ZnO está en forma amorfa.
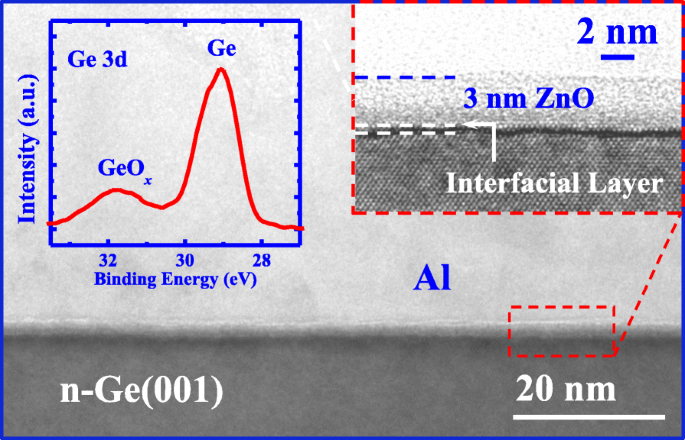
Imagen TEM para una muestra de Al / ZnO / n-Ge que muestra la capa uniforme de ZnO entre Al y Ge. El recuadro superior derecho muestra la imagen HRTEM de la interfaz Al / ZnO / n-Ge, y el recuadro superior izquierdo muestra el XPS Ge 3 d resultado de la muestra que demuestra la existencia de GeO x capa interfacial
Una delgada GeO x La capa interfacial se forma entre Ge y ZnO, que es mucho más pequeña en comparación con [31] debido a la menor temperatura de deposición utilizada en este trabajo. Esto se atribuye al hecho de que, durante la deposición de ZnO, Ge reacciona con el precursor de O, lo que lleva a la formación de GeO x ILLINOIS. GeO x también lo demuestra el XPS Ge 3 d resultado en el recuadro en la esquina superior izquierda.
La conductividad eléctrica de la película de ZnO se puede mejorar mediante el tratamiento con plasma de Ar, lo que provoca el aumento de la concentración de oxígeno vacantes V o , actuando como donantes de ZnO [32, 33]. La Figura 4 muestra los resultados XPS de O 1 s para el ZnO depositado y la muestra con tratamiento de plasma de Ar con una potencia de 50 W, un flujo de gas Ar de 60 sccm y una duración de 45 s. Los O 1 s el pico se deconvoluciona en dos picos utilizando el ajuste gaussiano. El pico a ~ 530 eV corresponde a la red de oxígeno en ZnO [34, 35]. Para la muestra depositada, el pico a 531,7 eV corresponde a V o (~ 531,5 eV) y oxígeno quimisorbido en la superficie de películas delgadas de ZnO, como grupos carbonilo e hidroxilo [35, 37]. Para la muestra con tratamiento con plasma de Ar, el pico está en ~ 531.5 eV, que cambia a una energía de enlace más baja, y se vuelve mucho más pronunciado en comparación con la muestra depositada, lo que indica que más V o se generan debido al tratamiento con plasma de Ar, y el oxígeno quimisorbido se elimina eficazmente. El aumento de los dopantes de tipo n en ZnO da como resultado una barrera de túnel más delgada y una menor resistencia en serie en la interfaz, lo que es responsable de la reducción de R c [36].

Resultados XPS de O 1 s y los resultados deconvolucionados para muestras de ZnO (3 nm) / n-Ge depositadas (superior) y tratadas con plasma Ar (inferior)
Hicimos las mediciones de XPS usando una muestra gruesa de ZnO y una muestra de interfaz ZnO / Ge con y sin tratamiento con plasma Ar, como se muestra en la Fig. 5. Encontramos que, después del tratamiento con plasma Ar, hubo un cambio de - 0.05 eV. Esto puede indicar que el VBO de ZnO / Ge es de aproximadamente 2,38 eV después del tratamiento con plasma de Ar y CBO de 0,17 eV.

VBM para muestra de interfaz ZnO / Ge con y sin tratamiento con plasma de Ar. un Zn 2 p y b espectros de bandas de valencia para una muestra de ZnO espesa c ZnO 2 p espectros para la muestra de interfaz ZnO / Ge. d Diagrama de alineación de bandas para metal tratado con plasma Ar / ZnO / n-Ge
Rendimiento eléctrico de contactos de Al / ZnO / n-Ge
La Figura 6a muestra la densidad de corriente medida J en función del voltaje aplicado V características de los contactos de Al en n-Ge ligeramente dopados. El Al / ZnO / n - -Los dispositivos Ge tienen los diferentes espesores de capa de ZnO. El esquema del dispositivo se muestra en el recuadro de la Fig. 6.
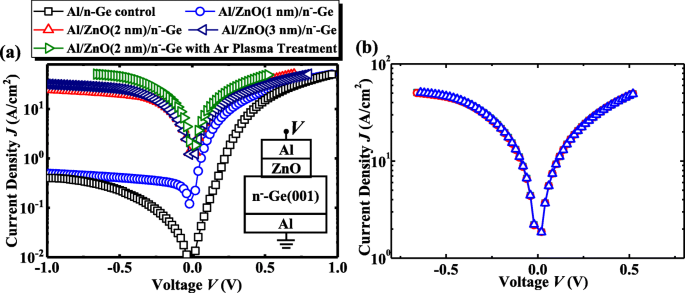
un J - V características para Al / n - -Ge control, Al / ZnO / n - -Ge con espesores de ZnO de 1 nm, 2 nm y 3 nm, y ZnO / Ge tratado con plasma de Al / 2 nm Ar, b J -V para tres dispositivos de ZnO / Ge tratados con plasma de Al / 2 nm Ar
Como se predijo, el dispositivo de control de Al / n-Ge sin ZnO muestra las características de rectificación con la alta altura de la barrera para los electrones debido a la fijación del nivel de Fermi en Al / n - -Ge [38]. En comparación con la muestra de control de Al / n-Ge sin ZnO, los dispositivos de Al / ZnO / n-Ge exhiben la J inversa mejorada , que se debe a la depinación a nivel de Fermi inducida por la reducción de los estados gap inducidos por metales (MIGS) en la interfaz metal / Ge [18, 19]. Esta mejora se potencia más con ZnO más espeso, lo que se debe al hecho de que se eliminan más MIGS. Pero la densidad de corriente directa para el dispositivo insertado de 3 nm de ZnO es menor que la de 2 nm. Esto puede explicarse de la manera siguiente. La principal densidad de corriente para Al / ZnO / n-Ge es la corriente de túnel. Si el ZnO no es lo suficientemente espeso, MIGS no se eliminará de manera efectiva y aún muestra características rectificadoras. Pero si el ZnO es demasiado grueso, la resistencia en serie de ZnO dominará toda la resistencia y la corriente se reducirá. Por lo tanto, existe una compensación entre la eliminación de MIGS y el aumento de la resistencia en serie de ZnO, y por lo tanto hay un espesor crítico para el IL [19]. En conclusión, se considera que 2 nm es el espesor óptimo para el contacto Al / ZnO / n-Ge.
Con el tratamiento con plasma Ar, el rendimiento de Al / ZnO / n - -El dispositivo Ge se ha mejorado aún más. Lo que sea para el barrido hacia atrás o hacia adelante del voltaje aplicado V , Al / 2 nm ZnO / n - -El dispositivo Ge con tratamiento con plasma Ar logra la J mejorada en comparación con el dispositivo con 2 nm ZnO o 3 nm ZnO, lo que se debe a que una gran cantidad de V o se generan en la película de ZnO durante el tratamiento con plasma de Ar. La mayor concentración de dopaje en ZnO puede reducir efectivamente la resistencia en serie de ZnO y reducir la barrera de efecto túnel para los electrones en la interfaz entre ZnO y Al, mejorando la densidad de corriente de efecto túnel.
La figura 6b muestra J - V características para tres Al / 2 nm ZnO / n - -Dispositivo Ge con tratamiento con plasma Ar. Está claro que el J para diferentes dispositivos es casi el mismo, lo que indica que tanto el proceso ALD como el tratamiento con plasma Ar tienen un efecto uniforme en la mejora de la densidad de corriente.
Se obtienen contactos óhmicos para Al / 2 nm ZnO / n - -Ge sin y con diferente duración del tratamiento con plasma de Ar de 15 s, 30 s, 45 sy 60 s, respectivamente, que se muestran en la Fig. 7.

yo - V curvas en Al / 2 nm ZnO / n - -Ge con diferentes d un sin tratamiento con plasma Ar y con tratamiento con plasma Ar duración de b 15 s, c 30 s, d 45 s y e 60 s
La resistencia total bruta R tot entre dos contactos disminuye con la disminución de d y la R final tot se modifica mediante un factor de corrección C, que se calcula con la ecuación C =( L / d ) · Ln (1 + d / L ) [39], donde L =25 μm representa el radio de la almohadilla interior, como se muestra en el recuadro de la Fig. 8a. Al trazar la R tot en función de d en la Fig. 8a, la resistencia de la hoja R sh de los n - -Ge se puede obtener de la pendiente de la línea y luego ρ c se calcula a partir de la intersección de la línea de ajuste lineal con el eje vertical. Para Al / 2 nm ZnO / n - -Dispositivo GE sin tratamiento con plasma Ar, el ρ c es 6,87 × 10 −2 Ω cm 2 , pero después del tratamiento con plasma de Ar de 45 s, hay una reducción de 17.2 veces en comparación con el tratamiento sin plasma de Ar y tiene la resistividad de contacto ρ c de 3,66 × 10 −3 Ω cm 2 . Comparamos los valores de ρ c para el Al / 2 nm ZnO / n - -Dispositivos Ge con diferentes duraciones de tratamiento con plasma Ar en la Fig. 8b. Se observa que ρ c del dispositivo disminuye con el tiempo de tratamiento hasta 30 s. Sin embargo, como el tiempo de tratamiento es superior a 30 s, ρ c casi permanece igual. La reducción en ρ c puede atribuirse al dopaje de ZnO, por lo tanto a la reducción de la barrera de túnel y la resistencia en serie, como se ha mencionado anteriormente. Pero no hay ningún cambio observable en la resistencia de la hoja de n - -Ge, que indica que no hay efecto sobre la conductividad de n - -Ge con tratamiento con plasma Ar.
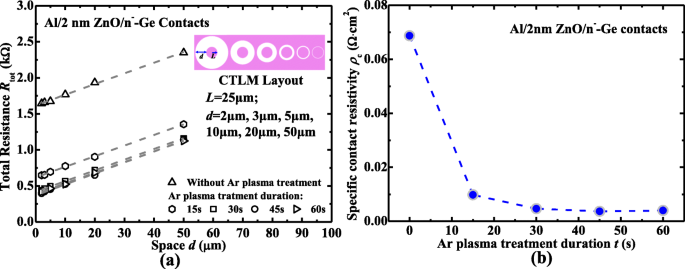
un R tot versus d curvas para el CTLM con Al / 2 nm ZnO / n - -Contactos de Ge con diferente duración del tratamiento con plasma de Ar, en el recuadro de la Fig. 5a se encuentra la información de la estructura CTLM utilizada en este trabajo. b ρ c versus diferente duración del tratamiento con plasma de Ar
La estructura CTLM con contactos de Al en Ge muy dopado se utiliza para investigar la característica de resistencia de contacto de Al / 2 nm ZnO / n + -Ge. La capa de ZnO se sometió al tratamiento con plasma de Ar durante 45 s. La figura 9a muestra el I medido - V curvas entre los contactos de Al con diferentes d , mostrando el excelente rendimiento óhmico. La Figura 9b traza la R tot en función de d para Al / 2 nm ZnO / n + -Ge CTLM y R sh y ρ c se extraen para ser 64 Ω / □ y 2,86 × 10 −5 Ω cm 2 , respectivamente.
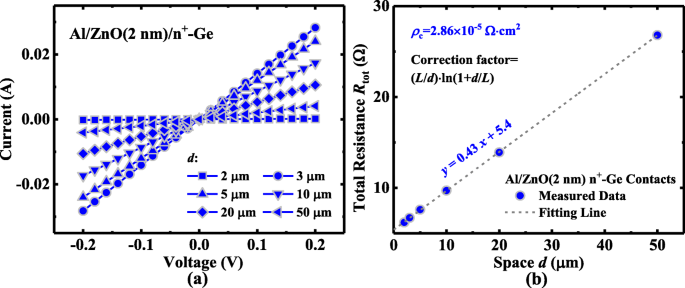
un yo - V curvas en Al / ZnO (2 nm) / n + -Ge con diferentes d con ZnO tratado con plasma Ar. b R tot versus d curvas para el CTLM con Al / ZnO (2 nm) / n + -Ge contactos
Comparamos el ρ c de ZnO tratado con Ar plasma Al / ZnO / n + -Ge dispositivos en este trabajo con los reportados en la literatura, como se muestra en la Fig. 10. Para los n + fuertemente dopados -Muestra de contacto Ge, Al / ZnO / n + -Ge se muestran los contactos ρ más pequeños c en comparación con los de Ni / GeSn [40, 41], Ni / Ge [42], Ti / n + -Ge en ref. [31] y Ti / TiO 2 / GeO 2 / Ge [31], Ni / Ge [42] con carbono implantado y Ti / n + -SiGe / n-Ge [43]. Los contactos óhmicos metálicos, como Ni / Ge, Ni / GeSn, Ti / Ge y Ni / Ge implantado con carbono, sufren un bloqueo severo a nivel de Fermi, lo que da como resultado la gran ρ c . Para Ti / TiO 2 / GeO 2 / Ge contact, una gran resistencia de tunelización fue introducida por la bicapa de 1 nm TiO 2 /1.5 nm GeO 2 IL, degradando las características de resistividad de contacto. Pero el ρ c en este trabajo es mayor que en la ref. [44]. Suponemos que esto puede deberse a que P + cuatro veces mayor dosis de implantación que en nuestro trabajo. Una dosis de implantación mayor permitirá el dopaje superficial más pesado de n + -Ge, lo que resulta en una barrera de Schottky más delgada y una ρ más pequeña c . Creemos que con un dopaje más pesado de n + -Ge en Al / ZnO / n + -Ge dispositivos, más pequeños ρ c dará como resultado.
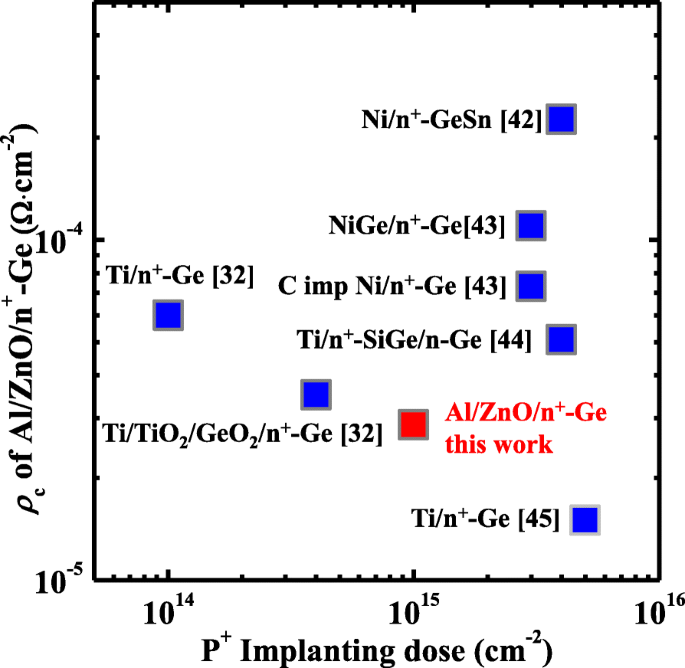
Comparación de ρ c de Al / ZnO / n + -Ge en este trabajo con los de otros contactos reportados, usando P + dosis de implantación como x eje
Conclusiones
Se investiga el efecto de depilación a nivel de Fermi inducido por ZnO IL en las estructuras de Al / ZnO / n-Ge. La medición de XPS demostró un pequeño CBO de 0,22 eV en ZnO / n-Ge, es decir, se produce la eliminación de FLP, lo que conduce a los contactos de metal óhmico en n-Ge. Se informa además que el tratamiento con plasma de Ar de ZnO conduce al aumento de la concentración de V o , actuando como los dopantes de tipo n en ZnO, lo que mejora la R c rendimiento en dispositivos Al / ZnO / n-Ge. Los contactos de metal óhmico se obtienen en n - y n + -Ge con ZnO IL tratado con plasma de Ar. Según las estructuras CTLM, los valores de ρ c 3,66 × 10 −3 Ω cm 2 y 2,86 × 10 - 5 Ω cm 2 se consiguen en Al / 2 nm ZnO / n - -Ge y Al / 2 nm ZnO / n + -Ge, respectivamente, con el tratamiento con plasma de Ar de ZnO a una potencia de 50 W durante 45 s.
Abreviaturas
- Al:
-
Aluminio
- ALD:
-
Deposición de la capa atómica
- Ar:
-
Argón
- CBO:
-
Desplazamiento de la banda de conducción
- CTLM:
-
Método de línea de transmisión circular
- DEZn:
-
Dietil zinc
- E g :
-
Band gap
- FLP:
-
Fijación de nivel Fermi
- Ge:
-
Germanio
- GeO x :
-
Óxido de germanio
- GeSn:
-
Estaño de germanio
- HCl:
-
Ácido clorhídrico
- HRTEM:
-
Microscopio electrónico de transmisión de alta resolución
- IL:
-
Capa interfacial
- MIGS:
-
Estados-gap-inducidos por metales
- MOSFET:
-
Transistores de efecto de campo semiconductores de óxido metálico
- Ni:
-
Níquel
- P + :
-
Iones de fósforo
- R c :
-
Resistencia de contacto
- R tot :
-
Resistencia total bruta
- SE:
-
Elipsometría espectroscópica
- Si:
-
Silicio
- Ti:
-
Titanio
- TiO 2 :
-
Dióxido de titanio
- UV-VIS:
-
Ultravioleta:visible
- VBO:
-
Desplazamiento de la banda de valencia
- V o :
-
Vacante de oxígeno
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- ZnO:
-
Óxido de zinc
- ρ c :
-
Resistividad de contacto específica
Nanomateriales
- ¿Cuál es la diferencia entre Inconel e Incoloy?
- ¿Cuál es la diferencia entre hoja de metal, placa y papel de aluminio?
- Diferencia entre estructura y clase:explicada con el ejemplo de C++
- Diferencia entre while y do-while:explicada con ejemplos
- Ajuste de la química superficial de la polieteretercetona mediante revestimiento de oro y tratamiento con plasma
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Evolución del área de contacto con carga normal para superficies rugosas:de escalas atómicas a macroscópicas
- ¿Qué es el tratamiento térmico? - Proceso y métodos
- ¿Cuál es la diferencia entre la fabricación de metal y la soldadura de metal?
- ¿Cuál es la diferencia entre la fabricación de metal y la soldadura?
- La diferencia entre templado y recocido



