Deposición de capas atómicas mejoradas con plasma de películas de cobalto utilizando Co (EtCp) 2 como precursor de metales
Resumen
Para la tecnología avanzada de interconexión de Cu, las películas de Co se han investigado ampliamente para que sirvan como revestimiento y reemplazo de la capa de semillas debido a una mejor humectabilidad al Cu que al Ta. En este artículo, las películas de Co se cultivan mediante deposición de capa atómica mejorada con plasma utilizando Co (EtCp) 2 como precursor, y se investigan detalladamente las influencias de los parámetros del proceso sobre las características de las películas de Co. Los resultados indican que la ventana del proceso es de 125–225 ° C con una tasa de crecimiento de ~ 0.073 Å / ciclo. Es decir, la conexión del grupo Et al ligando Cp puede permitir un crecimiento de película estable a 125 ° C, mientras que la temperatura correspondiente debe ser superior a 200 ° C en términos de Co (Cp) 2 y Co (MeCp) 2 . Las películas depositadas contienen elementos N y O además del Co y C. dominantes. Además, la prolongación del NH 3 El tiempo de pulso mejora significativamente la conductividad de la película de Co y se puede lograr una baja resistividad de 117 μΩ cm con un NH 3 tiempo de pulso de 40 s. La rugosidad cuadrática media muestra una variación menor con la temperatura de deposición y mantiene un valor bajo de ~ 0.3 nm, indicativo de una película de Co plana.
Antecedentes
Teniendo en cuenta el proceso de interconexión de Cu convencional en circuitos integrados de gran escala de alta velocidad, una capa de barrera como TaN es indispensable para evitar la difusión de átomos de Cu en los dieléctricos entre capas circundantes (ILD) [1]. Además de la capa de barrera, también es necesaria una capa de revestimiento como Ta para mejorar la adhesión entre la capa de barrera y Cu. Además, es difícil que la línea de Cu se deposite en la capa de revestimiento mediante galvanoplastia directamente debido a la débil nucleación de los átomos de Cu en la superficie de Ta. Como consecuencia, se necesita recubrir una capa de semillas de Cu sobre la capa de revestimiento antes de la galvanoplastia de Cu. Es decir, se debe insertar una pila de capa de semillas TaN / Ta / Cu entre la línea ILD y Cu. Además, esta pila se recubre en el ILD con un patrón de trincheras y vías. Con la reducción del tamaño de la función del dispositivo, el volumen disponible para la línea de interconexión de Cu disminuye constantemente. Con el fin de lograr una menor resistencia de interconexión de Cu, se ha investigado ampliamente la capa de barrera / revestimiento sin semillas [2, 3, 4, 5, 6]. Por ejemplo, TaN todavía funciona como capa de barrera y Co reemplaza a Ta como capa de revestimiento. Debido a una mejor humectabilidad de Co a Cu que Ta, Cu se puede galvanizar directamente sobre la superficie de Co. Tradicionalmente, la capa de barrera / revestimiento se hace crecer mediante un proceso físico de deposición de vapor. Sin embargo, la deposición de una capa de barrera / revestimiento de alta calidad es un desafío ya que el PVD tiene una tasa de cobertura de paso pobre en zanjas y vías de alta relación de aspecto. En cambio, se pueden obtener películas ultrafinas, continuas y de buena cobertura escalonada mediante la técnica de deposición de capa atómica (ALD) gracias a la propiedad de crecimiento autolimitante [7].
En cuanto a las películas de ALD Co, se han estudiado ampliamente un gran número de precursores de Co, especialmente los basados en el ligando ciclopentadienilo (Cp), como el bis-ciclopentadienilo cobalto (CoCp 2 ) [8,9,10,11,12,13,14], bis (η-metilciclopentadienil) cobalto [Co (MeCp) 2 ] [15], y ciclopentadienil isopropil acetamidinato cobalto [Co (CpAMD)] [16]. El empleo de CoCp 2 permite el crecimiento de películas de Co con baja resistividad y alta pureza; sin embargo, el crecimiento de la película estable se limita a temperaturas superiores a 250 ° C. Con la adición de un grupo metilo al ligando Cp, se puede lograr un crecimiento de temperatura más baja a 200 ° C, lo que se atribuye a la mayor reactividad del NH 3 radical al ligando MeCp en comparación con el ligando Cp. Sobre la base del crecimiento de película de Co con CoCp 2 y Co (MeCp) 2 como precursores, la ventana del proceso podría moverse a temperaturas más bajas, es decir, <200 ° C si el grupo etilo está conectado al ligando Cp.
En este trabajo, se cultivaron películas delgadas de Co mediante ALD mejorado con plasma (PE-ALD) utilizando bis (etilciclopentadienil) cobalto [Co (EtCp) 2 ] y NH 3 plasma como precursores. Se investigó detalladamente la influencia de diferentes parámetros del proceso en las características de las películas de Co. Como resultado, se logró con éxito una ventana de proceso de 125–225 ° C. Además, las películas de Co exhiben una resistividad más baja (~ 130 μΩ cm).
Métodos
Se cultivaron varias películas delgadas de Co mediante PE-ALD en un SiO 2 de 200 nm película, que se depositó sobre sustratos de silicio tipo p por oxidación térmica. Co (EtCp) 2 se utilizó como precursor del metal, que se almacenó en un recipiente a 70 ° C y se transfirió a la cámara de deposición con un N 2 gas portador. El NH 3 El plasma se generó mediante un generador de plasma remoto con una potencia de 2800 W, que actúa como agente reductor. El caudal de N 2 se mantuvo a 50 sccm y la presión de trabajo fue de ~ 1000 Pa durante el crecimiento de la película. Para investigar el efecto de la temperatura de deposición sobre el crecimiento de la película, se varió la temperatura del sustrato de 100 a 270 ° C con un paso de 25 ° C. Además, para optimizar los parámetros del proceso, los tiempos de pulso de Co (EtCp) 2 y NH 3 el plasma también se cambió, respectivamente. Además, para investigar el efecto del post recocido sobre el rendimiento de las películas de Co, las muestras depositadas a diferentes temperaturas se recocieron en el gas de formación (N 2 / 4% -H 2 ) a 400 ° C durante 30 min.
El espesor y la densidad de la película se dedujeron por reflexión de rayos X, y la microestructura de la película se determinó mediante difracción de rayos X de incidencia rasante (XRD) en un difractómetro (Bruker D8 Discover) con Cu K α radiación. La morfología de la superficie de la película se observó con microscopía de fuerza atómica (AFM) (Bruker Icon) y microscopio electrónico de barrido (SEM) (Zeiss SIGAMA HD). La composición elemental y los enlaces químicos de la película se analizaron mediante espectroscopia de fotoelectrones de rayos X (XPS) (Kratos Axis Ultra DLD). La resistencia de la hoja de la película se midió con una sonda de cuatro puntos y la resistividad de la película se calculó en función del espesor de la película y la resistencia de la hoja.
Resultados y discusión
Optimización de los parámetros del proceso ALD
La Figura 1a muestra la tasa de crecimiento de la película de Co en función de la temperatura del sustrato. Se encuentra que la tasa de crecimiento aumenta al aumentar la temperatura del sustrato a 125 ° C, y luego se obtiene una tasa de crecimiento relativamente estable de 0.073 ± 0.02 Å / ciclo entre 125 y 225 ° C. Sin embargo, cuando la temperatura del sustrato sube a 250 ° C o más, aumenta la tasa de crecimiento. Por lo tanto, el rango de temperatura de 125–225 ° C puede considerarse como una ventana de proceso adecuada. Comparado con Co (Cp) 2 y Co (MeCp) 2 , la adición del grupo Et al ligando Cp permite que la ventana del proceso se mueva a una temperatura de deposición más baja, lo que indica una mayor reactividad de los ligandos EtCp con NH 3 plasma. Este crecimiento a baja temperatura a 125 ° C es beneficioso para reducir el balance térmico. Con respecto a las temperaturas del sustrato inferiores a 125 ° C, el crecimiento relativamente más lento de la película debe atribuirse a la falta de energía de activación adecuada para la reacción química [7]. Una tasa de crecimiento tan alta a ≥ 250 ° C está relacionada con la descomposición térmica del precursor del metal [17]. Para investigar la influencia de Co (EtCp) 2 tiempo de pulso en la tasa de crecimiento de la película depositada, el tiempo de pulso de Co (EtCp) 2 aumenta gradualmente de 1 a 4 s con un paso de 1 s mientras que otros parámetros del proceso son fijos. Como se muestra en la Fig. 1b, la tasa de crecimiento aumenta de ~ 0.06 a ~ 0.073 Å / ciclo con el incremento de Co (EtCp) 2 tiempo de pulso de 1 a 2 s, y luego mantiene un valor relativamente estable. Esto indica que la adsorción superficial de Co (EtCp) 2 alcanza una saturación a un tiempo de pulso de 2 s. La figura 1b también ilustra la influencia de NH 3 -Tiempo de pulso plasmático sobre la tasa de crecimiento de la película. La tasa de crecimiento aumenta al prolongar NH 3 -tiempo de pulso plasmático; sin embargo, cuando el tiempo del pulso de plasma supera los 20 s, la tasa de crecimiento alcanza un valor de saturación de ~ 0,12 Å / ciclo.

Dependencia de la tasa de crecimiento de la película ALD en a temperatura del sustrato, b Co (EtCp) 2 y NH 3 tiempo de pulso
Caracterización de las copelículas depositadas
La Figura 2 muestra los espectros XPS de la encuesta de las películas depositadas a 175 ° C. Las películas depositadas constan de elementos Co, N, O y C. Vale la pena mencionar que para eliminar completamente la contaminación de la superficie, todas las muestras se grabaron in situ con bombardeo de iones Ar durante 6 min antes de la recolección de los espectros XPS. La Tabla 1 enumera los porcentajes elementales de la película depositada a 175 ° C con el tiempo de grabado y los contenidos de C y O permanecen constantes después de 6 min de grabado, lo que indica una eliminación completa de la contaminación de la superficie. La Tabla 2 enumera la relación de átomos elementales de las películas cultivadas a 100 y 175 ° C, respectivamente, que se extraen de los espectros XPS de alta resolución. A medida que la temperatura del sustrato aumenta de 100 a 175 ° C, el contenido relativo de C disminuye del 40 al 32% y el porcentaje elemental de N aumenta del 14 al 18%. Además, el porcentaje relativo de O muestra un ligero incremento del 5 al 7%. El mayor contenido de C debe atribuirse a la eliminación parcial de los ligandos EtCp [15, 16]. Dado que no hay elemento O en los precursores, los átomos de O en las películas depositadas probablemente se originan a partir del oxígeno en la cámara de reacción.
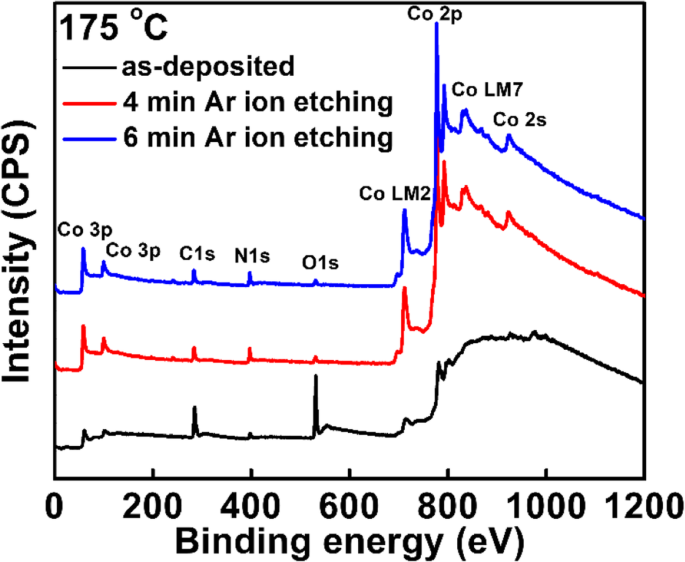
Los espectros de estudio de las películas de Co depositadas a 100 ° C con diferentes tiempos de grabado
La Figura 3a muestra los espectros C 1s de alta resolución de las películas depositadas a diferentes temperaturas. El espectro de C 1s se puede dividir bien en cuatro componentes a 283,2, 284,7, 286,1 ± 0,1 eV y 288,9 eV, que resultan de C-Co [12], CC [12, 18], CN [15, 19] y Enlaces CO [12], respectivamente. A medida que la temperatura aumenta de 100 a 175 ° C, el contenido relativo de enlace C-C disminuye de 61 a 56%, mientras que los de C-Co, C-N y C-O aumentan en 1%, 2% y 2%, respectivamente. Esto revela que se descompusieron más ligandos EtCp a una temperatura más alta, lo que condujo a la reducción del porcentaje relativo de C en la película. La Figura 3b muestra los espectros de N 1s de alta resolución de las películas depositadas a diferentes temperaturas. Cada espectro de N 1s se puede separar bien en dos componentes utilizando la función Gaussiana-Lorentziana. El pico situado en 397,8 eV debería estar asociado al enlace N-Co [13], y los picos centrados en 399,2 eV deberían corresponder al enlace N-C [20, 21]. A medida que la temperatura del sustrato aumenta de 100 a 175 ° C, el contenido relativo de N-Co disminuye del 72 al 69%. Esto se debe a que la desorción de nitrógeno de la película aumenta a temperaturas más altas, lo que da como resultado la formación de menos enlaces N-Co. La Figura 3c muestra Co 2p 3/2 de alta resolución Espectros XPS de las películas de Co depositadas a diferentes temperaturas. Con respecto a la existencia de enlaces C-Co y N-Co, como se muestra en la Fig. 3a, b, es razonable que el Co 2p 3/2 El espectro se puede dividir en tres componentes, que se encuentran en 778, 778,9 y 780,86 ± 0,34 eV, respectivamente. El pico de la energía de enlace más pequeña debe atribuirse al enlace Co-Co [12, 22]. Además, dado que la electronegatividad de Pauling de C (2.55) es menor que la de N (3.04), la densidad de carga positiva en el Co unido a N es mayor que la del Co unido a C. Por lo tanto, los picos en 778.9 y 780.86 ± 0.34 eV debería surgir de los enlaces Co-C y Co-N, respectivamente. Cuando la temperatura de deposición aumenta de 100 a 175 ° C, el contenido relativo de enlace Co-N disminuye del 48 al 32%, lo cual es consistente con la evolución del enlace N-Co en la Fig. 3b.

a de alta resolución Co 2p 3/2 , b C 1s y c Espectros N 1s XPS de las películas depositadas a 100 ° C y 175 ° C, respectivamente
Las propiedades cristalinas de las películas de Co se caracterizan por TEM, como se muestra en la Fig. 4. Las películas de Co depositadas a 100 y 250 ° C, respectivamente, se cristalizan ambas. La Figura 5 muestra las imágenes AFM de las películas de Co cultivadas a diferentes temperaturas. A medida que la temperatura de deposición aumenta de 100 a 250 ° C, la rugosidad de la raíz cuadrada media (RMS) muestra una variación menor y mantiene un valor bajo de ~ 0.3 nm, indicativo de una película de Co plana.
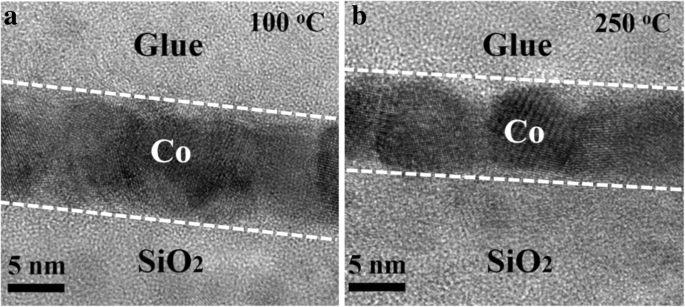
Las imágenes TEM transversales de las películas de Co (1200 ciclos) depositadas en a 100 ° C y b 250 ° C, respectivamente
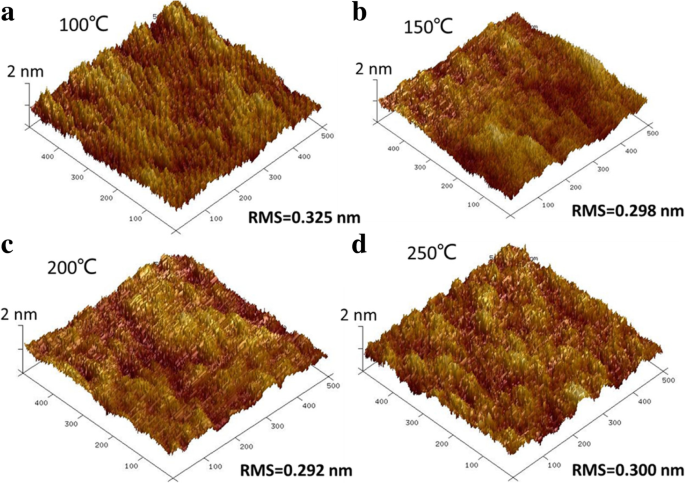
Imágenes AFM de las películas de Co (1200 ciclos) depositadas con Co (EtCp) 2 tiempo de pulso de 2 sy NH 3 tiempo de pulso de plasma de 10 s a diferentes temperaturas: a 100 ° C; b 150 ° C; c 200 ° C; d 250 ° C
La Figura 6a, b muestra la dependencia de la resistividad de las películas de Co en la temperatura del sustrato y NH 3 tiempo de pulso. La resistividad de la película se reduce notablemente de 652 a 130 Ω cm y luego se mantiene constante al aumentar la temperatura de deposición de 100 a 275 ° C. Los resultados deben atribuirse al aumento del contenido relativo de Co metálico en la película. Como el NH 3 el tiempo del pulso aumenta de 10 a 40 s, la resistividad de las películas de Co disminuye de 158 a 117 μΩ cm (ver Fig. 6b). La Figura 7 muestra el Co 2p 3/2 Espectros XPS de las películas de Co depositadas con diferentes NH 3 tiempos de plasma. Como el NH 3 El tiempo de plasma se prolonga de 10 a 40 s, el porcentaje relativo de enlaces Co-Co aumenta de 31 a 34% y el contenido relativo de enlaces Co-C disminuye de 40 a 31%. Además, el contenido de carbono disminuye en un 22% a medida que el NH 3 el tiempo del pulso plasmático aumenta de 10 a 40 s. Esto indica el aumento gradual de la eliminación de los ligandos de EtCp, contribuyendo así a la disminución de la resistividad de la película de Co.

La resistividad de la película de Co en función de la temperatura de crecimiento ( a ) y NH 3 tiempo de pulso ( b ), respectivamente
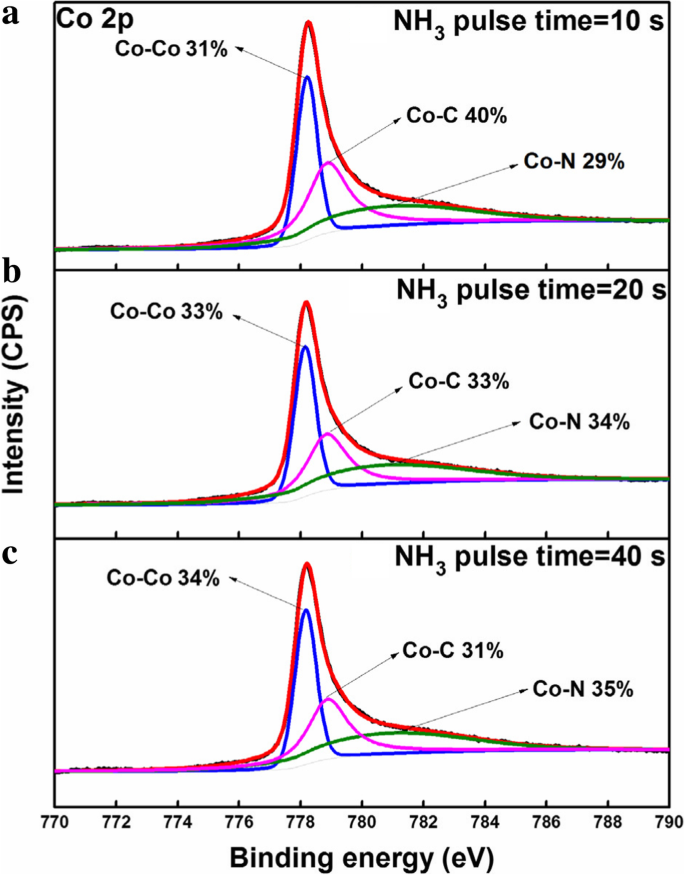
Los espectros XPS de las películas de Co con diferentes NH 3 tiempos de plasma: a 10 s; b 20 s; c 40 s
La Tabla 3 muestra la comparación de rendimiento de las películas de Co cultivadas por diferentes precursores. Comparado con CoCp 2 y Co (MeCp) 2 , Co (EtCp) 2 permite la deposición de la capa atómica de películas de Co a una temperatura más baja. Además, utilizando el precursor metálico de Co (EtCp) 2 conduce a una menor tasa de crecimiento. Teóricamente, el proceso ALD es el crecimiento de monocapa por monocapa. De hecho, el efecto de impedimento estérico y la adsorción superficial de los precursores afectan el crecimiento de la película. En términos del efecto de impedimento estérico, significa que los ligandos de las especies precursoras de metales quimisorbidos pueden proteger una superficie parcial y evitar que otras especies precursoras de metales se adsorban completamente en la superficie del sustrato. Dado que Co (EtCp) 2 tiene un ligando más grande en comparación con CoCp 2 y Co (MeCp) 2 , se supone que se producirá un efecto de impedimento estérico significativo durante el proceso de ALD. Esto puede conducir al crecimiento de sub-monocapa, lo que resulta en una tasa de crecimiento menor. Por otro lado, dado que una capa de revestimiento de Co debe depositarse sobre una capa de barrera de TaN para las futuras aplicaciones prácticas, se cultivaron 1200 ciclos de películas de Co sobre la película de ALD TaN a 125 ° C. La Figura 8 muestra la imagen TEM en sección transversal de la película de Co depositada sobre la superficie de TaN. Se observa que la película de Co es continua y uniforme, revelando un comportamiento de crecimiento superior. Además, se encuentra que el espesor (aproximadamente 10 nm) de la película de Co depositada en la película de ALD TaN es similar al que crece en el SiO 2 superficie.
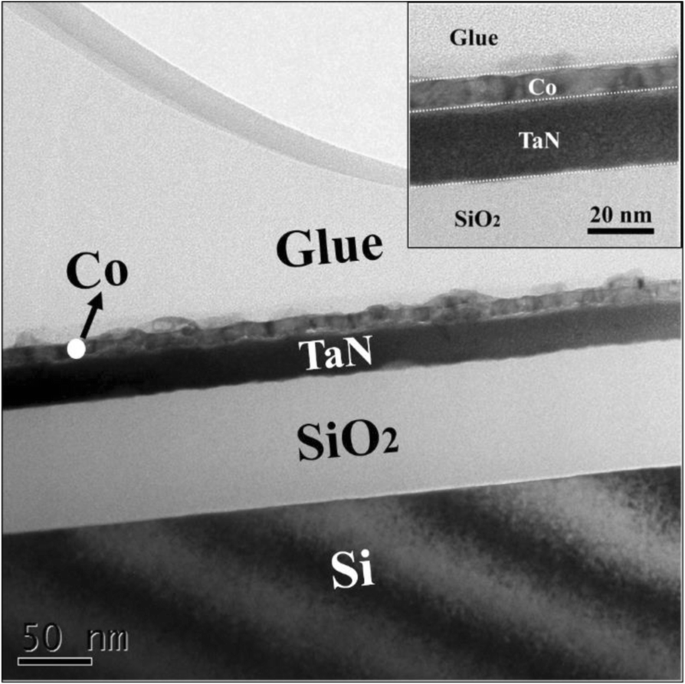
La imagen TEM en sección transversal de la película de Co (1200 ciclos) depositada a 125 ° C en la superficie de ALD TaN y el recuadro es una imagen ampliada
Conclusiones
El crecimiento de la película fina de Co es devuelto por PE-ALD utilizando los precursores de Co (EtCp) 2 y se investigó la influencia de los parámetros del proceso en las características de las películas de Co. La adición del grupo Et al ligando Cp permite que la ventana del proceso se mueva a una temperatura de deposición más baja de 125 ° C. Además, las películas de Co se componen de elementos Co y C junto con algunos elementos N y O. Con el aumento de la temperatura de deposición, los ligandos EtCp se eliminan de manera más suficiente y el porcentaje elemental relativo de C disminuye. Como consecuencia, la resistividad de las películas de Co depositadas se reduce de 652 a 130 μΩ cm y luego permanece en un valor estable cuando la temperatura del sustrato aumenta de 100 a 275 ° C. Para la temperatura de deposición de 125 ° C, la resistividad disminuye gradualmente con la prolongación de NH 3 se puede obtener un tiempo de pulso y una resistividad baja de 117 μΩ cm cuando un NH 3 Se utiliza un tiempo de pulso de 40 s. La rugosidad cuadrática media muestra una variación menor con la temperatura de deposición y mantiene un valor bajo de ~ 0.3 nm, indicativo de una película de Co plana.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- ALD:
-
Deposición de la capa atómica
- Co (CpAMD):
-
Ciclopentadienil isopropil acetamidinato cobalto
- Co (EtCp) 2 :
-
Bis (etilciclopentadienil) cobalto
- Co (MeCp) 2 :
-
Bis (η-metilciclopentadienil) cobalto
- CoCp 2 :
-
Bis-ciclopentadienil cobalto
- Cp:
-
Ciclopentadienilo
- ILD:
-
Dieléctrico de capa intermedia
- PE:
-
Mejorado con plasma
- RMS:
-
Raíz cuadrada media
- SEM:
-
Microscopio electrónico de barrido
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- XRD:
-
Difracción de rayos X
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Investigaciones de la sorción de iones de metales pesados utilizando nanocompuestos de biocarbón modificado con hierro
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Deposición en dos pasos de ZnO dopado con Al en p-GaN para formar contactos óhmicos
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Mejora de la selectividad del transductor amperométrico utilizando películas de fenilendiamina nanométricas
- Medición del grosor de la capa con un microscopio
- Ventajas del uso de aleaciones



