Diseño de puntos cuánticos GeSn / GeSiSn con ingeniería de deformación para la emisión directa de banda prohibida en el infrarrojo medio en el sustrato de Si
Resumen
Los puntos cuánticos GeSn / GeSiSn autoensamblados y diseñados por deformación en la matriz Ge se han investigado numéricamente con el objetivo de estudiar su potencialidad hacia la emisión de banda prohibida directa en el rango de IR medio. El uso de la aleación GeSiSn como medio circundante para los puntos cuánticos (QD) de GeSn permite ajustar la deformación alrededor del QD mediante la variación de la composición de Si y / o Sn. En consecuencia, el desajuste de la red entre los puntos cuánticos GeSn y la capa circundante GeSiSn se ha ajustado entre -2,3 y -4,5% a través de la variación de la composición de la barrera Sn para diferentes tamaños de QD en forma de cúpula. Los resultados obtenidos muestran que la longitud de onda de emisión, cumpliendo los criterios específicos de direccionamiento QD, se puede sintonizar sucesivamente en un amplio rango de IR medio de 3 a 7 μm abriendo nuevas perspectivas para fuentes láser del grupo IV totalmente integradas en sistemas fotónicos de Si para aplicaciones de detección.
Antecedentes
Recientemente, la demostración de materiales del grupo IV con banda prohibida directa a través de la aleación de Ge [1, 2] y SiGe [3, 4] con estaño ha motivado intensas actividades de investigación debido a las oportunidades reales y prácticamente implementables hacia la fotónica y la electrónica eficiente en chip. integración. De hecho, se ha demostrado que la aleación GeSn exhibe bandgap directo más allá de cierta composición a través de la disminución más rápida de Γ en comparación con el valle L [5,6,7,8]. Si bien los resultados informados son muy alentadores, las propiedades del material y las posibilidades de aplicación aún no se han explorado por completo. De hecho, la ruta principal realmente disponible para aumentar la longitud de onda operativa de los láseres semiconductores basados en GeSn, hacia la ventana de transparencia de la atmósfera que se superpone con las líneas de absorción de varios gases [9], incluye el aumento del contenido de Sn en las capas de GeSn [10, 11 ]. Sin embargo, debido al gran desajuste de la red entre Ge y Sn (14%), la preservación de la calidad cristalográfica del material aparece como el principal desafío que prohíbe este objetivo [12, 13]. Una solución potencialmente interesante para aumentar la longitud de onda de emisión y asegurar mejores confinamientos de portadores se relacionan con estructuras de dimensiones inferiores como nanocables [14,15,16], nanobarras [17] y puntos cuánticos [18]. Dentro de los criterios específicos de franqueza, la longitud de onda de emisión interbanda de banda prohibida directa está teóricamente limitada a 4,3 µm [19]. Para superar estas limitaciones, es necesario introducir un grado adicional de libertad en la concepción de estructuras cuánticas basadas en el grupo IV. Esto puede garantizarse mediante el uso de la capa ternaria GeSiSn [20,21,22], como material circundante para los puntos cuánticos (QD) de GeSn, que ofrece la posibilidad de ingeniería de deformaciones mediante la incorporación de composiciones de Si y Sn adecuadas . En consecuencia, se espera que el uso de la capa de ingeniería de deformación GeSiSn alrededor de GeSn QD ofrezca una gama más amplia de longitudes de onda de emisión de banda prohibida directa accesible.
En este contexto, informamos sobre el estudio teórico del efecto de la ingeniería de deformación mediante la variación de la composición de Sn en la capa GeSiSn que rodea la GeSn QD en la longitud de onda de emisión interbanda de banda prohibida directa.
Métodos
Dado que las compensaciones de banda entre las aleaciones binarias y ternarias del grupo IV que contienen Sn y el Ge no se conocen experimentalmente, se evalúa la alineación relativa de la banda entre los diferentes semiconductores del grupo IV involucrados en este trabajo, con respecto al borde de la banda de valencia de Ge, utilizando la teoría simplificada de los desplazamientos de banda de Jaros [23] como detallan D'Costa et al. [24]. Los efectos de deformación que surgen del desajuste de la red entre el sustrato Ge y la capa GeSiSn y entre el GeSn QD y el material GeSiSn circundante se han evaluado para los bordes de la banda de conducción y valencia.
De hecho, el borde de la banda de conducción se desplaza en \ (\ delta {E} _c ^ i \) y el de la banda de valencia en δE v como se muestra en la ecuación. (1) y (2):
$$ \ delta {E} _c ^ i ={a} _c ^ i \ left ({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right) $ $ (1) $$ \ delta {E} _v ={a} _v \ left ({\ varepsilon} _ {xx} + {\ varepsilon} _ {yy} + {\ varepsilon} _ {zz} \ right) + b \ left ({\ varepsilon} _ {xx} - {\ varepsilon} _ {zz} \ right) $$ (2)donde i denota L o Γ valle, a c y a v son el potencial de deformación de la banda de conducción y de valencia, respectivamente, y b es el potencial de deformación por cortante. \ ({\ varepsilon} _ {xx} ={\ varepsilon} _ {yy} =\ varepsilon =\ left (\ frac {a_s- {a} _ {\ mathrm {l}}} {a _ {\ mathrm {l }}} \ right) \) es la cepa del plan y \ ({\ varepsilon} _ {zz} =- 2 \ frac {C_ {12}} {C_ {11}} {\ varepsilon} _ {xx} \) es la tensión en la dirección de crecimiento. a s y a l son respectivamente el parámetro de rejilla del sustrato y la capa tensada. C 11 y C 12 son las constantes de rigidez.
Los parámetros binarios y ternarios del material de aleación se derivan de los de Ge, Si y Sn por interpolación lineal. Estos parámetros se toman de la Referencia [11].
Los bandgaps tensados dependientes de la composición se pueden evaluar agregando los correspondientes cambios de energía generados por la tensión al bandgap del material no tensado dado en la Ec. (3) para GeSn y Eq. (4) para GeSiSn:
$$ {E} _g ^ i \ left ({\ mathrm {Ge}} _ {1- {X} _d} {\ mathrm {Sn}} _ {X_d} \ right) =\ left (1- {X} _d \ right) {E} _g ^ i \ left (\ mathrm {Ge} \ right) + {X} _d {E} _g ^ i \ left (\ mathrm {Sn} \ right) - {b} ^ i { X} _d \ left (1- {X} _d \ right) $$ (3) $$ {\ displaystyle \ begin {array} {l} {E} _g ^ i \ left ({\ mathrm {Ge}} _ {1- {x} _b-y} {\ mathrm {Si}} _ y {\ mathrm {Sn}} _ {x_b} \ right) =\ left (1- {x} _b-y \ right) {E} _g ^ i \ left (\ mathrm {Ge} \ right) + {x} _b {E} _g ^ i \ left (\ mathrm {Sn} \ right) + {yE} _g ^ i \ left (\ mathrm {Si } \ right) - {b} _ {\ mathrm {Ge} \ mathrm {Sn}} ^ i {x} _b \ Big (1- {x} _b - \\ {} y \ Big) - {b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ iy \ left (1- {x} _b-y \ right) - {b} _ {\ mathrm {Ge} \ mathrm {Si}} ^ i {x} _por \ end {matriz}} $$ (4)donde b es el correspondiente parámetro de arco de banda prohibida de las aleaciones binarias resumidas en la Tabla 1.
Para determinar los estados confinados de las portadoras y deducir las energías de transición entre bandas, la ecuación de Schrödinger de masa efectiva de banda única se ha resuelto en coordenadas cartesianas mediante el método de elementos finitos proporcionado por el software COMSOL Multiphysics [25]:
$$ - \ frac {{\ mathrm {\ hslash}} ^ 2} {2} \ nabla \ left (\ frac {1} {m ^ {\ ast} \ left (\ overrightarrow {r} \ right)} \ mathrm {\ nabla \ uppsi} \ left (\ overrightarrow {r} \ right) \ right) + V \ left (\ overrightarrow {r} \ right) \ uppsi \ left (\ overrightarrow {r} \ right) =E \ uppsi \ left (\ overrightarrow {r} \ right) $$ (5)E representa la energía del portador y ψ es la función de onda correspondiente. m * es la masa efectiva del transportista, ћ es la constante de Planck reducida, \ (\ overrightarrow {r} \) es el vector de coordenadas tridimensionales y V es el potencial de confinamiento del portador (discontinuidad de la banda). Para simplificar el procedimiento de cálculo de la estructura electrónica QD, hemos adoptado la aproximación de deformación constante [26, 27] en lugar del enfoque de simulación atómica computacionalmente costoso que obviamente podría dar más precisión en el perfil de distribución de deformación [28, 29]. De hecho, consideramos que los portadores que limitan el potencial en el QD sometido a deformación por compresión son lo suficientemente profundos para minimizar el impacto de la falta de uniformidad de la deformación en los estados confinados de electrones [27]. Además, los bordes de la banda de conducción, que son los parámetros más importantes en este trabajo, que permiten estudiar la franqueza de la banda prohibida, solo se modifican porque la deformación hidrostática es menos sensible a la falta de uniformidad de la deformación, especialmente cuando se considera un desajuste de celosía relativamente bajo. [30].
Resultados y discusión
Dado que nos preocupa principalmente el impacto de la deformación alrededor de GeSn QD, la composición de Sn de QD se fija en 28% y la composición de Si de GeSiSn en 35%; Por tanto, el estudio se centra en el impacto de la composición de la barrera de Sn ( x b ) variación entre 6 y 22%. La deformación en plano resultante, ya sea en la capa GeSiSn o en la GeSn QD, se muestra en la Fig. 1a.
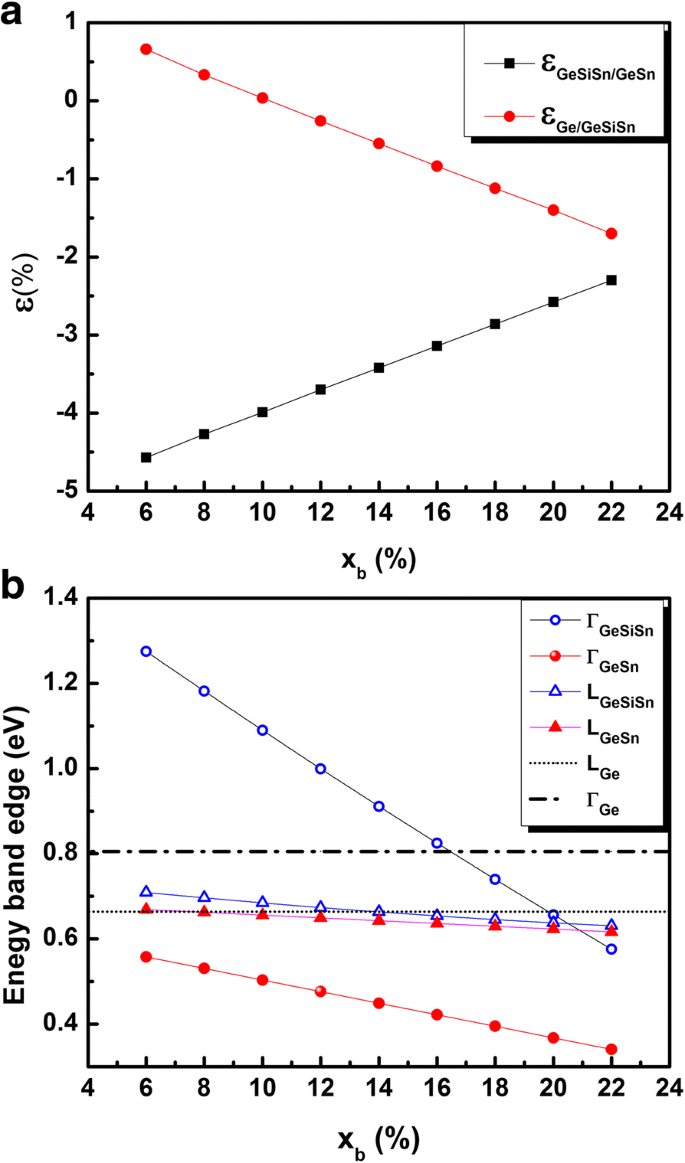
un Discrepancia de celosía entre Ge 0.65- xb Si 0.35 Sn xb y Ge (círculos rellenos) y entre Ge 0,72 Sn 0,28 y Ge 0.65- xb Si 0.35 Sn xb (cuadrados rellenos) en función de x b . b Bordes de banda en los valles L y G para Ge 0.65- xb Si 0.35 Sn xb , Ge 0,72 Sn 0,28 y Ge en función de x b
La deformación en planta en la capa bidimensional de material GeSiSn varía entre 0,6% ( x b =6%) y - 1,7% ( x b =22%). Suponemos que esta capa permanece pseudomeórfica tensa permitiendo mantener la estructura diseñada experimentalmente realizable. El GeSn se elige para ser tensado por compresión dentro del material circundante de GeSiSn con un desajuste de celosía que varía de - 2,3 a - 4,5%, lo que garantiza condiciones favorables para la formación de GeSn QD autoorganizado.
La figura 1b muestra la dependencia de la banda prohibida tensionada en los puntos L y Γ de Ge 0,72 Sn 0,28 y Ge (0.65- xb ) Si 0.35 Sn xb en función de x b . El Γ valle de Ge 0,72 Sn 0,28 el material permanece por debajo de los valles L, lo que demuestra su tipo I para toda la gama investigada de composición de barrera de estaño. Mientras tanto, cuando se tiene en cuenta el confinamiento de electrones, la banda prohibida efectiva aumenta y el efecto de tamaño de QD se vuelve decisivo [18], especialmente para QD muy tenso. De hecho, en presencia de confinamiento cuántico, la energía del estado fundamental debe considerarse en lugar del mínimo de la banda Γ. En consecuencia, se espera que los QD de menor tamaño tengan niveles de energía confinados más altos en el valle Γ que pueden exceder el valle L (y / o el nivel de energía de los electrones en el estado fundamental en el valle L). Por lo tanto, es importante investigar el rango del tamaño de QD que obedece a los criterios específicos de franqueza.
La estructura modelada se presenta esquemáticamente en la Fig. 2. El Ge 0.72 Sn 0,28 Se considera que QD tiene forma de cúpula con una base circular de diámetro D que van de 15 a 40 nm y una relación de altura fija a diámetro igual a 0,25. El QD se coloca dentro de una capa de GeSiSn de 15 nm de espesor que tiene una composición de Si del 35% y una composición de Sn sintonizable. Se supone que esta estructura se forma sobre un sustrato tamponado con Ge y se cubre con una capa de Ge.
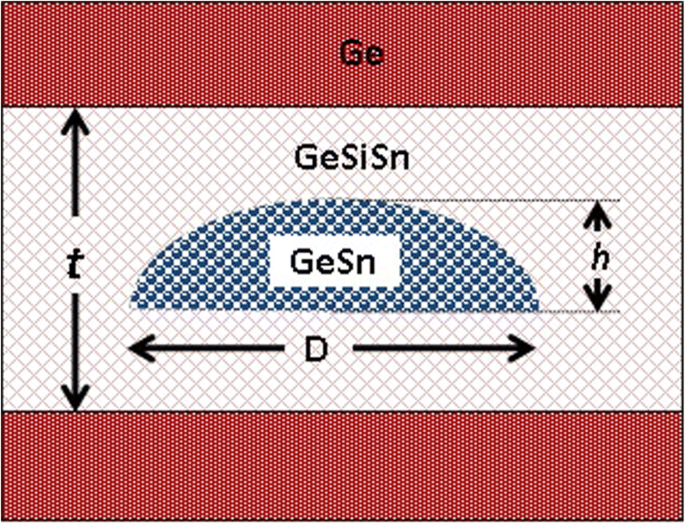
Presentación esquemática del GeSn QD modelado de altura ( h ) y diámetro ( D ) dentro de la capa reductora de tensión GeSiSn en matriz Ge
Para asegurar un diseño QD consistente para un mejor funcionamiento del dispositivo emisor de luz, se ha introducido un parámetro de direccionamiento adecuado que tiene en cuenta el espacio de energía entre la posición del nivel de energía confinado QD más bajo en los valles L y G [18]. Este parámetro se denota con GS L -GS Γ y debe ser superior a la energía térmica a temperatura ambiente para evitar la pérdida de los portadores por activación térmica, donde GS L (GS Γ ) representa el nivel de energía del estado fundamental del electrón en el valle L (Γ valle) con respecto al máximo de la banda de valencia. La evaluación de GS L -GS Γ se ilustra esquemáticamente en el recuadro de la Fig. 3.
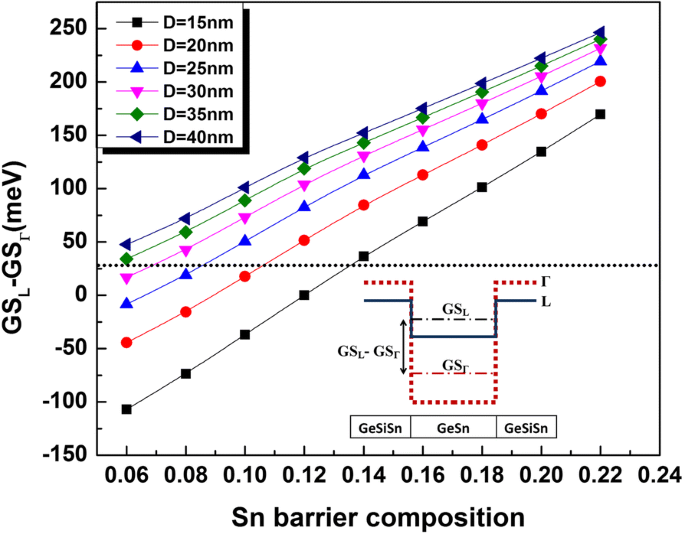
Parámetro de franqueza (GS L -GS Γ ) variación en función de la Ge 0.72 Sn 0,28 Tamaño de QD y composición de Sn de Ge 0.65- x Si 0.35 Sn x capa circundante. La línea de puntos indica la energía térmica a temperatura ambiente. El recuadro representa una definición esquemática del parámetro de franqueza
El cálculo de los niveles de energía de los electrones GeSn QD en Γ y L valles para diferentes diámetros en función de la composición de Sn en GeSiSn permite obtener el correspondiente parámetro de directividad (GS L -GS Γ ). Los resultados se representan en la Fig. 3. Para un x dado b , el valor de GS L -GS Γ se rige principalmente por el tamaño QD. Por consiguiente, los puntos más pequeños que tienen estados de energía confinada obviamente más altos requieren una energía de banda prohibida más baja a través de la reducción de la deformación para cumplir los criterios de franqueza. Como se muestra en la Fig.3, los puntos más grandes ( D > 25 nm) satisfacen GS L -GS Γ > 26 meV para x b superior al 8%. Sin embargo, se ha comprobado que la banda prohibida directa eficiente de QD de tamaño pequeño está garantizada para valores más altos de x b ( x b ≥ 14% para D =15 nm).
Dentro de los parámetros adoptados en este trabajo, y especialmente los parámetros de arco de los materiales binarios, el aumento del contenido de Sn del material GeSiSn reduce la mancha alrededor del QD y reduce también la banda prohibida del material circundante. De hecho, como se muestra en la Fig. 1b, el aumento de x b de 6 a 22% reduce la discontinuidad de la banda de conducción en Γ valle de 0,72 eV a 0,23 eV. De hecho, como se muestra en la Fig.4, donde la función de onda cuadrada \ ({\ left | \ uppsi \ left (\ overrightarrow {r} \ right) \ right |} ^ 2 \) del electrón en estado fundamental en puntos cuánticos de El diámetro de 35 nm se muestra en el plan xy para la composición de barrera de Sn de 6% y 22%, los electrones se encuentran completamente localizados dentro del QD independientemente de la composición de barrera (discontinuidad de la banda de conducción). Los electrones fuertemente confinados indican una mayor confiabilidad del QD investigado como medio activo para los emisores de luz en el sustrato de Si.

Función de onda de estado fundamental de electrones cuadrados para Ge 0,72 de 35 nm de diámetro Sn 0,28 QD para a Xb =6% y b Xb =22%
Limitando los tamaños de QD para una x determinada b para aquellos que generan una emisión de banda prohibida directa eficiente, hemos evaluado la longitud de onda de emisión interbanda del estado fundamental QD. Los resultados se muestran en la Fig.5, donde la longitud de onda de emisión se representa frente a x b para diferentes tamaños QD. Vale la pena señalar que el tamaño de QD más grande considerado en este trabajo ( D =40 nm) ha mostrado una pequeña separación de energía entre el estado fundamental del electrón y el primer estado excitado (por debajo de 26 meV) y, por lo tanto, se ha ignorado en este estudio. No obstante, la longitud de onda de emisión evaluada en función de x b se ha mantenido en la Fig. 5 con una línea de puntos.
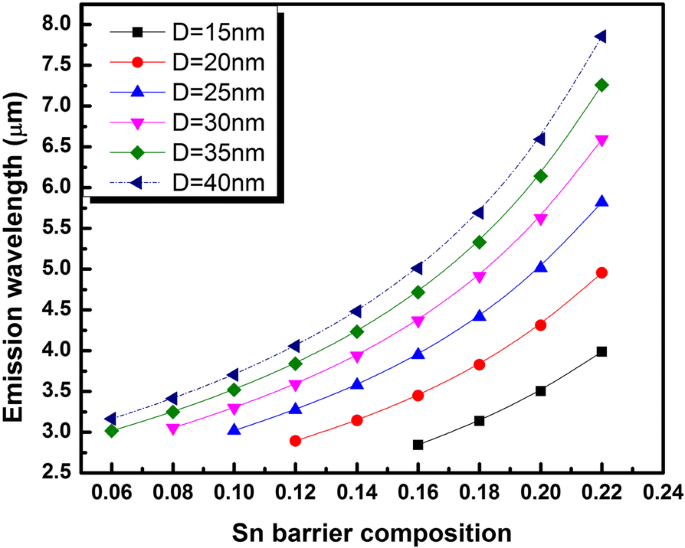
Longitud de onda de emisión en estado fundamental a temperatura ambiente de banda prohibida directa Ge 0,72 Sn 0,28 QD en función del tamaño y la composición de Sn de Ge 0.65- xb Si 0.35 Sn xb capa circundante
El rango de longitud de onda proyectado para ser cubierto por el diseño QD propuesto varía de 3 a 7 μm. El rango obtenido es extremadamente importante para la aplicación de detección de gas. La implementación experimental de esta estructura podría ofrecer la oportunidad de cubrir, por primera vez, todo el rango de IR medio con un material totalmente compatible con la tecnología microelectrónica existente, allanando el camino hacia nuevas perspectivas en optoelectrónica de IR medio basada en QD compatible con CMOS.
Conclusiones
GeSn QD en la capa de ingeniería de deformación GeSiSn en la matriz Ge se ha investigado como una función del tamaño de QD y el desajuste de la red con el material circundante. Se ha descubierto que la reducción de la tensión alrededor del GeSn QD variando la composición de Sn del material de barrera GeSiSn mejora la longitud de onda de emisión de banda prohibida directa de tipo I de 3 a 7 μm. La estructura diseñada abre nuevas perspectivas en el emisor de luz de infrarrojos medios totalmente compatible con la tecnología Si.
Abreviaturas
- CMOS:
-
Semiconductor de óxido de metal complementario
- GS L :
-
Nivel de electrones del estado fundamental en el valle L
- GS Γ :
-
Nivel de electrones del estado fundamental en Γ valle
- QD:
-
Puntos cuánticos
Nanomateriales
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- El diseño de la capa de emisión para multiplicadores de electrones
- Síntesis de puntos cuánticos de tipo II / tipo I de ZnSe / CdS / ZnS con supresión de reabsorción y su aplicación para el ensayo inmunoabsorbente
- Síntesis de puntos cuánticos de carbono codopados N, S ricos en piridínicos como imitadores enzimáticos eficaces
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- Un enfoque simple para sintetizar puntos cuánticos de carbono fluorescente de aguas residuales de tofu
- Síntesis de puntos cuánticos de sulfuro de antimonio solubles en agua y sus propiedades fotoeléctricas
- Diseño para la fabricación de PCB
- Consejos de diseño para la impresión 3D de sinterización directa de metal por láser



