Estudio sobre la memoria de conmutación de resistencia multinivel y el fotovoltaje dependiente del estado de la memoria en uniones Pt / Nd:SrTiO3
Resumen
Pt / Nd:SrTiO 3 Los dispositivos (STO) / In se fabricaron depositando electrodos de Pt de contacto Schottky y de In de contacto óhmico en un STO monocristalino con dopaje con Nd. Los dispositivos Pt / Nd:STO / In muestran la memoria de conmutación de resistencia (RS) multinivel y efectos de fotovoltaje (PV) dependientes del estado de la memoria, que se pueden controlar mediante la amplitud o magnitud del pulso aplicado. Tanto el RS como el PV están relacionados con la modulación inducida por polarización de la barrera de la interfaz, tanto en altura como en ancho, en la interfaz Pt / Nd:STO. Los resultados establecen una fuerte conexión entre los efectos RS / PV y la modulación de la interfaz Nd:STO activada por el campo eléctrico aplicado y proporcionan una nueva ruta mediante el uso de un voltaje de circuito abierto para detectar de forma no destructiva múltiples estados de memoria no volátiles.
Antecedentes
SrTiO 3 (STO) es un aislante de banda prohibida grande (3,2 eV). Se considera un material de perovskita modelo debido a su estructura cúbica simple en un amplio rango de temperatura [1]. STO tiene un rendimiento fotoeléctrico abundante que puede manipularse directamente mediante el dopaje con un metal de transición de tipo donante o aceptor. La gama de aplicaciones del sistema STO es muy amplia [2, 3]. Recientemente, el sistema STO ha recibido mucha atención científica debido a los fenómenos de conmutación resistiva (RS), que puede considerarse un buen candidato para construir la memoria resistiva de acceso aleatorio (RRAM) [4, 5].
El dispositivo RS basado en STO suele ser una estructura de metal / STO / metal. Se han investigado ampliamente las propiedades RS del sistema STO, es decir, desde STO dopado con aceptor hasta con donante. Se han propuesto diferentes mecanismos físicos para explicar el comportamiento de conmutación. Para STO dopado con aceptor (p. Ej., Fe y Cr), los trabajos enfatizan el cambio de propiedad en el volumen del cristal, en el que el RS se atribuyó a la migración de la vacante de oxígeno impulsada por el campo eléctrico, ya sea el transporte rápido de las vacantes de oxígeno a lo largo de las dislocaciones o la formación de una matriz de oxígeno-vacante bajo un alto estrés eléctrico [6,7,8,9,10,11]. Por otro lado, para el dispositivo RS basado en STO dopado con donante (por ejemplo, Nb), el contacto de tipo Schottky entre el metal y el Nb:STO de tipo n es necesario y se enfatiza en muchos trabajos. Sin embargo, algunos informes han relacionado RS con cambios de la capa de agotamiento de electrones en las uniones metal / Nb:STO, que es causada por la estequiometría del oxígeno dentro de una capa interfacial delgada [12,13,14] o por una desviación de la estequiometría catiónica nominal. en la región cercana a la superficie [15, 16] y algunos informes sugieren que la barrera interfacial se mantiene sin cambios durante el proceso de RS, pero los filamentos conductores juegan un papel vital para el cambio de resistencia [17,18,19].
En vista de los puntos informados anteriormente, es obvio que no ha habido consenso sobre el mecanismo de cambio de STO de tipo donante. Hasta ahora coexisten dos vistas de la interfaz y el cambio de resistencia a granel. En cuanto a las razones específicas de la RS, todavía hay muchos mecanismos físicos informados. El mecanismo físico poco claro se interpone en el camino del progreso de RRAM basado en material STO. Para aclarar el mecanismo RS y desarrollar un dispositivo RRAM basado en el sistema STO tipo donante, es una ventaja estudiar diferentes materiales STO dopados con metal.
Las propiedades de transporte electrónico de STO se pueden modular mediante dopaje con metal de transición [20]. En comparación con las películas delgadas, los monocristales tienen propiedades homogéneas en toda el área y defectos físicos y químicos bien establecidos. Hasta ahora, solo hemos encontrado monocristales STO dopados con donantes con elemento Nb informado para dispositivos RS. Para los monocristales STO dopados con Nd (Nd:STO), el radio iónico de Sr 2+ , Ti 4+ y Nd 3+ (Nd 2+ ) es 0,118, 0,0605 y 0,0983 (0,129) nm, respectivamente, lo que sugiere que Nd 3+ podría sustituir fácilmente a Sr 2+ en lugar de Ti 4+ debido a un radio similar entre Nd 3+ y Sr 2+ [21]. Este sitio de sustitución es diferente del Nb de tipo n:STO. Por lo tanto, el monocristal de Nd:STO es un material dopado por un donante y con una conductividad de tipo n, que será certificada por el efecto Hall más adelante. Nd:STO monocristalino es un nuevo STO de tipo n para RS, y hasta ahora no encontramos los trabajos informados.
En general, se sabe que el efecto fotovoltaico (PV) está relacionado con el campo eléctrico interno [22,23,24,25,26]. Por lo tanto, se espera que el efecto PV dependa de los estados de la memoria si el RS está determinado principalmente por la capa de agotamiento cerca del metal y la interfaz STO de tipo n. Por el contrario, el PV es irrelevante para los estados de memoria si el RS es inducido por los filamentos conductores. En este trabajo, fabricamos electrodos Schottky-contact Pt y Ohmic-contact In en monocristales Nd:STO de tipo n. La memoria RS y el efecto PV se estudiaron juntos para aclarar el mecanismo de conmutación del dispositivo Pt / Nd:STO / In. Curiosamente, los resultados muestran claramente que el dispositivo Pt / Nd:STO / In tiene memoria multinivel y efecto PV controlado por estado de memoria, que puede ser modulado por el sesgo de conmutación. Los resultados sugieren que el mecanismo compartido para RS y PV se relaciona con la modulación de la barrera de la interfaz Pt / Nd:STO, que son inducidas por la inyección y atrapamiento o desencadenamiento de portadores.
Métodos
Monocristales Nd:STO (100) de tamaño 5 mm × 5 mm × Se seleccionaron como sustrato 0,5 mm con impurificación de Nd al 0,05% en peso. Los electrodos In (electrodos naranjas) se presionaron directamente sobre la superficie rugosa de Nd:STO para formar los contactos óhmicos. Los electrodos de Pt con un diámetro de 0,1 mm se pulverizaron sobre el monocristal de Nd:STO a través de una máscara de sombra (electrodos azules). La distancia entre dos electrodos de Pt cercanos fue de 0,5 mm. El recuadro de la Fig. 2a muestra la configuración de los dispositivos Pt / Nd:STO / In e In / Nd:STO / In. Las características de corriente-voltaje (I – V) y RS se midieron en un SourceMeter Keithley 2400. Un campo eléctrico positivo se define como la corriente que fluye desde el electrodo In al Pt.
El efecto Hall se llevó a cabo utilizando el sistema de medición Ecopia HMS-3000 Hall para investigar la concentración de portador inducida por el dopaje con Nd. La estructura cristalina de la STO se examinó mediante difracción de rayos X (XRD, Bruker, D8-Advance) usando radiación Cu Kα. Las mediciones de la dispersión Raman se llevaron a cabo en un espectrómetro confocal micro-Raman (Renishaw R-1000) con luz láser visible de longitud de onda de 632,8 nm como fuente de excitación.
Resultados y discusión
La Figura 1a muestra los patrones XRD de monocristales STO y Nd:STO sin dopar. Todos los picos corresponden a la fase de perovskita y pueden indexarse al grupo espacial cúbico Pm3m con constante de red a ≈ 3.905 Å. Los picos no muestran ningún cambio observable después de la implantación de Nd, lo que indica que el dopaje con Nd tiene poco efecto sobre la estructura general. Los espectros Raman de los monocristales STO y Nd:STO sin dopar se dan en la Fig. 1b. Los espectros Raman de STO sin dopar muestran dos bandas anchas distintas que se originan en la dispersión de segundo orden, que están centradas en 200–400 cm −1 y 600–800 cm −1 y pertenece a la estructura cúbica ideal de perovskita. La posición de estas dos bandas está de acuerdo con la literatura publicada [27, 28]. También se observa la línea ampliada con una disminución de la banda ancha de segundo orden en Nd:STO, lo que indica una centrosimetría más débil como resultado del trastorno local inducido por el dopaje con Nd. En comparación con los patrones de XRD, los resultados de Raman indican que existen algunos defectos estructurales en la superficie del monocristal de Nd:STO, que deberían ser inducidos por el dopaje con Nd.

un Los patrones XRD y b Espectros Raman de STO sin dopar y monocristal de STO dopado con Nd
En general, se sabe que el monocristal STO sin dopar es un material aislante. Para investigar el impacto del dopaje con Nd en las propiedades eléctricas del monocristal STO, se midió el efecto Hall. Los resultados de Hall muestran que el monocristal de Nd:STO tiene una conductividad de tipo n, y la concentración de portador es de aproximadamente 2 × 10 19 cm −1 . Esta conductividad de tipo n se puede atribuir a la sustitución de Nd 3+ en Sr 2+ sitios.
El recuadro de la Fig. 2a muestra la ilustración esquemática de los dispositivos In / Nd:STO / In y Pt / Nd:STO / In. El yo - V Las características de los dispositivos In / Nd:STO / In y Pt / Nd:STO / In se representan en la Fig. 2a, b, respectivamente. El voltaje de barrido se aplicó como 0 V → 5 V → 0 V → - 5 V → 0 V con una corriente de cumplimiento de 50 mA. El dispositivo In / Nd:STO / In tiene I lineal - V curvas (mostradas en la Fig.2a) y exhibe un buen contacto óhmico entre los electrodos In presionados y el monocristal Nd:STO, pero no aparece ningún efecto RS, mientras que el dispositivo Pt / Nd:STO / In muestra propiedades RS reversibles, como se muestra en Figura 2b. Cuando el voltaje aplicado aumenta, ocurre la transición de resistencia, la dirección de la transición depende de la polaridad del voltaje aplicado. Cuando el voltaje aplicado disminuye, el estado de alta y baja resistencia (HRS y LRS) se mantendrá, lo que indica que el estado de resistencia es estable y no volátil después de la formación. El gran I - V la histéresis muestra que el dispositivo Pt / Nd:STO / In tiene las propiedades de memoria; El comportamiento del diodo prototípico indica que se forma una barrera Schottky en la interfaz Pt y Nd:STO de tipo n y domina la resistencia del dispositivo Pt / Nd:STO / In. Por lo tanto, es fácil concluir que el efecto RS del dispositivo Pt / Nd:STO / In proviene de la interfaz Schottky entre los monocristales de Pt y Nd:STO. Este resultado, RS depende de la interfaz Schottky, está de acuerdo con nuestros trabajos informados sobre el monocristal Nb:STO de tipo n [29].

El yo - V características de a el In / Nd:STO / In y b Pt / Nd:dispositivos STO / In en el rango de voltaje de 0 V → 5 V → 0 V → - 5 V → 0 V con corriente de cumplimiento de 50 mA. El recuadro muestra la ilustración esquemática del dispositivo
Para evaluar el potencial de aplicación del dispositivo Pt / Nd:STO / In en memoria múltiple, se investigó el efecto del ancho y la amplitud del pulso en los estados de resistencia y se muestra en la Fig. 3a-c. El dispositivo se configuró primero en LRS mediante un pulso de - 5 V con un ancho de 100 ms y luego se aplicó mediante un pulso de + 5 V con anchos de pulso variados de 100 ns, 10 μs y 10 ms, respectivamente. La resistencia se leyó a 0,1 V. Se logró la transición de resistencia correspondiente de LRS a estados de resistencia intermedia o HRS, como se muestra en la Fig. 3a. La Figura 3b muestra los ciclos consecutivos de RS de HRS a LRS inducidos por los pulsos de polaridad opuesta. Los resultados confirman que la resistencia multinivel se puede obtener mediante voltaje de pulso con diferentes anchos. La propiedad de retención de cada estado de resistencia se investigó más a fondo y no se observó ningún cambio significativo en las magnitudes de resistencia (que se muestra en el archivo adicional 1:Figura S1). La Figura 3c presenta bucles de memoria resistiva no volátil típicos controlados por voltaje de pulsos. El dispositivo Pt / Nd:STO / In se configuró primero en LRS mediante un pulso de - 3 V, seguido de un barrido del voltaje del pulso a + 2 V (o + 3, + 4 y + 5 V) y de regreso a - 3 V con ancho de pulso de 100 ms. La resistencia se leyó a 0,1 V. Se puede lograr una serie de estados de resistencia intermedios ajustando la magnitud del pulso. De la Fig. 3a-c, tenemos el resultado de que el estado de resistencia multinivel del dispositivo Pt / Nd:STO / In se puede lograr ajustando el ancho o la magnitud del pulso, lo que indica que el dispositivo se comporta como un memristor [23, 30 ].

Ciclos consecutivos de RS a de LRS a HRS y b de HRS a LRS. El dispositivo se configuró primero en LRS (HRS) mediante un pulso de - 5 V (+ 5 V) con un ancho de 100 ms y luego se aplicó mediante un pulso de + 5 V (- 5 V) con anchos de pulso variados de 100 ns, 10 μs, y 10 ms, respectivamente. La correspondiente transición de resistencia de LRS (HRS) a estados de resistencia intermedia o HRS (LRS). c R - V Bucles de histéresis controlados por voltaje de pulso. El dispositivo Pt / Nd:STO / In se configuró primero en LRS mediante un pulso de - 3 V, seguido de un barrido del pulso a + 2 V (o + 3, + 4 y + 5 V) y de nuevo a - 3 V con ancho de pulso de 100 ms. Toda la resistencia se leyó a 0,1 V
En general, se sabe que la fotoexcitación de los portadores de carga se produce cuando la longitud de onda iluminada coincide con la banda prohibida óptica del material activo. Los electrones y huecos generados serán separados por el campo eléctrico interno, lo que conduce al efecto PV [23, 24, 25]. En el caso del dispositivo Pt / Nd:STO / In, si los estados de memoria multinivel están determinados principalmente por la capa de agotamiento cerca de la interfaz Pt / Nd:STO, se espera que el efecto PV dependa de los estados de memoria del dispositivo. Por el contrario, el PV es irrelevante para los estados de la memoria si la capa de agotamiento se mantiene sin cambios durante el proceso de RS. Más interesante aún, encontramos un efecto PV dependiente del estado de la memoria para el dispositivo Pt / Nd:STO / In. La figura 4a, b muestra la I - V curvas en el régimen de baja polarización (- 0,6 a + 0,6 V) después de cambiar con una serie de pulsos de + 1 a + 5 V con 100 ms (cambiar de LRS a estados de resistencia intermedia y a HRS) bajo iluminación clara y oscuridad , respectivamente. Bajo iluminación ligera, el I - V Las curvas de HRS exhiben cambios notables a lo largo del eje de voltaje, y el voltaje de circuito abierto (Voc) (voltaje a corriente cero) es tan alto como ~ 135 mV. En correspondencia con una serie de estados de resistencia intermedios, el Voc disminuye gradualmente con la disminución de la resistencia del dispositivo y es insignificante para LRS. Mientras que se ha observado un pequeño cambio para I - V curvas medidas en la oscuridad. El resultado similar fue obtenido por Hu et al. [23]. Además, Shang et al. [24, 25, 26]. De acuerdo con este método, el Voc se midió adicionalmente en LRS y HRS. Como era de esperar, la iluminación de la luz produce un aumento de voltaje y el Voc depende de la resistencia de la unión (consulte el archivo adicional 1:Figura S2). Los resultados anteriores atestiguan que la magnitud de Voc depende de los estados de memoria del dispositivo Pt / Nd:STO / In.
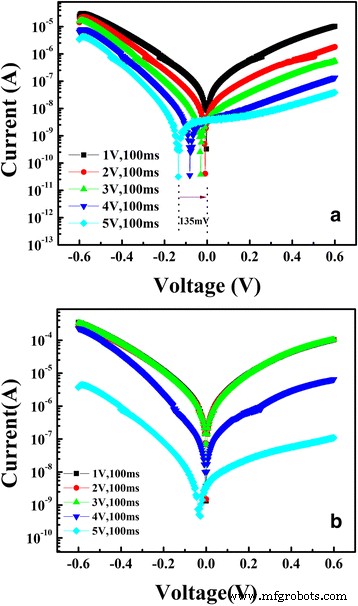
El yo - V curvas en el régimen de baja polarización (- 0,6 a + 0,6 V) después de conmutar con una serie de pulsos de tensión de + 1 a + 5 V con 100 ms (conmutación de LRS a estados de resistencia intermedia y a HRS) bajo a la iluminación luminosa y b oscuro, respectivamente
La memoria multinivel y el efecto PV dependiente del estado de la memoria del dispositivo Pt / Nd:STO / In sugieren inequívocamente que los estados de la memoria están determinados principalmente por la capa de agotamiento cerca de la interfaz Pt / Nd:STO. En otras palabras, el ancho y la altura de la barrera Schottky cerca de la interfaz Pt / Nd:STO serán modulados por voltaje de barrido. De acuerdo con los resultados de Raman en la Fig. 1b, existen algunos defectos (por ejemplo, vacantes de oxígeno) en la superficie Nd:STO. Cuando se aplicó un voltaje o pulso negativo al dispositivo, los electrones inyectados del electrodo In quedaron atrapados por los defectos en la interfaz Pt / Nd:STO. Los electrones atrapados conducen a una barrera de Schottky más estrecha y más baja, lo que resulta en LRS. Por el contrario, durante el próximo barrido de polarización positiva, los electrones atrapados se liberan debido a la existencia de la región de agotamiento, lo que resulta en HRS. Además, la distribución espacial de los defectos debería ser desigual. Se pueden formar clavos de Fermi en el defecto de alta densidad, por lo que HRS y LRS se pueden mantener cuando se elimina el sesgo aplicado. La capa de agotamiento se puede ajustar por el ancho o la magnitud del pulso, por lo que se observaron estados de memoria de varios niveles. La Figura 5 muestra el diagrama esquemático del proceso de captura o eliminación de trampas de electrones en la interfaz Pt / Nd:STO.
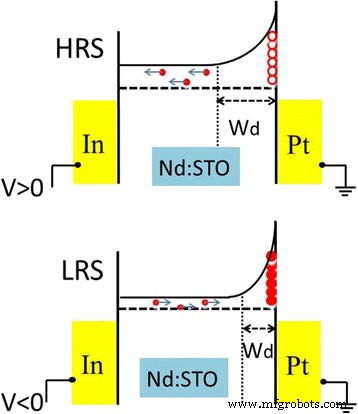
Diagrama esquemático de la estructura de la banda de energía y el estado de la interfaz del sistema Pt / NSTO / In en HRS y LRS. Las esferas rojas huecas y sólidas en la interfaz representan el estado de la interfaz desocupada y ocupada, respectivamente
El efecto PV dependiente del estado de la memoria es inducido por diferentes anchuras y alturas de la barrera de la interfaz Pt / Nd:STO en diferentes estados de memoria. El HRS con una región de agotamiento más amplia da como resultado más pares de agujeros de electrones generados en la región de agotamiento bajo iluminación de luz. Los electrones fotogenerados son impulsados hacia el volumen de Nd:STO por la fuerte flexión de la banda hacia arriba en el HRS, y los agujeros hacen un túnel a través de la barrera, lo que resulta en un Voc más alto. Por el contrario, el LRS con una región de agotamiento más baja y más estrecha da como resultado un Voc más bajo. En general, el Voc depende del ancho y alto de la barrera de la interfaz que corresponde a los estados de memoria multinivel del dispositivo Pt / Nd:STO / In.
Tenga en cuenta que tanto los estados de memoria como el efecto PV muestran una dependencia similar en el sesgo de conmutación, lo que indica el mecanismo compartido relacionado con el agotamiento / acumulación de electrones en la interfaz Nd:STO, lo que revela la importancia de la barrera de la interfaz y la redistribución de la carga de la interfaz (Fig. 5). El efecto PV es inducido por los electrones fotogenerados y los huecos separados por el campo eléctrico interno. Entonces, el efecto PV dependiente del estado de memoria observado en el dispositivo Pt / Nd:STO / In testifica que el RS es inducido por la modulación inducida por sesgo de la barrera Schottky en la interfaz Pt / Nd:STO y no por la formación de filamentos conductores. El Voc depende de los estados de memoria, por lo que dicho efecto PV dependiente del estado de resistencia proporciona una nueva ruta mediante el uso de Voc para detectar los estados de memoria del dispositivo RS además de la lectura de resistencia convencional [23]. Esta nueva ruta de lectura no es destructiva y confiable porque la iluminación ligera no cambiará el estado de la memoria de los dispositivos.
Conclusiones
En resumen, hemos investigado las características de RS y PV de dispositivos memristivos monocristalinos basados en Nd:STO. El efecto RS está relacionado con la unión Schottky cerca de la interfaz del monocristal de Pt y Nd:STO de tipo n. Los estados de la memoria se pueden modular por el ancho o la magnitud del pulso. El efecto PV dependiente del estado de memoria del dispositivo Pt / Nd:STO / In se obtiene mediante la tensión de conmutación. Estos efectos complementarios se atribuyen a la modulación inducida por sesgo de la barrera de la interfaz, tanto en altura como en ancho, en la interfaz Pt / Nd:STO, que es causada por la inyección de portadora y el proceso de captura / eliminación en la interfaz Pt / Nd:STO. . Los resultados establecen una fuerte conexión entre los efectos RS / PV y la modulación de la interfaz Nd:STO activada por el campo eléctrico aplicado y proporcionan una nueva ruta mediante el uso de Voc para detectar de forma no destructiva múltiples estados de memoria no volátiles.
Abreviaturas
- HRS:
-
Estado de alta resistencia
- I - V :
-
Corriente-voltaje
- LRS:
-
Estado de baja resistencia
- PV:
-
Fotovoltaje
- RRAM:
-
Memorias de acceso aleatorio de resistencia
- RS:
-
Cambio de resistencia
- XRD:
-
Difracción de rayos X
Nanomateriales
- El estudio de un nuevo sistema micelar similar a un gusano mejorado con nanopartículas
- Estudio de los primeros principios sobre la estabilidad y la imagen STM del borofeno
- Estudio experimental sobre las características de flujo y transferencia de calor de nanofluidos de agua-TiO2 en un tubo estriado en espiral
- Un estudio colectivo sobre modelado y simulación de memoria resistiva de acceso aleatorio
- Diseño y ajuste de la función de trabajo del grafeno mediante tamaño, modificación, defectos y dopaje:un estudio de teoría del primer principio
- Prueba de las propiedades estructurales, electrónicas y magnéticas de Ag n V (n =1–12) Clusters
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Dependencias de temperatura y presión de las propiedades elásticas de los cristales individuales de tantalio bajo una carga de tracción <100>:un estudio de dinámica molecular
- Estudio comparativo de las propiedades electroquímicas, biomédicas y térmicas de nanomateriales naturales y sintéticos
- Fabricación y propiedad fotocatalítica de nuevos nanocompuestos SrTiO3 / Bi5O7I
- Nuevo estudio:impacto del COVID-19 en el futuro del trabajo y la automatización



