Estudio de resolución atómica EDX, HAADF y EELS de aleaciones GaAs1-xBix
Resumen
La distribución de átomos aleados en semiconductores a menudo se desvía de una distribución aleatoria que puede tener efectos significativos sobre las propiedades de los materiales. En este estudio, se emplean técnicas de microscopía electrónica de transmisión de barrido para analizar la distribución de Bi en varios GaAs 1 − x claramente desarrollados con MBE Bi x aleaciones. La cuantificación estadística de imágenes HAADF de resolución atómica, así como simulaciones numéricas, se emplean para interpretar el contraste de columnas que contienen Bi en la interfaz GaAs-GaAsBi atómicamente abrupta (001) y el inicio del orden de tipo CuPt. Utilizando el mapeo EELS monocromático, se examinan los desplazamientos al rojo de la energía del plasmón en masa en una muestra que presenta dominios separados en fases. Esto sugiere un método simple para investigar las expansiones de volumen de celdas unitarias locales de GaAsBi y para complementar las mediciones de deformación reticular basadas en rayos X estándar. Además, una muestra de GaAsBi ordenada por CuPt de una sola variante cultivada en un sustrato de corte se caracteriza con mapeos EDX de composición a escala atómica, y se estima el parámetro de orden. Finalmente, una aleación de GaAsBi con una modulación de composición Bi vertical se sintetiza utilizando una baja tasa de rotación del sustrato. Atómicamente, la formación de imágenes EDX y HAADF resueltas muestra que el orden habitual de tipo CuPt se modula además a lo largo del eje de crecimiento con un período de tres constantes de red. Estas distintas muestras de GaAsBi ejemplifican la variedad de distribuciones de Bi que se pueden lograr en esta aleación, arrojando luz sobre los mecanismos de incorporación de los átomos de Bi y las formas de desarrollar aún más los semiconductores III-V que contienen Bi.
Introducción
El bismido GaAs 1 − x Bi x La aleación ha experimentado una gran cantidad de investigación y representa la clase emergente de semiconductores del grupo III-V que contienen bismuto [1]. El bismuto es el elemento estable y no tóxico más grande, que tras la incorporación produce una gran reducción de la banda prohibida de GaAs. La sustitución de Bi en la subred del grupo V permite lograr un arco de banda prohibida de hasta 90 meV / Bi% en GaAsBi con una deformación reticular moderada [1, 2, 3]. Una gran división de la banda de la órbita de espín es otro efecto notable de la incorporación de Bi en la red. Esto puede permitir suprimir la absorción de la banda de intervalencia y la recombinación Auger-Meitner en GaAs 1 − x Bi x con concentraciones x > 10% [4]. En combinación con la sensibilidad reducida de la banda prohibida, estas propiedades hacen que el bismido sea un candidato atractivo para aplicaciones en láseres infrarrojos de onda larga, fotodetectores y células solares multifuncionales, entre otros [1, 5, 6, 7].
La incorporación de Bi en la matriz de GaAs requiere condiciones de crecimiento no convencionales, ya que los átomos de Bi tienden a desorberse a temperaturas típicas de crecimiento de GaAs [8, 9, 10]. Normalmente se necesitan temperaturas del sustrato por debajo de 400 ° C, así como relaciones casi estequiométricas del grupo III / V. Se debe tener cuidado para evitar la formación de gotas superficiales de Ga o Bi que pueden ocurrir fácilmente cerca de estas condiciones y están asociadas con faltas de uniformidad en el espesor de la capa de crecimiento y su composición [11,12,13,14]. Las bajas temperaturas necesarias para incorporar concentraciones más grandes de Bi hacen que la epitaxia de haz molecular (MBE) sea el método preferido de síntesis, aunque se han realizado avances utilizando la epitaxia en fase de vapor orgánico metálico [15,16,17]. Las aleaciones de GaAsBi todavía muestran una intensidad de fotoluminiscencia (PL) sorprendentemente alta para estas bajas temperaturas de crecimiento, lo que se atribuye al efecto del tensioactivo Bi y la densidad reducida de los defectos puntuales relacionados con el As que se forman típicamente en los GaAs a baja temperatura [18, 19]. En la imagen del anti-cruce de la banda de valencia (VB), los átomos Bi individuales incorporados producen un estado resonante por debajo del VB de GaAs extendido, lo que provoca la reducción de la banda prohibida óptica [2, 20, 21]. Los cálculos de los primeros principios también demuestran que las agrupaciones compuestas por átomos Bi cercanos que interactúan pueden producir un estrechamiento de la banda prohibida significativamente mayor que por los átomos Bi aislados [22]. Estas diferentes configuraciones de Bi producen fuertes perturbaciones de VB y pueden introducir estados de defectos electrónicos localizados. Los estudios sugieren que la cepa de celosía producida por grandes átomos de Bi hará que sea más probable que los grupos se unan a las vacantes V Ga y V Como [23]. Las condiciones de crecimiento ricas en ácido deberían favorecer la formación de Bi Ga Defectos heteroantisitios que se prevé que causen trampas de agujeros profundos en GaAsBi [23, 24]. Los efectos de localización de excitones pronunciados se observan comúnmente en PL dependientes de la temperatura de las aleaciones de GaAsBi y se atribuyen a tales grupos relacionados con Bi y complejos de defectos [25, 26].
Como muchas otras aleaciones de semiconductores ternarios III-V, GaAsBi muestra la tendencia al ordenamiento espontáneo [27]. El llamado CuPt B El ordenamiento de tipo B, mediante el cual la concentración de átomos Bi se modula en cada segundo plano {111} de tipo B, se ha observado utilizando microscopía electrónica de transmisión de alta resolución (barrido) (STEM / TEM) [13, 17, 28]. Está ampliamente aceptado que el CuPt B -La modulación de tipo en las aleaciones III-V está impulsada por la dinámica de reconstrucción de la superficie y está acompañada por la reconstrucción (2 × 1) que consta de filas de dímeros de superficie [27, 29, 30, 31, 32, 33]. Cuando se deposita sobre sustratos planos de GaAs (001), el orden se produce en dos de los cuatro conjuntos distintos de planos {111}. Una sola subvariante de ordenación de tipo B se puede seleccionar adicionalmente utilizando sustratos vecinales. De hecho, un trabajo reciente mostró que esto también se aplica a GaAsBi, por lo que los grandes CuPt B -se han logrado dominios de tipo en un solo conjunto de planos {111} B utilizando obleas de corte de ángulo bajo [34]. El orden de tipo CuPt en GaInP 2 es probablemente el más estudiado, ya que en esta aleación se pueden lograr cristales de alta calidad con un parámetro de orden grande. El orden de largo alcance cambia la simetría del grupo de puntos de mezcla de zinc de tetraédrico T d a trigonal C 3v [35, 36] . Los efectos notables debidos a la reducción de la simetría incluyen el estrechamiento de la banda prohibida, la polarización de la fotoluminiscencia, la birrefringencia y la tensión anisotrópica [37,38,39]. La magnitud de estos efectos depende del parámetro de orden de largo alcance, η , que muestra el grado de distribución elemental entre planos de celosía ordenados. En un CuPt B -ordenó AB 1 − x C x aleación (para x <=0.5), el enrejado se alterna en AB rico en elementos B 1− ( x − η / 2) C x − η / 2 y AB rico en C 1- ( x + η / 2) C x + η / 2 monocapas a lo largo de una dirección <111> B. El parámetro de orden η =0 en una aleación aleatoria mientras que en una completamente ordenada con concentración x es así η =2 x .
Claramente, la distribución de Bi dentro de tales aleaciones ordenadas difiere de una aleación aleatoria, y esto debe tenerse en cuenta al deducir más las propiedades de la aleación [17, 40]. La comprensión de los efectos de ordenación de CuPt en las aleaciones de GaAsBi diluidas aún se encuentra en las primeras etapas, lo que requiere estudios más sistemáticos. En este artículo, se emplean métodos STEM avanzados con corrección de aberraciones para analizar los modos de distribución de Bi en varias aleaciones de GaAsBi cultivadas de forma distinta. El análisis se realiza mediante procesamiento estadístico de imágenes STEM Z-contrast y simulaciones de imágenes, así como espectroscopía dispersiva de energía de rayos X de resolución atómica (EDX). La espectroscopia de pérdida de energía de electrones monocromáticos (EELS) se emplea para investigar los cambios de volumen de células unitarias locales en GaAsBi utilizando cambios de energía de plasmón en masa.
Resultados y discusión
Los primeros GaAs 1 − x Bi x La muestra que se presenta aquí, S1, es un hetero-diodo p-i-n con capas de GaAs dopadas y bismuro intrínseco de 420 nm. Se determinó que la concentración de bismuto en la muestra era 4,5% de Bi usando difracción de rayos X (no mostrada aquí) y temperatura ambiente PL, lo que indica una banda prohibida de 1,10 eV (SI Fig. S1). Las medidas del borde de la banda PL se traducen a Bi% utilizando las referencias [1, 2, 4]. En la Fig. 1a se muestra una imagen STEM HAADF de resolución atómica en sección transversal a lo largo del eje de la zona [110] cerca de la interfaz GaAs-GaAsBi. El eje de crecimiento y otras direcciones cristalográficas relevantes están marcadas en la Fig. 1b y también se aplican a la Fig. 1a. Dado que los átomos de Bi pesados dispersan los electrones de la sonda a ángulos altos mucho más fuertes que los átomos de Ga o As, el detector HAADF con un ángulo de recolección interno grande (90 mrad aquí) resalta favorablemente la distribución de Bi en muestras delgadas. El cristal visto a lo largo de una dirección <110> aparece como una colección de "mancuernas" atómicas, que están orientadas paralelas al eje de crecimiento [001]. Debido a sus números atómicos similares (Z), Ga (31) y As (33) no se pueden distinguir fácilmente con la mera inspección de las imágenes HAADF. Sin embargo, las columnas del grupo V que contienen Bi muestran un contraste notablemente mayor. Como se puede ver en la Fig. 1a y en la región ampliada cerca de la interfaz, las columnas del grupo V se colocan en la mitad superior de las pesas por encima de las columnas Ga. Esto es de esperar cuando se obtienen imágenes de GaAsBi a lo largo del eje de la zona [110]. Tenga en cuenta que la polaridad de las mancuernas del grupo V / III se invierte cuando la muestra se ve a lo largo de la dirección ortogonal [\ (\ overline {1} \) 10]. Estas direcciones ortogonales en el plano también se pueden distinguir ya que la ordenación de tipo CuPt se produce en los planos de tipo {111} B y, por lo tanto, solo se pueden ver mediante la formación de imágenes a lo largo del eje de la zona [110]. La Figura 1b muestra una imagen HAADF de menor aumento más profunda dentro de la película con CuPt B pronunciado -tipo de pedido. Se ve que los dominios ordenados se alternan aleatoriamente entre los dos conjuntos de {111} planos B, es decir, (\ (\ overline {1} \) 11) y (1 \ (\ overline {1} \) 1). Estos se denominan B + y B - subvariantes por convención. La transformada de Fourier de la imagen se muestra en el recuadro superior izquierdo. Los cuatro puntos de Bragg principales son de tipo [111] *, mientras que los cuatro puntos de superrejilla de tipo 1/2 [111] * indican CuPt B ordenar con magnitud similar en los dos conjuntos de planos {111} B. Una región de GaAsBi separada en fases es visible en la Fig. 1b como una franja más oscura en la parte inferior de la imagen. Este dominio parece más oscuro que un bismido ya que es similar a GaAs deficiente en Bi. Debido a la metaestabilidad de las aleaciones de GaAsBi, en muchos artículos se ha informado de una descomposición espinodal y separación de fases [11, 12, 13, 14, 41, 42]. Para una descripción más clara de B + y B - ordenamiento subvariante, Figs. 1c, d se presentan formando imágenes usando 1/2 [111] * pares de reflexión de superrejilla. Se aplica una máscara a cada par de superredes en el espacio recíproco y se transforma Fourier inverso al espacio real. Las regiones más brillantes de los planos (111) en estas imágenes indican que el orden es más pronunciado, o en otras palabras, que el parámetro de orden varía localmente. También hay variaciones en el espesor de la superficie de la muestra TEM debido a la preparación de la muestra mediante un haz de iones enfocado. La preparación de la muestra puede dejar capas superficiales amorfas y aglomerados atómicos de Ga fundidos en la superficie, lo que puede provocar modulaciones débiles de la intensidad de la imagen. Sin embargo, Ga se dispersa mucho más débil a los ángulos altos que los átomos de Bi y no debería influir significativamente en el análisis de la distribución de Bi. La flecha en la Fig. 1d muestra una región con orden de límites anti-fase. Al otro lado de ese límite, el B + (B - ) El dominio cambia su fase al cambiar todos los planos ricos en Bi en planos ricos en As. El orden de los límites de anti-fase puede formarse por deslizamiento de dislocaciones o debido a una alternancia aleatoria entre B + y B - dominios durante el crecimiento [43]. Este último parece ser el caso aquí.
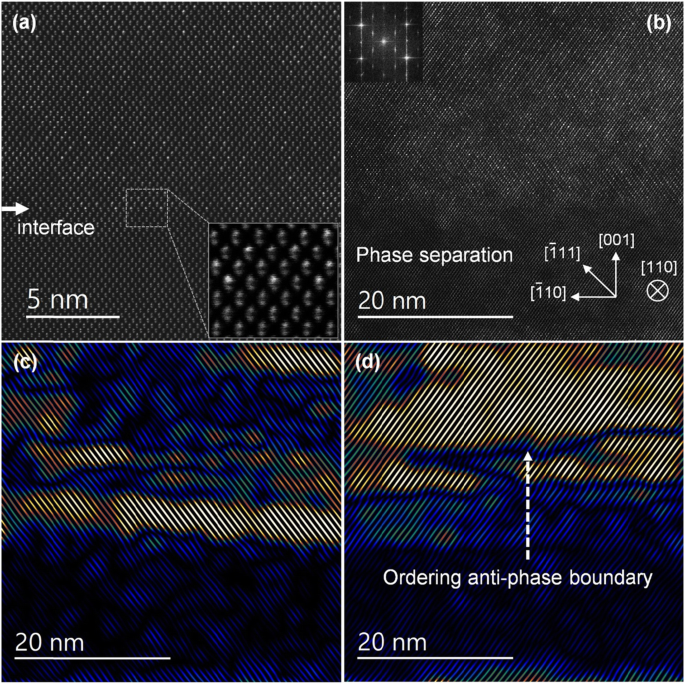
un Imagen HAADF de sección transversal del área de interfaz S1 GaAs-GaAsBi de muestra. Un recuadro ampliado de la interfaz se muestra en la parte inferior derecha. Las direcciones cristalográficas son las mismas que en la Fig. 1b. b Imagen HAADF de la muestra fuera de la interfaz. En el medio se ve un dominio similar a GaAs separado en fases espontáneamente alargado. El recuadro muestra la transformada de Fourier de la imagen. c Una imagen formada por ( b ) usando el 1/2 [\ (\ overline {1} \) 11] * par de reflejos de superrejilla. Los colores más brillantes indican un orden más pronunciado. d Una imagen formada por ( b ) usando el par de ½ [1 \ (\ overline {1} \) 1] * reflejos
La cuantificación de la imagen HAADF mostrada en la Fig. 1a se lleva a cabo a continuación considerando distribuciones espaciales de secciones transversales de dispersión de columna atómica (SCS) (ver Métodos). El algoritmo StatSTEM se utiliza para ajustar columnas con gaussianos bidimensionales, y el SCS de una columna dada se define como volumen bajo ese gaussiano [44, 45]. Se trata de una cuantificación basada en modelos paramétricos, en contraposición a la integración directa de intensidades de columna en una imagen experimental. El enfoque del modelo paramétrico puede ser más confiable si las intensidades de las columnas tienden a superponerse, como en <110> GaAsBi. La distribución de SCS en la figura 1a cuantificada se traza como un histograma en la figura 2b, que se ajusta provisionalmente con cinco gaussianos. Las distribuciones espaciales de SCS se trazan luego en la Fig. 2a en la estructura del modelo compuesta por una superposición de gaussianos usando los mismos cuadrados de esquema de color colocados en cada columna. Las columnas SCS de Ga y As se superponen fuertemente y producen el pico principal en el histograma. Esto se debe a los números Z similares de estos átomos, así como al ensanchamiento adicional introducido experimentalmente (ver Métodos). Al trazar el componente gaussiano inferior (color azul oscuro) o el superior (azul más claro) dentro de este pico principal, se muestra que ~ 60% de, por ejemplo, las columnas de As en la capa de amortiguación de GaAs se identifican correctamente, como se puede inspeccionar desde la polaridad de la mancuerna . A modo de comparación, la cuantificación SCS de la capa tampón de GaAs inferior sola se presenta en la Fig. Suplementaria S2. Sugiere que actualmente se necesitan más de dos gaussianos para distinguir mejor las columnas Ga y As en el campo de visión e indica que su SCS medio difiere hasta en un 10%. Esta diferencia concuerda con nuestras simulaciones que se muestran a continuación y también con los resultados encontrados en Beyer et al. [17], donde se resolvieron las distribuciones de intensidad de columna integradas de Ga y As en [010] GaAsBi. La presencia de átomos de Bi fuertemente dispersos extiende el SCS a valores por encima de ~ 5,5 × 10 5 e - Å 2 (ver SI Fig. S2), que da lugar al hombro derecho en la Fig. 2b. Está equipado con tres gaussianos para distinguir tentativamente las columnas con mayor contenido de Bi. La interfaz GaAs-GaAsBi atómicamente abrupta se puede ver en la Fig. 2a. Una inspección más detallada muestra que la primera capa de columnas del grupo V (001) que contiene un número significativo de átomos de Bi está dispuesta en cada segunda mancuerna a lo largo de la interfaz. Esto sugiere la aparición de un orden de tipo CuPt temprano en el crecimiento epitaxial. En el recuadro de la figura 2b se muestra una descripción de la configuración atómica de la interfaz. Recrea la disposición de los átomos a lo largo de la interfaz con los átomos Bi (naranja) en cada segunda columna a lo largo del primer plano del grupo V (001). Los primeros ~ 4-5 (001) planos atómicos en la Fig. 2a no muestran predisposición para CuPt B + o B - subvariantes. Un orden de variante único más pronunciado surge de la capa atómica ~ sexto (001) grupo-V y luego cambia a la otra subvariante. Sin defectos antisitio Bi Ga están indicados por la distribución SCS en la interfaz, que serían visibles como cuadrados en las columnas del grupo III con colores asociados con Bi. Probabilidad de varios Bi Ga antisites, sin embargo, se encuentra en la esquina superior derecha de la figura. Las columnas del grupo III y del grupo V muestran SCS tipo Bi en pesas individuales en esa región, lo que también puede indicar la presencia de pares de defectos Bi Ga -Bi Como . Para tener una mejor idea del número de átomos de Bi involucrados en la determinación del SCS, observe que en una muestra de espesor nominal de 20-25 nm hay 50-60 átomos en una columna <110>. Por lo tanto, es más probable que se encuentren de 2 a 3 átomos de Bi en una columna del grupo V para una aleación aleatoria con actualmente 4.5% de Bi. Este número será mayor en planos ricos en Bi ordenados, probablemente llegando hasta 6-7 en columnas con el SCS más grande [40]. Para complementar el análisis StatSTEM, a continuación se presenta la simulación de imágenes HAADF multicorte en un modelo de estructura de supercélula GaAsBi <110> (consulte Métodos para obtener más detalles).

un Una distribución de SCS en la Fig. 1a. Los cuadrados de colores en cada columna atómica están de acuerdo con el esquema de color SCS en la Fig. 2b. b Un histograma de SCS en la Fig. 1a, equipado con 5 gaussianos. El recuadro muestra una descripción de la región de la interfaz. Las columnas atómicas Ga están en azul oscuro, As — en azul más claro, y las columnas que contienen Bi están en naranja. c Imagen HAADF simulada de la estructura GaAsBi que se muestra en la Fig. 2d. El número de átomos de Bi en una columna se muestra entre paréntesis en naranja a la derecha de cada columna del grupo V. Los valores de SCS ajustados se muestran a la izquierda de cada columna y están normalizados al valor de SCS más grande en la supercélula. d La estructura del modelo GaAsBi <110> giró hacia los lados para resaltar las posiciones Bi (naranja), los átomos azul claro-As, azul oscuro-Ga. La flecha muestra la dirección del haz incidente
La contribución a la intensidad de la imagen HAADF de los átomos de Bi a diferentes profundidades de muestra puede ser no lineal debido a lo que se denomina en general canalización [46,47,48,49]. La cuantificación de dopantes a escala atómica, por lo tanto, requiere consideración al distinguir la verdadera variación en la composición de la variación en las configuraciones de dopantes [50, 51]. Para ilustrar el comportamiento de canalización, la variación de la intensidad de la sonda promedio con la profundidad de la muestra cuando se coloca sobre la columna As en <110> GaAs se simula numéricamente y se muestra en la Fig. S3 complementaria (ver Métodos). La estructura modelo GaAsBi de 17 nm de grosor utilizada para las simulaciones HAADF se muestra en la Fig. 2d rotada lateralmente para resaltar las posiciones de los átomos Bi (naranja) dentro de las columnas As (As — azul claro, Ga — azul oscuro). La flecha marca la dirección del haz incidente. La imagen simulada que se muestra en la Fig. 2c se ajusta utilizando el algoritmo StatSTEM para comparar con el experimento. Los valores de SCS obtenidos se normalizaron al valor de SCS de la columna con el SCS más grande (6 átomos de Bi) y se redondearon a dos dígitos significativos. Estos valores normalizados se muestran a la izquierda de cada columna. El número de átomos de Bi en cada columna del grupo V se muestra entre paréntesis a la derecha de la columna. En un acuerdo razonable con los hallazgos anteriores, la diferencia entre los valores de As y Ga SCS se encuentra en ~ 8%. La diferencia en SCS entre la columna de As puro y las columnas de As que contienen un átomo de Bi se encuentra en un rango de 2 a 4% para los átomos de Bi en posiciones diferentes. Uno puede ver claramente que diferentes configuraciones de Bi pueden malinterpretarse para diferentes composiciones, por ejemplo, 4 y 5 átomos o 5 y 6 átomos, que dan casi los mismos valores de SCS. Los átomos bi en una columna hacia la superficie inferior contribuyen cada vez menos al SCS. Varias configuraciones que tienen 2 átomos de Bi una tras otra examinadas aquí parecen producir grandes contribuciones a los valores de SCS. Se puede esperar encontrar una configuración de 2 átomos Bi a lo largo de una columna [110] en la práctica si el CuPt B ordenar en aleaciones GaAsBi de hecho produce unidades estructurales con C 3v simetría de grupo de puntos, es decir, un átomo de Ga con vecinos más cercanos 1 As y 3 átomos Bi. Tenga en cuenta que las columnas de Ga idénticas también muestran una variación en su SCS de hasta ~ 0,02. Esto sugiere que su entorno inmediato, por ejemplo, las columnas cercanas con fuerte dispersión, contribuye a una intensidad adicional debido a la dispersión múltiple o al acoplarlos a través de colas de sonda extendidas [52]. Los algoritmos de escalado mejorados recientemente introducidos abren la posibilidad de acelerar los cálculos de múltiples cortes de la mecánica cuántica y, por lo tanto, de explorar los efectos antes mencionados con más detalle [53, 54].
Para concluir el análisis STEM de la muestra S1, se utiliza espectroscopia de pérdida de energía de electrones (EELS) para mapear las energías de plasmón a granel. Los cambios de energía del plasmón estarán relacionados con los cambios de volumen de la celda unitaria y, por lo tanto, con la deformación de la aleación, como se analiza a continuación. GaAs exhibe un pico de plasmón principal a ~ 16 eV y, a diferencia de, por ejemplo, CdTe, no muestra características de interferencia complejas de las transiciones entre bandas [55]. Como primera aproximación para interpretar los cambios de energía del plasmón medidos, empleamos el modelo de Drude-Lorenz para el gas de electrones libres, donde los electrones libres son ahora los electrones de valencia en el semiconductor [56]. La energía de plasmón en masa en este modelo se da como \ ({E} _p =\ hslash {\ left (N {e} ^ 2 / Vm {\ epsilon} _0 \ right)} ^ {1/2} \), donde N es el número de electrones de valencia en la celda unitaria, e es la carga del electrón, V es el volumen de la celda unitaria, m es la masa del electrón, y ε 0 es la permitividad del espacio libre. El modelo simple de Drude-Lorenz generalmente predice la energía del plasmón dentro de un pequeño porcentaje en semiconductores y debe corregirse por los efectos de la estructura de bandas si se busca una mejor coincidencia [56]. Como se muestra en InGaAs y aleaciones de semiconductores de nitruro del grupo III, el cambio en el volumen de la celda unitaria es la principal cantidad que determina los cambios de energía del plasmón [57, 58]. De manera similar, la sustitución de átomos de Bi isoelectrónicos en la matriz de GaAs actúa principalmente para expandir el volumen de la celda unitaria, V , y así desplazar al rojo la energía del plasmón. A continuación, empleamos las energías máximas medidas de GaAs y GaAsBi para inferir el cambio de estado de deformación local en la capa de GaAsBi a través de una proporción de sus volúmenes de celda unitaria.
Se selecciona una región que contiene dominios GaAsBi separados en fase mostrados en la imagen HAADF Fig. 3. Se recogieron espectros EELS de cada píxel que acompaña a la imagen HAADF adquirida simultáneamente (ver Métodos y SI Fig. S4 para espectro sin procesar). Las líneas discontinuas en la imagen HAADF indican las interfaces entre el GaAsBi intrínseco y las capas de GaAs tipo p (abajo) y tipo n (arriba). Las líneas de demarcación de la interfaz se determinaron a partir de imágenes STEM de menor aumento (no se muestran aquí). La capa protectora de Pt es visible como el material de mayor contraste por encima de los n-GaAs superiores. Las capas de GaAs y también los dominios separados por fases dentro de GaAsBi aparecen más oscuros en la imagen HAADF. El perfil de la línea vertical en la figura de EELS del lado derecho se adquirió agrupando todos los puntos de datos de EELS horizontalmente. Muestra el cambio de energía máxima de plasmón en masa relativa, E GaAsBi -E GaAs , como se hace referencia a la energía del plasmón GaAs (medida en 16,23 eV) dentro de la capa tampón p-GaAs inferior. Se ve que el pico del plasmón cambia en promedio 0.08 eV a energías más bajas en la capa de GaAsBi. Las pequeñas variaciones dentro de ~ 0.01 eV se encuentran en los niveles de ruido de cuantificación. Los dominios de fase separada cerca de la parte superior de GaAs (capa delgada) y la parte inferior (dos dominios que se cruzan) regresan al valor de energía del plasmón de GaAs, lo que sugiere que contienen concentraciones de Bi insignificantes. Concentraciones de dopantes en las capas de GaAs (orden 10 17 cm −3 ) son insignificantes en comparación con N / V y no debe afectar la energía del plasmón. Ahora consideramos dos casos límite para los GaAs 1 − x Bi x volumen de celda unitaria V ; uno donde la celosía está completamente relajada y otro donde está completamente tenso al sustrato de GaAs. En el caso completamente relajado, la celda unitaria es cúbica con constante de celosía a ≈ 5.684 Å en x =4,5% de Bi [1]. Usando la relación de raíz cuadrada anterior entre la energía del plasmón y V , el cambio de energía relativo a GaAs debe ser \ (\ Delta {E} _p ^ {GaAs Bi} =16.23 \ left ({\ left ({V} _ {GaAs} / {V} _ {GaAs Bi} \ right) } ^ {1/2} -1 \ right) =- 0.132 \ mathrm {eV} \), que es claramente más grande que el medido. Con base en las tendencias de relajación de las aleaciones de GaAsBi, estimamos que ~ 30% de la celosía se relaja en esta película de 420 nm de espesor, considerando que también experimentó un recocido térmico corto mientras crecía la capa superior de n-GaAs. Por lo tanto, la celda unitaria promedio de GaAsBi se sobrestimará en el escenario completamente relajado y explica el \ (\ Delta {E} _p ^ {GaAsBi} \) más grande obtenido anteriormente. En el otro límite, se considera que la celosía de bismido está completamente deformada con la constante de celosía en el plano igual a la de GaAs ( a =5,653 Å). La constante de celosía fuera del plano requerida para recuperar el desplazamiento de energía de - 0.080 eV se encuentra entonces a z =5.709 Å. Esta es una a sensata z valor y se puede comparar con las mediciones XRD-RSM de GaAsBi tensado por compresión al sustrato de GaAs [1, 34, 59]. Debido a la relajación, se espera que las constantes de celosía reales se encuentren entre estos dos casos límite. Esto demuestra un método de caracterización prometedor que puede proporcionar información sobre la deformación reticular complementaria a las técnicas basadas en rayos X en tales aleaciones metaestables.

Imagen HAADF de sección transversal (izquierda) de la muestra p-i-n S1, con capas de GaAs y GaAsBi marcadas. Las regiones más oscuras dentro de GaAsBi son dominios separados por fases. El perfil de la línea (derecha) muestra el cambio de energía máxima del plasmón en masa de EELS, E GaAsBi - E GaAs , en relación con la capa tampón de GaAs. El perfil está estrechamente alineado con la imagen HAADF adquirida simultáneamente a la izquierda. Los píxeles de datos de EELS están completamente agrupados en la dirección horizontal y, por lo tanto, indican valores promediados espacialmente. La barra de escala es de 100 nm y también se aplica al eje vertical del perfil EELS
La segunda muestra de GaAsBi, S2, se hizo crecer sobre una capa tampón de GaAs que se depositó sobre un sustrato de Ge sobrante (ver Métodos). La heteroepitaxia de Ge-GaAsBi se analizó en nuestro trabajo anterior, que también demostró CuPt B de una sola variante de dominio grande pedidos en GaAsBi [34]. En este trabajo se presentan datos adicionales que se utilizan para completar la discusión sobre el ordenamiento bi atómico. La concentración total de bismuto en esta muestra es ~ 5.8% medida por PL (SI Fig. S1) [34]. El corte combinado con la capa tampón de GaAs empleada en esta epitaxia ayuda a evitar la formación de dominios antifase en GaAsBi, que todavía son difíciles de eliminar cuando se cultivan directamente en Ge no polar [60,61,62]. La Figura 4a muestra el área de la interfaz GaAs-GaAsBi con la capa GaAsBi visiblemente más brillante en la imagen HAADF. A diferencia de la película anterior de GaAsBi depositada sobre un sustrato plano de GaAs, aquí, un solo CuPt B La subvariante de ordenación se selecciona debido al recorte. Esto se puede ver en la imagen HAADF, y su transformada de Fourier insertada en la parte superior derecha que muestra un par de puntos de superrejilla 1/2 [\ (\ overline {1} \) 11] *. La figura 4b se formó aplicando una máscara al par de reflejos de superrejilla, análoga a la figura 1c, d. Muestra un ordenamiento mucho más uniforme y de gran dominio en la película. Se adquirieron imágenes EDX de resolución atómica de esta muestra para estimar el parámetro de orden η basado en el análisis composicional. El mapeo químico EDX a menudo sobresale sobre la cuantificación EELS de pérdida de núcleo alternativa, que tiende a tener una peor relación señal / ruido cuando se cuantifican los bordes de ionización retardada y de alta energía [56, 63,64,65]. La dirección de exploración STEM se cambió para alinear los planos ordenados (\ (\ overline {1} \) 11) horizontalmente. La Figura 4c-e muestra los mapas elementales de rayos X filtrados por Wiener. El orden de los átomos de Bi en cada segundo plano (\ (\ overline {1} \) 11) es claro y sigue Como posiciones atómicas. Para la cuantificación de la composición de EDX, se adquirieron dos conjuntos de datos con 512 × 512 píxeles cada uno de diferentes áreas de la muestra utilizando condiciones experimentales idénticas. Se alinearon las subregiones y se sumaron las señales sin procesar, lo que resultó en un total de 10 fotogramas. En la Fig. 4f se muestra un perfil de línea vertical de datos brutos sumados horizontalmente de As-K y Bi-M. Para cuantificar la composición de bismuto en los planos Bi-rich y Bi-deficiente (111), se utilizó una ventana de integración de 3 Å de ancho, centrada en los planos atómicos. Después de restar el fondo y promediar todos los planos (111), muestra que los recuentos de rayos X Bi son ~ 3 veces más altos en los planos ricos en Bi. La concentración total de 5,8% de Bi en la muestra, obtenida por las mediciones de PL y XRD-RSM, se utiliza para escalar linealmente los recuentos de rayos X de Bi a la composición, lo que muestra que Bi alcanza hasta el 9% en los planos Bi-rich. Por tanto, el parámetro de orden puede estimarse (ver Introducción) como η =0,07. Tenga en cuenta que un bismido completamente ordenado con esta concentración total de Bi tendría el parámetro de orden η =0,116. De manera similar al análisis HAADF, la cuantificación EDX de columnas individuales sufre efectos de canalización ya que el potencial de ionización de los electrones centrales está muy localizado. Como lo muestran otros autores en Al x Ga 1-x Como aleación, esto puede resultar en una desviación estándar del conteo de rayos X de hasta ~ 5% debido a diferentes configuraciones de dopantes [50]. Teniendo en cuenta la desviación, los recuentos de rayos X todavía se escalan linealmente con varios dopantes en muestras no demasiado gruesas. El error de configuración en el presente estudio se minimiza al promediar efectivamente más de ~ 11 columnas atómicas en cada (111) plano, para un total de ~ 130 columnas. Además, las colas de las sondas de electrones y la dispersión múltiple pueden producir una deslocalización de la señal en las imágenes EDX [52]. Las simulaciones de imágenes HAADF en la sección anterior que muestran la variación de los valores de Ga SCS sugieren la magnitud esperada de estos efectos en la cuantificación EDX. El ruido de disparo parece ser actualmente el principal factor limitante de precisión debido a los recuentos de rayos X bi inherentemente bajos en tales aleaciones diluidas.

un Imagen HAADF de la muestra S2 de GaAsBi cerca de la interfaz con la capa tampón de GaAs, cultivada en el recorte (001) Ge. La transformada de Fourier en la parte superior derecha muestra un par de picos que indican el orden en el conjunto único de planos (\ (\ overline {1} \) 11). b Una imagen formada por ( a ) usando el par de superredes 1/2 [\ (\ overline {1} \) 11] * Manchas de Bragg. c - e Wiener filtró imágenes EDX de la muestra de GaAsBi, con emisiones de rayos X Bi-M, As-K y Ga-K como se indica. Tenga en cuenta que en los datos EDX, las direcciones cristalográficas se rotan para alinear los planos ordenados (\ (\ overline {1} \) 11) horizontalmente. f Perfil de recuentos de rayos X verticales sumados horizontalmente de la señal As-K y Bi-M sin procesar. Se combinan dos conjuntos de datos alineados para obtener el perfil
The final GaAsBi sample, S3, that we wish to explore here was synthesized under conditions to create so-called vertical composition modulations (VCM) (see Methods) [66]. In contrast to samples S1 and S2, the VCM is achieved in S3 by utilizing a slower substrate rotation rate (RPM), which is coupled to intrinsically inhomogeneous elemental flux profiles reaching the substrate in a typical MBE chamber. The III/V elemental ratio within a sample region can be oscillated by controlling the RPM and the film growth rate to obtain the desired VCM period. A vertical spiral in regards to Bi concentration can be obtained in GaAsBi this way, as has been well explained in M.A. Stevens et al. [66]. A cross-sectional HAADF image of the GaAsBi sample S3 is shown in Fig. 5a, grown on a (001) GaAs substrate rotated 5 RPM and 300 nm/h growth rate. Total bismuth composition in the sample area under investigation was determined to be 2.8% Bi using room-temperature PL (SI Fig. S1). The VCM is visible with a well-defined superlattice-like appearance. The tendency to CuPtB order is also visible in this image, and here it incurs the additional vertical modulation. The inset on the top right shows Fourier transform of the image with arrows marking the pair of stripes, which result from Bi content modulation along the [\( \overline{1} \)10] direction on every second plane and accordingly reduced extent of (111)-type ordered planes along [001].

un HAADF image of the VCM GaAsBi sample S3. Bi concentration modulations along the growth [001] direction are visible, as well as CuPtB ordering within the Bi-enriched planes. Inset shows Fourier transform with reminiscent CuPtB ordering modulated by the VCM. b A combined Wiener filtered elemental EDX image of the sample with normalized X-ray counts for each element, Bi-green, As-Blue, and Ga-red. c Vertical X-ray count profile extracted from 3 × 3 binned raw As-K and Bi-M signals, horizontally summed within a 5 nm window
The sample was also investigated using atomic scale elemental EDX mapping. Figure 5b shows overlaid normalized and color-coded X-ray signals of Bi-M (green), As-K (blue), and Ga-K (red). The corresponding elemental Wiener filtered maps are shown in SI Fig. S5. The peak-to-peak distance between Bi-rich regions is 1.7 nm, which indicates the VCM period is ~ 3 lattice constants. The peak positions do not align on a single Bi-rich (001) plane. This offset reflects that Bi atoms with higher concentrations are dispersed over 2–3 group-V (001) atomic planes, which is clearer in the HAADF image (Fig. 5a). Figure 5c shows 4 VCM periods by plotting vertical Bi-M and As-K line profiles of horizontally summed counts in a 5 nm wide window from the 3 × 3 binned raw EDX data. Despite the signal noise, As-K X-ray count profile seems to inversely follow the Bi-M profile showing small dips at Bi-enriched regions. Such a correlation between substitutional element and the host element X-ray signals may be exploited in future atomic scale EDX analysis of dilute alloys.
Conclusions
Three different bulk GaAsBi samples regarding Bi distribution modes were investigated in this study using STEM techniques. The quantification of scattering cross sections was applied to a GaAs-GaAsBi hetero-diode grown on conventional (001) GaAs, showing atomically abrupt interface and early CuPtB -type ordering onset. Numerical multislice image simulations within the frozen-phonon thermal scattering approximation were used to investigate GaAsBi HAADF images. It showed that due to channeling, the configurational Bi variations can translate into apparent compositional variations. To carry out column-by-column Bi atom counting would thus require numerical image analysis. EDX mapping was presented of a single-variant ordered dilute GaAsBi sample grown on an offcut substrate. To avoid the configurational errors in elemental EDX quantification, the X-ray signals were averaged over many columns in (111) atomic planes, and the order parameter was estimated to be η =0.07 in this sample. The atomic-resolution HAADF and EDX were also used to analyze a VCM GaAsBi film synthesized using a slow substrate rotation rate. This sample showed Bi content modulation in the [001] axis with a period of three lattice constants in addition to the CuPtB ordenar. Finally, bulk plasmon energy mapping using monochromated EELS was performed on a GaAs-GaAsBi hetero-diode. As the plasmon energy shift in dilute GaAsBi is related to the unit-cell volume changes, this provides a simple method to complement XRD-based techniques to examine local strain-state in GaAsBi alloys.
Methods
Three different samples were examined in this study, samples S1, S2, and S3, all grown by solid-source MBE. The first sample, S1, is a GaAsBi p-i-n heterojunction, with an intrinsic 420-nm GaAsBi layer containing ~ 4.5 Bi%, as evaluated by XRD (not shown here) and room-temperature PL (SI Fig. S1). The n-type and p-type GaAs layers are 100 nm and 80 nm thick, respectively, and were doped to 5 × 10 17 cm −3 concentrations using Si and Be, respectively. The sample was grown on an n-type (001) GaAs substrate using SVT-A MBE reactor equipped with metallic Ga and Bi sources and a two-zone valved arsenic cracker. The GaAs layers were deposited using a 330-nm/h growth rate at 600 ° C substrate temperature, supplying arsenic overpressure. GaAsBi layer was grown using a 100 nm/h rate, 10 revolutions per minute (RPM) substrate rotation, 360 ° C (thermocouple readings), As/Ga BEP around 1.08, Bi flux ~ 10 −7 Torr. The (2 × 1) surface reconstructions were seen using RHEED during GaAsBi deposition. The second sample, S2, consisted of 280 nm thick GaAsBi with 1.0 eV band gap and~ 5.8 Bi%, as measured by PL (SI Fig. S1) and XRD [34]. This sample was grown over a ~ 300 nm GaAs buffer layer which was deposited on a p -type (001) Ge substrate with 6° offcut towards <110>. The first 50 nm of the buffer was deposited by migration-enhanced epitaxy. The remaining 300 nm of GaAs buffer was synthesized at 600 °C. GaAsBi film was grown at 350 °C, with BEP ratio of As to Ga in the range 1.063 to 1.1, and Bi/Ga ratio 0.35–0.37. The substrate was rotated 15 at RPM. The third and final sample, S3, was grown using the Veeco GENxplor MBE chamber, with the same type of sources and the arsenic cracker as in the SVT-A reactor. The sample consists of 500 nm GaAsBi with ~ 2.8% Bi, as measured by PL (SI Fig. 1) and XRD (not shown here). The layer was grown at 310 °C (band edge absorption measurement, kSA Bandit), on top of 80 nm GaAs buffer layer grown at 580 °C. The growth rate of the bismide was 0.5 monolayers/s, As/Ga BEP ratio ~ 1.35, and Bi flux ~ 8 × 10-8 Torr. The substrate was rotated at 5 RPM.
Transmission electron microscopy samples were prepared in a cross-sectional geometry by the focused ion beam (FIB) lift-out technique using FEI Helios Nanolab 650 dual-beam microscope. The samples were polished to 20–25 nm thickness, as measured by the EELS Log-ratio method, and argon-oxygen plasma-cleaned or degassed before loading into a microscope. HAADF imaging was carried out using cold-field emission double aberration-corrected JEOL JEM-ARM200CF operated at 200 kV [67]. The inner collection semi-angle of the HAADF detector was set to 90 mrad, with 22 mrad probe convergence semi-angle. The HAADF image analysis was carried out using StatSTEM add-on for Matlab [44]. Single width 2D Gaussian functions were fitted to the atomic columns after background subtraction. HAADF image simulation was performed using the muSTEM software using 15 frozen-phonon configurations, transmission functions with 0.02 Å square pixel size, and supercell size ~ 20 × 15 Å [68, 69]. The above experimental STEM probe parameters were used with defocus C1 =0, C3 =0.002 mm, and C5 =1 mm spherical aberration coefficients, and a fully coherent electron probe. Kirkland multislice code was used to calculate the average of electron probe intensity versus sample depth, averaged over 10 frozen-phonon configurations [68]. The intensity average is taken across the atomic column in a 1 Å wide window. X-ray energy dispersive spectroscopy was performed using 0.98 steradian solid-angle windowless silicon drift-detector JEOL JED-2300. The probe current was set to 200 pA for EDX characterization and pixel dwell time 0.2 msec. The EDX images were 512 × 512 pixels in size, and a total of 5 frames were accumulated for each data set. Wiener filtering was applied to both EDX images for visualization, and sample drift-correction was used on Fig. 5 EDX data. On-axis electron energy-loss spectrum imaging was carried out using a modified monochromated Nion Hermes-200 (ChromaTEM) operated at 100 kV. The probe convergence semi-angle was set to 10 mrad, EELS collection semi-angle 35 mrad, 0.02 eV EELS energy dispersion, and 0.005 s EELS exposure time. The FWHM of the ZLP with beam positioned on the sample was measured to be 0.11 eV. Gatan DM 3.01 image analysis software was employed post-acquisition to center and removes the ZLP. The spectrum image was binned vertically by a factor of 4 and fully binned in the horizontal direction. Cross-correlation-based “Align SI by peak” algorithm was employed within the Gatan DM 3.01 software to determine plasmon peak shifts. Room-temperature PL measurements were carried out using a 420-mm focal length monochromator along with thermoelectrically cooled InGaAs photodetector. Diode-pumped solid-state laser emitting at the wavelength of 532 nm with an estimated power density of 5 kW/cm 2 was used as an excitation source.
Disponibilidad de datos y materiales
The datasets used and/or analyzed during the current study are available from the corresponding author on reasonable request.
Abreviaturas
- BEP:
-
Beam equivalent pressure ratio
- EELS:
-
Electron energy-loss spectroscopy
- FFT:
-
Fast Fourier transform
- HAADF:
-
High-angle annular dark-field
- MBE:
-
Epitaxia de haz molecular
- PL:
-
Fotoluminiscencia
- STEM:
-
Scanning transmission electron microscopy
- SCS:
-
Scattering cross-section
- VCM:
-
Vertical composition modulations
- EDX:
-
X-ray energy dispersive spectroscopy
Nanomateriales
- Aplicación del molibdeno y sus aleaciones
- 4 usos del hafnio | Aplicaciones del hafnio y las aleaciones de hafnio
- Aplicaciones de molibdeno y aleaciones de molibdeno
- Aplicación de tungsteno y aleaciones de tungsteno
- Propiedades y aplicaciones de las aleaciones de cobre-níquel
- Una guía para el cobre confiable y sus aleaciones
- Tipos y características:Aleaciones de aluminio y bronce
- Comprensión de las aleaciones metálicas y el límite elástico
- 5 aleaciones metálicas industriales importantes y sus usos
- Tratamiento térmico de aluminio y aleaciones de aluminio
- Tratamiento térmico de cobre y aleaciones de cobre.



