Puntos cuánticos de indio de tamaño uniforme que crecen en la superficie de una capa epitaxial de InGaN mediante un proceso de enfriamiento de dos pasos
Resumen
Se propone un nuevo método para hacer crecer puntos cuánticos de indio (In QD) en la superficie de una capa epitaxial de InGaN mediante MOCVD. Se ha descubierto que se forman puntos cuánticos de tamaño uniforme en la superficie de una capa de InGaN cuando se lleva a cabo un proceso de enfriamiento de dos pasos. A través del análisis, encontramos que la formación de In QD en la superficie se debe a la reacción entre la capa rica en In de la superficie y el gas portador H 2 en el período de temperatura más baja en el proceso de enfriamiento de dos pasos. Al mismo tiempo, como la densidad de In QD depende en gran medida de la capa rica en In de la superficie, esto nos proporciona una forma de estudiar la propiedad de la superficie de la capa de InGaN directamente.
Introducción
En los últimos años, los materiales basados en (Al, In, Ga) N han atraído una gran atención debido a su aplicación exitosa en un dispositivo emisor de luz (LED) y diodo láser (LD) [1,2,3,4, 5]. InGaN tiene alta absorción, amplia cobertura espectral y dureza de radiación y siempre se utiliza como material activo para la fabricación de dispositivos optoelectrónicos. Sin embargo, es un gran desafío cultivar materiales InGaN de alta calidad, debido a una serie de problemas. Por ejemplo, la gran diferencia en la constante de celosía entre InN y GaN da como resultado una brecha de miscibilidad en fase sólida [6, 7]. La presión de vapor relativamente alta de InN en comparación con GaN conduce a una baja incorporación de indio en la aleación de InGaN [8]. Además, una gran diferencia en las entalpías de formación para InN y GaN provoca una fuerte segregación superficial de indio en el frente de crecimiento [9]. Por otro lado, en el proceso de crecimiento de la capa de InGaN, siempre existe una capa rica en In en la superficie debido al efecto de tracción, lo que afectará la calidad de la capa posterior de pozo cuántico múltiple (MQW) de InGaN / GaN por introduciendo átomos de indio en el crecimiento posterior de la capa de GaN [10]. Para obtener el alto rendimiento de los dispositivos optoelectrónicos basados en InGaN, tenemos que superar todos estos obstáculos. Durante la investigación, el crecimiento de una sola capa de InGaN siempre se utiliza para optimizar el parámetro de crecimiento de InGaN / GaN MQW. En este artículo, ocasionalmente encontramos forma de puntos cuánticos de tamaño uniforme en la superficie de la capa única de InGaN cuando se realiza un proceso de enfriamiento de dos pasos que reemplaza el proceso de enfriamiento regular de un paso después del crecimiento de la capa única de InGaN. A través del análisis, encontramos que la formación de In QDs está relacionada con la capa rica en In existente en la superficie de la capa InGaN, y eso nos proporciona una forma de estudiar la capa rica en In de la superficie directamente.
Experimento
Las muestras utilizadas en este estudio fueron capas individuales de InGaN cultivadas en un sustrato de zafiro de plano c mediante un AIXTRON 6 × 2 en un reactor de cabezal de ducha acoplado por deposición química metalorgánica (MOCVD) en un N 2 atmósfera. Trimetilgalio (TMGa), trimetilindio (TMIn) y amoníaco (NH 3 ) se utilizan como precursores de fuentes de Ga, In y N, respectivamente. Las capas individuales de InGaN con un grosor por debajo de 60 nm y el contenido de In de menos del 15% se cultivaron en una capa de GaN de dopaje no intencional de 2 μm de espesor después de una capa tampón de GaN de 25 nm cultivada sobre un sustrato de zafiro. El esquema de estructura se muestra en la Fig. 1. H 2 y N 2 se utilizan como gas portador en diferentes períodos del proceso de crecimiento. Convencionalmente, el N 2 se utiliza como gas portador en el proceso de crecimiento de la capa de InGaN porque H 2 tiene un efecto corrosivo sobre la capa de InGaN que disminuirá en gran medida la eficacia de la incorporación de In [11, 12]. Sin embargo, H 2 como gas portador puede mejorar en gran medida la movilidad superficial de los átomos y reducir la concentración de impurezas. Por lo tanto, H 2 Se prefiere usar como gas portador durante el crecimiento de la capa de GaN para mejorar la calidad del cristal. Generalmente, cuando finaliza el crecimiento de la capa de InGaN, la temperatura se reduce directamente a la temperatura ambiente en una atmósfera de nitrógeno. Aquí, llamamos a un proceso como “enfriamiento en un paso”. En este trabajo, se ha asumido un proceso de enfriamiento de dos etapas después del crecimiento de la capa de InGaN, en el que la temperatura se bajó a 400 ° C en una atmósfera de nitrógeno en el primer período de enfriamiento, y posteriormente se redujo a temperatura ambiente. en un H 2 atmósfera. La difracción de rayos X de alta resolución (XRD), la microscopía de fuerza atómica (AFM), el microscopio electrónico de barrido (SEM) y el espectrómetro de dispersión de energía (EDS) se utilizan para caracterizar las muestras de InGaN.
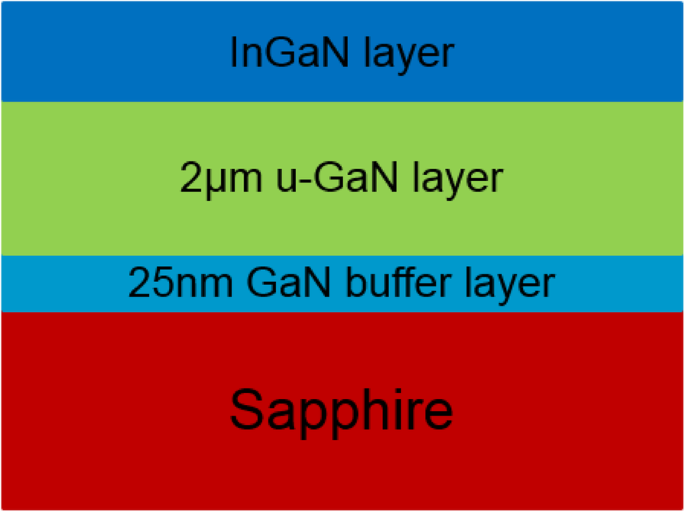
El esquema de la estructura de la capa única de InGaN cultivada en una plantilla de GaN mediante el uso de un sustrato de zafiro
Resultado y discusión
Se ha encontrado una topografía superficial anormal de la capa de InGaN cuando se cultiva en una sola capa de InGaN en la plantilla de GaN con un proceso de enfriamiento de dos pasos. La morfología de la superficie AFM de las muestras de InGaN con enfriamiento en un paso y enfriamiento en dos pasos se muestra respectivamente en la Fig. 2a y b. La Figura 2a muestra una morfología de superficie típica de la epilayer de InGaN, a partir de la cual podemos encontrar que la capa de InGaN tiene un claro flujo de pasos de crecimiento 2D. Al mismo tiempo, existen muchas islas 3D en la superficie de la muestra que se atribuyen a estar relacionadas con las líneas de dislocación del tornillo en la capa de GaN. También se puede ver que hay un punto oscuro en la parte superior de cada isla 3D que se ha demostrado que es el hoyo en V formado a lo largo de la dislocación del tornillo [13, 14]. A diferencia de la Fig. 2a, excepto la superficie de flujo escalonado y las islas 3D, también hay muchos puntos cuánticos de tamaño uniforme (los pequeños puntos blancos en la imagen) en la Fig. 2b. Combinado con el recuadro de la Fig.2b en la esquina superior izquierda, que es un diagrama 3D de la superficie, podemos obtener que el tamaño promedio de estos puntos cuánticos es de aproximadamente 100 nm × 100 nm, la altura promedio es de aproximadamente 20 nm y la la densidad es de alrededor de 1,6 × 10 8 cm −2 . Cabe señalar que la principal diferencia entre estas dos formas diferentes de enfriamiento de la muestra es que H 2 se utiliza como gas portador en lugar de N 2 en el segundo período de enfriamiento del proceso de enfriamiento de dos pasos. Por lo tanto, la formación de puntos cuánticos en la superficie de la capa de InGaN está relacionada con el gas portador H 2 en el proceso de enfriamiento a baja temperatura.
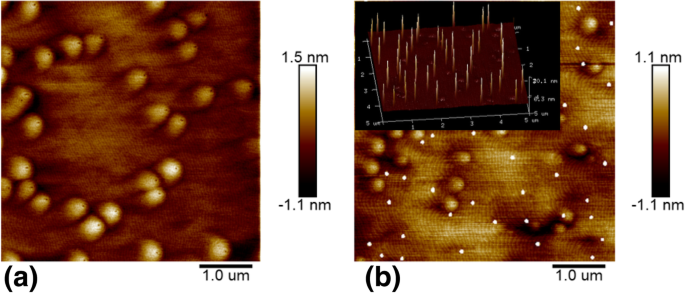
Topografía de superficie AFM de a Muestra de InGaN con enfriamiento en un solo paso y b Muestra de InGaN con proceso de enfriamiento de dos pasos donde el recuadro es un diagrama 3D de la superficie
Para comprender cómo sucede esto cuando se toma un proceso de enfriamiento de dos pasos en muestras de InGaN, realizamos un experimento de enfriamiento de dos pasos en GaN en lugar de InGaN. Esta capa de GaN se cultivó en las mismas condiciones que las muestras de una sola capa de InGaN que se estudiaron en este trabajo, es decir, a una temperatura de crecimiento relativamente más baja de 740 ° C y N 2 se utiliza como gas portador. La topografía de la superficie AFM de la capa de GaN después de un proceso de enfriamiento de dos pasos se muestra en la Fig. 3a. Podemos encontrar que no hay ningún punto cuántico que exista en la superficie y la superficie es exactamente igual que las muestras de capa de GaN cultivadas con MOCVD de enfriamiento en un solo paso, como se ha informado ampliamente [15]. Además, hemos comprobado lo que sucederá cuando se utilice el proceso de enfriamiento de dos pasos para una muestra de capa de InGaN con un contenido de In muy bajo en el que el contenido de In es solo del 1%. La Fig. 3b muestra la morfología de la superficie AFM de esta muestra de InGaN con bajo contenido de In después de un proceso de enfriamiento de dos pasos. Se encuentra que la densidad de puntos cuánticos tiene una disminución muy grande en comparación con la muestra de InGaN con alto contenido de In mencionada anteriormente, cuyo contenido de In es aproximadamente del 13%. Estos resultados significan que la formación de puntos cuánticos en la superficie de la capa de InGaN en el proceso de enfriamiento de dos pasos está correlacionada con el átomo de In, y estos puntos cuánticos pueden ser uno del estado In que se forma debido a la reacción entre InGaN capa y gas portador H 2 en el proceso de segundo enfriamiento.
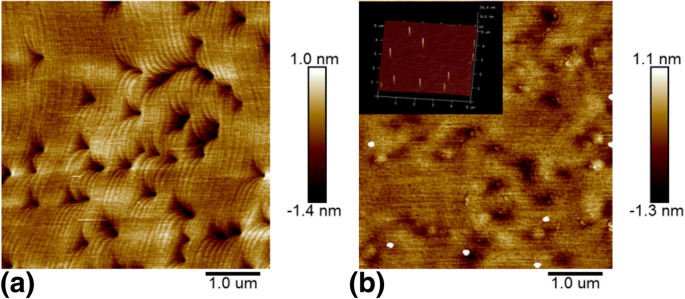
Topografía de superficie AFM de muestras con enfriamiento de dos pasos. un Capa de GaN. b Capa InGaN con contenido In 1%
Estudios anteriores han demostrado que existen tres estados diferentes de átomos de In en el proceso de crecimiento de la capa de InGaN [16, 17]. El primero son los átomos de In en la red cristalina de aleación de InGaN, que es la parte principal y el producto objetivo del crecimiento de la capa de InGaN; el segundo es la aleación de InN que siempre aparece en la superficie de la capa de InGaN; y el tercero es la gota de In que puede aparecer en alguna condición especial de crecimiento. Los diferentes estados del átomo de In se pueden distinguir por los espectros XRD, ya que tienen diferentes picos de difracción en el modo de exploración ω / 2θ. Para determinar a qué estado de In pertenecen estos puntos, se ha tomado la medición de XRD para las muestras de InGaN con procesos de enfriamiento de uno o dos pasos. La Figura 4 muestra los espectros XRD ω / 2θ típicos para muestras con enfriamiento de dos pasos (línea roja) y enfriamiento de un paso (línea azul). Se encontraron tres picos característicos para las muestras con enfriamiento en dos pasos, mientras que solo hay dos picos característicos para las muestras con enfriamiento en un paso. Entonces, el pico característico adicional para las muestras con enfriamiento en dos pasos puede representar los puntos cuánticos que se forman en la superficie. Los dos picos característicos que existen comúnmente en estas muestras se ubican alrededor de 33,5 ° y 34,5 °. Pertenecen al cristal InGaN y GaN, respectivamente. Mientras que se ha verificado que el pico característico adicional ubicado en 2θ =32,8 ° proviene de la gota In [16, 17]. Entonces podemos llegar a la conclusión de que los puntos cuánticos que observamos en la superficie de InGaN con el proceso de enfriamiento de dos pasos es la gota de In. Para confirmar esta conclusión, se ha tomado la medición SEM en las muestras con un proceso de enfriamiento de dos pasos, el resultado se muestra en la Fig. 5a, a partir de la cual también podemos encontrar que existen puntos en la superficie. Para identificar estos puntos, se ha tomado EDS en el mismo lugar, Fig. 5b – d muestra la distribución de átomos de superficie para In, Ga y N, respectivamente, de donde podemos obtener que el átomo de Ga y N se distribuyen uniformemente en la superficie, mientras que la concentración de átomos de In en los puntos es mucho mayor que su entorno, lo que representa que estos puntos son ricos en In. Entonces, combinado con el análisis anterior, podemos concluir que el gas portador H 2 puede reaccionar con la capa de InGaN a baja temperatura y formar gotas en la superficie.
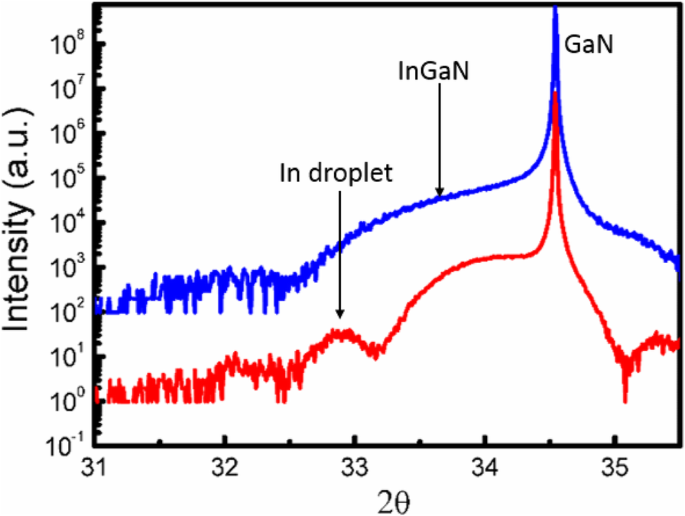
Los espectros XRD para la muestra con enfriamiento de dos pasos (línea roja) y enfriamiento de un paso (línea azul)
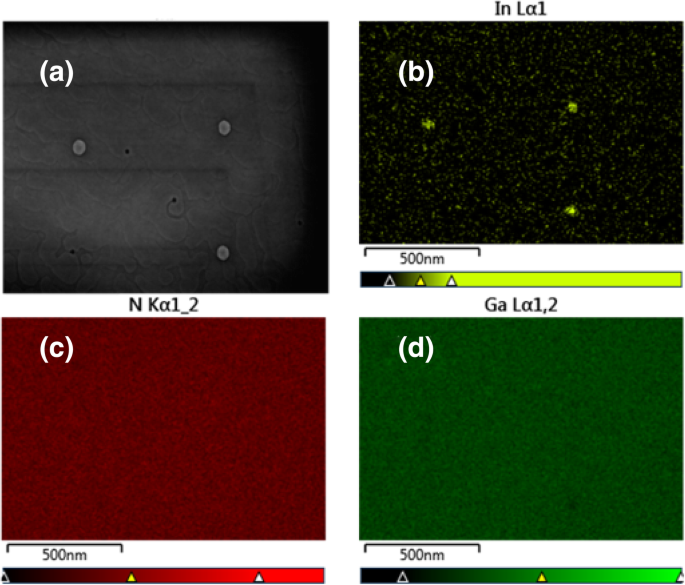
un La fotografía de superficie SEM para la muestra con un proceso de enfriamiento de dos pasos, b - d es el resultado del análisis del elemento EDS para el átomo In, N y Ga, respectivamente
Se ha informado que a menudo se forma una capa rica en In en la superficie de la capa epitaxial de InGaN debido al efecto de tracción de la superficie [10]. En nuestro experimento, las muestras se enfriaron directamente a temperatura ambiente después del crecimiento de una sola capa de InGaN, lo que significa que la capa superficial rica en In todavía existe en la superficie en el proceso de enfriamiento. Por lo tanto, hay dos posibilidades del origen del átomo de In para los QD de In que observamos:la capa de InGaN y la capa de superficie rica en In, respectivamente. Para saber cuál es el origen del átomo de In de los puntos cuánticos de In y cómo ocurre la reacción, se han llevado a cabo más experimentos. Se sabe que un proceso de recocido puede eliminar la capa rica en In [18]. Por lo tanto, realizamos un proceso de recocido térmico para las muestras de InGaN antes del proceso de enfriamiento de dos pasos. El tiempo del proceso de recocido térmico se establece en 60 s, y la temperatura es de aproximadamente 800 ° C, que es 60 ° más alta que la temperatura de crecimiento de la capa de InGaN. La topografía AFM de la muestra de InGaN con un proceso de recocido antes del proceso de enfriamiento de dos pasos se muestra en la Fig.6, obviamente no hay puntos cuánticos en la superficie. Sin embargo, en comparación con la Fig. 2a, se puede encontrar un gran cambio en la topografía de la superficie, la superficie se vuelve más rugosa. La falta de puntos cuánticos en la superficie muestra que la capa de InGaN no se formaría en QD con H 2 en el segundo proceso de enfriamiento, ya que el recocido térmico solo puede eliminar la capa rica en entrada. Entonces, la formación de punto cuántico en la superficie de la capa de InGaN en el proceso de enfriamiento de dos pasos se debe a la reacción entre la capa superficial rica en In y el gas portador H 2 en el rango de baja temperatura.
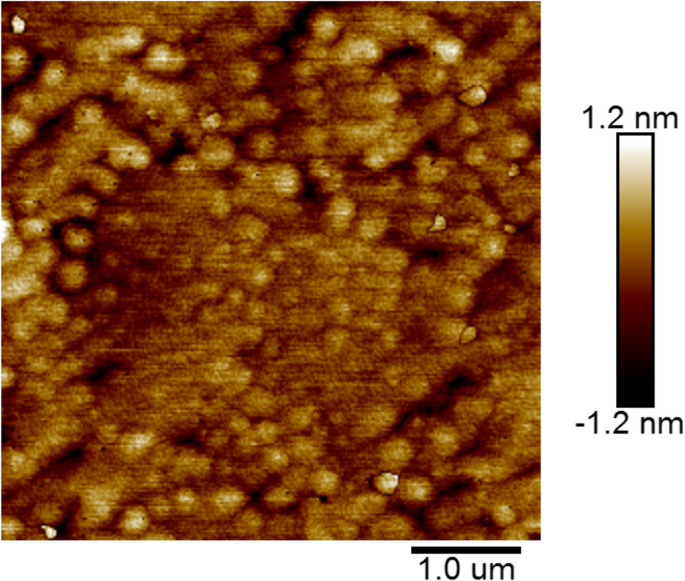
La topografía de la superficie AFM de la capa de InGaN con un recocido térmico antes del enfriamiento en dos pasos.
El efecto corrosivo del H 2 sobre el crecimiento de la capa InGaN se ha informado en gran medida. Se sabe que H 2 puede dificultar que los átomos de In se incorporen a la red [19, 20], y esa es la razón principal por la que convencionalmente solo N 2 se utiliza como gas portador en el crecimiento MOCVD de las capas de InGaN. El efecto corrosivo del H 2 en la capa de InGaN puede verse como un proceso inverso del crecimiento de la capa de InGaN, que puede expresarse mediante la siguiente reacción química:
$$ {3 \ mathrm {H}} _ 2 + 2 \ mathrm {In} \ mathrm {N} \ to 2 \ mathrm {In} + {2 \ mathrm {NH}} _ 3 $$La formación de puntos cuánticos en el proceso de enfriamiento de dos pasos puede verse como una especie de efecto corrosivo, pero existen algunas diferencias entre la temperatura alta (para hacer crecer InGaN con H 2 ) y baja temperatura (para enfriar InGaN y formar In QD con H 2 ). A alta temperatura, el átomo de In formado por el efecto corrosivo en la superficie tiene suficiente energía para escapar a través de la capa límite de la superficie, disminuyendo así la eficiencia de la incorporación de In. Sin embargo, a baja temperatura (por debajo de 400 ° C), nuestros resultados revelan que H 2 solo tiene un efecto corrosivo en la capa de superficie altamente contenida, ya que esta capa es más inestable que la capa de InGaN. Por otro lado, como la temperatura está por debajo de 400 ° C, los átomos de In que se forman en la superficie pueden escapar mucho menos a través del límite de la superficie a tiempo, por lo que migrarán a la superficie de la muestra y luego formarán gotas de In en la superficie.
En nuestro estudio, dado que la formación de In QD está relacionada con la capa con alto contenido de In en la superficie de InGaN, pueden proporcionar directamente alguna información sobre la capa rica en In de la superficie de InGaN. Las muestras de la capa de InGaN con diferente contenido y grosor de In se utilizan para realizar experimentos de tratamiento de enfriamiento en dos pasos. La Figura 7 muestra la topografía de la superficie de capas de InGaN con diferente contenido de In y espesor. El contenido de In es 7,65%, 8,45% y 9,6%, respectivamente, para las muestras A, B y C, y el grosor de la capa de InGaN para estas tres muestras es casi el mismo (aproximadamente 13,4 nm). A partir de las morfologías de la superficie de AFM de las muestras A, B y C, podemos encontrar que la densidad de In QD aumenta con el contenido de In en la capa de InGaN. Y la densidad de QD es de aproximadamente 2,4 × 10 7 cm −3 , 4,8 × 10 7 cm −3 y 9,2 × 10 7 cm −3 respectivamente para las muestras A, B y C, mientras que el tamaño de las QD para estas muestras es casi el mismo. Por otro lado, la muestra D tiene el mismo contenido de In que la muestra A (7,65%), mientras que su espesor de capa es de aproximadamente 41 nm. Compare la superficie de dos muestras de A y D, está claro que la densidad de puntos cuánticos de In aumenta cuando aumenta el grosor de la capa de InGaN. De nuestro análisis mencionado anteriormente, se aprende que la formación de estos puntos cuánticos In es causada por la reacción de H 2 con la capa superficial in-rich a baja temperatura. Por lo tanto, la tendencia cambiante de la densidad de In QD puede reflejar el estado de la capa superficial rica en In, es decir, los átomos inestables de In que existen en la capa superficial rica en In, aumentan junto con el aumento del contenido de In y el espesor de InGaN. capa. Este resultado es consistente con estudios teóricos previos que han demostrado que el contenido de In de la capa superficial rica en In está relacionado con el contenido de In y el espesor de las capas de InGaN [21]. Esto también prueba que el mecanismo de formación de puntos cuánticos de In está relacionado con la superficie de la capa rica en In.
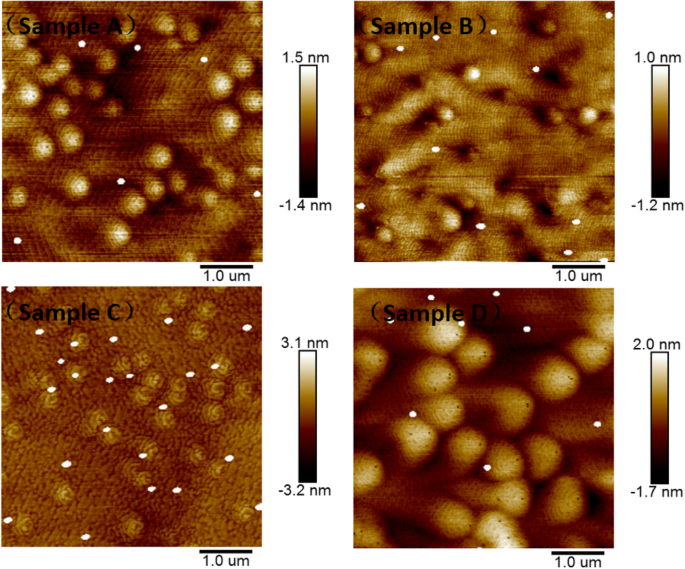
La topografía de la superficie AFM de las capas de InGaN a , b , c y d con diferente contenido y grosor (ver texto)
Conclusión
En este artículo, hemos introducido un nuevo método para obtener In QD de tamaño uniforme en la superficie de una capa de InGaN. Descubrimos que se forman In QD de tamaño uniforme en la superficie de una capa de InGaN cuando se realiza un proceso de enfriamiento de dos pasos. A través de un análisis detallado, encontramos que la formación de puntos cuánticos de In en la superficie se debe a la reacción entre la capa rica en In de la superficie y el gas portador H 2 a baja temperatura. Al mismo tiempo, nuestros experimentos revelan que H 2 solo tiene un efecto corrosivo en la capa superficial rica en In cuando la temperatura es inferior a 400 ° C, y este proceso corrosivo formará In QD en la superficie. Por otro lado, como la formación de In QD está estrechamente relacionada con la capa rica en In en la superficie, este proceso puede proporcionarnos una forma de estudiar la propiedad de esta capa directamente.
Método
El objetivo de este artículo es presentar un nuevo método para obtener In QD de tamaño uniforme en la superficie de la capa de InGaN. Las muestras utilizadas en este estudio se cultivaron mediante un AIXTRON 6 × 2 en un reactor de cabezal de ducha acoplado por deposición química metalorgánica (MOCVD). La difracción de rayos X de alta resolución (XRD), la microscopía de fuerza atómica (AFM), el microscopio electrónico de barrido (SEM) y el espectrómetro de dispersión de energía (EDS) se utilizan para caracterizar las muestras de InGaN. Todos los participantes de este estudio son científicos de la Academia de Ciencias de la Universidad de China de China.
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados y / o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- EDS:
-
Espectrómetro de dispersión de energía
- GaN:
-
Nitruro de galio
- En QD:
-
Puntos cuánticos de indio
- InGaN:
-
Nitruro de galio indio
- InN:
-
Nitruro de indio
- LD:
-
Diodo láser
- LED:
-
Dispositivo emisor de luz
- MOCVD:
-
Deposición química metalorgánica
- MQW:
-
Pozo cuántico múltiple
- NH 3 :
-
Amoníaco
- QD:
-
Puntos cuánticos
- SEM:
-
Microscopio electrónico de barrido
- TMGa:
-
Trimetilgalio
- TMIn:
-
Trimetilindio
- XRD:
-
Difracción de rayos X
Nanomateriales
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- El diseño de la capa de emisión para multiplicadores de electrones
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Defectos en la superficie del nanofósforo de MgAl2O4 dopado con Ti
- Control del crecimiento de nanocables de selenuro de indio de alta uniformidad (In2Se3) mediante el proceso de recocido térmico rápido a baja temperatura
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Sutil nanoestructuración de la superficie Au / Ru (0001)
- Factores clave que afectan los resultados del proceso de rectificado de superficies



