Efecto de las heteroestructuras bicapa CeO2 − x / ZnO y ZnO / CeO2 − x y la polaridad de electroformado en las propiedades de conmutación de la memoria no volátil
Resumen
Dispositivos de memoria con CeO bicapa 2 − x / ZnO y ZnO / CeO 2 − x Las heteroestructuras intercaladas entre los electrodos superior de Ti y los electrodos inferiores de Pt se fabricaron mediante pulverización catódica con magnetrón de RF a temperatura ambiente. Se utilizaron materiales semiconductores de tipo N en ambas heteroestructuras de dispositivos, pero, curiosamente, el cambio en la heteroestructura y la polaridad de electroformado provocó variaciones significativas en las propiedades de conmutación resistiva (RS). Los resultados han revelado que la polaridad de electroformado tiene una gran influencia tanto en CeO 2 − x / ZnO y ZnO / CeO 2 − x Rendimiento de heteroestructura como voltaje de electroformado, buena resistencia de ciclo a ciclo de conmutación (~ 10 2 ) y relación ON / OFF. Un dispositivo con CeO 2 − x / La heteroestructura de ZnO revela un buen rendimiento de RS debido a la formación de la barrera de Schottky en las interfaces superior e inferior. El mecanismo de conducción dominante del estado de alta resistencia (HRS) fue la emisión de Schottky en la región de campo alto. La naturaleza de la dependencia de la temperatura del estado de baja resistencia y HRS confirmó que la RS es causada por la formación y ruptura de filamentos conductores compuestos por vacantes de oxígeno.
Antecedentes
Las memorias flash convencionales se enfrentan a sus límites físicos y prácticos, por lo que la búsqueda de nuevos posibles candidatos para aplicaciones de memoria no volátil se ha vuelto muy necesaria. Con respecto a esto, se han sugerido varios tipos de memoria nuevos como los candidatos de memoria no volátil de próxima generación [1, 2]. Entre estos, la memoria resistiva de acceso aleatorio (RRAM) se considera el mejor candidato para el reemplazo de las memorias convencionales debido a sus características únicas, como alta capacidad de escalado, tiempo de retención de memoria prolongado, tamaño de dispositivo más pequeño, velocidad de conmutación rápida, baja utilización de energía. , no volatilidad y estructura simple [3]. La celda de memoria de RRAM es una estructura de metal-óxido-metal (MOM) similar a un condensador. Los comportamientos de conmutación resistiva bipolar (BRS) y RS unipolar (URS) entre dos estados de resistencia, es decir, el estado de baja resistencia (LRS) y el estado de alta resistencia (HRS) de una película de resistencia, se pueden lograr aplicando voltaje externo con la magnitud apropiada y polaridades [4, 5, 6].
El rendimiento de conmutación de un dispositivo RS depende de la uniformidad de los niveles de voltaje SET, voltaje RESET y corriente en LRS y HRS [7]. Estos parámetros de conmutación están influenciados por los dieléctricos de la película, los materiales de los electrodos y la técnica de fabricación / operación. Hasta ahora se han propuesto numerosos modelos para explicar la dependencia de las características de conmutación de estos parámetros. El comportamiento de conmutación puede clasificarse como limitado por volumen o limitado por interfaz [8]. Para la conmutación de tipo de volumen limitado, los parámetros de conmutación dependen en gran medida de la permitividad de las películas dieléctricas [9]. Sin embargo, la conmutación limitada por electrodo se debe a la correlación de electrones en la interfaz metal-dieléctrico y la función de trabajo de los materiales de los electrodos [10]. La interfaz entre un ánodo y una película dieléctrica también puede afectar los parámetros RS de un dispositivo de memoria [10, 11].
Entre varios óxidos, ceria (CeO 2 ) ha demostrado ser un material prometedor para aplicaciones de dispositivos de memoria RS debido a su gran constante dieléctrica (~ 26), menor energía libre de Gibbs (- 1024 kJ / mol), dos oxidaciones (Ce + 4 a Ce + 3 ), y la distribución de las vacantes (en particular las vacantes de oxígeno) en un patrón no estequiométrico [12, 13]. Por otro lado, el óxido de zinc (ZnO), debido a sus propiedades excepcionales, se está utilizando ampliamente en diversas aplicaciones. Se observa que el ZnO se utiliza como dieléctrico debido a su transparencia óptica, banda prohibida amplia, estabilidad química y alta resistividad (10 5 Ω-cm) [14]. Recientemente, se ha propuesto que las estructuras de memoria RS bicapa muestran propiedades superiores sobre los dispositivos basados en una sola capa en términos de reducción de los voltajes de electroformado y / o SET / RESET, mejora de la uniformidad en la conmutación, larga duración y autocumplimiento [15]. Xu y col. [16] investigó el comportamiento RS de ZrO 2 y pilas de doble capa de ZnO que ilustran que la migración de las vacantes de oxígeno depende de la altura de la barrera interfacial de óxido. Comportamiento de RS observado en la bicapa MnO / CeO 2 Se propuso que la estructura se debía a la reacción de oxidación y reducción del CeO 2 según lo informado por Hu et al. [17]. Yang y col. [18] reveló buenas características de conmutación resistiva de los dispositivos de CuO / ZnO bicapa en comparación con los dispositivos basados en ZnO de una sola capa. Park y col. [19] demostró un funcionamiento RS más confiable y reproducible observado en Pt / TiO x / ZnO / Pt celdas de memoria que el anotado en las celdas de memoria Pt / ZnO / Pt. Hsieh y col. [20] describió que Ni / ZnO / HfO 2 Los dispositivos de / Ni exhibieron un comportamiento de conmutación resistiva bipolar con características multinivel durante el proceso de RESET. Todas estas características mejoradas de RS motivaron investigaciones profundas de bicapa ya sea como ZnO / CeO 2 o como CeO 2 / Heteroestructuras de ZnO, ya que aún no se ha informado de ningún estudio sobre estas pilas y la influencia de la formación de polaridad en sus características RS y su rendimiento de memoria.
En este trabajo, hemos informado la influencia de la heteroestructura bicapa, así como la polaridad de electroformado en las propiedades RS de ZnO / CeO 2 − x y director ejecutivo 2 − x / Dispositivos de memoria basados en ZnO. Los resultados han demostrado que el CeO 2 − x positivamente electroformado / Dispositivos de ZnO y ZnO / CeO electroformado negativamente 2 − x Los dispositivos demuestran voltajes de electroformado más bajos y una resistencia de conmutación de ciclo a ciclo mucho mejor (~ 10 2 ) rendimiento. La dependencia de la temperatura de las resistencias LRS y HRS de estos dispositivos bicapa con polaridades de polarización opuestas indica que el mecanismo RS observado puede explicarse por canales de conducción basados en vacantes de oxígeno.
Métodos
Dos tipos de Ti / CeO 2 / ZnO / Pt y Ti / ZnO / CeO 2 / En este trabajo se prepararon dispositivos de heteroestructura de Pt para su estudio comparativo. Para la fabricación del primer Ti / CeO 2 / Dispositivo de heteroestructura de ZnO / Pt, se depositó una capa activa de película delgada de ZnO (~ 10 nm) sobre Pt / Ti / SiO 2 comercial / Sustratos de Si (Pt) a temperatura ambiente mediante pulverización catódica con magnetrón de radiofrecuencia (RF) utilizando un objetivo cerámico de ZnO (99,99% de pureza). Durante la deposición, potencia de RF de 75 W y presión de ~ 10 mTorr bajo Ar:O 2 (6:18) se mantuvieron la mezcla (caudal =24 sccm). Luego, director ejecutivo 2 La capa (5 nm) se depositó sobre ZnO / Pt mediante pulverización catódica con magnetrón de RF en las mismas condiciones para formar CeO 2 bicapa / Heteroestructura de ZnO. Finalmente, el electrodo superior (TE) de Pt / Ti se depositó en ambas heteroestructuras mediante pulverización catódica secuencial de corriente continua (CC) con magnetrón utilizando una máscara de sombra metálica. Esta técnica produjo dispositivos circulares (celdas de memoria) con un diámetro de 150 μm. Aquí, el Pt se utilizó como capa protectora para proteger al Ti TE de la oxidación. De la misma forma, un segundo Ti / ZnO / CeO 2 El dispositivo de heteroestructura de / Pt también se fabricó en las mismas condiciones que se mantuvieron para Ti / CeO 2 / ZnO / Pt heteroestructuras. Ambos Ti / CeO 2 / ZnO / Pt y Ti / ZnO / CeO 2 / Los dispositivos de memoria de heteroestructura Pt se caracterizaron por el analizador de parámetros de semiconductores Agilent B1500A utilizando un método de medición estándar de dos sondas. La estructura bicapa de estos dispositivos se caracterizó mediante microscopía electrónica de transmisión de alta resolución y vista cruzada (HRTEM-JEM 2001F).
Resultados y discusión
La Figura 1a, b muestra la configuración esquemática de Ti / CeO 2 bicapa / ZnO / Pt y Ti / ZnO / CeO 2 / Pt dispositivos de memoria de heteroestructura, respectivamente. La Figura 2a – d muestra corriente-voltaje típico ( I - V ) curvas de Ti / CeO 2 − x / ZnO / Pt y Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura, que también incluyen el proceso de electroformado inicial, lo que indica las características típicas de RS bipolar. Cuando se aplicó un barrido de + 2 V a TE, se produjo un salto repentino de corriente a 0,6 V, lo que indica la formación de trayectorias conductoras entre dos electrodos (Fig. 2a). El dispositivo permaneció en estado ON (LRS) después de que se eliminó el voltaje de electroformado positivo. La Figura 2a también muestra que el dispositivo volvió a cambiar exitosamente a HRS con un barrido de voltaje negativo de 0 a - 1 V, y a LRS nuevamente con un barrido de voltaje positivo de 0 a + 1 V.Una polaridad opuesta, es decir, voltaje de electroformado negativo, También se proporcionó para activar / iniciar el comportamiento de conmutación en la misma celda de memoria de heteroestructura. En este sentido, cuando se aplicó un barrido de 0 a - 8 V a TE, la resistencia del dispositivo mostró una caída repentina a - 5,6 V, lo que lo encendió desde el estado APAGADO llamado electroformado negativo (Fig. 2b). Después de la electroformación negativa, el dispositivo falló en el RESET positivo y el SET negativo debido a su avería irreversible. Se observa que se necesitan voltajes de electroformado negativos mucho más altos para iniciar las características de RS que los voltajes de electroformado positivos. Sin embargo, después de la electroformación negativa, no se observó histéresis de conmutación, ya que el dispositivo permaneció en el estado ON independientemente de la aplicación de los voltajes SET y RESET; este hecho indica la formación de filamentos conductores permanentes durante el proceso de electroformado. La ruptura irreversible durante el electroconformado negativo podría ser el resultado de diferentes alturas de barrera de túnel iniciadas por la diferencia en las funciones de trabajo de los electrodos superior e inferior [21]. Estos resultados muestran que el dispositivo con Ti / CeO 2 − x La heteroestructura de / ZnO / Pt puede ser adecuada para características no volátiles solo si se electroforma con polaridad positiva, seguida de polaridades negativa y positiva de las correspondientes operaciones RESET y SET. La única diferencia entre el segundo (Ti / ZnO / CeO 2 − x / Pt) y primero (Ti / CeO 2 − x / ZnO / Pt) es la posición de las capas aislantes en la heteroestructura sándwich. Es por eso que el dispositivo con Ti / ZnO / CeO 2 − x La heteroestructura de / Pt también se puede electroformar en polaridades positivas y negativas de los potenciales de polarización de la misma manera Ti / CeO 2 − x / Dispositivo de heteroestructura de ZnO / Pt. La figura 2c muestra una I-V bipolar típica curvas para tal electroconformado positivo y posterior comportamiento de conmutación. Con un barrido de 0 a + 4 V, el dispositivo se electroformó para cambiarlo al estado ENCENDIDO (un cambio abrupto de resistencia a + 3 V) como se ilustra en la Fig. 2c. Luego, el dispositivo se enciende por debajo de + 2 V (SET positivo) y se apaga a - 1,5 V (RESET negativo) durante el ciclo de conmutación repetible. De manera similar, el dispositivo con la misma heteroestructura electroformado negativamente (a - 3,5 V) mostró un RESET positivo (a + 1,5 V) y un SET negativo (a - 2,5 V) como es obvio en la Fig. 2d. Para proteger ambos dispositivos de una avería permanente, se aplicó un cumplimiento de corriente de 1 mA durante los procesos de electroformado y SET.
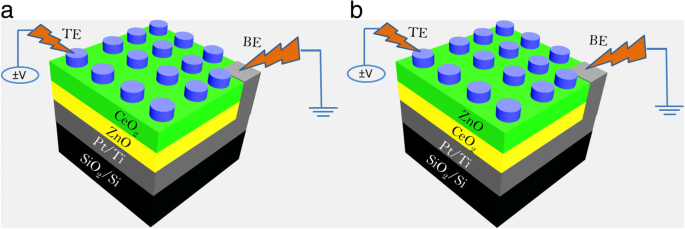
Configuración esquemática de la bicapa a Ti / CeO 2 / ZnO / Pt y b Ti / ZnO / CeO 2 / Pt dispositivos
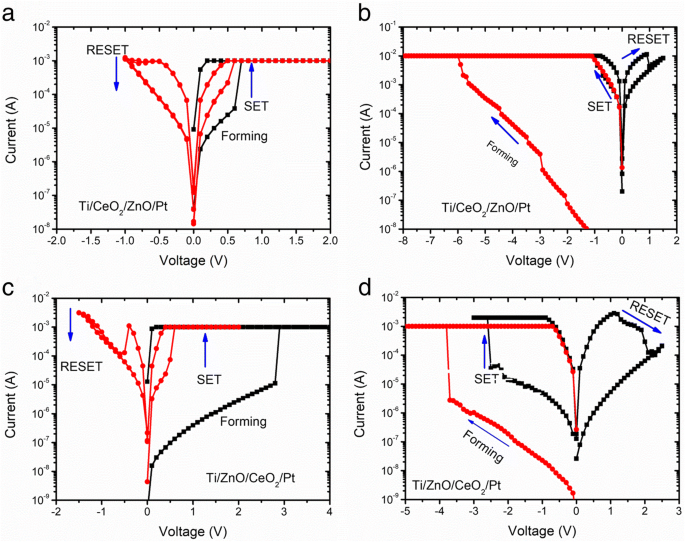
Los dispositivos representan el comportamiento bipolar típico. un Formación positiva (+ ve) y operación de conmutación posterior y b operación de formación y conmutación negativa (−ve) del Ti / CeO 2 − x / ZnO / Pt heteroestructuras. c + operación de formación y conmutación y d −ve operación de formación y conmutación de Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria. Las flechas indican el cambio de dirección
Para verificar la uniformidad de los parámetros de conmutación para ambos dispositivos de memoria de heteroestructura, las probabilidades acumulativas de voltajes operacionales (voltajes SET y RESET) que se indican en varios ciclos de conmutación se muestran en la Fig. 3a, b. El Ti / CeO 2 − x El dispositivo de memoria de heteroestructura / ZnO / Pt exhibe variaciones relativamente más estrechas en los voltajes SET y RESET en comparación con Ti / ZnO / CeO 2 − x / Dispositivo de memoria de heteroestructura de Pt. La Figura 3c, d revela el análisis estadístico de los voltajes de SET, RESET y electroformado promedio de ambos dispositivos de memoria de heteroestructura. El Ti / CeO 2 − x Se encuentra que los dispositivos / ZnO / Pt requieren voltajes de electroformado mucho más bajos en comparación con los necesarios para Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura, pero los voltajes SET y RESET muestran solo variaciones leves. Las fluctuaciones más pequeñas en los voltajes de operación de ambos dispositivos podrían estar asociadas con la creación y ruptura de filamentos que tienen lugar en las interfaces. Liu y col. [22] sugirió que los bajos voltajes SET / RESET y la uniformidad de conmutación indicados en WO x / NbO x La estructura bicapa podría atribuirse al efecto combinado de la migración de oxígeno entre dos capas de óxido y la transición metal-aislante. Como energía libre de Gibbs ΔG de la formación de óxido para ZnO y CeO x tiene una gran diferencia de aproximadamente 706 kJ / mol (para CeO 2 , ΔG =- 1024 kJ / mol y para ZnO es - 318.52 kJ / mol) y se produce un efecto de calentamiento localizado, se induce el intercambio de oxígeno. Es bien sabido que la capa fina de ZnO tiene muchas vacantes de oxígeno debido a la baja energía de formación [23]. Además, muchas vacantes de oxígeno iniciales presentes en la capa de ZnO juegan un papel importante en la conducción a través de trampas poco profundas [24]. Además, se afirma que el fenómeno de libre formación en los dispositivos basados en ZnO podría atribuirse a una alta concentración de vacantes de oxígeno ya presentes en los cristales de ZnO [25]. De todos los hechos antes mencionados, se puede concluir que en presencia de una película de ZnO que posee una gran cantidad de vacantes de oxígeno en ambos dispositivos de heteroestructura (ZnO / CeO 2 − x y director ejecutivo 2 − x / ZnO) juega un papel crucial en la reducción de voltajes operacionales. Las vacantes de oxígeno en ZnO podrían actuar como trampas poco profundas para los electrones y los electrones en estos sitios de captura pueden quedar atrapados o desencajarse fácilmente con valores pequeños de voltajes SET y RESET.

Distribución de probabilidad acumulada ciclo a ciclo de voltajes operacionales en a Ti / CeO 2 − x / ZnO / Pt y b Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura. c Análisis estadístico de los voltajes SET y RESET de Ti / CeO 2 − x / ZnO / Pt y Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura. d Evaluación estadística de los voltajes de electroformado tanto para Ti / CeO 2 − x / ZnO / Pt y Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura
Para investigar la confiabilidad de las heteroestructuras de ambos dispositivos, se realizaron pruebas de resistencia a diferentes polaridades de potencial de polarización. Los valores de resistencia de HRS y LRS se obtienen a 0,2 V de los ciclos de conmutación de resistencia de CC. La Figura 4a describe las características de resistencia de Ti / CeO 2 − x / ZnO / Pt Dispositivo de memoria de heteroestructura. Se ve que Ti / CeO 2 positivamente electroformado Los dispositivos de memoria de heteroestructura / ZnO / Pt exhibieron una buena resistencia con una ventana de memoria de ~ 10 que podría garantizar HRS y LRS claramente distinguibles. Formación de la barrera de Schottky en Ti / CeO 2 − x La interfaz se debe a la diferencia de función de trabajo entre el Ti TE y la capa adyacente de CeO 2 − x , lo que da lugar a buenas propiedades de RS. Cuando el mismo dispositivo de heteroestructura (Ti / CeO 2 − x / ZnO / Pt) se electroformó negativamente, el dispositivo no se pudo cambiar de LRS a HRS como se muestra en la Fig. 4b. La Figura 4c ilustra las características de resistencia de Ti / ZnO / CeO 2 − x positivamente electroformado / Dispositivo de memoria de heteroestructura Pt que exhibe una propiedad de resistencia muy pobre. La ventana de memoria parece estar casi colapsada, lo que hace que los estados ON y OFF sean prácticamente indistinguibles. Este hecho puede atribuirse a la incapacidad del ZnO para capturar los portadores inyectados debido a la presencia de una alta concentración de vacantes, lo que hace que la conducción se dirija hacia Ti TE porque no se forma una barrera en la interfaz Ti / ZnO debido a la diferencia de función de trabajo insignificante entre Ti (4,33 eV) y ZnO (4,35 eV), y esto conduce a una mala resistencia [26]. Otra razón puede ser la alta densidad de defectos dentro del ZnO / CeO 2 − x matriz creada bajo un fuerte campo eléctrico, porque la migración de vacantes de oxígeno se mejora significativamente a lo largo de los defectos extendidos. Además, las vacantes de oxígeno con carga positiva segregadas en los sitios de defectos aumentan los estados de densidad de la superficie, lo que da como resultado el colapso de la relación ON / OFF. Sugiere que cuando se forma el contacto de bloqueo de Ti / ZnO, los niveles de Fermi están alineados entre sí debido al movimiento de electrones de Ti a ZnO. Como resultado, la mayoría de los portadores se acumulan en la superficie de la capa de óxido y casi no se forma ninguna barrera [26]. La Figura 4d demuestra características de resistencia mucho mejores del Ti / ZnO / CeO 2 − x formado negativamente / Pt dispositivo de memoria de heteroestructura en comparación con los de un dispositivo formado positivamente. Zhu y col. [27] fabricó tres tipos diferentes de dispositivos:(i) Ag / ZnO / NSTO / In, (ii) Ag / CeO 2 / NSTO / In y (iii) Ag / CeO 2 / ZnO / NSTO / In. El dispositivo bicapa (CeO 2 − x / ZnO), en comparación con los de una sola capa, exhibieron un mejor comportamiento de RS con una retención de datos de aproximadamente 10 años. Atribuyeron mejores características de RS de heteroestructuras bicapa a la barrera de interfaz entre CeO 2 − x / Estructura bicapa de ZnO y existencia de un gran número de vacantes que actúan como centros trampa en las películas de ZnO.
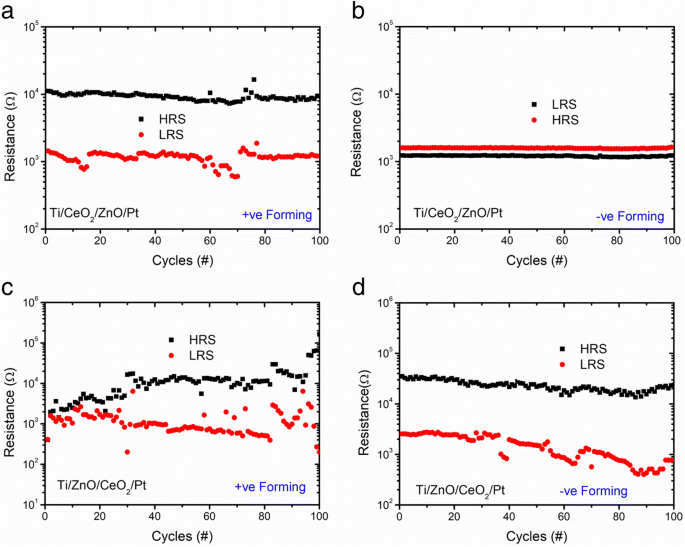
Características de resistencia de a positivamente electroformado y b Ti / CeO electroformado negativamente 2 − x / ZnO / Pt dispositivos de memoria de heteroestructura. c Positivamente electroformado y d Ti / ZnO / CeO electroformado negativamente 2 − x / Pt dispositivos de memoria de heteroestructura
El rendimiento de retención de ambos CeO 2 − x / ZnO y ZnO / CeO 2 − x También se investigaron heteroestructuras bicapa. El tiempo de retención de ambos dispositivos de heteroestructura se midió a temperatura ambiente con un voltaje de lectura de 0,2 V como es obvio en la Fig. 5a, b. No se necesitaba energía eléctrica para mantener constante la resistencia en un estado dado. Hasta un tiempo de retención de 10 4 s, las resistencias del HRS y LRS no revelan ningún signo de deterioro, lo que implica que la información almacenada en ambos dispositivos de heteroestructura se puede conservar durante mucho más tiempo que 10 4 s.

Características de retención de a Ti / CeO positivamente electroformado 2 − x / ZnO / Pt dispositivos de memoria de heteroestructura y b Ti / ZnO / CeO electroformado negativamente 2 − x / Pt dispositivos de memoria de heteroestructura a temperatura ambiente
Para investigar sobre el mecanismo de conducción que prevalece en la región de campo alto de ambos dispositivos de memoria de heteroestructura, el procedimiento de ajuste de la curva se realizó bajo positivo (para CeO 2 − x / ZnO) y negativo (para ZnO / CeO 2 − x ) polaridades del potencial de polarización. La Figura 6a, b describe que los ajustes de la curva lineal a los datos experimentales están bien alineados con el comportamiento de emisión de Schottky para ambos dispositivos de heteroestructura en sus respectivas polaridades de polarización. Se sabe que la emisión de Schottky tiene lugar cuando el electrodo inyecta electrones activados térmicamente a través de la barrera en la banda de conducción del aislante, por lo que se denomina mecanismo de electrodo limitado. Generalmente, la emisión de Schottky surge cuando el contacto del electrodo es altamente inyectable al portador. La relación lineal de ln ( I ) frente a √ V indica que los electrones han alcanzado una cantidad adecuada de energía para conquistar la barrera energética. La conducción óhmica (la corriente es proporcional al voltaje aplicado) que ocurre en una región de campo bajo muestra que la corriente fluye debido a los electrones generados térmicamente (los resultados no se muestran aquí). El modelo de emisión de Schottky generalmente se puede describir mediante una ecuación de la forma [28]:\ (\ ln (J) =\ ln {A} ^ {\ ast} {T} ^ 2-q \ left ({\ varPhi} _b- \ sqrt {\ frac {qV} {4 \ pi {\ varepsilon} _o {\ varepsilon} _rd}} \ \ right) / {k} _BT \), donde J es la densidad de corriente, A * es la constante de Richardson, T es la temperatura, q es carga eléctrica, V es voltaje ecléctico, ε r es constante dieléctrica, ε o es la permitividad del espacio libre, d es el espesor de la película y k B es la constante de Boltzmann. Además, los valores de resistencia dependientes de la temperatura de LRS y HRS se midieron a un voltaje de 0.2 V en el rango de temperatura de 200-300 K tanto para CeO 2 − x / ZnO y ZnO / CeO 2 − x dispositivos de memoria de heteroestructura como se muestra en la Fig. 6c, d. Se puede observar que las propiedades de transporte eléctrico de ambos dispositivos de heteroestructura en estado de baja resistencia son de naturaleza metálica, es decir, las resistencias en LRS aumentan con el aumento de temperatura. En contraste con esto, las propiedades de transporte eléctrico para ambos dispositivos en HRS son de naturaleza semiconductora, es decir, las resistencias en HRS disminuyen con el aumento de temperatura. Valores de la energía de activación ( E a ) obtenido de los gráficos de Arrhenius de LRS de ambos dispositivos de heteroestructura (resultados no mostrados) son ~ 0.092 eV, y comparables a la energía de la primera ionización de las vacantes de oxígeno (~ 0.1 eV) [25, 26, 29], lo que indica que la primera La ionización de las vacantes de oxígeno es responsable de la conducción en el HRS, lo que confirma aún más el predominio de la emisión de Schottky como mecanismo de conducción operativo en el HRS. El comportamiento metálico en LRS y el comportamiento semiconductor en HRS de ambos dispositivos de heteroestructura proporcionan evidencia suficiente en apoyo del comportamiento de conmutación en Ti / CeO 2 − x / ZnO / Pt y Ti // ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura que se pueden asociar con mecanismos filamentosos conductores basados en vacantes de oxígeno.
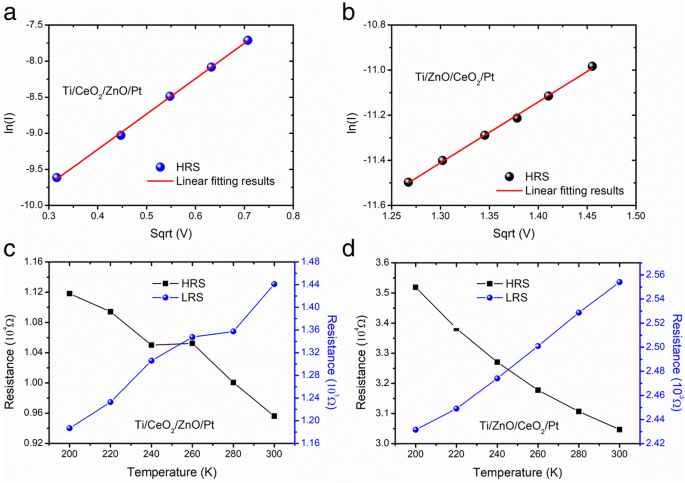
log I-V 1/2 características en el HRS del estado SET. un Para Ti / CeO 2 − x / ZnO / Pt. b Para Ti / ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura. Dependencia de la temperatura de LRS y HRS de c Ti / CeO 2 − x / ZnO / Pt y d Ti // ZnO / CeO 2 − x / Pt dispositivos de memoria de heteroestructura
La Figura 7 describe el diagrama de bandas de energía propuesto para CeO 2 y materiales semiconductores de tipo n-n de ZnO en estado estacionario. La diferencia entre las funciones de trabajo de ZnO (4.35 eV) y CeO 2 (3,33 eV) es igual a 1,02 eV para la misma transición electrónica en la vacante de oxígeno [30]. La función de trabajo inferior de CeO 2 (3.33 eV) que el de ZnO (4.35 eV) permite el movimiento de electrones desde CeO 2 a ZnO, dando lugar a su mayor concentración en la matriz.
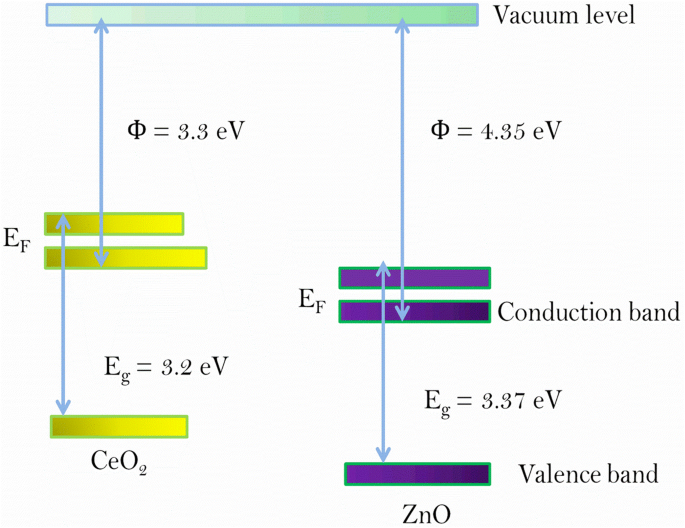
Diagrama de bandas de energía del director ejecutivo 2 y materiales semiconductores de tipo n ZnO
Según nuestro estudio anterior [31], las características RS de Ti / CeO de una sola capa 2 − x El dispositivo / Pt se atribuyó a la formación de una capa interfacial de TiO que juega un papel clave en la creación y ruptura de trayectorias filamentosas conductoras. Warule y col. propuso que el comportamiento de RS en los dispositivos Ti / ZnO / Pt fue inducido por la creación y desconexión de filamentos conductores basados en vacantes de oxígeno [32]. Además, el fenómeno de ausencia de formación en los dispositivos Ti / ZnO / Pt está relacionado con la existencia de una cantidad considerable de vacantes de oxígeno en los dispositivos Ti / ZnO / Pt preparados [32,33,34]. La barrera de Schottky en la interfaz ZnO / Pt puede eliminarse mediante la existencia de una cantidad adecuada de vacantes de oxígeno en la película de ZnO, lo que da como resultado un contacto óhmico en la interfaz ZnO / Pt. En consecuencia, la formación de la capa interfacial de TiO se puede asociar con el efecto RS en la bicapa ZnO / CeO 2 − x y director ejecutivo 2 − x / Heteroestructuras de ZnO. Es bien sabido que el Ti es un metal altamente reactivo con el oxígeno atmosférico:por lo tanto, puede formar fácilmente una capa de TiO en la interfaz Ti / óxido [35]. En Ti / ZnO / CeO 2 − x / Dispositivo de memoria de heteroestructura Pt, el ZnO es un semiconductor de tipo n y contiene muchas vacantes de oxígeno, por lo que se forma un contacto óhmico en la interfaz Ti / ZnO [36]. Como el Ti y el ZnO tienen aproximadamente las mismas funciones de trabajo, el Ti no puede extraer iones de oxígeno del ZnO para crear una capa interfacial de TiO. Se ha informado que existen iones de oxígeno no reticulados y oxígenos relacionados con defectos reticulares en las películas de ZnO [37]. Debido a la deposición de ceria (CeO 2 ) por pulverización catódica de RF a temperatura ambiente, CeO 2 fabricado las películas son de naturaleza policristalina. Por lo tanto, las películas de ceria pueden ser no estequiométricas, como ya hemos demostrado en nuestro trabajo de investigación anterior que la ceria se reduce a CeO 2 − x [12]. Hu y col. [17] también informó de tal reducción de CeO 2 durante la deposición a CeO 2 − x . Defectos en el CeO 2 − x las películas son insuficientes para movilizar iones de oxígeno. Por lo tanto, CeO 2 − x capa sirve como depósito de oxígeno en Ti / ZnO / CeO 2 − x / Heteroestructura de Pt. Energía de Gibb para la formación de CeO 2 es mucho más pequeño (- 1024 kJ / mol) que el de ZnO (- 318,52 kJ / mol) como se describió anteriormente, por lo que existen oxígenos no reticulares en el ZnO debido a su naturaleza no estequiométrica, que se mueven hacia CeO 2 capa incluso en ausencia de sesgo externo [37]. Por lo tanto, cuando Ti TE se deposita sobre ZnO, no se espera que se forme una capa interfacial entre Ti y ZnO, aunque la energía de Gibbs de formación de TiO es menor que la de ZnO. Cuando se aplica voltaje positivo al TE, los iones de oxígeno se atraen hacia el CeO 2 − x / La interfaz Pt y los filamentos conductores se generan con vacantes de oxígeno debido a su capacidad de disposición de líneas y deriva.
Por otro lado, en Ti / CeO 2 − x / ZnO / Pt dispositivos de memoria de heteroestructura, una capa de TiO interfacial muy delgada se forma en Ti / CeO 2 − x interfaz como obvio de la imagen HRTEM (Fig. 1c) y como sugiere nuestro estudio anterior [37]. La energía de Gibbs de formación de TiO (- 944 kJ / mol) es relativamente mayor que la de CeO 2 − x (- 1024 kJ / mol); por lo tanto, aunque el Ti debido a su alta afinidad por el oxígeno captura iones de oxígeno de CeO 2 − x para formar la capa interfacial de TiO, una parte de los iones de oxígeno regresa a CeO 2 − x capa en ausencia / presencia de un campo negativo externo [38]. La energía de Gibbs de formación de óxido para TiO y ZnO son - 944 kJ / mol y - 318,52 kJ / mol respectivamente. En consecuencia, se puede obtener energía de Gibbs de formación de óxido para (1/2) CeO 2 =- 512 kJ / mol. En comparación con el ZnO, la afinidad por el oxígeno del Ce es un poco más alta que la del Zn, por lo que los iones de oxígeno se difunden desde el ZnO al CeO 2 − x capa y luego a la capa de TiO desde donde estos iones pueden migrar a TE, dejando vacantes de oxígeno en las capas de óxido. En consecuencia, todos los iones de oxígeno se juntan en la interfaz superior y se forman filamentos conductores con huecos de oxígeno entre los electrodos. En presencia de polaridad de polarización opuesta, los iones de oxígeno se envían de regreso a las capas de óxido, lo que resulta en el llenado de las vacantes de oxígeno que conducen a la ruptura del filamento.
Las funciones de trabajo de los electrodos superior de Ti e inferior de Pt son 4,33 y 5,65 eV respectivamente [39]. La afinidad electrónica y la función de trabajo del ZnO (3,37 eV y 4,35 eV) son más altas que las del CeO 2 (3,50 eV y 3,2 eV) [40]. Entonces, una barrera de energía en el ZnO / CeO 2 − x Se espera una interfaz, como la barrera de Schottky. En el régimen de voltaje positivo, los electrones no se pueden inyectar fácilmente a través de los defectos en CeO 2 por electrodo inferior de Pt a la capa de ZnO porque la función de trabajo de ZnO es más alta que CeO 2 . Es por eso que los electrones son menos capaces de desplazarse del electrodo superior de ZnO al Ti, ya que el Ti no puede atraer iones de oxígeno del ZnO debido a sus funciones de trabajo similares. La altura de la barrera en la parte superior Ti / ZnO y CeO 2 − x / Las interfaces inferiores de Pt son respectivamente 0.05 eV y 2.45 eV, altura de barrera en CeO 2 / La interfaz inferior de Pt es más alta, por lo que los electrones no pueden activarse fácilmente del metal al dieléctrico, lo que da como resultado la formación de una barrera de Schottky en la interfaz inferior [41].
Sin embargo, la altura de la barrera de la interfaz superior Ti / ZnO es insignificante debido a funciones de trabajo similares, pero es mucho más alta en la parte inferior CeO 2 − x / Pt interfaz, por eso la polaridad del campo de polarización no es suficiente para equilibrar las alturas de barrera de las dos interfaces; en consecuencia, las características de resistencia y conmutación de Ti / ZnO / CeO 2 − x / La heteroestructura de Pt no es tan buena con la polaridad positiva de la polarización aplicada. Cuando se aplica un barrido de voltaje negativo al electrodo superior de Ti, la inyección de electrones de Ti TE no puede controlar la barrera en la interfaz Ti / ZnO porque no se forma una barrera Schottky en la interfaz superior Ti / ZnO en Ti / ZnO / CeO 2 − x / Pt heteroestructura como se muestra en la Fig. 8a, b.
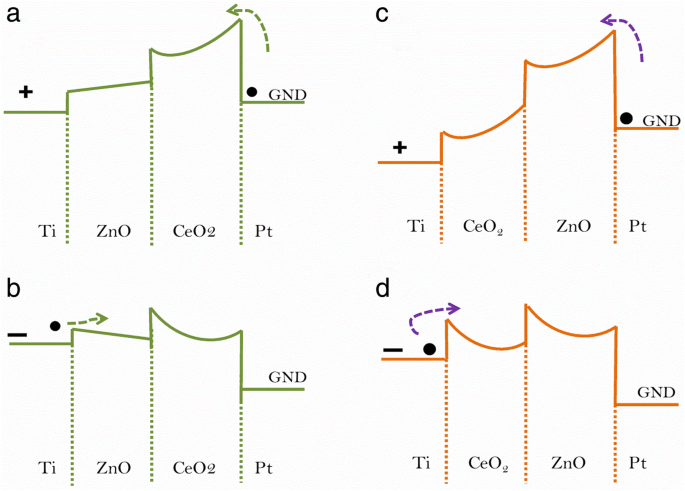
Diagramas esquemáticos para el desplazamiento de la banda de conducción de a , b Ti / ZnO / CeO 2 − x / Pt y c , d Ti / CeO 2 − x / ZnO / Pt dispositivos de memoria de heteroestructura. Las flechas representan la dirección de deriva de los electrones según las polaridades de conmutación
En la región de voltaje positivo, por otro lado, los electrones se pueden inyectar fácilmente a través de los defectos en ZnO del electrodo de Pt al CeO 2 − x capa. Estos electrones luego se derivan de CeO 2 − x capa al electrodo superior de Ti. Las alturas de barrera del Ti / CeO superior 2 − x (1,13 eV) y las interfaces inferiores ZnO / Pt (2,28 eV) sugieren una emisión de Schottky como se muestra en la Fig. 8c, d. Cuando se aplica un voltaje negativo al electrodo superior de Ti, la inyección de electrones desde el electrodo superior está controlada por esta barrera de Schottky en Ti / CeO 2 − x interfase, porque los fenómenos de captura y eliminación de trampas pueden ocurrir fácilmente en la barrera inferior (1,13 eV). Los iones de oxígeno se pueden migrar a Ti / CeO 2 − x interfaz aplicando un voltaje positivo. El mecanismo RS en Ti / CeO 2 − x El dispositivo de memoria de heteroestructura de ZnO / Pt puede explicarse por la creación y disolución de filamentos conductores con vacantes de oxígeno en las capas de óxido [41]. Significa que los iones de oxígeno pueden moverse hacia adelante y hacia atrás entre Ti / CeO 2 − x interfaz y capas de óxido por dos polaridades opuestas de la polarización externa. Cuando se barre un voltaje positivo en el electrodo de Ti, los iones de oxígeno se derivan de CeO 2 − x / ZnO a Ti / CeO 2 − x interfaz. Los filamentos conductores con vacantes de oxígeno se forman en la capa de óxido y, en consecuencia, el estado de resistencia cambia de estado APAGADO (HRS) al estado ENCENDIDO (LRS). Cuando se barre un voltaje negativo en Ti TE, se inicia el proceso de eliminación de trampas y los iones de oxígeno se recolectan en Ti / CeO 2 − x la interfaz se mueven hacia el electrodo inferior. Los filamentos conductores se rompen debido a la migración de iones de oxígeno. De este modo, el dispositivo se conmuta de nuevo a HRS. Con base en los resultados actuales, hemos investigado el efecto de la heteroestructura del dispositivo como CeO 2 − x / ZnO y ZnO / CeO 2 − x y polaridad de electroformado en parámetros de conmutación resistiva para posibles aplicaciones en dispositivos de memoria resistivos de acceso aleatorio. Hemos notado que tanto las estructuras del dispositivo como su polaridad de electroformado tienen una influencia significativa en los parámetros de conmutación, como el voltaje de electroformado, la ventana de memoria y la uniformidad en los voltajes SET / RESET. Sin embargo, se necesita más atención para lograr un tiempo de programación / borrado más rápido, una mayor escalabilidad, dispositivos sin electroformado y de baja emisión en investigaciones futuras. En particular, es necesario trabajar para elegir el material de electrodo adecuado, utilizando nanocristales o iones metálicos incrustados en una capa aislante y un dispositivo de fabricación en las estructuras de la capa amortiguadora.
Conclusiones
En conclusión, se han realizado investigaciones profundas sobre el comportamiento de RS cambiando la morfología de la bicapa ZnO / CeO 2 − x y director ejecutivo 2 − x / Heteroestructuras de ZnO y signo de polaridades de electroformado. Se nota un impacto significativo en el rendimiento, las características de resistencia, los voltajes de electroformado y la uniformidad en los voltajes operativos. Los resultados experimentales revelan la formación de una capa interfacial de TiO en Ti / CeO 2 − x / ZnO / Pt heteroestructura al aplicar sesgo de polaridad positiva, y CeO 2 − x La capa durante la polaridad negativa sirve como depósito de oxígeno en Ti / ZnO / CeO 2 − x / Pt heteroestructuras. En conjunto, puede desempeñar un papel importante en la mejora de la uniformidad y repetibilidad de los parámetros RS. El mecanismo de conducción dominante en HRS fue la emisión de Schottky limitada por electrodos en una región de campo alto. La dependencia de la temperatura de las resistencias LRS y HRS lleva a la conclusión de que el mecanismo RS observado se basa en el movimiento de las vacantes de oxígeno bajo el voltaje aplicado.
Abreviaturas
- BRS:
-
Conmutación resistiva bipolar
- DC:
-
Corriente continua
- HRS:
-
Estado de alta resistencia
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- LRS:
-
Estado de baja resistencia
- MAMÁ:
-
Metal-óxido-metal
- RRAM:
-
Memoria resistiva de acceso aleatorio
- RS:
-
Conmutación resistiva
- TE:
-
Electrodo superior
- URS:
-
Conmutación resistiva unipolar
Nanomateriales
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Propiedades paramagnéticas de nanomateriales derivados del fullereno y sus compuestos poliméricos:efecto de bombeo drástico
- Síntesis hidrotermal de nanopartículas de In2O3, gemelos híbridos, discos hexagonales, heteroestructuras de ZnO para mejorar las actividades fotocatalíticas y la estabilidad
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Síntesis de nanocristales de ZnO y aplicación en células solares de polímero invertido
- Efecto sinérgico del grafeno y los MWCNT en la microestructura y las propiedades mecánicas de los nanocompuestos de Cu / Ti3SiC2 / C
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Propiedades ópticas de películas de ZnO dopado con Al en la región infrarroja y sus aplicaciones de absorción
- Preparación y propiedades antibiofilm de películas compuestas de óxido de zinc / alúmina anódica porosa



