Transistor de memoria ferroeléctrico MoS2 2D de funcionamiento de bajo voltaje con estructura de compuerta Hf1-xZrxO2
Resumen
El transistor de efecto de campo ferroeléctrico (FeFET) surge como una tecnología de memoria no volátil intrigante debido a su prometedora velocidad de funcionamiento y resistencia. Sin embargo, cambiar la polarización requiere un alto voltaje en comparación con el de la lectura, lo que afecta el consumo de energía de escribir una celda. Aquí, informamos una celda FeFET compatible con CMOS con bajo voltaje de funcionamiento. Diseñamos el ferroeléctrico Hf 1-x Zr x O 2 (HZO) para formar dieléctricos de puerta de capacitancia negativa (NC), que genera un bucle de histéresis en el contador de reloj de dominio de polarización en el disulfuro de molibdeno de pocas capas (MoS 2 ) FeFET. El capacitor negativo no estabilizado soporta inherentemente la tasa de oscilación subthermiónica y por lo tanto permite cambiar la polarización ferroeléctrica con la ventana de histéresis mucho menos de la mitad del voltaje de operación. El FeFET muestra una alta relación de corriente de encendido / apagado de más de 10 7 y una ventana de memoria en sentido antihorario (MW) de 0,1 V con un voltaje mínimo de programa (P) / borrado (E) de 3 V. Resistencia robusta (10 3 ciclos) y retención (10 4 s) también se demuestran las propiedades. Nuestros resultados demuestran que el HZO / MoS 2 El transistor de memoria ferroeléctrica puede lograr nuevas oportunidades en aplicaciones de memoria no volátil escalables en tamaño y voltaje.
Antecedentes
El mercado de memoria integrada de sistema en chip (SoC) se encuentra actualmente en una era de enorme crecimiento, que requiere que la memoria sea capaz de lograr un funcionamiento más rápido, un tamaño de celda más pequeño y un menor consumo de energía [1,2,3,4,5,6 ]. La memoria ferroeléctrica, uno de los candidatos más prometedores, ha sido reconsiderada debido al descubrimiento del óxido de hafnio ferroeléctrico en 2011 [7].
En las últimas décadas, FeFET no se desempeñó bien en todos estos aspectos, incluidos los requisitos de bajo voltaje para la operación de la memoria, la simplicidad de los pasos del proceso y el proceso de integración de semiconductores de óxido de metal (CMOS) mínimamente complementario y preocupaciones de contaminación limitada [8,9,10, 11]. Para abordar esto, recientemente, se ha realizado una tremenda investigación sobre la memoria no volátil (NVM) 2D FeFET basada en varios materiales ferroeléctricos, incluido PbZrTiO 3 (PZT) y [P (VDF-TrFE)] polímero [12,13,14,15,16,17,18], que se debe a las propiedades prometedoras del material 2D en "más que la era de Moore". En el FeFET, los dos estados estables de polarización espontánea de un material ferroeléctrico incorporado en una pila de compuertas de transistores se utilizan para el almacenamiento de datos a través del voltaje umbral controlable habilitado por los voltajes de compuerta P / E reducidos aplicados. Se informa que los comportamientos de histéresis reproducibles, una alta relación de encendido / apagado de 10 4 , buenas propiedades de retención hasta 10 4 s, y se ha logrado una operación de conmutación estable en PZT / MoS 2 FeFET [19]. Notablemente, una movilidad máxima de 625 cm 2 / V ∙ s, un gran MW de 16 V para una compuerta de ± 26 V:rango de voltaje y una alta relación de encendido / apagado de 8 × 10 5 también han sido demostrados por un polímero de tipo n [P (VDF-TrFE)] / MoS 2 FeFET [15]. Sin embargo, existen muchos problemas fundamentales que podrían impedir su aplicación práctica, como la compatibilidad con CMOS, la capacidad de escalado y los estados de la interfaz entre Fe y material 2D. El óxido de hafnio ferroeléctrico, un tipo de material ferroeléctrico novedoso, tiene una excelente compatibilidad con CMOS y capacidad de escalado, lo que podría servir para el nodo de tecnología avanzada de FeFET NVM en un nodo de tecnología inferior a 5 nm en los próximos 5 a 10 años [20]. En consecuencia, un lote de HfO 2 Se han incorporado pilas dieléctricas basadas en 2D en FeFETs 2D, que tienen como objetivo lograr transistores de efecto de campo de capacitancia negativa (NCFET) con conmutación de ENCENDIDO / APAGADO abrupto a través de una pendiente de menos de 60 mV / década y características libres de histéresis [21,22,23 , 24,25,26], aunque los experimentos de masa basados en la pila dieléctrica NC con materiales de canal 2D alternativos han extraído conclusiones fantásticas, destacaron los requisitos de sobretensión para distinguir entre NCFET y FeFET. Todavía hay una falta de investigación sistemática con respecto a la física y la viabilidad de la tecnología del dispositivo en la memoria ferroeléctrica de un transistor basada en MoS 2 y HZO ferroeléctrico.
En este trabajo, un FeFET con un HZO MoS 2 de pocas capas Se ha propuesto un transistor. Es capaz de escalar el voltaje P / E a través del efecto NC inducido por la ingeniería de la pila de puertas bajo un voltaje P / E reducido. Demostramos experimentalmente que en HZO MoS 2 se ha logrado un MW en sentido antihorario de 0,1 V con pendiente inferior a 60 mV / década FeFET, que se puede atribuir a la modulación de la densidad de portadora local en el canal 2D mediante un cambio rápido del dipolo ferroeléctrico. Atribuimos la histéresis disminuida de HZO / MoS 2 FeFET como voltaje de drenaje aumentando a efecto negativo de reducción de barrera inducida por drenaje (DIBL). Además, también se estudió sistemáticamente la retención, las características de resistencia y la dependencia del voltaje umbral del voltaje de drenaje de HZO MoS 2 FeFET, abriendo un camino viable para diseñar HZO MoS 2 FeFET NVM y sus aplicaciones prácticas.
Métodos
6 nm Hf 1-x Zr x O 2 película y 2 nm Al 2 O 3 fue depositado el p + Sustrato de Si usando ALD a 300 ° C, con [(CH 3 ) 2 N] 4 Hf (TDMAHf), [(CH 3 ) 2 N] 4 Zr (TDMAZr) y H 2 O vapor como precursor de Hf, precursor de Zr y precursor de oxidante, respectivamente. Posteriormente, el sustrato se sometió a un recocido térmico rápido (RTA) a 450 ° C durante 30 s en N 2 ambiente. Después de eso, MoS 2 de pocas capas las escamas se exfoliaron mecánicamente y se transfirieron al sustrato. El diámetro de p + Sustrato de Si utilizado para depositar HZO (6 nm) / AI 2 O 3 (2 nm) es de 6 pulgadas. Empleamos la litografía por haz de electrones (EBL) para modelar las almohadillas de contacto en la resistencia de poli (metacrilato de metilo) (PMMA) A5. Los parámetros de centrifugado, los parámetros de horneado y los parámetros de imagen son 500 r / min (9 s) + 4000 r / min (40 s), 170 ° C (5 min), MIBK:IPA =1:3 (15 s), respectivamente . Luego, los electrodos de fuente / drenaje (Ti / Au, 5/65 nm de espesor) se evaporaron usando un sistema de evaporación por haz de electrones (EBE) y se grabaron con una solución de acetona. Después del despegue, el dispositivo se recoció a 300 ° C durante 2 h para mejorar el contacto. Realizamos la caracterización eléctrica de nuestro MoS 2 fabricado / Transistores de efecto de campo HZO que utilizan una estación de sonda con un micromanipulador. El voltaje de la puerta trasera ( V GS ) se aplicó sobre el sustrato de Si tipo p fuertemente dopado. Se utilizó un sistema de caracterización de semiconductores (PDA) para medir el voltaje fuente-drenaje ( V DS ), el voltaje de la puerta trasera ( V GS ), y la corriente de drenaje de la fuente ( I DS ).
Resultados y discusión
Preparamos un MoS 2 de pocas capas por exfoliación mecánica de cristal a granel y transfirió el MoS 2 nanoflake en 2 nm Al 2 O 3 / 6 nm HZO / p + Sustrato de Si (ver más detalles en la sección “Experimental”). Las figuras 1a yb muestran una vista esquemática en 3D y una sección transversal del HZO / MoS 2 Estructura FeFET, respectivamente. Una imagen de microscopía electrónica de barrido (SEM) de vista superior del HZO / MoS 2 FeFET se muestra en la Fig. 1c. El ancho y largo del MoS 2 canal son 2 μm y 12 μm, respectivamente. Como se muestra en la Fig. 1d, el grosor del MoS 2 El canal se confirmó mediante microscopía de fuerza atómica (AFM). El espesor medido de 1,57 nm indica la presencia de 4 capas de MoS 2 [26].
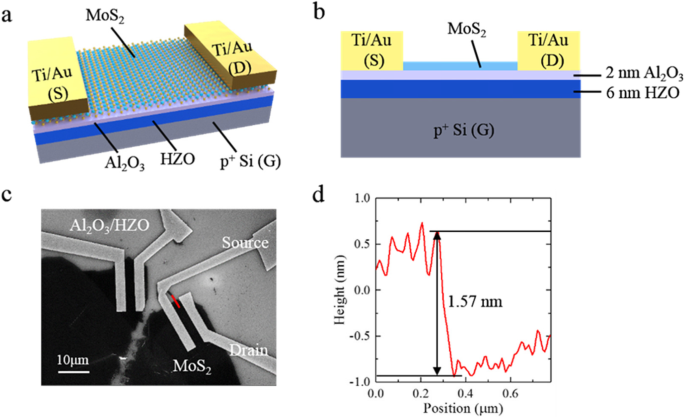
Estructura del dispositivo y propiedades básicas del MoS 2 / HZO FeFET. un Representación esquemática tridimensional del MoS 2 / HZO FeFET. b Sección transversal esquemática del MoS 2 / HZO FeFET. c Imagen SEM de vista superior del MoS 2 fabricado / HZO FeFET con electrodos de drenaje / fuente de Ti / Au, aisladores de compuerta ferroeléctrica HZO y MoS 2 canales. d Perfil de altura usando AFM en modo de contacto a lo largo de la línea roja en c , validando la altura del MoS 2 canal.
Como se muestra en la Fig. S1c yd, la composición elemental y de enlace de HZO se examinó mediante las mediciones de fotoelectrones de rayos X (XPS). Se encuentra que los picos son 19.05 eV, 17.6 eV, 185.5 eV y 183.2 eV, que corresponden al Hf 4f 5/2 , Hf 4f 7/2 , Zr 3d 3/2 y Zr 3d 5/2 , respectivamente [27]. La concentración atómica a lo largo del perfil de profundidad en la Fig. S1e confirma aún más la distribución del Al 2 O 3 / HZO / p + Estructura de tres capas de Si. Todo lo anterior confirma que la película de HZO que crece a través de nuestro sistema de deposición de capa atómica (ALD) es altamente cristalina.
Antes de investigar la caracterización de HZO / MoS 2 FeFET, el comportamiento ferroeléctrico del Au / 2 nm Al 2 O 3 / 6 nm HZO / p + En la Fig. 2a se muestra la pila de compuertas de Si que utiliza la medición de voltaje de polarización. Claramente, nuestro HZO de 6 nm / Al 2 de 2 nm fabricado O 3 los condensadores exhiben bucles de histéresis de voltaje de polarización (medidos a 1 kHz). Mientras tanto, la polarización remanente P r y el voltaje coercitivo V c aumenta al aumentar el voltaje de barrido máximo, lo que implica el P-V Los bucles de histéresis se transforman de bucle menor a bucle mayor. A medida que el voltaje de barrido máximo aumenta de 2 a 4 V, P r alcanza 0,66 μC / cm 2 , 0,86 μC / cm 2 y 1,1 μC / cm 2 , respectivamente y V c alcanza 1,12 V, 1,9 V y 2,04 V, respectivamente. P extraído r y V c dentro de 10 5 Los ciclos de barrido de CC duraderos se muestran en la Fig. 2b y c. Obviamente, efectos de despertar y fatiga significativos dentro de 10 5 Los ciclos se observan en el HZO de 6 nm / Al 2 de 2 nm O 3 condensador. El despertar y la fatiga se pueden atribuir a la difusión y redistribución de las vacantes de oxígeno bajo el campo eléctrico. El efecto de fatiga generalmente se asocia con la captura de carga en los sitios de defectos relacionados con las vacantes de oxígeno [28]. Los comportamientos de histéresis para la PRphase y lazo en forma de mariposa para el PRampl utilizando microscopía de fuerza de respuesta piezoeléctrica (PFM) se muestran en la Fig. S1b yc, lo que indica un cambio de polarización en función del voltaje de polarización de barrido. Teniendo en cuenta las diferentes resistencias de contacto entre la medición de voltaje de polarización y la medición de voltaje de respuesta piezoeléctrica, el V medido c en la Fig. S1b yc no es tan consistente con los valores obtenidos en la Fig. 2a.

un Bucles de histéresis P-V para HZO (6 nm) / Al 2 O 3 (2 nm) condensador con diferentes rangos de barrido de voltaje. Dependencia de ( b ) P r y c V c sobre ciclismo para HZO (6 nm) / Al 2 O 3 (2 nm) condensador con ciclos de ± 4 V / 1 kHz
Además, se observa que hay un aumento en MW acompañado con el rango de voltaje de barrido elevado del voltaje de la puerta ( V GS, rango ). Por lo general, la película policristalina HZO existe como estado multidominio [29], y la distribución del campo coercitivo de estos dominios satisface la distribución gaussiana. Por lo tanto, debe haber una mayor dependencia de la V elevada GS, rango . El coercitivo archivó E C corresponde al valor del campo eléctrico externo que puede reducir la polarización remanente a cero. Por lo tanto, la V GS , rango utilizado para cambiar la polarización en la película HZO se vuelve más grande con un voltaje coercitivo relacionado más alto V C . Esta es la razón por la que los bucles de voltaje de polarización de la película HZO se extienden con un V más grande. GS, rango , que se ha demostrado en la Fig. 2a. En otras palabras, la intensidad de polarización mejorada y la conmutación ferroeléctrica ocurren con el V elevado GS, rango , lo que lleva a los fenómenos antes mencionados del MW extendido en sentido antihorario producido por el aumento de V GS, rango . En V GS, rango =(−2, 2 V), los MW casi desaparecen y emergen características casi libres de histéresis, lo que significa la compensación casi completa entre los efectos de la conmutación ferroeléctrica y la captura / eliminación de trampas de carga.
Para investigar más a fondo el efecto de la conmutación ferroeléctrica, el V GS, rango se ha incrementado continuamente a (−6, 6 V) y (−6,5, 6,5 V). El I medido DS - V GS curvas del HZO MoS 2 FeFET en V GS, rango =(−6, 6 V) y (−6,5, 6,5 V) se muestran en la figura 3a. De manera similar, la ventana de memoria en sentido antihorario aumenta con la V extendida GS, rango . En V GS, rango =(−6,5, 6,5 V), el MW en sentido antihorario está por encima de 4 V y la relación de encendido / apagado también aumenta a 10 7 , que se debe a la conmutación de polarización mejorada bajo un voltaje aplicado externo mayor. Generalmente, el mecanismo subyacente a los comportamientos de histéresis que se muestran en el I DS - V GS curvas durante el barrido bidireccional de V GS es el cambio de voltaje de umbral, que puede ser modificado por los efectos predominantes de la conmutación de polarización, es decir, el efecto NC [30,31,32], que da como resultado una histéresis en sentido antihorario. Se llevó a cabo un estudio adicional de las características mejoradas del subumbral en el otro dispositivo bajo una V reducida GS, rango . El I medido DS - V GS y punto extraído SS— I DS curvas del otro dispositivo en V GS, rango =(−3, 3 V) se grafican en la Fig. 3b. Está demostrado que en V GS, rango =(−3, 3 V), HZO / MoS 2 FeFET exhibe SS For =51,2 mV / década y SS Rev =66,5 mV / década, respectivamente. Es decir, la SS de menos de 60 mV / década y un MW de 0,48 V se pueden lograr simultáneamente en HZO / MoS 2 FeFET a temperatura ambiente, que será una pista para distinguir entre NCFET y FeFET.
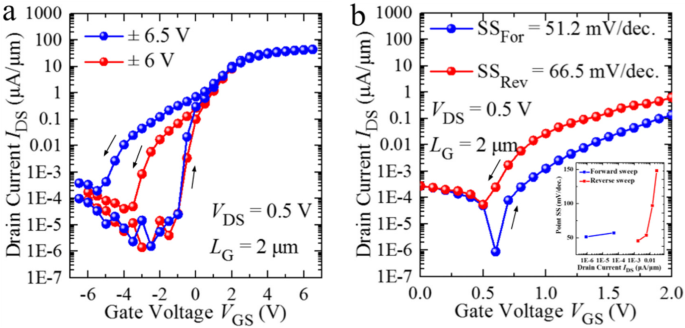
La prueba de corriente continua (CC) del HZO / MoS 2 FeFET cuando el voltaje de drenaje ( V DS ) es 0,5 V. a La comparación entre las curvas de transferencia con 6 V y 6,5 V como máximo de la tensión de puerta trasera. b Vista ampliada de las curvas de transferencia en un intervalo de 0 a -2 V de V GS, rango =(−3, 3 V). Pendiente de subumbral puntual (SS) en función de la corriente de drenaje ( I DS ) del HZO / MoS 2 FeFET es ( b ) recuadro. El dispositivo muestra SS For =51,2 mV / dec
Como se sabe, en NCFET, el SS puede ser menor de 60 mV / década a temperatura ambiente debido a la incorporación de la capacitancia dieléctrica de puerta negativa ( C ins ), que se puede obtener mediante el segmento de pendiente negativa de d P / d E <0 inducida por la película ferroeléctrica, contribuyendo al factor de pila de la puerta (m) <1. El mecanismo subyacente al efecto NC [33] es el campo de despolarización generado por la película ferroeléctrica [34,35,36,37,38]. Se ha informado experimentalmente que debido al apantallamiento incompleto en la interfaz de la película ferroeléctrica [39], la carga de polarización residual podría producir un campo eléctrico interno a través de la película ferroeléctrica, que tiene la dirección opuesta al voltaje aplicado externamente, lo que lleva a la distribución del voltaje a través de la pila de puertas y el potencial de superficie del canal amplificado, denominado "efecto de amplificación de voltaje" [40,41,42]. Por lo general, la amplificación de voltaje se puede dividir en dos partes, la variación acelerada del potencial de la superficie del canal y el valor reforzado posterior, lo que proporciona la conmutación de ENCENDIDO / APAGADO abrupta y la I mejorada ACTIVADO / Yo APAGADO , respectivamente. Sin embargo, para FeFET, hay otra historia. Según el concepto de adaptación de capacitancia entre capacitancia ferroeléctrica ( C FE ) y capacitancia semiconductora de óxido metálico ( C MOS ) [43, 44, 45], cuando | C FE |> C MOS , la capacitancia total teórica ( C total ) es positivo y el sistema es estable, lo que da como resultado los mismos comportamientos de polarización durante el barrido bidireccional de V GS y el NCFET estable sin histéresis. Sin embargo, una buena coincidencia que da como resultado una SS y una transconductancia mejoradas es muy difícil de lograr, ya que tanto C MOS y C FE son condensadores muy no lineales y dependientes de la polarización. Además, | C FE |> C MOS debe garantizarse para todo el rango de voltaje de funcionamiento para evitar la histéresis. En cambio, una vez | C FE | < C MOS , la C teórica total es negativo y el sistema es inestable, debe producirse un comportamiento de polarización separada durante la bi-conmutación de V GS para mantener la C total positivo, que podría producir la histéresis en sentido antihorario en FeFET para la aplicación NVM. Aquí, se menciona que los comportamientos histeréticos son el efecto posterior de la conmutación de polarización separada, lo que significa que el ancho de la ventana de histéresis se puede modificar fácilmente en función del concepto de adaptación de capacitancia, como, que puede manipularse mediante la variación de V DS . Con un ajuste de capacitancia apropiado, incluso con un V muy reducido GS, rango =(−3, 3 V), HZO / MoS 2 FeFET todavía exhibe una ventana de histéresis obvia, y el cambio abrupto de SS For =51,2 mV / dec al mismo tiempo, lo que sugiere además la existencia del efecto NC (efecto de polarización ferroeléctrica) también en la región subumbral. Aunque NCFET y FeFET son diferentes, FeFET también se puede adoptar como dispositivos lógicos con un MW más pequeño comparable, manteniendo un SS profundo por debajo de 60 mV / dec y un I más alto. ACTIVADO / Yo APAGADO proporción también debido al efecto NC.
El impacto de V DS sobre el ancho de MW se ha investigado cuidadosamente. El yo DS - V GS curvas en escalas logarítmicas bajo diferentes V DS se caracterizan en la Fig. S3. Se exhibe que, en una V fija GS, rango =(−2, 2 V), los valores de V GS extraído en I DS =70 nA para el barrido bidireccional de V GS todos cambian a la dirección negativa. Mientras tanto, también se demuestra que la variación en el barrido hacia adelante de V GS es mucho más obvio que el de barrido inverso, lo que indica los fenómenos significativos de DIBL negativo. Cabe señalar que el efecto DIBL negativo siempre ocurre con un efecto NC [46, 47].
Después de la prueba de corriente continua (CC) anterior del HZO / MoS 2 FeFET, además llevamos a cabo los MW medidos para diferentes P / E V GS pulsos con 10 ms de ancho en la Fig. 4a. MW se define como el cambio máximo Δ V TH después de P / E V GS pulsos. Durante el V pulsado GS aplicación, los otros terminales se fijaron en V S = V D =0 V. Para la operación de lectura (R), V GS estaba en el rango de -1 V a 1 V con V D =0,5 V y V S =0 V. Como se muestra en la Fig. 4a, los MW extraídos se vuelven más grandes como P / E V GS aumentan las legumbres. Cuando el P / E V impuesto GS El pulso es de ± 3 V, el MW extraído es de 0,1 V. Cuando el P / E V impuesto GS El pulso es de ± 5,5 V, el MW extraído es 0,275 V. En comparación con los MW en sentido antihorario de 4 V y 0,48 V en la Fig. 3a yb, los MW extraídos después de P / E V GS el pulso se reduce considerablemente. Esto posiblemente se deba a una mayor densidad de estados de atrapamiento inducidos por la alta humedad en el aire [48]. Por lo tanto, el mecanismo de captura / eliminación de trampa de carga se mejora y el bucle de histéresis en sentido antihorario finalmente se reduce. Además, estudiamos la resistencia al ciclismo y la retención de datos del HZO / MoS 2 FeFET bajo pulsos P / E con una altura de ± 5,5 V en la Fig. 4b. El programa V GS el pulso fue de 10 ms de ancho con V S = V D =0 V. La Figura 4b ilustra los MW medidos en función de los ciclos de resistencia. El ciclo de resistencia está formado por pulsos periódicos P / R / E / R de voltaje de puerta trasera. Los voltajes aplicados a la puerta trasera de la altura de P, E, R fueron + 5,5 V, −5,5 V y 0 V, respectivamente. Y el ancho de pulso de P y E fue de 10 ms. Claramente, un MW de 0,3 V se puede mantener sin una degradación significativa después de 10 3 Ciclos P / E. A medida que aumenta el número de ciclos de resistencia, el MW aumenta a 0,38 V después de 10 ciclos y luego vuelve a disminuir a 0,28 V después de 600 ciclos. El primer MW ampliado se denomina efecto despertador y el MW reducido posterior se denomina efecto de fatiga. El efecto de despertar corresponde al des-pinning de la pared del dominio, lo que lleva a un aumento de los dominios de polarización conmutables de la película HZO [49]. El efecto de fatiga corresponde a cargas recién inyectadas que fijan las paredes del dominio después de un gran número de ciclos P / E [50]. La retención de datos a temperatura ambiente se muestra en la Fig. 4c. Aquí, la degradación de MW es insignificante después de 10 4 s. Por lo tanto, se puede esperar que un MW de aproximadamente 0,3 V sea sostenible durante 10 años mediante las líneas de extrapolación de puntos. Como se muestra en la Fig. 4d, el dispositivo es estable después de 10 3 ciclos bajo los pulsos P / E con alturas de ± 3 V. La estabilidad del HZO / MoS 2 FeFET muestra una gran perspectiva de las aplicaciones en la tecnología de memoria no volátil.

Rendimiento de la memoria del HZO / MoS 2 FeFET bajo pulsos P / E. un MW extraídos (MW) bajo pulsos P / E con alturas de ± 3 V, ± 4 V, ± 5 V, ± 5,5 V y ± 6 V. b Medidas de resistencia en condiciones de pulso P / E. c Característica de retención del HZO / MoS 2 FeFET. d Resistencia del HZO / MoS 2 FeFET por 10 3 ciclos bajo los pulsos P / E con alturas de ± 3 V
Una comparación de la figura del mérito con los dispositivos basados en FeFET que combinan MoS 2 y los dieléctricos de compuerta ferroeléctrica se proporcionan en la Tabla 1. Aquí, se enumeran la estructura del dispositivo, la polarización remanente, el campo eléctrico coercitivo, la dirección del bucle de histéresis, el MW, el voltaje de trabajo, los ciclos de resistencia y el tiempo de retención. Es obvio que el dispositivo que fabricamos exhibe la capa ferroeléctrica más delgada de 6 nm HZO y el voltaje de trabajo más bajo en comparación con otros trabajos [12,13,14,15,16,17,18], lo cual es importante para el futuro 2 nm o el nodo de proceso de 3 nm de la memoria de final de línea (BEOL). Al escalar el grosor de la capa ferroeléctrica, se logró un MW de aproximadamente 0,1 V bajo un voltaje de trabajo bajo de ± 3 V.Un voltaje de trabajo tan bajo se puede atribuir a las características intrínsecas de la capa de HZO en comparación con sus contrapartes, como P (VDF-TrFE) o HfO 2 , que tiene un espesor mucho mayor. Además, nuestro dispositivo posee una polarización remanente menor P r de 1,1 μC / cm 2 en comparación con otros FeFET informados. La rápida desintegración de la pérdida de retención en un FeFET se debe a la existencia del campo de despolarización E dep , que proviene de la compensación de carga incompleta debido a la existencia del Al 2 O 3 capa. Aquí, E dep es directamente proporcional a la polarización remanente P r [51]. Por lo tanto, la alta E c y bajo P r haz la proporción E dep / E c en MoS 2 / HZO FeFET mucho menor, lo que lleva a una pérdida de retención muy pequeña asociada con el efecto de campo de despolarización. Aunque las prestaciones de retención de MoS 2 Los FeFET basados en HZO y P (VDF-TrFE) rondan los 10 4 s, la película P (VDF-TrFE) debe ser de 150 nm [17].
Conclusiones
En conclusión, investigamos MoS 2 de pocas capas dispositivos de transistores de memoria ferroeléctricos basados en un dieléctrico de puerta trasera HZO. Nuestros dispositivos fabricados exhiben histéresis en sentido antihorario inducida por polarización ferroeléctrica. Además, nuestro HZO / MoS 2 El transistor de memoria ferroeléctrica mostró un excelente rendimiento del dispositivo:una alta relación de corriente de encendido / apagado de más de 10 7 y un MW en sentido antihorario de 0,1 V a un voltaje P / E de 3 V, que tiene la resistencia (10 3 ciclos) y retención (10 4 s) desempeño. Por lo tanto, creemos que los resultados de nuestro MoS 2 Los transistores de memoria ferroeléctricos no volátiles basados en datos muestran perspectivas prometedoras para el futuro de las aplicaciones de memoria no volátil 2D de baja potencia.
Disponibilidad de datos y materiales
Los autores declaran que los materiales, datos y protocolos asociados están disponibles para los lectores, y todos los datos utilizados para el análisis están incluidos en este artículo.
Nanomateriales
- Clasificaciones y paquetes de transistores (BJT)
- Algunos ejemplos con circuitos de CA
- American Control Electronics:variador de CC de bajo voltaje con opción de placa programable a presión
- MoS2 con espesor controlado para evolución electrocatalítica de hidrógeno
- Nanoesferas de carbono monodispersas con estructura porosa jerárquica como material de electrodo para supercondensador
- Electrodo de puerta plateado impreso con inyección de tinta y curado por UV con baja resistividad eléctrica
- Mejora de la absorción y modulación de frecuencia del microbolómetro THz con estructura de micropuente mediante antenas de tipo espiral
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- Transistores de efecto de campo ferroeléctricos basados en patrones de banda de micrones dominados por nanotubos de carbono de pared simple con capa de control de defectos de HfO2
- Rendimiento analógico / RF del transistor de efecto de campo de túnel de fuente dual de puerta en forma de T
- Crecimiento del mercado de control de bajo voltaje



