Transistores de efecto de campo ferroeléctricos basados en patrones de banda de micrones dominados por nanotubos de carbono de pared simple con capa de control de defectos de HfO2
Resumen
Los transistores de efecto de campo ferroeléctricos (FeFET) con nanotubos de carbono de pared simple (SWCNT) dominan una franja de micrones de ancho con patrón de canal, (Bi, Nd) 4 Ti 3 O 12 películas como aislante y HfO 2 Se desarrollaron y fabricaron películas como capa de control de defectos. Los SWCNT-FeFET preparados poseen excelentes propiedades, como conductancia de canal grande, alta relación de corriente de encendido / apagado, alta movilidad de portadora de canal, excelente rendimiento de resistencia a la fatiga y retención de datos. A pesar de su espesor equivalente de capacitancia delgada, el aislador de puerta con HfO 2 La capa de control de defectos muestra una densidad de corriente de fuga baja de 3,1 × 10 −9 A / cm 2 a un voltaje de puerta de - 3 V.
Antecedentes
El transistor de efecto de campo ferroeléctrico (FeFET) es un candidato prometedor para dispositivos de memoria no volátiles y circuitos integrados debido a su alta velocidad, estructura de dispositivo único, bajo consumo de energía y operación de lectura no destructiva [1, 2, 3]. (Bi, Nd) 4 Ti 3 O 12 (BNT) es una película delgada ferroeléctrica libre de Pb con propiedades químicas estables y rendimiento de resistencia a la fatiga. Por lo tanto, el FeFET que usa BNT como dieléctrico de puerta tendría un voltaje de umbral más pequeño, una conductancia de canal grande, etc. Los nanotubos de carbono (CNT) se han aplicado ampliamente en FeFET por su alta conductividad y gran movilidad de portadores [4, 5, 6, 7]. Es bien sabido que no hay enlaces colgantes en la superficie de los NTC ideales, lo que conduce a una pequeña reacción de interfaz entre la película ferroeléctrica y los NTC [8, 9]. Sin embargo, es muy difícil lograr un único crecimiento de CNT entre los electrodos fuente y de drenaje en el experimento. Además, la relación de corriente de encendido / apagado de la red de nanocables de CNT FeFET es generalmente baja debido a la mezcla de nanotubos metálicos en la red de CNT [7, 10]. Song y col. propuso utilizar una franja de CNT de micras de ancho de múltiples paredes con patrón como material de canal de FeFET para resolver los problemas antes mencionados, pero el rendimiento de resistencia a la fatiga y la retención de las características físicas de CNT FeFET no está claro [9]. En comparación con el CNT de paredes múltiples (MWCNT), el CNT de pared simple (SWCNT) es una hoja de grafeno única envuelta sin costuras formada en un tubo cilíndrico [11]. Además, existen algunos defectos (como impurezas de iones, vacantes de oxígeno y dislocaciones) que son difíciles de controlar durante la fabricación de películas ferroeléctricas delgadas [12,13,14]. La difusión de estos defectos puede afectar la relación de corriente de encendido / apagado, el rendimiento de resistencia a la fatiga y la retención de datos [15, 16]. Por lo tanto, implantamos HfO 2 capa en SWCNT-FeFET, que se utiliza para bloquear la difusión de defectos puntuales y se puede utilizar como una capa amortiguadora para aliviar el desajuste entre BNT y Si y, por lo tanto, para reducir la densidad de dislocación en la película BNT. Puede controlar los defectos en SWCNT-FeFET y luego mejorar significativamente la relación de corriente de encendido / apagado, las características de fatiga y la retención de datos.
En este estudio, fabricamos SWCNT de red con patrones de bandas de micrones de ancho regulares y alineados como capa de canal, películas BNT como aislante y HfO 2 películas como capa de control de defectos para fabricar FeFET tipo puerta inferior y se espera que obtengan una buena relación de corriente de encendido / apagado, características de fatiga y retención de datos. La estructura de SWCNT-FeFET y su procedimiento de preparación se muestran en la Fig. 1a, b. Además, también hemos fabricado MWCNT-FeFET para comparar.
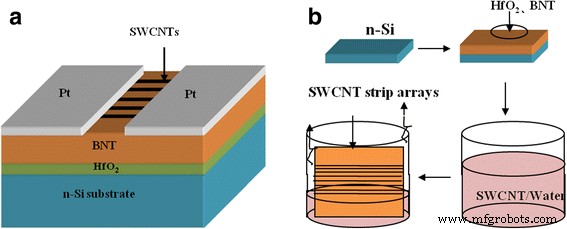
un El diagrama de estructura del SWCNT-FeFET con patrón de rayas. b Diagrama de flujo del SWCNT / BNT / HfO con patrón de franjas 2 -Fabricación FEFET
Métodos
En los dispositivos FeFET, la franja SWCNT de micrones de ancho con patrón se usa como canal, la película delgada BNT se usa como dieléctrico de puerta, HfO 2 las películas se utilizan como capa de control de defectos, y el Si tipo n fuertemente dopado se utiliza como sustrato y electrodo de puerta trasera de FeFET simultáneamente. La resistividad del Si tipo n es 0.0015 Ω cm. El HfO 2 se depositó sobre el sustrato de Si mediante deposición por láser pulsado (PLD) utilizando un láser excímero KrF con una longitud de onda de 248 nm, y su espesor es de aproximadamente 20 nm. La película de BNT se depositó sobre el sustrato de Si mediante PLD como se describe en el trabajo inicial [17], y su espesor es de aproximadamente 300 nm. El SWCNT prístino descargado por arco se compró del Instituto de Química Orgánica de Chengdu (Academia China de Ciencias); la longitud y el diámetro son de 10 a 30 μm y de 0,8 a 1,1 nm, respectivamente. Su pureza es del 85%, lo que significa que SWCNT está dominado. Los SWCNT se fabricaron mediante el autoensamblaje inducido por evaporación. La concentración de dispersión de SWCNT / agua fue de 100 mg / L, la velocidad de evaporación se varió en un rango de 9 a 21 μL / min y la temperatura fue de 80 ° C. Al controlar la temperatura de evaporación del solvente, se formó un patrón de rayas bien definido en la interfaz sólido-líquido-vapor en el BNT / HfO 2 / Sustrato de Si. A continuación, se depositaron electrodos de fuente / drenaje de Pt en los SWCNT / BNT mediante pulverización catódica con haz de iones utilizando una placa de máscara. El área total de la placa metálica de la máscara es de 1 cm 2 , y las áreas de origen y drenaje son de 4,5 mm 2 . La longitud del canal ( L ) y ancho ( W ) de FeFET son 200 y 1500 μm, respectivamente. El SWCNT-FeFET fabricado seguido de un recocido posterior a 500 ° C durante 2 h para mejorar el contacto entre los electrodos fuente / drenaje y los SWCNT. Como se informó, la red CNT contiene nanotubos metálicos y semiconductores. La red CNT se procesó aplicando un voltaje de puerta grande. Los nanotubos metálicos SWCNT fueron casi eliminados y los nanotubos semiconductores SWCNT permanecieron por corriente de carga [18]. Para comparar, SWCNT / SiO 2 -Los FET fueron fabricados con el mismo método y condiciones; MWCNTs / BNT-FET también se fabricó mediante el método descrito en el trabajo inicial [9]. Las características de FeFET se midieron utilizando un analizador de parámetros Keithley 4200. Los bucles de histéresis y las polarizaciones de FeFET se midieron utilizando un analizador ferroeléctrico RT Precision Workstation.
Resultados y discusión
La Figura 2 muestra imágenes típicas de SEM de los SWCNT con patrón de franjas. Los SWCNT regulares y alineados con un patrón de franjas de micrones de ancho se muestran en la Fig. 2a. Las franjas protuberantes y claras son franjas SWCNT, en las que las SWCNT están densamente empaquetadas como se muestra en la imagen ampliada de una franja en la Fig. 2b. Las rayas hundidas y grises corresponden al BNT / HfO 2 desnudos / Sustrato de Si en los espacios entre rayas SWCNT de micras de ancho. La concentración de la solución precursora de SWCNT aumenta con la evaporación y el ancho de las franjas graduadas aumenta ligeramente con la disminución del nivel de líquido de SWCNT / agua. El BNT / HfO 2 películas y películas BNT sobre el sustrato de Si se muestran en la Fig. 2c, d. Se puede ver que la superficie del BNT / HfO 2 La película está compuesta por muchos granos y poros cristalinos, lo que indica una rugosidad mayor que la de las películas BNT. La figura 2e muestra la P - V bucles de histéresis de BNT y BNT / HfO 2 películas, respectivamente. Las polarizaciones de los bucles de histéresis del BNT / HfO 2 las películas son más grandes que las películas BNT en el mismo voltaje. Aunque HfO 2 capa compartida parte del voltaje de BNT / HfO 2 películas, la película BNT todavía muestra un mejor valor de polarización que la de BNT cultivada en sustrato de Si. Es porque las películas BNT cultivadas en HfO 2 La capa tiene una concentración de defectos de difusión más baja que la de las películas de BNT que crecen directamente sobre el sustrato de Si.

un Micrografía SEM de franja SWCNT con patrón en SWCNT / BNT / HfO 2 -FeFET. b La estructura de cuadrícula de SWCNT. c Imagen SEM de la superficie para BNT / HfO 2 película. d Imagen SEM de la superficie para película BNT. e Bucles de histéresis de BNT y BNT / HfO 2 películas
La Figura 3 muestra las características de salida ( I DS -V DS ) curvas de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET. SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET muestran el típico p -características del transistor de canal y corrientes fuente-drenaje saturadas a bajo voltaje fuente-drenaje. La longitud de su canal ( L ) es de 200 µm. Debido al patrón de banda SWCNT de micrones de ancho, la corriente "activada" y la conductancia del canal de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET ambos alcanzan 3.8 × 10 −2 A, 3,6 × 10 −2 A y 9,5 × 10 −3 S, 9 × 10 −3 S en V GS =- 4 V y V DS =4 V. Sin embargo, SWCNT / BNT / HfO 2 -FeFET muestra corrientes en estado apagado más bajas que las de SWCNT / BNT-FeFET, y SWCNT / BNT-FeFET muestra un fenómeno de corriente de fuga grave en V GS =0 V . Esto se debe a que el HfO 2 capa bloquea eficazmente la difusión de defectos.

Curvas de características de salida de SWCNT / BNT / HfO 2 -FeFET (letf) y SWCNT / BNT-FeFET (derecha)
Las características de transferencia ( I D - V G ) del SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET con L =200 μm y V DS =0,6 V se muestran en la Fig. 4. El voltaje umbral ( V th ) de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET son V th =0,2 V y V th =0.8 V por un ajuste lineal de ( I D ) 1/2 frente a V GS curva del transistor que opera en la región de saturación. La movilidad del canal ( μ sentado ) se calcula en función de ( I DS ) 1/2 frente a V GS curva, así como la expresión de la región de saturación para un transistor de efecto de campo [19],
$$ {I} _ {\ mathrm {DS}} =\ left (\ frac {\ varepsilon_0 {\ varepsilon} _r {\ mu} _ {\ mathrm {sat}} W} {t _ {\ mathrm {ins}} 2L} \ right) {\ left ({V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}} \ right)} ^ 2 para \ kern0.5em {V_ { \ mathrm {DS}}} ^ {{} ^ 3} {V} _ {\ mathrm {GS}} \ hbox {-} {V} _ {\ mathrm {th}}, $$donde ε r es la permitividad relativa y t ins es el espesor BNT. Una constante dieléctrica relativa ( ε r ) de película BNT es 350, que se mide a 1 MHz con el analizador de parámetros HP4156. El μ sentado de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET son 395 y 300 cm 2 / V s. La figura 5 muestra el I DS - V GS curvas de transferencia logarítmica del SWCNT / BNT / HfO 2 fabricado -FeFET, SWCNT / BNT-FeFET y SWCNT / SiO 2 / HfO 2 -FET en modo de doble barrido. El barrido de voltaje de la puerta se realizó a V DS de 0,6 V y en el V GS varía de - 7 a 4 V, - 6 a 3 V y - 4 a 1 V. El I DS relación de encendido / apagado de SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y SWCNT / SiO 2 / HfO 2 -FET son 2 × 10 5 , 2 × 10 4 y 2,3 × 10 2 en el V GS rango de - 7 a 4 V. El I DS relaciones de encendido / apagado de SWCNT / BNT / HfO 2 -FeFET son más altos que los de MWCNT / BNT-FeFET [9] y SWCNT / BNT-FeFET. Es porque el HfO 2 Se implantó una capa de control de defectos en SWCNT-FeFET, que bloquea eficazmente la difusión de defectos. Para yo DS - V GS características, obtuvimos un bucle de histéresis en sentido horario debido a la inversión de polarización ferroeléctrica de la película BNT, el ancho de ventana de memoria (MW) obtenido de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET son aproximadamente 4,2 y 4,1 V, que es más grande que el de CNT / PZT-FeFET (1,1 V) con la red CNT como capa de canal [20]. El MW más grande indica un buen acoplamiento dieléctrico en este sistema FeFET. En la Fig. 4c, podemos ver el ancho de ventana obtenido de SWCNT / SiO 2 / HfO 2 -FET es de aproximadamente 1 V, que es causado principalmente por densidades de defectos de SWCNT [21]. Estos resultados sugieren que la histéresis de la ventana de memoria (4,2 V) del FeFET ferroeléctrico es causada tanto por la polarización de BNT como por las densidades de los defectos de SWCNT.
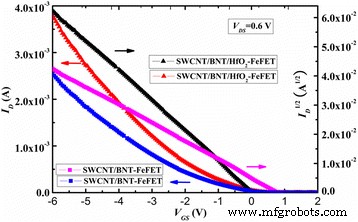
La curva de características de transferencia lineal y ajustada I DS 1/2 - V G curva en V DS =0,6 V para la franja con patrón de SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET

Curvas de transferencia logarítmica de rayas con patrón a SWCNT / BNT / HfO 2 -FeFET, b SWCNT / BNT-FeFET y c SWCNT / SiO 2 / HfO 2 -FET en V DS =0,6 V . Las flechas indican un bucle de histéresis en sentido antihorario y las líneas continuas muestran el ancho de la ventana de memoria
La Figura 6a muestra las características de corriente-voltaje de fuga del BNT / HfO 2 y película BNT. Como puede verse, las corrientes de fuga son 1,2 × 10 −9 A y 1,5 × 10 −8 A para BNT / HfO 2 y película BNT, respectivamente, cuando el voltaje alcanza hasta - 3 V. Las características de fuga corriente-voltaje del BNT / HfO 2 y la película BNT se estudiaron para su comparación ajustando el I - V datos. Las características de la corriente de fuga de un contacto Schottky fueron representadas por Ln ( J ) = b ( V + V bi * ) 1/4 [9, 22, 23] y los gráficos correspondientes para BNT / HfO 2 y películas BNT en el rango de voltaje de 0 a 3.8 V se muestran en la Fig. 6b. Los voltajes incorporados V bi * y pendiente b en la fórmula se puede obtener ajustando el experimento I-V datos. Las densidades de carga espacial calculadas N ef , que consistió en centros de atrapamiento profundo y vacantes de oxígeno [22], son aproximadamente 2.132 × 10 17 cm −3 y 1.438 × 10 19 cm −3 para BNT / HfO 2 y película BNT, respectivamente. Se indica que las películas de BNT depositadas sobre sustrato de Si son semiconductores de tipo n según la fórmula de alturas de barrera de interfaz [24]. Esto es consistente con el efecto del HfO 2 sobre la reducción de la corriente de I D - V G curva en la Fig. 4a, b, porque BNT de tipo n genera electrones y aumenta la corriente de salida en voltaje negativo. La conducción de la película de BNT muestra un mecanismo controlado por volumen, lo que implica además que el BNT de tipo n es inducido principalmente por los defectos de conducción o las impurezas [9, 22].
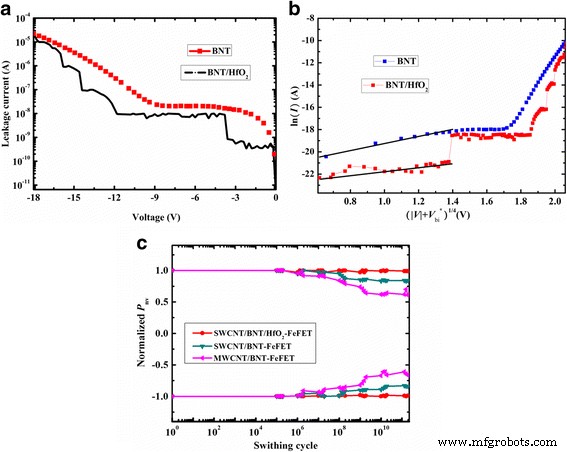
un Características de fuga de corriente-voltaje del BNT / HfO 2 y película BNT. b La curva de ajuste de las características de corriente-voltaje de fuga del BNT / HfO 2 y película BNT. c Rendimiento de resistencia a la fatiga del SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET
La Figura 6c muestra el rendimiento de resistencia a la fatiga para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET con un pulso bipolar de 100 KHz en el V GS rango de - 7 a 4 V. El rendimiento de resistencia a la fatiga de FeFET se manifiesta en la pérdida de polarización conmutable con ciclos de conmutación repetidos. El valor de la polarización no volátil ( P nv ) se obtiene mediante la ecuación P nv = P r * - P r ^ y luego, normalizado con P nv / P r0 * [25], donde P r * es el doble de polarización remanente de FeFET, P r ^ es la pérdida de polarización después del siguiente pulso, y P r0 * es la polarización remanente inicial dos veces de FeFET. La pérdida parcial de la P normalizada nv después de las 10 11 Se observan ciclos de conmutación de lectura / escritura para el FeFET, que son aproximadamente 3, 10 y 25% para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET, respectivamente. Cuando BNT crece directamente en el electrodo inferior Si, el rendimiento de fatiga de SWCNT / BNT-FeFET es muy malo debido a la difusión entre BNT y el sustrato de Si a través del límite de grano [12,13,14]. Estos resultados sugieren que el HfO 2 La capa bloquea eficazmente la difusión del sustrato de Si y reduce las impurezas de iones, lo que da como resultado un excelente rendimiento de resistencia a la fatiga.
Para evaluar la confiabilidad del dispositivo de FeFET hacia la aplicación NVRAM, hemos examinado la retención de datos. La Figura 7 muestra las curvas de retención de corriente de fuente-drenaje para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET a temperatura ambiente. El pulso de voltaje de V GS =- 4 V y V GS =1 V en V DS =1 V se aplica a la puerta y al electrodo de drenaje de la fuente, cambiando el voltaje de FeFET al estado de apagado o encendido, respectivamente. Las relaciones de corriente en estado activado / desactivado medidas son casi 3 × 10 4 , 7 × 10 3 y 6 × 10 2 para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET después de 10 6 s, respectivamente. No hay una pérdida significativa en la relación actual de estado activado / desactivado (3,2%) después de un tiempo de retención de 1 × 10 6 s para SWCNT / BNT / HfO 2 -FeFET. Extrapolando las curvas a 10 8 s para SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET, las relaciones de corriente de estado encendido / apagado son casi 1.9 × 10 4 , 3 × 10 3 y 2 × 10 2 , respectivamente. La relación de estado encendido / apagado de SWCNT / BNT / HfO 2 -FeFET sigue siendo lo suficientemente alto para la función de las memorias, lo que demuestra una propiedad de retención deseable del dispositivo de memoria actual. La retención está influenciada por la corriente de fuga de la puerta [26, 27]. El largo tiempo de retención indica HfO 2 La capa de control de defectos puede reducir eficazmente la corriente de estado apagado y la corriente de fuga de la puerta, lo que estabiliza la relación de corriente de encendido / apagado. Además, también hicimos una comparación entre los FET de base ferroeléctrica y diferentes CNT en la Tabla 1, lo que sugiere que el SWCNT / BNT / HfO 2 fabricado -FeFET en este estudio puede proporcionar una alta relación de corriente de encendido / apagado, un excelente rendimiento de resistencia a la fatiga y retención de datos.
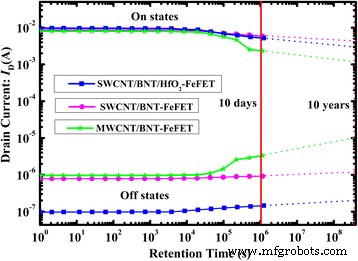
Características de retención del SWCNT / BNT / HfO 2 -FeFET, SWCNT / BNT-FeFET y MWCNT / BNT-FeFET a temperatura ambiente
Para comprender mejor cómo los defectos influyen en las características físicas del dispositivo, el P - E bucles de histéresis y I DS - V GS curva para SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET se simularon considerando la carga asimétrica causada por defectos utilizando nuestros modelos anteriores [12, 28]. Se considera que una carga asimétrica causada por defectos simula la P - E bucles de histéresis y I DS - V GS curva de BNT, y se considera que una carga simétrica simula la de BNT / HfO 2 . Los resultados de la simulación se muestran en las Fig. 8a, b, que son similares a los resultados experimentales de las Figs. 2e y 5a, b, respectivamente. Los resultados de la simulación indican HfO 2 La capa reduce eficazmente las cargas asimétricas de las películas ferroeléctricas causadas por defectos, lo que aumenta aún más la corriente en estado inactivo. Por lo tanto, se puede demostrar que los defectos de la película delgada ferroeléctrica fueron controlados eficazmente por HfO 2 capa de control de defectos.
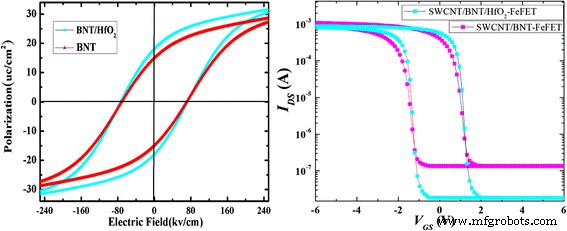
Simulación de a P - E bucles de histéresis de BNT y BNT / HfO 2 películas y b yo DS - V GS curva para SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET
Conclusiones
En resumen, el efecto de HfO 2 materiales como capa de control de defectos en la relación de corriente de encendido / apagado, rendimiento de resistencia a la fatiga y retención de datos de los SWCNT / BNT-FeFET se han investigado, en los que los defectos de la película delgada ferroeléctrica están controlados por HfO 2 como capa de control de defectos. Debido a la fina capa de control de defectos de HfO 2 , el SWCNT / BNT / HfO 2 fabricado -FeFET muestra una corriente de fuga baja de 1,2 × 10 −9 A cuando el voltaje llega a - 3 V, una gran relación de corriente de encendido / apagado de 2 × 10 5 , a V th de 0,2 V y una μ de 395 cm 2 / V s. Además, el SWCNT / BNT / HfO 2 -FeFET mostró un excelente rendimiento de resistencia a la fatiga y una buena retención de datos que se atribuyen al delgado HfO 2 capa de control de defectos. La histéresis se repite P - E y yo DS - V GS curva para SWCNT / BNT / HfO 2 -FeFET y SWCNT / BNT-FeFET fueron simulados para comprender cómo los defectos influyen en las características físicas del dispositivo. Los resultados de la simulación demostraron además que la carga asimétrica se puede reducir en SWCNT / BNT / HfO 2 -FeFET por HfO 2 para controlar los defectos.
Abreviaturas
- BNT:
-
(Bi, Nd) 4 Ti 3 O 12
- FeFET:
-
Transistores de efecto de campo ferroeléctricos
- MWCNT:
-
CNT de paredes múltiples
- PLD:
-
Deposición de láser pulsado
- SWCNT:
-
Nanotubos de carbono de pared simple
Nanomateriales
- Los artículos recientes detallan la escalabilidad de nanotubos de carbono, avances en la integración
- Hilo de nanotubos de carbono, músculo y láminas transparentes
- Control completo de polarización de terahercios con ancho de banda ampliado a través de metauperficies dieléctricas
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Dielectroforesis mejorada por calentamiento para película alineada de nanotubos de carbono de pared simple de densidad ultra alta
- Nanoesferas de carbono monodispersas con estructura porosa jerárquica como material de electrodo para supercondensador
- Diseño de materiales de nanotubos de carbono compuestos y limpios mediante caracterización porosimétrica
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Efecto de la estabilidad térmica mejorada de la capa de soporte de alúmina sobre el crecimiento de nanotubos de carbono de pared simple alineados verticalmente y su aplicación en membranas de nanof…



