Un nuevo TFET de canal SiGe en forma de aleta sin doping con rendimiento mejorado
Resumen
En este trabajo se propone y estudia un canal TFET (DF-TFET) de SiGe sin dopaje en forma de aleta. Para formar una unión de túnel de línea sin dopaje de alta eficiencia, se induce un canal de SiGe en forma de aleta y una superposición de puerta / fuente. A través de estos métodos, se puede obtener el DF-TFET con alta corriente en estado, relación de conmutación de 12 órdenes de magnitud y ningún efecto ambipolar obvio. Alto κ Se induce el dieléctrico de la compuerta de pila de material para mejorar la fuga fuera de estado, las características de la interfaz y la confiabilidad de DF-TFET. Además, mediante el uso del canal sin dopaje y la estructura de la aleta, se pueden resolver las dificultades del proceso de dopaje y la formación de superposición de puertas asimétricas. Como resultado, la estructura de DF-TFET puede poseer una buena aplicabilidad de fabricación y reducir notablemente la huella. En este trabajo se estudian el mecanismo físico del dispositivo y el efecto de los parámetros sobre el rendimiento. Finalmente, la corriente en estado ( I ACTIVADO ) de 58.8 μA / μm, oscilación mínima del subumbral de 2.8 mV / dec (SS min ), oscilación media del subumbral (SS avg ) de 18,2 mV / dec. Con características de capacitancia mejoradas, se puede obtener una frecuencia de corte de 5.04 GHz y un producto de ancho de banda de ganancia de 1.29 GHz. Con un rendimiento y una robustez mejorados, DF-TFET puede ser un candidato muy atractivo para aplicaciones de energía ultrabaja.
Introducción
Con la reducción de los MOSFET, la velocidad de conmutación, el rendimiento de alta frecuencia, la densidad, el costo y la funcionalidad de los circuitos integrados (IC) se encuentran con una gran mejora [1]. Pero con el progreso continuo de la reducción de voltaje, el alto consumo de energía inaceptable se convierte en un problema serio para los circuitos integrados modernos [1, 2]. Benefíciese del mecanismo de tunelización de banda a banda, el túnel FET (TFET) con SS pronunciado y bajo consumo de energía brinda una nueva solución a este problema y atrajo mucha atención [3,4,5,6,7,8,9 ]. Pero las aplicaciones de los TFET convencionales basados en silicio están limitadas por la corriente en estado considerablemente baja ( I ACTIVADO ), baja relación de conmutación, efecto ambipolar severo y gran oscilación media del subumbral (SS) [1, 7]. Para mejorar el rendimiento de los TFET, en los últimos años se han propuesto aplicaciones de nuevas estructuras y nuevos materiales en TFET. Por ejemplo, en los últimos años se han propuesto TFET con una capa mejorada de velocidad de tunelización [5, 10, 11]. Con esta capa, la longitud efectiva de la ruta de tunelización se reduce y da como resultado una mejora obvia de la tasa de tunelización. Además, los TFET con estructura de puerta mejorada son estudiados por muchos grupos de investigación [12,13,14,15,16,17,18,19,20]. El concepto de túnel de línea se introduce en L-TFET [17,18,19]. Como resultado, SS avg de 42,8 mV / década y I ACTIVADO de 10 −6 Se puede lograr A / μm mediante L-TFET. Para mejorar aún más el rendimiento de los TFET, se informa de un TG-TFET mejorado con superposición en forma de T y fuente dual [20, 21]. Como resultado, el I ACTIVADO de TG-TFET alcanza 81 μA / μm. Para mejorar aún más el rendimiento del dispositivo, se requieren altos requisitos sobre el perfil de dopaje de la unión de túnel. Los ingenieros de fundición necesitan crear una unión abrupta muy empinada que tenga solo varios nanómetros de espesor, y esto es muy difícil de lograr. Para evitar esta dificultad, grupos de investigación informaron sobre el TFET sin dopaje (DL-TFET) en una película semiconductora intrínseca delgada utilizando el concepto de plasma de carga [22, 23]. En DL-TFET, la dificultad de fabricación se puede reducir significativamente eliminando la unión abrupta ultra empinada. Se puede evitar la degradación del rendimiento inducida por fluctuaciones aleatorias de dopantes. Además, la fabricación del DL-TFET no exige altos presupuestos térmicos para crear la fuente y el drenaje, lo que abre la posibilidad de realizar TFET en otros sustratos como el silicio monocristalino sobre vidrio. Como resultado, la SS de DL-TFET se ha mejorado enormemente. Sin embargo, debido a la baja eficiencia de la unión de túnel puntual, la corriente de DL-TFET no es lo suficientemente alta, lo que es difícil de cumplir con los requisitos cada vez mayores de las aplicaciones de circuitos modernos.
En este trabajo, se propone y estudia un novedoso canal TFET (DF-TFET) de SiGe sin dopaje en forma de aleta. Para mejorar el rendimiento y la robustez del dispositivo, la unión de túnel de línea y el material SiGe se aplican a DF-TFET. Mientras tanto, la función de trabajo de metal de la puerta se optimiza para mejorar aún más la velocidad de túnel. Además, el canal sin dopaje redujo la dificultad del proceso de fabricación, mientras que la estructura de aleta hace aplicable la fabricación asimétrica de puerta / puerta trasera. Como resultado, la corriente en estado ( I ACTIVADO ) de 58.8μA / μm, corriente de fuga en estado desactivado ( I APAGADO ) cerca de 10 −11 μA / μm, oscilación media del subumbral (SS avg ) de 18,2 mV / dec y oscilación mínima del subumbral (SS min ) de 2,8 mV / dec se puede alcanzar mediante DF-TFET. Con capacitancia de puerta relativamente pequeña ( C gg ) y puerta para drenar la capacitancia ( C gd ), se puede obtener un buen rendimiento analógico / RF. Finalmente, la frecuencia de corte ( f T ) alcanzó 5,04 GHz y el producto de ancho de banda de ganancia (GBW) alcanzó 1,29 GHz.
Las estructuras de este documento son las siguientes:La sección “Estructura del dispositivo y método de simulación” muestra los métodos de simulación TCAD de este trabajo. Se introducen la estructura y el parámetro de DF-TFET. Se ilustran las diferencias y ventajas de DF-TFET en comparación con DL-TFET y TG-TFET. El mecanismo, la característica y el rendimiento analógico / RF de DF-TFET se analizan en la sección “Resultados y discusión”. En esta sección se realiza una comparación de rendimiento entre DF-TFET, DL-TFET y TG-TFET. Además, en esta sección se estudia la influencia de los parámetros del dispositivo en el rendimiento y los parámetros de RF típicos de DF-TFET. Para comprender mejor el potencial de los DF-TFET en aplicaciones de potencia ultrabaja, se llevaron a cabo comparaciones de características eléctricas entre diferentes TFET y DF-TFET con polarización de bajo voltaje.
Estructura del dispositivo y método de simulación
La estructura propuesta de DF-TFET se ilustra en la Fig. 1a. Para mejorar el rendimiento del dispositivo, la unión de túnel de línea se aplica al canal SiGe en forma de aleta sin dopaje mediante el concepto de plasma de carga [24, 25]. Se sabe que el espesor dieléctrico de la puerta puede afectar significativamente la corriente de túnel. Esto se debe a que en el resultado de la aproximación WKB [26], como se muestra en la Ec. (1), la probabilidad de tunelización depende de la longitud de cribado efectiva ( λ ), masa portadora efectiva ( m * ), banda prohibida de energía ( E g ) y ventana de energía de cribado eficaz (Δ Φ ).
$$ T _ {{{\ text {WKB}}}} \ approx \ exp \ left ({- \ frac {{4 \ lambda \ sqrt {2m ^ {*}} \ sqrt {E _ {{\ text {g} }} ^ {3}}}} {{3q \ hbar (E _ {{\ text {g}}} + \ Delta \ Phi)}}} \ right) $$ (1)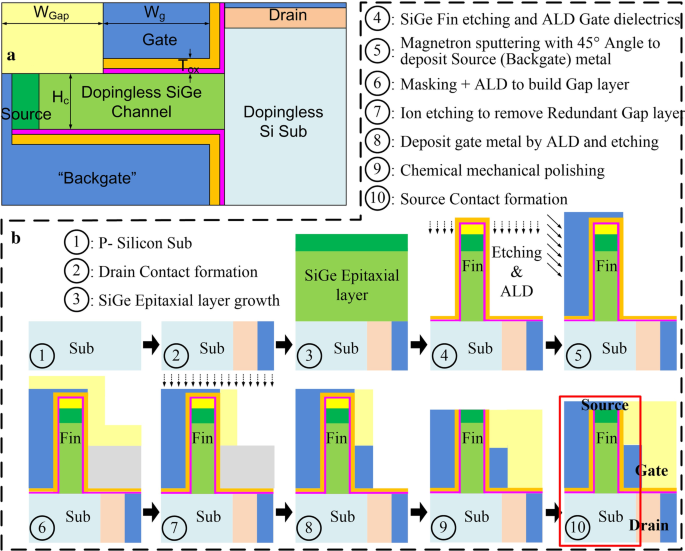
un Estructura y b flujo de fabricación de DF-TFET
Reducir el grosor del dieléctrico de la puerta o usar un κ alto el dieléctrico reducirá λ y aumentar Δ Φ , lo que provocará un aumento exponencial de la probabilidad de tunelización. Por lo tanto, usando alto κ Los dieléctricos y la reducción del espesor del dieléctrico pueden aumentar significativamente la corriente en estado de TFET. Pero el pequeño espesor dieléctrico y los problemas de calidad de la interfaz de alta κ Los dieléctricos causarán serios problemas de confiabilidad. Por lo tanto, un dieléctrico de puerta de pila de 0.5 nm de Al 2 O 3 y 2,0 nm de HfO 2 está configurado para garantizar una buena calidad de interfaz [27, 28, 29], que puede reducir significativamente la corriente de fuga y mejorar la confiabilidad del dieléctrico de la puerta. El electrodo fuente está ubicado en la parte superior de la estructura de la aleta. Al mismo tiempo, también está al lado de un lado de la aleta y funciona como una "puerta trasera" para aplicar un sesgo cero. Mediante el uso de electrodo de puerta y fuente con diferentes funciones de trabajo en metal, se puede formar una unión de túnel de línea en el canal de SiGe en forma de aleta sin dopaje mediante el concepto de plasma de carga. La dirección de tunelización banda a banda (BTBT) es perpendicular a la superficie del canal / puerta. Esto puede ayudar a aumentar I ACTIVADO mejorando el área de unión de túneles efectiva.
Alta relación de conmutación ( I ACTIVADO / Yo APAGADO ) se puede obtener debido a la gran corriente en estado ( I ACTIVADO ) y una pequeña corriente fuera de estado ( I APAGADO ) proporcionada por el empalme de túnel de la línea. Además, la aplicación de una estructura de aleta en DF-TFET puede reducir notablemente la huella en comparación con la línea de cepilladora TFET de túneles [30, 31]. La Figura 1b muestra un flujo de fabricación disponible para formar la estructura de DF-TFET. La Tabla 1 muestra los principales parámetros del proceso de DF-TFET. Finalmente, sin la dificultad de hacer una unión p – n abrupta y uniforme, se puede lograr un buen rendimiento y robustez del dispositivo.
Para comprender mejor las diferencias y ventajas de DF-TFET, DL-TFET y TG-TFET, la figura 2 muestra la estructura de estos tres dispositivos. Con la unión de túnel de línea, se espera que L-TFET y TG-TFET obtengan una alta corriente en estado. Pero los resultados experimentales muestran que el rendimiento real de L-TFET no es tan alto como se esperaba [18, 19]. Una de las razones más importantes es la dificultad para formar una unión p – n abrupta y uniforme con características de interfaz perfectas. Basado en la estructura de L-TFET, TG-TFET hace una gran mejora en I ACTIVADO . Pero TG-TFET todavía se enfrenta a la dificultad de formar una unión p – n abrupta perfecta. Por lo tanto, para obtener el buen rendimiento deseable, debe obtenerse una unión p – n abrupta y uniforme que tenga solo varios nanómetros de espesor, pero es muy difícil de realizar en el proceso de fabricación. Al usar un canal sin dopaje, DL-TFET puede evitar este problema y brindar una mejor calidad de interfaz cerca de la unión de túnel. Sin embargo, en comparación con los TFET de túnel de línea [16,17,18,19,20,21] con uniones p – n abruptas, el resultado de la simulación muestra que el I ACTIVADO de DL-TFET es relativamente bajo [22, 23]. Para una mayor mejora, el DF-TFET se propone y se estudia en este trabajo.
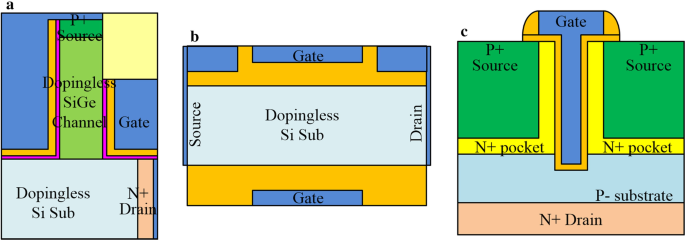
Estructura de a DF-TFET, b DL-TFET, c TG-TFET
La simulación de DF-TFET se realiza en herramientas Silvaco Atlas TCAD. El modelo BTBT no local se introduce en esta simulación para tener en cuenta la variación espacial de la banda de energía, lo que puede ayudar a mejorar la precisión del proceso de tunelización BTBT. Se considera que el modelo de movilidad Lombardi hace que la movilidad del canal sea precisa. El modelo de estrechamiento de la brecha de banda se tiene en cuenta para adaptarse a las regiones de contacto óhmico dopadas pesadas, y el modelo de recombinación Shockley-Read-Hall también se tiene en cuenta en este documento.
Resultados y discusión
Mecanismo y comparación de DF-TFET, DL-TFET y TG-TFET
La Figura 3a muestra la comparación de las características de transferencia de DF-TFET, DL-TFET y TG-TFET. Benefíciese de la unión de túnel de línea en el canal SiGe en forma de aleta, DF-TFET alcanza una corriente en estado ( I ACTIVADO ) de 58.8 μA / μm y logra una gran relación de conmutación de más de 12 órdenes de magnitud donde no se produce un efecto ambipolar evidente. Además, la oscilación mínima del subumbral (SS min ) de 2,8 mV / dec y oscilación media del subumbral (SS avg ) de 18,2 mV / dec. Como resultado, DF-TFET tiene una mejora obvia en I ACTIVADO en comparación con DL-TFET y oscilación subumbral en comparación con TG-TFET. yo ACTIVADO de DF-TFET es más de un orden de magnitud mayor que DL-TFET en V DS = V GS =1 V. La Figura 3b muestra la condición de la banda de energía de DF-TFET e ilustra la formación de una ventana de tunelización en un canal en forma de aleta. La línea roja de puntos en el recuadro de la Fig. 3b muestra la posición donde se obtiene la curva de la banda de energía.
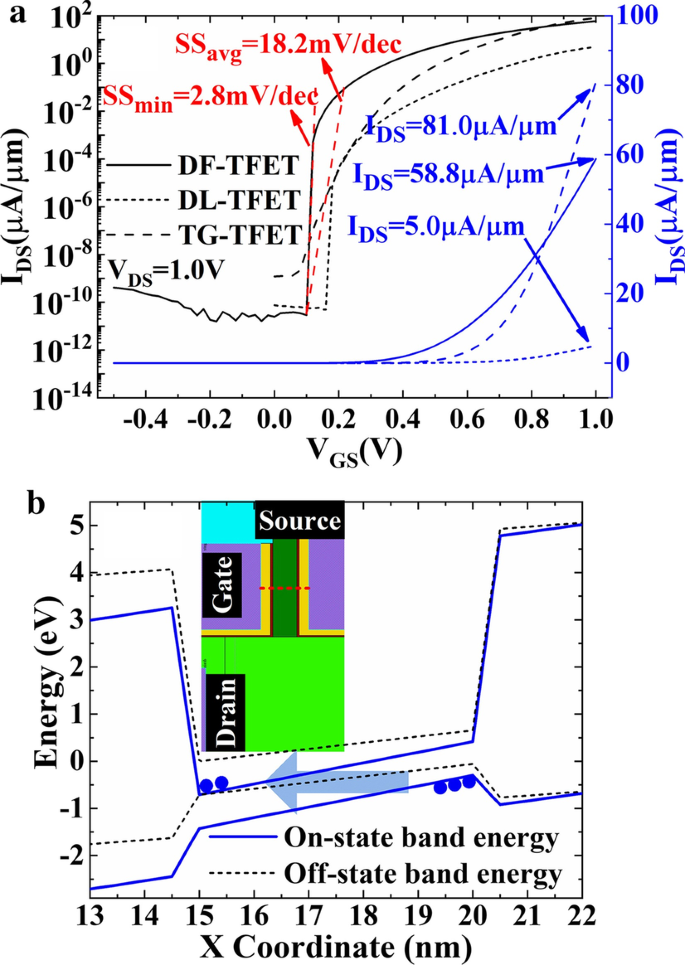
un Características de transferencia de DF-TFET, DL-TFET y TG-TFET. b Condición de la banda de energía de DF-TFET en diferentes condiciones de trabajo (el recuadro muestra la posición de la línea de corte)
La distribución de la cantidad física importante en el proceso de tunelización de DF-TFET se muestra en la Fig.4, que incluye la distribución de (a) potencial, (b) e tasa de tunelización, (c) densidad de corriente total y (d) tasa de recombinación en un condición de trabajo en el estado. En la Fig. 4a, se puede observar un claro gradiente de potencial perpendicular a la interfaz puerta / canal. Por lo tanto, se genera una enorme diferencia de potencial en el canal en forma de aleta y esto modulará la concentración de electrones y huecos en ambos lados del canal de la aleta. Al mismo tiempo, se puede formar una curvatura pronunciada de la banda de energía en el canal en forma de aleta. Como resultado, se puede formar una unión de túnel de línea paralela a la interfaz de puerta / canal. La Figura 4b muestra la tasa de tunelización electrónica en el canal de estructura de aletas. El valor máximo de la tasa de tunelización electrónica se distribuye uniformemente cerca de la interfaz puerta / canal y paralelo a la superficie. Esto prueba que la unión de túnel de línea es paralela a la interfaz puerta / canal. La figura 4c muestra la ruta actual en DF-TFET. Los electrones de la banda de valencia del lado de la puerta trasera / canal forman un túnel hacia la banda de conducción cerca del lado de la puerta / canal. Bajo la influencia del voltaje de la puerta y el voltaje de drenaje, los electrones se mueven a lo largo del canal de la aleta hasta el electrodo de drenaje. De esta manera, se forma una ruta de corriente de tunelización en DF-TFET. La Figura 4d muestra la distribución de la tasa de recombinación en DF-TFET; esto puede ilustrar la ubicación del cruce de túneles de manera más obvia. La franja violeta en el canal de la aleta SiGe puede representar la ubicación de la unión del túnel.
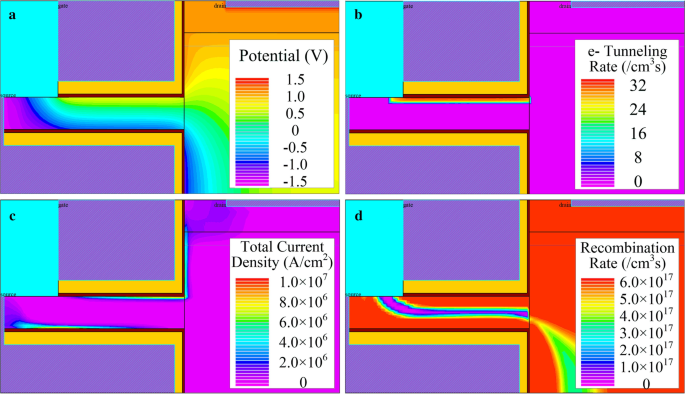
Distribución de a potencial, b e tasa de tunelización, c densidad de corriente y d tasa de recombinación de DF-TFET
Características de CC con diferentes parámetros y rendimiento analógico / RF
La Figura 5a, b muestra las características de entrada y salida de DF-TFET bajo diferentes sesgos. El aumento de V DS tiene poco efecto sobre las características de oscilación por debajo del umbral, pero I ACTIVADO tendrá un crecimiento lineal mientras V DS aumenta de 0,2 a 1,2 V (en V GS =1,0 V). La Figura 5c muestra la frecuencia de corte ( f T ) y el producto de ancho de banda de ganancia (GBW) calculado por las Ecs. (2) y (3). El resultado muestra que se puede obtener una frecuencia de corte de 5,04 GHz y un producto de ancho de banda de ganancia de 1,29 GHz.
$$ f _ {{\ text {T}}} =\ frac {{g _ {{\ text {m}}}}} {{2 \ pi C _ {{{\ text {gs}}}} \ sqrt {1 + 2C _ {{{\ text {gd}}}} / C _ {{{\ text {gs}}}}}}} \ approx \ frac {{g _ {{\ text {m}}}}} {{2 \ pi \ left ({C _ {{{\ text {gs}}}} + C _ {{{\ text {gd}}}}} \ right)}} =\ frac {{g _ {{\ text {m} }}}} {{2 \ pi C _ {{{\ text {gg}}}}}} $$ (2) $$ {\ text {GBW}} =g _ {{\ text {m}}} / 2 \ pi 10C _ {{{\ text {gd}}}} $$ (3)
un Entrada, b salida y c características de radiofrecuencia de DF-TFET
La Figura 6a muestra el efecto de la función de trabajo de la puerta ( φ Puerta ) y función de trabajo de drenaje ( φ Drenaje ) sobre las características de transferencia de DF-TFET. Con la función de trabajo creciente, la curva característica de transferencia se desplaza hacia la dirección positiva. Como la función de trabajo varía de 3,7 a 4,2 eV, la V th aumenta linealmente de 0 a 0,5 V mientras que I ACTIVADO disminuye linealmente de 93,4 a 18,6 μA / μm. Esto hace posible ajustar V th para aplicar a diferentes requisitos de aplicación. La Figura 6b muestra el efecto de la proporción de composición X de Si 1− X Ge X . El aumento en la composición del germanio conduce a la disminución de la banda prohibida de energía y al aumento de la ventana de tunelización, como se muestra en el recuadro de la Fig. 6b. Finalmente, los resultados en I ACTIVADO La curva característica de aumento y transferencia se traslada hacia la dirección negativa. Sin embargo, cuando X > 0,7, tanto la curva característica de transferencia como la I ACTIVADO tienen pocos cambios con el aumento de X . Esto se debe a que la estructura de la banda de energía del canal se vuelve insensible a X cuando X > 0,7, como se muestra en el recuadro de la Fig. 6b. La Figura 6c, d muestra el efecto de la longitud de la puerta ( W g ) y espesor del canal ( H c ) sobre las características de la transferencia. El recuadro de la Fig. 6c muestra las dimensiones del canal del dispositivo bajo diferentes W g . No es difícil observar en la Fig. 6d que DF-TFET sufrirá I ACTIVADO disminuir cuando H c se vuelve demasiado pequeño y demasiado grande. Por lo tanto, una H adecuada c beneficiará el rendimiento del dispositivo.

Transferir características con diferentes a función de trabajo de puerta ( φ Puerta ) y función de trabajo de drenaje ( φ Drenaje ), b Relación de composición de SiGe, c longitud de la puerta ( W g ) y d espesor del canal ( H c )
Para comprender el potencial de DF-TFET en aplicaciones de potencia ultrabaja, la Tabla 2 muestra una comparación de rendimiento de diferentes TFET con DF-TFET. En comparación con los TFET con una unión de tunelización p – n tradicional fuertemente dopada [6, 20, 32,33,34,35], DF-TFET tiene ventajas obvias sobre SS y relación de conmutación. Esto se debe a las características de DF-TFET al usar dopaje electrostático. En comparación con otros TFET sin dopaje [22, 23, 36, 37], DF-TFET tiene ventajas obvias en I ON . Esto se debe a la velocidad mejorada de tunelización mediante el uso de uniones de tunelización de línea y material SiGe. Combinando las ventajas de la unión de tunelización p – n y la unión de tunelización sin dopaje, DF-TFET puede proporcionar una alta corriente de funcionamiento y un bajo consumo de energía estática en aplicaciones de energía ultrabaja.
Conclusión
En este trabajo se propone un novedoso DF-TFET y se analizan las características eléctricas mediante el método de simulación. Se discuten y estudian las características de la estructura, el mecanismo físico, el rendimiento con diferentes parámetros y el rendimiento analógico / RF de DF-TFET. Benefíciese del canal de estructura de aleta sin dopaje, el dieléctrico de la compuerta apilada, el material del canal SiGe y la unión de túnel de línea de alta eficiencia, se puede obtener un buen rendimiento en las características de conmutación y características analógicas / RF. Además, al evitar la formación de la unión p – n abrupta en el proceso de fabricación, se puede lograr un dopaje uniforme con alta consistencia y alta solidez en la fluctuación del proceso. El resultado de la simulación muestra que, I ACTIVADO de 58.8 μA / μm, relación de conmutación de 12 órdenes de magnitud, sin efecto ambipolar obvio, SS min de 2,8 mV / dec y f T de 5,04 GHz se puede lograr mediante DF-TFET. Con la gran corriente de operación, alta relación de conmutación, SS pronunciado, buena confiabilidad, proceso de fabricación estable y buena capacidad de fabricación, se puede esperar que sea uno de los candidatos prometedores para las futuras aplicaciones de sensores sensibles y IC de baja potencia.
Disponibilidad de datos y materiales
No aplicable (este manuscrito es un estudio puramente teórico sobre el rendimiento analógico / RF de TFET. Los datos de simulación se han proporcionado en este manuscrito y no se describirán aquí).
Abreviaturas
- DF-TFET:
-
TFET de canal SiGe en forma de aleta sin dopaje
- CI:
-
Circuitos integrados
- TGTFET:
-
Puerta en forma de T TFET de doble fuente
- DL-TFET:
-
TFET sin dopaje
- I ACTIVADO :
-
Corriente en estado
- I APAGADO :
-
Corriente fuera de estado
- SS min :
-
Oscilación mínima del subumbral
- SS avg :
-
Oscilación del subumbral medio
- C gg :
-
Capacitancia de puerta
- C gd :
-
Puerta para drenar la capacitancia
- f T :
-
Frecuencia de corte
- GBW:
-
Obtenga un producto de ancho de banda
- λ :
-
Duración de la proyección efectiva
- m * :
-
Masa portadora efectiva
- E g :
-
Brecha de banda energética
- Δ Φ :
-
Ventana de energía de cribado eficaz
- W g :
-
Longitud de la puerta
- W Espacio :
-
Longitud de la brecha
- T buey :
-
Espesor del óxido de la puerta de la pila
- H c :
-
Espesor del canal
- φ Puerta / φ Drenaje :
-
Función de trabajo de puerta y desagüe
- V DS :
-
Drene a la fuente de voltaje
- V GS :
-
Puerta a voltaje de fuente
Nanomateriales
- Un enfoque novedoso trae una estabilidad PUF mejorada
- Mejore el rendimiento con soldadura automatizada
- Blog:Wearables médicos con gran rendimiento
- Un nuevo fotocatalizador de heterounión Bi4Ti3O12 / Ag3PO4 con rendimiento fotocatalítico mejorado
- Rendimiento mejorado de un nuevo catalizador anódico de PdAu / VGCNF para la electrooxidación en una pila de combustible de glicerol
- Mecanismo de conducción y resistencia mejorada en RRAM basado en HfO2 con tratamiento de nitruración
- Fabricación de heteroestructuras jerárquicas de núcleo-capa de ZnO @ NiO para un rendimiento fotocatalítico mejorado
- Láseres de nanocables de plasma de canal con cavidades de ranura en V
- Efectos de las variaciones de grabado en la formación de canales Ge / Si y el rendimiento del dispositivo
- Célula solar híbrida de silicio nanoestructurado orgánico de alto rendimiento con estructura de superficie modificada
- 6 maneras en las que mejoramos Protocase Designer con la versión 4.6



