Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
Resumen
Se han obtenido las dependencias del espesor de transición crítico de crecimiento bidimensional a tridimensional (2D-3D) de la composición para películas GeSiSn con un contenido fijo de Ge y un contenido de Sn de 0 a 16% a la temperatura de crecimiento de 150 ° С . Se han construido los diagramas de fase del cambio de superestructura durante el crecimiento epitaxial de Sn sobre Si y sobre Ge (100). Usando los datos del diagrama de fase, es posible identificar la cubierta de Sn en la superficie de Si y controlar la segregación de Sn en la superestructura observada en el patrón de difracción de electrones de alta energía de reflexión (RHEED). Las estructuras multicapa con las capas pseudomórficas GeSiSn y la matriz de islas de una densidad de hasta 1.8 × 10 12 cm −2 se han cultivado considerando la supresión de la segregación de Sn por la disminución de la temperatura de crecimiento de GeSiSn y Si. La superestructura de doble dominio (10 × 1) relacionada con la presencia de Sn en la superficie se observó por primera vez en las estructuras periódicas multicapa durante el crecimiento de Si en la capa GeSiSn. Las estructuras periódicas de GeSiSn / Si demostraron la fotoluminiscencia en el rango de 0,6 a 0,85 eV correspondiente al rango de longitud de onda de 1,45 a 2 μm. El cálculo del diagrama de bandas para la estructura con el pseudomorfo Ge 0.315 Si 0,65 Sn 0.035 capas permite asumir que los picos de fotoluminiscencia corresponden a las transiciones entre bandas entre la X valle en Si o el Δ 4 -valle en GeSiSn y la subbanda de agujeros pesados en la capa GeSiSn.
Antecedentes
Los dispositivos emisores de luz efectivos no se presentaron ya que Si es el semiconductor con la banda prohibida indirecta, aunque los dispositivos fotónicos de silicio, como guías de ondas [1], fotodetectores [2] y moduladores [3] se crearon con éxito.
La adición de Sn en la matriz de la solución sólida de Ge, Si o GeSi es uno de los enfoques para obtener el semiconductor de banda prohibida directa que se basa en los materiales del grupo IV. La inclusión de Sn en la red de Ge reduce la diferencia entre los mínimos de Г y L valles, y GeSn puede convertirse en un material de banda prohibida directa. Como se mostró, la franqueza para la red cúbica de GeSn surge con un contenido de Sn de aproximadamente el 9% [4, 5]. Este valor puede ser inferior al 6% en presencia de la deformación por tracción, mientras que para películas con deformación por compresión, la transición puede esperarse para el contenido de Sn superior al 11% [6]. La reducción del bandgap debido a la inclusión de Sn permite incrementar la longitud de onda operativa desde el rango del infrarrojo cercano al medio, lo cual es deseable en el campo de las interconexiones ópticas, en los sistemas de comunicación por fibra óptica de nueva generación, sensores, procesamiento de señales, conversión de energía y dispositivos de almacenamiento óptico [7]. Por lo tanto, durante los últimos años, el interés por la clase de materiales Ge-Si-Sn ha aumentado significativamente.
Se combinan grandes esfuerzos para obtener películas epitaxiales de GeSn de calidad instrumental [8, 9]. Uno de los problemas serios es la formación de inclusiones de Sn (precipitados) durante el crecimiento de la capa de GeSn [10, 11]. Además de la precipitación, se observa la segregación de Sn en el proceso de crecimiento de la capa de GeSn, GeSiSn y oxidación de la película de GeSn [11, 12]. Las técnicas de crecimiento fuera del equilibrio, como la epitaxia de haz molecular (MBE) y la deposición química de vapor (CVD), sirven como métodos fiables para la supresión de la precipitación y la segregación. Para reducir el efecto de la precipitación y segregación de Sn, se puede realizar la disminución de la temperatura de crecimiento [13] o la inclusión de la deformación, o la adición del tercer elemento, por ejemplo, Si, que reduce la tensión local alrededor de los átomos de Sn.
Los datos sobre morfología y estructura superficial o sobre los mecanismos de formación de películas GeSiSn monocristalinas, prácticamente, no se encuentran en la literatura, a pesar de la gran promesa de los materiales basados en compuestos del grupo IV. Estos datos son necesarios para la creación de nanoheteroestructuras con capas de GeSiSn tensas y relajadas. En este trabajo, se muestran en primer lugar los datos relacionados con la creación de estructuras multicapa, superredes no solo con capas GeSiSn pseudomórficas sino también con nanoislas GeSiSn, que no contienen dislocaciones y permiten variar el ancho de banda prohibida del material en un amplio rango. y cubren el rango de longitud de onda infrarroja que antes no estaba disponible para GeSi.
El propósito de este artículo es estudiar el crecimiento de la película GeSiSn pseudomórfica elásticamente estresada, la formación de nanoislas tridimensionales y obtener las estructuras periódicas multicapa que contienen capas y nanoislas pseudomórficas de GeSiSn.
En nuestros artículos anteriores [14,15,16], los diagramas cinéticos del estado morfológico de la película GeSiSn se construyeron para varios desajustes de parámetros de celosía entre GeSiSn y Si en el rango de contenido de Sn de 0 a 8% utilizando la difracción de electrones de alta energía de reflexión ( RHEED). Este artículo incluye nuevas dependencias críticas del espesor de transición de crecimiento bidimensional a tridimensional (2D-3D) de la composición de la película GeSiSn con un contenido fijo de Ge en el rango de contenido de Sn de 0 a 16%. Se obtuvieron los diagramas de fase del cambio de superestructura durante el crecimiento de Sn sobre Si y Ge (100). A pesar del hecho de que en [17,18,19], se estudiaron reconstrucciones de superficies de Sn en Si en las diferentes cubiertas de estaño, nuestros datos demostraron nuevas superestructuras. Además, el diagrama de fase del cambio de superestructura durante el crecimiento de Sn en Ge (100) no se presentó anteriormente en ninguna parte. Las propiedades ópticas de las estructuras periódicas multicapa, incluidas las capas pseudomórficas de GeSiSn, se estudiaron en primer lugar mediante el método de fotoluminiscencia para muestras con diferentes contenidos de Sn. El cálculo del diagrama de bandas de las heteroestructuras GeSiSn / Si se llevó a cabo utilizando el enfoque de la teoría del modelo sólido [20].
Experimental
Todas las muestras con capas pseudomórficas GeSiSn y con nanoislas GeSiSn se cultivaron en condiciones de vacío ultra alto 10 −7 –10 −8 Pa sobre el equipo de epitaxia de haz molecular (MBE) "Katun C." La cámara de crecimiento epitaxial tiene el evaporador de haz de electrones para Si y las células de efusión de Knudsen para Ge y Sn. La tasa de crecimiento de la capa de GeSiSn se varió de 0,015 a 0,05 nm / s. El crecimiento epitaxial se llevó a cabo sobre sustratos de Si (100) en el rango de temperatura de 150–450 ° С con un contenido de Sn de 0 a 20%. No solo se obtuvieron capas individuales de GeSiSn, sino también estructuras periódicas multicapa, que contienen heterouniones GeSiSn / Si. Al principio, se depositó la capa GeSiSn, que luego se cubrió con una capa de Si de 10 nm a una temperatura de crecimiento de 400-500 ° С. La técnica principal para controlar los cambios en la morfología y la estructura de la superficie e investigar los mecanismos de crecimiento fue la reflexión de la difracción de electrones de alta energía (RHEED). El patrón RHEED se registró en una cámara de video durante el crecimiento. Luego, se eligió un perfil, junto con una de las direcciones cristalográficas, y se crearon los cambios de intensidad de este perfil en coordenadas espacio-temporales. El análisis de la distribución de la intensidad del espacio-tiempo de RHEED nos permitió estudiar los mecanismos del crecimiento bidimensional, los cambios en la superestructura y la formación de islas tridimensionales. El momento de la transición del crecimiento bidimensional al tridimensional (transición 2D-3D) se determinó a partir de la dependencia temporal de la intensidad del patrón RHEED junto con una de las varillas en la dirección en la que aparece el reflejo de volumen. Las dependencias del espesor crítico de transición 2D-3D del contenido GeSiSn con un contenido Ge fijo se crearon basándose en el método de determinación de la transición 2D-3D. Sobre la base de estas dependencias, el grosor de la capa pseudomórfica GeSiSn se estableció en estructuras multicapa y se crearon capas con una matriz de nanoislas GeSiSn. La morfología y la estructura de la superficie se analizaron mediante microscopía de túnel de barrido (STM) en un equipo de vacío ultra alto Omicron-Riber. Las propiedades ópticas de la muestra se estudiaron mediante espectroscopía de fotoluminiscencia (PL) utilizando un monocromador ACTON 2300i y un detector OMA-V enfriado basado en la matriz de fotodiodos InGaAs con una banda de sensibilidad de 1,1 a 2,2 μm. Para excitar la fotoluminiscencia, se utilizó la radiación láser Nd:YAG (532 nm).
Resultados y discusión
Se estudió el crecimiento de la película delgada de GeSiSn a la temperatura de 150 ° С en el rango de contenido de Sn de 0 a 16%. La acumulación de tensión se produce durante la deposición de la capa de GeSiSn causada por el desajuste entre el parámetro de red de GeSiSn y Si. La transición de la transición 2D-3D se observa con un cierto grosor. El procedimiento para determinar la transición 2D-3D en el ejemplo de Ge 0.6 Si 0,28 Sn 0.12 El crecimiento se presenta en la Fig. 1. Existen los patrones RHEED iniciales de la superficie de Si antes de Ge 0.6 Si 0,28 Sn 0.12 deposición de película (Fig. 1a), el patrón RHEED final (Fig. 1c) formado por Ge 0.6 Si 0,28 Sn 0.12 isla y la capa de humectación, así como la distribución de intensidad espacio-tiempo del perfil vertical indicado por la flecha en la Fig.1a y la dependencia de la intensidad del perfil horizontal (perfil horizontal indicado en la distribución de intensidad espacio-tiempo en la Fig. 1b) en Ge 0.6 Si 0,28 Sn 0.12 espesor de la película (Fig. 1b). El momento de transición 2D-3D se determinó trazando la tangente al gráfico de intensidad en el espesor (Fig. 1b) en la región de un aumento brusco de intensidad. Este enfoque es generalmente aceptado [21].
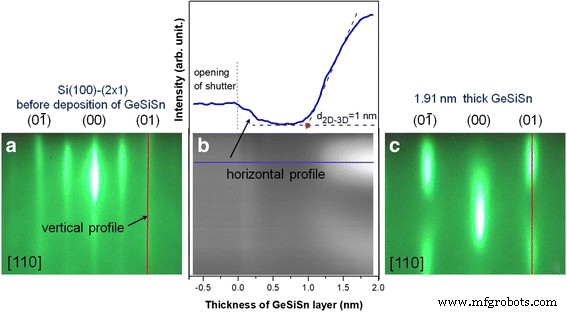
Determinación del momento de transición 2D-3D durante el crecimiento de la película GeSiSn: a Patrón RHEED de la superficie Si (100) - (2 × 1) antes de Ge 0.6 Si 0,28 Sn 0.12 se muestra el crecimiento, b la distribución de la intensidad del espacio-tiempo del perfil vertical en la escala de grises y la dependencia de la intensidad del perfil horizontal del Ge 0.6 depositado Si 0,28 Sn 0.12 espesor de la película. Los perfiles están indicados por las flechas en ( a ) y ( b ) y c el patrón RHEED final después del Ge 0.6 de 1,91 nm de espesor Si 0,28 Sn 0.12 deposición
Las dependencias del grosor crítico de transición 2D-3D de la composición de las películas GeSiSn con un contenido de Ge fijo y un contenido de Sn de 0 a 16% se construyen (Fig. 2) utilizando la técnica de transición 2D-3D descrita anteriormente. Anteriormente, se publicaron los diagramas cinéticos para el estado morfológico de las películas GeSiSn en el rango de temperatura de 150–450 ° С, en un desajuste de celosía diferente entre GeSiSn y Si [14]. Sobre la base del análisis del diagrama cinético, se determinó la temperatura óptima de 150 ° С, a la cual el espesor crítico de transición 2D-3D alcanza su valor máximo y se suprime la segregación de Sn. El valor del espesor de la película GeSiSn por debajo de la curva correspondiente al espesor crítico de transición 2D-3D en la temperatura y composición determina la región de existencia de películas pseudomórficas. En las curvas se observa la disminución del espesor crítico de transición 2D-3D, con el aumento del contenido de Sn de 0 a 16% (Fig. 2). Tal comportamiento se explica por el efecto de tensión. El aumento del contenido de Sn de 0 a 16%, por ejemplo, Ge 0.6 Si 0,28 Sn 0.12 crecimiento, da como resultado el aumento de la falta de coincidencia de los parámetros de la red entre Ge 0.6 Si 0,28 Sn 0.12 y Si de 2,5 a 5,6%, respectivamente, y reduciendo el tiempo y, en consecuencia, el espesor de transición a nanoislas tridimensionales. La naturaleza de la característica que aparece en la curva con el 30% de contenido de Ge y se observa en el contenido de Sn de 3 a 10% hasta el final no está completamente clara. Conociendo la magnitud del espesor crítico de transición 2D-3D, es posible obtener las películas pseudomórficas GeSiSn y utilizarlas en las estructuras periódicas multicapa con la heterounión GeSiSn / Si. En nuestros experimentos, la precisión para determinar el espesor crítico de transición 2D-3D es de 0.06 nm y está determinada principalmente por la inexactitud de mantener el caudal de Si debido a la inestabilidad de la operación de la fuente.
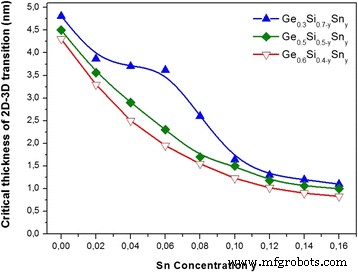
El espesor crítico de transición 2D-3D depende de la composición de la película GeSiSn a varios valores fijos de contenido de Ge, contenido de Sn de 0 a 16% y a una temperatura de crecimiento de 150 ° С
La elección del grosor de la capa pseudomórfica en la base de los diagramas cinéticos obtenidos anteriormente [16] y las dependencias del grosor crítico de transición 2D-3D en la composición (Fig. 2) permiten hacer crecer no solo capas individuales de GeSiSn, sino también usar estas capas. en estructuras periódicas multicapa. En la estructura periódica de GeSiSn / Si, donde la capa de GeSiSn está cubierta por la capa de Si, el problema surge debido a la segregación de Sn sobre la superficie de Si. La segregación de Sn conduce a la reconstrucción de la superficie y a la aparición de toda la serie de superestructuras en función de la concentración superficial de Sn. La investigación de la reconstrucción de la superficie durante el crecimiento de Sn en Si (100) y Ge (100) fue necesaria para comprender qué recubrimiento de Sn corresponde a la superestructura observada en la imagen RHEED. Los diagramas de fase del cambio de la superestructura se construyeron en el rango de temperatura de 100–750 ° С. Un diagrama similar para el crecimiento de Sn en Si (100) se presentó por primera vez en [17]. Ueda y col. Sn depositado a temperatura ambiente seguido de recocido. Observaron la superestructura solo después de recocer la película. En nuestros experimentos, Sn se depositó a una temperatura de 100 ° С y se obtuvo sobre la superficie reconstruida de Si (100– (2 × 1). El aumento de temperatura hasta 750 ° С dio como resultado la formación de la serie de superestructura en el superficie (Fig. 3). El efecto de posición de los átomos de Sn adsorbidos en la superficie de Si (100) sobre la energía de enlace de Sn-Si se estudió mediante la espectroscopia de fotoelectrones en [18]. La disminución de la energía de enlace de Sn-Si se observó con el Aumento de la cobertura de Sn. Por lo tanto, todas las reconstrucciones, que ocurren durante el crecimiento de Sn en Si (100), pueden explicarse por una disminución en la energía del sistema de superficie. La transición al crecimiento tridimensional está asociada con la acumulación de deformaciones debidas La aparición de película policristalina se observó en [17] en la película gruesa de 3,2 ML (monocapa) de Sn. La formación de película policristalina es causada por una baja temperatura de deposición de la película de Sn. El mismo razonamiento se relaciona con el Sn crecimiento en la superficie Ge (100). En la actualidad, las contribuciones sobre las superestructuras Sn en Ge (100) no se han informado en la literatura.

Diagramas de fases del cambio de la superestructura durante el crecimiento: a Sn en Si (100) y b Sn en Ge (100)
Las superestructuras indicadas en los diagramas aparecen tanto con el aumento como con la disminución de la temperatura. Estos diagramas de fase ayudan a determinar la concentración de Sn en la superficie en el crecimiento de Si sobre la capa de GeSiSn. Las superestructuras que aparecen en la superficie de Si durante el crecimiento periódico de la estructura se pueden observar a temperaturas que difieren de las temperaturas presentadas en los diagramas de fase. La capa de Si se deposita sobre la superficie de GeSiSn a temperaturas de 400–500 ° С; sin embargo, pueden aparecer las superestructuras que son características para todo el rango de temperatura presentado en la Fig. 3. La creación de la estructura con heterouniones GeSiSn / Si requiere prevenir la formación de la superestructura de dos dominios (5 × 1), que se asocia con la segregación de Sn y la obstrucción en la formación de la estructura periódica multicapa con las capas pseudomórficas (Fig.4a ). La forma más sencilla de suprimir la segregación de Sn en el crecimiento de Si sobre la capa GeSiSn es el crecimiento de Si en dos etapas. La primera etapa implica la deposición de la capa de Si de 1 a 2 nm de espesor a temperatura ambiente. El crecimiento adicional de Si continúa a una temperatura de 400–500 ° С. Esta temperatura está determinada por el contenido de Sn en la capa GeSiSn. Las principales series de superestructuras que ocurren durante el crecimiento de Si en la capa GeSiSn en estructuras periódicas multicapa consisten en (2 × 1) + (2 × N), c (8 × 4), (4 × 1), (6 × 1) y (5 × 1). Además, la superestructura de dos dominios (10 × 1) se observa en la superficie de Si (Fig. 4b). Esta superestructura no apareció en los experimentos en el crecimiento de Sn sobre Si y Ge, pero se puede decir que corresponde al recubrimiento mínimo de Sn ya que desaparece durante un recocido corto a una temperatura de 400-500 ° С y el (2 × 1) aparece la superestructura, que es una característica de la superficie de Si.

Superestructuras observadas en el crecimiento de Si en la capa GeSiSn en la estructura periódica multicapa en la dirección azimutal [110]: a (5 × 1) y b (10 × 1)
Se obtuvieron estructuras periódicas, que contienen capas pseudomórficas o una matriz de nanoislas GeSiSn. Utilizando los diagramas cinéticos del estado morfológico de la película GeSiSn, se investigó una matriz de islas GeSiSn en la estructura periódica multicapa. Las imágenes STM de Ge 0.75 Si 0.2 Sn 0.05 superficie con la matriz de nanoislas en el primero (Fig. 5a) y en el quinto período (Fig. 5b) con un tamaño de escaneo de 400 nm × 400 nm. La matriz de islas se obtuvo a una temperatura de crecimiento de 250 ° С. Los histogramas de la distribución del número de islas en tamaño también se muestran en la Fig. 5. Las islas con densidad de 5,18 × 10 11 cm −2 y el tamaño medio de 8,95 nm se presentan en la Fig. 5c. El Ge 0,75 depositado Si 0.2 Sn 0.05 el espesor de la película fue de 1,78 nm. El tamaño medio de la isla en el quinto período es de aproximadamente 4 nm y la densidad de la isla alcanza 1,8 × 10 12 sm −2 con un espesor efectivo de Ge 0,75 Si 0.2 Sn 0.05 película de 1,89 nm, y se deduce del histograma de la figura 5d. Un aumento en la densidad en un factor de 3,5 y una disminución en el tamaño de la isla en un factor de 2 pueden estar relacionados con el aumento de la fracción de Sn en la superficie de Si con un aumento en el número de período. Esta afirmación se ve confirmada por el cambio en las superestructuras, observado por el patrón RHEED durante el crecimiento de la película de Si sobre la capa de GeSiSn, de (2 × 1) y (2 × N) a la estructura superficial c (8 × 4). La formación de la superestructura c (8 × 4) tiene lugar durante el proceso de crecimiento de Sn sobre Si, a partir del espesor de recubrimiento de 0,4 monocapa (ML) a una temperatura de crecimiento de 400 ° С. Con la disminución de la temperatura de crecimiento a 100 ° С, podemos aumentar la densidad de la isla, pero la calidad de la superficie es peor. Un aumento de la temperatura de crecimiento a más de 250 ° С mejora la segregación de Sn. Por lo tanto, el rango de temperatura de crecimiento óptimo de las capas GeSiSn con la matriz de la isla es 150-250 ° С, donde se observan oscilaciones de reflexión especular en el crecimiento de la capa de humectación GeSiSn, correspondiente al mecanismo de crecimiento 2D.

Imágenes STM de Ge 0.75 Si 0.2 Sn 0.05 superficie con un tamaño de escaneo de 400 nm × 400 nm: a el Ge 0.75 Si 0.2 Sn 0.05 superficie en el primer período, b el Ge 0.75 Si 0.2 Sn 0.05 superficie en el quinto período; los histogramas de distribución para el número de islas en el tamaño de la base para Ge 0,75 Si 0.2 Sn 0.05 película: c en el primer período (el Ge 0.75 Si 0.2 Sn 0.05 espesor de película es igual a 1,78 nm) y d en el quinto período (el Ge 0.75 Si 0.2 Sn 0.05 espesor de película es igual a 1,89 nm)
La perfección cristalina de la estructura multicapa se estudió mediante microscopía electrónica de transmisión (TEM). Las imágenes TEM para una estructura multicapa con Ge 0.5 Si 0.45 Sn 0.05 La heterounión / Si y un período de 25 nm se muestran en la Fig. 6. A partir de los datos de TEM, se puede concluir que nuestras muestras no contienen dislocaciones de roscado y son cristalinas perfectas con interfaces nítidas. El estado pseudomórfico de la película GeSiSn en una estructura periódica multicapa, la red cristalina y las cepas se discuten en [14] sobre la base del análisis de datos obtenido con la ayuda de TEM. La composición de la película GeSiSn se determinó estableciendo flujos de Si, Ge y Sn. Las tasas de crecimiento de Si, Ge y Sn se midieron con un medidor de espesor de cuarzo. La composición de la película GeSiSn se identificó mediante difractometría de rayos X. El análisis mostró la coincidencia tanto del conjunto como de las composiciones medidas.
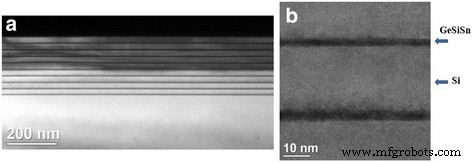
un Imagen TEM de la estructura multicapa que incluye Ge 0.5 Si 0.45 Sn 0.05 heterotransición con el período de 25 nm. b Imagen TEM de alta resolución de la misma estructura
Las propiedades ópticas de las estructuras periódicas multicapa con capas GeSiSn se investigaron mediante fotoluminiscencia para estructuras con diferentes contenidos de Sn. Las estructuras demostraron su fotoluminiscencia en el rango de 0,6 a 0,8 eV, que corresponde al rango de longitud de onda de 1,45 a 2 μm (Fig. 7). Se obtuvieron los espectros de fotoluminiscencia con los máximos de intensidad en 0,78, 0,69 y 0,65 eV. Corresponden a las longitudes de onda de 1,59, 1,8 y 1,9 μm, y se observan a 3,5, 4,5 y 6% de Sn, respectivamente. El aumento del contenido de Sn en la capa GeSiSn conduce tanto a la disminución de energía de las transiciones ópticas como al aumento de la intensidad de la fotoluminiscencia. El aumento de intensidad puede ser causado por el aumento de profundidad del pozo cuántico para un mayor contenido de Sn en la capa de solución sólida GeSiSn. Para avanzar en el rango de longitud de onda a más de 2 μm, se requiere un aumento del contenido de Sn en las capas GeSiSn. Para determinar las transiciones ópticas observadas en los espectros de luminiscencia, fue necesario calcular el diagrama de bandas de la heteroestructura GeSiSn / Si.

Los espectros de fotoluminiscencia de estructuras periódicas multicapa con un contenido de Sn de 3,5, 4,5 y 6% en las capas pseudomórficas de GeSiSn
El diagrama de bandas de heteroestructura GeSiSn / Si se calculó utilizando el enfoque de la teoría de modelos sólidos [20]. Dentro de este modelo, ambos semiconductores que forman la heterounión deben colocarse en la escala de "energía" única para determinar la posición de la banda en la heterounión. El valor de la banda prohibida de valencia para las heteroestructuras de Ge / Si en la heterounión es bien conocido [22] y es igual a 0,54 eV; además, la banda de valencia de Ge se encuentra más alta en la energía que la banda de valencia de Si. La banda prohibida entre Ge y Sn se conoce a partir del modelo presentado en [23] y es de 0,69 eV [24]. Por lo tanto, el valor de banda prohibida en la heterointerfaz para el Si / Si 1-x-y Ge x Sn y La heteroestructura se puede escribir como:
$$ {E} _ {v, av} =0.54x + 1.23y $$Dado que la banda de valencia del semiconductor está formada por las subbandas de los agujeros pesados y ligeros, y también por la subbanda separada por la interacción espín-órbita; luego, la posición de la banda de valencia ( E v, av ) promediado en las tres subbandas se utiliza para determinar la banda prohibida y la construcción del diagrama de bandas de heteroestructura. Para determinar la posición de la subbanda de los agujeros pesados y ligeros, así como la subbanda dividida por la interacción giro-órbita, se utilizan las siguientes expresiones:
$$ {\ Displaystyle \ begin {array} {l} {E} _ {\ mathrm {HH} \ left (\ mathrm {LH} \ right)} ={E} _ {v, av} + {\ Delta} _0 / 3 \\ {} {E} _ {\ mathrm {SO}} ={E} _ {v, av} -2/3 {\ Delta} _0 \ end {array}}, $$donde los índices HH, LH y SO indican las subbandas de agujeros pesados y ligeros, así como la subbanda dividida por espín. El Δ 0 El valor denota la energía de división de espín-órbita en el semiconductor. Después de determinar la posición de la subbanda de la banda de valencia en la heterounión, las posiciones de los valles correspondientes de la banda de conducción se determinan mediante la expresión:
$$ {E} ^ n ={E} _ {\ mathrm {Ge}} ^ n \ left (1-xy \ right) + {E} _ {\ mathrm {Si}} ^ nx + {E} _ {\ mathrm {Sn}} ^ ny- {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ nx \ left (1-xy \ right) - {b} _ {\ mathrm {Sn} \ mathrm {Ge }} ^ ny \ left (1-xy \ right) - {b} _ {\ mathrm {Si} \ mathrm {Sn}} ^ n xy, $$donde índices n = Γ , L y X indicar los valles correspondientes \ ({b} _ {\ mathrm {SiGe}} ^ n \), \ ({b} _ {\ mathrm {SnGe}} ^ n \) y \ ({b} _ {\ mathrm {SiSn}} ^ n \) –– parámetros de "inclinación", teniendo en cuenta la desviación de la ley lineal para el ancho de banda prohibida, \ ({E} _ {\ mathrm {Ge}} ^ n \), \ ({ E} _ {\ mathrm {Si}} ^ n \) y \ ({E} _ {\ mathrm {Sn}} ^ n \) –– Ge, Si y Sn espacios de banda en el valle correspondiente. Casi todos los parámetros se toman de [24]. Los parámetros de inclinación para los valles L y Г se toman de [25].
Después de determinar la posición de todas las bandas de interés en la heterounión, se tuvo en cuenta su desplazamiento bajo la influencia de deformaciones. La influencia de las deformaciones en la banda prohibida se tuvo en cuenta mediante las constantes de potencial de deformación [26]. Dado que las capas bidimensionales eran pseudomórficas, en nuestro caso, se utilizó el enfoque estándar para determinar las deformaciones que se describe, por ejemplo, en [26]:las deformaciones en un plano de pozo cuántico se pueden determinar a partir de ε xx (yy) = ε ǀǀ =( a GeSiSn - a Si ) / a Si , donde a –– la constante de celosía del material correspondiente. En la dirección, que es perpendicular al plano del pozo cuántico, valor de deformación ε zz =−2 ( С 12 / С 11 ) ε xx se puede determinar a través de la C 12 y C 11 módulos elásticos del compuesto cristalino. La constante de red de la solución sólida se determinó a partir de la relación cuadrática:
$$ {a} _ {\ mathrm {Ge} \ mathrm {SiSn}} ={a} _ {\ mathrm {Ge}} \ left (1-xy \ right) + {a} _ {\ mathrm {Si} } x + {a} _ {\ mathrm {Sn}} y + {b} _ {\ mathrm {Si} \ mathrm {Ge}} ^ {\ hbox {'}} x \ left (1-x \ right) + { b} _ {\ mathrm {Sn} \ mathrm {Ge}} ^ {\ hbox {'}} y \ left (1-y \ right), $$donde a Ge , a Si , a Sn ––Ge, Si y Sn parámetros de celosía [24], \ ({b} _ {\ mathrm {SiGe}} ^ {\ hbox {'}} \) =- 0.026 Å, \ ({b} _ {\ mathrm {SnGe}} ^ {\ hbox {'}} \) =0.166 Å –– parámetros de «arqueamiento», teniendo en cuenta la desviación de la ley de Vegard.
Según los cálculos del diagrama de bandas, los picos PL corresponden a las transiciones entre bandas entre el valle X de Si o el Δ 4 -valle de GeSiSn y la banda de agujeros pesados en la capa de GeSiSn (Fig. 8).
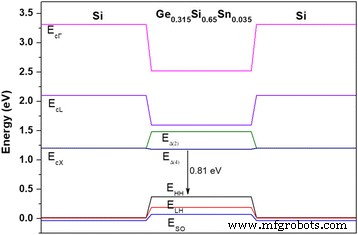
El Si / Ge 0.315 Si 0,65 Sn 0.035 / Diagrama de bandas de heterocomposición de Si
Conclusiones
Se determinaron las dependencias críticas del espesor de transición 2D-3D de la composición de las capas de GeSiSn con un contenido fijo de Ge y Sn, que varía de 0 a 16% a la temperatura de crecimiento de 150 ° С. Se realizaron los diagramas de fase de la superestructura para el crecimiento epitaxial de Sn sobre Si (100) y Ge (100). Las estructuras periódicas multicapa con capas pseudomórficas y con una matriz de islas GeSiSn de una densidad de hasta 1.8 × 10 12 sm −2 se obtuvieron. Por primera vez, en la estructura periódica multicapa durante el crecimiento de Si en la capa GeSiSn, se observó una superestructura de dos dominios (10 × 1), que se transforma en una superestructura (2 × 1) con un ligero recocido. Las estructuras periódicas GeSiSn / Si demostraron su fotoluminiscencia en el rango de 0,6 a 0,8 eV, que corresponde al rango de longitud de onda de 1,45 a 2 μm. Basado en los cálculos del diagrama de bandas para la estructura con pseudomorfo Ge 0.315 Si 0,65 Sn 0.035 capas, los picos PL corresponden a las transiciones entre bandas entre el X-valle de Si o el Δ 4 -valle de GeSiSn y la banda de agujeros pesados en la capa GeSiSn. Un mayor progreso en la región de onda larga requiere una investigación de las propiedades ópticas de las estructuras con un gran contenido de Sn.
Abreviaturas
- CVD:
-
Deposición de vapor químico
- MBE:
-
Epitaxia de haz molecular
- ML:
-
Monocapa
- PL:
-
Fotoluminiscencia
- RHEED:
-
Refracción por difracción de electrones de alta energía
- STM:
-
Microscopía de túnel de barrido
- TEM:
-
Microscopía electrónica de transmisión
Nanomateriales
- Nanopartículas semiconductoras
- Estructura y propiedades electrónicas de la nanoarcilla de caolinita dopada con metal de transición
- Modulación de las propiedades de anisotropía óptica y electrónica de ML-GaS por campo eléctrico vertical
- Síntesis fácil y propiedades ópticas de nanocristales y nanovarillas de selenio pequeños
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Influencia del agua en la estructura y propiedades dieléctricas de la microcristalina y nanocelulosa
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Propiedades ópticas y electrónicas de fotodiodos N + / P de silicio hiperdopado con azufre inducido por láser de femtosegundo
- Preparación y propiedades ópticas de las películas GeBi mediante el método de epitaxia de haz molecular
- Mejora de la absorción y modulación de frecuencia del microbolómetro THz con estructura de micropuente mediante antenas de tipo espiral



