Ventana de memoria y mejora de la resistencia de los FeFET basados en Hf0.5Zr0.5O2 con capas de semillas de ZrO2 caracterizadas por mediciones rápidas de pulsos de voltaje
Resumen
El HfO 2 El transistor de efecto de campo ferroeléctrico (FeFET) con una pila de puertas de metal / ferroeléctrico / aislante / semiconductor (MFIS) se está considerando actualmente como un posible candidato para memoria no volátil de alta densidad y velocidad de escritura rápida. Aunque el rendimiento de retención del HfO 2 FeFET basado en una pila de puertas MFIS podría satisfacer los requisitos para aplicaciones prácticas, su ventana de memoria (MW) y su confiabilidad con respecto a la resistencia deberían mejorarse aún más. Este trabajo investiga la ventaja de emplear ZrO 2 capas de semillas en el MW, retención y resistencia del Hf 0.5 Zr 0.5 O 2 FeFET basados en (HZO) con pilas de compuertas MFIS, mediante el uso de medidas rápidas de pulso de voltaje. Se encuentra que el FeFET basado en HZO con un ZrO 2 La capa de semillas muestra un MW inicial más grande y extrapolado a 10 años, así como un rendimiento de resistencia mejorado en comparación con el FeFET basado en HZO sin el ZrO 2 capa de semillas. Los resultados indican que el empleo de una pila de compuertas de alto k / Si cristalino directo mejoraría aún más el MW y la confiabilidad del HfO 2 FeFET basados en.
Antecedentes
HfO 2 Las películas delgadas ferroeléctricas se consideran materiales prometedores de apilamiento de puertas para transistores de efecto de campo ferroeléctrico (FeFET) debido a su compatibilidad y escalabilidad complementaria de semiconductores de óxido de metal (CMOS). Entre varios tipos de estructuras de pila de compuertas que se pueden usar en FeFET, un metal / ferroeléctrico / aislante / semiconductor (MFIS) representa una configuración más práctica porque sigue las arquitecturas actuales de dispositivos MOS y combina bien con la moderna compuerta de metal de alta k. (HKMG) procesos. Por lo tanto, se han realizado grandes esfuerzos para diseñar y fabricar FeFET con estructuras de pila de compuertas MFIS para aplicaciones en memorias no volátiles integradas, transistores de efecto de campo de capacitancia negativa, neuronas artificiales, sinapsis y dispositivos de lógica en memoria [1,2,3,4 , 5,6,7,8].
Hasta ahora, los FeFET de alta densidad y velocidad de escritura rápida con estructuras de pila de puertas MFIS se han fabricado con éxito utilizando procesos HKMG [9, 10]. Además de la alta densidad de integración y la velocidad de escritura rápida, una gran ventana de memoria (MW) y una alta confiabilidad con respecto a la retención y la resistencia también son críticas para emplear FeFET para aplicaciones de memoria no volátil [11,12,13,14]. Debido a un desplazamiento de banda grande al silicio, un campo coercitivo alto y una constante dieléctrica moderada del HfO 2 películas delgadas ferroeléctricas basadas en HfO 2 Los FeFET basados en MFIS con estructuras de pila de compuertas exhiben propiedades de retención confiables (extrapolación de 10 años) [15, 16, 17]. Sin embargo, aunque el HfO 2 las películas delgadas a base de agua demuestran una resistencia moderada superior a 1 × 10 9 ciclos de conmutación [14, 18], HfO 2 Los FeFET basados en estructuras de pila de puertas MFIS tienen una resistencia bastante limitada que va desde 1 × 10 4 a 1 × 10 7 ciclos de conmutación [17, 19,20,21,22,23]. Teóricamente, se espera que el empleo de capas aislantes de alta k reduzca el campo eléctrico en la pila de compuertas MFIS, lo que aliviaría la flexión de la banda, mejorando así las propiedades de resistencia y los MW del HfO 2 FeFET basados en [12, 14]. Experimentalmente, Ali et al. verificó que aumentar el valor k de la capa aislante ultrafina (es decir, usar SiON en lugar de SiO 2 ) puede mejorar eficazmente las propiedades de resistencia y el MW del HfO 2 FeFET basados en [13]. En nuestra investigación anterior [24], informamos que la inserción de un cristalino ZrO 2 La capa de alto k en las pilas de compuertas MFIS podría mejorar la calidad cristalina y suprimir la formación de fase monoclínica en Hf 0.5 Zr 0.5 O 2 (HZO) películas delgadas, lo que conduce a un gran MW de 2.8 V caracterizado por el método de barrido de voltaje de CC.
En este trabajo, informamos sobre la caracterización de los MW, la retención y la resistencia de los FeFET basados en HZO con y sin ZrO cristalino 2 capas de semillas mediante el uso de mediciones rápidas de pulsos de voltaje positivo y negativo. Además, la ventaja de emplear ZrO 2 cristalino Se discuten las capas de semillas sobre el MW y las propiedades de resistencia.
Métodos
Los FeFET de canal n con y sin ZrO 2 Las capas de semillas se fabricaron utilizando un proceso de compuerta última, como se describe en [24]. El ZrO 2 La capa de semillas y la capa de HZO se cultivaron a una temperatura de crecimiento de 300 o C por deposición de capa atómica (ALD). El esquema de los FeFET fabricados se muestra en la Fig. 1a, cuyo ancho de canal ( W ) y longitud ( L ) fueron de 80 y 7 μm, respectivamente. Mientras tanto, TaN / HZO / TaN y TaN / HZO / ZrO 2 También se fabricaron condensadores de / TaN para evaluar las propiedades ferroeléctricas de las películas delgadas de HZO. La polarización-voltaje ( P – V ) Los bucles de histéresis de los condensadores se midieron utilizando un sistema de prueba ferroeléctrico RT66A de Radiant Technologies, mientras que las características del dispositivo de los FeFET se midieron con un analizador de dispositivos semiconductores Agilent B1500A con una unidad generadora de impulsos (B1525A) [20]. En la Fig. 1b y c se muestran dos secuencias de prueba principales utilizadas para las mediciones de MW y resistencia. Para las mediciones de MW y retención, los pulsos de programa / borrado (P / E) se aplicaron primero a las puertas de los FeFET, y las operaciones de lectura se realizaron en diferentes intervalos de tiempo usando I D - V G barrido ( V D =0,1 V) para detectar V TH . Generalmente, V TH se determina como un voltaje de puerta correspondiente a una corriente de drenaje de 10 −7 A ∙ W / L [25], y el MW se define como la diferencia de V TH valores entre los estados programado y borrado. Para las mediciones de resistencia, el MW se midió después de un cierto número de pulsos P / E alternos.

un Esquema de los FeFET fabricados. El ZrO 2 cristalino adicional La capa de semillas está marcada por líneas de cuadrícula negras. b , c Secuencias de prueba utilizadas para mediciones de resistencia y MW
Resultados y discusión
La figura 2a muestra la P – V bucles de histéresis de TaN / HZO / TaN y TaN / HZO / ZrO 2 / Condensadores TaN. Sorprendentemente, el TaN / HZO / ZrO 2 El capacitor / TaN posee propiedades ferroeléctricas aún mejores que el capacitor TaN / HZO / TaN, lo cual es consistente con los resultados reportados [26], lo que indica que el ZrO cristalino 2 De hecho, la capa de semillas podría mejorar la calidad cristalina y suprimir la formación de fase monoclínica en películas delgadas de HZO [24]. La figura 2b muestra la I D - V G curvas de los FeFET basados en HZO con y sin ZrO cristalino 2 adicional capas de semillas después de pulsos P / E. Las líneas rojas del símbolo representan el I D - V G curvas después de aplicar un pulso de programa de 7 V / 100 ns, mientras que las líneas de símbolo azul representan la I D - V G curvas después de aplicar un pulso de borrado de - 7 V / 100 ns. Se puede ver que el I D - V G Las curvas de ambos FeFET muestran características de conmutación en sentido antihorario, lo que sugiere que los MW de los FeFET actuales se originan a partir de la conmutación de polarización de las capas de HZO, en lugar de la captura e inyección de carga. Sin embargo, el FeFET basado en HZO con el cristalino adicional ZrO 2 La capa de semillas exhibe un MW mejorado de 1.4 V, aproximadamente 1.8 veces más grande que el (0.8 V) del FeFET basado en HZO sin el ZrO 2 cristalino adicional capa de semillas. Además, el MW obtenido de 1,4 V es comparable a los mejores resultados informados hasta la fecha [9, 11, 14, 17, 21,22,23, 27].
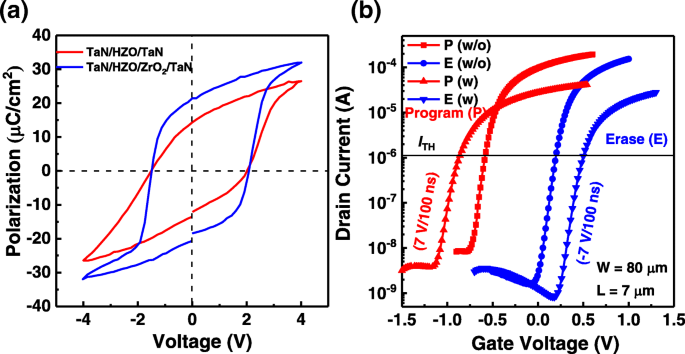
un P – V bucles de histéresis de TaN / HZO / TaN y TaN / HZO / ZrO 2 / TaN Estructuras MFM medidas a 4 V y una frecuencia de 5 kHz. b yo D - V G curvas de FeFET basados en HZO con (w) y sin (w / o) ZrO 2 capas de semillas después de un pulso de programa (+ 7 V / 100 ns) y un pulso de borrado (- 7 V / 100 ns)
Fiabilidad con respecto a la retención de los FeFET basados en HZO con y sin ZrO 2 cristalino adicional También se evaluaron las capas de semillas. La Figura 3 muestra la V TH características de retención después de aplicar un pulso de programa de 7 V / 100 ns y un pulso de borrado de - 7 V / 100 ns a temperatura ambiente. Está claro que el V TH los valores son aproximadamente lineales con la escala de tiempo logarítmica. El MW extrapolado después de 10 años para el FeFET basado en HZO con el ZrO 2 cristalino adicional La capa de semillas es de 0,9 V, mayor que la (0,6 V) para el FeFET basado en HZO sin el ZrO 2 cristalino adicional capa de semillas. Dado que el espesor equivalente de capacitancia gruesa (CET) del ZrO 2 (1,5 nm) / SiO 2 (2.6 nm) capas aislantes de la compuerta conducirían a un campo de despolarización mejorado en la pila de compuertas [13, 15], se podría esperar una mejora adicional en las propiedades de retención si el espesor del SiO 2 capa se reduce.

Características de retención de FeFET basados en HZO con y sin ZrO 2 capas de semillas
La figura 4 muestra la evolución de I D - V G curvas después de ± 7 V / 100 ns alternando ciclos P / E. Para el FeFET sin el ZrO 2 cristalino adicional capa de semillas, tanto un cambio significativo como una degradación de la pendiente en el I D - V G Las curvas se observan desde las primeras etapas del ciclo P / E, y el I D - V G las curvas en los estados borrados presentan una mayor degradación de la pendiente en comparación con los estados del programa. Para el FeFET con el ZrO 2 cristalino adicional capa de semillas, aunque el I D - V G Las curvas en estados borrados exhiben un cambio positivo obvio durante las primeras etapas del ciclo P / E que se atribuye al efecto de "despertar" [13, 28,29,30,31,32], sin un cambio obvio de I D - V G Las curvas en los estados del programa se observan hasta 1 × 10 3 ciclos. Además, para el FeFET con el ZrO 2 cristalino adicional capa de semillas, el I D - V G las curvas en los estados de programa y borrado muestran solo una ligera degradación de la pendiente de hasta 1 × 10 3 ciclos.
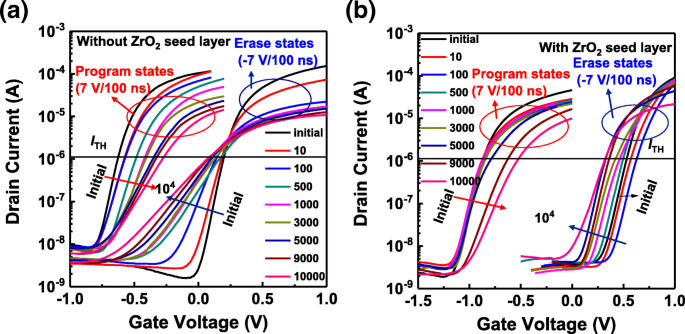
Evolución de I D - V G curvas de FeFET basados en HZO a sin y b con ZrO 2 capas de semillas con ciclos P / E
Según informes anteriores [12, 28, 33], el cambio paralelo en I D - V G Las curvas se atribuyen a la acumulación gradual de cargas atrapadas en la pila de puertas, mientras que la degradación de la pendiente en I D - V G curvas es el resultado de la generación de trampas de interfaz. Dado que las cargas atrapadas pueden eliminarse por medios eléctricos, pero la generación de trampas de interfaz es irreversible, minimizar la generación de trampas de interfaz es extremadamente importante para mejorar las propiedades de resistencia [28]. Las trampas de interfaz generadas por el ciclo P / E (Δ N eso ) se puede describir usando la Ec. (1) [34, 35]:
$$ \ Delta \ mathrm {SS} =\ frac {\ Delta {N} _ {it} kT \ ln 10} {C_ {FI} {\ varnothing} _F} $$ (1)donde ΔSS es el cambio de la oscilación del subumbral, k es la constante de Boltzmann, T es la temperatura absoluta, C FI es la capacitancia total de la pila de puertas, y ∅ F es el potencial de Fermi. El Δ N eso en función del ciclo P / E para los FeFET basados en HZO con y sin ZrO cristalino 2 adicional Las capas de semillas se muestran en la Fig. 5. Claramente, para el FeFET sin el ZrO 2 cristalino adicional capa de semillas, el Δ N eso aumenta obviamente desde las primeras etapas del ciclo P / E, y Δ N eso en los estados borrados es mucho mayor que en los estados del programa. Sin embargo, el Δ N eso para el FeFET con el ZrO 2 cristalino adicional La capa de semillas casi no cambia hasta 1 × 10 3 ciclos, y siempre es más pequeño que el del FeFET sin el ZrO 2 cristalino adicional capa de semillas. Porque al insertar el ZrO 2 adicional La capa de semillas reduce el campo eléctrico en la pila de puertas y, por lo tanto, la curvatura de la banda es más débil, la generación de trampas de interfaz se alivia [12, 14].
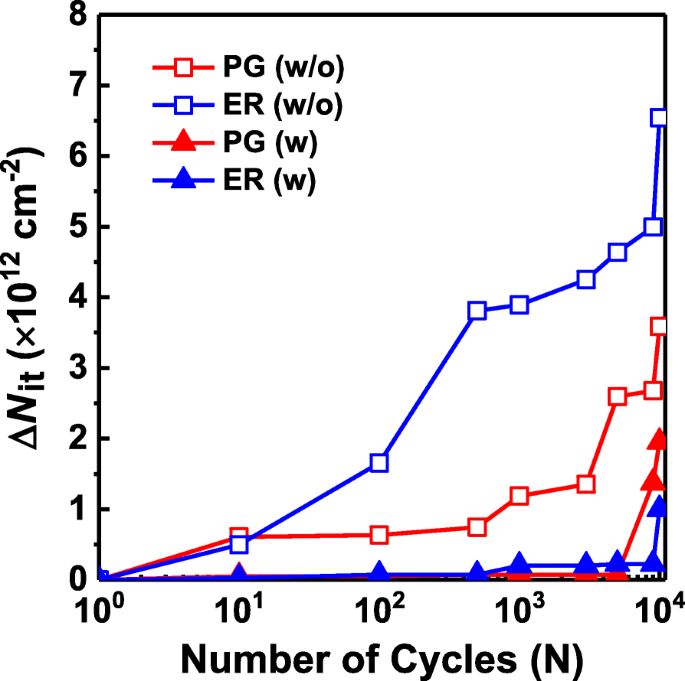
Evolución de ∆ N eso con ciclo P / E
La Figura 6 muestra la evolución de las características de la corriente de fuga de la puerta ( I G - V G curvas) de FeFET basados en HZO con y sin ZrO 2 capas de semillas con ciclos P / E. Para el FeFET sin el ZrO 2 cristalino adicional capa de semillas, la corriente de fuga de la compuerta aumenta drásticamente desde las primeras etapas del ciclo P / E. Sin embargo, la corriente de fuga de la puerta para el FeFET con el cristalino adicional ZrO 2 La capa de semillas casi no cambia hasta 5 × 10 2 ciclos, y siempre es más pequeño que el del FeFET sin el ZrO 2 cristalino adicional capa de semillas. Se informa que el aumento de la corriente de fuga de la puerta podría estar relacionado con las trampas de interfaz generadas [28]. La reducción en la corriente de fuga de la compuerta con ciclos para el FeFET con el ZrO 2 cristalino adicional La capa semilla se atribuiría a la supresión de la generación de trampas de interfaz.
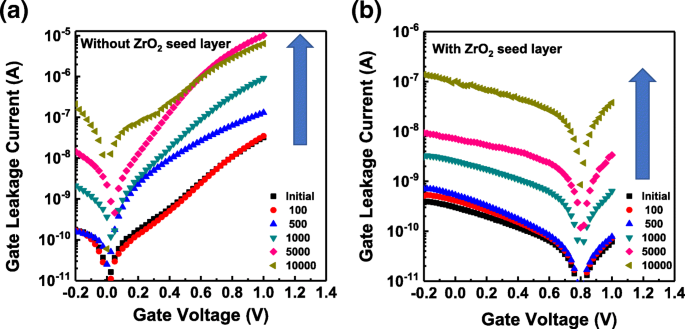
Evolución de las características de la corriente de fuga de la puerta ( I G - V G curvas) de FeFET basados en HZO a sin y b con ZrO 2 capas de semillas con ciclos P / E
La V TH valores para programar y borrar estados extraídos de I D - V G curvas de los FeFET basados en HZO con y sin ZrO cristalino 2 adicional Las capas de semillas se muestran en la Fig. 7. El FeFET basado en HZO con el ZrO 2 cristalino adicional La capa de semillas siempre exhibe un MW más grande que el FeFET basado en HZO sin el ZrO 2 cristalino adicional capa de semillas. Además, el MW del FeFET basado en HZO sin el ZrO 2 cristalino adicional La capa de semillas disminuye obviamente desde las primeras etapas del ciclo P / E, mientras que el MW del FeFET basado en HZO con el ZrO 2 cristalino adicional La capa de semillas disminuye ligeramente hasta 1 × 10 3 ciclos. A medida que aumenta aún más el número de ciclos P / E, el FeFET basado en HZO con el ZrO 2 cristalino adicional La capa de semillas también muestra una degradación obvia en la pendiente del I D - V G curvas y el MW, debido a la generación mejorada de trampas de interfaz. Sin embargo, el MW del FeFET basado en HZO con el ZrO 2 cristalino adicional la capa de semillas sigue siendo mayor que 0,9 V hasta 1 × 10 4 ciclos, que es aproximadamente 2,3 veces mayor que el (0,4 V) del FeFET basado en HZO sin el ZrO 2 cristalino adicional capa de semillas. Como se discutió anteriormente, la disminución del campo eléctrico requerido para obtener estados de polarización más saturados es probablemente responsable de las propiedades de resistencia mejoradas.

Evolución de V TH con ciclo P / E
Conclusiones
Los MW, así como la confiabilidad con respecto a la retención y resistencia de los FeFET basados en HZO con TaN / HZO / SiO 2 / Si y TaN / HZO / ZrO 2 / SiO 2 Las pilas de compuertas / Si MFIS se caracterizaron por mediciones rápidas de pulsos de voltaje. Los resultados muestran que el FeFET basado en HZO con el ZrO 2 cristalino adicional La capa de semillas exhibe una ventana de memoria inicial grande de 1.4 V y una retención extrapolada de 10 años de 0.9 V, mayor que la ventana de memoria inicial (0.8 V) del FeFET basado en HZO sin el ZrO 2 capa de semillas. Además, la fiabilidad con respecto a la resistencia del FeFET basado en HZO se puede mejorar insertando el ZrO 2 cristalino capa de semillas entre la capa de HZO y el SiO 2 / Sustrato de Si. El MW y la mejora de la resistencia de los FeFET basados en HZO con ZrO 2 Las capas de semillas están relacionadas principalmente con la calidad cristalina mejorada de la capa de HZO y la generación suprimida de trampas de interfaz debido a la disminución del campo eléctrico requerido para obtener estados de polarización más saturados. Sobre la base de este trabajo, se espera que el empleo de una pila de compuertas de alto k / Si cristalino directo mejore aún más los MW y la confiabilidad del HfO 2 basados en FeFET y, por lo tanto, justifican un mayor estudio y desarrollo.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este artículo se incluyen dentro del artículo.
Abreviaturas
- CMOS:
-
Semiconductor de óxido de metal complementario
- FeFET:
-
Transistor de efecto de campo ferroeléctrico
- FeFET:
-
Transistores de efecto de campo ferroeléctrico
- HKMG:
-
Puerta de metal high-k
- HZO:
-
Hf 0.5 Zr 0.5 O 2
- I D :
-
Drenar corriente
- L:
-
Longitud
- MFIS:
-
Metal / ferroeléctrico / aislante / semiconductor
- MW:
-
Ventana de memoria
- P / E:
-
Programar / borrar
- P – V :
-
Polarización-voltaje
- SS :
-
Oscilación del subumbral
- V G :
-
Voltaje de puerta
- V TH :
-
Voltaje umbral
- W:
-
Ancho
- Δ N eso :
-
Las trampas de interfaz generadas
Nanomateriales
- ST:MCU de 8 bits con analógico enriquecido y DMA en paquete SO-8 de bajo costo
- Nanomaterial inteligente y nanocompuesto con actividades agroquímicas avanzadas
- Memoria resistiva ZrO2 / ZrO2 - x / ZrO2 sin cumplimiento con comportamiento de conmutación multiestado interfacial controlable
- Mecanismo de conducción y resistencia mejorada en RRAM basado en HfO2 con tratamiento de nitruración
- Mejora de la absorción y modulación de frecuencia del microbolómetro THz con estructura de micropuente mediante antenas de tipo espiral
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- FET de canal U de puerta rectangular de alto rendimiento con solo 2 nm de distancia entre los contactos de fuente y drenaje
- Una referencia de voltaje sin resistencia de baja potencia a nanoescala con PSRR alto
- Memristor flexible basado en Hf0.5Zr0.5O2 depositado en capa atómica con plasticidad sináptica a corto / largo plazo
- Alto voltaje de ruptura y baja resistencia dinámica a la activación de AlGaN / GaN HEMT con implantación de iones de flúor en la capa de pasivación de SiNx
- Transiciones de fase y formación de una estructura tipo monocapa en películas delgadas de oligotiofeno:exploración con una difracción de rayos X in situ y mediciones eléctricas combinadas



