Memoria resistiva ZrO2 / ZrO2 - x / ZrO2 sin cumplimiento con comportamiento de conmutación multiestado interfacial controlable
Resumen
Una transformación controlable del modo de conmutación interfacial al filamentario se presenta en un ZrO 2 / ZrO 2 - x / ZrO 2 memoria resistiva de tres capas. Los dos modos de conmutación se investigan con los posibles mecanismos de conmutación y transformación propuestos. Modulación de resistividad del ZrO 2 - x Se propone que la capa sea responsable de la conmutación en el modo de conmutación interfacial mediante la inyección / retracción de iones de oxígeno. La conmutación está libre de cumplimiento debido a la resistencia en serie intrínseca de los filamentos formados en el ZrO 2 capas. Al ajustar el RESET voltajes, se puede lograr una memoria multiestado controlable y estable, lo que claramente apunta hacia la capacidad de desarrollar la memoria multiestado de alto rendimiento de próxima generación.
Antecedentes
El desarrollo de una memoria no volátil más densa, más rápida y que consuma menos energía es de gran importancia para las innovaciones en la tecnología de la información moderna [1, 2]. Si bien muchos contendientes han surgido para ser la próxima generación de dispositivos de memoria, la memoria resistiva de acceso aleatorio (RRAM) basada en óxidos metálicos es uno de los candidatos más prometedores por sus ventajas de alta velocidad, alta escalabilidad, bajo consumo de energía y buena compatibilidad con el Proceso CMOS [3]. Aunque el mecanismo de conmutación detallado de la memoria resistiva sigue siendo incierto, se acepta ampliamente que la migración de las vacantes de oxígeno bajo un campo eléctrico aplicado juega un papel clave en el comportamiento de conmutación [4]. Dependiendo del mecanismo de conmutación, la conmutación resistiva se puede clasificar en modos filamentosos e interfaciales (homogéneos). El modo filamentoso se logra mediante la formación y ruptura de filamentos vacantes de oxígeno entre dos electrodos. Por otro lado, la conmutación de resistencia en el modo interfacial está controlada por la distribución de las vacantes de oxígeno a lo largo de una interfaz. La corriente se localiza en los filamentos conductores en el modo filamentoso, mientras que se distribuye homogéneamente a través del área del dispositivo en el modo interfacial [5, 6]. El modo de conmutación resistiva que se caracteriza en un dispositivo de memoria depende en gran medida de su estructura. En general, la exposición del modo interfacial en el sistema basado en óxido metálico se basa en la existencia de un perfil de gradiente de oxígeno a lo largo del eje vertical [7, 8]. Recientemente, también se ha informado de la coexistencia de ambos modos en un sistema material [9,10,11]. Modulando los parámetros de medición, también se puede lograr la transformación entre estos dos modos [12]. Sin embargo, el cambio en el modo interfacial generalmente se atribuye al cambio de la altura de la barrera de Schottky inducida por los procesos de acumulación y agotamiento de los portadores a través de estados defectuosos en la interfaz de la capa de función / electrodo [7, 9,10,11,12,13, 14,15,16,17,18] en lugar del efecto de la migración de las vacantes de oxígeno en las interfaces óxido / óxido.
En los últimos años, se ha logrado un gran progreso para aumentar la densidad de almacenamiento de RRAM. Además de los esfuerzos para reducir las dimensiones físicas de la celda de memoria, se ha convertido en utilizar los estados de resistencia intermedia (IRS) entre el estado de alta resistencia (HRS) y el estado de baja resistencia (LRS) para realizar el almacenamiento multiestado dentro de una celda de memoria. una solución alternativa popular [19, 20]. Este comportamiento de almacenamiento multiestado es importante para el almacenamiento de alta densidad y los dispositivos sinápticos electrónicos basados en óxidos [21, 22, 23]. El almacenamiento multiestado en modo de conmutación de filamentos se realiza controlando el ancho y / o el número de filamentos conductores con diferentes RESET voltajes o SET cumplimientos vigentes. Una variedad de óxidos metálicos, incluido TiO x , ZnO, SiO x y HfO 2 , han demostrado un comportamiento multiestado en dispositivos RRAM [24,25,26,27]. También se informó de almacenamiento multiestado en modo de conmutación interfacial donde se propuso que el ajuste de los anchos de las regiones defectuosas en oxígeno era responsable de este comportamiento [12, 28]. Sin embargo, ambos modos de conmutación requieren cumplimiento actual en el SET proceso para proteger el dispositivo de averías y, en el caso de conmutación filamentosa, para lograr estados de resistencia multiplicados más bajos. Estos requisitos podrían generar complejidad en el diseño de circuitos RRAM. Por lo tanto, la memoria resistiva libre de cumplimiento con comportamiento de conmutación multiestado controlable podría ser ventajosa, ya que minimiza el exceso de corriente durante la conmutación y tiene el potencial de reducir considerablemente el costo de fabricación [29, 30].
Recientemente, el uso de ZrO 2 ya que la capa de conmutación activa ha atraído la atención debido a su alta estabilidad termodinámica, composición simple y compatibilidad con el proceso de semiconductores [31, 32, 33]. Además, insertando una capa alienígena dentro del ZrO 2 Se ha demostrado que la película para producir una heteroestructura de óxido es un método eficaz para mejorar las características de conmutación en ZrO 2 -dispositivos basados en [34, 35]. En este trabajo, demostramos un ZrO 2 / ZrO 2 - x / ZrO 2 -memoria resistiva basada en la cual un ZrO 2 - x no estequiométrico La capa se forma dentro del ZrO 2 capa insertando una capa Zr. Se observan los modos interfacial y filamentario, y se puede realizar una transformación controlable de interfacial a filamentoso. Se investigan las características de conmutación y el rendimiento de ambos modos. Mientras que la interfaz óxido / electrodo tiene un efecto sobre los comportamientos de conmutación en el modo filamentoso, la conmutación en el modo interfacial dependía en gran medida de las interfaces óxido / óxido en las estructuras de tres capas. Lo más importante es que la conmutación resistiva en el modo interfacial disfruta de una propiedad libre de cumplimiento incorporada, así como un comportamiento de almacenamiento multiestado en diferentes RESET voltajes.
Métodos
ZrO 2 Se prepararon películas delgadas mediante pulverización catódica con magnetrón asistida por plasma de frecuencia media (Leybold Optics HELIOS Pro XL) a temperatura ambiente. En este proceso, el sustrato giraba a una velocidad de 180 rpm para asegurar una deposición uniforme. Durante cada rotación, se depositó en primer lugar una fina capa de Zr a partir de objetivos de metal Zr (99,99% de pureza) utilizando una potencia de 2000 W en una atmósfera de Ar. Esta fina película se transformó en una capa de óxido pasando el sustrato por debajo del O 2 plasma de la fuente de RF. El O 2 El caudal se puede ajustar para producir ZrO x películas con diferentes composiciones. Las propiedades de composición de las películas depositadas se investigaron usando rayos X de dispersión de energía (EDX) donde se usó un microscopio Zeiss EVO LS 25 equipado con un detector de rayos X Oxford INCA x-act. Se depositaron películas con un gran espesor de 1 μm directamente sobre obleas de Si para minimizar la influencia del sustrato. Se recopilaron patrones de difracción de rayos X (XRD) en incidencia de pastoreo ( θ =1 °) usando un difractómetro Rigaku Smartlab con un Cu-K de 9 kW α fuente. Los datos de espectroscopía de fotoelectrones de rayos X (XPS) se obtuvieron utilizando un sistema de sonda ThermoScientific Theta con Al – K α radiación (energía de fotones =1486,6 eV). El perfil de profundidad XPS se realizó utilizando una pistola de iones Ar a un voltaje de haz de 3 kV en un área de trama de 2 × 2 mm. Se prepararon muestras de microscopía electrónica de transmisión (TEM) usando pulido mecánico convencional seguido de molienda iónica hasta transparencia electrónica usando Ar + a 6 keV. Se realizó un último paso de molienda de baja energía a 500 eV. Con el fin de minimizar el daño superficial, la estructura y morfología de las muestras se analizaron utilizando un JEOL 2100 TEM equipado con LaB 6 y JEOL ARM200F TEM / scan TEM (STEM) con una pistola Schottky, ambos operando a 200 kV. La medición STEM de campo oscuro anular (ADF) se realizó en ARM200F, con correctores CEOS de aberración de imagen y sonda. Las imágenes ADF-STEM se obtuvieron usando un detector de campo anular JEOL con una corriente de sonda de aproximadamente 23 pA, un semiángulo de convergencia de ∼25 mrad y un ángulo interno de 45-50 mrad. Un Oxford Instruments X-Max N Se utilizó el detector de deriva de silicio (SSD) sin ventana 100TLE para realizar el análisis STEM-EDX.
El comportamiento de conmutación resistiva del ZrO 2 de tres capas / ZrO 2 - x / ZrO 2 La película fue investigada como memoria. Se pulverizó reactivamente una película de TiN de 200 nm de espesor (objetivo de Ti en un N 2 atmósfera) sobre el SiO 2 capa para formar el electrodo inferior. Esto fue seguido por la pulverización catódica reactiva de un segundo SiO 2 capa (objetivo de Si en un O 2 atmósfera). Esta capa de SiO 2 se diseñó para formar áreas de dispositivos activos mediante fotolitografía y grabado con iones reactivos. Posteriormente, ZrO 2 / ZrO 2 - x / ZrO 2 (20 nm / 5 nm / 20 nm) se depositaron tri-capas para formar la capa de conmutación. La estructura de tres capas se obtuvo deteniendo el plasma de oxígeno durante el ZrO 2 crecimiento. ZrO 2 La capa se logra bajo un O 2 caudal de 20 sccm mientras que el ZrO 2 - x La capa se obtiene apagando el O 2 flujo durante 20 s. Un ZrO 2 idéntico / ZrO 2 - x / ZrO 2 También se depositó triple capa sobre un sustrato de Si para la caracterización XRD y XPS. Finalmente, se pulverizó una capa de TiN de 200 nm y se modeló sobre la triple capa para formar el electrodo superior. Todas las mediciones eléctricas se realizaron con un sistema de caracterización de semiconductores Keithley 4200. Durante las mediciones, la polarización del voltaje de programación se aplicó al electrodo superior, mientras se mantenía conectado a tierra el electrodo inferior. Los contactos de la sonda / punto a los electrodos superior e inferior de los dispositivos se realizaron a través de un par de agujas de sonda Wentworth, utilizando una sonda semiautomática AVT 702 de los laboratorios Wentworth. Las mediciones de barrido de tensión CC se realizaron a una velocidad constante de 0,5 V / s.
Resultados y discusión
Las propiedades de la estructura de tres capas fueron investigadas en primer lugar por XRD. La Figura 1 muestra el patrón XRD de las tri-capas depositadas (rojo) que presenta dos picos colocados a 28,2 ° y 29,8 °. Estos dos picos se pueden asignar al pico −111 del monoclínico ZrO 2 fase y el pico 101 del tetragonal ZrO 2 fase, respectivamente, lo que indica la existencia de dos fases. Caracterizaciones EDX y XRD realizadas en un solo ZrO x capas con diferentes composiciones (que se muestran en el archivo adicional 1:Figura S1 y S2) revelan que la ZrO estequiométrica 2 muestra la fase monoclínica (azul) mientras que la fase tetragonal (verde) se detectó a partir del ZrO deficiente en oxígeno 2 - x capa. No se observaron picos XRD de Zr metálico (rosa) en el patrón XRD de tres capas. Esto sugiere la coexistencia tanto de ZrO 2 estequiométrico y ZrO 2 - x deficiente en oxígeno capa en la estructura de tres capas y la capa de Zr incrustada se ha oxidado.
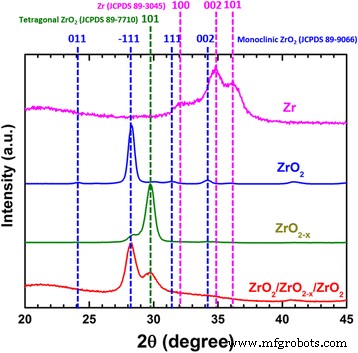
Patrones XRD del ZrO 2 depositado / ZrO 2 - x / ZrO 2 estructura de tres capas ( rojo ), ZrO deficiente en oxígeno 2- x capa ( verde ), estequiométrico ZrO 2 capa ( azul ) y capa pura de Zr metálico ( rosa )
La Figura 2a, b presenta los resultados XPS de los perfiles de pico de Zr 3d y O 1s durante un tiempo de grabado de 800 s. Dos picos colocados en ca. 182.3 y 184.5 eV se pueden atribuir al Zr 4+ completamente oxidado estado [36, 37], que dominan los espectros Zr hasta un tiempo de grabado de ca. 300 s. Una intensidad mejorada clara de dos picos colocados en ca. Posteriormente se pueden observar 178,3 y 180,5 eV entre el tiempo de grabado de 300 a 400 s; esto también va acompañado de la reducción de O 2− intensidad máxima a ca. 530,0 eV. Se ha sugerido que estos dos picos de Zr 3d están asociados con el Zr 0 metálico o no oxidado estado [36]. Esto indica la ZrO 2 - x deficiente en oxígeno La capa se encuentra en el medio de esta estructura de tres capas. Después de 400 s de tiempo de grabado, el Zr 4+ los picos reanudan su dominio y la intensidad de la O 2− pico ha vuelto a la normalidad. La concentración atómica a lo largo del perfil de profundidad en la Fig. 2c confirma aún más la oxidación de la capa de Zr incrustada en ZrO 2 - x no estequiométrico . También vale la pena mencionar que los gradientes de composición entre ZrO 2 y ZrO 2 - x También se observaron interfaces, lo que se sugiere para facilitar la formación del comportamiento de conmutación interfacial [8]. Teniendo en cuenta los resultados de XRD y XPS, es razonable creer que la fase monoclínica detectada en la XRD se origina a partir de dos ZrO 2 estequiométricos capas. El ZrO deficiente en oxígeno intercalado 2 - x La capa, por otro lado, contribuye a la fase tetragonal aunque no se pueden descartar algunos rastros de regiones amorfas.
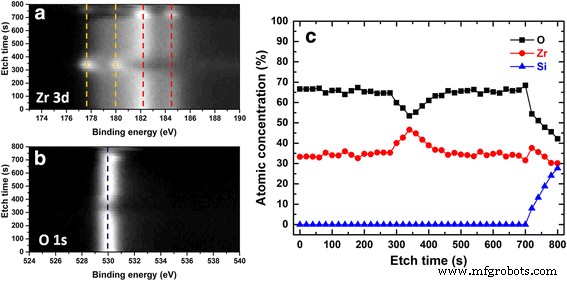
Espectros XPS de a Zr 3d y b O 1 para el ZrO 2 / ZrO 2 - x / ZrO 2 estructura de tres capas durante un tiempo de grabado de 700 s. c Perfil de profundidad XPS del ZrO 2 / ZrO 2 - x / ZrO 2 estructura de tres capas
La medición de TEM confirma aún más la estructura de tres capas con ZrO 2 - x deficiente en oxígeno capa claramente observada como se muestra en la Fig. 3a. Además, otra capa interfacial entre el ZrO 2 La capa y el electrodo inferior de TiN también son visibles. El correspondiente perfil de EDX se demuestra en la Fig. 3b en la que la interdifusión de átomos de Ti, O, N y Zr es evidente en los primeros 10 nm. Además, la relación O:Zr mucho más alta (cuadrado abierto) en los primeros 5 nm confirma la existencia de un TiO x N y capa interfacial entre el ZrO 2 y el electrodo inferior de TiN. De hecho, como ZrO 2 se pulveriza inmediatamente después de TiN, el O 2 el plasma reaccionará con la superficie de TiN para formar un TiO x N y capa cuando el ZrO 2 La capa es todavía muy fina. Formación similar de TiO interfacial x N y también se informó la capa [38, 39].
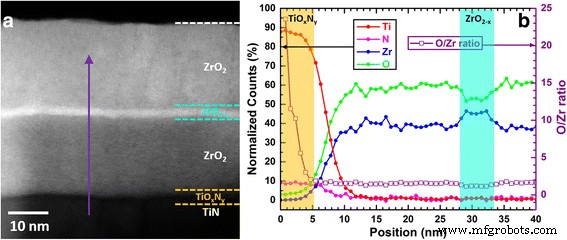
un Imagen ADF-STEM de la sección transversal de la muestra y b Perfiles de línea elemental STEM-EDX del TiN / ZrO 2 / ZrO 2 - x / ZrO 2 estructura
Basado en los resultados de la caracterización, el esquema del ZrO 2 / ZrO 2 - x / ZrO 2 La memoria de tres capas se muestra en la Fig. 4a. Se mide que el dispositivo prístino se encuentra en el estado de alta resistencia como se muestra en la Fig. 4b. Un gran voltaje de formación negativo ( I CC =1 mA) para inducir la ruptura dieléctrica suave e iniciar la conmutación. De manera bastante inusual, esto está asociado con un proceso de formación de dos pasos, lo que sugiere la formación consecutiva de dos filamentos en los dos ZrO 2 capas y el dispositivo está SET en un estado de baja resistencia. Luego se aplicó un voltaje positivo a RESET el dispositivo en el HRS como se muestra en la Fig. 4c. Notablemente, este RESET El proceso se caracteriza por una disminución gradual y continua de la corriente, una característica típica de la conmutación resistiva interfacial. El SET El proceso mediante la aplicación de una polarización de voltaje negativo también muestra un comportamiento similar, lo que sugiere que la conmutación resistiva interfacial es el modo de conmutación dominante. El comportamiento de conmutación interfacial se demuestra además por la dependencia del área de la corriente tanto en HRS como en LRS (que se muestra en la Fig. 4d). Ambas corrientes aumentan a medida que aumenta el tamaño del electrodo, lo que indica que la conducción de la corriente no es filamentaria. El aumento de la corriente, aunque no es totalmente proporcional al área. Esto podría explicarse por la modulación menos eficaz de la resistividad en tamaños de celda más grandes durante la conmutación interfacial debido a la mayor cantidad de límites de grano y corriente de fuga [12]. También se informó de un comportamiento similar en otros dispositivos de conmutación resistivos interfaciales bicapa [8, 12]. El SET El proceso demuestra un comportamiento de autocumplimiento. Esto es beneficioso para la aplicación en memoria resistiva, ya que minimiza el exceso de corriente durante la conmutación y tiene el potencial de reducir considerablemente el costo de fabricación [29, 30].
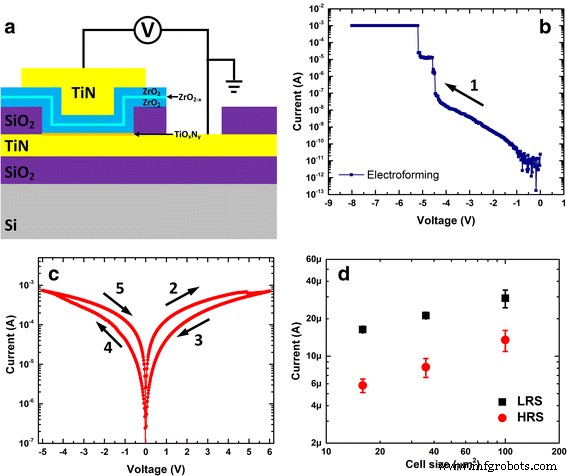
un Esquema del TiN / ZrO de tres capas 2 / ZrO 2 - x / ZrO 2 / Memoria TiN. b I – V características del proceso de electroformado para el TiN / ZrO 2 / ZrO 2 - x / ZrO 2 / Dispositivo TiN. c I – V características de la conmutación interfacial después de la formación. d Actual como función del tamaño del dispositivo para HRS / LRS en el modo de conmutación interfacial
La transformación del modo de conmutación interfacial al modo de conmutación filamentoso puede desencadenarse mediante un segundo paso de formación como se demuestra en la Fig. 5a. Se aplicó un sesgo más negativo en el dispositivo en HRS con un cumplimiento de corriente de 20 mA. Esto conduce a un aumento brusco de la corriente a aprox. −8 V, y el dispositivo permanece posteriormente en un estado de resistencia mucho menor. Después de RESET proceso con un sesgo positivo, el modo de conmutación del dispositivo se ha transformado completamente en filamentario, caracterizado por el agudo SET (control de corriente) y RESET transiciones. La Figura 5b muestra la distribución de probabilidad acumulativa de los LRS y HRS de los modos de conmutación interfacial y filamentoso en los que se pueden observar diferencias distintivas entre esos dos conjuntos de estados de resistencia, lo que indica que el dispositivo se ha conmutado en modos diferentes. Para arrojar luz sobre el mecanismo de conducción de ambos modos de conmutación, el I – V logarítmico gráficos de curvas y ajustes lineales del SET Se presentan los procesos. El I – V La curva en HRS en modo interfacial sigue un comportamiento óhmico a bajo voltaje con la adición de un término cuadrático a voltaje más alto, es decir, I ∝ aV + bV 2 , que es la característica típica del modelo de corriente limitada de carga espacial (SCLC) como se muestra en la Fig. 5c [40,41,42]. También se informaron observaciones similares de este mecanismo SCLC en otros dispositivos de memoria resistiva interfacial [8, 12]. Por otro lado, el logarítmico I – V curvas del SET El proceso en la conmutación filamentaria después de la transformación se muestra en la Fig. 5d. La curva sugiere que la corriente se rige por el modelo SCLC con trampas [40,41,42]. Aunque se utiliza un modelo de conducción similar para explicar la conmutación interfacial y filamentaria, los dos modos aún demuestran características distintas, particularmente en un estado de baja resistencia. La conducción de corriente para LRS en modo filamentario consta de dos regiones:la región óhmica ( I ∝ V ) y la región de la ley del niño ( I ∝ V 2 ) mientras que este último no se observó en la conducción LRS de la conmutación interfacial. Esto indica que la conmutación filamentaria está mediada por un proceso de captura / eliminación de la portadora [43]. Especulamos que se genera una cantidad sustancial de trampas en las rutas conductoras durante el segundo proceso de formación, lo que lleva al término cuadrático de corriente en LRS del modo filamentario.

un yo - V características del proceso de transformación ( naranja ) de la conmutación interfacial ( rojo ) a la conmutación filamentaria ( azul ). b Gráfico de probabilidad acumulada de HRS y LRS para ambas interfaces ( V REINICIAR =6 V) y modos de conmutación filamentosos. El SET proceso I – V curvas de la c interfacial y d modos de conmutación filamentosos en gráfico logarítmico doble
ZrO 2 de una sola capa También se fabricó una memoria con un espesor de película de 40 nm para compararla con el esquema mostrado en la Fig. 6a. El proceso de electroformado ( I CC =1 mA) del TiN / ZrO 2 / El dispositivo TiN presenta un solo paso con un voltaje mucho más alto (Fig. 6b). Posteriormente se observó un comportamiento de conmutación bipolar (Fig. 6c), que es similar al modo filamentario en el dispositivo de tres capas. Sin embargo, el modo de conmutación interfacial no se observó en este dispositivo de una sola capa. La figura 6d muestra el I – V logarítmico curvas del SET procesos para dispositivos monocapa que demuestren buenas concordancias con el modelo SCLC con trampas. Esto también respalda la conclusión de que el ZrO intercalado 2 - x La capa es crucial para la conmutación interfacial que tiene lugar en el ZrO 2 - x capa o cerca de la ZrO 2 - x / ZrO 2 interfaz.
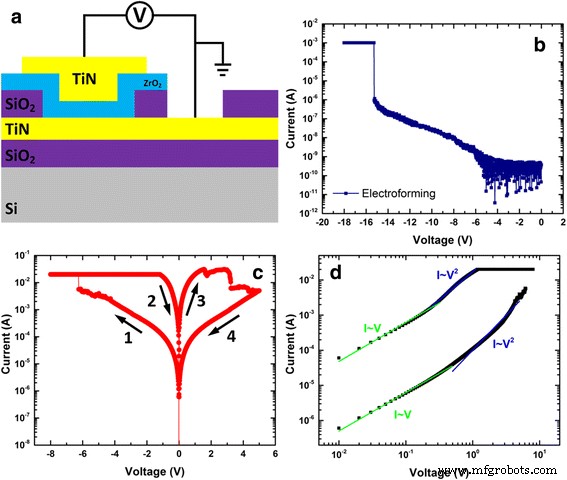
un Esquema de la capa única TiN / ZrO 2 / Dispositivo TiN. b I – V características del proceso de electroformado para el TiN / ZrO 2 / Dispositivo TiN. c I – V características del TiN / ZrO 2 / Dispositivo TiN después de la formación. d I – V curvas del SET proceso en gráfico logarítmico doble con ajuste lineal
Con base en los resultados de la caracterización, se propone un mecanismo detallado de ambos modos de conmutación y la transformación, como se muestra en la Fig. 7. Al aplicar un voltaje de formación negativo, los iones de oxígeno se empujan hacia el electrodo inferior mientras que las vacantes de oxígeno migran hacia la parte superior. electrodo y forman un filamento conductor. El TiO interfacial x N y La capa juega un papel crucial en el comportamiento bipolar, ya que sirve como depósito de oxígeno [38, 44]. Se generan dos filamentos débiles consecutivamente dentro del ZrO 2 inferior y superior capas, caracterizadas por el proceso de formación de dos pasos (Fig. 7b, c). Aunque es posible que se hayan inyectado algunos iones de oxígeno en el medio ZrO 2 - x capa, el nivel de vacantes de oxígeno sigue siendo lo suficientemente alto como para mantener la capa en un estado de baja resistencia. Por lo tanto, el dispositivo ha estado cambiando al LRS (Fig. 7c). Cuando se aplica un sesgo positivo, los iones de oxígeno son atraídos desde el TiO x N y capa al ZrO 2 - x capa, lo que resulta en la formación de una capa rica en oxígeno. Esta modulación estequiométrica del ZrO 2 - x La capa cambia la memoria a HRS (Fig. 7d). Se requiere otro sesgo negativo para SET el dispositivo en LRS empujando los iones de oxígeno desde la capa media hacia el TiO x N y depósito (Fig. 7e). La propiedad libre de conformidad del dispositivo puede derivarse de la baja conductividad de los dos filamentos, que efectivamente sirve como resistencias intrínsecas en serie. La transformación ocurre cuando se aplica un sesgo significativamente grande que induce la formación de un filamento mucho más fuerte y conductor a través de toda la estructura de tres capas (Fig. 7f). La resistencia del dispositivo ya no depende del ZrO 2 - x capa, y el modo de conmutación se transforma de interfacial a filamentoso. A continuación, el dispositivo se puede encender y APAGAR utilizando sesgo positivo y negativo, respectivamente (Fig. 7g, h).
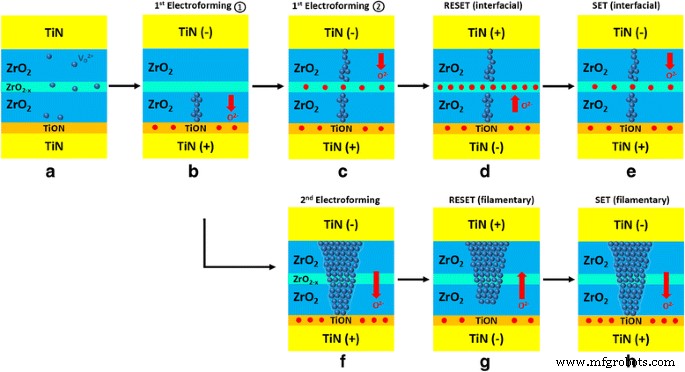
Esquemas del mecanismo de conmutación en el TiN / ZrO de tres capas 2 / ZrO 2 - x / ZrO 2 / Dispositivo TiN para el modo de conmutación interfacial ( a - e ). La transformación del modo interfacial al modo filamentario ( f ) y el modo filamentario ( g , h )
El modo de conmutación interfacial en este trabajo ofrece la posibilidad de almacenamiento multiestado. Como la resistencia del dispositivo en el modo interfacial está mediada por el nivel de iones de oxígeno en el ZrO 2 - x capa, se pueden lograr estados de resistencia múltiple controlando la cantidad de iones de oxígeno en la capa media usando diferentes RESET voltajes. La Figura 8a muestra el I – V características del dispositivo con RESET voltajes de 5.0, 5.5 y 6.0 V con un SET constante voltaje de -5 V. Vale la pena mencionar que como la migración de las vacantes de oxígeno es impulsada por el campo eléctrico, estos parámetros son escalables con el espesor de capa. Con una capa funcional gruesa de alrededor de 50 nm, este trabajo presentado todavía tiene un buen potencial para escalar y reducir significativamente tanto el SET y RESET voltajes. La Figura 8b muestra las características cíclicas de esta operación de memoria multiestado donde se demuestra la propiedad de conmutación resistiva reversible y reproducible para aprox. 100 ciclos, lo que indica un comportamiento de resistencia prometedor de este dispositivo.
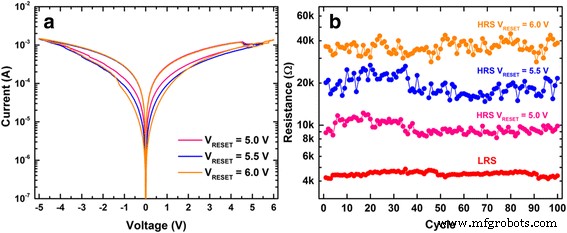
un I – V características de la conmutación interfacial para el TiN / ZrO 2 de tres capas / ZrO 2 - x / ZrO 2 / Dispositivo TiN con RESET variable voltajes. b Prueba de resistencia de 100 ciclos para la conmutación interfacial con diferentes RESET voltajes
Conclusiones
Se observó una transformación controlable del modo interfacial al modo interfacial filamentario en un ZrO 2 / ZrO 2 - x / ZrO 2 memoria de tres capas. Se propone el posible mecanismo de conmutación y transformación. El ZrO 2 - x incrustado Se cree que la capa es una capa crucial para el modo de conmutación interfacial. Este modo exhibe un comportamiento libre de cumplimiento posiblemente debido a la resistencia en serie intrínseca de los dos filamentos delgados formados en el ZrO 2 capas. Controlando el RESET voltajes, se pueden lograr resistencias multiestado en HRS. Este comportamiento de almacenamiento multiestado apunta claramente hacia la capacidad de desarrollar la memoria multiestatal de alto rendimiento de próxima generación.
Abreviaturas
- ADF-STEM:
-
Microscopía electrónica de transmisión de barrido de campo oscuro anular
- EDX:
-
Espectroscopia de rayos X de dispersión de energía
- HRS:
-
Estado de alta resistencia
- Servicio de Impuestos Internos:
-
Estado de resistencia intermedia
- LRS:
-
Estado de baja resistencia
- RRAM:
-
Memoria resistiva de acceso aleatorio
- SCLC:
-
Carga espacial de corriente limitada
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
- XRD:
-
Difracción de rayos X
Nanomateriales
- Una SRAM 4T integrada de RRAM con carga de conmutación resistiva autoinhibida mediante un proceso lógico CMOS puro
- Un estudio colectivo sobre modelado y simulación de memoria resistiva de acceso aleatorio
- Convertidor de polarización con birrefringencia controlable basado en metauperficie híbrida de grafeno totalmente dieléctrico
- Efecto de campo ferroeléctrico Inducido por efecto de conmutación asimétrica resistiva en BaTiO3 / Nb:Heterouniones epitaxiales SrTiO3
- Un estudio de la variabilidad en la memoria de acceso aleatorio resistivo de contacto por modelo de vacante estocástico
- Fabricación de patrones de conmutación óptica con microfibras de colores estructurales
- Funciones duales del dispositivo V / SiOx / AlOy / p ++ Si como selector y memoria
- Investigación de la banda de energía en las heterouniones de disulfuro de molibdeno y ZrO2
- Mejora dieléctrica de capacitores MIM de Al2O3 / ZrO2 / Al2O3 depositados en capas atómicas mediante recocido por microondas
- Ge pMOSFET de alta movilidad con dieléctrico de ZrO2:impactos del recocido posterior
- Característica de conmutación resistiva de baja potencia en la memoria de acceso aleatorio resistiva de dos capas de HfO2 / TiOx



