Un estudio de la variabilidad en la memoria de acceso aleatorio resistivo de contacto por modelo de vacante estocástico
Resumen
La variabilidad en la celda de memoria resistiva de acceso aleatorio ha sido uno de los desafíos críticos para el desarrollo de matrices RRAM de alta densidad. Si bien las fuentes de variabilidad durante la conmutación resistiva varían para diferentes películas de óxido de metal de transición, generalmente se cree que la generación / recombinación de vacantes de oxígeno estocástico es la causa dominante. Mediante el análisis de datos experimentales, se establece un modelo estocástico que vincula las características de conmutación posteriores con sus estados iniciales de contacto de las celdas RRAM. Al combinar un modelo de red de conducción y el mecanismo de túnel asistido por trampa, los impactos de la concentración y distribución de las vacantes de oxígeno intrínseco en la película dieléctrica RRAM se demuestran con la simulación de Monte Carlo. Los datos de medición en las matrices RRAM de contacto concuerdan bien con las características proyectadas por el modelo basado en la presencia de vacantes intrínsecas distribuidas aleatoriamente. Se verifica una fuerte correlación entre las características de formación y los estados iniciales, lo que vincula los comportamientos de formación con las vacantes de oxígeno preformado. Este estudio proporciona una comprensión integral de las fuentes de variabilidad en los dispositivos RRAM de contacto y un esquema de entrenamiento de reinicio para reducir el comportamiento de variabilidad en los estados RRAM subsiguientes.
Antecedentes
La memoria resistiva de acceso aleatorio (RRAM) se ha considerado una solución prometedora de almacenamiento de datos no volátiles, como resultado de sus características deseables, como baja potencia, alta velocidad P / E y compatibilidad superior con el proceso lógico CMOS [1,2,3 , 4]. Sin embargo, todavía hay muchos obstáculos que superar para implementar fácilmente matrices de memoria RRAM en los circuitos CMOS de última generación [5, 6]. Uno de los desafíos clave en la matriz RRAM considerable se encuentra en la variación existente entre y dentro de las células [7, 8, 9, 10]. Se han propuesto muchos modelos y simulaciones para describir el proceso estocástico de generación / recombinación de la vacante de oxígeno (Vo-) en la película de óxido de metal de transición (TMO) [11,12,13,14]. Kim y Brivio propusieron modelos de redes de interruptores automáticos aleatorios para emular las características eléctricas típicas de RRAM unipolar y bipolar, respectivamente [11, 12]. Sin embargo, las resistencias en estos estudios se establecieron para que fueran constantes sin considerar el transporte de electrones en la película RRAM. Además, debido a que los modelos presentados discuten los procesos estocásticos de RRAM desde un solo nivel de dispositivo en lugar del análisis estadístico, la variabilidad del comportamiento de RRAM en una matriz no se abordó y discutió bien en trabajos anteriores [11,12,13,14]. Además, la presencia de defectos en la película dieléctrica durante la fabricación se ha estudiado extensamente durante muchos años [15, 16], pero su impacto en las características de conmutación resistiva en RRAM aún debe analizarse exhaustivamente para que la tecnología se aplique en macros de memoria considerables. Para investigar el efecto de la distribución de Vo intrínseca en las características de RRAM, se construye una red de resistencias modelada en el mecanismo de túnel asistido por trampa para un análisis estadístico adicional de la variación y durante las operaciones en este estudio [11,12,13,14, 17 ]. Además, el proceso de generación estocástica de Vo- es simulado por el método de Monte Carlo para establecer la correlación entre la RRAM en sus estados iniciales y las siguientes características de formación [18,19,20]. La fuerte correlación entre el voltaje intrínseco y el voltaje de formación se establece verificando el resultado de la simulación con los datos medidos en las matrices RRAM de contacto [21]. Finalmente, los diferentes tipos de filamentos conductores (CF) generados y la variación del estado de resistencia después de las operaciones de formación como resultado de la distribución de Vo intrínseca se proyectan e investigan exhaustivamente. Además, en este estudio se propone y demuestra una solución para aliviar el impacto de preformar la variabilidad de Voon.
Métodos
Los datos de medición para un análisis estadístico adicional sobre la variabilidad se recopilan de arreglos de RRAM de contacto de 16 × 16 (CRRAM) que fueron fabricados por procesos lógicos CMOS de 28 nm, donde el proceso de fabricación de CRRAM se ilustra en la Fig. 1 [21]. La capa de óxido de protección de resistencia (RPO) y el dieléctrico de capa intermedia (ILD) se depositan primero después de que se completa el proceso de entrada con los transistores formados. Para construir una película de conmutación resistiva funcional, se realiza el tamaño adecuado del orificio de contacto, tamaño de contacto de 30 nm × 30 nm, para evitar cortocircuitos en el enchufe W y la región de difusión n +. Finalmente, la capa de barrera, TiN y el tapón de tungsteno se depositan individualmente. La imagen TEM en sección transversal de CRRAM se muestra en la Fig. 2a. Como se muestra en la imagen, CRRAM está conectado en serie con un transistor de selección de canal n. Se adopta una estructura 1T1R para garantizar la selección adecuada en una matriz y evitar sobreimpulsos. La Figura 2b muestra el mapeo de la composición de CRRAM. Su capa de óxido de metal de transición (TMO), con un espesor de 9 nm, compuesta de TiN / TiON / SiO 2 apilado se forma entre los electrodos de silicio de tungsteno superior e inferior. Después de la fabricación del dispositivo, el análisis eléctrico y la construcción del modelo físico en este estudio se completan con el analizador de parámetros de semiconductores Aglient 4156C y la plataforma de software MATLAB, respectivamente.
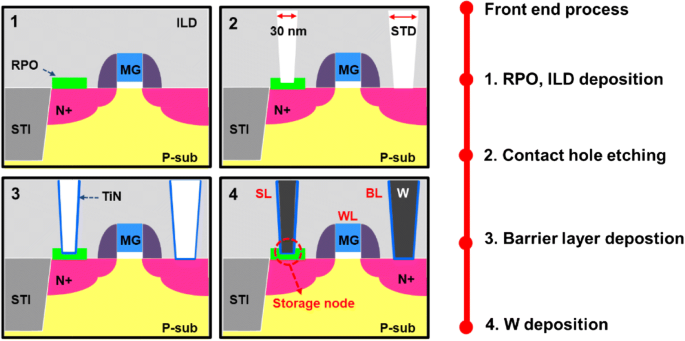
Flujo de proceso de RRAM de contacto en una plataforma de proceso lógico CMOS de puerta metálica de alta k de 28 nm. El tamaño de contacto más pequeño para CRRAM está diseñado para controlar el espesor de grabado para formar una capa de conmutación resistiva funcional
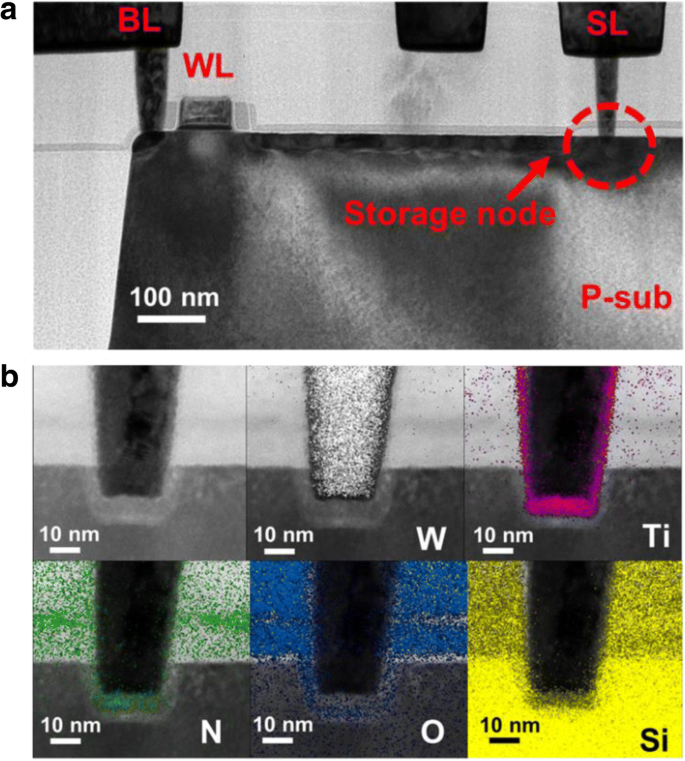
un Imagen TEM de sección transversal de la estructura 1T1R CRRAM. b Mapeo de composición de CRRAM. La película de conmutación resistiva está compuesta de TiN / TiON / SiO 2 intercalado entre el enchufe de tungsteno superior y el electrodo de Si inferior
Como se informó en un estudio anterior [22], se encuentra una amplia distribución de estados iniciales en la matriz CRRAM. Para investigar el origen de la variación del estado inicial, primero se comparan los espesores de la capa de TMO con diferentes resistencias iniciales en la Fig. 3. Los datos sugieren que no hay una diferencia de espesor significativa entre las dos celdas con una gran diferencia en los niveles de resistencia inicial. Se ha informado de muchos estudios que Vo- se genera en películas dieléctricas o RRAM durante la fabricación [23,24,25,26], lo que implica que se espera que la diferencia en el número y densidad de Vo- sea responsable de las variaciones de conductividad iniciales.
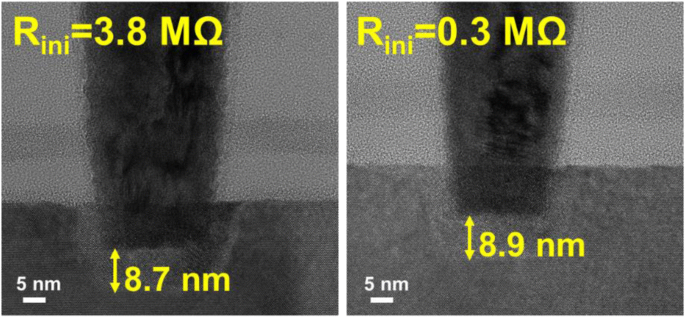
Comparación del espesor de la capa de TMO entre dos células CRRAM con gran diferencia de resistencia inicial. Ambas células se observan con espesores de capa dieléctrica de alrededor de 9 nm
Resultados y discusión
Modelo intrínseco de distribución de vacantes
Para emular las interacciones entre Vo- intrínseco, se establece un modelo de red de resistencias que se muestra en la Fig. 4a [11,12,13,14]. Las resistencias en cada cuadrícula se calculan a través de un flujo de simulación descrito en la Fig. 4b, mientras que los parámetros físicos correspondientes utilizados se enumeran en la Tabla 1. Basado en la imagen TEM de CRRAM, una estructura bidimensional de 30 nm de ancho, 10 nm de espesor , se define para describir la capa TMO, como se muestra en la Fig. 5a. La resistencia del sitio de óxido, R óxido , y la cuadrícula de malla están determinadas por la propiedad del material de anatasa-TiO 2 , que se ha utilizado como material de conmutación resistiva en muchos estudios [27,28,29,30]. Debido a su estructura tetragonal, las constantes de celosía de anatasa-TiO 2 varían con el eje cristalográfico. Para simplificar, las cuadrículas de malla en nuestro modelo están configuradas para ser de 1 nm al introducir la constante de celosía en la dirección c de anatasa-TiO 2 [31,32,33]. Además, las resistencias de las rejillas también se determinan haciendo referencia a la resistividad de anatasa-TiO 2 [34, 35]. Como se muestra en la Fig. 5a, inicialmente se dan Vo- distribuidos aleatoriamente dentro de la malla 2-D. Las dependencias de la temperatura y el campo eléctrico de la corriente de conducción de CRRAM se resumen en la Fig. 6a, b, respectivamente. Las características clave de la corriente de tunelización asistida por trampa (TAT) se muestran por su efecto de temperatura débil y la dependencia lineal entre ln (J) y 1 / E [17, 36]. Utilizando el modelo de conducción TAT, el perfil de potencial dentro de la película TMO debe calcularse primero para obtener aún más cada Vo-resistencia localizada. Se espera que la distribución de Vo- afecte predominantemente la corriente conductora, ya que la distancia de túnel varía entre las vacantes de oxígeno. La resistencia de Vo-, R ij , luego se calcula mediante la ecuación. 1, que considera las probabilidades de presencia de Vo en el sitio y adopta el modelo TAT, para calcular la probabilidad de tunelización entre estados de vacantes.
$$ {R} _ {\ mathrm {ij}, N} =\ frac {R _ {\ mathrm {óxido}}} {\ alpha \ {C} _ {\ mathrm {Vo} -} ^ {\ kern0.75em \ beta} \ \ exp \ left (\ frac {\ phi} {d} \ right)} $$ (1)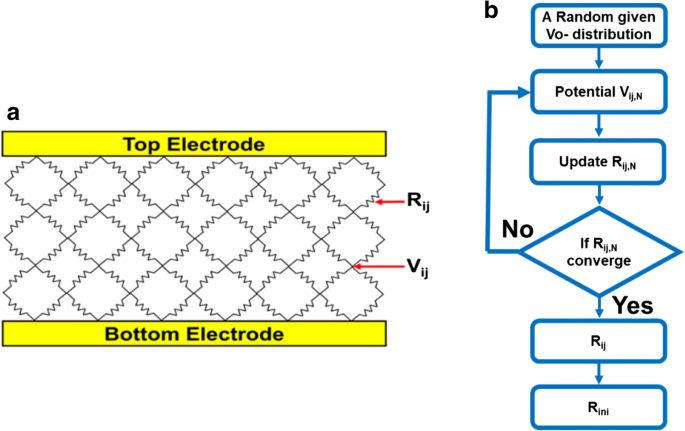
un Esquema del modelo de red de resistencias compuesto por resistencia localizada variable de Vo-. Los nodos de esta red están conectados entre sí para simular la interacción entre Vo-. b Flujo de simulación de variabilidad del nivel de resistencia inicial. La distribución estocástica de la voz intrínseca durante la fabricación se considera mediante el método de Monte Carlo

un La distribución aleatoria de la Vo- intrínseca se da inicialmente en la película RRAM. b Distribución de resistencia localizada de Vo calculada mediante la consideración de tunelización asistida por trampa. c R ini La distribución de células frescas recolectadas de matrices CRRAM concuerda bien con los datos de simulación al considerar el mecanismo de conducción TAT de preformar Vo-
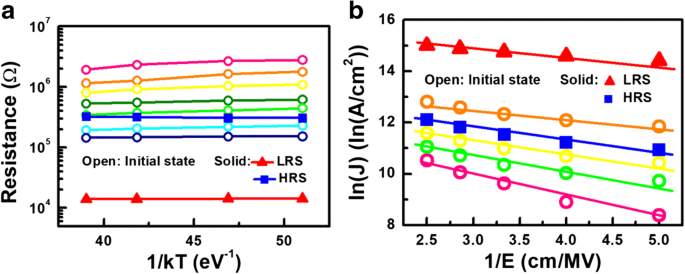
El mecanismo de conducción de CRRAM se determina marcando a dependencia de la temperatura y b dependencia del campo eléctrico. Se cree que la tunelización asistida por trampa seguida de CRRAM se debe a dos características de conducción, una dependencia débil de la temperatura y un ajuste lineal entre ln (J) y 1 / E
Cada R ij, N se actualiza en cada iteración hasta que el resultado converja eventualmente. Como la R final ij Se obtiene la distribución, como se ilustra en la Fig. 5b, la resistencia general, R ini , de una célula fresca también se puede proyectar posteriormente, como se muestra en la Fig. 5c. Como puede verse en la Fig. 5c, la variación de R simulada ini distribución obtenida por el flujo de simulación propuesto considerando la distribución estocástica y la concentración de Vo intrínseca- concuerda bastante bien con la distribución de la R ini medido en matrices CRRAM. Por lo tanto, capas de Vo-in TMO intrínsecas distribuidas aleatoriamente, que crean múltiples rutas de túnel, contribuyen a la resistencia inicial ampliamente extendida que se encuentra en las matrices CRRAM preformadas.
Análisis del proceso de conformado no uniforme
Después de modelar las causas atribuidas a la variación de celda a celda en el estado fresco, se analiza la operación de formación, inicializando las características de conmutación resistiva. El flujo de simulación de la operación de formación en el modo de barrido de CC se muestra en la Fig. 7 [18,19,20]. Como se muestra en la Fig. 8a, una celda está conectada a un transistor seleccionado en serie con una resistencia de canal de aproximadamente 5 KΩ en la región lineal y una corriente de saturación de alrededor de 80 μA. Como resultado del bajo voltaje de formación, deben considerarse los mecanismos de conducción y tensión del dieléctrico en régimen de bajo campo eléctrico. Basado en el modelo químico térmico propuesto en estudios previos, se ha demostrado una predicción precisa de falla dieléctrica [37,38,39,40]. Comportamiento teórico de la avería del TiO 2 simulado por el modelo químico térmico [41] ha mostrado características similares a las observadas en CRRAM. Por lo tanto, la tasa de generación de Vo se obtiene con base en el modelo químico térmico aquí [42,43,44]. Como sugiere el modelo químico térmico, los puntos de la cuadrícula al lado de Vo- se definen como un punto débil en la vecindad que rodea los defectos. La presencia de Vo- también induce un campo mejorado localizado, que se muestra en la Fig. 8b, y acelera el proceso de generación de Vo- [45]. Considerando el tiempo para el proceso de ruptura dieléctrica en el modelo químico térmico con una dependencia de campo de exp. (- E), la probabilidad de generación de Vo P ij se calcula mediante la siguiente ecuación [42].
$$ {P} _ {\ mathrm {ij}} =\ gamma \ \ exp \ left (\ mathrm {E} \ right) \ \ left \ {\ begin {array} {c} \ kern1.75em \ upgamma =0, \ mathrm {if} \ \ mathrm {sitio} \ \ mathrm {is} \ \ mathrm {not} \ \ mathrm {débil} \ \ mathrm {spot} \\ {} \ upgamma =1, \ mathrm {if } \ \ mathrm {sitio} \ \ mathrm {es} \ \ mathrm {débil} \ \ mathrm {lugar} \ end {matriz} \ derecha. $$ (2)
Flujo de simulación de un proceso de conformado basado en el modelo químico térmico, asumiendo el tiempo de falla dieléctrica con dependencia del campo eléctrico de exp. (- E)
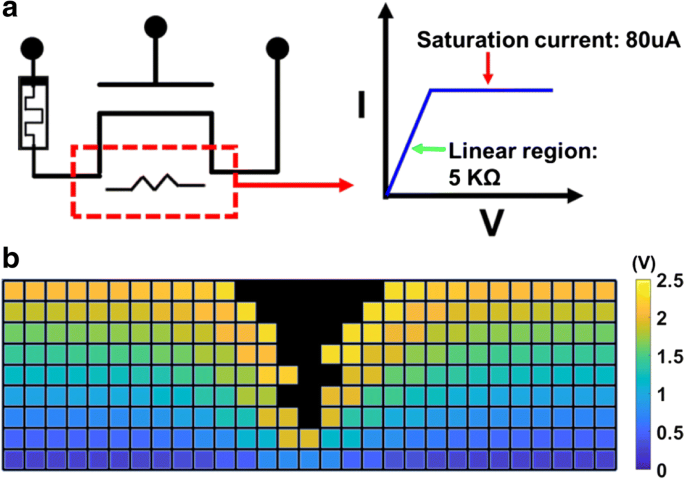
un La operación de formación se simula mediante un CRRAM conectado en serie con un transistor ideal. b La distribución de potencial eléctrico no uniforme, resultante de Vo- preexistente, induce un campo localizado y acelera la generación de nuevos defectos
Un nivel crítico, P g y un criterio, P ij > P g , se definen para determinar si se genera una nueva Vo-. Se aplica un proceso de rampa para actualizar la nueva distribución de Vo- en cada iteración hasta que el voltaje de formación alcanza los 2,7 V. Finalmente, con un Vo- intrínseco distribuido aleatoriamente, el nivel de resistencia bajo R formando después de la operación de formación se puede obtener. Según el modelo anterior, el R simulado formando distribución proyectaba una amplia variación, como se muestra en la Fig. 9a, y el I-V calculado las características concuerdan bien con los datos medidos. Además, también se investiga la correlación entre las características de formación y los estados iniciales. Una mayor concentración y Vo distribuida localizada aceleran el proceso de formación. Por lo tanto, la correlación positiva entre el voltaje de formación y R ini se encuentran tanto en los resultados de la simulación como en los datos medidos, como se muestra en la Fig. 9b.
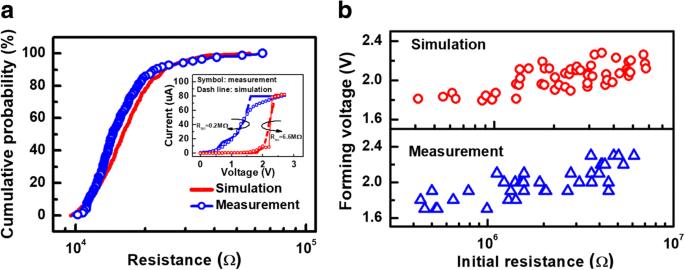
un La distribución de resistencia simulada de la operación de conformado concuerda bien con el resultado de la medición. b Las correlaciones positivas entre la resistencia inicial y el voltaje de formación se encuentran tanto en los datos medidos como en los simulados debido a más puntos débiles y mayor intensidad de campo eléctrico producidos por el preformado. Vo-
Además, el Vo generado en la operación de formación induce una ruta conductora y da como resultado un cambio de CF en las células, donde la evolución de CF durante el proceso de formación se muestra en la Fig. 10. Para células con alto R ini , hay menos Vo intrínseca y menos puntos débiles, como se ilustra en la Fig. 10a. Después de la operación de formación, es más probable que se produzca una única vía conductora entre los electrodos. Sin embargo, el crecimiento de CF en células con mucho Vo intrínseco mostrado en la Fig. 10b tiende a estar más extendido; por lo tanto, los CF dendríticos se generan después de su formación. La correlación entre diferentes topografías de CF y la distribución de Vo en su estado fresco también se verifica mediante datos de medición. Se sabe que Vo y CF en la capa TMO producen un ruido telegráfico aleatorio (RTN) distintivo durante el proceso de captura / eliminación de trampas de electrones [46]. Las fluctuaciones de resistencia ocurren si la ruta conductora está bloqueada por electrones atrapados, y la resistencia disminuye cuando el electrón se desencaja. El análisis RTN de CRRAM después de la formación se resume en la Fig. 11. Se encuentra una fluctuación de resistencia regular de dos pasos en células con un alto R ini , cuando la captura / eliminación de trampas de electrones tiene lugar en un dispositivo con un CF dominante. Por otro lado, el RTN de varios niveles se encuentra en celdas con bajo R ini que se espera que obstruya la FQ dendrítica con más de una vía. El resultado estadístico de RTN se resume en la Fig. 12, analizando la medición de RTN de más de 200 células CRRAM. Los datos sugieren que las celdas con alto R ini tienden a exhibir solo RTN de dos niveles, lo que es más probable que ocurra en dispositivos con una CF dominante [46,47,48,49]. La variación de resistencia después de la operación de formación se muestra en la Fig. 13. Los datos sugieren que se encuentran variaciones de resistencia más altas tanto en el resultado de medición como en el de simulación en las celdas con R bajo. ini . A medida que los CF menos confinados empujan al transistor seleccionado a ingresar temprano a la región de saturación, es posible que una celda no se forme correctamente, lo que lleva a niveles de resistencia de estado de baja resistencia más amplios.

Progreso de la FQ en la celda con a alta resistencia inicial y b baja resistencia inicial. Una mayor concentración intrínseca de Vo en la capa de TMO da como resultado una generación aleatoria de Vo en los puntos débiles. Estos Vo- también se conectan entre sí para formar caminos dendríticos

Las topografías de CF en la celda con a alta resistencia inicial y b Las resistencias iniciales bajas se analizan mediante sus correspondientes datos RTN. La ocurrencia de fluctuación de resistencia múltiple en células con baja resistencia inicial y Vo- verifica la existencia de CF dendríticas en la capa de TMO

Se resume la correlación entre el nivel de resistencia inicial y el nivel de RTN en las células CRAM. Se espera que ocurra una mayor probabilidad de fluctuación de resistencia de dos niveles para las células con una ruta conductora dominante, que se correlacionó fuertemente con las células de alta R ini
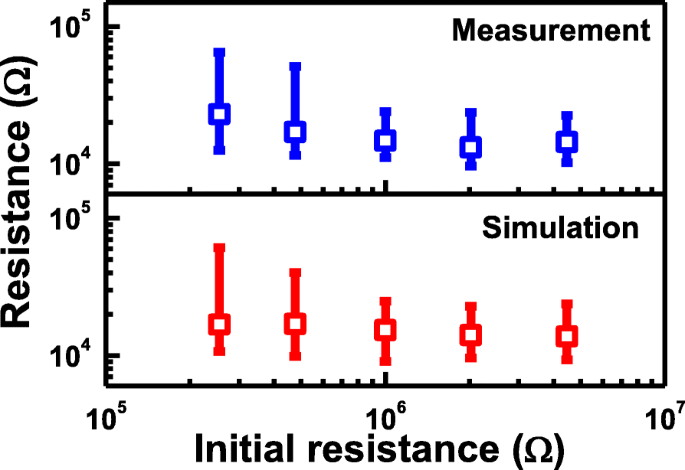
El análisis de la variación del nivel de resistencia después de la operación de conformado se examina mediante simulación y medición. La mayor variación inducida por la generación de CF dendrítica se encuentra en células con baja resistencia inicial
Para aliviar la variabilidad de formación causada por la Vo intrínseca en la capa TMO, se propone aplicar a ciegas una operación de entrenamiento de reinicio, que barre SL a 1,4 V bajo un voltaje WL fijo de 2 V, en celdas de memoria completas en la matriz CRRAM antes de la formación. Se espera que esta operación aniquile los defectos preexistentes existentes en las células con bajo R ini y para asegurar un crecimiento de CF mejor confinado durante el proceso de formación subsiguiente. Debido al bajo voltaje aplicado, no hay cambios en las celdas con alto R ini después del proceso de formación. Con una operación de entrenamiento de reinicio general, la resistencia de las células con bajo R ini , aumenta sin perturbar las células con una R alta ini , como se muestra en la Fig. 14. Posteriormente, se pueden obtener características de conformado más uniformes.

Se propone aplicar una operación de entrenamiento de reinicio general en la matriz CRRAM. Resistencia en células con bajo R ini aumenta al aniquilar los defectos intrínsecos, pero las células con alto R ini no se molesta
Conclusiones
Se ha establecido con éxito un modelo de red de resistencias que considera el efecto de campo local y la conducción de túnel asistida por trampa entre Vo-. Mediante la simulación de Monte Carlo, se investiga la variabilidad celular en su resistencia inicial, así como el proceso de formación. La variación en los estados frescos de CRRAM se puede explicar con éxito por una distribución dada aleatoriamente de Vo- intrínseco. La distribución de la resistencia proyectada después de la formación también concuerda bien con el resultado de la medición al adoptar el modelo químico térmico. Se discute el crecimiento de CF durante la formación y se relaciona con la variabilidad observada en este proceso. Finalmente, se propone una operación de entrenamiento de reinicio para aliviar aún más la variabilidad de formación causada por Vo- intrínseco en la capa TMO. Una fuerte correlación entre los estados iniciales y las características de formación proporcionan pautas para nuevas operaciones de adaptación para el desarrollo futuro de tecnologías RRAM.
Abreviaturas
- CF:
-
Filamento conductor
- CRRAM:
-
Póngase en contacto con la memoria resistiva de acceso aleatorio
- C Vo- :
-
Vo- concentración
- d:
-
Distancia de túnel
- E:
-
Campo eléctrico
- ILD:
-
Dieléctrico de capa intermedia
- N :
-
Tiempo de iteración
- P g :
-
Probabilidad de cambio de umbral
- P ij :
-
Probabilidad de generación de Vo
- R formando :
-
Resistencia después de la operación de formación
- R ij :
-
Resistencia localizada de Vo-site
- R ini :
-
Estado de resistencia inicial
- R óxido :
-
Resistencia localizada del sitio de óxido
- RPO:
-
Óxido de protección de resistencia
- RRAM:
-
Memoria resistiva de acceso aleatorio
- RTN:
-
Ruido de telégrafo aleatorio
- TAT:
-
Túneles asistidos por trampa
- TMO:
-
Óxido de metal de transición
- V f :
-
Formación de voltaje
- V ij :
-
Potencial
- Vo-:
-
Vacante de oxígeno
- α :
-
Parámetro de ajuste
- β :
-
Parámetro de ajuste
- γ :
-
Parámetro de ajuste
- ϕ :
-
Diferencia de potencial eléctrico
Nanomateriales
- CASO DE ESTUDIO:El estilo Honda
- Yantracraft y el Templo Dorado
- Modelo de retención de TaO / HfO x y TaO / AlO x RRAM con características de interruptor autorrectificante
- El estudio de un nuevo sistema micelar similar a un gusano mejorado con nanopartículas
- Una SRAM 4T integrada de RRAM con carga de conmutación resistiva autoinhibida mediante un proceso lógico CMOS puro
- Estudio de los primeros principios sobre la estabilidad y la imagen STM del borofeno
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Estudio sobre la memoria de conmutación de resistencia multinivel y el fotovoltaje dependiente del estado de la memoria en uniones Pt / Nd:SrTiO3
- Un estudio colectivo sobre modelado y simulación de memoria resistiva de acceso aleatorio
- Una metodología de dos pasos para estudiar la influencia de la agregación / aglomeración de nanopartículas en el módulo de Young de nanocompuestos poliméricos
- Estudio comparativo de las propiedades electroquímicas, biomédicas y térmicas de nanomateriales naturales y sintéticos



