Caracterización y fabricación del CFM-JTE para dispositivo de potencia 4H-SiC con protección de alta eficiencia y mayor ventana de tolerancia a la dosis de JTE
Resumen
Un rectificador PiN 4H-SiC de 13,5 kV con un área activa considerable de 0,1 cm 2 se fabrica en este documento. Se ha propuesto la extensión de terminación de unión modulada por campo de carga (CFM-JTE) para satisfacer el requisito de voltaje inverso ultra alto, que amplía la ventana de tolerancia de dosis JTE, haciéndola aproximadamente 2,8 veces mayor que la del JTE convencional de dos zonas. Además, el CFM-JTE se puede implementar mediante el proceso JTE convencional de dos zonas. La corriente directa medida es de hasta 100 A @ V F =5,2 V en ausencia de tecnología de mejora de la vida útil de la portadora. La estructura CFM-JTE alcanza el 96% del voltaje de ruptura teórico de la unión del plano paralelo con un área terminal relativamente pequeña de 400 μm, lo que contribuye a lograr la figura de mérito de Baliga de 58.8 GW / cm 2 .
Introducción
El carburo de silicio se ha convertido en una nueva opción para mejorar las aplicaciones de energía debido a sus características de funcionamiento de voltaje más alto en capas activas más delgadas, densidad de potencia extendida, conmutación de frecuencia más alta, mejor disipación de calor, tamaño de sistema más pequeño y costo del sistema más bajo [1, 2]. En los últimos años, los rectificadores de SiC comerciales y los MOSFET se han clasificado en 1,2–1,7 kV. Sin embargo, en campos de aplicación representativos como redes inteligentes, vehículos eléctricos, fuentes de alimentación por impulsos y fuentes de alimentación de estado sólido de voltaje ultra alto, existe una demanda creciente de capacidad de bloqueo de más de 10 kV y capacidad de corriente directa de más de 1000 A cm −2 .
Hasta ahora, los principales desafíos que enfrentan los dispositivos electrónicos de potencia de SiC de 10 kV y de nivel superior se han centrado en el rendimiento de la tecnología de terminación de unión, la simplificación de los procesos de fabricación, la alta calidad de la capa epitaxial gruesa y la reducción de los defectos superficiales. Para los dispositivos de SiC de voltaje ultra alto, la longitud de la estructura del terminal es en su mayoría de 6 a 8 veces la del espesor epitaxial [3], lo que reduce enormemente la tasa de utilización de la oblea y, por lo tanto, aumenta el costo de fabricación. Los rectificadores 4H-SiC PiN se han convertido en los candidatos más adecuados para aplicaciones de voltaje ultra alto como resultado del efecto de modulación de la conductividad. Para la estructura del anillo limitador de campo (FLR), se puede obtener un diseño de optimización preciso mediante el cálculo analítico [4], mientras que la fotolitografía actual no puede lograr el espacio y el ancho precisos de los anillos. Se ha aplicado el novedoso terminal de anillo limitador de campo para el dispositivo de 10 kV de SiC para tener una alta eficiencia de protección inversa [5, 6], pero su área terminal excede los 700 μm, lo que resulta en un consumo adicional de la oblea de SiC. La extensión de terminación de unión (JTE) es otra estructura de protección de terminal de alta eficiencia que se usa con frecuencia, pero su eficiencia es extremadamente sensible a la dosis de JTE. Para niveles de voltaje ultra alto, los MZ-JTE y CD-JTE [7] se utilizan para modular críticamente el campo eléctrico y requieren condiciones y tiempos estrictos de implantación de iones, lo que a su vez aumenta la complejidad y el costo de fabricación. Con el fin de mejorar la capacidad de conducción, se han realizado investigaciones sobre las características de la altura de barrera entre diversos metales y SiC [8, 9]. Por lo general, se forma una película de Ti / Al de 50–100 nm de espesor para el contacto óhmico del ánodo y la película de Ni para el contacto óhmico del cátodo, respectivamente. Además, la escala del área activa del rectificador 4H-SiC afectará en gran medida las características de la corriente directa. Se encuentra que en la capa epitaxial de 4H-SiC tipo N, la Z 1/2 centro ( E C —0,65 eV), el nivel de aceptor de la monovacante de carbono, afecta principalmente a la vida útil del portador [10]. La implantación de iones de aluminio conducirá a una gran concentración de niveles profundos masivos que involucran a Z 1/2 centro en la periferia de la mesa y la región de terminación de la unión [11], lo que resulta en una disminución de la vida útil del portador. Por lo tanto, rectificadores 4H-SiC con una gran área activa (> 9 mm 2 ) son necesarios en el diseño y la fabricación debido al impacto de la vida útil reducida del portador en la región de la periferia de la mesa y la región de terminación es relativamente insignificante.
En este artículo, el rectificador 4H-SiC CFM-JTE PiN se fabrica en una capa epitaxial de 100 μm de 5 × 10 14 cm −3 y alcanza una capacidad de bloqueo considerable de 13,5 kV en el estado apagado y corriente directa de 100A @ V F =5,2 V en estado activado. La resistencia diferencial de encendido del rectificador CFM-JTE PiN se mide en 3,1 mΩ cm 2 a temperatura ambiente. El CFM-JTE obtiene el 96% de la tensión de ruptura teórica a través del concepto y análisis de la modulación del campo de carga, lo que amplía favorablemente la ventana de tolerancia de la dosis de implantación y conduce a una longitud de terminación aceptable de 400 μm.
Métodos
Análisis de la estructura del dispositivo
El diseño, optimización y análisis son ejecutados por Silvaco-TCAD. La Figura 1 muestra el esquema de la estructura 4H-SiC PiN con terminación, que incluye:(a) campo de carga modulado (CFM-JTE), (b) JTE asistido por anillo exterior (ORA-JTE) y (c) JTE de dos zonas (TZ-JTE). En el estado de bloqueo, la tasa de ionización por colisión entre electrones y huecos está estrechamente relacionada con la intensidad del campo eléctrico. Un concepto de modulación de campo eléctrico de carga E q ( r ) se propone revelar el mecanismo de modulación del CFM-JTE a través del método de superposición vectorial del campo eléctrico terminal causado por el campo eléctrico de carga E q ( r ) en la Fig. 1a. El CFM-JTE consta de la región JTE1, la región JTE2 y tres grupos de anillos. Los anillos múltiples dividen de manera equivalente el terminal en cinco zonas dopadas:R 1 -R 2 , R 2 -R 3 , R 3 -R 4 , R 4 -R 5 y R 5 -R 6 , donde los cargos efectivos de Q 1 , Q 2 , Q 3 , Q 4 y Q 5 se introducen, respectivamente. Basado en la descomposición y superposición de vectores de campo eléctrico en x y años coordenadas, el campo eléctrico general ubicado en R i punto causado por el campo de potencial aplicado E p ( r ) y el campo eléctrico de carga E Qi ( r ) generado por cada Q i se puede expresar analíticamente en x y años direcciones, como se indica en las Ecs. (1) y (2), respectivamente.
$$ E_ {Ri, x} =E_ {px} + \ mathop \ sum \ limits_ {j =1} ^ {i - 1} E_ {Qjx} - \ mathop \ sum \ limits_ {j =i} ^ {5 } E_ {Qjx} $$ (1) $$ E_ {Ri, y} =E_ {py} + \ mathop \ sum \ limits_ {j =1} ^ {i - 1} E_ {Qjy} + \ mathop \ sum \ limits_ {j =i} ^ {5} E_ {Qjy} $$ (2)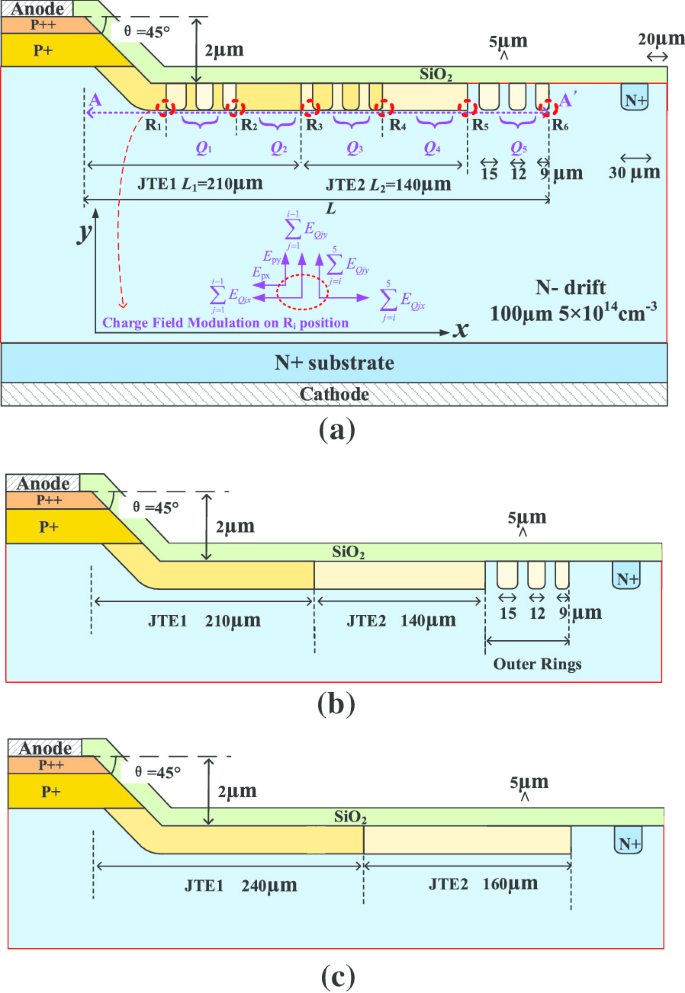
Sección esquemática del rectificador 4H-SiC PiN con a CFM-JTE, b ORA-JTE, c convencional TZ-JTE
En el estado desactivado, la región de agotamiento de bajo dopado se contrae prematuramente y aborta en la región de terminación debido al efecto de curvatura en la unión principal de PiN. Por tanto, el campo de potencial aplicado E p ( r ) se concentra plenamente en la periferia de la unión principal. La existencia de Q i promueve el agotamiento a lo largo del CFM-JTE hasta la capa epitaxial más externa. La fuerza del campo eléctrico de carga E Qi está asociado con la cantidad de Q i . La disminución de Q i a lo largo del borde exterior del terminal logra efectivamente la modulación del campo eléctrico en la región del terminal. En consecuencia, a través del mecanismo y el efecto de la modulación del campo eléctrico de carga, CFM-JTE supera la deficiencia del bajo coeficiente de difusión de SiC para formar el efecto de dopaje lateral variado (VLD), que es una tecnología de protección de terminal de unión muy eficaz, robusta y madura. para dispositivos de Si [12, 13]. El ancho del anillo ( w r ) de cada grupo se reduce a 15 μm, 12 μm y 9 μm, respectivamente. El espacio de cada anillo es igual al mismo valor de 5 μm. La longitud y la dosis de la región JTE1 y la región JTE2 están ambas en una proporción fija de 3:2. Los parámetros detallados del rectificador propuesto se dan en la Tabla 1.
Simulación y optimización
Para disminuir las desviaciones causadas por la sensibilidad de la estructura del dispositivo y las concentraciones de dopaje, se aplica la configuración de procesamiento Athena. Las concentraciones de dopaje del CFM-JTE se forman a través de múltiples pasos de simulación del proceso de implantación de aluminio. La profundidad total del dopaje alcanza casi 1 μm.
La Figura 2 muestra las capacidades de bloqueo y las tolerancias a la dosis de implantación de CFM-JTE, ORA-JTE y TZ-JTE convencional. Las cuatro estructuras de terminación comparten un valor de longitud fija de L =400 μm para comparar su eficiencia. Tanto la duración como la dosis de JTE1 y JTE2 se fijan en una proporción de 3:2. La simulación se realiza en la estructura 2-D, y el criterio de juicio de ruptura es que la corriente de fuga inversa alcanza 1 × 10 –9 A. La línea negra sólida representa el BV teórico que se calcula como 14,1 kV según [10, 14], y la línea discontinua gris indica 12 kV. El margen de diseño del 20% se aplica en el objetivo para 10 kV considerando la tolerancia del proceso y la desviación de la simulación. En el TZ-JTE convencional, la tensión de ruptura es bastante sensible a la dosis de implantación y alcanza más de 12 kV solo cuando la dosis varía entre 0,98 y 1,14 × 10 13 cm −2 . La sensibilidad de ORA-JTE a la concentración de inyección de JTE se alivia y una ventana de tolerancia más amplia de 0.97-1.28 × 10 13 cm −2 se obtiene para mantener la tensión objetivo por encima de 12 kV. El CFM-JTE tiene la tolerancia más amplia de la ventana de dosis de implantación en un rango de 0,86 a 1,30 × 10 13 cm −2 , que es aproximadamente 2,8 veces la del TZ-JTE convencional y 1,4 veces la del ORA-JTE. Por lo tanto, el CFM-JTE muestra una mayor solidez para las variaciones del proceso.
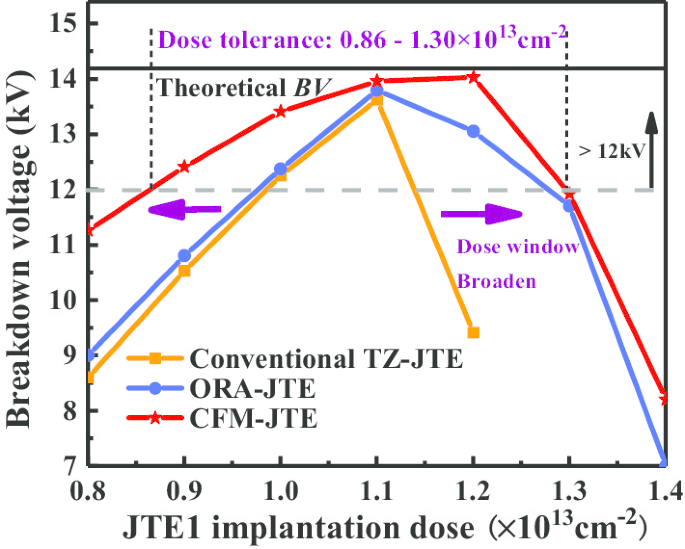
Comparación de capacidades de ruptura con la ventana de dosis JTE para el rectificador 4H-SiC PiN con CFM-JTE, ORA-JTE y TZ-JTE convencional
La Figura 3 muestra la comparación de la distribución e intensidad del campo eléctrico de superficie de CFM-JTE, ORA-JTE y TZ-JTE en el estado de bloqueo. El campo eléctrico de pico se concentra principalmente en la unión principal y la periferia terminal. CFM-JTE aplana la distribución del campo eléctrico y promueve la fuerza del campo eléctrico a lo largo del terminal, lo que finalmente mejora la capacidad de bloqueo de manera eficiente.
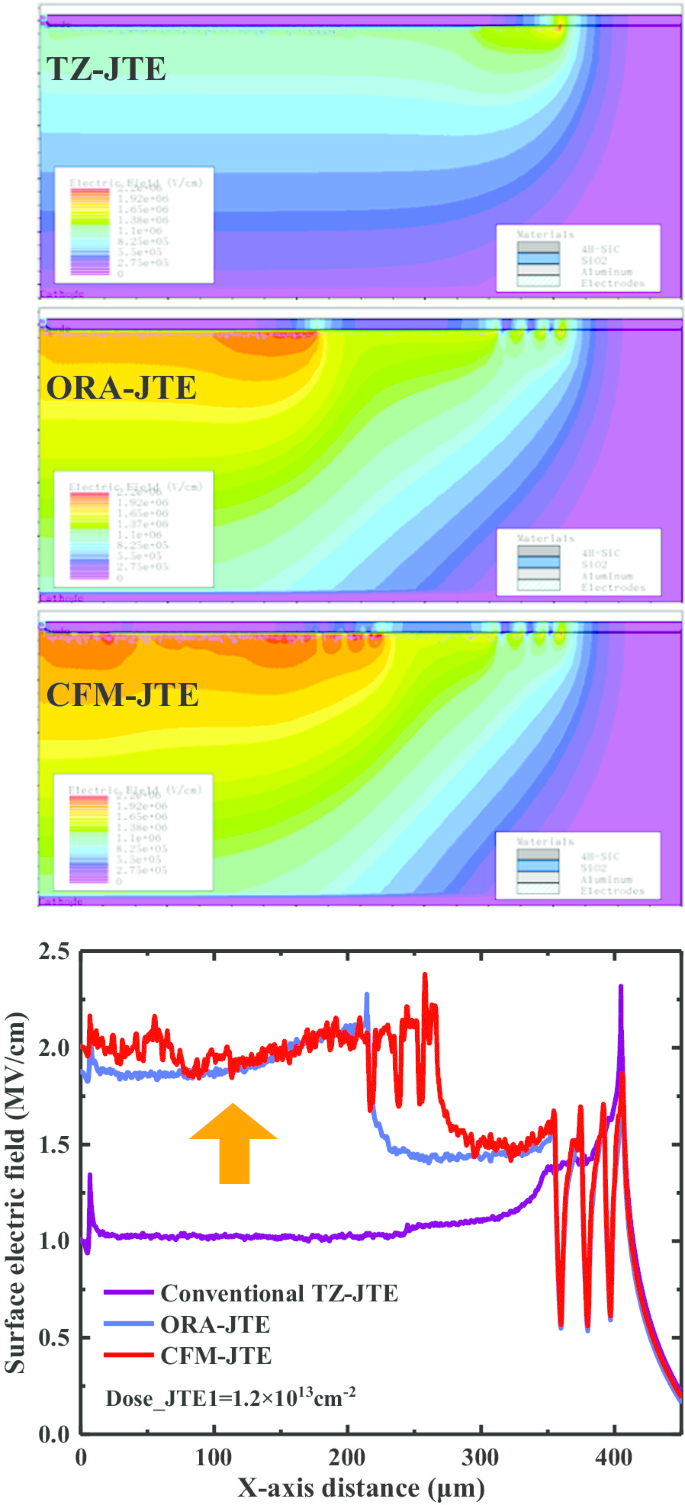
Distribución e intensidad del campo eléctrico de superficie inversa en CFM-JTE, ORA-JTE y TZ-JTE convencional
Para comprender el mecanismo del campo eléctrico de carga moduladora de CFM-JTE, las distribuciones del campo eléctrico de ruptura a través de la línea de corte AA 'en la Fig. 1a con diferentes dosis de implantación de JTE1 se representan en la Fig. 4. La existencia de Q i , especialmente el Q altamente dopado 1 zona próxima a la unión principal, alivia enormemente la concentración de líneas de campo eléctrico en la esquina de grabado de mesa. El Q 5 La zona está configurada para aliviar el hacinamiento del campo eléctrico en R 5 punto en la Fig. 1a. Los resultados demuestran que la uniformidad de la distribución del campo eléctrico se puede mejorar eficazmente mediante la modulación del campo eléctrico de carga E Qi ( r ) en la terminal. Por lo tanto, se podría mejorar la capacidad del voltaje de bloqueo y la confiabilidad del dispositivo.

Distribuciones de campo eléctrico de superficie en desglose correspondientes a diferentes dosis de implantación de JTE1
El tamaño del área del terminal afecta directamente la eficiencia de la utilización del chip. En el estado de bloqueo, el campo de potencial aplicado se agrupa alrededor de la periferia de la unión principal. La región JTE1 cerca de la unión principal necesita introducir más cargas para mejorar el efecto de modulación del campo de carga ( E q ). Por lo tanto, L 1 debe configurarse más de L 2 . Cuando la proporción de L 1 a L 2 se fija en 3:2, las capacidades de bloqueo de diferentes longitudes L en el terminal se analizan comparativamente en la Fig. 5.

Capacidades de bloqueo con diferentes longitudes de terminales
Las distribuciones de campo eléctrico correspondientes se muestran en la Fig. 6. El área a gran escala de CFM-JTE es propicia para aumentar la carga requerida Q i y dando juego al efecto de modulación de E Qi ( r ), para obtener una mayor ventana de tolerancia a la dosis de implantación (TW). Cuando la longitud de CFM-JTE L se establece en 300 μm, 350 μm, 400 μm y 450 μm, el rango de TW aumenta secuencialmente, correspondiente a 3 × 10 12 cm −2 , 3,2 × 10 12 cm −2 , 4,4 × 10 12 cm −2 y 4,7 × 10 12 cm −2 en rango a condición de que el BV sea superior a 12 kV. Es más apropiado seleccionar una longitud de terminal L de 400 μm en este trabajo basado en la compensación del tamaño del terminal, la ventana de tolerancia a la dosis de JTE, la modulación del campo eléctrico del terminal y la capacidad de voltaje de ruptura.
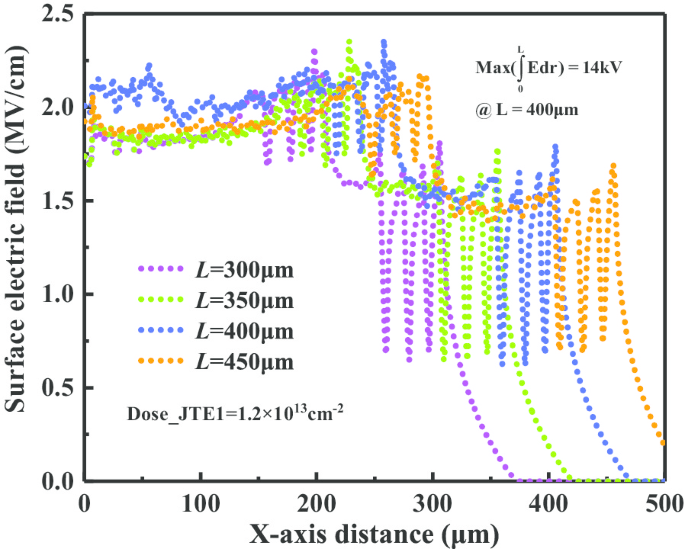
Distribuciones de campo eléctrico de superficie en desglose correspondientes a diferentes longitudes de terminales
La existencia de estados de superficie debe considerarse en la fabricación real del rectificador 4H-SiC PiN. Estos estados de superficie se derivan de agujeros atrapados en estados de interfaz profunda, cargas de óxido fijas de P-SiC (incluido P ++ capa y región P-JTE) / SiO 2 interfaz y el proceso de implementación [15,16,17,18]. Para la terminación CFM-JTE, la modulación del campo eléctrico en la interfaz S 1 y S 2 por interfaz de cargas positivas ( Q eso ), cargos efectivos ( Q j ) y el potencial aplicado en la dirección de la vertical se analiza en la Fig. 7.
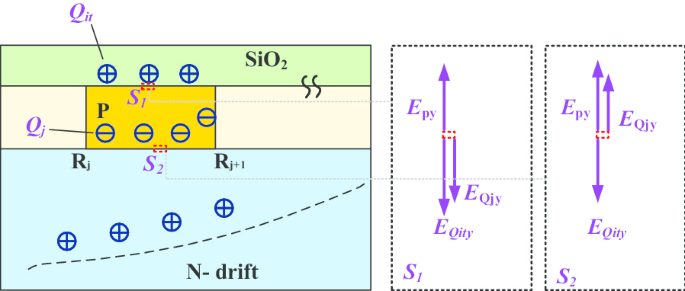
Modulación de campo eléctrico en S 1 y S 2 por interfaz de cargas positivas ( Q eso ), cargos efectivos ( Q j ) y potencial aplicado
Cargas de interfaz positivas ( Q eso ) generan un campo de carga opuesto ( E Qity ) en comparación con el campo de potencial aplicado ( E py ), lo que ayuda a mitigar la intensidad del campo eléctrico en la dirección de la interfaz vertical. La Figura 8 muestra las distribuciones del campo eléctrico en SiO 2 / Interfaz SiC S 1 en condiciones de Q diferente eso .

Distribuciones de campo eléctrico en SiO 2 / Interfaz SiC con diferentes Q eso
En términos del análisis de modulación del campo de carga en la interfaz S 2 , E Qity es opuesta a la dirección del vector de E py y E Qjy . La existencia de Q eso ayuda a reducir el campo eléctrico en S 2. Considerando la existencia del cargo por interfaz ( Q eso ), una carga efectiva de ionización más grande Q j es necesario para contrarrestar la intensidad del campo eléctrico generado por el Q eso . En consecuencia, cuando la cantidad de Q eso aumenta, la concentración de dosis de implantación óptima de JTE debe mejorarse simultáneamente para mantener la misma capacidad de bloqueo. Como se muestra en la Fig. 9, la BV-Dosis general la curva se desplaza en la dirección de subida con el aumento de Q eso .

Comparación de influencias a la capacidad de bloqueo por cargas de interfaz en rectificador 4H-SiC PiN
Resultados y discusión
El rectificador CFM-JTE 4H-SiC PiN propuesto se ha fabricado en una oblea tipo N de 4 pulgadas con 4 ° fuera del eje (0001). La oblea se hace crecer mediante epitaxia con cuatro capas (N + , N - , P + , P ++ ) correspondiente a la concentración de 1 × 10 18 cm −3 , 5 × 10 14 cm −3 , 1 × 10 18 cm −3 y 5 × 10 19 cm −3 . El flujo de proceso principal de la fabricación de CFM-JTE se muestra en la Fig. 10. El P ++ La capa se hace crecer mediante epitaxia para obtener un dopaje uniforme y elevado para promover la calidad de contacto óhmico entre el SiC y el metal del ánodo. La estructura de grabado de mesa se forma en la instalación de ICP-RIE a través de la máscara de grabado de mesa. El gas de grabado se compone principalmente de SF 6 y oxigeno. Se implementan múltiples implantaciones de iones de Al a una energía máxima de 500 keV para formar la estructura CFM-JTE. Se aplica una implantación de iones de Al en dos pasos para formar las cinco zonas dopadas decrecientes. JTE1 y R 2 -R 3 Las zonas se forman a través de la primera máscara de implantación. JTE2, R 1 -R 2 , R 3 -R 4 , R 4 -R 5 y R 5 -R 6 Las regiones se configuran simultáneamente mediante la implantación de iones de Al a través de la segunda máscara de implantación. Como es sabido por todos, la tasa de activación de iones en el carburo de silicio no es alta después de implantado con iones de alta energía, acompañada de graves daños en la red. Para mejorar la situación indeseable anterior, las implantaciones de iones de aluminio se realizan a una temperatura de 500 ° C a través de una máscara de óxido. El recocido posterior a la implantación se ha realizado en ambiente de argón a una temperatura de 1800 ° C durante 10 min con una capa de carbono para renovar aún más el daño causado por la implantación de iones de alta energía y mejorar la precisión de la concentración de dopaje al aumentar el ión efectivo. tasa de activación. El contacto óhmico de SiC de tipo P se forma utilizando Al / Ti. El proceso de RTA se lleva a cabo e inspecciona constantemente durante dos minutos en un entorno de nitrógeno de gas inerte a una temperatura de 1000 ° C. Capas de pasivación de alta calidad (SiO 2 capa, Si 3 N 4 película y capa gruesa de poliimida) se depositan para evitar fugas en la superficie y evitar chispas en el aire [5]. El rectificador CFM-JTE PiN cubre un área activa de hasta 0,1 cm 2 . El proceso de fabricación es consistente con el rectificador JTE 4H-SiC PiN convencional de dos zonas, sin máscaras o pasos de proceso adicionales, lo que es extremadamente propicio para reducir la complejidad y el costo de fabricación.
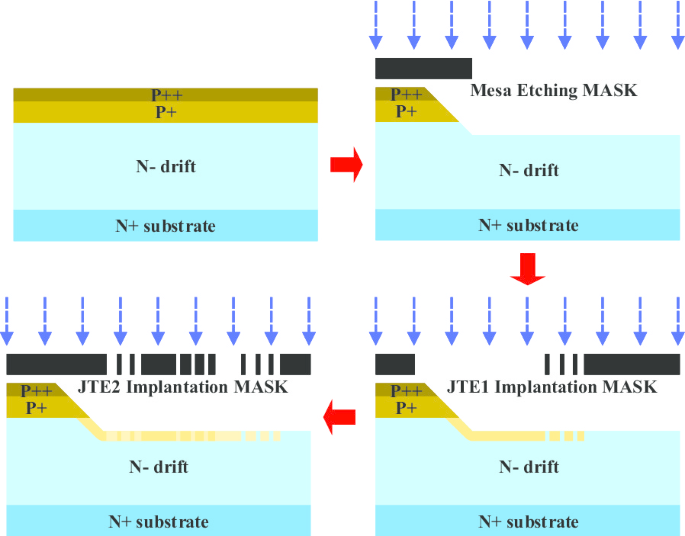
Flujo de proceso del CFM-JTE
Las características de avance del rectificador CFM-JTE PiN fabricado se prueban en la oblea utilizando el instrumento CS-3200 Curve Tracer. El rectificador CFM-JTE PiN fabricado exhibe una gran capacidad de conducción de corriente directa sin tecnología de mejora de la vida útil de la portadora. La corriente directa se mide hasta 100 A correspondiente a un voltaje directo de 5,2 V, como se muestra en la Fig. 11. La resistencia diferencial de encendido del rectificador propuesto se mide como 3,1 mΩ cm 2 a temperatura ambiente, correspondiente al voltaje directo de 3.6 V. Las características de conducción directa a diferentes temperaturas también se ilustran en el recuadro de la Fig. 11. El I – V La curva muestra la peculiaridad del coeficiente de temperatura negativo. Esto se debe a que a medida que aumenta la temperatura, la movilidad del material disminuye, mientras que la brecha de banda más estrecha del material de SiC reduce el potencial autoconstruido de la unión P – N, y la vida útil del portador de la región de deriva se extiende con el aumento de temperatura, lo que conduce a un aumento en la densidad de corriente. El voltaje de encendido medido se define a una densidad de corriente directa de 10 A · cm −2 . Se reduce gradualmente de 3,14 a 3,04 V cuando la temperatura ambiente aumenta de 25 a 150 ° C. El desplazamiento máximo del voltaje de encendido hacia adelante se ha atascado en un rango del 3%, correspondiente a un valor de 0.1 V, que exhibe una estabilidad de temperatura mucho mejor que Si PiN.
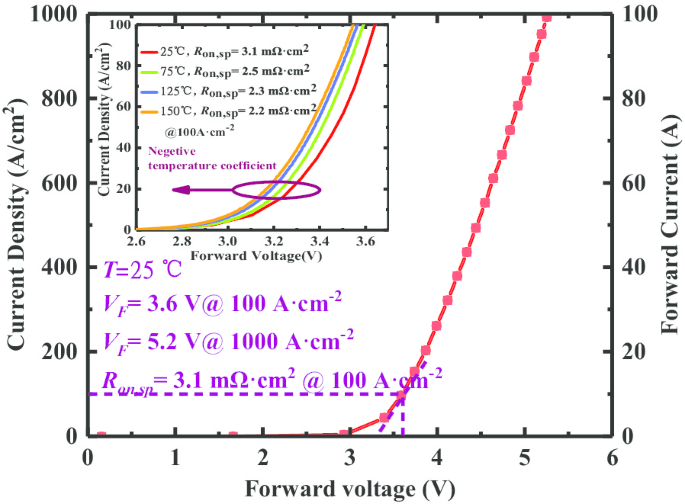
Adelante I – V Curva del rectificador CFM-JTE PiN y características en diversos ambientes de temperatura en el recuadro
Los rectificadores 4H-SiC PiN con CFM-JTE, ORA-JTE y el TZ-JTE convencional se fabrican en la oblea de 4 pulgadas, y sus efectos de protección de terminales se muestran en la Fig. 12. Las mediciones de voltaje de ruptura inversa se ejecutan y se sumergen en aceite Fluorinert para evitar la formación de arcos en el aire. En mediciones experimentales con una dosis de JTE1 de 1,2 × 10 13 cm −2 , los rectificadores PiN con ORA-JTE y el TZ-JTE convencional obtienen las capacidades de bloqueo de 12,5 kV y 9,6 kV, respectivamente, con la misma longitud de terminal de 400 μm.
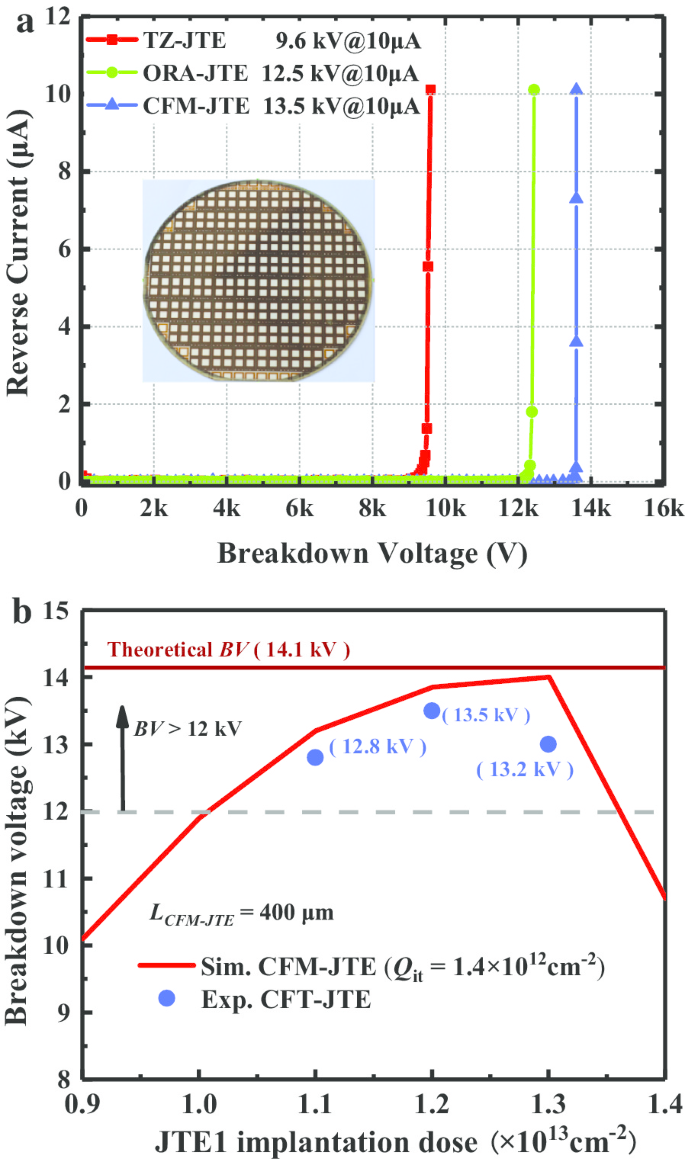
Características de avería del rectificador PiN 4H-SiC fabricado. un BV medido del CFM-JTE, ORA-JTE y TZ-JTE. b VB medido del CFM-JTE con diferente dosis de implantación. Las marcas sólidas son los valores experimentales
Las muestras de varios lotes de rectificadores CFM-JTE PiN podrían obtener repetidamente el voltaje de ruptura de 13,5 kV a la corriente de fuga de 10 μA. El voltaje de bloqueo experimental alcanza hasta el 96% del valor de ruptura teórico, lo que indica que el CFM-JTE tiene una mayor eficiencia de protección de terminales. Se ha logrado una tensión soportada de más de 130 V / μm en la capa de deriva de 100 μm del rectificador 4H-SiC PiN. La figura de mérito de Baliga (BFOM =BV 2 / R encendido, sp ) alcanza 58,8 GW / cm 2 a temperatura ambiente. Se han fabricado los CFM-JTE PiNs con diferentes dosis de implantación de JTE1. Los valores experimentales y simulados de la tensión de ruptura se muestran en la Fig. 12b. Los valores experimentales están de acuerdo con la tendencia de la simulación y confirman que la estructura CFM-JTE puede expandir la ventana de tolerancia a la dosis de JTE de manera efectiva. La Tabla 2 compara las características de los rectificadores 4H-SiC de voltaje ultra alto reportados recientemente. El rectificador CFM-JTE 4H-SiC fabricado en este trabajo muestra un rendimiento excelente en los aspectos de capacidad de bloqueo de voltaje ultra alto, capacidad de conducción de corriente directa ultra alta y alta eficiencia de terminación.
Conclusiones
En este trabajo se ha diseñado y fabricado con éxito el rectificador 4H-SiC CFM-JTE PiN. La tensión de ruptura experimental del CFM-JTE PiN es 13,5 kV correspondiente al 96% del valor de bloqueo teórico. El CFM-JTE exhibe una eficiencia de protección terminal muy mejorada en comparación con el ORA-JTE (BV =12.5 kV, con eficiencia de protección hasta 88%) y el TZ-JTE convencional (BV =9.6 kV, con eficiencia de protección hasta 68% ). El rectificador CFM-JTE PiN adquiere una gran corriente directa de 100 A @ V F =5,2 V sin utilizar la tecnología de mejora de la vida útil de la portadora y muestra un avance estable I – V características a varias temperaturas. La cifra de mérito de Baliga para el rectificador CFM-JTE PiN alcanza los 58,8 GW / cm 2 a temperatura ambiente. La tolerancia de la ventana de dosis de implantación para CFM-JTE se amplía en función de la modulación del campo eléctrico de carga, que es aproximadamente 2,8 veces mayor que la del TZ-JTE convencional y 1,4 veces la del ORA-JTE, lo que muestra una mayor solidez a la variación del proceso. Además, el proceso de fabricación de CFM-JTE es consistente con el proceso convencional TZ JTE sin aumentar el número de procesos o máscaras excepcionalmente complejos, lo que demuestra que el CFM-JTE es óptimo para aplicaciones de ultra alta potencia con una eficiencia terminal satisfactoria y tolerancia del proceso.
Disponibilidad de datos y materiales
Todos los datos están disponibles sin restricciones.
Abreviaturas
- SiC:
-
Carburo de silicio
- JTE:
-
Extensión de terminación de cruce
- CFM:
-
Campo de carga modulado
- TZ-JTE:
-
Extensión de terminación de unión de dos zonas
- FLR:
-
Anillo limitador de campo
- MZ-JTE:
-
Extensión de terminación de unión de múltiples zonas
- CD-JTE:
-
Extensión de terminación de unión contradopada
- Ti:
-
Titanio
- Al:
-
Aluminio
- E c :
-
Banda de conducción de energía
- V F :
-
Voltaje directo
- ORA-JTE:
-
Extensión de terminación de unión asistida por anillo exterior
- E q :
-
Cargar campo eléctrico
- E p :
-
Campo de potencial aplicado
- Q i :
-
Carga efectiva
- VLD:
-
Dopaje lateral variado
- w r :
-
Ancho del anillo
- 2D:
-
Dos dimensiones
- BV:
-
Voltaje de ruptura
- TW:
-
Ventana de tolerancia
- Q eso :
-
Carga de interfaz
- Q j :
-
Carga efectiva de ionización
- RTA:
-
Recocido térmico rápido
- R encendido, sp :
-
On-resistencia específica
- BFOM:
-
Figura de mérito de Baliga
Nanomateriales
- Consideraciones de diseño de detección, control y protección de circuitos para aplicaciones de seguridad en el hogar inteligente
- Fabricación y caracterización de un nuevo catalizador anódico compuesto de nanofibras de carbono Tio2 para celdas de combustible de metanol directo mediante el método de electrohilado
- Fabricación, caracterización y actividad biológica de sistemas de nanoportación de avermectina con diferentes tamaños de partículas
- Fabricación, caracterización y citotoxicidad de nanopartículas de carbonato de calcio derivadas de concha de oro-berberecho conjugado de forma esférica para aplicaciones biomédicas
- La fabricación y el rendimiento de absorción de ondas electromagnéticas de alta eficiencia de los nanocompuestos estructurados CoFe / C Core-Shell
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Síntesis y caracterización de zeolitas jerárquicas ZSM-5 con mesoporosidad excepcional y excelentes propiedades catalíticas
- Litografía de difracción basada en máscaras de un paso para la fabricación de estructuras suspendidas 3D
- Dispositivo multifuncional con funciones conmutables de absorción y conversión de polarización en el rango de terahercios
- Un nuevo dispositivo modula la luz visible con la huella más pequeña y el consumo de energía más bajo
- El enfoque de seguridad de gas y llamas para la industria de generación de energía



