Influencia del te-dopaje en los nanocables VS InAs sin catalizador
Resumen
Divulgamos sobre el crecimiento de nanocables de InAs libres de catalizador dopado con Te por epitaxia de haz molecular en sustratos de silicio (111). Se han observado cambios en la morfología del alambre, es decir, una disminución de la longitud y un aumento del diámetro con el aumento del nivel de dopaje. El análisis de la estructura cristalina basado en microscopía electrónica de transmisión y difracción de rayos X revela una mejora de la relación entre el segmento de mezcla de zinc / (wurtzita + mezcla de zinc) si se proporciona Te durante el proceso de crecimiento. Además, las mediciones eléctricas de dos puntos muestran que el aumento de Te-dopaje provoca una ganancia en la conductividad. Dos series de crecimiento comparables, que difieren solo en As-presión parcial en aproximadamente 1 × 10 −5 Torr, manteniendo todos los demás parámetros constantes, se analizaron para diferentes niveles de Te-doping. Su comparación sugiere que la estructura del cristal se ve fuertemente afectada y la ganancia de conductividad es más clara para los cables que crecen a una presión parcial de As comparativamente más alta.
Antecedentes
Los nanocables (NW) han atraído una atención notable en la última década, ya que se considera que constituyen un pilar prometedor para la tecnología emergente y futura. Sus aplicaciones técnicas son diversas, desde transistores de efecto de campo y dispositivos ópticos hasta células solares [1, 2]. La amplia aplicabilidad de los NW se basa en sus características notables, como una alta relación de aspecto, una disipación de energía ultrabaja y, en el caso de los InAs, la ausencia de una barrera Schottky en la interfaz con los contactos metálicos [3, 4, 5] . Esto último se debe al hecho de que InAs presenta una capa de acumulación superficial que permite el contacto óhmico [6]. Desde la perspectiva de la física, los InAs NW tienen propiedades sobresalientes, es decir, una alta movilidad de electrones [7], una masa efectiva baja [8], un factor g grande [9] y un fuerte acoplamiento Rashba espín-órbita [10, 11]. Debido a esto, se convirtieron en un ingrediente importante en la investigación relacionada con la información cuántica [5, 12,13,14].
Los InAs NW se cultivan comúnmente a través de un método de crecimiento de vapor-líquido-sólido (VLS) utilizando gotas de oro como catalizador. El uso de Au presenta al menos dos inconvenientes. Por un lado, incorpora como impureza no intencionada en los NW degradando sus propiedades materiales [2, 15, 16], por otro lado, la integración de importantes aplicaciones ya demostradas como los transistores de efecto de campo NW (FET) [17], FET de túnel [18], fotodetectores [19], etc., en la tecnología basada en silicio no es posible. Por lo tanto, en esta comunicación se aplicó un crecimiento sin catalizador en el modo vapor-sólido (VS) desarrollado previamente [20]. Una parte de la fase de mezcla cúbica de zinc (ZB), que es la fase estable en los materiales III-V a granel, la fase de wurtzita hexagonal (WZ) también está presente en los nanocables. El politipismo ZB-WZ y otros defectos como gemelos rotacionales y fallas de apilamiento son comúnmente reportados. Fase pura, casi libre de fallas de apilamiento InAs NWs pueden obtenerse mediante crecimiento VLS asistido por Au [21, 22] pero no utilizando el método VS libre de catalizador [23,24,25]. Estos defectos repercuten negativamente en el transporte [26, 27] y las propiedades ópticas [28].
Una forma de contrarrestar la disminución de la carga de transporte es el uso del dopaje, es decir, la incorporación de transportistas adicionales. Sin embargo, los métodos de dopaje bien establecidos utilizados para las capas semiconductoras compuestas III-V no pueden simplemente transferirse a las estructuras de alambre. Los nanocables tienen facetas de crecimiento axial y radial con diferente orientación de cristal y reconstrucciones de superficie que dan como resultado un crecimiento altamente anisotrópico que se supone que influye en la incorporación de dopante. La situación se complica por los diferentes modos de crecimiento, vapor-líquido-sólido (VLS) y VS, de las facetas participantes [29, 30] y el peculiar politipismo de la fase cristalina [31]. Todas estas características específicas dan como resultado una distribución de dopantes no homogénea, tanto axial como radialmente [29, 32, 33]. El elemento Si del grupo IV se ha utilizado comúnmente como dopante de tipo n para películas delgadas III-V cultivadas con MBE. Sin embargo, se sabe que el Si exhibe un comportamiento anfótero, es decir, los átomos de Si se pueden incorporar como donantes en los sitios de la red de cationes o aceptores en los sitios de la red de aniones, dependiendo de la orientación del sustrato y las condiciones de crecimiento [34, 35]. Este comportamiento se observó también en nanocables que se correlacionan con las diferentes orientaciones de los cristales de las facetas involucradas en el crecimiento, los mecanismos de crecimiento y la temperatura de crecimiento [29, 36, 37]. Por otro lado, el elemento Te del grupo VI es un dopante de tipo n muy eficaz en depiladoras [38] que no presenta riesgo de comportamiento anfótero. Además, Te tiene algunas otras ventajas:una menor energía de ionización en comparación con otros dopantes de tipo n comúnmente utilizados en los sistemas de materiales III-V, lo que potencialmente conduce al logro de niveles de dopaje más altos [39]; un coeficiente de difusión más bajo [40] y un efecto de memoria más débil en comparación con otros elementos del grupo VI, a saber, S y Se, que son importantes para interfaces abruptas [41]. Se ha informado sobre el comportamiento exclusivamente dopante de tipo n de Te para nanocables de GaAs catalizados con Au [42] y autocatalizados que muestran el potencial de una concentración rica en dopaje alto, pero también el impacto en la morfología del alambre y la estructura cristalina [43, 44]. .
En esta comunicación, investigamos el te-dopaje en InAs NW, brindando información sobre el impacto del dopaje en la morfología del NW y el cambio entre la estructura ZB y WZ dentro del crecimiento de VS en presencia de Te. Las investigaciones basadas en microscopía electrónica de barrido (SEM) revelaron un fuerte impacto de Te en la morfología NW. La microscopía electrónica de transmisión de alta resolución (HR-TEM) [45] y las mediciones de difracción de rayos X (XRD) sirvieron para evidenciar un cambio en la relación ZB / (WZ + ZB) y las mediciones eléctricas de dos puntos mostraron un aumento en la conductividad con elevar el nivel de dopaje.
Métodos / Experimental
Los InAs NW se cultivaron en el modo VS sin el uso de ningún catalizador extraño en sustratos de Si (111) de tipo n.
Preparación del sustrato
Antes del crecimiento, los sustratos se limpiaron con HF y agua desionizada. Un tratamiento consecutivo con peróxido de hidrógeno durante 45 s conduce a la formación de unas pocas películas de SiO2 de grosor angstrom que contienen poros, que sirven como centros de nucleación para el crecimiento de NW [20]. Después de la oxidación, los sustratos se transfirieron inmediatamente al bloqueo de carga en el que se calentaron a 200 ° C durante 45 min. A esto le siguió un paso de desgasificación dentro de la cámara de preparación, calentando las muestras a 400 ° C durante otros 45 min.
Crecimiento de los nanocables InAs
Los NW se cultivaron a una temperatura del sustrato de 475 ° C durante 1:20 h en una cámara de epitaxia de haz molecular (MBE) Omicron Pro 100. Una tasa de crecimiento de 0,1 μmh −1 se utilizó para el crecimiento NW. El arsénico se proporcionó a través de una celda de craqueo de As y la presión equivalente del haz de As4 (BEP) se ajustó a valores de 2,3 × 10 –5 Torr y 3,3 × 10 –5 Torr. La primera serie de muestras (serie A) se cultivó a una presión parcial de As más alta en comparación con una segunda serie de crecimiento (serie B) (véase la Tabla 1), mientras se mantenían constantes todos los demás parámetros. Se suministró telurio durante el crecimiento usando GaTe estequiométrico. La temperatura de funcionamiento de la celda de efusión se varió entre 401 ° C y 562 ° C basándose en calibraciones realizadas en capas de GaAs dopado con Te mediante mediciones Hall. Las temperaturas de la celda GaTe de 401 ° C, 447 ° C, 500 ° C y 561 ° C corresponden a una concentración de portador de aproximadamente 1 × 10 15 cm −3 , 4 × 10 16 cm −3 , 5 × 10 17 cm −3 y 6 × 10 19 cm −3 respectivamente, en capas de GaAs (100) utilizadas para la calibración.
Procesamiento del dispositivo
Para procesar los contactos de dos puntos, los NW se transfirieron mecánicamente a un sustrato de Si previamente modelado que se cubrió con 200 nm de SiO2. Se proporciona un diagrama esquemático de los pasos de contacto en el archivo adicional 1:Figura S1. Antes de la deposición del metal, los alambres se recubrieron por rotación mediante un sistema de tres capas de 50 K (AR-P639.04), 50 K y 950 K (AR-P679.04) de resistencia de PMMA sobre la cual se definió la forma de contacto. mediante litografía por haz de electrones. Después del revelado, el área de contacto se pasivó con polisulfuro de amonio diluido al 3,5% (H 2 O:(NH4) 2 S 3 , 34:1) a 60 ° C durante 30 min. Los electrodos, que constan de titanio de 100 nm y oro de 40 nm, se depositaron mediante un evaporador de haz de electrones.
La lista completa de muestras investigadas mediante SEM, TEM, XRD y mediciones eléctricas se presenta en la Tabla 1. Aquí, las letras A, B y C indican la serie de muestras que se cultivaron cada una a diferentes presiones parciales de As, pero aparte de eso en igualdad de condiciones. Una temperatura GaTe de 0 ° C corresponde a un obturador de celda cerrada.
Resultados y discusión
Morfología
Se utilizaron imágenes SEM para investigar la influencia del dopaje Te en la morfología del alambre. Los resultados se presentan en la Fig. 1. Cada punto de datos en los gráficos representa la media de al menos 40 cables y la barra de error su desviación estándar.

Morfología de nanocables. Longitud y diámetro medios de los nanocables a diferentes temperaturas de la celda GaTe. un La serie A se cultivó a una presión parcial de As de aproximadamente 3,3 × 10 –5 Torr. b La serie B se cultivó a una presión parcial de As de 2,3 × 10 –5 Torr. Las líneas discontinuas son una guía para los ojos. La micrografía SEM que se muestra en el recuadro muestra InAs NW sin dopar rodeados de cristalitos formados durante el crecimiento. La barra de escala es de 300 nm y 120 nm, respectivamente
La Figura 1a muestra la morfología de la serie A de alambre que creció a una presión parcial de As de aproximadamente 3.3 × 10 −5 Torr. La temperatura de la celda GaTe osciló entre 0 ° C y 561 ° C. Teniendo en cuenta la barra de error, no se observa una tendencia clara del diámetro y la longitud NO hasta una temperatura de la celda de 500 ° C. Sin embargo, a 561 ° C, el suministro de Te es claramente perjudicial, lo que provoca un fuerte aumento del diámetro y una disminución de la longitud NO. La serie de crecimiento B, representada en la Fig. 1b, se ha cultivado a una presión de As comparativamente más baja de 2,3 × 10 −5 Torr. El recuadro muestra una vista lateral de SEM ejemplar de una muestra cultivada, que exhibe InAs NW y agrupaciones en la superficie del sustrato. Más imágenes SEM de las series A y B se muestran en el archivo adicional 1:Figura S2. Aquí, se exploró un rango de temperatura de la celda GaTe de 0 ° C a 462 ° C. Observamos una disminución en la longitud cuando se agrega Te durante el crecimiento para la serie B a una temperatura celular de 401 ° C. Comparando las medidas de las series A y B en el mismo intervalo de temperatura, se observa que, en particular, la disminución de la longitud NW es más clara a presiones de As comparativamente más bajas (serie B). Sin embargo, se observa la misma tendencia general, es decir, se observa una disminución en la longitud NO para ambas series y un aumento en el diámetro para la serie A.
El dopaje con Si conduce de manera similar a un diámetro aumentado y una longitud disminuida para InAs y GaAs, independientemente del método de crecimiento (MBE o epitaxia en fase vapor metalorgánica (MOVPE)) [46, 47]. Se observó el mismo cambio en las dimensiones para el dopado con Te de GaAs NW sin catalizador cultivados por MBE [44]. Parece que independientemente del sistema de materiales utilizado, es decir, materiales IIIV dopados con materiales del grupo IV (InAs / Si, GaAs / Si) o del grupo VI (GaAs / Te, InAs / Te), se observa la misma tendencia general en cuanto a morfología.
Te exhibe un radio covalente bastante grande con respecto a los átomos de la red del anfitrión y, por lo tanto, puede actuar como tensioactivo [48, 49]. Por tanto, el comportamiento observado podría tener su origen en una disminución de la difusividad de los átomos de In causada por Te. Esto, a su vez, podría provocar un aumento del crecimiento radial y una disminución de la longitud, ya que los In adatoms se ven obstaculizados en su camino hacia la punta NW, donde controlan el crecimiento [46]. Comparando la Fig. 1a (serie A) y la Fig. 1b (serie B), encontramos que la presión de As influye en cómo la morfología del alambre se ve afectada por la adición de Te. El hallazgo sugiere que podría ser posible contrarrestar el impacto decreciente de Te en la dimensión radial y axial del alambre de InAs aumentando la presión de As hasta cierto punto.
Estructura cristalina
El impacto de los Te-dopantes en la estructura cristalina se investigó usando TEM y XRD. Adoptando la clasificación utilizada por Caroff et al. [49], se asignó una secuencia de apilamiento de cristales a un segmento ZB (cf. Fig. 2a) o WZ (cf. Fig. 2d) si la secuencia de apilamiento seguía exactamente cuatro bicapas de átomos. Esto significa que ... ABCA ... se contó como un segmento ZB y ... ABAB ... como un segmento WZ. Esto se ilustra en la Fig. 2b, e. Aquí, cada letra representa una bicapa de átomos. Algunas secciones de alambre se interrumpen por fallas de apilamiento (SF) que consisten en una capa faltante o en exceso dentro de la secuencia cristalina, como se presenta en la Fig. 2c, f. Aunque rara vez se observa, el hermanamiento rotacional también está presente en algunos segmentos (no se muestra aquí).
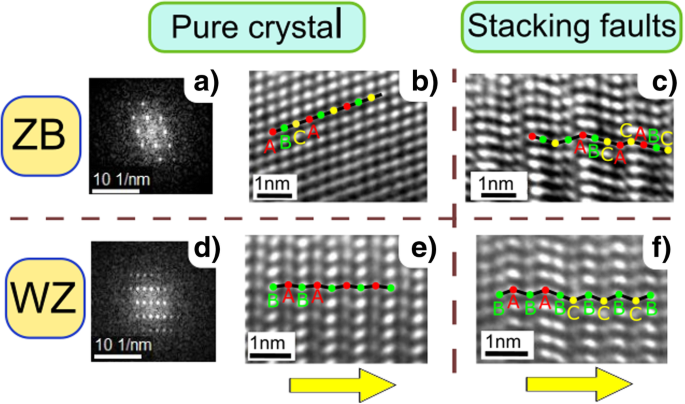
Análisis de estructura cristalina. Imágenes HR-TEM de InAs NW, que ilustran las estructuras cristalinas ZB y WZ con y sin fallas de apilamiento. Las flechas amarillas indican la dirección de crecimiento [111]. Los puntos de colores y las líneas negras son una guía para que los ojos sigan la característica de apilamiento. un Patrón de difracción FFT para ZB sin defectos. b , c Estructura ZB. d Patrón de difracción FFT para WZ y e sin defectos - f Estructura WZ
Las secciones de cristal se identificaron como segmentos ZB o WZ solo si se observaba una secuencia completa que constaba de cuatro bicapas de átomos. Las secciones restantes se atribuyeron a SF o gemelos rotacionales.
La estructura cristalina en tres niveles de dopaje diferentes evaluados de acuerdo con las características explicadas se ilustra en la Fig. 3. Se resaltan diferentes áreas WZ y ZB. Sin embargo, para el análisis, solo se contaron los segmentos individuales. Para cuantificar la influencia del dopaje Te sobre la estructura cristalina del NO, se analizó y promedió una longitud total de aproximadamente 150 nm de segmentos de 10 NO para cada nivel de dopaje (véase la Fig. 3b-d). La relación del segmento ZB / (WZ + ZB) se determinó contando el número de segmentos ZB y WZ individuales. Se analizaron las muestras B1, B3, C1 y A4 a 0 ° C, 447 ° C y 500 ° C (véase la Fig. 4), respectivamente. Observamos una mejora de la relación del segmento ZB / (WZ + ZB) con el aumento de la temperatura de la celda GaTe. Esta tendencia se ilustra en la Fig. 4. Al comparar los dos primeros puntos de datos (0 ° C y 447 ° C), la relación mejorada se debe a un aumento más fuerte en los segmentos ZB en comparación con el aumento de los segmentos WZ de los no dopados a los temperatura de dopaje más baja (véase el recuadro de la Fig. 4). Se mejoran ambos tipos de estructura y se reduce el número de SF. Sin embargo, la tendencia difiere para el tercer punto. Al comparar el nivel de dopaje más alto con el más bajo (500 ° C y 447 ° C), encontramos que el número de segmentos WZ disminuye y el número de segmentos ZB se mantiene casi constante (cf. inset Fig.4) mientras que el número de SF aumenta. Esto conduce a una relación elevada. Aún así, la sección ZB se promueve en comparación con el caso sin dopar. Por último, los resultados muestran que el dopaje Te de hecho mejora la relación entre el segmento ZB / (WZ + ZB). Sin embargo, sigue siendo ambiguo si la formación de segmentos ZB es promovida estrictamente por la incorporación de Te.
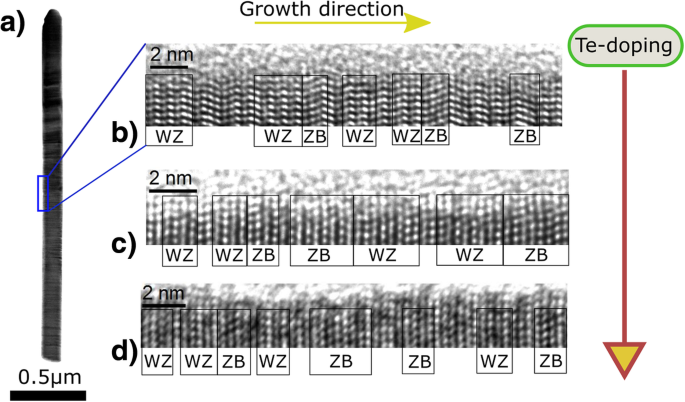
Influencia del tedopaje en la estructura cristalina. Imágenes TEM que representan la estructura cristalina en InAs NW sin dopar y Tedopado. un Vista lateral de un InAs NW. b - d Imágenes HR-TEM de la estructura cristalina de InAs NW (imagen girada 90 ° en el sentido de las agujas del reloj). Las áreas WZ y ZB están etiquetadas. Se eligieron las siguientes muestras y temperaturas de la celda GaTe: b B1 (como 4 -BEP =2,3 × 10 −5 Torr), sin dopar, es decir, 0 ° C. c B3 (como 4 -BEP =2,3 × 10 −5 Torr), 447 ° C. d C1 (como 4 -BEP =3,0 × 10 −5 Torr), 500 ° C

Relación entre los segmentos ZB y WZ. Relación entre el número de segmentos ZB y el número total de segmentos identificados como WZ o ZB en función de la temperatura de la celda GaTe. Para las dos primeras mediciones se han analizado B1 y B3. A 500 ° C, los resultados de los alambres C1 y A4 se fusionaron a medida que crecían en un As-BEP similar. El gráfico de barras en el recuadro muestra la longitud acumulada de todos los segmentos WZ y ZB presentes en el NW a la temperatura de celda indicada, respectivamente
Para complementar las observaciones realizadas por TEM, se realizaron mediciones de XRD. Realizamos exploraciones φ centradas en los reflejos cúbico (220) y hexagonal [10,11,12,13,14,15]. Estos reflejos pueden atribuirse sin ambigüedades a la estructura ZB y WZ, respectivamente. La medida de las respectivas intensidades permitió extraer el I ZB / ( Yo ZB + yo WZ ) relación de intensidad. Las exploraciones φ representadas en la Fig. 5a, sirvieron para determinar las intensidades relativas de los picos ZB y WZ en cada temperatura de dopaje de la celda GaTe. Para el reflejo ZB, se producen seis picos a pesar de que la celosía cúbica solo debería conducir a una simetría triple. Asignamos estos picos a gemelos simétricos en la estructura ZB. Los picos simétricos de seis veces que ocurren en el escaneo WZ son característicos de la estructura cristalina hexagonal y coinciden con nuestras expectativas. En este caso, se supone que la intensidad de la señal de los cristalitos de superficie de InAs (véase el recuadro de la Fig. 1) es dos órdenes de magnitud menor que la señal NW [50] y, por tanto, puede despreciarse. La relación de intensidad correspondiente I ZB / ( Yo ZB + yo WZ ) se representa en la Fig. 5b (triángulos de colores para la serie A). Muestra un aumento del I ZB / ( Yo ZB + yo WZ ) relación de intensidad con el aumento de la temperatura de la celda GaTe, que se hace evidente después de 401 ° C para la serie A. Este resultado está de acuerdo con la observación ya obtenida del análisis TEM. Tenga en cuenta que las relaciones de intensidad dadas no representan la proporción real ZB / WZ, pero constituyen un resultado cualitativo. Esto se debe a que los diferentes reflejos son de diferente intensidad, según el factor de estructura que no se ha tenido en cuenta explícitamente. Sin embargo, la comparación entre los puntos de datos sigue siendo válida. Se realizó la misma medición sensible al reflejo para la serie B, que se cultivó a una presión de As más baja que la serie A presentada anteriormente. Los resultados representados en la Fig. 5b (puntos negros) muestran una tendencia similar a la de la serie A, es decir, un aumento en la relación de intensidad ZB / (WZ + ZB) a temperaturas de celda más altas. Sin embargo, el impacto de los átomos de Te en la estructura cristalina es menos distinto en comparación con las presiones de As más altas y solo se observa un aumento claro a 462 ° C. Aunque la serie B muestra solo una mejora de la relación de intensidad ZB / (WZ + ZB) en el XRD para la temperatura más alta de la celda GeTe de 462 ° C, la serie A muestra claramente un aumento a 447 ° C y 500 ° C de temperatura de la celda. Esta observación sugiere que los átomos de As facilitan la incorporación de átomos de Te, lo que a su vez conduce a un cambio en la estructura cristalina. Por lo tanto, se observa un impacto más fuerte en la relación ZB / (WZ + ZB) para la respectiva presión de As más alta. La disminución de la relación de intensidad a 447 ° C en la Fig. 5b podría deberse a efectos de sombra, ya que la densidad del NO para la muestra B3 estaba por encima del promedio, aunque esto aún no se comprende completamente.

Análisis de rayos X de la estructura reticular. un φ exploraciones obtenidas mediante mediciones de rayos X en InAs NWs A1-A4. b I resultante ZB / ( Yo WZ + yo ZB ) relación de intensidad frente a la temperatura de la celda GaTe. Los puntos de datos triangulares se extraen de las medidas representadas en ( a ) para las muestras A1 – A4. Los puntos negros indican los puntos de datos de las muestras B1 – B4
A partir de los resultados de TEM presentados anteriormente, se concluye que los NW que se cultivaron con el suministro de Te muestran un mayor número de segmentos ZB y WZ y, por lo tanto, menos SF en comparación con el caso sin dopar. Además, las mediciones de XRD indican que la relación de intensidad ZB / (WZ + ZB) aumenta con el aumento del nivel de dopaje de Te (a temperaturas más altas) que está cualitativamente en línea con las mediciones de TEM. A diferencia de los elementos comunes utilizados para el dopaje de materiales III-V como Si (InAs / Si [30], GaAs / Si), C (GaAs / C) o Be (GaAs / Be), Te afecta claramente a la estructura cristalina del NW. La promoción de la formación de ZB observada podría originarse a partir de un cambio de energías superficiales, reduciendo la barrera de energía para la nucleación de ZB. Esto se observó igualmente en nanocables de InP dopados con zinc [51] donde se utilizó crecimiento de VLS catalizado con Au. Sin embargo, se necesita más investigación para aclarar el mecanismo subyacente.
Medidas eléctricas
La conductividad definida por σ =A · R · L −1 w se extrajo de mediciones de dos puntos utilizando contactos de Ti / Au. Aquí, A es la sección transversal hexagonal del cable con A =3√3 d 2 NW / 8 donde d NW es el diámetro máximo, R la resistencia y Lw la distancia entre los contactos eléctricos. L w y d NW se han medido individualmente para cada cable a través de imágenes SEM. En la figura 6a-d se presentan características I – V ejemplares de InAs NW sin dopar y dopados. Los gráficos muestran el comportamiento óhmico esperado debido a la capa de acumulación superficial de InAs [6, 52]. La conductividad en dependencia del nivel de dopaje se determinó con base en las mediciones I – V y la geometría NW. La dependencia resultante entre la conductividad y la temperatura de la celda GaTe se ilustra en la Fig. 6e. A cada temperatura, se examinaron al menos 20 NW para la serie A. Al comparar los cables sin dopar y dopados, se observa un aumento en la conductividad promedio de aproximadamente un orden de magnitud en el nivel de dopaje más alto. A una temperatura de la celda de GaTe de 500 ° C, se determinó una conductividad promedio de aproximadamente 80 S / cm (en comparación con aproximadamente 8 S / cm para 0 ° C). Aunque la dispersión de la conductividad para niveles de dopaje más altos es bastante distinta, nuestra observación muestra que la incorporación de Te de hecho tiene un fuerte impacto, lo que lleva a un aumento de la conductividad en promedio. La comparación de la XRD y la medición de la conductividad sugiere que por debajo de 401 ° C el impacto del Te en la estructura cristalina y las propiedades de transporte juega un papel menor. La gran variación en la conductividad de los InAs NW mencionada anteriormente se ha informado de manera similar en la literatura [53]. No se observó ninguna tendencia de la conductividad con respecto a un cambio en el diámetro NW o el espaciamiento de los contactos, como se esperaba [26]. Por lo tanto, excluimos la relación de aspecto diferente como fuente de error. Identificamos tres razones principales responsables de la fuerte variación en la conductividad:(i) el método de pasivación por contacto que utiliza polisulfuro de amonio podría conducir a una calidad de contacto heterogénea. (ii) La superficie del alambre no está pasivada y los estados de la superficie pueden verse influenciados por una saturación no homogénea de los enlaces colgantes en las facetas del lado del alambre a través del agua y el oxígeno, lo que finalmente da como resultado una oxidación superficial no uniforme. Esto, a su vez, tiene un fuerte impacto en las características del transporte, dando lugar a grandes errores [54]. Una forma de prevenir estos estados de superficie heterogéneos es la pasivación mediante la deposición in situ de Al 2 O 3 [53, 55]. (iii) El dopaje no homogéneo a lo largo del NO, como se observa para el dopaje de Si [26], también podría causar la gran dispersión de datos, aunque intentamos excluirlo colocando los contactos centrados para cada cable. Finalmente, las variaciones en la longitud NW (ver Fig. 1) y la densidad pueden conducir a efectos de sombra, evitando la incorporación homogénea de Te a través de la muestra. Sin embargo, se necesitan investigaciones más sistemáticas para identificar el origen de la gran varianza observada. Además, se llevaron a cabo mediciones de conductividad para NW de la serie B que crecieron a una presión de As comparativamente más baja. Aquí, se midieron al menos seis cables para cada temperatura de celda GaTe. Los resultados representados en la Fig. 6e muestran un comportamiento similar a los discutidos anteriormente para la serie A. La conductividad de InAs NWs aumenta para temperaturas de celda GaTe más altas. Sin embargo, el efecto es menos distinto en comparación con la serie A, que crece a una presión de As más alta. Comparando las conductividades de ambas series a 401 ° C y 447 ° C en la Fig. 6e, encontramos que los valores para la serie A son aproximadamente dos veces más grandes que los encontrados para B. Los resultados de XRD presentados anteriormente (ver Fig. 5 ) ilustran que la estructura cristalina en la serie A se ve más afectada por la incorporación de Te que en la serie B. La combinación de ambos hallazgos indica que la conductividad elevada está relacionada con el cambio en la estructura cristalina, es decir, el aumento de ZB / (WZ + ZB) relación de intensidad. Se sabe por la bibliografía que una modificación en la estructura cristalina de InAs NW de dominada por WZ hacia dominada por ZB mejora la conductividad [50, 53, 56]. Basado en investigaciones de TEM en InAs 1 - x Sb x NW, Sourribes et al. informaron de un aumento de la conductividad en 1,5 para una ganancia en la fracción NW ZB del 20 al 80% [50]. Nuestros resultados de TEM (ver Fig.4) muestran una relación ZB / (WZ + ZB) elevada de 32% (NW sin dopar) a 43% (NW dopado máximo) mientras que el valor de conductividad promedio aumenta en aproximadamente un factor de 10. Este La comparación sugiere que la estructura cristalina alterada no es la única razón para la mejora de la conductividad. Aunque la modificación de la estructura cristalina afecta el transporte del portador, el efecto observado probablemente también se deba a una densidad aumentada del portador inducida por Te que actúa como donante.
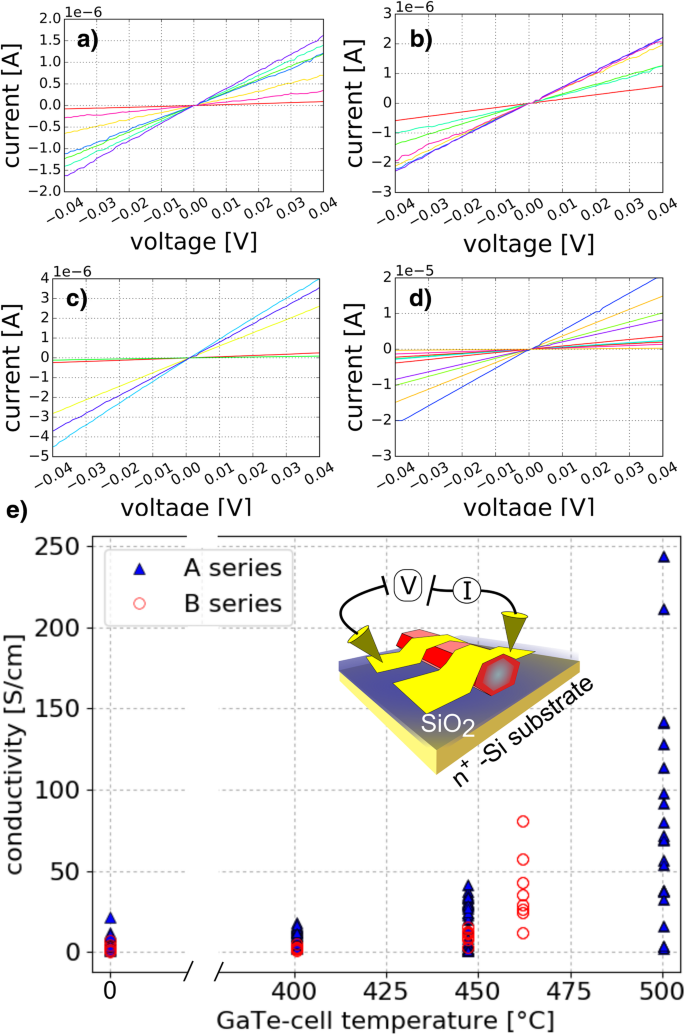
Caracterización eléctrica. un - d Mediciones I – V ejemplares de InAs NW a una temperatura de celda GaTe de 0 ° C, 401 ° C, 447 ° C y 500 ° C (serie A) medidas a través de contactos de dos puntos. e Valores de conductividad determinados de InAs NW dopados con Te en dependencia de la temperatura de la celda GaTe para las series A (alto As-BEP) y B (bajo As-BEP). El recuadro muestra un esquema de la configuración de medición eléctrica
Conclusión
En resumen, hemos cultivado InAs NW sin catalizador dopado con Te en sustratos de Si (111) mediante el método de crecimiento sólido de vapor. Te fue proporcionado por una celda GaTe que permite el crecimiento de InAs NW dopados con Te a diferentes niveles de dopaje ajustando la temperatura de la celda. Se caracterizaron dos series de muestras cultivadas en diferentes As-BEP mediante SEM, TEM, XRD y mediciones eléctricas. Hemos demostrado que Te cambia la morfología NW conduciendo a una tendencia general de un aumento de la tasa de crecimiento radial y una disminución de la tasa de crecimiento axial. El impacto es más fuerte a presiones parciales de As comparativamente más bajas. Las mediciones de TEM y XRD revelaron que la estructura cristalina de NW se ve afectada por la adición de Te, lo que da como resultado un aumento de la relación ZB / (WZ + ZB) para ambas series de crecimiento. La influencia sobre la estructura cristalina de NW que creció a una As-BEP comparativamente más alta fue más mejorada que la observada para las NW que crecieron a una As-BEP más baja. Las mediciones eléctricas de dos puntos demostraron un aumento en la conductividad promedio de los cables que crecen con suministro de Te. Esto se observó para dos series de crecimiento, cultivadas a diferentes presiones de As. La comparación entre las dos series de muestras mostró que las propiedades cristalinas y eléctricas de InAs NW se ven más afectadas por la adición de Te a presiones de As más altas. El resultado indica que la conductividad promedio mejorada está fuertemente relacionada con el cambio en la estructura cristalina, es decir, el aumento en la relación ZB / (WZ + ZB). Atribuimos las propiedades de transporte mejoradas tanto al elemento Te incorporado del grupo VI que actúa como donante como a una estructura cristalina alterada. Este trabajo constituye una contribución importante para ampliar las opciones de dopaje NW que es de gran interés para contrarrestar la degradación de las propiedades de transporte por los SF.
Abreviaturas
- Como:
-
Arsénico
- BEP:
-
Haz de presión equivalente
- C:
-
Carbono
- GaAs:
-
Arseniuro de galio
- GaTe:
-
Telururo de galio
- HR-TEM:
-
Microscopía electrónica de transmisión de alta resolución
- InAs:
-
Arseniuro de indio
- MBE:
-
Epitaxia de haz molecular
- MOVPE:
-
Epitaxia en fase vapor metalorgánica
- NW:
-
Nanocable
- SEM:
-
Microscopía electrónica de barrido
- SF:
-
Fallo de apilamiento
- Si:
-
Silicio
- Te:
-
Telurio
- VS:
-
Vapor-sólido
- WZ:
-
Wurtzita
- XRD:
-
Difracción de rayos X
- ZB:
-
Mezcla de zinc
Nanomateriales
- Mantener el crecimiento de IoT
- Crecimiento de CMMS para pequeñas empresas
- Los científicos de materiales enseñan a los nanocables cómo 'bailar'
- Acerca de las nanopartículas semiconductoras
- Investigaciones de estructuras de vacantes relacionadas con su crecimiento en la hoja h-BN
- Crecimiento autocatalizado de nanocables verticales de GaSb en vástagos de InAs mediante deposición de vapor químico metalorgánico
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido
- Investigación teórica de nanocables de germanio tensados biaxialmente por tracción
- Control del crecimiento de nanocables de selenuro de indio de alta uniformidad (In2Se3) mediante el proceso de recocido térmico rápido a baja temperatura
- Influencia de la rigidez elástica y la adherencia de la superficie en el rebote de nanopartículas
- Sensor de gas de hidrógeno de nanocables de óxido de cobre asistido por luz ultravioleta



