Propiedades eléctricas de superredes de onda media y onda larga InAs / GaSb cultivadas en sustratos de GaAs mediante epitaxia de haz molecular
Resumen
En el presente trabajo, informamos sobre las propiedades de transporte eléctrico en el plano de las superredes de onda media (MWIR) e infrarroja de onda larga (LWIR) InAs / GaSb tipo II (T2SL) cultivadas por el sistema de epitaxia de haz molecular (MBE) en GaAs (001) sustrato. El enorme desajuste de celosía entre el sustrato T2SL y GaAs se reduce mediante el crecimiento de la capa tampón de GaSb basada en la técnica de matriz de desajuste interfacial (IMF). Para compensar la tensión en InAs / GaSb T2SL, utilizamos una secuencia especial de contraventanas para obtener interfaces similares a InSb y GaAs. Se encuentra que el MWIR InAs / GaSb T2SL exhibe un p - y n -tipo de conducción a bajas y altas temperaturas, respectivamente. Curiosamente, se observa que la temperatura de cambio de conducción depende de la temperatura de crecimiento. Por otro lado, la conducción LWIR T2SL está dominada solo por electrones. Es importante señalar que el mecanismo de dispersión dominante en LWIR T2SL a bajas temperaturas es el mecanismo de dispersión de la rugosidad de la interfaz.
Antecedentes
Dado que InAs / GaSb T2SL ha sido conceptualizado por Sai-Halasz et al. [1] en 1977 se ha prestado mucha atención a la investigación de este material semiconductor. Los fotodetectores basados en este T2SL presentan un potencial teóricamente mayor que el telururo de mercurio y cadmio (HgCdTe) y los sistemas de material infrarrojo de última generación para la próxima generación de aplicaciones infrarrojas (IR) [2, 3]. Curiosamente, InAs / GaSb T2SL exhibe una alineación inusual de banda de brecha rota de tipo II donde el mínimo de la banda de conducción de InAs se ubica 140 meV por debajo de la parte superior de la banda de valencia de GaSb [1]. En consecuencia, la transición fundamental entre las subbandas de orificios pesados y el fondo de la banda de conducción depende del grosor de la capa de InAs o GaSb [4]. Sin embargo, la principal ventaja de esta alineación es la reducción de la tasa de recombinación de Auger gracias a la supresión de algunas vías no radiativas en la banda de valencia [5]. Además, la tunelización banda a banda se reduce significativamente debido a las grandes masas efectivas (≈ 0.04 m 0 ) de electrones y huecos [6]. Estas dos últimas características permiten la reducción de la corriente oscura, lo que conduce a la alta temperatura de funcionamiento (CALIENTE) del fotodetector.
InAs / GaSb T2SL se cultiva tradicionalmente en sustrato de GaSb de celosía. Sin embargo, este último es caro y está disponible en tamaños pequeños de menos de 3 pulgadas, lo que impide la realización de arreglos de plano focal (FPA) de gran formato. Además, los sustratos de GaSb no están “preparados para epi” y sus superficies de crecimiento contienen muchos defectos macroscópicos [7]. Además, el coeficiente de absorción es relativamente alto en el sustrato de GaSb (≈ 100 cm −1 ) para radiación IR superior a 5 μm [8]. Debido a sus numerosas ventajas, GaAs se ha propuesto como un candidato viable para el crecimiento de InAs / GaSb T2SL [9,10,11,12]. De hecho, están preparados para epi, son rentables y están disponibles en tamaños grandes de hasta 6 pulgadas. Además, el GaAs tiene un coeficiente de absorción dos órdenes de magnitud menor que el del GaSb. Desafortunadamente, existe un gran desajuste de celosía (~ 7.5%) entre GaAs e InAs / GaSb T2SL que da como resultado una alta densidad de dislocación por desajuste (10 9 cm −2 ) [13]. Por lo tanto, es obligatorio concebir nuevas técnicas de crecimiento para aliviar la tensión y reducir la densidad de luxación. Entre estas técnicas se encuentran la nucleación a baja temperatura [14] y la técnica IMF [15, 16].
Para mejorar el rendimiento de los fotodetectores basados en InAs / GaSb T2SL, se necesita una mejor comprensión de los parámetros fundamentales. Uno de estos parámetros es la concentración de portador de fondo que está asociado con la vida útil del portador minoritario y las longitudes de difusión. Vale la pena señalar que los materiales a granel de InAs y GaSb tienen polaridad opuesta de concentración de portadores. De hecho, los materiales de InAs y GaSb cultivados mediante epitaxia de haz molecular (MBE) son residualmente n - y p -tipo, respectivamente [17, 18]. En consecuencia, se predice que la conducción de InAs / GaSb T2SL dependerá del grosor de cada constituyente.
En este artículo, investigamos las propiedades de transporte en el plano de 10 ML InAs / 10 ML GaSb y 24 ML InAs / 7 ML GaSb T2SL dedicadas a la detección en regiones MWIR y LWIR, respectivamente, cultivadas en GaAs semiaislante (001) sustratos. Este estudio se logra mediante la realización de una medición del efecto Hall dependiente de la temperatura utilizando el método de Van der Pauw. Además, se presenta la influencia de la temperatura de crecimiento en la conducción de los InAs / GaSb T2SL.
Métodos
Las muestras de InAs / GaSb T2SL se cultivaron en sustratos semi-aislantes de GaAs (001) en un sistema MBE de fuente sólida RIBER Compact 21-DZ. Este último está equipado con celdas de efusión estándar para elementos del grupo III (indio (In) y galio (Ga)) y celdas agrietadas con válvula para materiales del grupo V (arsénico (As) y antimonio (Sb)). Las temperaturas del cracker se mantuvieron a 900 ° C tanto para As como para Sb para producir As 2 y Sb 2 , respectivamente. El termopar manipulador (TC) y BandiT (BT) se utilizan para controlar la temperatura de crecimiento. Este último ha sido calibrado a partir de la temperatura de desorción del óxido de GaAs. Después de la desoxidación de los sustratos de GaAs a 610 ° C (medido por BT), se depositó una capa de GaAs de 250 nm de espesor a 585 ° C (BT) para obtener una superficie de partida suave. Posteriormente, se ha cultivado una capa tampón de GaSb de 1 μm de espesor utilizando la técnica IMF a una temperatura de BT de 440 ° C [16, 19]. Esta técnica consiste en la formación de una matriz periódica de dislocación de desajuste de 90 ° en la interfaz GaAs / GaSb que conduce a una baja densidad de dislocación (≈ 10 6 cm −2 ) [20]. Después del crecimiento de la capa amortiguadora de GaSb, el BT ya no se puede utilizar debido a los cambios de emisividad, la rugosidad de la superficie y los mecanismos de absorción radiativa adicionales [21]. Por tanto, la temperatura de crecimiento de InAs / GaSb T2SL está controlada únicamente por el TC. MWIR 10 ML InAs / 10 ML GaSb T2SL se cultivan a diferentes temperaturas del sustrato, 330, 390 y 400 ° C (TC) para investigar la influencia de la temperatura de crecimiento en las propiedades de transporte. Por otro lado, LWIR 24 ML InAs / 7 ML GaSb T2SL se ha depositado a solo 390 ° C. Para compensar la deformación entre InAs y GaSb, se utilizó una secuencia especial de contraventanas, que se informó que conducía a una mejor calidad estructural [22, 23], de la siguiente manera:el crecimiento de InAs fue seguido por un remojo de Sb de 8 s para formar InSb -como enlaces, mientras que el crecimiento de GaSb fue seguido por 2 s de remojo en As para hacer crecer la interfaz similar a GaAs. La relación de flujo V / III es de 8,3 y 4,6 para InAs y GaSb, respectivamente. Además, la tasa de crecimiento es de 0,5 ML / s tanto para InAs como para GaSb. El crecimiento se controló in situ mediante un sistema de difracción de electrones de alta energía por reflexión (RHEED).
Las muestras cultivadas se evaluaron mediante difracción de rayos X de alta resolución (HRXRD) de PANalytical X’Pert para investigar las propiedades estructurales. El Cu Kα 1 radiación ( λ ≈ 1.5406 Å) que se originan a partir de un foco de línea y un monocromador Ge (004) de cuatro rebotes se han utilizado. Las propiedades de transporte se evaluaron mediante mediciones de efecto Hall utilizando el método de Van der Pauw en un sistema ECOPIA, con un rango de temperatura de 80-300 K. Las mediciones se realizaron en muestras cuadradas de 6 × 6 mm 2 ; el contacto se hizo mediante puntos de indio en cada esquina. Se aplicó un campo magnético de 0,4 T normal a las muestras.
Resultados y discusión
La Figura 1 ilustra el HRXRD 2θ-ω medido y simulado curvas de barrido de la reflexión simétrica (004) para MWIR y LWIR InAs / GaSb T2SL. La simulación se realiza mediante el software "Epitaxy" proporcionado por PANalytical X’Pert. Como puede verse, hay satélites bien resueltos con un pedido de hasta 4 para MWIR T2SL y hasta 7 para LWIR uno. Esto indica la alta calidad estructural de las capas cultivadas, especialmente para LWIR T2SL. Por otro lado, el ancho completo a la mitad del máximo (FWHM) del pico de orden cero medido en ω-2θ La dirección es 107 y 99 segundos de arco para MWIR y LWIR T2SL, respectivamente. El período de superrejilla ( L ) se determina a partir de la distancia angular entre dos satélites adyacentes (Δ θ ) de la siguiente manera:

HRXRD 004 2θ-ω escaneo de un MWIR b y LWIR InAs / GaSb T2SL. Experimental (línea negra) y simulada (línea roja) HRXRD 2θ-ω busca el reflejo (004) de a MWIR T2SL; hay satélites bien resueltos con un orden de hasta 4, que es una característica de buena calidad de superrejilla. El FWHM del pico de orden cero es 107 segundos de arco, b y LWIR InAs / GaSb T2SL; hay picos satélites con un orden de hasta 7, lo que confirma la alta calidad cristalina. El FWHM del pico de orden cero es 99 segundos de arco. El período de cada superrejilla se calcula a partir de la distancia entre satélites adyacentes
$$ L =\ lambda / \ left (2 \ times \ Delta \ theta \ times \ mathit {\ cos} {\ theta} _ {SL} \ \ right) $$ (1)donde λ es la longitud de onda del haz de rayos X incidente mencionado anteriormente y θ SL es el ángulo de Bragg del pico de orden cero de la superrejilla. De la Fig. 1, el período de MWIR y LWIR T2SL es 6.74 ± 0.01 y 10.24 ± 0.02 nm, respectivamente. Al ajustar la curva medida con la simulada, se encuentra que la composición de un período de MWIR T2SL es la siguiente:GaSb 3.4 nm (11.2 ML), GaAs 0.1 nm (0.2 ML), InAs 3.0 nm (10.1 ML), y InSb 0,2 nm (0,5 ML). Además, los espesores de los componentes LWIR T2SL son los siguientes:GaSb 2,3 nm (7,5 ML), GaAs 0,1 nm (0,2 ML), InAs 7,4 nm (24,7 ML) e InSb 0,4 nm (1 ML). La falta de coincidencia de la red determinada a partir del ángulo entre el pico de orden cero y la capa de amortiguación de GaSb es 8,9 × 10 −3 y 4.5 × 10 −3 para MWIR y LWIR T2SL, respectivamente. La Figura 2 presenta el mapa de espacio recíproco (RSM) asimétrico (115) para las T2SL crecidas. En ambas muestras, los satélites de las superredes y el pico de GaSb están alineados verticalmente (tienen el mismo componente del vector de dispersión Q x ), lo que lleva a la conclusión de que ambos T2SL están prácticamente sobrecargados.

115 RSM asimétrico de a MWIR y b LWIR InAs / GaSb T2SL. El mapa de espacio recíproco para la reflexión asimétrica (115) de a MWIR y b LWIR InAs / GaSb T2SL. Los picos en ambas superredes están alineados verticalmente (tienen el mismo valor del vector de dispersión Q x ). Por lo tanto, las dos superredes para MWIR y LWIR están prácticamente tensas
Los parámetros eléctricos en el plano de los MWIR InAs / GaSb T2SL crecidos se ilustran en la Fig. 3. Como puede verse, el InAs / GaSb T2SL dopado no intencionalmente exhibe un cambio reproducible en el tipo de conductividad. A pesar de la influencia de la capa de búfer de GaSb ( p -tipo) en las mediciones de efecto Hall, debe tenerse en cuenta que el cambio en el tipo de conductividad se debe solo a la capa T2SL. Este cambio también fue informado por varios grupos [6, 24, 25, 26]. El T2SL exhibe una p -tipo de conducción por debajo de la temperatura a la que se produce el cambio ( T ch ) y una n -tipo de conducción por encima de T ch . Como se mencionó anteriormente, las capas InAs y GaSb exhiben una n -type y p -tipo de conducción, respectivamente. Por lo tanto, el fondo residual de InAs / GaSb T2SL con un espesor similar para los dos constituyentes es inducido por la compensación de portadora mayoritaria de los constituyentes binarios de T2SL [27]. Por el valor de T ch , Mohseni y col. [6] informó un valor de 140 K, Christol et al. [24] obtuvo un valor de 190 K, mientras que Khoshakhlagh et al. [25] señaló un valor de 200 K. El comportamiento de la concentración y la movilidad del portador de la hoja está gobernado por los bien conocidos mecanismos intrínsecos de dispersión de fonones (acústicos, piezoeléctricos, polares y ópticos no polares). Excepcionalmente, la movilidad de la sala aumenta con el aumento de la temperatura por encima de T ch (Figura 3b); esto es probablemente debido a las trampas ionizadas debido a la interfaz InSb en la interfaz GaSb-on-InAs [6]. T ch el valor es 145, 195 y 225 K, para el T2SL cultivado a 330, 390 y 400 ° C, respectivamente (Fig. 3); esto se debe probablemente a la alta concentración del agujero a una temperatura de crecimiento más alta, lo que cambia la T ch para bajar la temperatura. La alta concentración de agujeros se debe a defectos y vacantes ionizadas a altas temperaturas de crecimiento. El InAs / GaSb T2SL cultivado a 390 ° C se caracteriza por una concentración de portador de 1.8 × 10 16 y 2,5 × 10 16 cm −3 a 80 y 300 K, respectivamente. Este resultado es mejor que el informado por Mohseni et al. [6] (La concentración de Hall varía de 1,5 a 4 × 10 17 cm −3 ) y prácticamente igual al reportado por Christol et al. [24] (concentración Hall de 1,6 × 10 16 y 6 × 10 16 cm −3 a 100 y 300 K, respectivamente). Por otro lado, la movilidad del Salón es de 1300 ( p -tipo) y 3200 cm 2 / V s ( n -tipo), a 80 y 300 K, respectivamente. La movilidad alcanzada es muy superior a la reportada por Christol et al. [24], que obtuvo una movilidad Hall de 100 y 1800 cm 2 / V sa 100 y 300 K, respectivamente.

un Hall de concentración y b Hall de movilidad de MWIR InAs / GaSb T2SL cultivados a diferentes temperaturas. Los parámetros eléctricos de los MWIR InAs / GaSb T2SL crecieron a diferentes temperaturas. un Concentración Hall:los tres T2SL presentan un cambio de conductividad. Son p -tipo a bajas temperaturas y n -tipo a altas temperaturas. b Movilidad de la sala:hay dos regiones para la tendencia de movilidad. Para baja temperatura, la movilidad disminuye debido a los diferentes mecanismos de dispersión. Para altas temperaturas, la movilidad aumenta al aumentar la temperatura, lo que puede explicarse por las trampas ionizadas en una interfaz similar a InSb. La temperatura a la que se produce el cambio de conductividad aumenta cuando aumenta la temperatura de crecimiento, lo que se debe a los altos niveles de defectos a temperaturas más altas
La resistividad de las tres muestras diferentes se muestra en la Fig. 4. Se puede notar que la resistividad y la temperatura tienen dos pendientes bien definidas. Para cada muestra, se pueden extraer dos energías de activación térmica de la ley de Arrhenius. Para el n -tipo región, la energía de activación E an es 58, 72 y 68 meV para el T2SL cultivado a 330, 390 y 400 ° C, respectivamente. Mientras que para el p -tipo región, E ap es igual a 7, 12 y 14 meV, para los InAs / GaSb T2SL depositados a 330, 390 y 400 ° C, respectivamente. Para temperaturas bajas (por debajo de T ch ), el T2SL muestra una p -tipo debido a p -portadores de tipo asociados con E ap que dominan los mecanismos de recombinación y generación de portadores. Para temperaturas superiores a T ch , el T2SL exhibe una n -tipo de conducción debido a la activación de portadores de nivel profundo asociados con alta energía de activación E an . La fuente de estos niveles profundos son los niveles poco profundos en el InAs masivo que es el resultado de la alineación de bandas entre InAs e InAs / GaSb T2SL y que actúa como niveles profundos en el InAs / GaSb T2SL [28].
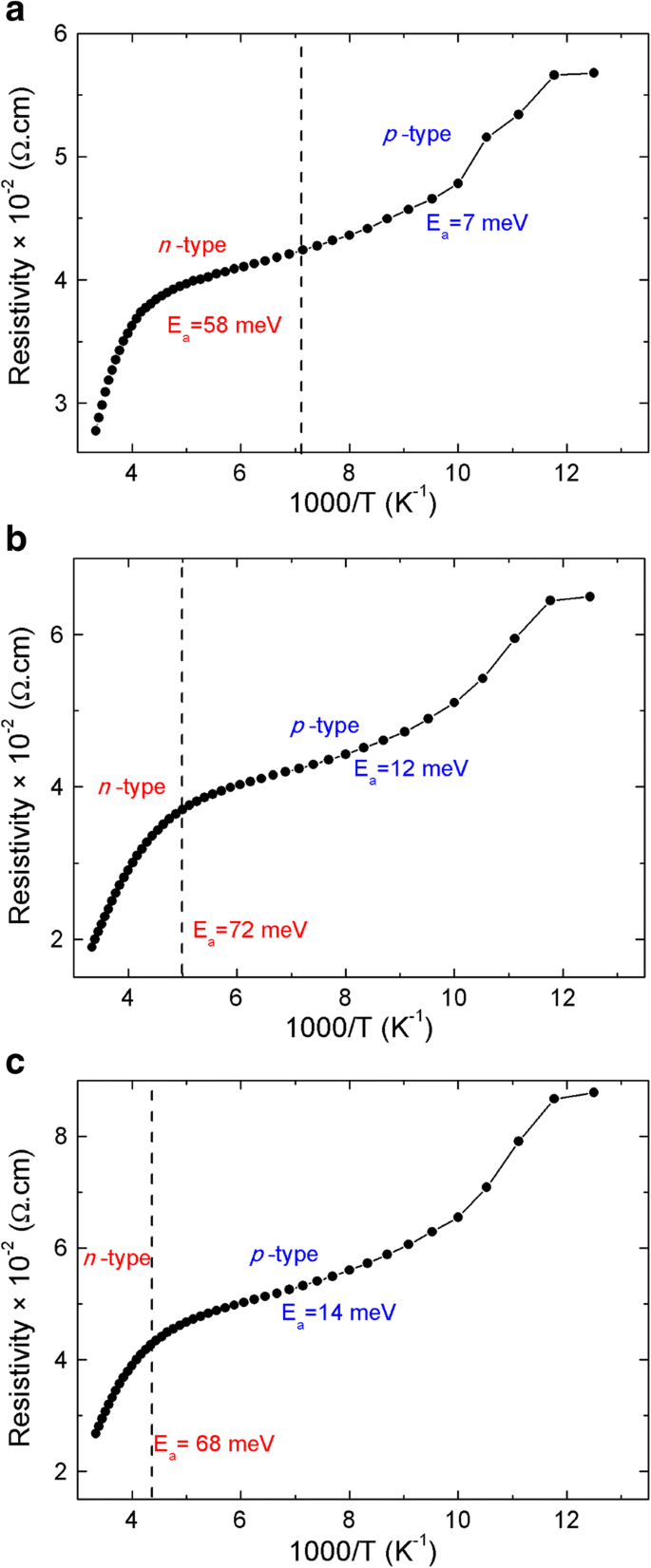
Resistividad Hall del MWIR InAs / GaSb T2SL crecido a a 330 ° C, b 390 ° C y c 400 ° C. La resistividad Hall del MWIR InAs / GaSb T2SL depositado a diferentes temperaturas de crecimiento, a 330 ° C, b 390 ° C y c 400 ° C. Para cada gráfico, hay dos pendientes bien definidas. De la ley de Arrhenius se pueden extraer dos energías térmicas, lo que confirma la existencia de dos niveles de impurezas. Uno representa el n -tipo portadores, y el segundo corresponde a la p -portadores de tipo. El nivel de impureza profunda asociado al n -tipo portadores es el resultado de la alineación de bandas entre InAs e InAs / GaSb T2SL
La concentración de Hall, la movilidad y la resistividad del LWIR InAs / GaSb T2SL se presentan en la Fig. 5. Frente al MWIR T2SL, no hay cambio de tipo de conductividad en el caso de esta muestra. Este T2SL exhibe una n -tipo de conducción. La influencia de la p -Tipo de capa de búfer GaSb (portadores de baja movilidad) en la medición del efecto Hall para esta n -tipo T2SL (transportistas de alta movilidad) es insignificante, ya que la movilidad Hall es proporcional al cuadrado de la movilidad de los transportistas. Khoshakhlagh y col. [25] informó el mismo resultado para 13 ML InAs / 7 ML GaSb T2SL. Además, Szmulowicz et al. [29] señaló que LWIR T2SL, en el que la capa de InAs es más gruesa que GaSb, tiende a ser n -escribe. Este n -tipo de conducción se debe al gran espesor de la capa de InAs (residualmente n -dopado.) en comparación con el de GaSb. Estos n Los portadores de tipo-están asociados con una energía de activación de 33 meV (Fig. 5b). El comportamiento de la concentración y la movilidad de Hall es típico de n -semiconductores de tipo, excepto en el rango de temperatura por debajo de 95 K, donde la concentración y la movilidad del portador son casi independientes de la temperatura. Esto es una indicación de la existencia de un mecanismo de dispersión independiente de la temperatura en esta región de temperatura. Se ha demostrado que este último es el mecanismo de dispersión de rugosidad de la interfaz (IRS) [30,31,32,33,34]. Este mecanismo es dominante a baja temperatura, donde la dispersión de fonones se congela [35]. El mecanismo IRS se debe a la existencia de interfaces, así como a la variación de los espesores de las capas, lo que resulta en la variación de los niveles de energía electrónica; por lo tanto, actúan como una fuente de dispersión de portadores [35]. Además, la movilidad de Hall dominada por el mecanismo IRS es proporcional a la sexta potencia del espesor de InAs (\ (\ mu \ propto {d} _ {\ mathrm {InAs}} ^ {6.2} \)) [35].

un Hall de concentración, Hall de movilidad y b Resistividad Hall de LWIR InAs / GaSb T2SL dopado involuntariamente. Las propiedades de transporte de LWIR InAs / GaSb T2SL. un Hall de concentración y movilidad:esta superrejilla exhibe solo n -tipo de conducción para todo el rango de temperatura. La concentración de Hall aumenta al aumentar la temperatura que es causada por los efectos de ionización. Por otro lado, el comportamiento de la movilidad de Hall se rige por los diferentes mecanismos de dispersión (fonones e impurezas ionizadas) para temperaturas superiores a 95 K. Para temperaturas inferiores a 95 K, la movilidad es constante (así como la concentración de Hall), lo que confirma la existencia de otro mecanismo de dispersión que es independiente de la temperatura. Este último es el mecanismo de rugosidad de la interfaz. b Resistividad Hall:según la ley de Arrhenius, solo hay una energía térmica asociada a un nivel de impureza
Conclusiones
En resumen, las T2SL de InAs / GaSb se han cultivado en un sustrato de GaAs utilizando una capa tampón de GaSb basada en la técnica IMF. Además, estos T2SL se han demostrado para regiones de detección de MWIR y LWIR. Se ha encontrado que MWIR T2SL exhibe un cambio en el tipo de conducción, forma p - a n -tipo a medida que aumenta la temperatura. Además, la temperatura a la que se produce el cambio aumenta a medida que aumenta la temperatura de crecimiento de las T2SL. Este cambio de tipo de conducción se atribuye a la existencia de dos niveles de impurezas con dos energías de activación diferentes. Por otro lado, se demuestra que la conducción LWIR InAs / GaSb T2SL es n -tipo para todo el rango de temperatura. Además de los mecanismos de dispersión convencionales, se ha demostrado que el mecanismo IRS es el mecanismo de dispersión dominante a bajas temperaturas. Estos resultados permiten una mejor comprensión de las propiedades físicas de InAs / GaSb T2SL, lo que conduce a la mejora del rendimiento de los fotodetectores IR basados en este material.
Abreviaturas
- BT:
-
BandiT
- FPA:
-
Matrices de plano focal
- FWHM:
-
Ancho completo a la mitad del máximo
- CALIENTE:
-
Alta temperatura de funcionamiento
- HRXRD:
-
Difracción de rayos X de alta resolución
- FMI:
-
Matriz de inadaptación interfacial
- IR:
-
Infrarrojos
- Servicio de Impuestos Internos:
-
Dispersión de la rugosidad de la interfaz
- LWIR:
-
Infrarrojos de onda larga
- MBE:
-
Epitaxia de haz molecular
- MWIR:
-
Infrarrojos de onda media
- RHEED:
-
Difracción de electrones de alta energía por reflexión
- RSM:
-
Mapa del espacio recíproco
- T2SL:
-
Superrejilla de tipo II
- TC:
-
Termopar
Nanomateriales
- Preparación y propiedades magnéticas de nanopartículas de espinela de FeMn2O4 dopadas con cobalto
- Hacia los nanofluidos de TiO2:Parte 1:Preparación y propiedades
- Modelado y simulación de dinámica molecular del corte con diamante de cerio
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Dependencia de la temperatura de la banda prohibida en MoSe2 crecido por epitaxia de haz molecular
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Efectos bipolares en el fotovoltaje de heteroestructuras metamórficas de puntos cuánticos de InAs / InGaAs / GaAs:soluciones de caracterización y diseño para dispositivos sensibles a la luz
- Preparación y propiedades ópticas de las películas GeBi mediante el método de epitaxia de haz molecular
- Prueba de las propiedades estructurales, electrónicas y magnéticas de Ag n V (n =1–12) Clusters
- Dependencia de la toxicidad de las nanopartículas en sus propiedades físicas y químicas
- Dependencias de temperatura y presión de las propiedades elásticas de los cristales individuales de tantalio bajo una carga de tracción <100>:un estudio de dinámica molecular



