Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LED
Resumen
Las características de In 0.2 de ocho períodos Ga 0.8 Se exploran los pozos cuánticos (QW) de N / GaN con dopaje de silicio (Si) en las primeras dos a cinco barreras cuánticas (QB) en la secuencia de crecimiento de los diodos emisores de luz azul (LED). Las depiladoras de estructuras QW se cultivan en 20 pares de In 0.02 Ga 0,98 Superrejilla de N / GaN que actúa como capas de alivio de tensión (SRL) sobre sustratos de zafiro estampados (PSS) mediante un sistema de deposición de vapor químico orgánico metálico a baja presión (LP-MOCVD). Espectros de fotoluminiscencia dependiente de la temperatura (PL), corriente frente a voltaje ( I - V ) curvas, potencia de salida de luz frente a corriente de inyección ( L - yo ), y se miden las imágenes de microscopía electrónica de transmisión de alta resolución (HRTEM) de las depiladoras. Las consecuencias muestran que los QW con cuatro QB dopados con Si tienen una mayor energía de localización de portadora (41 meV), menores voltajes de encendido (3,27 V) y de ruptura (- 6,77 V) y una mayor potencia de salida de la luz de los LED azules en una inyección más alta. actual que otras muestras. La baja altura de barrera de los QB en una muestra de QB dopada con cuatro Si da como resultado un potencial de confinamiento suave de los QW y menores voltajes de encendido y ruptura del diodo. Las imágenes HRTEM dan la evidencia de que esta muestra tiene interfaces relativamente difusivas de QW. La distribución uniforme de los portadores entre ocho QW y la localización superior de los portadores en cada pozo son responsables de la mejora de la potencia de salida de luz, en particular, para la alta corriente de inyección en la muestra QB dopada con cuatro Si. Los resultados demuestran que cuatro QB de ocho In 0.2 Ga 0.8 Los QW de N / GaN con dopaje de Si no solo reducen el efecto Stark confinado cuánticamente (QCSE), sino que también mejoran la distribución y localización de los portadores en los QW para un mejor rendimiento óptico de los LED azules.
Antecedentes
El dopaje con silicio (Si) en las barreras cuánticas (QB) de GaN puede activar la detección de Coulomb del campo de polarización y causar la supresión del efecto Stark confinado cuánticamente (QCSE) en pozos cuánticos (QW) de InGaN / GaN. Las recombinaciones radiativas de excitones en QW de InGaN / GaN pueden mejorarse considerablemente mediante QB dopados con Si [1, 2, 3, 4]. Las fluctuaciones de composición del indio (In) y la separación de fases espinodal se producen en la aleación ternaria InGaN debido a la brecha inherente de miscibilidad en fase sólida de GaN e InN. La formación de grupos ricos en In podría actuar como localizaciones de portadores fuertes, previniendo las trampas de los centros de recombinación no radiativa (NRC) y facilitando la recombinación radiativa de excitones en QW de InGaN / GaN [5,6,7,8,9,10]. La fluctuación de la composición de indio en los QW de InGaN / GaN tiene un impacto significativo en el comportamiento de los dispositivos, por ejemplo, la eficiencia cuántica interna (IQE), la eficiencia cuántica externa (EQE) y las características de corriente-voltaje. Debe tenerse en cuenta la fluctuación del indio en los QW de InGaN / GaN para tener una mejor explicación del rendimiento de los dispositivos [11]. Los QW de InGaN / GaN con QB dopados con Si han mostrado las propiedades de las modificaciones de la nanoestructura del material y las formaciones de islas a nanoescala debido al crecimiento en espiral de las capas QW [12], promoción de la estabilidad térmica de los QW de InGaN / GaN [13], mejora de la potencia de salida de luz y los comportamientos de descarga electrostática (ESD) del LED a medida que aumenta la concentración de dopaje en los QB [14], bloqueo fácil del transporte del portador de orificios que conduce a la recombinación de excitones en los pozos entre GaN de tipo p (p-GaN ) y las barreras dopadas [15], etc.
Se informan los períodos favorables y el grosor de los QW de InGaN / GaN para un brillo alto y un EQE alto con una corriente de inyección alta (por encima de varias decenas de mA) de LED azules [16,17,18]. En los informes, nueve períodos de QW de InGaN / GaN cultivados en sustratos de zafiro estampados (PSS) muestran una mejora significativa de la potencia de emisión de luz y las propiedades de caída de EQE [16]. Las mejores prestaciones ópticas y eléctricas de los LED azules se demuestran si la región activa consta de 12 períodos de QW de InGaN / GaN a la corriente de inyección de 42 A / cm 2 [17]. La reducción aparente de la caída de EQE y la mejora de IQE se demuestran para el grosor de QB reducido de 24,5 a 9,1 nm en los resultados de simulación de LED de InGaN / GaN [18]. El dopaje de Si con el grosor adecuado y el número de QB en los QW de InGaN / GaN es crucial para una mayor promoción del brillo y la eficiencia de los LED azules de InGaN que funcionan con una corriente de inyección alta. En este informe, presentamos las características ópticas, eléctricas y del material de In 0.2 de ocho períodos Ga 0.8 QW de N / GaN con los primeros dos a cinco QB en la secuencia de crecimiento que poseen dopaje Si de LED azules. Los resultados brindan una visión más profunda de los mecanismos de localización de portadores, potencial de confinamiento y QCSE de QW en los comportamientos de luminiscencia de los LED azules bajo alta corriente de inyección.
Métodos experimentales
La Figura 1 muestra la ilustración esquemática de las estructuras de capas de material de muestras de LED azules. Las depiladoras se depositan mediante un reactor horizontal de un sistema de deposición de vapor químico metalorgánico a baja presión (LP-MOCVD) en PSS de orientación (0001) (plano c). El diámetro, la altura y el intervalo de las estructuras piramidales regulares en los PSS son 2, 1,5 y 1 μm, respectivamente. Los PSS tienen un grosor de 3 μm y se precalientan a 1150 ° C en un ambiente de hidrógeno antes del crecimiento de las depiladoras. Trimetilgalio (TMGa), trimetilindio (TMIn), trimetilaluminio (TMAl) y NH 3 gaseoso se utilizan como precursores en fase de vapor de galio elemental (Ga), In, aluminio (Al) y nitrógeno (N), respectivamente. Silano (SiH 4 ) y bis-ciclopentadienil magnesio (Cp 2 Mg) son precursores del dopante Si y magnesio (Mg) en las sustancias de tipo n y p, respectivamente. Los gases portadores de precursores son la mezcla de hidrógeno (H 2 ) y nitrógeno (N 2 ) con una proporción de 1:1 que no es químicamente reactivo.
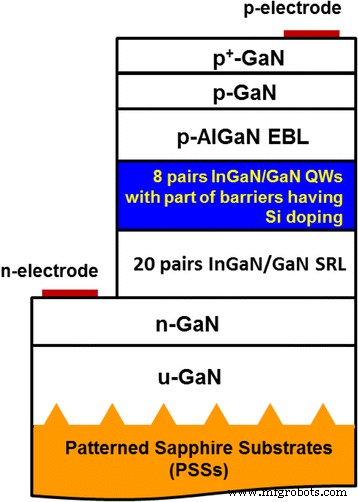
Diagrama esquemático de las estructuras de capas de chips LED azules fabricados. Estos dibujos esquemáticos de espesores de capa epitaxial están exagerados para mayor claridad y no están a escala
La capa tampón de GaN (u-GaN) sin dopar y luego el GaN (n-GaN) de tipo n dopado con Si con un espesor de 3 y 3,3 μm se cultivan sobre PSS. La concentración de dopaje de n-GaN es 10 19 cm −3 . Veinte pares de In 0.02 Ga 0,98 A continuación, se deposita sobre n-GaN una superrejilla de N / GaN con un espesor de 2/2 nm. Desempeña el papel de capas de alivio de tensión (SRL), que se utiliza para reducir la extensión de la tensión de las depiladoras en PSS.
Las capas activas de LED azules contienen In 0.2 de ocho períodos Ga 0.8 QW de N / GaN. Los espesores de QW y QB son de 2,5 y 8 nm con una temperatura de crecimiento de 750 y 900 ° C, respectivamente. Si dopaje con una concentración de alrededor de 3 × 10 17 cm −3 en los primeros dos, tres, cuatro y cinco QB de la secuencia de crecimiento se denominan muestras A, B, C y D, respectivamente. Al de tipo p 0,16 Ga 0,84 La capa de bloqueo de electrones N (EBL) tiene un espesor de 20 nm y se cultiva a 950 ° C con dopaje de Mg. capa de ventana p-GaN y p + -Las capas de contacto de GaN se cultivan a 950 ° C con un espesor de 100 y 20 nm, y las concentraciones de dopaje son 10 19 y 10 20 cm −3 .
Las depiladoras se graban selectivamente en la capa de n-GaN mediante un sistema de plasma acoplado inductivamente (ICP) para formar una estructura de mesa LED. La capa de contacto transparente (TCL) de óxido de indio y estaño (ITO) se deposita sobre el p + -Superficie de GN mediante un evaporador de haz de electrones. Las capas de electrodos de contacto de varios metales de cromo / platino / oro (Cr / Pt / Au) se evaporan posteriormente sobre el p + -Capas de GaN y n-GaN para un buen contacto óhmico. Las obleas LED se lapean y pulen hasta aproximadamente 120 μm para cortar en cubitos. Dispositivos LED estándar tipo mesa con un tamaño de chip cuadrado de 1 mm 2 se producen.
La corriente frente a la tensión ( I - V ) curvas y la potencia de salida de luz ( P fuera ) versus la corriente de inyección ( L - yo ) Se miden las curvas de 20 a 300 mA a temperatura ambiente (RT) de diodos. Espectros de fotoluminiscencia dependiente de la temperatura (PL) de ocho períodos In 0.2 Ga 0.8 Se examinan los QW de N / GaN. La fuente de luz de excitación de PL es un láser de He-Cd (325 nm) con una potencia promedio de 45 mW. Las imágenes de microscopía electrónica de transmisión de alta resolución (HRTEM) se toman de un microscopio electrónico de transmisión de emisión de campo EM-3000F (FE-TEM) con un voltaje de aceleración de 300 kV y una resolución de 0,14 nm.
Resultados y discusión
La Figura 2 traza los espectros PL de muestras a varias temperaturas de 10 a 300 K. Se puede observar la disminución monótona de la intensidad del pico PL con el aumento de temperatura. Esto se origina por el aumento del proceso de recombinación no radiativa con el aumento de temperatura. Todos los perfiles espectrales PL están ajustados por funciones de forma de línea gaussiana para encontrar las variaciones de la energía máxima máxima con la temperatura, como se muestra en la Fig. 3. La energía máxima máxima de emisión de PL para el In 0.2 no dopado Ga 0.8 N / GaN QWs es 2.68 eV a temperatura ambiente. Esto significa que las energías máximas de PL de las muestras con los primeros dos a cinco QB que tienen dopaje con Si exhiben un desplazamiento al azul cuando se compara con el no dopado. Los primeros dos a cinco QB con dopaje Si pueden reducir el QCSE en QW de manera efectiva. Cabe señalar que los usos de PSS y SRL en las estructuras de depiladoras pueden reducir la parte del campo piezoeléctrico (PZ) así como QCSE en In 0.2 Ga 0.8 QW de N / GaN.

Espectros PL dependientes de la temperatura de muestras a varias temperaturas de 10 a 300 K

Variaciones de la energía máxima máxima de PL frente a la temperatura de las muestras. Las curvas que mejor se ajustan usando la ecuación de Varshni se muestran en líneas sólidas gruesas y negras
En la Fig. 3, se pueden mostrar las variaciones de la energía máxima máxima de PL frente a la temperatura que exhiben curvas en forma de S de todas las muestras. Las curvas en forma de S muestran el rojo inicial, luego el azul y luego el rojo con el aumento de temperatura. Este comportamiento se atribuye a la luminiscencia colectiva dependiente de la temperatura de fuertes excitones localizados en QW. La ecuación empírica de Varshni que se muestra a continuación se puede utilizar para ajustar el rango de cambio de azul a rojo de las variaciones en forma de S [19,20,21].
$$ {E} _ {\ mathrm {g}} (T) ={E} _ {\ mathrm {g}} (0) - \ frac {\ alpha {T} ^ 2} {\ left (T- \ beta \ right)} - \ frac {\ sigma ^ 2} {k _ {\ mathrm {B}} T} $$ (1)donde E g (0), α , β y σ son los parámetros de ajuste. E g (0) es la energía de banda prohibida de QW a la temperatura absoluta 0 K. α y β son los coeficientes térmicos que son parámetros dependientes del material. σ es el parámetro de ensanchamiento gaussiano y refleja físicamente el grado de distribución térmica de los portadores dentro de los estados localizados en la cola de la banda. El segundo término de la ecuación. (1) indica que la energía de la brecha de banda de los semiconductores tiende a disminuir al aumentar la temperatura y se conoce como contracción de la brecha de energía debido al aumento de la amplitud de las vibraciones atómicas. El tercer término se utiliza para caracterizar el grado de localización de la portadora con la temperatura bajo el supuesto de una distribución de portadora no degenerada y una densidad de estado localizada similar a la de Gauss. La localización de portadora fuerte es un aspecto crucial para lograr el aumento de la recombinación radiativa y el IQE en los QW de InGaN debido a la mejora de la superposición entre las funciones de onda de electrones y huecos. La ecuación de Varshni no es aplicable en el rango de desplazamiento al rojo de la energía pico PL a baja temperatura, debido a la fuerte degeneración en la distribución de portadores. Los mejores resultados de ajuste de las muestras se ilustran en curvas sólidas gruesas y negras en la Fig. 3. La energía de localización de las muestras A, B, C y D es 24, 28, 41 y 13 meV, respectivamente. La muestra C posee la mayor energía de localización, σ (41 meV). La localización del operador en los QW con cuatro QB dopados con Si es más fuerte que en los demás. La energía de localización más pequeña ( σ ) ocurre en la muestra D con el valor 13 meV.
Corriente-voltaje ( I - V ) Las características bajo polarización directa e inversa de los LED azules se muestran en la Fig. 4. En esta figura, los voltajes de encendido para las muestras A, B, C y D son 3.41, 3.47, 3.27 y 4.03 V en la corriente directa 20 mA, respectivamente. Los voltajes de ruptura para las muestras A, B, C y D son - 8.85, - 9.99, - 6.77 y - 11.55 V a la corriente inversa 1 μA, respectivamente. La muestra C tiene los voltajes de ruptura y encendido más pequeños. La muestra D tiene los voltajes de ruptura y encendido más grandes. Por consiguiente, en la muestra C se sugiere una altura de barrera más baja de los QB. Se espera un potencial de confinamiento suave (suave) de los QW en la muestra con los primeros cuatro QB que tienen dopaje con Si. El perfil de potencial de confinamiento suave implica que los desplazamientos de banda de valencia y conducción de los QW no se toman como funciones escalonadas, es decir, no como potencial de confinamiento rectangular. Los potenciales de confinamiento suaves pueden suprimir la recombinación Auger en gran medida y prevenir la acumulación de portadores abundantes en los primeros pozos en la dirección de inyección de QW de InGaN / GaN [22,23,24]. También se puede lograr un potencial de confinamiento uniforme mediante una disminución lineal de la composición de In a lo largo de la dirección de crecimiento de los QW de InGaN / GaN. Esto puede tener una mejor distribución de los portadores entre los QW y el transporte de orificios, lo que da como resultado una mejora de la caída rápida de EQE y la potencia de salida de luz [25,26,27,28,29,30].
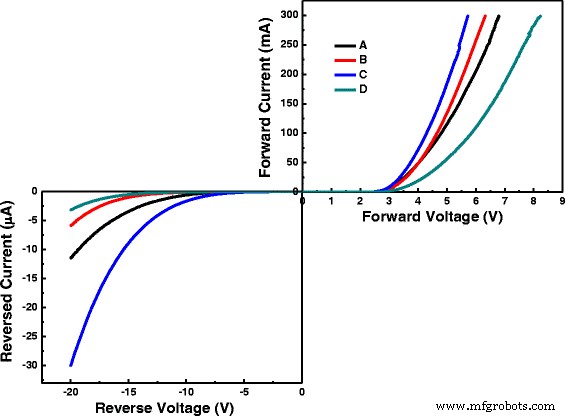
Corriente-voltaje ( I - V ) curvas bajo polarizaciones directas e inversas de diodos
La Figura 5 muestra las medidas de la potencia de salida de luz ( P fuera ) de LED frente a la corriente de inyección ( L - yo ) curva de 0 a 300 mA mediante un probador de chips. El aumento de la P fuera con el aumento de la corriente de inyección de L - yo se pueden observar curvas. La P más alta y la más baja fuera para alta corriente de inyección se muestran en las muestras C y D, respectivamente. Saturaciones de P fuera a la corriente de inyección se muestran 300 mA en todas las muestras excepto en la muestra C.Efecto de saturación de P fuera Se refiere a la corriente desbordando los QWs. El menor desbordamiento de corriente de los QW tiene lugar en el potencial de confinamiento suave de los QW y en la fuerte localización de portadoras dentro de la muestra de QW. Una mejor distribución de los portadores entre ocho QW y una fuerte recombinación radiativa de los portadores dentro de los QW se muestran en la muestra con cuatro QB que contienen dopaje con Si.

Potencia de salida de luz ( P fuera ) versus la corriente de inyección ( L - yo ) curvas de 0 a 300 mA de diodos
Las imágenes de campo oscuro, campo claro y campo claro agrandado del microscopio electrónico de transmisión de alta resolución de sección transversal (HRTEM) de muestras se muestran en las Figs. 6, 7 y 8. En la Fig. 6, los contrastes brillantes y oscuros corresponden a las depiladoras de InGaN y GaN. Se pueden observar ocho períodos de QW y 20 pares de superredes. En la Fig. 7, las variaciones de contraste oscuro representan las fluctuaciones del contenido local de In y la formación de grupos ricos en indio en los QW [31,32,33,34]. Los grupos ricos en indio actúan como estados localizados relativamente profundos de portadores que conducen a una alta recombinación excitónica radiativa. La distorsión de la celosía y los defectos de apilamiento se observan alrededor de estos grupos ricos en indio, lo que indica que la energía de deformación se relajó parcialmente en la capa de InGaN como se muestra en la imagen ampliada del cuadrado rojo en la Fig. 8a. En comparación con las imágenes ampliadas de campo claro, se ven interfaces más difusivas (no abruptas) de QW en las muestras C y D, como se muestra en la Fig. 8c, d. El agente proviene de la conocida interdifusión de átomos de In y Ga en la interfaz pozo / barrera. En la muestra D se produjo un confinamiento y una localización de portadores muy débiles de los QW, que concuerda con el peor comportamiento optoelectrónico de esta muestra. En las imágenes, las dislocaciones de subprocesamiento (TD) no se forman en todas las muestras. Los NRC ocurren principalmente en sitios TD. En estas muestras se muestra una mejor calidad de las depiladoras como se esperaba debido al empleo de PSS y SRL [35,36,37]. Cuatro QB con dopaje de Si en QW de ocho períodos son la condición favorable para modificar el potencial de confinamiento para lograr el potencial de confinamiento suave de los QW de InGaN / GaN, lo que lleva al mejor rendimiento optoelectrónico del LED azul.
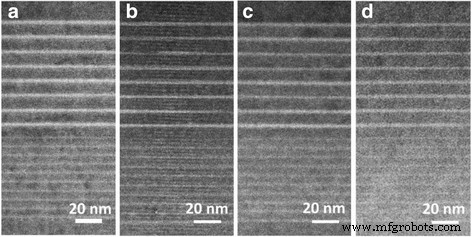
Imágenes de campo oscuro de las muestras. un Muestra A. b Muestra B. c Muestra C. d Muestra D
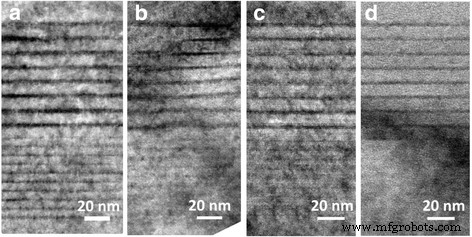
Imágenes de campo brillante de las muestras. un Muestra A. b Muestra B. c Muestra C. d Muestra D
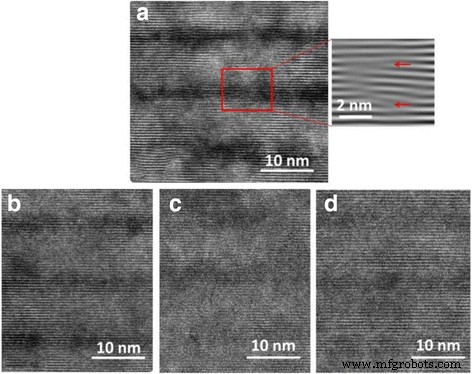
Imágenes ampliadas de campo claro de las muestras. un Muestra A. b Muestra B. c Muestra C. d Muestra D
Conclusiones
Espectros PL dependientes de la temperatura, I - V curvas, L - yo curvas e imágenes HRTEM de LED azules con In 0.2 de ocho períodos Ga 0.8 Se investigaron los QW de N / GaN que tienen los primeros dos a cinco QB en la secuencia de deposición que contienen dopaje con Si. Los resultados demuestran que la muestra con los primeros cuatro QB que contienen dopaje de Si tiene una altura de barrera relativamente más baja y una mayor energía de localización de los portadores, lo que se evidencia por las interfaces difusivas de los QW en las imágenes HRTEM. El potencial de confinamiento suave de los QW acompañado de una localización más fuerte del portador dentro de los QW da lugar a una distribución más uniforme del portador entre ocho QW y una mayor recombinación radiativa de los portadores dentro de los QW en esta muestra. Se produjo una disminución de los procesos Auger y la fuga de portadores, así como un aumento de la recombinación radiativa de QW en los LED azules con cuatro QB dopados con Si bajo alta corriente de inyección. Los resultados proporcionan condiciones óptimas de QB con dopaje de Si a través del análisis de los efectos de la localización del portador, el potencial de confinamiento, el campo PZ y las nanoestructuras de materiales sobre las propiedades de luminiscencia de In 0.2 Ga 0.8 N / GaN QW de LED azules.
Abreviaturas
- Al:
-
Aluminio
- Cp 2 Mg:
-
Bis-ciclopentadienil magnesio
- EBL:
-
Capa de bloqueo de electrones
- EQE:
-
Eficiencia cuántica externa
- FE-TEM:
-
Microscopio electrónico de transmisión de emisión de campo
- Ga:
-
Galio
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- ICP:
-
Plasma acoplado inductivamente
- En:
-
Indio
- IQE:
-
Eficiencia cuántica interna
- ITO:
-
Óxido de indio y estaño
- I - V :
-
Corriente versus voltaje
- L - yo :
-
Potencia de salida de luz frente a corriente de inyección
- LP-MOCVD:
-
Deposición de vapor químico metalorgánico a baja presión
- Mg:
-
Magnesio
- N:
-
Nitrógeno
- n-GaN:
-
GaN de tipo n
- NRC:
-
Centros de recombinación no radiativa
- PL:
-
Fotoluminiscencia
- PSS:
-
Sustratos de zafiro estampados
- PZ:
-
Piezoeléctrico
- QB:
-
Barreras cuánticas
- QCSE:
-
Efecto Stark confinado cuántico
- QW:
-
Pozos cuánticos
- RT:
-
Temperatura ambiente
- Si:
-
Silicio
- SiH 4 :
-
Silano
- SRL:
-
Capas de alivio de tensión
- TCL:
-
Capa de contacto transparente
- TMAl:
-
Trimetilaluminio
- TMGa:
-
Trimetilgalio
- TMIn:
-
Trimetilindio
- u-GaN:
-
GaN sin doblar
Nanomateriales
- 5G y GaN:el cambio de LDMOS a GaN
- El reordenamiento atómico de múltiples pozos cuánticos basados en GaN en gas mixto H2 / NH3 para mejorar las propiedades estructurales y ópticas
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- Emisión multicolor de una estructura de nanopiramida cuasicristalina fotónica ultravioleta basada en GaN con múltiples pozos cuánticos semipolares InxGa1 − xN / GaN
- Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Romper el ancho del canal Multi-Mesa limitado de los HEMT de GaN normalmente desactivados mediante la modulación de la longitud del orificio de vía
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente
- Preparación de una matriz periódica de nanoesferas de poliestireno utilizando el método de inmersión con grabado posterior a la deposición y su aplicación para mejorar la eficiencia de extracció…
- Fotodetector ultravioleta de alto rendimiento basado en puntos cuánticos de grafeno decorados Nanorods de ZnO / Heterojunciones de isotipo de película de GaN



