Romper el ancho del canal Multi-Mesa limitado de los HEMT de GaN normalmente desactivados mediante la modulación de la longitud del orificio de vía
Resumen
Presentamos nuevos transistores de alta movilidad de electrones (HEMT) normalmente fuera de GaN que superan las limitaciones típicas en el ancho del canal multi-mesa (MMC) a través de la modulación de la longitud del orificio de paso para regular el efecto de pantalla de neutralidad de carga. Hemos preparado GaN HEMT en modo de mejora (modo E) con anchos de hasta 300 nm, basados en un efecto de fijación de superficie mejorado. Los HEMT de GaN en modo E que tienen estructuras y anchos de MMC, así como longitudes de orificios de paso de 100 nm / 2 μm y 300 nm / 6 μm, respectivamente, exhibieron voltajes de umbral positivos ( V th ) de 0,79 y 0,46 V, respectivamente. Las resistencias de las MMC y las estructuras de longitud de orificio de paso fueron más bajas que las de los HEMT de GaN de nanocintas de tres puertas típicas. Además, los dispositivos no solo lograron el modo E, sino que también mejoraron el rendimiento energético de los HEMT de GaN y mitigaron eficazmente el efecto térmico del dispositivo. Controlamos el efecto de fijación de la superficie de la pared lateral de la longitud del orificio de paso para obtener los HEMT de GaN en modo E. Nuestros hallazgos sugieren que la longitud del orificio de paso normalmente fuera de GaN HEMT tiene un gran potencial para su uso en la electrónica de potencia de próxima generación.
Antecedentes
Los nitruros de banda ancha III-V son materiales semiconductores prometedores para la operación de frecuencia y voltaje debido a sus excelentes propiedades de material, que incluyen grandes espacios de banda, campos eléctricos críticos, velocidades de electrones de alta saturación y conductividades elevadas [1, 2]. En consecuencia, se utilizan ampliamente en diversas aplicaciones, incluidos los diodos emisores de luz (LED) y los transistores [3]. Además, las heteroestructuras de nitruro de aluminio galio / nitruro de galio (AlGaN / GaN) forman gases de electrones bidimensionales (2DEG) adecuados para el desarrollo de dispositivos de alto rendimiento, aprovechando la polarización espontánea y piezoeléctrica de los compuestos de nitruro III [4,5 , 6]. La cantidad de 2DEG está influenciada por la proporción de dopaje inducido por polarización, que afecta directamente a las características del dispositivo [7,8,9]. Aunque tienen muchas propiedades atractivas, los transistores de alta movilidad de electrones (HEMT) AlGaN / GaN no han encontrado utilidad universal porque sus características electrónicas pueden requerir configuraciones de circuito complejas para aplicaciones de circuitos digitales, de potencia, RF y de microondas. En consecuencia, el funcionamiento normalmente apagado sería esencial para cualquier dispositivo semiconductor III-V futuro [10, 11]. Aunque se han probado algunas técnicas especiales de fabricación (p. Ej., Uso de puertas empotradas [12,13,14], inserción de capas de recubrimiento tipo p debajo de la puerta [15, 16], estructuras de unión de túnel [17], implantación de iones de fluoruro en la barrera debajo de la compuerta [18], y la inclusión de capas delgadas de barrera de AlGaN con una compuerta de metal especial y un tratamiento de recocido térmico rápido (RTA) [19]), pueden empeorar el rendimiento del dispositivo y causar problemas de estabilidad a través de daños materiales inducidos por el procesamiento y aumento de los efectos del campo térmico y eléctrico.
Alternativamente, un equipo de la Universidad de Hokkaido descubrió que los HEMT de AlGaN / GaN fabricados con nanocanales de aletas mostraban un cambio en el voltaje umbral ( V th ) en sentido positivo [20, 21]. Un grupo de la Universidad de Soochow informó que el valor de V th experimentó un cambio positivo sistemático cuando el ancho del nanocanal era inferior a 90 nm [22]. Los investigadores de la Universidad Nacional de Kyungpook consideraron la relajación de la tensión parcial de los lados de los canales para explicar el comportamiento [23]. Un equipo del Instituto de Tecnología de Massachusetts simuló el voltaje umbral después de la pasivación de la superficie de los HEMT basados en GaN y determinó que se producían valores positivos cuando el ancho del canal era inferior a 100 nm [24], como resultado de los efectos de las paredes laterales y el aumento de la tensión de tracción. que disminuyó la concentración de electrones en el canal. Las estructuras en forma de aleta no solo cambian el voltaje de umbral, sino que también mejoran la capacidad de control de la puerta, debido a la estructura 3-D, que induce un rendimiento en estado activado al tiempo que mejora las características del estado desactivado. La corriente de drenaje máxima normalizada ( I D / mm) en un HEMT de AlGaN / GaN que tiene una estructura en forma de aleta es más alto que en una estructura plana correspondiente [25]. Aunque estos métodos se han utilizado para fabricar HEMT en modo E, sigue siendo un gran desafío desarrollar transistores de potencia de GaN de alto rendimiento normalmente. En primer lugar, la combinación de una baja resistencia ( R en ) y se debe lograr una potencia total baja del dispositivo cuando el ancho del canal está limitado a menos de 100 nm. Aunque el valor de R en del canal puede reducirse reduciendo la longitud de la puerta normalmente cerrada, controlar la corriente de fuga de drenaje en estado desactivado plantea otro desafío porque el ancho de la puerta influye en la transconductancia y la fuga de la puerta a través de la dispersión del campo de coulomb de polarización y las rutas de fuga de la puerta [26, 27 ]. Las películas depositadas se pueden utilizar como dieléctricos de puerta para mejorar estos problemas [28].
En esta carta, describimos un gran avance en la limitación de ancho de los canales de triple puerta y proponemos un método para modular la longitud del orificio de paso de los canales. Nuestro dispositivo logró el modo E con un ancho de estructura MMC de 300 nm y una longitud de orificio de paso de 6 μm y exhibió un voltaje de umbral de 0.46 V. Este enfoque no solo disminuyó la resistencia de encendido del dispositivo ( R en ) pero también podría mitigar el efecto de calentamiento Joule. Al combinar una triple puerta 3-D con varios anchos de canal y longitudes de orificio de paso, logramos que normalmente los HEMT de GaN tengan valores positivos de V th de 0,79 y 0,46 V cuando los anchos de canal / longitudes de orificios de paso eran 100 nm / 2 μm y 300 nm / 6 μm, respectivamente.
Métodos
La oblea epi de AlGaN / GaN se cultivó en un sustrato de zafiro (0001) utilizando un sistema de deposición de vapor químico orgánico metálico Nippon Sanso SR-2000 (MOCVD). El crecimiento de la estructura epitaxial comenzó con una capa de nucleación de GaN depositada a 600 ° C. A continuación, se depositaron a 1180 ° C una capa tampón de GaN dopada involuntariamente de 2 μm de espesor, una capa de barrera de AlGaN dopada no intencionalmente de 21,8 nm de espesor con una composición nominal de aluminio del 23% y una capa superior de GaN de 2 nm de espesor. El procesamiento del dispositivo se inició utilizando un sistema de grabado de iones reactivos (RIE) de plasma acoplado inductivamente (ICP) con un BCl 3 / Cl 2 mezcla de gas para aislar una mesa de 130 nm de profundidad y grabar una estructura de trinchera periódica. Posteriormente, se aplicaron dos procesos para restaurar las facetas cristalinas de la región del receso y las paredes laterales de la mesa y disminuir los niveles de defectos superficiales y daños por bombardeo iónico. El primero involucró el uso de KOH fundido para el grabado químico húmedo cristalográfico para eliminar el daño superficial inducido por el grabado en seco y simultáneamente producir paredes laterales verticales lisas; el segundo implicó aplicar una solución de piraña (una mezcla de H 2 SO 4 y H 2 O 2 ) para la limpieza de superficies y eliminación de residuos orgánicos. Se aplicó fotolitografía convencional con una lámpara de mercurio para definir el drenaje, la fuente, la puerta y las almohadillas de contacto para las mediciones de CC. Los contactos óhmicos a la heterounión AlGaN / GaN, compuesta de titanio / aluminio / níquel / oro (Ti / Al / Ni / Au, 30/120/20/80 nm), se depositaron en las regiones de drenaje / fuente mediante evaporación por haz de electrones y recocido a 850 ° C durante 30 s al vacío. Para completar el canal del transistor, se fabricó un electrodo de puerta mediante evaporación por haz de electrones de Ni / Au (20/80 nm). La Figura 1 proporciona representaciones esquemáticas de la sección transversal de la estructura HEMT, una vista superior del dispositivo y un diagrama estructural en 3D del dispositivo. La longitud de la puerta ( L g ), Ancho de estructura MMC ( W MMC ), Estructura MMC vía-agujero-longitud ( L MMC ) y la altura de la estructura MMC ( H MMC ) fueron de 2 μm, 100-500 nm, 1-6 μm y 130 nm, respectivamente. Las aletas se conectaron en paralelo. Para mejorar el efecto de fijación de la superficie, la estructura de longitud de orificio pasante de GaN HEMT no se sometió a pasivación. La Figura 2a presenta una imagen de microscopía electrónica de barrido (SEM) de vista superior de la superficie metálica en la región de fuente y drenaje. La imagen de microscopía óptica (OM) en la Fig. 2b revela puertas y canales completos; Observar cuántos canales existían en el dispositivo fue útil al calcular la corriente real. La superficie parecía rugosa en la imagen porque, después del recocido, los átomos migraron en la red cristalina y el número de dislocaciones disminuyó, disminuyendo efectivamente la resistencia. La imagen SEM en la Fig. 2c confirmó las dimensiones del canal.
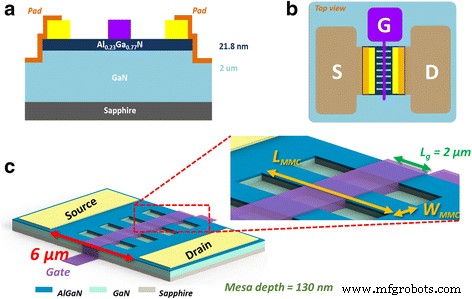
Representaciones esquemáticas de a la sección transversal de la estructura HEMT, vista desde una dirección paralela al canal del transistor; b la vista superior de la estructura HEMT; y c la estructura 3-D del HEMT
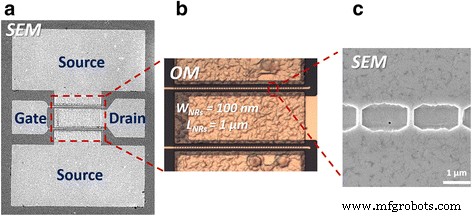
un Imagen SEM de vista superior del dispositivo; b imagen OM de vista superior del dispositivo, que revela un ancho y una longitud de canal de 100 nm y 1 μm, respectivamente; y c imagen SEM de vista superior del canal
Resultados y discusión
Hasta la fecha, la mayoría de los desarrollos tecnológicos en los transistores de alto voltaje de GaN se han basado en AlGaN / GaN HEMT, que son dispositivos intrínsecamente en modo de agotamiento (modo D) debido al gas de electrones 2-D inducido por polarización en la interfaz AlGaN-GaN [29]. No obstante, se necesitarán transistores de GaN normalmente desactivados si la industria de la electrónica de potencia ha de adoptar ampliamente las tecnologías de GaN.
El número de enlaces colgantes en una superficie de (Al) GaN es aproximadamente 10 15 cm −2 ; estas uniones colgantes inducen una flexión de la banda empobrecida en la superficie como resultado de un efecto de fijación de la superficie. La Figura 3a muestra las áreas con la superficie agotada del canal lateral de las puertas de las paredes laterales en la estructura de tres puertas. Investigadores de la Universidad Nacional de Kyungpook informaron de un fenómeno similar [21]. La figura 3b presenta la I DS - V G características de transferencia de dispositivos que tienen un valor fijo de L MMC de 2 μm y valores de W MMC de 100, 300 y 500 nm. Cuando el voltaje de drenaje a fuente era de 8 V, los valores de V th de estos dispositivos fueron +0,79, −1,32 y −2,18 V, respectivamente. Por lo tanto, se produjo un cambio positivo en el voltaje umbral cuando los canales se hicieron más estrechos. Este fenómeno puede haberse debido al agotamiento del canal lateral y al clavado de la superficie de la longitud del orificio de 2 μm desde la pared lateral en la estructura de la longitud del orificio de la MMC a través de los efectos del agotamiento del canal lateral y la flexión de la superficie de la longitud del orificio de la vía. .

un Representación esquemática de HEMT de AlGaN / GaN que tienen canales anchos y estrechos. b yo DS - V G características de transferencia medidas para un dispositivo que tiene un valor de L MMC de 2 μm y varios valores de W MMC
La Figura 4 muestra el I DS –V G características de transferencia de dispositivos que tienen un valor fijo de W MMC de 300 nm y valores de L MMC de 1, 2 y 6 μm. Cuando el voltaje de drenaje a fuente era de 8 V, los valores de V th fueron −2,12, −1,07 y +0,46 V, respectivamente. El dispositivo logró un funcionamiento normalmente apagado cuando la longitud y el ancho de la MMC eran de 6 μm y 300 nm, respectivamente. Modular la longitud del orificio de paso y el ancho del canal puede proporcionar un dispositivo que muestra un funcionamiento normalmente apagado. La Tabla 1 enumera los voltajes de umbral medidos para varias longitudes de orificios de paso y anchos de canales de múltiples mesas. Cuando el ancho del canal se fijó en 500 nm y la longitud del orificio de paso aumentó de 0,8 a 6 μm, el valor de V th aumentó de -2,62 a -1,62 V, la corriente de drenaje de saturación disminuyó de 747 a 98 mA / mm y la transconductancia disminuyó de 270 a 40 mS / mm. Cuando el ancho del canal se fijó en 300 nm y la longitud del orificio de paso aumentó de 0,8 a 6 μm, el valor de V th aumentó de -2,15 a +0,46 V, la corriente de drenaje de saturación disminuyó de 685 a 6,8 mA / mm y la transconductancia disminuyó de 290 a 7,4 mS / mm. Cuando el ancho del canal se fijó en 100 nm y la longitud del orificio de paso aumentó de 0,8 a 2 μm, el valor de V th aumentó de −0,41 a +0,79 V, la corriente de drenaje de saturación disminuyó de 547 a 53 mA / mm y la transconductancia disminuyó de 400 a 67 mS / mm. La capacidad de manejo de corriente del HEMT se ve fuertemente afectada por las concentraciones de portadores [20, 21]. En consecuencia, las corrientes de drenaje de saturación y las transconductancias de los dispositivos se vieron fuertemente afectadas por los estados de la superficie total de la pared lateral y el efecto de superficie agotada del canal de triple compuerta al variar los anchos y longitudes de los orificios de paso de los HEMT de GaN. En comparación con los dispositivos informados anteriormente [23], nuestro dispositivo ha alcanzado un nuevo hito en cuanto a baja resistencia, normalmente sin GaN HEMT.

yo DS - V G características de transferencia de dispositivos que tienen un valor fijo de W MMC de 300 nm y varios valores de L MMC
Conclusiones
Hemos preparado HEMT de GaN en modo E que tienen una estructura de canal multi-mesa (MMC); exhibieron un voltaje de umbral positivo de 0,46 V cuando el ancho del canal y la longitud del orificio de paso eran 300 nm y 6 μm, respectivamente. Inferimos que los efectos tanto del agotamiento del canal lateral como de la flexión de la superficie de la longitud del orificio de paso. Cuando se contenía una puerta triple que tenía una estructura de longitud de orificio de paso de MMC, los nuevos HEMT de GaN normalmente desactivados exhibían una resistencia de activación muy baja, incluso cuando se aumentaba el ancho de la estructura de MMC a 300 nm (anteriormente limitado a menos de 100 nm). Además, la modulación de la estructura MMC de la longitud del orificio de paso se proporciona normalmente a partir de los HEMT de GaN, lo que mejora el rendimiento de potencia excelente, como resultado del aumento del ancho del dispositivo de la estructura MMC.
Nanomateriales
- Mangos soldables frente a tiradores pasantes:¿Cuál es la diferencia?
- Rompiendo la anatomía de un tornillo
- Modulación de ancho de pulso
- El código abierto y el IoT:innovación mediante la colaboración
- Construyendo un camino a través del laberinto de seguridad de IoT
- 5G y GaN:el cambio de LDMOS a GaN
- Rompiendo el ciclo de la deuda tecnológica de la cadena de suministro
- Transformación del proceso de adquisición mediante robótica
- Protocalabazas a través de los años
- Secadores de aire refrigerados:información básica
- Desglosando los conceptos básicos de la fabricación de conductos



