Placa de microcanales de alta sensibilidad y larga duración procesada por deposición de capa atómica
Resumen
Como componente clave del dispositivo multiplicador de electrones, una placa de microcanal (MCP) se puede aplicar en muchos campos científicos. Óxido de aluminio puro (Al 2 O 3 ) como capa de emisión de electrones secundarios (SEE) se depositaron en los poros de MCP a través de la deposición de capa atómica (ALD) para superar problemas como la alta corriente oscura y la baja vida útil que a menudo ocurren en el MCP tradicional. En este artículo, investigamos sistemáticamente la morfología, la distribución de elementos y la estructura de las muestras mediante microscopía electrónica de barrido (SEM) y espectroscopía de energía dispersa (EDS), respectivamente. Corriente de salida de diferente espesor de Al 2 O 3 se estudió y se encontró un espesor óptimo. Las pruebas experimentales muestran que la ganancia promedio de ALD-MCP fue casi cinco veces mejor que la del MCP tradicional, y el ALD-MCP mostró una mejor sensibilidad y una vida útil más larga.
Introducción
La placa de microcanal (MCP) es un multiplicador de electrones compacto de alta ganancia [1, 2, 3]. Es un componente clave en MCP-PMT, dispositivos de visión nocturna, microscopía electrónica, cámara de encuadre de rayos X, etc. [4, 5, 6, 7]. Se ha utilizado en una gama más amplia de aplicaciones de detección de partículas y fotones, como iones, electrones, neutrones, rayos X y rayos UV [8,9,10,11]. La placa de microcanal es una matriz bidimensional delgada compuesta por varios millones de poros de vidrio conductor ultrafinos de 4 a 25 μm de diámetro y de 0,2 a 1,2 mm de longitud. MPC tiene tres características de estructura principales:ángulo de polarización, relación entre la longitud del canal y el diámetro del canal y la relación del área abierta (relación entre el área abierta total y el área efectiva completa). En general, el ángulo de polarización varía de 5 a 15 °. La relación entre la longitud del canal y el diámetro del canal es de aproximadamente 20:1 a 100:1 y la relación de área abierta de aproximadamente 60 a 80%. El MCP tradicional está hecho de vidrio de silicato de plomo y se fabrica mediante estirado, apilado, fusión, corte, grabado y reducción de hidrógeno. Después del procesamiento químico de reducción de hidrógeno, la capa conductora y la capa de emisión secundaria de electrones (SEE) se generan en el poro. Cuando un electrón o radiación ingresa a un canal, los electrones secundarios se emiten desde la capa SEE y esos electrones son acelerados por un campo eléctrico desarrollado por un voltaje V D aplicado sobre la capa conductora. Finalmente, se produjeron más electrones secundarios de esta manera y se realizó la amplificación de electrones. Aunque el MCP tradicional se ha utilizado ampliamente en muchos campos, existen varios inconvenientes [12]. En primer lugar, el grabado químico de alto ruido aumenta Ra en la superficie interna del poro, el factor de ruido aumenta y la S / N se reduce cuando se multiplican los fotoelectrones. En segundo lugar, el horneado al vacío y el lavado de electrones dan como resultado la variación del elemento de superficie de MCP y reducen la carga extraída y la ganancia de MCP. En tercer lugar, la resistencia eléctrica y las propiedades de emisión de electrones secundarios no se pueden ajustar de forma independiente. Debido a que las causas de los inconvenientes son diferentes y el proceso de producción del MCP tradicional es complejo, es difícil superar todas las desventajas al mismo tiempo ajustando los parámetros del proceso.
A medida que la tecnología de deposición de capa atómica (ALD) se aplica en más y más áreas de investigación [13,14,15,16,17], algunos investigadores propusieron una capa conductora depositada y una capa SEE dentro de los canales para optimizar el rendimiento del MCP tradicional [18, 19,20,21,22,23]. ALD es una técnica de deposición de película delgada en la que se hace crecer una película sobre un sustrato al exponer su superficie a especies gaseosas alternas. La ALD se considera un método de deposición con gran potencial para producir películas conformadas muy delgadas con control del espesor y la composición de las películas posibles a nivel atómico [24, 25].
Existen muchas ventajas al aplicar la tecnología ALD en el posprocesamiento de MCP. Dióxido de silicio (SiO 2 ) es el principal material de emisión de electrones secundarios en el MCP tradicional [26] y tiene un bajo rendimiento de electrones secundarios (SEY). Si depositamos un material de alto SEE en la pared del canal, la ganancia de MCP podría mejorarse. Debido al proceso de grabado, las superficies de los canales internos del MCP tradicional mantienen una mayor rugosidad superficial y tienen muchos orificios a nanoescala. Los agujeros a nanoescala absorben gases y otros contaminantes que son difíciles de limpiar. Cuando se acelera, los electrones chocan con absorbentes, que son ionizados y acelerados por el campo eléctrico. Los iones acelerados ionizan cada vez más absorbentes y consumen un electrón extra del MCP. Debido a que la vida útil del MCP se decide por la cantidad total de carga eléctrica, la existencia de absorbentes conduce a una vida útil más corta. Mientras tanto, el proceso de lavado eléctrico es necesario para garantizar un alto vacío. Más absorbentes necesitan más tiempo de lavado eléctrico y cuestan más carga eléctrica, lo que reduce aún más la vida útil del MCP. Si depositamos material SEE de varios nanómetros de alto en la superficie del canal interno, se podrían rellenar partes de los orificios a nanoescala para mejorar la rugosidad de la superficie y luego tener una vida útil más larga.
En este artículo, Al 2 O 3 El material SEE se preparó mediante la técnica ALD en los poros de MCP con 15 mm de longitud de lado. Se investigaron sistemáticamente la morfología, la distribución de elementos, la estructura de la película delgada de óxido depositado con ALD y el rendimiento de ALD-MCP.
Métodos experimentales y de cálculo
El esquema de la configuración del experimento se muestra en la Fig. 1. El sistema consta de cátodo de oro, MCP y ánodo de PCB y se coloca en una cámara de vacío evacuada a 2 × 10 −4 Pa. Los voltajes para todos los electrodos se suministran mediante una fuente de alimentación multicanal de alto voltaje y se alimentan a la cámara de vacío mediante alimentadores de alto voltaje. Hay un picoamperímetro entre el ánodo de la PCB y el suelo para medir la corriente de salida del MCP. Una lámpara de mercurio atenuada actúa como fuente de luz ultravioleta cuando medimos la corriente de salida del MCP. La lámpara de mercurio sin atenuación sirve como fuente de luz ultravioleta cuando aceleramos la prueba de vida de la placa de microcanal.
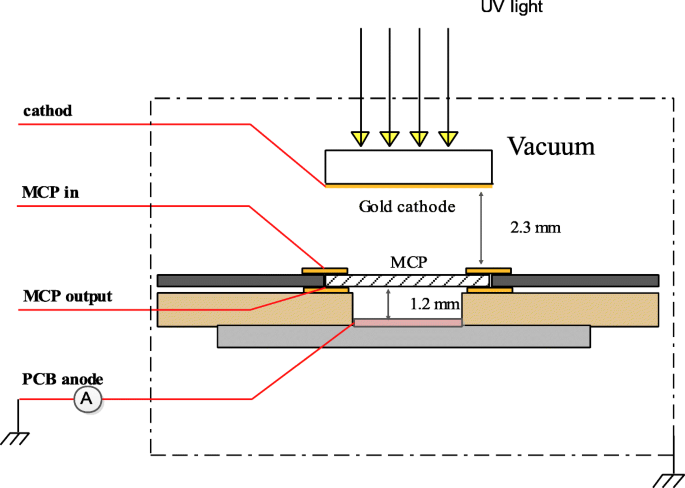
El esquema de la configuración del experimento
Se utilizó un sistema comercial de deposición de capa atómica de pared caliente para preparar películas delgadas de nano-óxido sobre la superficie del canal interno de MCP (como se muestra en la Fig. 2) y silicio. Las muestras depositadas sobre silicio se utilizan para medir el rendimiento de las emisiones secundarias. Los sustratos de silicio pulido se limpiaron ultrasónicamente en acetona / etanol / ácido fluorhídrico / agua DI y luego se colocaron en una cámara de ALD esperando su deposición. Los MCP desnudos (espesor =1,2 mm, tamaño de poro =24 μm, relación de aspecto =40, ángulo de polarización =10 °) se calentaron a 200 ° C durante 1 h para hacer crecer películas delgadas de nanoóxidos. Según el documento [27, 28], es más difícil controlar el grosor y la composición de los materiales en MCP que en un sustrato plano. Se adoptaron dos enfoques para hacer que el espesor y la composición, en la medida de lo posible, se distribuyeran uniformemente en los poros de MCP. Uno es la extensión de precursores para cada ciclo de ALD (muestra F). El otro está utilizando un modelo de flujo de detención (muestra G), cuyos precursores pulsos ingresan y se difunden en la cámara de pared caliente durante varios segundos, luego se bombean y purgan con gas portador.
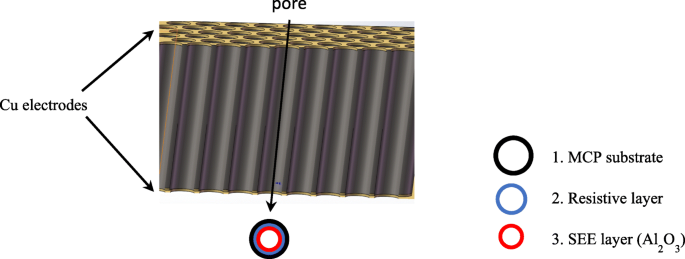
Diagrama esquemático de la estructura de ALD-MCP
Para la deposición de la segunda capa de emisión de electrones secundarios, Al 2 O 3 se realizó utilizando TMA y agua desionizada como Al y precursor oxidante, respectivamente. Se utilizó nitrógeno de ultra alta pureza como gas portador y de purga. El Al 2 O 3 La ALD se realizó usando TMA y H 2 separados O exposición con secuencia TMA / N 2 / H 2 O / N 2 (0.05 / 10 / 0.05 / 10s). El MCP cuadrado con 15 mm de longitud de lado recubierto de aproximadamente 4 nm (muestra B), 6 nm (muestra C), 8 nm (muestras D y H), 10 nm (muestra E) y 60 nm Al 2 O 3 (muestra F). La muestra G se realizó utilizando TMA y H 2 separados O exposición con secuencia TMA / Stop / N 2 / H 2 O / Stop / N 2 (0.05 / 3/20 / 0.05 / 3 / 20s) por 600 períodos. Un MCP circular (50 mm de diámetro) se dividió en dos partes; una parte se desnudó y la otra parte se cubrió con dos piezas de oblea de silicio semicircular, para obtener un MCP que es mitad con proceso ALD y mitad sin procesar. Los detalles de los parámetros experimentales se enumeran en la Tabla 1. Las superficies de las muestras de MCP se examinaron mediante microscopía electrónica de barrido (SEM). La composición elemental de la película se midió mediante el método SEM transversal (EDS). Después de la funcionalización ALD, la capa de cobre con 200 nm como electrodos se preparó en ambos lados del MCP mediante un sistema de evaporación para la caracterización eléctrica del MCP y las pruebas de vida.
Resultados y discusión
Como se muestra en la Fig. 1, el principio de la prueba de ganancia de MCP se muestra a continuación. El fotón ultravioleta llega al cátodo de oro y se convierte en fotoelectrón por efecto fotoeléctrico. El fotoelectrón se acelera por el voltaje entre el cátodo y la MCPin y obtiene una energía de electrones primarios. Luego, fotoelectrón con energía de electrones primarios amplificada por MCP y nubes de electrones de salida al ánodo de PCB. Por último, los electrones fluyen al suelo y la corriente de salida se midió con un picoamperímetro. La corriente de salida de MCP está ordenada por voltajes de polarización entre diferentes electrodos. Para determinar los voltajes para cada electrodo, se ensambló la muestra A y el voltaje entre MCPin y MCPout se estableció en un valor fijo; luego, cambie los voltajes del cátodo y el ánodo para obtener un valor óptimo.
La corriente de salida de MCP como función de la energía del fotoelectrón (la energía del electrón primario antes de entrar en MCPin) se muestra en la Fig.3 cuando el ajuste de voltaje de polarización para MCP es 1400 V. La corriente de salida de MCP aproximadamente aumenta linealmente a medida que la energía del fotoelectrón disminuye. de 400 V y entra en una meseta a una energía superior a 400 eV. Esto se puede atribuir al hecho de que el SEY del dióxido de silicio es particularmente bajo con una energía de electrones incidente más baja y una vez que el SEY está cerca del máximo, la corriente de salida se vuelve estable.

Tensión de polarización entre cátodo y MCPin en función de la corriente de salida de MCP
La Figura 4 muestra la curva SEY de Al 2 O 3 y SiO 2 . En la figura, el SEY de Al 2 O 3 aumenta con el voltaje y obtiene el valor más grande de 3.6 a 400 V, y esta tendencia se corresponde aproximadamente con la Fig. 3. En el Al 2 O 3 Curva SEY, el valor SEY desciende por encima de 400 eV. Pero como se muestra en la Fig. 3, la corriente de salida sigue aumentando cuando el voltaje de polarización está por encima de 400 V. Esto puede explicarse por la relación de área abierta de MCP. El MCP que usamos tiene una relación de área abierta de aproximadamente 60%; significa que cuando los fotoelectrones llegan al MCPin, el 40% de ellos no pueden entrar en los canales y serían reflejados por la superficie superior del MCP. Cuando aumenta el voltaje entre el cátodo y MCPin, el campo eléctrico volvería a acelerar el 40% de los electrones y volvería a entrar en el canal.
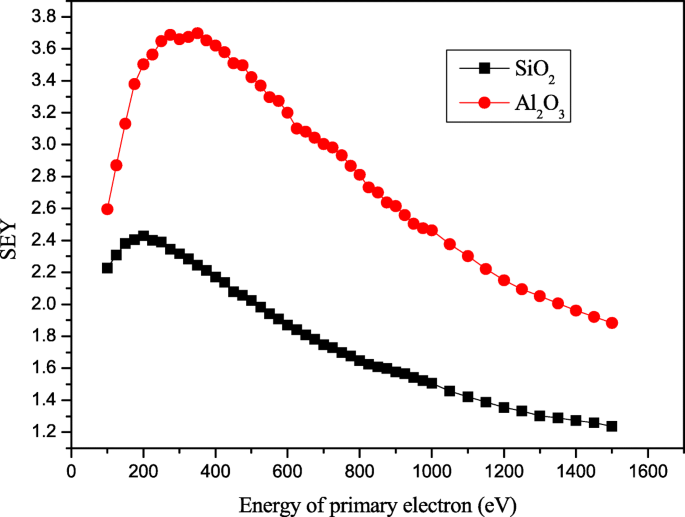
Rendimiento de electrones secundarios (SEY) de SiO2 ALD Al2O3
Debido a que la uniformidad de la capa SEE puede afectar la uniformidad del detector de imágenes MCP, la uniformidad de la capa SEE es un factor clave para la caracterización de ALD-MCP. La Figura 5 muestra los espectros y la composición elemental de muestras de MCP de sección transversal procesadas mediante la extensión del modelo de precursor y el modelo de flujo de parada. La distribución de Al se caracteriza por EDS en cinco lugares a lo largo de la superficie interna de los poros. Para reducir el error de medición de EDS, los datos de distribución de elementos se midieron con dos muestras más gruesas, la muestra F y la muestra G, que depositaron 60 nm Al 2 O 3 . En la Fig. 5a, b, se midió la composición elemental de los MCP revestidos y no revestidos para excluir la influencia del sustrato en la distribución de Al. La cantidad de Al es inferior al 1% en el sustrato y demasiado pequeña para afectar los resultados finales del experimento. En la Fig. 5c se muestra la distribución de las muestras depositadas por el modelo de parada de flujo y el modelo de precursor extendido. El contenido de Al en diferentes ubicaciones significó que los elementos están distribuidos de manera más uniforme en la superficie interna del poro que muestra depositada al extender el modelo de precursores. Esto también implica que la técnica ALD es capaz de depositar una película delgada de nano-óxido homogénea sobre sustratos con estructura compleja. La distribución de elementos de la muestra depositada por el modelo de flujo de parada muestra un mal uniforme. Las superficies superior e inferior de MCP tienen un porcentaje atómico bajo, mientras que la mitad del canal tiene un porcentaje atómico alto. Esto probablemente se deba a que los precursores en la superficie fueron fáciles de purgar y obtener una capa de deposición atómica. En el medio del canal, los precursores eran difíciles de purgar y obtenían una deposición de vapor en lugar de una deposición atómica.

Espectros y composición elemental de muestras transversales de MCP. un Espectros y composición elemental de ALD MCP. b Espectros y composición elemental de MCP sin recubrimiento. c Al distribución de muestras depositadas por modelo de parada de flujo y modelo de precursor extendido.
El espesor con SEM podría ser una mejor opción para confirmar la uniformidad. Por tanto, el grosor de las capas SEE depositadas en la superficie interior de los poros de MCP se midió mediante SEM y se resume en la Fig. 6. El grosor de cinco puntos diferentes a lo largo de un poro, como se muestra en la Fig. 6a, se midió directamente mediante SEM. Las curvas de espesor de diferentes modelos de deposición se muestran en la Fig. 6c, que básicamente coincide con la distribución de Al como en la Fig. 5c.
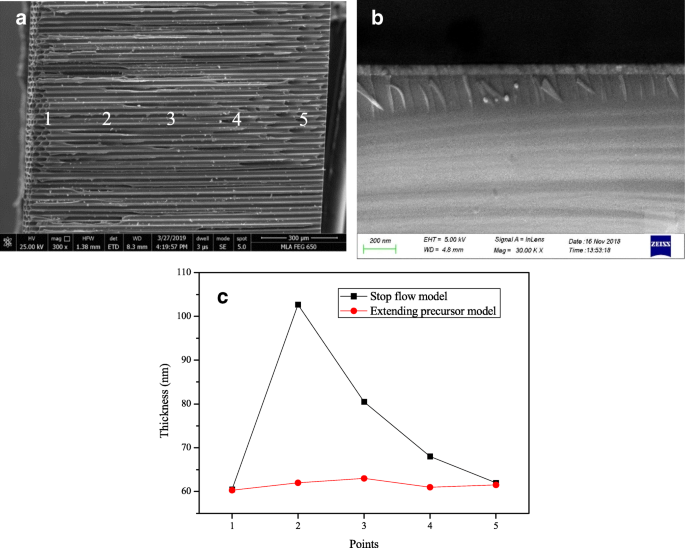
Imágenes SEM transversales de MCP. un Imágenes SEM transversales de muestras de ALD-MCP. b Imágenes SEM de corte transversal de la capa de Al2O3 en la superficie del canal interno. c Espesor de la capa SEE en diferentes ubicaciones medidas con SEM
Después de que se prepararon los electrodos de cobre en ambos lados del MCP, la caracterización eléctrica medida por un sistema se muestra en la Fig. 1. La Figura 7 muestra la corriente de salida y la imagen del MCP tradicional y el ALD-MCP revestido. La figura 7a muestra la corriente de salida en función de diferentes espesores de Al 2 O 3 . En la Fig. 7b, a medida que el espesor de la película aumenta de 6 a 10 nm, la corriente de salida de MCP sin recubrimiento de sustraído recubierto aumenta significativamente primero y luego se mantiene estable. Los ALD-MCP con Al 2 de 8 nm y 10 nm O 3 El revestimiento obtuvo más de cinco veces la corriente de salida que el MCP convencional. Significa que Al 2 de 8 nm de espesor O 3 es óptimo para la aplicación MCP. Esto es causado por el ALD-MCP que tiene un material SEY más alto que podemos ver en la Fig. 3. Como se muestra en (a), cuando se recubre 4 nm en la superficie del canal interno del MCP, la corriente de salida es menor que la del no recubierto MCP. Esto probablemente porque no hay material continuo y existen muchos defectos cuando el espesor de Al 2 O 3 está por debajo de 4 nm. La recombinación de electrones ocurre en defectos para reducir la cantidad de electrones secundarios y conducir a una corriente de salida más baja que la MCP sin recubrimiento.
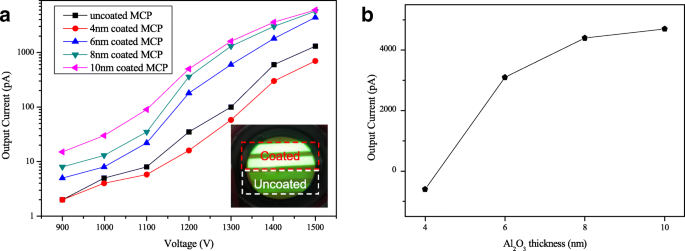
Corriente de salida e imagen de MCP tradicional y ALD-MCP revestido. un Corriente de salida de diferentes espesores de recubrimiento de Al2O3 en MCP y fotografía de una pantalla de fósforo iluminada por medio de Al2O3 de 8 nm recubierto y mitad sin recubrimiento. b Corriente de salida del MCP recubierto restar sin recubrimiento en función del espesor de Al2O3
Después de que depositamos Al 2 de 8 nm O 3 en la mitad de la muestra H, hay cuatro tiras de cobre depositadas en la muestra H y una pantalla de fósforo en lugar del ánodo de PCB para recoger los electrones de salida. Como se muestra en la Fig. 7b, el MCP medio revestido tiene una imagen más brillante que el MCP sin revestimiento. Esto es consistente con la caracterización eléctrica.
La muestra A y la muestra D se iluminaron continuamente con una lámpara de mercurio ultravioleta para una prueba de por vida. Para acelerar las pruebas de vida, se utilizó una lámpara de mercurio ultravioleta de alta potencia sin atenuación. Los MCP se hicieron funcionar con grandes corrientes de salida y permanecen en un nivel de saturación durante varios días. Como se muestra en la Tabla 2, la corriente oscura y la corriente de salida a un nivel de iluminación bajo se midieron antes y después de las pruebas de vida útil. Antes de la prueba, la corriente oscura del MCP tradicional era de 1,0 pA y el ALD-MCP era de 1,2 pA. La corriente de oscuridad más alta de ALD-MCP se debió simplemente a que los sustratos de los MCP eran MCP tradicionales y el ALD-MCP estaba recubierto por un material de alto SEY. Después de las pruebas de por vida, la corriente oscura de ALD-MCP funciona mejor mientras mostraba un rendimiento similar antes de las pruebas de por vida. Según la Tabla 2, la corriente de salida del MCP tradicional cayó aproximadamente un 50% después de la iluminación de alta potencia, mientras que ALD-MCP muestra un mejor comportamiento y la corriente de salida se mantuvo alrededor de 6nA.
Conclusiones
La morfología, composición y estructura de las películas delgadas de nanoóxidos Al 2 O 3 preparados a través de la deposición de la capa atómica. Se midieron las uniformidades de espesor en el canal depositado al extender el modelo precursor y el modelo de flujo de parada. El contenido de Al y el espesor de la película en diferentes ubicaciones a lo largo de los canales significaron que la extensión del precursor puede obtener una mejor uniformidad para un MCP con un tamaño de poro de 24 μm y una relación de aspecto de 40. Hemos evaluado un sistema de prueba de MCP y hemos observado que los voltajes de polarización entre el cátodo y la superficie superior del MCP pueden afectar la corriente de salida. Se estudiaron las propiedades eléctricas y las medidas de vida útil. Los resultados de las mediciones eléctricas mostraron que cuando el espesor de la película aumenta de 6 a 10 nm, la corriente de salida aumenta y la velocidad disminuye. Y ALD-MCP que están recubiertos de más de 8 nm de Al 2 O 3 tiene aproximadamente cinco veces la corriente de salida que los MCP tradicionales y tiene un mejor rendimiento de por vida.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- ALD-MCP:
-
Placa de microcanal procesada por deposición de capa atómica
- EDS:
-
Espectroscopía de energía dispersa
- MCP:
-
Placa de microcanal
- VER capa:
-
Capa de emisión de electrones secundarios (SEE)
- SEM:
-
Microscopía electrónica de barrido
- SEY:
-
Rendimiento de electrones secundarios
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Presentación de la estructura atómica y electrónica de las nanofibras de carbono de copa apilada
- El diseño de la capa de emisión para multiplicadores de electrones
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Las nanofibras jerárquicas de poliamida 6-ZnO antibacteriana fabricadas por deposición de capas atómicas y crecimiento hidrotermal
- Electrodeposición de SnO2 en FTO y su aplicación en células solares de perovskita de heterounión plana como capa de transporte de electrones
- Propiedades fotocatalíticas de los polvos de TiO2 recubiertos con Co3O4 preparados por deposición de capa atómica mejorada con plasma
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Tratamiento UV de capas de transporte de electrones de SnO2 procesado a baja temperatura para células solares planas de perovskita
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN



