Evolución estructural de la interfaz HfO2 / Si dependiente de la temperatura y su mecanismo
Resumen
En este trabajo, el óxido de hafnio (HfO 2 ) se depositan películas delgadas sobre sustratos de Si de tipo p mediante la deposición de una capa atómica de plasma remoto sobre Si de tipo p a 250 ° C, seguido de un recocido térmico rápido en nitrógeno. Efecto de la temperatura posterior al recocido sobre la cristalización de HfO 2 películas y HfO 2 Se investigan las interfaces / Si. La cristalización del HfO 2 películas y HfO 2 La interfaz / Si se estudia mediante microscopía electrónica de transmisión de emisión de campo, espectroscopía de fotoelectrones de rayos X, difracción de rayos X y microscopía de fuerza atómica. Los resultados experimentales muestran que durante el recocido, el oxígeno se difunde desde HfO 2 a la interfaz Si. Para temperaturas de recocido por debajo de 400 ° C, el HfO 2 La película y la capa interfacial son amorfas, y la última consiste en HfO 2 y dióxido de silicio (SiO 2 ). A una temperatura de recocido de 450-550 ° C, el HfO 2 La película se vuelve policristalina multifase y una SiO 2 cristalina se encuentra en la interfaz. Finalmente, a una temperatura de recocido superior a 550 ° C, el HfO 2 La película está dominada por policristalino monofásico, y la capa interfacial se transforma completamente en SiO 2 cristalino .
Introducción
Óxido de hafnio (HfO 2 ) La película fina es un material interesante para una variedad de aplicaciones. Se puede utilizar en revestimiento óptico multicapa [1], revestimiento protector [2], dieléctrico de compuerta [3], capa pasivante [4,5,6], y así sucesivamente debido a sus excelentes propiedades, como alta densidad, alta refracción índice, banda prohibida amplia y estabilidad térmica relativamente alta. Se han utilizado muchos métodos para preparar HfO 2 película delgada, como evaporación por haz de electrones [7], deposición de solución química [8], pulverización catódica reactiva [9], deposición de vapor químico orgánico metálico [10], epitaxia de haz molecular [11] y deposición de capa atómica (ALD). ALD es un método prometedor para obtener películas delgadas con control de espesor de alta precisión y uniformidad de alta precisión. Se encuentra que el pos-recocido tiene influencias significativas en ALD HfO 2 películas [12,13,14,15]. Según la investigación, HfO 2 las películas delgadas pueden cristalizar a una temperatura de recocido superior a 500 ° C [16,17,18]. La estructura cristalina de HfO 2 afecta fuertemente las propiedades ópticas y eléctricas. Por ejemplo, el cambio estructural de HfO 2 de fase amorfa a cristalina monoclínica podría conducir a cambios en el índice de refracción de 1,7 a 2,09, la brecha óptica de 5,75 a 6,13 eV y la constante dieléctrica de 24,5 a 14,49 [19, 20]. Para ALD HfO 2 depositado sobre sustratos de silicio, generalmente se observa una capa de óxido en HfO 2 / Interfaz Si [21, 22]. Se informa que la presencia de esta capa interfacial disminuye la constante dieléctrica [22]. Además, Kopani et al. [23] presentó las propiedades estructurales de 5 nm HfO 2 películas después de la oxidación con ácido nítrico de sustratos de Si dopados con n. Descubrieron que la alta temperatura de recocido aumenta la tasa de crecimiento de los núcleos cristalinos. Sin embargo, sus propiedades de cristalización en particular HfO 2 / interfaz sustrato se han estudiado escasamente. Por lo tanto, la temperatura de recocido que afecta a las propiedades de cristalización del HfO 2 Las películas delgadas preparadas por ALD merecieron una mayor investigación.
En este trabajo, el HfO 2 Se fabricaron películas delgadas mediante una deposición de capa atómica de plasma remoto (RP-ALD) sobre sustratos de silicio de tipo p. El post-recocido se realizó mediante un sistema de recocido térmico rápido (RTA) a diferentes temperaturas. Los cambios estructurales y las propiedades de cristalización del HfO 2 Las películas delgadas por RTA se caracterizaron por microscopía de fuerza atómica (AFM), difracción de rayos X incidente rasante (GIXRD), espectroscopía de fotoelectrones de rayos X (XPS) y microscopía electrónica de transmisión de alta resolución (HR-TEM). El HfO 2 dependiente de la temperatura También se investiga la evolución estructural de la interfaz / Si y su mecanismo.
Método
Se utilizaron obleas Czochralski Si de 2 pulgadas y 250 μm orientadas de doble cara pulidas (100) con una resistividad de 30 Ω cm. Antes de la deposición, las obleas de Si se limpiaron mediante un método estándar de Radio Corporation of America seguido de inmersión en una solución diluida de ácido fluorhídrico (5%) durante 2 minutos para eliminar posibles óxidos perdidos sin enjuague final con agua. Después de la limpieza, todas las obleas se secaron con nitrógeno puro (N 2 ) gas y se monta en el soporte del sustrato. Aproximadamente 15 nm HfO 2 (168 ciclos de ALD) se depositaron películas delgadas en obleas de Si mediante RP-ALD (Picosun R-200, Finlandia) utilizando tetrakis (etilmetilamino) hafnio (TEMAH) y oxígeno (O 2 ) en pulso alterno con N 2 purga de la cámara de reacción entre pulsos. El TEMAH y O 2 el plasma se pulsó al interior del reactor en la siguiente secuencia:pulso TEMAH 1,6 s; N 2 purgar 10 s; O 2 pulso de plasma 10 s, y N 2 purgar 12 s. Después de depositar el HfO 2 películas delgadas, el recocido térmico rápido se realizó en N 2 ambiente durante 10 min. Las temperaturas de recocido se variaron de 400 a 600 ° C para investigar el efecto sobre la cristalización del HfO 2 películas delgadas y HfO 2 / Si interfaz. La Tabla 1 enumera las condiciones típicas de RPALD y post-recocido.
Las mediciones de AFM se realizaron en modo de tapping para investigar la morfología de la superficie del HfO 2 Peliculas delgadas. Las imágenes AFM que se muestran en este trabajo son escaneos de 2 μm × 2 μm con una resolución de 256 puntos × 256 líneas. La estructura de HfO 2 Las películas se caracterizaron por mediciones de difracción de rayos X incidente rasante (GIXRD, Rigaku TTRAXIII, Japón) con un tubo de rayos X de foco fino largo de Cu. Se produjeron rayos X con una longitud de onda de 0,154 nm a una tensión de funcionamiento de 50 kV y una corriente de 300 mA. Se seleccionó un ángulo de incidencia de 0,5 ° para obtener patrones de difracción sobre un 2 θ rango de 20 a 60 °. También se realizó espectroscopia de fotoelectrones de rayos X (XPS, Thermo Fisher K-alpha) utilizando radiación de rayos X monocromática de Al Kα (hν =1486,6 eV). Para el análisis XPS, se utilizó una mancha de 100 μm de diámetro y se recolectaron fotoelectrones en un ángulo de despegue de 45 °. Las secciones transversales del HfO 2 Se prepararon películas delgadas mediante una técnica de extracción de haz de iones enfocado en un sistema Hitachi NX2OOO. Las imágenes transversales del HfO 2 Las películas delgadas se examinaron mediante un microscopio electrónico de transmisión de alta resolución de emisión de campo (HR-TEM, JEM-2100F, EE. UU.).
Resultados y discusión
La Figura 1 muestra las imágenes AFM para el HfO 2 películas recocidas a diferentes temperaturas. Los valores de la raíz cuadrada media (RMS) y la rugosidad superficial promedio (Ra) se muestran para indicar la rugosidad superficial. El valor RMS es de 0,44 nm para la película depositada. Aumenta ligeramente a 0,47 nm cuando la temperatura de recocido se eleva a 500 ° C. El aumento adicional de la temperatura de recocido a 600 ° C conduce a una mejora significativa en la rugosidad de la superficie con un valor eficaz que aumenta a 0,69 nm. La misma tendencia se observa en los valores de Ra. El aumento de la rugosidad de la superficie de las películas recocidas podría inferir un cambio estructural.
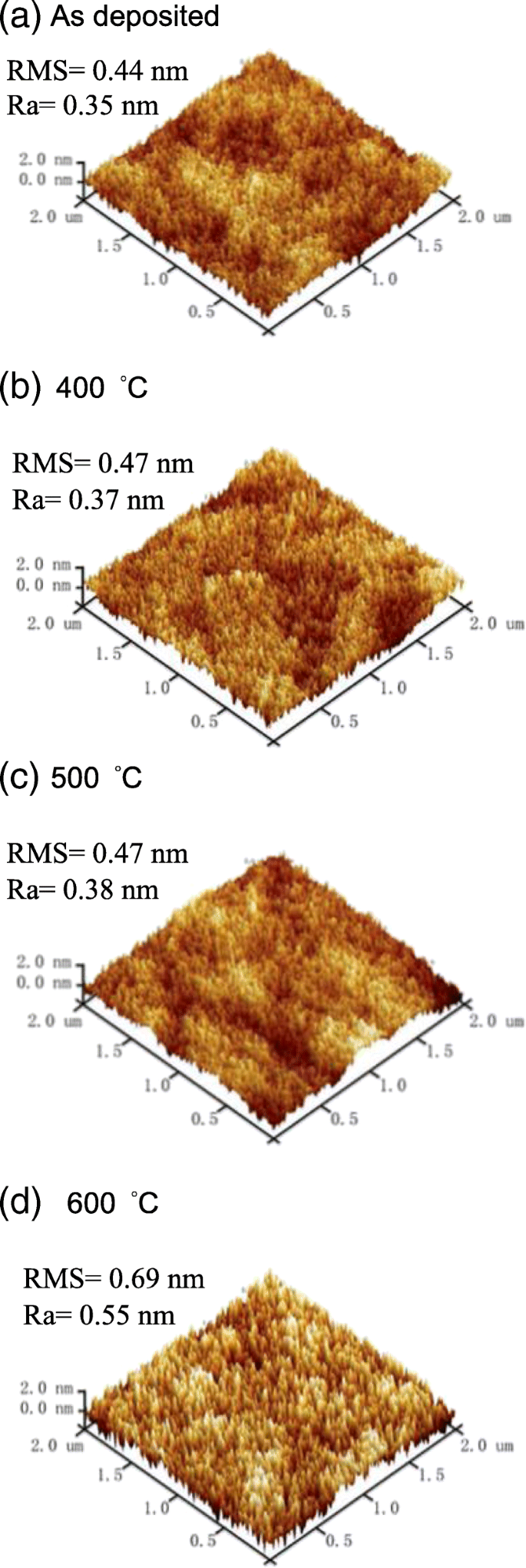
Imágenes AFM de a tal como se depositó, b 400 ° C recocido, c 500 ° C recocido y d HfO recocido a 600 ° C 2 películas
La Figura 2 muestra los espectros GIXRD dependientes de la temperatura de varios HfO 2 Peliculas delgadas. El HfO 2 depositado las películas son amorfas y permanecen amorfas después del recocido a 400 y 450 ° C. A una temperatura de recocido superior a 500 ° C, aparecen picos de difracción, lo que indica la formación de HfO 2 cristalino . Los picos en 1 / d =0.319 y 0.354 Å −1 corresponden a los planos -111 y 111 de la fase monoclínica (ICDD PDF # 34-0104, grupo espacial P21 / c), respectivamente. El pico a 1 / d =0.340 Å −1 corresponde al plano (111) de la fase ortorrómbica (ICDD PDF # 21-0904, grupo espacial Pbcm). Otros picos cercanos a 1 / d =0.380 ~ 0.395 son los planos 200, 020 y 002 de la fase monoclínica y el plano 020 de las fases ortorrómbicas. Los resultados también revelan que la fase monoclínica disminuye y las fases ortorrómbicas aumentan con la temperatura de recocido. El HfO 2 ortorrómbico domina la estructura cristalina a temperaturas de recocido más altas. Sin embargo, los picos de difracción de HfO 2 ortorrómbico se observaron a un 1 / d más bajo (un espaciado d más pequeño) en comparación con los del ICDD PDF # 21-0904. Además, el desplazamiento de 1 / d =0,340 Å −1 hacia un valor más alto indica que el espaciado d disminuye con la temperatura de recocido.
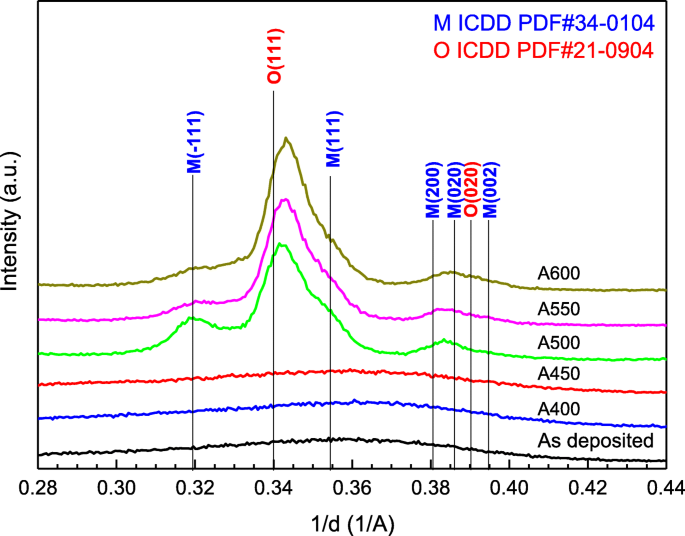
Espectros GIXRD de HfO 2 películas delgadas recocidas a diferentes temperaturas
Las concentraciones de Hf y O dentro del HfO 2 Las películas se midieron utilizando XPS perfilado en profundidad. La Figura 3 muestra la relación de composición O / Hf del HfO 2 tal como se depositó y después del recocido. Película (s. La relación O / Hf disminuye de 1,60 a 1,29 con la temperatura de recocido. Debido al uso de N 2 durante el recocido, el HfO 2 se vuelve deficiente en oxígeno con la temperatura. El HfO 2 deficiente en oxígeno La película también da como resultado un espaciado d más pequeño como se mencionó anteriormente.

Relación atómica de oxígeno a hafnio para HfO 2 películas delgadas recocidas a diferentes temperaturas
Las figuras 4a, b, c, d, eyf muestran las imágenes HR-TEM de sección transversal de alta resolución de 400 ° C, 450 ° C, 500 ° C, 550 ° C y HfO recocido a 600 ° C 2 películas delgadas sobre sustratos de Si, respectivamente. Se puede ver que el HfO 2 La capa y el sustrato de Si se muestran claramente en estas imágenes. Además, una capa delgada con un grosor de 1 a 2 nm entre HfO 2 y el sustrato de Si podría ser el SiO 2 película. Como se muestra en la Fig. 4a, no hay una disposición de celosía obvia en el HfO 2 depositado como está depositado película, lo que indica que esta película es amorfa. Después del recocido a 400 ° C, aunque la mayoría de las regiones de HfO 2 películas todavía son amorfas, podemos observar que en esta película se forma una fracción de arreglos de celosía con valores de espaciamiento d de 2.82 y 3.12 Å. Estos dos valores de espaciado d están indexados a HfO 2 monoclínico (111) y HfO 2 monoclínico (- 111) planos, respectivamente, y la película recocida a 400 ° C muestra la estructura nanocristalina. Con el aumento de la temperatura de recocido de 400 a 600 ° C, la calidad cristalina de HfO 2 la película se mejora gradualmente. Cuando el HfO 2 la película se templa a 500–550 ° C, las disposiciones de celosía principales consisten en HfO 2 monoclínico (- 111), monoclínico HfO 2 (200) y HfO 2 ortorrómbico (111) se puede identificar. Sin embargo, aumentando aún más la temperatura de recocido a 600 ° C, la estructura reticular del HfO 2 ortorrómbico (111) todavía existe en la película, y los otros dos arreglos de celosía desaparecen gradualmente. Por otro lado, los valores de espaciado d de HfO ortorrómbico 2 (111) planos para HfO 2 recocido a 500 ° C, 550 ° C y 600 ° C se determina que las películas tienen 2,93, 2,90 y 2,88 Å, respectivamente. Esto concuerda bien con el resultado XRD de que el HfO 2 ortorrómbico (111) el pico de difracción se desplaza hacia la dirección del ángulo alto al aumentar la temperatura de recocido de 500 a 600 ° C. El resultado revela que el contenido de oxígeno de HfO 2 la película se reduce gradualmente a medida que aumenta la temperatura de recocido. El otro fenómeno interesante se puede encontrar en los cambios de estructura cristalina y espesor del SiO 2 capa. En el estado depositado, el SiO 2 La capa es amorfa. Incluso si la muestra se templa a 400 ° C, la energía térmica no es lo suficientemente alta como para transformar la estructura de SiO 2 capa de amorfa a cristalina. No obstante, al aumentar la temperatura de recocido de 450 a 600 ° C, el SiO 2 cristalino capa (con el SiO 2 cúbico (220) estructura) y su espesor aumenta de 1,0 a 1,6 nm. Se puede observar que el SiO 2 amorfo La capa se transforma completamente en SiO cúbico 2 estructura después de recocer la muestra a 600 ° C. Con un incremento de la temperatura de recocido de 550 a 600 ° C, el valor de espaciado d del SiO cúbico 2 (220) aumenta de 2,48 a 2,56 Å. Esto significa que el contenido de oxígeno de SiO 2 La capa aumenta al aumentar la temperatura de recocido. Se puede especular razonablemente que la adición de contenido de oxígeno en el SiO 2 La capa se atribuye a la difusión de átomos de oxígeno procedentes del HfO 2 película. Además, el espesor total disminuye para la temperatura de recocido de 550 y 600 ° C y podría estar relacionado con el aumento de la densidad de la película causado por la cristalización y la eliminación de hidrógeno.
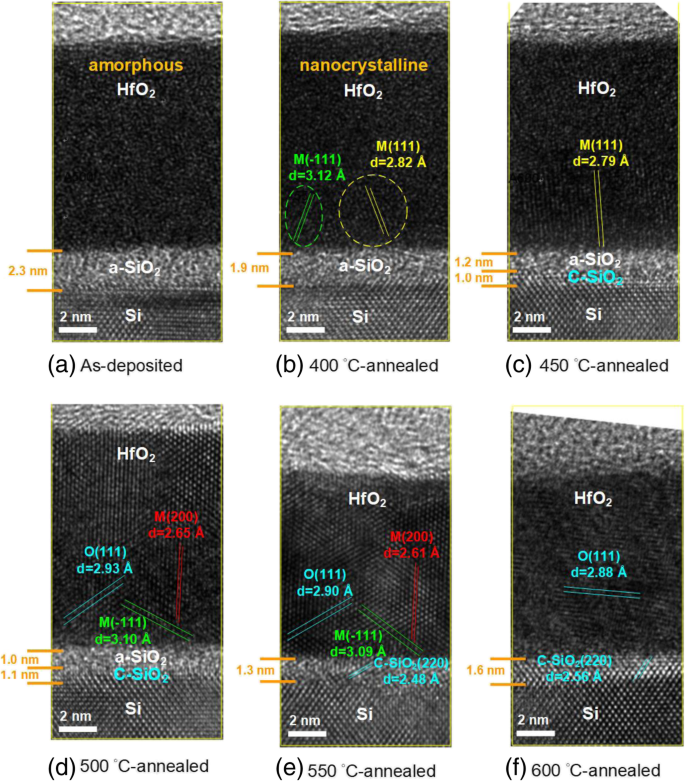
Imágenes TEM transversales de a tal como se depositó, b 400 ° C recocido, c 450 ° C recocido, d 500 ° C recocido, e 550 ° C recocido y f HfO recocido a 600 ° C 2 / Si
Con base en los resultados anteriores, la Fig. 5 ilustra los mecanismos del HfO 2 películas con diferentes temperaturas de recocido. Considerando que la temperatura de recocido es menor de 400 ° C (Fig. 5a), la película es amorfa donde los átomos de Hf y O están dispuestos al azar. La capa interfacial entre HfO 2 y la oblea de c-Si es un óxido mixto que consta de a-SiO 2 y a-HfO 2 . A una temperatura de recocido de 450–550 ° C (Fig. 5b), el HfO 2 la película recibe energía térmica que conduce a un cambio estructural de amorfa a policristalina con fases monoclínica y ortorrómbica. La orientación cristalina y el espaciado d se indican de acuerdo con los resultados de HR-TEM y GIXRD. Un SiO 2 cristalino se forma la capa. Varios trabajos informaron una capa de óxido de silicio ordenada en la interfaz de a-SiO 2 y (100) c-Si, pero el mecanismo y la estructura a escala atómica siguen siendo controvertidos. La oxidación térmica del silicio podría considerarse como operaciones de inserción secuencial de átomos de oxígeno en enlaces Si-Si, y esto induce una gran acumulación de deformaciones por compresión en las regiones oxidadas y posiblemente podría causar una transformación estructural en óxido ordenado en el SiO 2 Interfaz / c-Si [24]. También se ha informado de que la fase cristalina que contiene oxígeno podría formarse en condiciones de alta sobresaturación de oxígeno de Si [25] o baja densidad de defectos de interfase [26]. De las imágenes XPS y TEM de este trabajo, el HfO 2 capa es deficiente en oxígeno. Las cantidades significativas de oxígeno se difunden desde HfO 2 hacia el sustrato de silicio, y esto podría conducir a la sobresaturación de oxígeno en la interfaz c-Si y la formación de SiO cristalino 2 . En este rango de temperatura, el SiO 2 cristalino el grosor de la capa aumentaría pero el a-HfO 2 + A-SiO 2 el espesor de la capa de mezcla disminuye al aumentar la temperatura de recocido. A una temperatura de recocido superior a 550 ° C (Fig. 5c), el HfO 2 La estructura está dominada por una fase única ortorrómbica policristalina (111). La capa interfacial está completamente gobernada por SiO 2 cristalino . El espaciado d disminuye para HfO 2 ortorrómbico capa y aumenta para c-SiO 2 . Aunque el recocido de HfO 2 es necesario para lograr una alta pasivación de la oblea de Si y una constante dieléctrica, a altas temperaturas, la cristalización resultante del HfO 2 y el SiO 2 interfacial puede reducir las propiedades de la película. Se encuentra que la temperatura de recocido de 500 ° C obtiene la mejor constante dieléctrica de 17.2. El aumento adicional de la temperatura de recocido conduce a una reducción de la constante dieléctrica, posiblemente debido al cambio en la fase cristalina. Tomida y col. informó que la constante dieléctrica de HfO 2 disminuye cuando la estructura se transforma de policristalina a monoclínica monofásica [27]. La mejor pasivación de HfO 2 / Si también se puede obtener a la temperatura de recocido de 500 ° C, ya que temperaturas más altas pueden conducir a un c-SiO 2 completo capa interfacial y deshidrogenación en la interfaz.
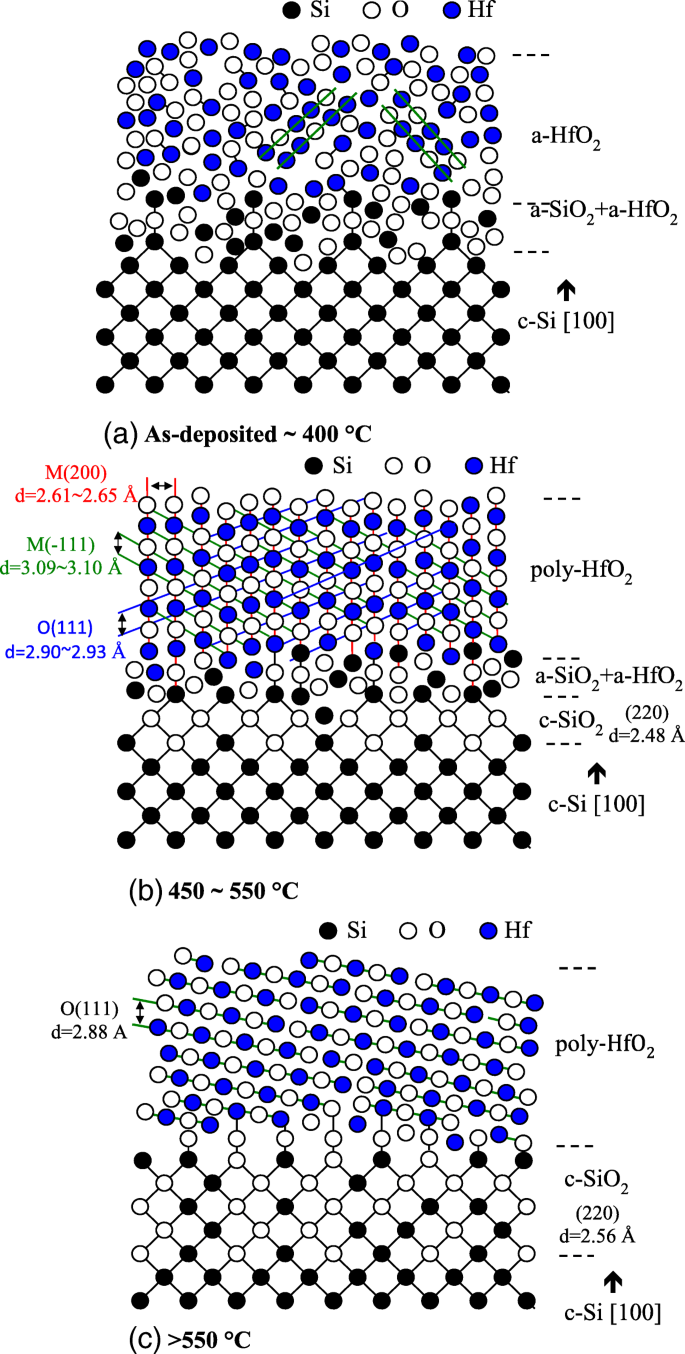
Diagramas del mecanismo de cristalización de HfO 2 películas y capa interfacial en los rangos de temperatura a depositado a 400 ° C, b 450 a 550 ° C y c más allá de 550 ° C. También se indican el valor de espaciado d y la orientación cristalina
Conclusión
HfO 2 Las películas se preparan utilizando RP-ALD y el efecto de la temperatura de recocido sobre la estructura cristalina del HfO 2 ha sido investigado. Para el HfO 2 depositado y que recocido por debajo de 400 ° C, el HfO 2 y la capa interfacial es amorfa. Con el aumento de la temperatura de recocido, el espaciamiento d del ortorrómbico se reduce mientras que el del c-SiO 2 La capa interfacial aumenta, lo que indica la difusión de oxígeno de HfO 2 a la interfaz Si. La temperatura de recocido superior a 550 ° C muestra un HfO 2 capa con monofásico ortorrómbico policristalino, y la capa interfacial se transforma completamente en c-SiO 2 . Aunque se requiere recocido para HfO 2 en muchas aplicaciones, como lograr una alta pasivación de obleas de Si y una constante dieléctrica alta, la cristalización podría ser perjudicial para las propiedades de la película. La temperatura de recocido de 500 ° C puede tener la mejor calidad de pasivación de obleas de Si y constante dieléctrica.
Abreviaturas
- AFM:
-
Microscopía de fuerza atómica
- a-HfO 2 :
-
Óxido de hafnio amorfo
- ALD:
-
Deposición de la capa atómica
- a-SiO 2 :
-
Dióxido de silicio amorfo
- c-SiO 2 :
-
Dióxido de silicio cristalino
- GIXRD:
-
Difracción de rayos X incidente rasante
- HfO 2 :
-
Óxido de hafnio
- HR-TEM:
-
Microscopía electrónica de transmisión de alta resolución
- N 2 :
-
Nitrógeno
- O 2 :
-
Oxígeno
- RMS:
-
Raíz cuadrada media
- RP-ALD:
-
Deposición remota de la capa atómica de plasma
- RTA:
-
Recocido térmico rápido
- TEMAH:
-
Tetrakis (etilmetilamino) hafnio
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Preparación de nanoesferas poliméricas impresas con iones de paladio (II) y su eliminación del paladio (II) de la solución acuosa
- Mecanismo de conducción y resistencia mejorada en RRAM basado en HfO2 con tratamiento de nitruración
- Fabricación de películas delgadas de SrGe2 en sustratos Ge (100), (110) y (111)
- Prueba de las propiedades estructurales, electrónicas y magnéticas de Ag n V (n =1–12) Clusters
- Fabricación de nanofibras helicoidales CA / TPU y análisis de su mecanismo
- Caracterización por resonancia magnética y de microondas dependiente del grosor de películas de FeCoBSi con patrón de rayas combinadas
- Una simulación teórica de las respuestas a la radiación de la superrejilla de Si, Ge y Si / Ge a la irradiación de baja energía
- Síntesis controlada y propiedades de adsorción selectiva de las nanohojas de Pr2CuO4:una discusión del mecanismo
- Evaluación de la toxicidad de las nanopartículas de PEG-PCCL e investigación preliminar sobre su efecto antitumoral de la carga de paclitaxel



