Redistribución de portadores entre dos tipos de estados localizados en los pozos cuánticos de InGaN / GaN estudiados por fotoluminiscencia
Resumen
Los pozos multicánticos (MQW) de InGaN / GaN se preparan en las mismas condiciones mediante deposición de vapor químico orgánico metálico (MOCVD), excepto el grosor de las capas de la tapa que crecen adicionalmente en cada capa de pocillo de InGaN. La intensidad de la fotoluminiscencia (PL) de la muestra de la capa fina es mucho más fuerte que la de la muestra de la capa superior más gruesa. Curiosamente, la muestra de la capa de capa gruesa tiene dos picos de fotoluminiscencia con un alto poder de excitación, y las curvas de temperatura máxima de energía de PL muestran una transición anómala de una forma de V invertida a una forma de S regular con un poder de excitación creciente. Mientras tanto, exhibe una estabilidad térmica más pobre de la muestra de la capa de cubierta gruesa con una potencia de excitación más alta que con una potencia de excitación más baja. Tal fenómeno atípico se atribuye a la redistribución de portadores entre los dos tipos de estados localizados que es inducida por la distribución no homogénea de la composición de indio en la muestra de la capa de cubierta gruesa. Además, la luminiscencia de los estados localizados profundos tiene una mejor estabilidad térmica y la luminiscencia de los estados localizados poco profundos tiene una estabilidad térmica pobre. De hecho, una distribución de indio no homogénea más severa puede ser causada por la degradación del crecimiento epitaxial posterior de la región MQW de InGaN / GaN debido a un tiempo de crecimiento de la capa superior de GaN a baja temperatura más prolongado.
Introducción
La estructura de pozo multi-cuántico (MQW) de InGaN / GaN ha recibido gran atención debido a su amplio uso en diodos emisores de luz (LED) y diodos láser (LD) [1,2,3,4,5,6]. Aunque la alta densidad de dislocación de subprocesos y la reducción de la superposición de la función de onda causada por la polarización espontánea y piezoeléctrica de los MQW de InGaN / GaN, su eficiencia de luminancia sigue siendo sorprendentemente alta [7,8,9,10]. Una de las principales razones es que la localización de los excitones en mínimos potenciales debido a las fluctuaciones del contenido de indio conduce a la formación de estados de tipo punto cuántico en los pozos cuánticos de InGaN / GaN [11]. Sin embargo, sigue siendo ambiguo cómo juegan los estados de localización en el mecanismo de luminiscencia. Varios estudios han informado del efecto de las fluctuaciones de la composición de InGaN sobre las recombinaciones radiativas y Auger [12,13,14]. Las simulaciones teóricas de unión estrecha atomística utilizadas por Jones encontraron que la localización aumenta las tasas de recombinación tanto radiativa como Auger, pero la tasa de recombinación Auger aumenta en un orden de magnitud mayor que la radiativa [15]. Experimentalmente, la localización del portador conduce a la relajación de la regla de selección k en el proceso de recombinación de Auger y, por lo tanto, mejora fuertemente el proceso de recombinación de Auger en QW de InGaN / GaN polares bajo alta excitación óptica [16]. Es bien sabido que el comportamiento en forma de S dependiente de la temperatura de la energía pico de luminiscencia es una huella de la localización del portador. Se proponen muchos modelos, como el modelo de conjunto de estado localizado (LSE), para explicar la localización del portador y el comportamiento de redistribución térmica, mostrando que la variación de la energía pico de luminiscencia con la temperatura puede verse influenciada por el proceso de redistribución del portador único bajo diferentes niveles de excitación [17, 18,19,20,21]. Generalmente, los dispositivos fabricados, como los diodos láser, siempre funcionan con una densidad de portadora inyectada más alta [22]. En este caso, los espectros de fotoluminiscencia de estados localizados pueden exhibir un comportamiento único a diferentes niveles de excitación asociados con la uniformidad de estados localizados. Por lo tanto, se necesitan más estudios para comprender el efecto de las fluctuaciones de la aleación en los dispositivos InGaN.
En este trabajo, se preparan dos muestras típicas con diferentes espesores de capas de capa de GaN que se cultivan adicionalmente en cada capa de pozo de InGaN mediante un sistema de deposición de vapor químico metal-orgánico (MOCVD). Las propiedades de los MQW se caracterizan en detalle por las mediciones de difracción de rayos X de alta resolución (HRXRD), fotoluminiscencia dependiente de la temperatura (TDPL) y fotoluminiscencia dependiente de la potencia (PDPL). Se encuentra que la muestra de la capa de cubierta gruesa muestra un pico anómalo en el lado de mayor energía bajo una alta potencia de excitación óptica. Esto implica la coexistencia de dos tipos diferentes de estados localizados. Mientras tanto, la intensidad de PL decae más rápidamente a bajas temperaturas cuando la potencia de excitación aumenta más. Por lo tanto, podemos suponer que la fotoluminiscencia de estados localizados profundos tiene una mejor estabilidad térmica y que la fotoluminiscencia de estados localizados superficiales tiene una estabilidad térmica pobre.
Métodos
Materiales
Se estudian las muestras de InGaN / GaN MQW con diferentes espesores de capa de cubierta cultivadas sobre un sustrato de zafiro plano c mediante un AIXTRON 3 × 2 en un reactor de cabezal de ducha de acoplamiento cerrado. Trimetilgalio (TMGa), trimetilindio (TMIn) y amoníaco (NH 3 ) se utilizaron para el crecimiento epitaxial como precursores de fuentes de Ga, In y N, respectivamente, en los que H 2 y N 2 fueron el gas portador del crecimiento de GaN e InGaN, respectivamente. MQW consta de dos períodos de QW de InGaN / GaN. Durante el crecimiento de cada capa de pocillo, el caudal de TMIn se mantuvo constante. A continuación, se hizo crecer una capa superior de GaN a la misma temperatura que la capa, es decir, 710 ° C. Posteriormente, la temperatura se elevó a 830 ° C y se mantuvo durante varios segundos, y luego la capa de barrera se hizo crecer a 830 ° C. Ambas muestras A y B se cultivan en las mismas condiciones, excepto el tiempo de crecimiento de la capa superior de GaN, es decir, es 30 s para la muestra A y 200 s para la muestra B. El diagrama esquemático de la estructura y los parámetros de crecimiento de dos MQW de InGaN / GaN A y B se muestran en la Fig. 1.
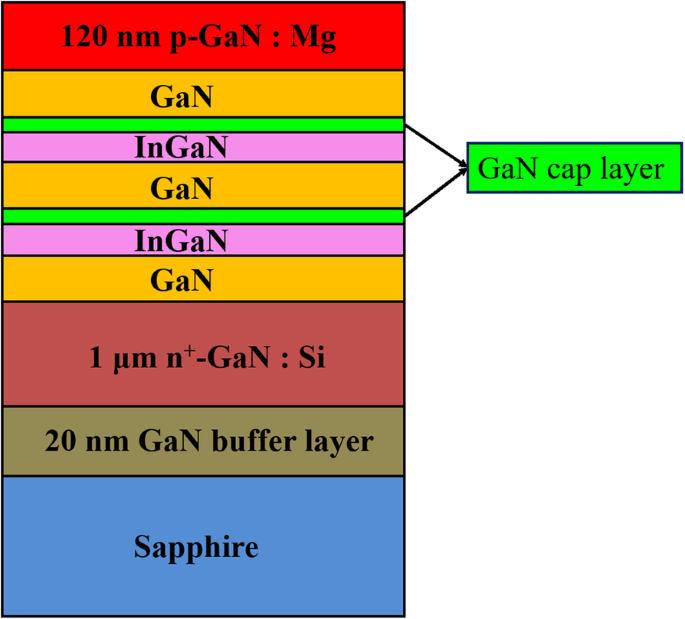
El diagrama esquemático de la sección transversal de las estructuras de la epilayer de dos MQW
Caracterización
Para determinar el contenido promedio de indio, el espesor del período y la calidad del material de dos MQW de InGaN / GaN, se realiza una medición de difracción de rayos X de alta resolución (HRXRD) con Rigaku Ultima IV con radiación Cu-Ka (λ =1,54 Å) que funcionó a 40 kV y 30 mA. Para las mediciones de fotoluminiscencia dependiente de la temperatura (TDPL) y PL dependiente de la potencia de excitación (PDPL), se utilizó un láser de 405 nm como fuente de luz de excitación con un tamaño de punto de 0,5 mm 2 , y la potencia de excitación varió de 0,01 a 50 mW. Las muestras se montaron en un criostato de He de ciclo cerrado y la temperatura se controló de 10 a 300 K.
Resultados y discusiones
Para investigar las propiedades estructurales de dos muestras A y B, se llevaron a cabo exploraciones simétricas ω-2θ (0002), como se muestra en la Fig. 2a. El pico del sustrato se origina en el plano GaN (002) y los picos satélite proceden de los MQW. Los picos de satélite hasta el cuarto orden se pueden observar claramente en las dos muestras, lo que indica una buena periodicidad de capa. Además, la composición promedio de indio y el espesor periódico se pueden obtener ajustando las curvas medidas, como se muestra en la Tabla 1. Se puede ver que a medida que aumenta el espesor de la capa superior, el espesor de la barrera de GaN y el espesor y la composición de indio de InGaN bien las capas aumentan ligeramente. En realidad, debido a que la tasa de crecimiento de la capa superior es tan pequeña como 0,006 nm / sy la temperatura de crecimiento es tan baja como 710 K, el cambio del espesor de la barrera es relativamente pequeño. Sin embargo, teniendo en cuenta que el crecimiento de capas de capa de GaN adicionales puede tener influencias no solo en el grosor de la capa de barrera, sino también en la difusión, evaporación y redistribución de átomos de In en las capas de pozos de InGaN, como se discutirá en detalle más adelante.

HRXRD realiza escaneos de omega-2theta y mapeo del espacio recíproco de ambas muestras. un Curvas HRXRD Omega-2theta en el plano GaN (0002) para las muestras A y B. b Mapeo del espacio recíproco (RSM) para la difracción de GaN (10-15) de la muestra A
Mientras tanto, para examinar el estado de deformación de las capas GaN QB e InGaN QW, se realiza el mapeo del espacio recíproco (RSM) en las proximidades del plano GaN (10-15). El resultado de la muestra A se muestra en la Fig. 2b (La figura RSM de B es similar, pero no se muestra aquí). Podemos observar que para la muestra A, los picos de satélite de MQW y el pico de GaN se alinean bien en la misma línea vertical, lo que indica que los MQW de ambas muestras están completamente tensos sin ninguna relajación [23].
La Figura 3 muestra las mediciones de PDPL para dos muestras a 10 K. Es interesante encontrar que las dos muestras exhiben comportamientos bastante diferentes. Para la muestra A, hay un pequeño pico ubicado en el lado de menor energía (pico A 1 ) del pico dominante A 2 . Se confirma que el pico A 1 es una réplica de fonón que está a 92 meV del pico principal A 2 . La réplica fonética de B 2 también aparece en la muestra B y se denomina pico B 1 . Por otro lado, en la Fig. 3b, se puede observar que solo hay un pico de luminiscencia dominante B 2 con potencia de excitación inferior a 5 mW. Sin embargo, cuando la potencia de excitación es superior a 10 mW, otro pico B 3 aparece anormalmente en el lado de mayor energía de B 2 y pico B 3 gradualmente se convierte en el pico de emisión dominante en lugar del pico B 2 cuando la potencia de excitación aumenta más. Aquí, podemos suponer que la mayoría de los portadores ópticos excitados quedaron atrapados primero en el primer tipo de estados electrónicos (por ejemplo, estados localizados creados por los grupos locales ricos en In), y luego se recombinan radiativamente, produciendo un pico de luminiscencia A 2 y B 2 . [24].
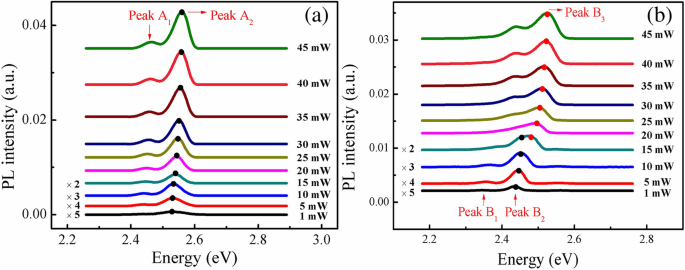
Espectros PL de las muestras A ( a ) y B ( b ) a varias potencias de excitación diferentes, medidas a temperaturas de 10 K
Examinar el comportamiento del pico anómalo B 3 de la muestra B además, hemos realizado las mediciones de TDPL bajo diferentes potencias de excitación mostradas en la Fig. 4, en la que las Fig. 4a yb son los espectros de PL obtenidos con potencia de excitación de 5 mW y 40 mW, respectivamente. Tenga en cuenta que el fenómeno de dos picos de los espectros de emisión en la Fig.4b se vio claramente a temperaturas por debajo de 200 K y se volvió borroso hacia 300 K. Resumiendo el comportamiento de los espectros de emisión, se puede ver que la transición del pico de emisión de baja energía al El pico de emisión de alta energía se produce en un rango estrecho de potencia de excitación y tiene un carácter de "conmutación". Fuera de la región de transición estrecha, una sola energía baja ( B 2 ) o de alta energía ( B 3 ) el pico de emisión domina a potencias de excitación bajas y altas, respectivamente.
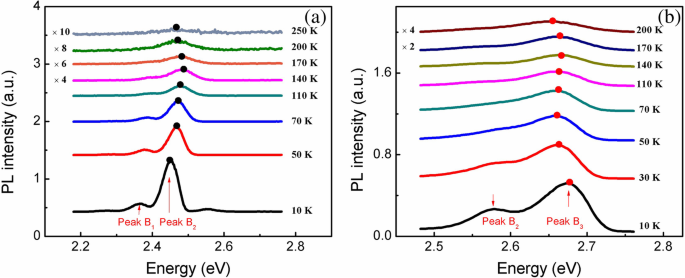
Espectros PL de la muestra B en un rango de temperatura de 10 a 300 K, medidos con potencias de excitación de 5 mW ( a ) y 40 mW ( b )
Además, una inspección más cercana de la variación de la energía pico de emisión dominante con la temperatura de ambas muestras, podemos encontrar algo único. Como se muestra en la Fig. 5a, cuando la potencia de excitación aumenta de 5 a 40 mW para la muestra A, la variación de la energía pico PL con el aumento de temperatura (llamada curva ET a continuación) muestra curvas de "forma de V invertida", que es diferente de la normal. Forma de “S”. La forma de V invertida casi no cambia con el aumento de la potencia de excitación, excepto por un desplazamiento general hacia el azul de la energía máxima. La dependencia de la temperatura en forma de "V" invertida se explica como una acción conjunta del efecto de llenado del portador en los centros luminiscentes y el efecto de contracción de la banda prohibida acompañado de un aumento de la temperatura [25, 26]. Por otro lado, como se muestra en la Fig. 5b, las curvas E-T para la muestra B con una potencia de excitación inferior a 5 mW muestran una forma de V invertida. Esta situación es similar a la de la muestra A. Sin embargo, cuando la potencia de excitación aumenta gradualmente a 40 mW, aparece un primer corrimiento al rojo en el rango de temperatura más bajo y las curvas E-T tienen una forma de S regular. Aparentemente, este fenómeno contradice la expectativa de que cuando la potencia de excitación es lo suficientemente grande, el efecto de localización desaparecerá por completo y el comportamiento de la temperatura de la energía máxima seguirá de cerca la ley de Varshni [27].

Energía pico de emisión de PL en función de la temperatura para las muestras A ( a ) y B ( b ) bajo diferentes potencias de excitación. Las líneas continuas son curvas de ajuste teóricas que utilizan el modelo LSE. Los puntos son los datos del experimento
Por lo tanto, para explicar cuantitativamente la dependencia de potencia óptica excitada anómala observada de la luminiscencia de los estados localizados, se empleó el modelo de luminiscencia LSE para ajustar las curvas E-T, propuesto por Q. Li et al. Este modelo se puede utilizar en todos los rangos de temperatura, y no solo puede ajustarse a las curvas E-T en forma de “S”, sino también a las formas de “V” o “V” invertida. Además, también se demostró que el modelo LSE se puede reducir al modelo de cola de banda de Eliseev et al. A altas temperaturas [24, 25]. En este modelo, el pico de energía en función de la temperatura se puede describir como [18,19,20,21]:
$$ E (T) =\ left ({E} _0- \ frac {\ alpha {T} ^ 2} {\ theta + T} \ right) - {xk} _BT $$ (1)donde θ es la temperatura de Debye del material específico y a es el parámetro Varshni, k B es la constante de Boltzmann y x se puede resolver numéricamente mediante la siguiente ecuación trascendental [18,19,20,21]:
$$ {xe} ^ x =\ left [{\ left (\ frac {\ sigma} {k_BT} \ right)} ^ 2-x \ right] \ left (\ frac {\ tau_r} {\ tau_ {tr} } \ right) {e} ^ {\ left ({E} _0- {E} _a / {k} _BT \ right)} $$ (2)donde σ es la desviación estándar de distribución de los estados localizados. En otras palabras, significa el ancho de la distribución de densidad de estado de tipo gaussiano. τ r y τ tr representan la recombinación radiativa y la vida útil de escape del portador localizado, y por lo tanto τ r / τ tr implica la parte de portadores que se recombina de forma no radiativa. E 0 es la energía central de los centros localizados, y E a da un nivel de "marcado" por debajo del cual todos los estados localizados están ocupados por transportistas a 0 K, que es como el nivel de cuasi-Fermi en la distribución de Fermi-Dirac. Es obvio que E 0 y E a juntos están relacionados con el origen de los centros localizados de luminiscencia [17].
Los parámetros de ajuste obtenidos de ambas muestras se muestran en la Tabla 2. Para la muestra A, la energía central E 0 y E a cambia a 19 meV y 18 meV de 5 a 40 mW, respectivamente. Se nota que el E 0 - E a y σ casi no ha cambiado. Se debe a que a medida que aumenta la potencia excitada, más y más transportistas estarán entusiasmados. Primero, los portadores fotogenerados examinarán el fuerte campo piezoeléctrico de los pozos de InGaN, lo que conducirá a un aumento de la energía central E 0 . En segundo lugar, cada vez más operadores ocuparán estados electrónicos más altos de acuerdo con el efecto de llenado, lo que da como resultado el aumento del nivel de cuasi-Fermi de los operadores localizados E a . Por lo tanto, E 0 - E a representa la acción conjunta del efecto de pantalla de polarización y el efecto de relleno del portador y, por lo tanto, se observa un desplazamiento hacia el azul general en la posición del pico para la muestra A. A diferencia de la muestra A, para la muestra B, de 5 a 40 mW, hay mayores aumentos de E 0 y E a , 73 meV y 57 meV, respectivamente. E 0 - E a aumentar en 16 meV, τ r / τ tr cambios en varios órdenes de magnitud, y σ disminuye un poco. Tales cambios son tan grandes que tenemos que asumir que el origen de los centros de luminiscencia es diferente a diferentes potencias de excitación de 5 mW y 40 mW.
Por lo tanto, se sugiere que para la muestra B, hay dos tipos de estados de localización, que se distribuyen a dos profundidades de energía diferentes en las capas del pozo debido a la distribución no homogénea de la composición de indio, es decir, con una composición de indio más alta (estados de localización profunda) y una menor composición de indio (estados de localización superficial). Además, para explicar el fenómeno anterior de la muestra B, los diagramas esquemáticos que indican el posible mecanismo de redistribución de la portadora entre dos tipos de estados localizados se representan en la Fig. 6. A 10 K, bajo una potencia de excitación más baja, como 5 mW, se muestra En la Fig. 6a, la mayoría de los portadores ópticos excitados primero quedan atrapados en el primer tipo de estados electrónicos (estados localizados profundos) y, por lo tanto, domina el pico de energía más bajo, mientras que a 40 mW, como se muestra en la Fig. 6b, se fotogenera cada vez más. los portadores ocuparán el nivel de energía más alto, y luego los estados localizados poco profundos con la densidad de estado de energía más alta también se llenan y, por lo tanto, el pico de energía más alto domina gradualmente con el aumento de la potencia excitada. Por lo tanto, E 0 y E a aumentar mucho, y τ r / τ tr aumentar en varias órdenes que implican la capacidad de escape de los transportistas fuera de los estados localizados. A medida que la temperatura aumenta a 30 K, a 5 mW, como se muestra en la Fig. 6c, los portadores fotogenerados con una cierta cantidad de energía térmica se utilizan principalmente para llenar los estados localizados más profundos, lo que resulta en un primer desplazamiento hacia el azul de las curvas E-T; sin embargo, en la Fig. 6d, cuando se trata de 40 mW, basado en el supuesto de que los estados localizados poco profundos tienen más capacidad que los estados localizados profundos, la mayoría de los portadores fotogenerados permanecen en estados localizados poco profundos y podrán transferir a estados localizados profundos que tienen una gran capacidad para unir portadores. Por lo tanto, las curvas E-T se desplazan al rojo. En otras palabras, los cambios anormales de apariencia de las curvas ET están relacionados con múltiples tipos de estados de localización debido a la distribución no homogénea del indio en las capas de pozos de InGaN de la muestra B. Y se supone que tales fluctuaciones de composición se deben principalmente a las fluctuaciones aleatorias de la aleación en un escala atómica [28].

Diagramas esquemáticos que indican el posible mecanismo de variación anómala de la energía pico PL vs curvas T con diferentes potencias de excitación. Las distribuciones de portadoras a una T inferior (10 K) se muestran en ( a ) y ( b ) para P =5 mW y 40 mW, respectivamente. Las distribuciones de portadoras a una T superior (30 K) se muestran en ( c ) y ( d ) para P =5 y 40 mW, respectivamente
Además, la aparición de un pico de emisión de alta energía bajo una alta potencia de excitación de la muestra B también conduce a una variación anómala de la intensidad integrada de PL. En la Fig. 7, se representan gráficamente las curvas integradas de intensidad frente a temperatura de las muestras A y B medidas a potencias de excitación de 5 mW y 20 mW, respectivamente. Primero, tenga en cuenta que la extinción térmica de la muestra B es obviamente más rápida que la de la muestra A. Generalmente, la extinción térmica de luminiscencia de los MQW de InGaN está dominada por los procesos de recombinación no radiativa que pueden describirse mediante la ecuación de Arrhenius. Por lo tanto, la extinción térmica rápida implica una mala estabilidad térmica de la muestra B. Además, cuando la potencia de excitación es lo suficientemente alta, el impacto de los centros de recombinación no radiativa a temperaturas relativamente bajas no será tan significativo, porque los centros de recombinación no radiativa se saturan fácilmente. por exceso de portadores [27]. Esto puede explicar perfectamente la variación más lenta de la intensidad integrada PL frente a las curvas 1 / T con el aumento de la potencia de excitación de la muestra A. Sin embargo, es bastante interesante para la muestra B que la intensidad integrada normalizada bajo potencia de excitación de 5 mW sea incluso mayor que por debajo de 20 mW cuando la temperatura es inferior a 125 K, y resulta ser opuesta a temperaturas superiores a 125 K. Como se mencionó anteriormente, se supone que solo un pico de emisión de energía menor que se origina en estados localizados profundos es dominante a 5 mW, mientras que otro superior originado en estados localizados poco profundos se vuelve dominante a 20 mW. Por lo tanto, se concluye que los centros de luminiscencia localizados profundos tienen una mejor eficiencia de luminiscencia que los centros de luminiscencia poco profundos. Esto concuerda bien con el resultado de la investigación anterior relacionada con los estados localizados [28]. Por lo tanto, también se puede probar, hasta cierto punto, que hay dos tipos de estados localizados excitados a 20 mW para la muestra B.
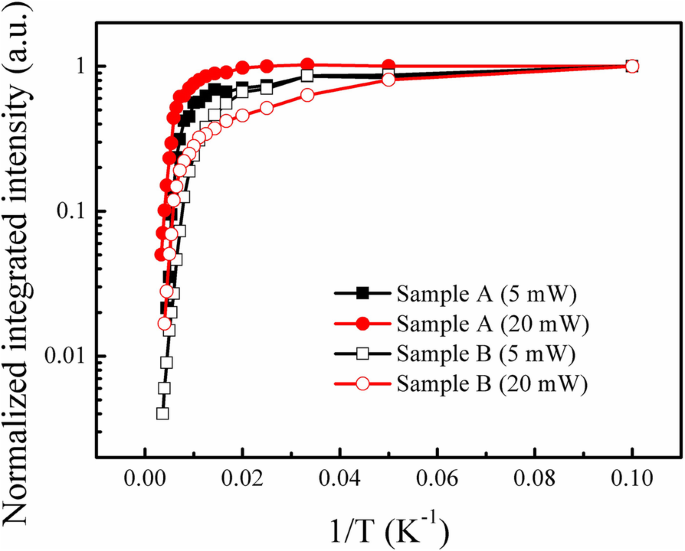
La intensidad integrada extraída de los espectros PL de ambas muestras en un rango de temperatura de 10 a 300 K, medida con potencias de excitación de 5 mW y 20 mW
Según todos estos análisis, demostramos que el pico B 3 se origina en los estados de localización con menor potencial relacionados con la distribución no homogénea de la composición de indio de la muestra B. Concuerda bien con los resultados experimentales del pico de energía de emisión más alto B 3 y la reducción del IQE de la muestra B a bajas temperaturas bajo mayor potencia de excitación. En realidad, en el proceso de crecimiento de QW, considerando los efectos de arrastre, los átomos de indio tienden a acumularse en la parte superior de la capa de InGaN QW y forman una capa adicional conocida como capa flotante de indio [29]. El crecimiento de la capa superior de GaN más gruesa a baja temperatura es perjudicial para la evaporación de estos átomos flotantes de indio. En consecuencia, los átomos de In pueden incorporarse en la capa superior de GaN y la capa de barrera después del crecimiento QW [30]. Naturalmente, este comportamiento dará como resultado un aumento del grosor de la capa del pozo y, por lo tanto, se mejora la QCSE. La tensión más alta y el campo piezoeléctrico más fuerte en el QW activo inducirían una relajación más localizada y, por lo tanto, potenciales localizados más profundos y barreras más altas. Mientras tanto, se introducen más dislocaciones y defectos en el crecimiento posterior de la capa de barrera de GaN. Generalmente, existe una gran tensión de tracción cerca de las dislocaciones, y los átomos de indio pueden tender a acumularse cerca de las dislocaciones y distribuirse de manera no homogénea. [31, 32] Por lo tanto, en el crecimiento de la capa de pozos de InGaN, hay más áreas ricas y pobres en indio asociadas con el aumento de la densidad de dislocaciones. Significa que la escala de fluctuaciones del indio aumentará a medida que aumente el espesor de la capa de cobertura. En nuestros experimentos, muestra que se introducen dos tipos diferentes de estados de localización en la muestra B con una capa superior más gruesa, y el pico PL de mayor energía de emisión se activa con una mayor potencia de excitación. Por otro lado, el portador fotogenerado que permanece en estados localizados profundos puede filtrar los defectos y, por lo tanto, tiene una mejor estabilidad térmica, mientras que el portador fotogenerado que permanece en estados localizados poco profundos será capturado por la recombinación no radiativa relacionada con el defecto una vez que puedan superar el problema. altura de barrera relativamente menor.
Conclusiones
En resumen, las muestras de pozos multi-cuánticos (MQW) de InGaN / GaN con diferentes espesores de capas de capa de GaN que se cultivan adicionalmente en las capas de pozos de InGaN se preparan mediante un sistema de deposición de vapor químico metalorgánico (MOCVD). Sus propiedades estructurales y ópticas se investigan y analizan mediante mediciones de HRXRD, TDPL y PDPL. Los resultados de PDPL muestran que un pico de energía de alta emisión adicional se excita a una potencia de excitación más alta solo para la muestra B que se cultiva con capas de cubierta gruesas. Mientras tanto, los resultados de TDPL medidos a diferentes potencias de excitación para la muestra B revelan que las curvas E-T del pico PL dominante cambian de forma de V invertida a forma de S regular cuando aumenta la potencia de excitación. Además, se encontró una peor estabilidad térmica de la muestra B a alta potencia de excitación. Estos fenómenos anómalos implican que hay dos tipos de estados localizados de la muestra B que son inducidos por la distribución relativamente no homogénea del indio. Estas conclusiones nos brindan una mayor comprensión del mecanismo de fotoluminiscencia de los pozos cuánticos verdes de InGaN / GaN y el efecto de inhomogeneidad a un nivel de excitación alto que puede ayudarnos en la fabricación de diodos láser de InGaN / GaN.
Abreviaturas
- HRXRD:
-
Difracción de rayos X de alta resolución
- LD:
-
Diodos láser
- LED:
-
Diodos emisores de luz
- LSE:
-
Conjunto estatal localizado
- MOCVD:
-
Sistema de deposición de vapor químico metalorgánico
- MQW:
-
Pozos multi-cuánticos
- NH 3 :
-
Amoníaco
- PDPL:
-
Fotoluminiscencia dependiente de la potencia
- RSM:
-
Mapeo del espacio recíproco
- TDPL:
-
Fotoluminiscencia dependiente de la temperatura
- TMGa:
-
Trimetilgalio
- TMIn:
-
Trimetilindio
Nanomateriales
- El reordenamiento atómico de múltiples pozos cuánticos basados en GaN en gas mixto H2 / NH3 para mejorar las propiedades estructurales y ópticas
- El diseño de la capa de emisión para multiplicadores de electrones
- Emisión multicolor de una estructura de nanopiramida cuasicristalina fotónica ultravioleta basada en GaN con múltiples pozos cuánticos semipolares InxGa1 − xN / GaN
- Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
- Puntos cuánticos de bismuto en pozos cuánticos de GaAsBi / AlAs recocidos
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente



