Modelo de retención de TaO / HfO x y TaO / AlO x RRAM con características de interruptor autorrectificante
Resumen
Un modelo de comportamiento de retención para auto-rectificación de TaO / HfO x - y TaO / AlO x Se propone una memoria resistiva de acceso aleatorio (RRAM). La RRAM de tipo trampa puede tener un estado de alta resistencia (HRS) y un estado de baja resistencia (LRS); la degradación en un LRS suele ser más severa que en un HRS, porque el LRS durante el proceso SET está limitado por la capa de resistencia interna. Sin embargo, si TaO / AlO x Los elementos se apilan en capas, se puede mejorar la retención de LRS. El tiempo de retención de LRS estimado por el método de extrapolación es de más de 5 años a temperatura ambiente. Ambos TaO / HfO x - y TaO / AlO x Las estructuras basadas en RRAM tienen la misma capa de cobertura de TaO, y los niveles de energía de activación de ambos tipos de estructuras son de 0,38 eV. Además, el adicional AlO x capa de conmutación de un TaO / AlO x La estructura crea una barrera de difusión de O más alta que puede mejorar sustancialmente la retención, y el TaO / AlO x La estructura también muestra un LRS bastante estable en condiciones sesgadas.
Antecedentes
Debido a que la tecnología flash NAND se enfrenta a un límite de escala, los diseños de memoria de acceso aleatorio resistiva vertical (VRRAM) con pocas pilas de película, altos rendimientos de fabricación y sin problemas de acoplamiento cruzado son candidatos prometedores para aplicaciones de memoria de alta densidad [1,2,3 ]. La arquitectura 1TnR con estructura vertical tridimensional (3D) ayuda a obtener un costo de bits ultrabajo para arreglos densos altamente compactos [4, 5, 6]. Varios investigadores han propuesto operar RRAM a niveles de corriente bajos cambiando el mecanismo de conmutación de resistencia de un tipo filamentario a un modelo de ruta de conducción de tipo de atrapamiento de defectos, modulación de vacantes o interfaz [7, 8, 9]. Sin embargo, las cuestiones fundamentales para los fallos de retención y la migración de las vacantes de oxígeno siguen sin resolverse [3, 10]. En algunos estudios de retención de tipo filamentoso, se han propuesto muchos modelos diferentes para explicar las pérdidas de retención [11,12,13]. El cambio de mecanismo de conmutación también indica una dirección diferente que podría mejorar la retención [11]. Nuestros estudios anteriores han demostrado que TaO / HfO x Los dispositivos pueden mostrar valores de no linealidad favorables de aproximadamente 40, valores de resistencia superiores a 1000 ciclos y retención de datos de 85 ° C [6, 7]. Sin embargo, obtener una retención estable a niveles de corriente de funcionamiento tan bajos sigue siendo un desafío. En esta carta, se propone un modelo de retención para realizar la pérdida de retención en dos dispositivos diferentes del tipo de atrapamiento de defectos con el método de Arrhenius. La energía de activación extraída no explica de manera convincente la mejora de la retención por el AlO x capa. Aunque el original era ambiguo, la interpretación más probable es que la unión densa facilita la retención.
Métodos
En la fabricación de TaO / HfO x y TaO / AlO x dispositivos para el presente estudio, el electrodo inferior (BE) está compuesto de metal TiN depositado por deposición física de vapor (PVD) en 8 pulgadas. sustratos de óxido térmico / Si. Cada BE fue modelado y grabado con un proceso de grabado y litografía convencional. Después de que cada TiN BE se había grabado con gas a base de cloro, el fotorresistente restante (PR) y los residuos de grabado se eliminaron utilizando un sistema de plasma remoto que aplicó O 2 y H 2 O a 180 ° C. Durante el proceso de eliminación de PR, se formó una fina capa de oxidación de TiON en la superficie de cada TiN BE. Luego, capas de conmutación resistivas de HfO x y AlO x se prepararon mediante deposición de capa atómica (ALD) con HfCl 4 -H 2 O y TMA-H 2 O precursores, respectivamente. Los dos elementos resistivos HfO x y AlO x se depositaron a 300 y 250 ° C. En la parte superior de las capas de conmutación resistivas, la capa de TaO fue depositada por PVD a través de oxidación por plasma a baja temperatura (LTPO) [14]. Esta fabricación deposita Ta metal a una velocidad ultrabaja (0,2 Å / s). La oxidación de plasma estable se realizó con una mezcla de Ar y O 2 gases. Esta capa de TaO sirvió como una resistencia interna de autocomplacencia, que tenía relativamente fugas en comparación con las películas de conmutación resistivas anteriores [7]. El electrodo superior también fue PVD-TiN. Las vistas transversales y la información de espesor del TaO / HfO x y TaO / AlO x los dispositivos de memoria se ilustran en la Fig. 1a, b respectivamente. El espesor de la película de TaO / HfO x se comprobó mediante microscopía electrónica de transmisión (no se muestra). Una vez modeladas las células, se depositó el óxido a baja temperatura para pasivación a 250 ° C. Finalmente, se aplicó un proceso de back-end convencional para terminar la fabricación de estructuras de contacto y almohadillas metálicas.

Gráficos esquemáticos de celdas con información de espesor para a TaO / HfO x dispositivos y b TaO / AlO x dispositivos. Ambas gráficas describen dispositivos para los cuales PVD depositó las capas de TaO con procesos de LTPO, y las capas interfaciales inferiores de TiON se formaron por oxidación del plasma durante la eliminación de la fotorresistencia
Resultados y discusión
Las mediciones eléctricas se realizaron con un analizador de parámetros de semiconductores HP4156C. La densidad de corriente establecida y restablecida ( J ) versus voltaje ( J - V ) curvas de TaO / HfO x y TaO / AlO x los dispositivos se muestran en la Fig. 2a, b respectivamente. Ambos estados de resistencia iniciales ( R inicial ) del TaO / HfO x y TaO / AlO x los dispositivos eran HRS. Los dispositivos de memoria virgen se programaron para LRS con sesgo positivo y se barrieron hacia atrás. Luego, cada celda se cambió de LRS a HRS mediante la aplicación de voltaje negativo. Ambos J – V los gráficos contienen tres tamaños de celda, a saber, 0,1, 0,56 y 25 μm 2 . En el J – V gráficos, todas las curvas de dispositivos con diferentes áreas se parecen entre sí, lo que indica tanto TaO / HfO x y TaO / AlO x los dispositivos tenían (i) la misma densidad de corriente en el estado inicial, (ii) voltajes de activación y reinicio similares, y (iii) la misma densidad de corriente en LRS y HRS. Además, la propiedad de densidad de corriente constante está claramente ilustrada por la resistencia frente al área ( R - A ) parcelas en la Fig. 2c, d. La fuerte dependencia del área tanto en R inicial y LRS se puede observar mediante el control de la densidad de corriente. Independientemente de la escala del área de la celda y la corriente de cumplimiento, la misma relación de resistencia de encendido / apagado se mantiene en ambos dispositivos. Esta característica del interruptor de densidad de corriente constante implica que las celdas de memoria están programadas o borradas uniformemente por el campo eléctrico. Se considera que estos dispositivos tienen propiedades de conmutación de tipo trampa, que se relacionan en gran medida con la modulación de las vacantes [8]. En el caso de RRAM de tipo atrapamiento, no se han observado saltos bruscos de corriente durante el proceso de lance, pero se han observado comúnmente saltos de corriente bruscos para RRAM de tipo filamentoso. En la presente investigación, se observaron diferentes voltajes de conmutación para las diferentes capas de conmutación con HfO x o AlO x . El rango de voltaje establecido de un TaO / AlO x dispositivo es de 4 a 4,5 V, que es más grande que el de un TaO / HfO x dispositivo (3 a 4 V). El rango de voltaje de reinicio de un TaO / AlO x dispositivo es de −1,5 a −2,5 V, que es más grande que el de un TaO / HfO x dispositivo (−0,5 a −1,5 V). Un AlO x El sistema consume más energía para completar el ajuste y restablecer los interruptores que un HfO x el sistema consume. Durante la configuración de los interruptores, las capas de conmutación HfO x y AlO x lograr averías suaves a voltajes de aproximadamente 3 y 3,5 V, respectivamente. En ambos tipos de dispositivos, antes de que se formen filamentos en la capa de conmutación, la corriente está limitada por la resistencia interna de la capa de TaO. Durante el proceso de autocumplimiento de la RRAM de tipo atrapamiento, se generan vacantes de oxígeno excesivas dentro de la capa de conmutación [7]. Esas vacantes de oxígeno se recombinan durante el proceso de reinicio de polarización negativa. A diferencia de la RRAM de tipo filamentoso, el HRS siempre es más bajo que el estado de resistencia inicial (IRS) después de una operación de reinicio [15,16,17]. En resumen, la captura de defectos es un proceso que modula las vacantes mediante la recombinación de las vacantes de iones de oxígeno para controlar la variación de resistencia en la capa de conmutación. Comparado con un HfO x capa de conmutación, la captura de defectos provoca un voltaje y potencia más altos en el AlO x capa durante la configuración y el restablecimiento de un interruptor.
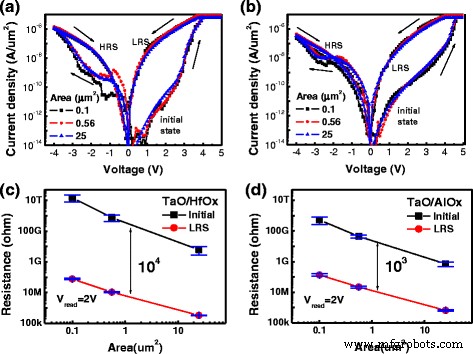
Densidad de corriente con trazado de voltaje de a TaO / HfO x dispositivos con diferentes tamaños de celda. b TaO / AlO x dispositivos con diferentes tamaños de celda. La resistencia frente a la gráfica de área de c a TaO / HfO x dispositivo y d a TaO / AlO x dispositivo. Ambos gráficos contienen el IRS y LRS con voltaje de lectura =2 V. Cada punto de datos proporciona el promedio de 10 dispositivos y la desviación estándar correspondiente
Después de investigar el comportamiento de conmutación, se investigaron los comportamientos de retención de HRS y LRS de las unidades de memoria de tipo atrapamiento. Las gráficas de la variación de la resistencia en función del tiempo a 85 ° C y 1 V para el TaO / HfO x y TaO / AlO x los dispositivos se muestran en la Fig. 3a, b. En ambos gráficos, la variación LRS es más pronunciada que la variación HRS. La estabilidad de resistencia de TaO / AlO x es mayor que la de TaO / HfO x . Las cifras ilustran que los HRS tendían a desplazarse hacia los IRS para ambos tipos de dispositivos; los IRS están marcados con líneas discontinuas en la Fig. 3a, b. La tendencia de la resistencia que regresa al estado virgen del dispositivo se muestra en la Fig. 3c para TaO / AlO x y en la Fig. 3d para TaO / HfO x . Para darse cuenta de esto, ambos tipos de dispositivos se programaron inicialmente para LRS a temperatura ambiente, como se muestra en el I – V barridos (línea negra). Luego, el TaO / AlO x y TaO / HfO x Los dispositivos se hornearon en hornos a 150 ° C durante 48 hy a 120 ° C durante 120 h, respectivamente. Para ambos casos, el I – V El barrido después de haber sido horneado fue similar al barrido inicial. Mediante este procedimiento, los LRS de los dispositivos de tipo trampa volvieron a su estado original después de un tiempo en un entorno de alta temperatura. A diferencia de los dispositivos de tipo filamento, que presentan un movimiento notable de átomos de oxígeno, los dispositivos de tipo atrapamiento tienen pares de iones de oxígeno y vacantes separados por distancias cortas. La tendencia a la deriva de la resistencia al estado inicial está relacionada con su cristalinidad original, que está controlada principalmente por la temperatura de proceso de ALD. Como resultado, los LRS en ambos tipos de dispositivos se pueden restablecer a HRS (o IRS) por sesgo negativo o energía térmica. Esta propiedad es diferente con la RRAM filamentaria.
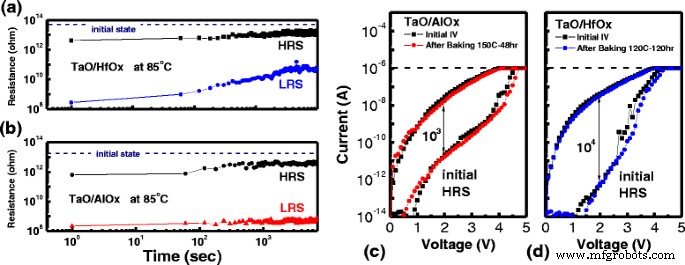
Gráficos de variación de resistencia frente al tiempo para a TaO / HfO x y b TaO / AlO x dispositivos. Ambas gráficas contienen variación HRS y LRS a voltaje de lectura =1 V en 85 ° C. Después del I - V Se establecieron barridos de cada dispositivo virgen, el dispositivo se horneó y luego se programó para LRS nuevamente: c TaO / AlO x (150 ° C durante 48 h); d TaO / HfO x (120 ° C durante 120 h)
En las pruebas de retención estándar para memoria no volátil, la retención de datos se prueba tanto a temperatura ambiente como a alta temperatura; los dispositivos deben poder retener datos tanto a temperatura ambiente como a alta temperatura para que sean útiles en aplicaciones reales. Energía de activación ( E a ) La extracción por el método de Arrhenius en el gráfico de retención es un método común para evaluar la retención de datos [18, 19]. Como puede verse en la Fig. 3a, la variación LRS es más pronunciada que la variación HRS. Por lo tanto, la relación de resistencia ( R proporción ) de LRS frente al tiempo de horneado a temperaturas que oscilan entre 30 y 150 ° C. Un ejemplo de extracción de tiempo de retención de un TaO / AlO x dispositivo se muestra en la Fig. 4a. La tasa de degradación de la resistencia se puede calcular mediante la pendiente del ajuste lineal en log ( R proporción ) -log (tiempo) escala. Considerando la relación máxima de resistencia de encendido / apagado de aproximadamente 10 3 para un TaO / AlO x dispositivo, como se muestra en la Fig. 3c, un tiempo de retención con 10 3 veces se puede calcular la variación LRS. La retención de datos de LRS estimada a temperaturas de medición que oscilan entre 30 y 150 ° C se muestra en la Fig. 4b. Cada punto de datos representa información de más de 18 dispositivos para ambos tipos de dispositivos. En un TaO / AlO x dispositivo, la retención de datos es tan alta como 10 6 sa 150 ° C y 2 × 10 8 s (aproximadamente 5 años) a temperatura ambiente; esos tiempos son casi 10 1,5 veces más largos que los de un TaO / HfO x dispositivo. El punto más interesante es que tanto TaO / HfO x y TaO / AlO x los dispositivos muestran el mismo E a =0,38 eV, calculado a partir de la pendiente extraída. El mismo E a implica que ambos tipos de dispositivos experimentan reacciones químicas similares en el proceso de degradación de LRS. Este E a participa en todos los procesos cinéticos activados térmicamente, incluida la liberación de iones de oxígeno cerca de las interfaces TaO y los procesos de difusión de oxígeno en AlO x y HfO x capas. Sin embargo, los coeficientes de autodifusión de oxígeno de HfO x y AlO x las capas son diferentes a altas temperaturas (> 1000 ° C); las medidas exactas se pueden encontrar en la literatura [20, 21]. El coeficiente de difusión de oxígeno a baja temperatura (<200 ° C) también depende del espesor de HfO x dieléctricos [22]. Si los procesos de difusión en capas cambiantes dominan la reacción química, entonces el E a los valores deben ser diferentes debido a los diferentes coeficientes de difusión en HfO x y AlO x capas. Ambos tipos de dispositivos en este trabajo exhibieron el mismo E a =0,38 eV; esto estaba relacionado con el hecho de que ambos tipos de dispositivos tenían la misma capa de cobertura de TaO en la parte superior de las capas de conmutación. La degradación de LRS es un proceso de recombinación de vacantes e iones, lo que significa que la capa TaO controla esta reacción química y la mayoría de las vacantes están abarrotadas cerca de la interfaz entre TaO y la capa de conmutación. Esas vacantes prefieren permanecer en la interfaz de capa de conmutación / TaO; este fenómeno podría estar respaldado por el punto de vista de la estabilidad termodinámica, según lo informado por Zhong et al. [23]. En su simulación de TiN / Ta / HfO x / TiN, los iones de oxígeno prefirieron permanecer en Ta / HfO x interfaz porque existía una diferencia de baja energía entre Ta y HfO x [23]. En su simulación, como en los experimentos presentes, la capa resistiva de TaO atrapó la mayoría de los iones de oxígeno y dominó este proceso de recombinación de vacantes. La degradación de LRS se esquematiza en la Fig. 4c. Los iones de oxígeno vuelven al estado de equilibrio térmico anterior durante el proceso de horneado, lo que da como resultado una pérdida de retención. Se pueden notar diferencias entre Ta / HfO x dispositivo propuesto por Zhong et al. y el TaO / HfO x dispositivo en este estudio, pero en ambos estudios, la capa de TaO se formó por varios ciclos de deposición de metal Ta y procesos LTPO [14]. Debido al proceso LTPO, el TaO / HfO rico en metales x La interfaz se puede considerar como un depósito de iones de oxígeno. Durante el proceso de recombinación de los iones de oxígeno y las vacantes, la densidad de empaquetamiento del átomo juega un papel esencial. Las propiedades superiores de retención de LRS obtenidas en el AlO x La capa de cambio podría explicarse por la alta densidad atómica del AlO x capa. Es bien sabido que la longitud del enlace de Al – O es más corta que la de Hf – O [24, 25]. El enlace corto en el AlO x reduce la movilidad de los iones de oxígeno debido a la alta interacción de culombio, lo que da como resultado una barrera de difusión de alta vacancia de oxígeno. Esta barrera hace que el tiempo de retención sea mayor en un TaO / AlO x dispositivo que en un TaO / HfO x uno.
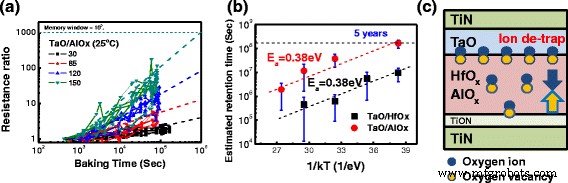
un Relación de variación de la resistencia frente al tiempo de horneado para diferentes temperaturas en TaO / AlO x dispositivos. La resistencia inicial promedio fue de 179 MOhm con un voltaje de lectura de 2 V, y la tasa de degradación de la resistencia LRS se calculó mediante el método de ajuste lineal en log ( R proporción ) –Escala log (T). b Tiempo de retención estimado (1000 ×) versus gráfico de 1 / kT. Cada punto contiene datos de 18 dispositivos tomados a un voltaje de lectura de 2 V. Las energías de activación extraídas fueron 0.38 eV tanto en TaO / AlO x y TaO / HfO x dispositivos. c Diagrama esquemático de retención de diferentes barreras de difusión de oxígeno en HfO x o AlO x con una capa de taponamiento TaO
Además, el modelo de pérdida de retención de un dispositivo de tipo filamentoso es diferente al de un dispositivo de tipo atrapador de defectos. El comportamiento de retención de la RRAM de tipo filamentoso está relacionado con la rotura del filamento, y la dirección de difusión de la vacante es lateral [11, 19, 24]. En la RRAM que atrapa defectos, la dirección de difusión del defecto es longitudinal, que es paralela al campo eléctrico externo. Por lo tanto, el comportamiento de retención puede verse afectado por la dirección y la magnitud de la polarización. La Figura 5a, b muestra la retención de polarización a través de la relación de resistencia para los dos dispositivos. La relación de resistencia se define como la resistencia del dispositivo de tensión a la resistencia del LRS. Un sesgo positivo puede ayudar a mantener el LRS, pero un sesgo negativo acelera el proceso de degradación. Esas propiedades de polarización podrían explicarse por la interacción entre el campo localizado de pares de iones de oxígeno y las vacantes y el campo eléctrico externo. Si la dirección del campo externo es la misma que la dirección establecida (positiva), se extiende el tiempo de retención; si el campo externo está en la dirección de reinicio (negativo), causa degradación. En un campo eléctrico bajo con ± 100 mV, la degradación por polarización es la misma que la degradación sin polarización en ambos tipos de dispositivos. Esta desviación de ± 100 mV podría estar cubierta por las compensaciones de banda de TiON-HfO x , TiON-AlO x y uniones TiN-TaO. A TaO / AlO x dispositivo con un alto sesgo positivo de 500 mV no muestra una degradación obvia.
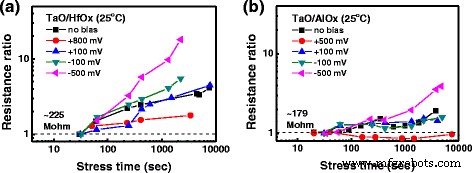
Relación de resistencia al sesgo frente al tiempo de estrés para a TaO / HfO x y b TaO / AlO x dispositivos a temperatura ambiente
Conclusiones
En resumen, comparamos dos tipos de dispositivos RRAM autorectificados a través de sus características de interruptor y analizamos sus comportamientos de retención. El TaO / AlO x El dispositivo mostró un voltaje de conmutación más alto y una estabilidad térmica LRS más robusta que el TaO / HfO x dispositivo lo hizo. El beneficio de una retención robusta de AlO x El cambio de capa se debe a la alta barrera de difusión de oxígeno más que a la energía de activación. La energía de activación de la pérdida de retención está relacionada con el proceso de eliminación de trampas de iones en la capa resistiva de TaO. La alta densidad atómica de AlO x la película puede mejorar la retención de LRS. Se ha propuesto un modelo esquemático de pérdida de retención y los resultados de retención en sesgo respaldaron este modelo. Este modelo podría ser beneficioso para el desarrollo de dispositivos RRAM de baja corriente, retención prolongada y autorregulación para futuras aplicaciones de memoria de alta densidad.
Nanomateriales
- Características y aplicaciones del titanio
- Circuito con un interruptor
- Liderando con persistencia y perseverancia
- switch…caso en C (Sentencia Switch en C) con ejemplos
- Nanomaterial inteligente y nanocompuesto con actividades agroquímicas avanzadas
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Síntesis fácil de compuesto de CuSCN coloreado y conductor recubierto con nanopartículas de CuS
- Biocompatibilidad mejorada en matrices anódicas TaO x nanotubos
- Mecanismo de conducción y resistencia mejorada en RRAM basado en HfO2 con tratamiento de nitruración



