Detector infrarrojo de longitud de onda larga P + –π – M – N + InAs / GaSb Superlattice de alto rendimiento pretratado con vulcanización anódica
Resumen
El detector de infrarrojos de superrejilla InAs / GaSb se ha desarrollado con un gran esfuerzo. Sin embargo, su rendimiento, especialmente los detectores infrarrojos de longitud de onda larga (LWIR), todavía está limitado por el rendimiento eléctrico y la eficiencia cuántica óptica (QE). Obligar a la región activa a ser p El tipo a través del dopaje adecuado puede mejorar en gran medida la QE, y la técnica de activación se puede emplear para mejorar en gran medida el rendimiento eléctrico. Sin embargo, el voltaje de polarización de saturación es demasiado alto. La reducción del voltaje de polarización de saturación tiene amplias perspectivas para la aplicación futura de dispositivos de control de voltaje de puerta. En este documento, informamos que el P + - π –M – N + Los detectores infrarrojos de longitud de onda larga superlattice InAs / GaSb exhiben diferentes niveles de dopaje en la región π que tienen un sesgo de saturación mínimo reducido a - 10 V con un SiO 2 de 200 nm capa después de un pretratamiento de vulcanización anódica simple y eficaz. El voltaje de polarización de la puerta de saturación es mucho más bajo que - 40 V que informó con el mismo grosor de un SiO 2 de 200 nm capa de pasivación y estructura similar. La caracterización óptica y eléctrica indica que el rendimiento eléctrico y óptico del dispositivo se vería debilitado por una concentración excesiva de dopaje. A 77 K, la longitud de onda de corte del 50% del dispositivo es de aproximadamente 8 µm, la longitud de onda de corte del 100% es de 10 µm, la eficiencia cuántica máxima es del 62,4%, la capacidad de respuesta máxima es de 2,26 A / W a 5 µm y la máxima RA del dispositivo es 1259,4 Ω cm 2 . Además, la detectividad específica del detector dopado con Be 780 ° C sin electrodo de puerta presenta un pico de 5,6 × 10 10 cm Hz 1/2 / W a 5 µm con una tensión de polarización inversa de 70 mv, que es más de tres veces la del detector dopado con Be 820 ° C. Además, la detectividad específica máxima podría aumentarse aún más a 1,3 × 10 11 cm Hz 1/2 / W a 5 µm con un voltaje de polarización de reserva de 10 mv que tiene una polarización de - 10 V en el electrodo de puerta.
Introducción
Las superredes de capa deformada de tipo II (T2SL) se han convertido cada vez más en el foco de la investigación actual desde que Sai-Halasz et al. [1] propuso su concepción. Se pueden generar detectores de infrarrojos de alto rendimiento diseñando cuidadosamente la estructura de la banda y la deformación de los T2SL [2]. La superrejilla InAs / GaSb, un miembro bien estudiado de las T2SL, es un excelente sistema de materiales que presenta amplias perspectivas en el detector de infrarrojos [3]. El detector de infrarrojos de superrejilla InAs / GaSb se ha desarrollado con un gran esfuerzo. Sin embargo, su rendimiento, especialmente los detectores infrarrojos de longitud de onda larga (LWIR), todavía está limitado por el rendimiento eléctrico y la eficiencia cuántica óptica (QE) [4]. La temperatura ambiente correspondiente (basada en tierra) del detector LWIR es de alrededor de 300 K, que corresponde a la longitud de onda máxima de 9,6 µm (el centro de la ventana de transmisión atmosférica LWIR) y tiene una amplia gama de aplicaciones [5]. Se utiliza ampliamente en varios campos, como la detección de gases, la visión nocturna, la alerta temprana por infrarrojos, la detección remota por infrarrojos y la guía por infrarrojos, no solo para uso militar sino también para la vida de las personas. Es extremadamente significativo y desafiante fabricar detectores infrarrojos de onda larga de alto rendimiento.
El diseño estructural y la preparación del proceso del detector tienen un impacto significativo en el rendimiento del detector LWIR. Aumentar el grosor de la región activa parecía ser la forma más directa y eficaz de mejorar la QE. Sin embargo, se introducen más centros de trampa junto con el aumento del grosor, lo que conduce a una reducción de las características eléctricas del detector. En el LWIR y los detectores infrarrojos de longitud de onda muy larga (VLWIR), la capa de InAs tiende a ser más gruesa que la capa de GaSb. Por lo tanto, el material es n -tipo (los portadores minoritarios son huecos). Obligar a la región activa a ser p -tipo mediante el dopaje adecuado puede aumentar considerablemente la QE sin ningún cambio en el tamaño de la región del dispositivo [6]. Sin embargo, no es que cuanto mayor sea la concentración de dopaje, mayor será la mejora en el rendimiento del dispositivo. En particular, el rendimiento eléctrico [7] y óptico del dispositivo podría verse debilitado por una concentración excesiva de dopaje.
Además de cambiar la concentración de dopaje en π En la región, la técnica de compuerta se ha aplicado recientemente en los detectores infrarrojos de longitud de onda media (MWIR) y en los detectores LWIR [8] para mejorar el rendimiento del dispositivo. Sin embargo, requiere un voltaje de polarización de puerta muy alto. El sesgo de la puerta se puede expresar mediante la ecuación. (1).
$$ \ sigma =\ varepsilon \ varepsilon_ {0} V / d, $$ (1)donde \ (\ varepsilon \) denota la constante dieléctrica relativa de la capa dieléctrica, \ (\ varepsilon_ {0} \) representa la constante dieléctrica de vacío, V se refiere al voltaje de polarización de la puerta de saturación, d es el espesor de la capa dieléctrica y σ representa la densidad de carga en la interfaz. El sesgo de la puerta se ha debilitado en base a la fórmula con gran esfuerzo; los medios de usar dieléctrico de alto k como Y 2 O 3 [9] para pasivar o reducir el espesor de la capa [10] es eficaz. Sin embargo, hay poca investigación sobre la reducción de la densidad de carga. En este artículo, primero se realiza la anodización para reducir significativamente el sesgo de saturación. Una mezcla de NaS 2 · 5H 2 Se utiliza O y etilenglicol como solución de vulcanización. Durante el proceso de curado anódico, la combinación de átomos de azufre y enlaces colgantes en la superficie del dispositivo cierra los canales conductores en la superficie del dispositivo [11], reduce la recombinación de la superficie del dispositivo y debilita la densidad de carga superficial del dispositivo. dispositivo. Luego, se obtiene una capa de azufre elemental denso y uniforme en la superficie del dispositivo. A continuación, la superficie de la capa de azufre elemental se cubre con una capa de SiO 2 de 200 nm. . El electrodo de puerta se coloca en el SiO 2 capa. El voltaje de polarización de la puerta de saturación se reduce a medida que disminuye la densidad de carga en la interfaz.
En este estudio, LWIR P + pretratado con vulcanización anódica - π –M – N + Los detectores se fabrican con un voltaje de polarización de puerta de baja saturación basado en InAs / GaSb T2SL con diferentes dopajes π regiones. Los resultados indican que no es cuanto mayor es la concentración de dopaje, mayor es la mejora en el rendimiento del dispositivo. Específicamente, el rendimiento eléctrico y óptico del dispositivo se vería debilitado por una concentración excesiva de dopaje. Además, el pretratamiento de vulcanización anódica puede reducir significativamente el sesgo de la puerta a - 10 V, que es mucho más bajo que el informado con el mismo grosor de un SiO 2 de 200 nm. Capa de pasivación con aproximadamente 40 V en una estructura similar.
Métodos
Materiales y estructura
Los materiales son producidos por un sistema GEN 20 MBE de fuente sólida en el n de 2 pulgadas -tipo GaSb (001) sustratos. En este trabajo, el detector LWIR de alto rendimiento se basa en el P + - π –M – N + estructura. En las Figs. Se ilustra un esquema de los dispositivos, patrones de difracción de rayos X de alta resolución (HRXRD) y microscopía de fuerza atómica (AFM). 1 y 2. La figura 1 indica que la estructura consta de una P + de 1300 nm de espesor. Tampón de GaSb, seguido de un InAs de 8 ML / GaSb de 12 ML de 500 nm de espesor (Be:aproximadamente 1 × 10 18 cm −3 ) P + región, un InAs 12-ML ligeramente dopado con P de 2000 nm (Be:780 ° C 800 ° C 820 ° C) / 7-ML GaSb π región M, una región M de 500 nm no dopada de 18 ML InAs / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb, una región M de 500 nm de espesor 18 ML / 3-ML GaSb / 5-ML AlSb / 3-ML GaSb (Si:aproximadamente 1 × 10 18 cm −3 ) N + región y una N + de 30 nm Capa InAs Cap. Y también muestra la alineación de la banda de simulación con la estructura. Teniendo en cuenta que el rendimiento del P + - π –M – N + El detector LWIR estaría significativamente influenciado por el dopaje del π región, preparamos tres muestras con diferentes temperaturas de dopaje Be que varían de 780 a 820 ° C.
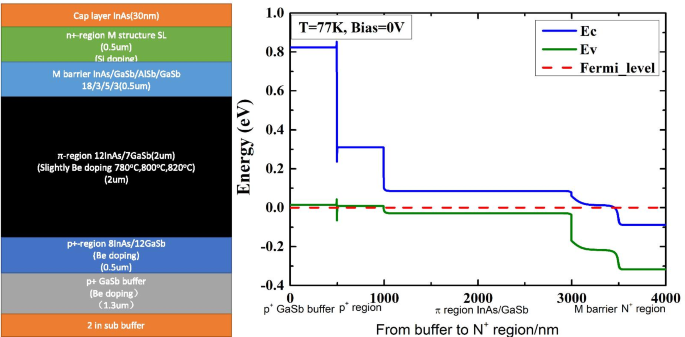
La estructura epitaxial y la alineación de bandas de los materiales con diferentes niveles de dopaje en la región π

Curvas oscilantes HRXRD para muestras con diferentes niveles de dopaje en la región π
Los períodos de superrejilla de 59,3 Å, 58,4 Å y 89,5 Å para la p -contacto, p La región activa y la capa de estructura M, con desajustes de celosía de 60 segundos de arco, 0 segundos de arco y 0 segundos de arco, en consecuencia, se muestran en la Fig. 2. El ancho total a la mitad del máximo para los SL en cada región es 32 segundos de arco, 25 segundos de arco y 12 segundos de arco, lo que indica que el material tiene alta calidad en las interfaces.
La Figura 3 presenta que los pasos atómicos aparecen con la raíz cuadrada media (RMS) de rugosidad con 1.87 Å sobre un área de 10 × 10 µm.
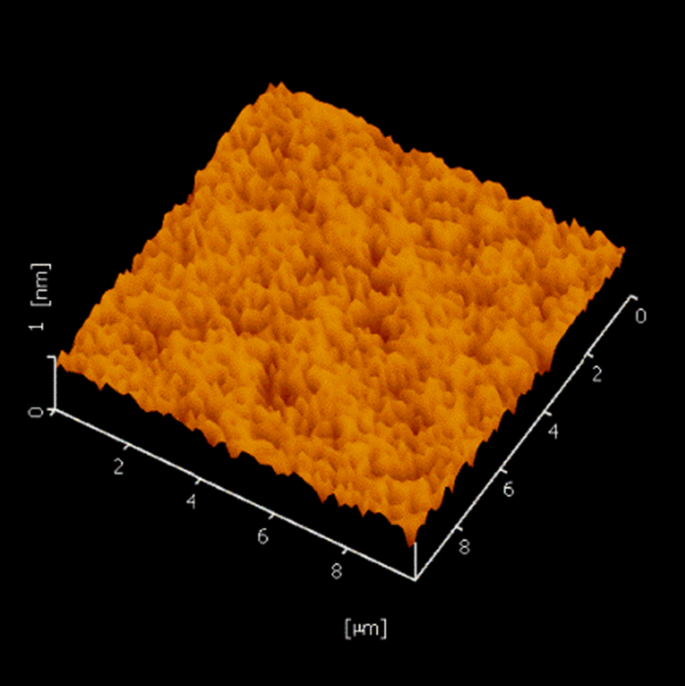
AFM de 10 × 10 µm 2 área de una muestra
Estructura y fabricación del dispositivo
El proceso es similar al de la Referencia [12]. Primero, la oblea se cubre con SiO 2 como una máscara de escucha. Luego, se adoptan los pasos de litografía estándar correspondientes. Luego, abrimos la máscara dura mediante un sistema de plasma acoplado inductivamente (ICP). A continuación, la mesa se obtiene utilizando un sistema de plasma acoplado inductivamente (ICP) con un CH 4 / Cl 2 / Ar mezcla. Específicamente, las obleas se graban desde la capa superior hasta la P + contacto [12]. Luego, el SiO 2 restante se elimina la capa. Luego, sumergimos un lado de la oblea en una solución mixta de sulfuro de sodio y etilenglicol y luego aplicamos una corriente constante a la oblea y establecemos un voltaje umbral. Se formará una capa de átomos de azufre en la superficie de la película y la resistencia cambiará. El voltaje en la oblea aumentará gradualmente hasta que alcance el voltaje umbral, y luego, se completará la vulcanización. Luego, la capa de azufre elemental se cubre con una capa de SiO 2 de 200 nm. . Además, se vuelve a realizar fotolitografía para abrir la ventana a través de la capa de SiO 2 y azufre elemental como las regiones de contacto metálico de los electrodos metálicos superior e inferior. Además, se realiza otra fotolitografía diseñada con dos formas de electrodos; una forma de electrodo es para el diodo cerrado (GD) y la otra es para el diodo no cerrado (UGD). Ti (50 nm) / Pt (50 nm) / Au (300 nm) se deposita mediante un haz de electrones depositado para los electrodos metálicos. Finalmente, los electrodos superior, inferior y de compuerta se adquieren mediante desprendimiento de metal.
La figura 4 ilustra la estructura del GD. Como sabemos, el ángulo de inclinación del grabado del material se puede ajustar cambiando la potencia del ICP, la potencia de RF, el flujo de gas y la presión de la cámara. En este estudio, el ángulo de inclinación real de la pared lateral es de entre 80 grados y 85 ° para facilitar el contacto de la compuerta de depósito en la pared lateral. El electrodo de puerta se coloca en la pared lateral del SiO 2 capa.
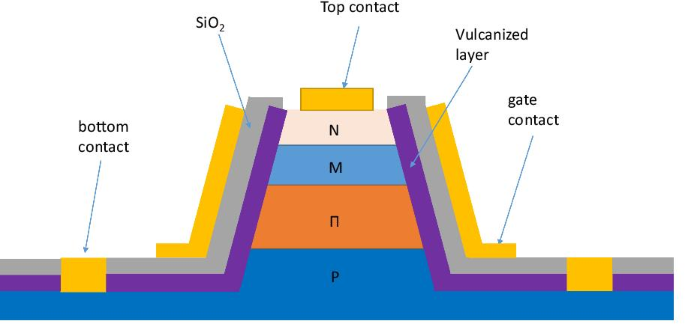
El diagrama de estructura del dispositivo de GD
La Figura 5 demuestra que los semidiodos se depositan para ser GD en los tres troqueles (780 ° C, 800 ° C y 820 ° C Be doping). Entonces, se pueden obtener tanto el diodo cerrado (GD) como el diodo no cerrado (UGD). En última instancia, muestra A (780 ° C GD), muestra B (780 ° C UGD), muestra C (800 ° C GD), muestra D (800 ° C UGD), muestra E (820 ° C GD) y muestra F (820 ° C UGD) se puede adquirir.

Imagen del dispositivo bajo un microscopio óptico
Resultados y discusión
En los detectores de infrarrojos, una detectividad específica ( D *) se usa generalmente para caracterizar el rendimiento del detector, que se calcula mediante la ecuación. (2).
$$ D ^ {*} =\ frac {Ri} {{\ sqrt {2qJ + 4 \ frac {kT} {{RA}}}}} $$ (2)donde q denota la cantidad de carga electrónica; K se refiere a la constante de Boltzmann; T es la temperatura Kelvin; Ri se refiere a la capacidad de respuesta del detector de infrarrojos; J es la densidad de corriente oscura del dispositivo bajo un cierto sesgo; y RA se refiere al producto del valor de resistencia y el área de la matriz. J y RA caracterizan el rendimiento eléctrico del dispositivo. Y Ri se puede convertir en QE con la fórmula:
$$ QE =\ frac {hC} {{q \ lambda}} Ri $$ (3)donde \ (h \) es la constante de Planck, \ ({} C \) es la velocidad de la luz, q denota la cantidad de carga electrónica, \ ({} \ lambda \) es la longitud de onda específica, y QE y Ri caracterizan el rendimiento óptico del dispositivo. La Figura 6 muestra las características ópticas de las muestras con diferentes π niveles de dopaje en la región a 77 K. Todas las muestras tienen una longitud de onda de corte del 50% similar de 8 µm y una longitud de onda de corte del 100% de 10 µm a 77 K. p -tipo de π región, no es que cuanto mayor sea la temperatura, mayor será el QE y la capacidad de respuesta. Sin embargo, la QE y la capacidad de respuesta se reducen significativamente con el aumento de la concentración de dopaje. Para superredes de capa deformada de tipo II (T2SL), la temperatura de dopaje durante el crecimiento es crítica para la concentración de dopaje. Cuanto mayor sea la temperatura, mayor será la concentración de dopaje. El QE de 780 ° C alcanza su valor máximo de 62,4%, que es 1,5 veces mayor que el QE de 820 ° C. Esto se debe a que se introducen demasiadas impurezas con el aumento de la concentración de dopaje, lo que conduce a la disminución de la vida útil del portador / longitud de difusión en exceso y a la reducción de la QE y la capacidad de respuesta [6]. Además, provocan el corrimiento al rojo espectroscópico de la figura 6a. Las figuras 6a yb indican que 780 ° C es la mejor temperatura de dopaje de los materiales para la caracterización óptica, con una capacidad de respuesta máxima de 2,26 A / W a 5 µm y una QE máxima de 62,4%.
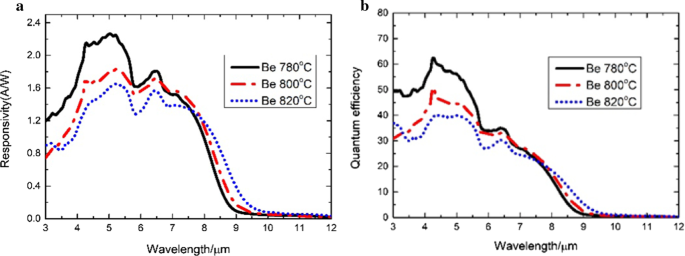
Las características ópticas de las muestras con diferentes niveles de dopaje en la región π a 77 K
La Figura 7 muestra las características eléctricas de las muestras UGD con diferentes π niveles de dopaje en la región a 77 K. El rendimiento eléctrico del dispositivo se vería muy afectado por diferentes π concentraciones de dopaje regionales [7]. Con el aumento en el nivel de dopaje de la región π, el producto del valor de resistencia y el área de la matriz (RA) en cierto sesgo se vuelve más pequeño, y la densidad de corriente oscura se vuelve más grande en consecuencia. Similar a la Referencia [6], RA alcanza su máximo en casi 0 V con una ruptura suave a medida que aumenta la polarización inversa, lo que sugiere que el dispositivo tiene un modo de corriente oscura de tunelización. Alcanzamos un RA máximo de 1259,4 Ω cm 2 con Be dopado con 780 ° C a - 200 mv, que es casi 40 veces más que con Be dopado con 820 ° C. La Figura 7b ilustra que la densidad de la corriente oscura es similar en el sesgo negativo en el rango de - 0,1 a 0 V, y la densidad de la corriente oscura con Be dopada con 780 ° C es un poco más pequeña en comparación con otras. La corriente oscura es 4.9 × 10 −3 A / cm 2 para el dispositivo con Doparse con 780 ° C a - 70 mv.
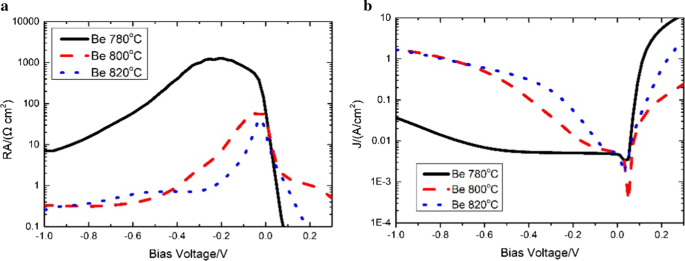
Las características eléctricas de las muestras UGD con diferentes π niveles de dopaje en la región a 77 K
La D correspondiente * se puede calcular tomando el Ri, J específico , y valores de RA bajo diferentes voltajes de polarización a 77 K. La Figura 8 exhibe la detectividad de las muestras de UGD con diferentes π regiones. A - 30 mv, la detección máxima es de 5,6 × 10 10 cm Hz 1/2 / W a 5 µm con Be dopado con 780 ° C, mientras que es 3.8 × 10 10 cm Hz 1/2 / W con Doparse con 820 ° C. El pico de detectividad del Be dopado con 780 ° C es 1,5 veces mayor que el del Be dopado con 820 ° C. Por lo tanto, la concentración de dopaje adecuada es extremadamente significativa. Sin embargo, una concentración de dopaje demasiado alta debilitaría el rendimiento del dispositivo.

Correlación entre la detectividad específica a 77 K de muestras UGD con π niveles de dopaje y longitud de onda de la región
La Figura 9 presenta las características eléctricas de la muestra de GD con Be dopado con 760 ° C a 77 K.A diferencia de los dispositivos de control de voltaje de compuerta ordinarios, el pretratamiento de vulcanización anódica se realiza primero en este estudio para reducir notablemente el voltaje de polarización de la compuerta de saturación. Además, una mezcla de NaS 2 · 5H 2 Se utiliza O y etilenglicol como solución de vulcanización. El método de pasivación de vulcanización de ánodo se emplea para formar una capa de azufre elemental denso y uniforme en la superficie del dispositivo. Durante la reacción electroquímica, los átomos de azufre se combinan con los enlaces colgantes en la superficie del dispositivo, lo que contribuye a cerrar los canales electrónicos generados por los enlaces colgantes de la superficie y a aislar el mecanismo de recombinación electrón-agujero de la superficie del dispositivo [11]. Luego, la superficie de la capa de azufre elemental se cubre con una capa protectora de 200 nm SiO 2 , y el electrodo de puerta se coloca en la pared lateral del SiO 2 capa. Como se informó en investigaciones anteriores, la correlación entre el sesgo de saturación y el grosor de la capa dieléctrica del dispositivo es casi lineal. La figura 9 sugiere que el sesgo de saturación del dispositivo se puede reducir a aproximadamente -10 V mediante un pretratamiento de vulcanización simple y eficaz; este valor reducido en otras investigaciones es de unos 40 V y es cuatro veces mayor en dispositivos de estructura similar con el mismo espesor SiO 2 capa [10]. Además, RA alcanza su máximo de 25 Ω cm 2 cerca de 0 V. La tendencia a la baja se ha ralentizado significativamente cuando aplicamos voltaje de polarización negativo a aproximadamente - 10 V. Cuando aplicamos el voltaje de polarización de - 10 V en el electrodo de puerta, RA es 10 Ω cm 2 a - 0,3 V, que es 40 veces mayor que sin voltaje de polarización aplicado. Además, es casi dos órdenes de magnitud más bajo que sin voltaje de polarización a - 0,6 V. La figura 9b indica que la corriente oscura alcanza su mínimo de 2 × 10 –4 A / cm 2 cerca de 0 V, y se reduce en un orden de magnitud a - 0,3 V. Como sabemos, la curva IV no cambiaría con la polarización de la puerta a 0 V cuando la tensión de polarización es positiva. Además, el RA del dispositivo aumenta significativamente cuando el voltaje de polarización aumenta de 0 a - 10 V; mientras tanto, la corriente oscura del dispositivo disminuye en consecuencia. Cuando el voltaje de polarización varía de - 10 a - 20 V, el RA del dispositivo disminuye ligeramente y la corriente oscura del dispositivo aumenta en consecuencia. En polarización de reserva alta (p. Ej., -1 V) entre los electrodos superior e inferior, la corriente oscura disminuye con la polarización de la puerta y luego aumenta ligeramente más allá de -12 V.Es principalmente para la característica de polarización de la puerta. En la Fig. 10 se muestra una introducción adicional. Para una polarización inversa baja (p. Ej., - 0,1 V), la corriente oscura parece aumentar a medida que aumenta la polarización de la puerta, que es completamente diferente de la de - 1 V. Para una polarización inversa diferente, sospechamos que el principal mecanismo de fuga es diferente. Para un sesgo de reserva baja, el sesgo de puerta alto muestra una influencia negativa, ya que influye en la dispersión superficial de electrones y electrones calientes. Y para una alta polarización inversa, la fuga disminuye porque su corriente de fuga superficial disminuye. Entonces es diferente.

Las características eléctricas de las muestras de GD con 780 ° C se dopan con diferentes voltajes de polarización de puerta y el voltaje de polarización en el electrodo superior e inferior
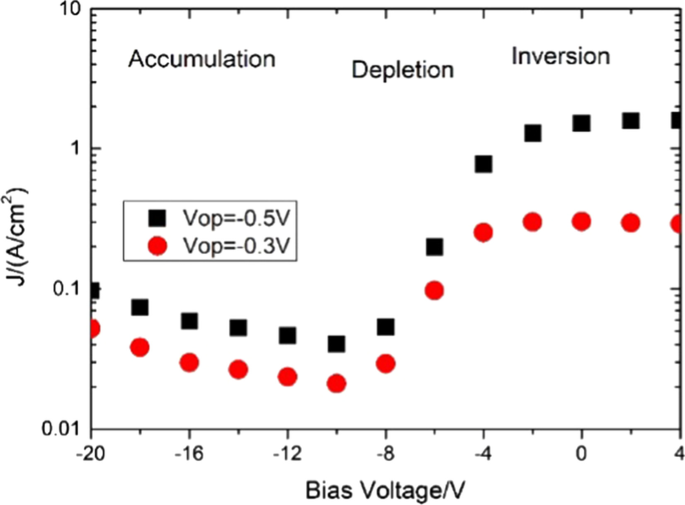
Correlación entre la densidad de corriente oscura inversa y la polarización de la puerta de la muestra GD con 780 ° C Doparse en diferentes polarizaciones de funcionamiento del diodo
Como se ilustra en la Fig. 10, con una polarización de reserva alta (p. Ej., -1 V) entre los electrodos superior e inferior, la corriente oscura disminuye con la polarización de la puerta y luego aumenta ligeramente más allá de -12 V; podemos ver que el dispositivo existe en tres etapas con el cambio en el voltaje de polarización a 77 K [10]. Según la Referencia [13], el P + y N + regiones para P + –Π – M – N + El dispositivo de estructura está muy dopado, y la región M es una región de banda más grande con una masa efectiva más grande en comparación con π y P + región; por lo tanto, el sesgo de la puerta tiene mucha más influencia en el π región en comparación con otras [13]. Usando un método similar con Chen [10], se analizan tres etapas durante el proceso de alta tensión de polarización negativa (- 20 a - 10 V) que se aplica en el electrodo de puerta; los resultados indican que la pared lateral de la mesa está en condición plana o bajo acumulación [8], y la densidad de corriente oscura aumenta ligeramente con la polarización de la puerta debido a la interfaz de vulcanización. Se sospecha que la interfaz de vulcanización no es homogénea de densidad leve, en algún lugar la densidad es insuficiente se descompone ligeramente. Cuando se aplica voltaje de polarización negativa (- 10 a - 2 V), la pared lateral de la mesa se agota y la corriente oscura aumenta suavemente. Además, el ancho de agotamiento inducido por el campo alcanza su máximo y la formación de la capa de inversión cuando el voltaje de polarización a -2 V se aplica a la polarización de puerta positiva; por tanto, la densidad de la corriente oscura se mantiene constante. Según la Referencia [14], se explica por qué la corriente de generación-recombinación de superficie (G – R) a - 0,5 V es mayor que a - 0,3 V.
La Figura 11 muestra que, con la polarización de la puerta en - 10 V, la D * para la muestra de GD con 780 ° C Be doped alcanza su pico de detección de 1.3 × 10 11 cm Hz 1/2 / W a 5 µm, que es más del doble que bajo voltaje sin polarización con 780 ° C Estar dopado y más de tres veces que bajo voltaje sin polarización con 820 ° C Estar dopado a 77 K. Indica que se aplica la polarización negativa apropiada puede mejorar significativamente el rendimiento del dispositivo.
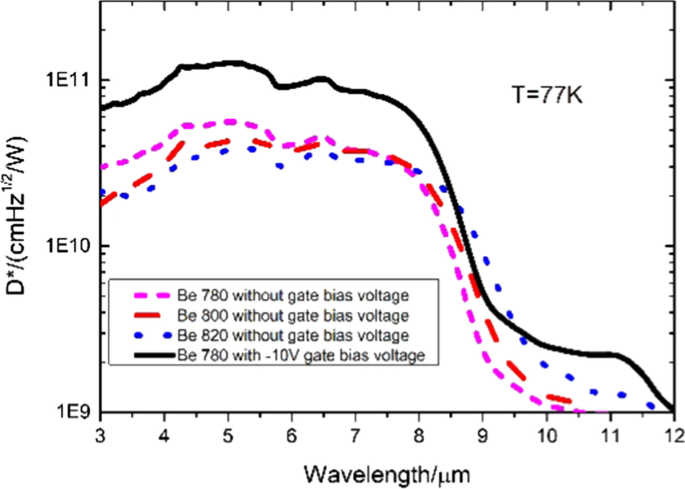
Correlación entre la detectividad de la muestra GD con 780 ° C Be dopada y muestras UGD con diferentes niveles de dopaje en la región π y la longitud de onda a 77 K
Conclusiones
2017 Northwestern University informó fotodetectores nBn infrarrojos de longitud de onda larga (LWIR) basados en InAs / InAs 1− x Sb x superredes de tipo II. El dispositivo exhibió una longitud de onda de corte de ∼ 10 µm a 77 K con una capacidad de respuesta máxima de 2.65 A / W, correspondiente a una eficiencia cuántica del 43% y RA 664 Ω cm 2 y una densidad de corriente oscura de 8 × 10 5 A / cm 2 , bajo voltaje de polarización de 80 mV a 77 K; el fotodetector exhibió una detectividad específica de 4.72 × 10 11 cm Hz 1/2 / W [5]. La capacidad de respuesta máxima de este dispositivo es 1,3 × 10 11 cm Hz 1/2 / W a 5 µm y 0 V con voltaje de polarización de puerta de - 10 V que es comparable con el dispositivo nBn. Pero el punto débil es la uniformidad de RA del dispositivo, que influye en el rendimiento del dispositivo.
En conclusión, obligar a la región activa a ser p -escribir mediante dopaje en π La región puede mejorar eficazmente el rendimiento de la superlattice P + de LWIR InAs / GaSb - π –M – N + detector [6]. Sin embargo, no es que cuanto mayor sea la concentración de dopaje, mayor será la mejora en el rendimiento del dispositivo. En particular, el rendimiento eléctrico y óptico del dispositivo podría verse reducido por una concentración de dopaje excesiva. La caracterización óptica a 77 K indica que obtenemos un máximo de QE del 62,4% a 4,26 µm y un máximo de 2,26 A / W a 5 µm con Be dopado con 780 ° C. La caracterización eléctrica sugiere que un RA máximo de 1259,4 Ω cm 2 Se obtiene con Be dopado a 780 ° C. La detectividad específica alcanza su máximo de 5,6 × 10 10 cm Hz 1/2 / W a 5 µm con Be dopado con 780 ° C. Además, el sesgo de saturación del dispositivo se puede reducir drásticamente mediante un pretratamiento de vulcanización anódica simple y eficaz. El pretratamiento de vulcanización exhibe su potencial para reducir el voltaje de polarización de la puerta. La caracterización eléctrica ilustra que el sesgo de saturación es solo - 10 V, mientras que es de 40 V en otras investigaciones sin pretratamiento de vulcanización en una estructura similar con el mismo espesor del SiO 2 capa. Además, el rendimiento del dispositivo se puede mejorar significativamente aplicando una polarización negativa adecuada en el electrodo de puerta. Un máximo de 1,3 × 10 11 cm Hz 1/2 / W se alcanza a 5 µm y 0 V con - voltaje de polarización de compuerta de 10 V con Be dopado con 780 ° C a 77 K. Limitado por el equipo experimental y las condiciones experimentales, elegimos SiO 2 para ser una capa dieléctrica, pero en el seguimiento, se considera usar medio Hi-K para experimentos adicionales. En teoría, el voltaje de polarización de la puerta se puede reducir aún más.
Disponibilidad de datos y materiales
Los autores declaran que los materiales y los datos están disponibles de inmediato para los lectores sin calificaciones indebidas para acuerdos de transferencia de material. Todos los datos generados o analizados durante este estudio se incluyen en este artículo.
Abreviaturas
- LWIR:
-
Detectores de infrarrojos de longitud de onda larga
- QE:
-
Eficiencia cuántica
- T2SL:
-
Superredes de capa tensada tipo II
- VLWIR:
-
Detectores de infrarrojos de longitud de onda muy larga
- MWIR:
-
Detectores de infrarrojos de longitud de onda media
- HRXRD:
-
Difracción de rayos X de alta resolución
- AFM:
-
Microscopía de fuerza atómica
- ICP:
-
Plasma acoplado inductivamente
- GD:
-
Diodo cerrado
- UGD:
-
Diodo no cerrado
- D *:
-
Detectividad específica
- RA:
-
Producto del valor de resistencia y el área de la matriz
- Ri:
-
Responsividad del detector de infrarrojos
- G – R:
-
Generación-recombinación
Nanomateriales
- Entrevista con el experto:Scott DeFelice de Oxford Performance Materials sobre la evolución de los polímeros de alto rendimiento para la impresión 3D
- Síntesis fácil de WS2 / Bi2MoO6 heteroestructurados como fotocatalizadores impulsados por luz visible de alto rendimiento
- Crecimiento autocatalizado de nanocables verticales de GaSb en vástagos de InAs mediante deposición de vapor químico metalorgánico
- Biocompatibilidad mejorada en matrices anódicas TaO x nanotubos
- Rendimiento fotocatalítico de luz visible de nanocompuestos de ZnO / g-C3N4 dopado con N
- Preparación y rendimiento fotocatalítico de fotocatalizadores LiNb3O8 de estructura hueca
- Un nuevo fotocatalizador de heterounión Bi4Ti3O12 / Ag3PO4 con rendimiento fotocatalítico mejorado
- Rendimiento mejorado de un nuevo catalizador anódico de PdAu / VGCNF para la electrooxidación en una pila de combustible de glicerol
- Detector UV autoamplificado de alto rendimiento basado en matrices de nanomace SnO2-TiO2
- Microarreglos mesoporosos de VO2 bidimensionales para supercondensadores de alto rendimiento
- Evaluación automática del rendimiento del detector de rayos X



