Comportamientos de programación dependientes de la polaridad del voltaje de la memoria de transistor de película delgada amorfa In-Ga-Zn-O con una captura de carga de ZnO depositada en capa atómica Capa
Resumen
Las memorias amorfas de transistores de película delgada (TFT) de In-Ga-Zn-O (a-IGZO) están atrayendo muchos intereses para futuras aplicaciones de sistemas en paneles; sin embargo, normalmente presentan una baja eficacia de borrado. En este artículo, investigamos los comportamientos de programación dependientes de la polaridad del voltaje de una memoria TFT a-IGZO con una capa de captura de carga de ZnO depositada en una capa atómica (CTL). Los dispositivos prístinos demuestran características programables eléctricamente no solo bajo polarizaciones de puerta positivas sino también bajo polarizaciones de puerta negativas. En particular, este último puede generar una eficiencia de programación mucho mayor que el primero. Al aplicar un pulso de polarización de puerta de +13 V / 1 μs, el dispositivo muestra un cambio de voltaje de umbral (ΔV th ) de 2 V; y el ΔV th es tan grande como −6,5 V para un pulso de polarización de puerta de −13 V / 1 μs. En el caso de programación de 12 V / 1 ms (P) y borrado de −12 V / 10 μs (E), se puede lograr una ventana de memoria de hasta 7,2 V a 10 3 de ciclos P / E. Comparando los CTL de ZnO recocidos en O 2 o N 2 con el depositado, se concluye que la vacante de oxigeno (V O ) los defectos relacionados dominan las características de programación bipolar de los dispositivos de memoria TFT. Para programar con voltaje de puerta positivo, los electrones se inyectan desde el canal IGZO en la capa de ZnO y se atrapan preferentemente en niveles profundos de vacancia de oxígeno ionizado individualmente (V O + ) y vacante de oxígeno doblemente ionizado (V O 2+ ). Con respecto a la programación con voltaje de puerta negativo, los electrones se liberan fácilmente de las vacantes de oxígeno neutro debido a los donantes poco profundos y el túnel de regreso al canal. Esto, por lo tanto, conduce a un borrado altamente eficiente mediante la formación de vacantes de oxígeno ionizado adicionales con cargas positivas.
Antecedentes
Un transistor de película delgada (TFT) basado en óxido de indio-galio-zinc amorfo (a-IGZO) se ha estudiado extensamente para su aplicación a sistemas electrónicos flexibles y transparentes [1,2,3,4,5,6,7 , 8,9,10,11,12]. Esto se atribuye a algunas propiedades específicas de las películas a-IGZO, como buena uniformidad, baja temperatura de procesamiento, transparencia a la luz visible y alta movilidad de electrones [13]. Aparte de eso, también se han propuesto memorias no volátiles a-IGZO TFT, y su capacidad de almacenamiento de datos no volátiles amplía el alcance de la utilización del dispositivo a-IGZO TFT. Como arquitectura típica de dispositivos de memoria no volátil, una memoria TFT a-IGZO de compuerta flotante se ha investigado intensamente en los últimos años. Hasta ahora, se han explorado varios materiales como puerta flotante (es decir, medio de almacenamiento de carga), como dieléctricos [14, 15], nanocristales metálicos [16, 17] y materiales semiconductores [18,19,20,21]. . Dado que a-IGZO es un semiconductor natural de tipo n, y la inversión de huecos apenas se realiza en un a-IGZO TFT bajo una polarización de puerta negativa, por lo tanto, las memorias a-IGZO TFT generalmente tienen una baja eficiencia de borrado. En otras palabras, la mayoría de las memorias TFT de a-IGZO no se pueden borrar eléctricamente a través de la inyección del orificio del canal [14, 15, 16]. Sin embargo, Zhang et al. [21] fabricó una memoria TFT usando a-IGZO como capa de captura de carga (CTL) y capa de canal, que exhibía características programables eléctricamente y borrables, así como una buena retención de datos. Mientras tanto, Yun et al. También investigó las características de las memorias a-IGZO TFT con diferente composición IGZO CTL, revelando una ventana de memoria decreciente al aumentar el O 2 presión parcial (P O2 ) durante la deposición por pulverización catódica del CTL [18]. Además, Bak et al. informaron del rendimiento de las memorias TFT a-IGZO con varios CTL de ZnO de conductividad e infirieron que la naturaleza electrónica optimizada de la estructura de banda prohibida para los CTL de ZnO podría ser uno de los factores más importantes para realizar memorias TFT de óxido altamente funcionales [20]. Aunque las memorias TFT a-IGZO a-IGZO de semiconductor de óxido mencionadas anteriormente exhiben velocidades superiores de programación / borrado eléctrico, las características de programación bipolar de los dispositivos mencionados anteriormente no se han informado, y los procesos de captura correspondientes de diferentes cargas en el CTL del semiconductor de óxido no lo son. claro todavía, especialmente para la captura de cargas positivas.
En este trabajo, se fabricó una memoria TFT a-IGZO programable bipolar utilizando una película de ZnO depositada en una capa atómica como CTL. Al comparar las características de programación bipolar de los dispositivos de memoria TFT con el depósito, O 2 - o N 2 CTL de ZnO recocidos, se discutieron los procesos de captura de diferentes cargas en la capa de ZnO. Se revela que los defectos relacionados con la vacante de oxígeno dominan las características de programación bipolar de los dispositivos de memoria a-IGZO TFT.
Métodos
Las obleas de Si (100) de tipo P con resistividad de 0,001 a 0,005 Ω cm se limpiaron utilizando el proceso de limpieza RCA estándar y se utilizaron como puerta trasera del dispositivo. Luego, 35 nm Al 2 O 3 y películas de ZnO de 20 nm se depositaron sucesivamente por deposición de capa atómica (ALD) a 250 ° C y 200 ° C, que sirvieron como capa de bloqueo y CTL de la memoria TFT, respectivamente. Vale la pena mencionar que la película de ZnO tiene una rugosidad de raíz cuadrada media (RMS) de 0.553 nm. Posteriormente, se realizó fotolitografía y grabado en húmedo para definir los CTL de ZnO. Después de eso, un Al 2 de 8 nm O 3 La capa de tunelización se hizo crecer mediante ALD. Los precursores de dietilzinc (DEZ) / H 2 O y TMA / H 2 O se utilizaron para el crecimiento de ZnO y Al 2 O 3 películas, respectivamente. Posteriormente, se depositó una película de a-IGZO de 40 nm mediante pulverización catódica con magnetrón de radiofrecuencia como una capa de canal a temperatura ambiente mediante el uso de un InGaZnO 4 objetivo. A continuación, se definió el canal activo con una anchura (W) / longitud (L) de 100/10 µm mediante fotolitografía y grabado con HCl diluido. Los contactos de fuente y drenaje de Ti / Au (30 nm / 70 nm) se formaron mediante evaporación con haz de electrones seguida de un proceso de despegue. Finalmente, todos los dispositivos fabricados se recocieron a 250 ° C en O 2 durante 5 min para mejorar su rendimiento. Las caracterizaciones eléctricas se realizaron utilizando un analizador de parámetros de semiconductores (Agilent B1500A) a temperatura ambiente. El voltaje de umbral (V th ) se define como el voltaje de la puerta a la que la corriente de drenaje es igual a W / L × 10 −9 A. La concentración de portador de las películas de ZnO se extrajo de las mediciones del efecto Hall (Ecopia HMS-3000) a temperatura ambiente.
Resultados y discusión
La Figura 1 muestra los diagramas esquemáticos del dispositivo de memoria a-IGZO TFT fabricado bajo programación de polarización positiva y negativa, respectivamente. Durante la programación eléctrica, se aplica un pulso eléctrico en la puerta trasera y los electrodos de fuente y drenaje se conectan a tierra. La Figura 2 muestra las características de programación de los dispositivos de memoria prístinos en diferentes condiciones. Para el dispositivo de memoria impecable, exhibe una relación de corriente de encendido / apagado ( I en / Yo desactivado ) de 1,5 × 10 7 , movilidad de efecto de campo de 7,1 cm 2 V −1 s −1 y una oscilación subumbral (SS) de 0,67 V / dec. En términos de programación de 80 ms con diferentes sesgos positivos, el I d - V g La curva se mueve gradualmente en la dirección de una polarización positiva en función del voltaje de programación, por ejemplo, la V th resultante cambio relativo al dispositivo prístino (ΔV th ) aumenta de 1.3 a 4.8 V al aumentar el voltaje de programación de 8 a 13 V, exhibiendo saturación de programación a 12 V, como se muestra en la Fig. 2a. Un ΔV th tan significativo sugiere que se inyectan electrones considerables del canal a-IGZO de tipo n en el CTL de ZnO. Además, cuando el voltaje de programación se fija en 13 V, el ΔV th aumenta lentamente de 2 a 3,1 V prolongando el tiempo de programación de 1 μs a 30 ms, como se muestra en la Fig. 2c. Curiosamente, cuando el dispositivo de memoria prístino se programa con un sesgo de puerta negativo, la V th exhibe un cambio notable hacia un sesgo negativo, que se muestra en la Fig. 2b. Para un tiempo de programación constante de 80 ms, el ΔV th aumenta de −5,2 a −7,4 V con un sesgo de programación creciente de −8 a −13 V. Incluso si el dispositivo de memoria prístino está programado a -13 V durante 1 μs, también puede demostrar un ΔV th tan grande como −6,5 V, que se muestra en la figura 2d. Esto significa que una gran cantidad de electrones se eliminan del CTL, por lo que quedan muchas cargas positivas.
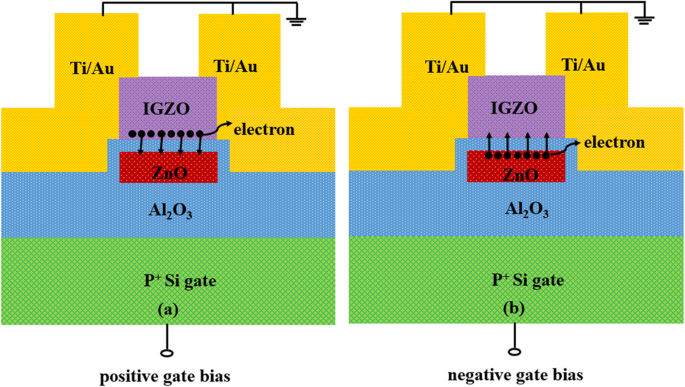
Los diagramas esquemáticos de sección transversal del dispositivo de memoria a-IGZO TFT programado bajo una polarización de puerta positiva ( a ) y un sesgo de puerta negativo ( b ), respectivamente.
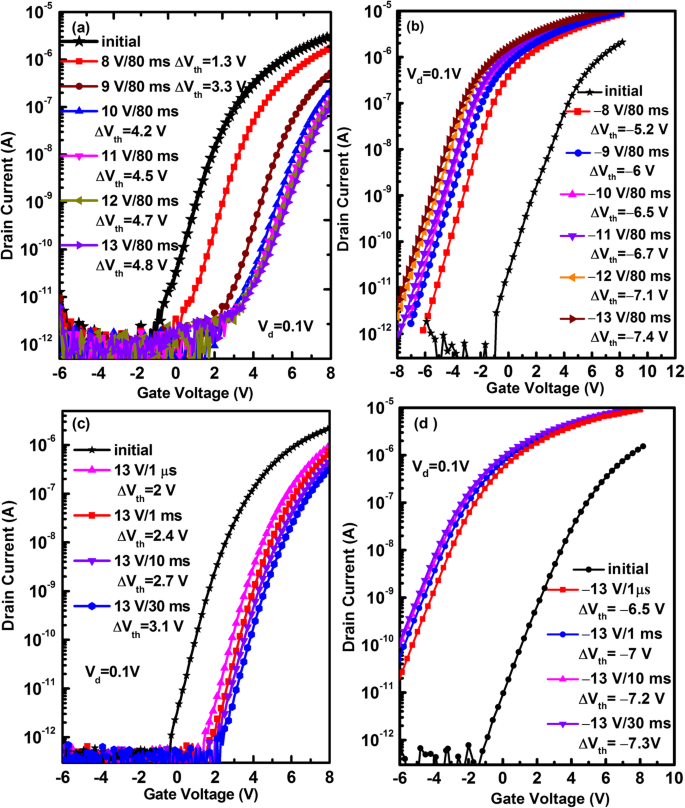
Las curvas de transferencia del dispositivo de memoria a-IGZO TFT y las programadas a en varios sesgos de puerta positivos durante un tiempo constante de 80 ms, b en varios sesgos de puerta negativos durante un tiempo constante de 80 ms, c a 13 V durante varios tiempos de programación, y d a −13 V durante varios tiempos de programación. Todas las curvas de transferencia de cada figura se midieron en el mismo dispositivo y todas las operaciones de programación se llevaron a cabo en secuencia.
Para comprender el efecto de captura de carga de la capa de ZnO, los TFT a-IGZO sin ZnO CTL también se fabrican como dispositivos de control para la comparación. La Figura 3 muestra las características de transferencia de los dispositivos de control cuando se programan bajo diferentes polarizaciones positivas y negativas, respectivamente. Se encuentra que el dispositivo no exhibe un ΔV th discernible independientemente de la polaridad y amplitud del voltaje de programación. Esto indica que el ΔV th distinto mencionado anteriormente para los dispositivos de memoria deben adscribirse al ZnO CTL. Por otro lado, se observa que IGZO es un semiconductor natural de tipo n, por lo que los electrones en el canal IGZO se pueden inyectar fácilmente en el CTL de ZnO bajo una polarización de puerta positiva (por ejemplo, . , +9 V). Sin embargo, cuando se aplica una polarización de programación negativa al electrodo de puerta del dispositivo, el canal a-IGZO tiende a agotarse y la conducción del agujero apenas se logra [15]. En este caso, el dispositivo no se puede programar mediante la inyección de un orificio desde el canal y, por lo tanto, la posibilidad única de programación eléctrica debe realizarse eliminando el atrapamiento de electrones intrínsecos en el CTL de ZnO prístino. De hecho, nuestros resultados experimentales indican que el dispositivo se puede programar fácilmente bajo sesgos de puerta negativos, ver Fig. 2d. La Figura 4 muestra las características de resistencia de la memoria en función de los ciclos de programación / borrado (P / E). El dispositivo muestra una ventana de memoria de 3,7 V durante 10 3 de ciclos P / E en el caso de programación de 11 V / 1 ms y borrado de −9 V / 10 μs. Además, se puede lograr una ventana de memoria de hasta 7,2 V a 10 3 de ciclos P / E con respecto a la programación de 12 V / 1 ms y el borrado de −12 V / 10 μs. La Tabla 1 compara las características de programación y borrado de varias memorias TFT a-IGZO [14, 22, 23]. Comparado con otros dispositivos, nuestro dispositivo exhibe una eficiencia de borrado mucho mayor incluso bajo un sesgo más bajo (-12 V) y un tiempo mucho más corto (10 μs) a pesar de una superioridad no notable en la eficiencia de programación.
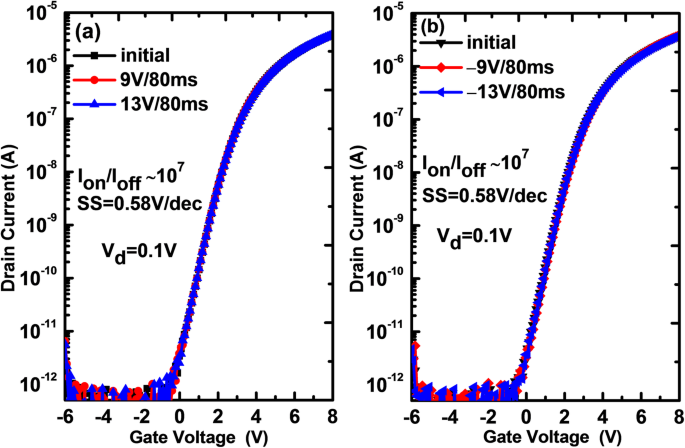
Las curvas de transferencia del dispositivo a-IGZO TFT y las programadas a en diferentes polarizaciones de puerta positiva durante un tiempo constante de 80 ms y b a diferentes polarizaciones de puerta negativa durante un tiempo constante de 80 ms
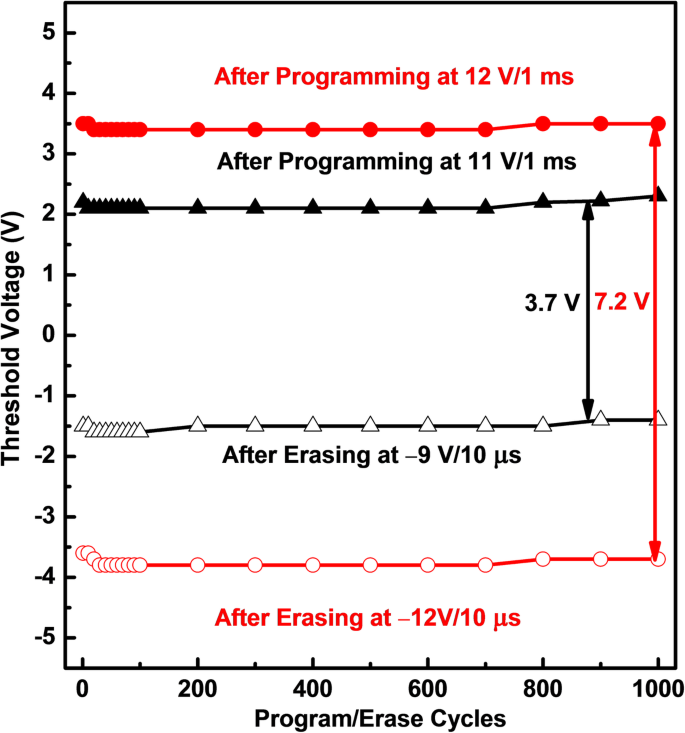
Las características de resistencia del dispositivo de memoria a-IGZO TFT en función de los ciclos P / E
Para aclarar el origen de los electrones desencajados del CTL de ZnO prístino, se comparan varios CTL de ZnO procesados en los dispositivos de memoria TFT a-IGZO. La Figura 5 muestra la dependencia del voltaje de programación de △ V th para los dispositivos con diferentes CTL de ZnO. Se observa que, para los dispositivos de memoria con el depósito y N 2 CTL de ZnO recocidos, el ΔV th resultante exhibe una tendencia creciente similar con el aumento del voltaje de programación a pesar de las polaridades del voltaje. Sin embargo, para el dispositivo de memoria con O 2 - CTL de ZnO recocido, el valor absoluto de ΔV th muestra una disminución significativa bajo la misma condición de programación, por ejemplo, el valor absoluto de ΔV th disminuye en 2 y 3 V, respectivamente, en el caso de pulsos de programación de 13 V / 80 ms y −12 V / 1 μs. Además, se observan comportamientos de programación saturados para el O 2 CTL de ZnO recocido en el caso de sesgos de puerta positivos y negativos. Esto debería atribuirse a trampas limitadas en el CTL. En una palabra, el post-recocido en O 2 a 250 ° C reduce el número de centros de trampa en la película de ZnO, lo que conduce a una disminución en la capacidad de captura de carga.

Los cambios de voltaje de umbral de los dispositivos de memoria a-IGZO TFT con diferentes capas de captura de carga de ZnO procesadas en función de a tensión de programación positiva para un tiempo de programación constante de 80 ms y b tensión de programación negativa para un tiempo de programación constante de 1 μs. Para cada condición, se midieron cinco dispositivos.
Para investigar la influencia del post-recocido en las propiedades de la película de ZnO, las películas de ZnO depositadas y procesadas se caracterizan por mediciones de efecto Hall y XPS. Como se muestra en la Fig.6, la película de ZnO recocida en N 2 a 250 ° C muestra una concentración de portador de 4,4 × 10 19 cm −3 , que está muy cerca de eso (4.5 × 10 19 cm −3 ) de la película de ZnO depositada; sin embargo, la película de ZnO recocida en O 2 a 250 ° C muestra una disminución notable en la concentración de portador, que es igual a 1.8 × 10 18 cm −3 . Se ha informado de que los donantes intrínsecos en las películas semiconductoras de ZnO de tipo n son las vacantes de oxígeno [24]. Kwon y col. También informó que la relación atómica O / Zn en la película de ALD ZnO disminuyó gradualmente de 0,90 a 0,78 al aumentar la temperatura de deposición de 70 a 130 ° C [25]. Esto revela la existencia de vacantes de oxígeno en las películas de ALD ZnO. Por lo tanto, el O 2 -La disminución inducida por el recocido en la concentración de portadores (electrones) debe estar relacionada con la reducción de las vacantes de oxígeno en la película de ZnO. Además, los espectros XPS de O1s de alta resolución de la película de ZnO depositada y los recocidos en N 2 o O 2 se analizan, como se muestra en la Fig. 7. Los tres picos deconvolucionados están centrados en 530.0, 531.6 y 532.4 eV, correspondientes a O 2− iones unidos con Zn 2+ (O1), las vacantes de oxígeno (O2) y el elemento de oxígeno quimisorbido (–OH, etc.) (O3), respectivamente [26]. En comparación con la película de ZnO depositada, el post-recocido en O 2 genera una disminución del 2,1% en el porcentaje relativo de O2. Sin embargo, para la película de ZnO recocida en N 2 , el porcentaje relativo de O2 prácticamente no cambia. Estos resultados indican que el O 2 El recocido puede pasivar las vacantes de oxígeno en la película de ZnO, pero el N 2 el recocido no puede hacer. Esto confirma aún más la correlación entre las vacantes de oxígeno y la concentración de portadores.

Las concentraciones de portador de la película de ZnO depositada y los recocidos en diferentes condiciones.
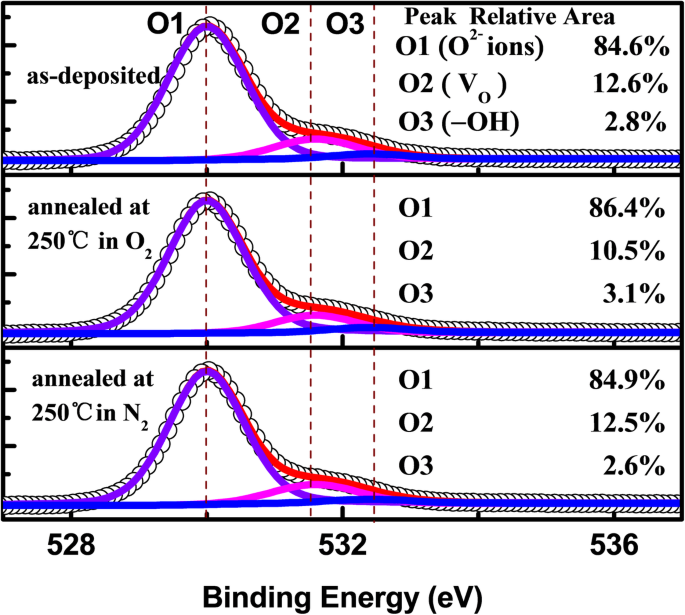
Espectros XPS de O1s de alta resolución de la película de ZnO depositada y de los recocidos a 250 ° C en O 2 y N 2 , respectivamente. O1 y O2 corresponden a O 2− iones unidos con Zn 2+ y vacantes de oxígeno, respectivamente. El O3 se atribuye al elemento oxígeno quimisorbido (–OH, etc.). Para eliminar involuntariamente los contaminantes de la superficie, todas las muestras se grabaron con bombardeo de iones in situ
Con base en los resultados experimentales antes mencionados, se puede concluir que las características de programación de los dispositivos de memoria prístinos están dominadas por la concentración de defectos relacionados con la vacante de oxígeno en el CTL de ZnO. En otras palabras, las vacantes de oxígeno en la película de ZnO sirven principalmente como centros trampa para atrapar cargas positivas y negativas. Se informa que los defectos relacionados con la vacante de oxígeno en ZnO incluyen la vacante de oxígeno neutro (V O ), vacante de oxígeno ionizado individualmente (V O
+
) y la vacante de oxígeno doblemente ionizado (V O
2+
), cuyos niveles de energía se ubican en 0.02-0.04, 0.3-0.45 y 0.61 eV, respectivamente, por debajo del mínimo de la banda de conducción de ZnO [27, 28]. Dado que la película de ZnO depositada muestra una alta concentración de electrones en nuestro caso, la concentración de las vacantes de oxígeno neutro que sirven como donantes superficiales debería ser mucho mayor que la de las vacantes de oxígeno ionizado (V O
+
y V O
2+
). En términos de programación en una polarización de puerta positiva, los electrones en la capa de acumulación del canal a-IGZO se inyectan en la capa de ZnO por el mecanismo de túnel de Fowler-Nordheim (FN), que se demuestra por un ΔV th
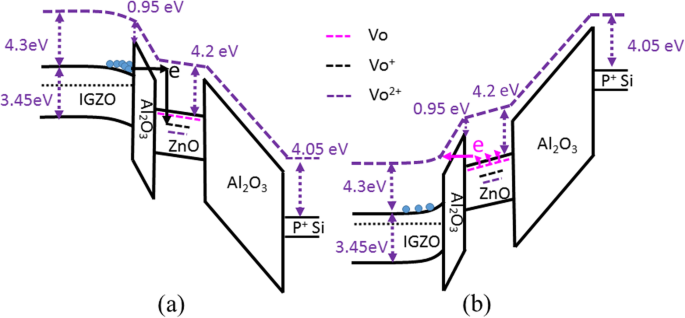
Diagramas de bandas de energía de los dispositivos de memoria a-IGZO TFT programados en a un sesgo de puerta positivo y b un sesgo de puerta negativo, respectivamente. V o , V o + y V o 2+ denotar vacante de oxígeno neutro, vacante de oxígeno ionizado individualmente y vacante de oxígeno doblemente ionizado, respectivamente
Conclusiones
En resumen, fabricamos una memoria TFT a-IGZO programable bipolar con un CTL de ZnO depositado en una capa atómica. En comparación con la programación con un sesgo de puerta positivo, la programación con un sesgo de puerta negativo puede generar una eficiencia mucho mayor. Esto se debe a que durante la programación dependiente de la polaridad del voltaje entran en vigor diferentes defectos de vacancia de oxígeno. Es decir, defectos profundos de V O + y V O 2+ juegan un papel clave para que los electrones atrapen durante la programación de polarización positiva y defectos superficiales de V O donar principalmente electrones durante la programación de sesgo negativo, lo que resulta en la generación de vacantes de oxígeno con carga positiva.
Disponibilidad de datos y materiales
Los conjuntos de datos que respaldan las conclusiones de este manuscrito se incluyen dentro del manuscrito.
Abreviaturas
- a-IGZO:
-
Óxido de indio-galio-zinc amorfo
- ALD:
-
Deposición de la capa atómica
- CTL:
-
Capa de captura de carga
- TFT:
-
Transistor de película fina
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Ajuste de nivel de Fermi de películas de ZnO mediante deposición de capa atómica superciclada
- Células solares de perovskita invertida altamente eficientes con capa de transporte de electrones CdSe QD / LiF
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Mejora del rendimiento del dispositivo a-IGZO TFT mediante un proceso de interfaz limpia a través de nanocapas Etch-Stopper
- Resistencia de contacto reducida entre el metal y n-Ge mediante la inserción de ZnO con tratamiento con plasma de argón
- Efecto de las heteroestructuras bicapa CeO2 − x / ZnO y ZnO / CeO2 − x y la polaridad de electroformado en las propiedades de conmutación de la memoria no volátil
- Investigación de la banda de energía en las heterouniones de ZnO / β-Ga2O3 depositado en la capa atómica (\ (\ overline {2} 01 \))
- Transistor semiconductor de óxido metálico de doble difusión lateral de resistencia específica ultrabaja con doble puerta mejorada y capa parcialmente enterrada en P
- Transistor de efecto de campo SnSe2 con alta relación de encendido / apagado y fotoconductividad con conmutación de polaridad
- Python - Programación de extensiones con C



