Modificación de las propiedades ópticas de puntos cuánticos de InAs con límite de GaAsSb mediante capas intermedias de InAlAs
Resumen
En este trabajo, investigamos las propiedades ópticas de los puntos cuánticos (QD) de InAs cubiertos con In 0.15 compuesto Al 0,85 As / GaAs 0.85 Sb 0,15 Capas reductoras de deformación (SRL) mediante difracción de rayos X de alta resolución (HRXRD) y espectroscopía de fotoluminiscencia (PL) a 77 K. Thin In 0,15 Al 0,85 Como capas con grosor t =20 Å, 40 Å y 60 Å se insertaron entre los QD y un GaAs de 60 Å de espesor 0.85 Sb 0.15 capa. Las emisiones de tipo II observadas para GaAs 0.85 Sb 0,15 -capped InAs QDs fueron suprimidos por la inserción de In 0.15 Al 0,85 Como capa intermedia. Además, la longitud de onda de emisión se corrió al azul para t =20 Å y corrido al rojo para t ≥ 40 Å como resultado del aumento del potencial de confinamiento y del aumento de la tensión, respectivamente. La separación de energía del estado fundamental y del estado excitado se incrementa hasta alcanzar los 106 meV para t =60 Å en comparación con 64 meV para los QD limitados solo con GaAsSb SRL. Además, el uso de In 0.15 Al 0,85 A medida que las capas se reducen significativamente, el ancho de línea espectral QD de 52 a 35 meV para las muestras con 40 y 60 Å de espesor In 0.15 Al 0,85 Como capas intermedias.
Antecedentes
En las últimas décadas, los puntos cuánticos autoorganizados (QD) sintetizados mediante la técnica de Stranski-Krastanov han atraído una gran atención. Sus propiedades ópticas y electrónicas se han investigado intensamente debido a sus posibles aplicaciones en dispositivos optoelectrónicos [1]. El sistema QD de InAs / GaAs ampliamente investigado se ha empleado en una variedad de dispositivos optoelectrónicos como material activo. Durante el crecimiento de estas nanoestructuras, se produce un cambio significativo en el tamaño y la forma de los QD durante el proceso de taponado. Este proceso es bastante complejo e implica entremezclado, segregación o difusión mejorada por deformación [2]. El uso de una capa de recubrimiento de GaAs puro limita la emisión de QD a menos de 1300 nm. Para aliviar este problema, se han utilizado capas reductoras de tensión hechas de (Ga, In) (As, Sb, N) [2,3,4,5,6,7]. En particular, se ha prestado especial atención al ternario GaAsSb, ya que su alineación de banda resultante se puede adaptar para que sea de tipo I o tipo II cambiando el contenido de Sb [8, 9] y por su capacidad para extender la longitud de onda de emisión más allá de la banda C [10]. Sin embargo, la diferencia de energía entre el estado fundamental y excitado se limita a 60-75 meV cuando se utiliza GaAsSb como capa reductora de deformación (SRL) [11]. Esta separación de energía no evita que los portadores se escapen térmicamente de los QD. Para aplicaciones que requieren una larga vida útil de portadora, la inserción de una barrera delgada entre las QD de InAs y GaAsSb será beneficiosa, ya que aumentará la separación de portadora entre las QD y el pozo cuántico (QW) de GaAsSb. Como ejemplo, se han utilizado capas intermedias de GaAs, lo que ha dado lugar a una mejora de la eficiencia energética de las células solares en un factor del 23% [12]. El uso de capas de InAlAs puede ser de interés para diseñar el tipo de recombinación radiativa. Para la transición de tipo II, la inserción de InAlAs aumentará la vida útil de la portadora [13] y la separación de energía entre el estado fundamental y el primer estado excitado [14,15,16]. Además, se espera que la inserción de una capa de InAlAs entre InAs QD y GaAsSb disminuya la segregación y suprima los átomos de In y Ga entremezclados entre los InAs QD y GaAsSb SRL y reduzca aún más la tensión QD [17]. Los SRL compuestos de InAlAs / InGaAs se han utilizado para limitar los QD de InAs, lo que da como resultado una emisión de longitud de onda larga y una separación de energía favorable entre el estado fundamental y excitado de hasta 104 meV [16, 18].
En este documento, informamos la primera investigación del efecto de usar un In 0.15 Al 0,85 Como capa intermedia sobre las propiedades ópticas de InAs / GaAs 0.85 Sb 0,15 QDs mediante espectroscopia de fotoluminiscencia (PL). En particular, se estudiaron en detalle la variación de la longitud de onda de la emisión, el tipo de emisión óptica, el ancho de la línea espectral y la separación de energía entre el estado fundamental y el primer estado excitado.
Métodos
Las muestras investigadas en el presente estudio se cultivaron en sustratos de GaAs (001) de tipo p de 2 ″ epi-ready en un sistema de epitaxia de haz molecular Veeco Gen20A. Se utilizaron crackers con válvula para generar As 2 y Sb 2 dímeros. Después del crecimiento de una capa tampón de GaAs a 590 ° C, la temperatura del sustrato se redujo luego a ~ 485 ° C para desarrollar un QD de InAs nominalmente de 2,5 ml de espesor. Después de una breve pausa en As 2 flujo, un compuesto In 0.15 Al 0,85 As / GaAsSb SRL se depositó inmediatamente seguido por el crecimiento de un GaAs de 5 nm de espesor a la misma temperatura, después de lo cual la temperatura de crecimiento se incrementó a 570 ° C para hacer crecer una capa de barrera de GaAs de 38 nm. El grosor de GaAsSb se fijó en 60 Å mientras que el grosor de In 0,15 Al 0,85 Como se varió de 20 a 60 Å. La SRL de GaAsSb de 60 Å de espesor se realizó utilizando un As 2 / Sb 2 Relación de flujo que da un contenido de Sb del 15% según se determina mediante mediciones de difracción de rayos X en una muestra de referencia. Se utilizó una tasa de crecimiento de Ga fija de 0,5 ml / s para todas las capas. Se cultivaron cuatro muestras indicadas como A, B, C y D para las cuales el In 0.15 Al 0,85 Como espesor t se estableció en 0 Å, 20 Å, 40 Å y 60 Å, respectivamente. Con base en el procedimiento utilizado por Krijn [19] y utilizando los parámetros en [20], se ha estimado la posición relativa de las bandas de conducción y valencia y en la Fig. 1 se muestra un esquema de las estructuras desarrolladas con su correspondiente diagrama de bandas.
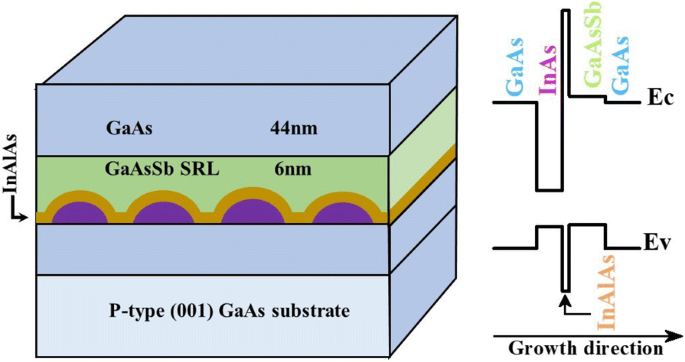
Esquema de las estructuras crecidas y diagrama de bandas de energía correspondiente de InAs QDs cubiertos con un compuesto In 0.15 Al 0,85 Como /GaAs0.85 Sb 0,15 . El In 0.15 Al 0,85 Como espesor t =0 Å, 20 Å, 40 Å y 60 Å para las muestras A, B, C y D, respectivamente
La calidad del cristal de las muestras se caracterizó por difracción de rayos X de alta resolución (HRXRD) utilizando un difractómetro de rayos X Panalytical. Las propiedades ópticas de las muestras cultivadas se evaluaron mediante espectroscopía PL a 77 K utilizando un módulo PL conectado a un instrumento infrarrojo por transformada de Fourier Vertex 80 (Bruker Optics GmbH) y utilizando un detector de InGaAs de alta ganancia termoeléctricamente enfriado [21]. Las muestras se excitaron con una fuente de láser de estado sólido CW de 532 nm.
Resultados y discusión
La calidad del cristal de las muestras cultivadas se caracterizó por HRXRD utilizando escaneos de curvas oscilantes registrando el patrón de difracción de 004 planos atómicos. La Figura 2a muestra los patrones de difracción obtenidos para las muestras A, B, C y D correspondientes al espesor de InAlAs de 0, 20, 40 y 60 Å, respectivamente. Se observan picos satélites claros resultantes de InAs / InAlAs / GaAsSb que muestran la buena calidad cristalina de las muestras cultivadas. Las curvas de balanceo de rayos X simuladas se incluyen en la Fig. 2a junto con los datos experimentales. El contenido medio de Sb obtenido en la muestra de referencia A es del 13% y el espesor de GaAsSb es de 66 Å. Estos valores se utilizaron en las muestras B, C y D para encontrar el contenido de In y el grosor de la capa intermedia de InAlAs. La simulación mostró que el contenido promedio de In es 13.5% y el espesor de la capa intermedia de InAlAs es 22 Å, 44 Å y 65 Å en las muestras B, C y D, respectivamente, que están cerca de los espesores nominales.

un ω de alta resolución / 2 θ escanea las muestras A, B, C y D. b Espectro PL de la muestra A obtenido a 77 K y 100 mW de excitación. c PL dependiente de la potencia de la muestra A a 77 K. d El pico de energía correspondiente para las dos primeras transiciones ópticas versus P ex 1/3 a 77 K
Las propiedades ópticas de la muestra de referencia A se investigaron primero a 77 K utilizando la técnica PL dependiente de la potencia. La Figura 2b muestra el espectro PL para una potencia de excitación de 100 mW. El espectro PL puede ajustarse mediante tres picos gaussianos centrados en 1004 meV, 1068 meV y 1113 meV, que pueden identificarse como las transiciones ópticas fundamentales y excitadas. El ancho total a la mitad del máximo (FWHM) de los estados fundamental y primer excitado es 52 y 58 meV, respectivamente. Para comprender el origen de las dos primeras transiciones ópticas observadas, se varió la potencia de excitación de 1 a 100 mW y se adquirieron los espectros PL correspondientes como se muestra en la Fig. 2c. Para cada potencia de excitación, la energía de los dos primeros picos se extrajo utilizando un ajuste de función multi-gaussiana y se representó como una función de la raíz cúbica de la potencia de excitación como se muestra en la Fig. 2d. La energía de la transición fundamental disminuye con la reducción de la potencia de excitación consistente con una transición de tipo II que indica que la emisión es el resultado de la recombinación de electrones ubicados en el estado fundamental de electrones en el QD (E0 QD ) y los orificios ubicados en el GaAsSb QW (H0 QW ). Para la alineación de bandas de InAs / GaAsSb tipo II, la localización de electrones y huecos en los QD y GaAsSb SRL, respectivamente, induce un efecto de flexión de banda resultante del campo eléctrico, que se encuentra predominantemente a lo largo de la dirección de crecimiento [22]. Se espera que la energía de transición de tipo II aumente proporcionalmente con la tercera raíz del poder de excitación como lo demostraron Jin et al. [22]. De manera similar, la energía de la primera transición de estado excitado disminuye al reducir la potencia de excitación, y esta transición es probablemente el resultado de la recombinación de electrones en el primer estado de excitación de electrones en el QD (E1 QD ) y agujeros dentro de GaAsSb QW (H0 QW ) ya que la densidad de estados en GaAsSb QW es mucho mayor que la densidad de estados en los QD. Las dos primeras transiciones ópticas se ilustran en la Fig. 3a. Observamos también que la separación de energía entre el estado fundamental y el primer estado excitado ΔE permanece casi constante a 64 meV con una potencia de excitación decreciente, y esto es evidencia de que el campo eléctrico resultante de la acumulación de carga es perpendicular a la dirección de crecimiento [22], es decir, los agujeros en el GaAsSb están localizados por encima de los QD. Se espera una emisión de tipo II en la muestra A ya que el contenido de Sb en el GaAsSb, que es del 13%, se acerca a la composición en la que se produce una transición del tipo I al tipo II [23, 24]. Para el contenido de Sb considerado, debería existir una pequeña compensación de banda de valencia entre los QD y el GaAsSb QW que favorezca la localización de huecos en el GaAsSb QW y, posteriormente, las emisiones de tipo II [25, 26].
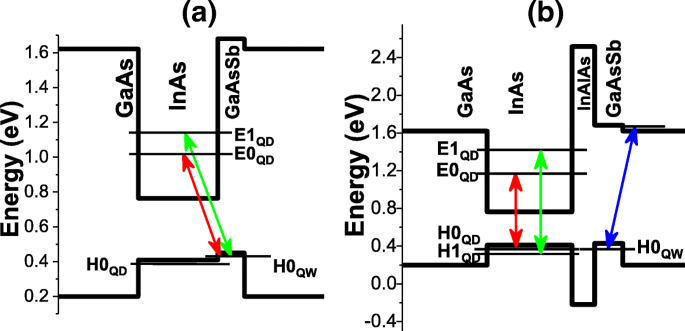
Perfiles de banda de la muestra A ( a ) y muestras B, C y D ( b ) con sus correspondientes canales de recombinación
La figura 4a muestra la emisión de PL correspondiente a las muestras con diferente In 0.15 Al 0,85 Como espesor con potencia de excitación que va desde 1 a 100 mW. Se pueden identificar tres picos principales para todas las muestras que contienen un In 0.15 Al 0,85 Como capa intermedia. Observamos una alteración de las posiciones de los picos de energía de los diferentes canales radiativos con respecto a la muestra de referencia A. A una potencia de excitación de 100 mW, la energía de la transición fundamental, FWHM, y la separación de energía ΔE fueron extraídas y comparadas con la muestra A. Los valores extraídos se informan en la Fig. 4b.

un PL dependiente de la potencia de InAs / In 0.15 Al 0,85 As / GaAsSb QD a 77 K. b La energía pico correspondiente, FWHM y ΔE frente al espesor de InAlAs y c la variación de la energía máxima de los canales de transición óptica en función de la raíz cúbica de la potencia de excitación para las muestras B, C y D
La transición del estado fundamental de la muestra A ocurre a 1004 meV con un FWHM de 52 meV y una separación de energía ΔE de 64 meV. Insertar 20 Å de In 0.15 Al 0,85 Como (muestra B) induce un desplazamiento hacia el azul de la transición del estado fundamental en 52 meV. El desplazamiento al azul es consistente con lo que se ha observado cuando se utilizó un compuesto InAlAs / InGaAs para QD cultivados a casi la misma temperatura de crecimiento [27]. El desplazamiento hacia el azul de la energía de transición del estado fundamental de los QD de InAs en la muestra B resulta del aumento del potencial de confinamiento [15]. A medida que aumenta la barrera para los electrones y los huecos, la separación del nivel de energía de los electrones y los huecos debería aumentar, lo que conduce al desplazamiento hacia el azul de la emisión observado. Es bien sabido que la limitación de InAs con GaAs da como resultado una reducción de la altura de QD como consecuencia de la segregación de In y la mezcla de In-Ga [28]. La introducción de Sb en la capa de cobertura de GaAs reduce la descomposición de QD al inhibir la mezcla de In-Ga impulsada por la deformación [29]. Se espera que la inserción de la capa intermedia de InAlAs suprima aún más la segregación de In y la mezcla de In-Ga resultante de la inactividad de los adatomos de Al. De hecho, Jun et al. [17] han demostrado mediante STEM que el uso de una capa de combinación de InAlAs / InGaAs como capa de cobertura suprime fuertemente la segregación de In-Ga y la mezcla de In-Ga a lo largo de la dirección de crecimiento durante el proceso de limitación de las QD de InAs, lo que conduce a un aumento altura de las nanoestructuras y una mayor concentración de In en InAs QD después de la limitación. Teniendo en cuenta la baja temperatura de crecimiento de los QD, es decir, 485 ° C, se espera que la segregación del indio y el entremezclado de la interfaz entre los QD y la capa intermedia de InAlAs sean insignificantes como resultado de la inactividad de los Al adatoms.
El FWHM y ΔE se reducen y aumentan a 39 meV y 92 meV, respectivamente. Aumentando aún más el grosor de In 0.15 Al 0,85 En cuanto a 40 Å y 60 Å (muestras C y D, respectivamente) provoca un corrimiento al rojo de la longitud de onda de emisión. Este desplazamiento al rojo probablemente se deba a la modificación de la deformación en InAs QD a medida que el espesor total del compuesto InAlAs / GaAsSb SRL aumenta con el aumento del espesor de InAlAs [30]. Esto puede cambiar las dimensiones estructurales de los QD y, por tanto, modificar los niveles de energía de los electrones y los huecos. Parece que para las muestras C y D (40 Å y 60 Å, respectivamente), el efecto de deformación domina el efecto de potencial de confinamiento. El FWHM más bajo de 35 meV y la separación de energía más alta ΔE de 35 meV y 106 meV se obtuvieron respectivamente para la muestra D. El ΔE grande es causado por el uso de una capa de InAlAs más gruesa y posiblemente una mayor altura de QD [31, 32]. La separación de energía es comparable a la obtenida cuando se utiliza una SRL compuesta de InAlAs / InGaAs (104 meV) [16, 33]. La reducción de la FWHM puede entenderse en términos de una reducción del entremezclado entre In 0,15 Al 0,85 As y QDs y, por tanto, una preservación de la distribución QD. Los parámetros extraídos se resumen en la Tabla 1.
La intensidad de PL de las muestras B y C aumentó en comparación con la muestra A; sin embargo, se observó una fuerte reducción de la intensidad de PL para la muestra D, es decir, una reducción en un factor de 5 en comparación con la muestra C. La intensidad de PL reducida resulta de la reducción de la inyección de portador de la capa de GaAsSb a los QD. De hecho, durante la iluminación, se fotogeneran numerosos portadores y la inserción del In 0.15 Al 0,85 Como capa intermedia crea una barrera para los portadores y puede limitar su inyección en las QD. Los portadores pueden transferirse a los QD a través de un proceso de tunelización, y la intensidad de PL es mayor para las muestras con In 0.15 más delgado. Al 0,85 Como barreras [34]. La muestra D mostró la intensidad PL más baja como túnel a través de 60 Å In 0.15 Al 0,85 Como se reduce en gran medida, y esto se evidencia por el aumento de la emisión de PL del GaAsSb QW como se muestra en la Fig. 4a. La reducción del proceso de tunelización favorece y potencia la recombinación radiativa de electrones y huecos en el GaAsSb QW.
La observación principal del PL dependiente de la potencia a 77 K para las muestras B, C y D que se muestran en la Fig.4a son las posiciones de energía fija de los dos primeros picos con una potencia de excitación creciente en contraposición a lo que se observó en la muestra A. es una característica de una emisión de tipo I en la que tanto los electrones como los huecos se localizan dentro de los QD. Los dos primeros picos de emisión resultan de la recombinación de electrones y huecos en los estados fundamental y excitado primero en los QD (E0 QD -H0 QD y E1 QD -H1 QD ). Creemos que el tercer pico se origina en una emisión de tipo II resultante de la recombinación de electrones dentro de GaAs y huecos localizados en GaAsSb QW. De hecho, la energía correspondiente a esta transición aumenta con el aumento de la potencia de excitación, como se muestra en la figura 4a y la figura 4c característica de una transición de tipo II. Además, vemos que su intensidad aumenta al aumentar In 0.15 Al 0,85 Como espesor de capa. Esto está de acuerdo con la reducción de la intensidad PL de la transición fundamental como un In 0.15 más grueso Al 0,85 Como capa reduce los portadores que tunelizan desde GaAsSb a los QDs y favorece la emisión de tipo II obtenida de la recombinación de electrones y huecos ubicados en GaAs y GaAsSb, respectivamente. En la figura 3b se representa un esquema de los canales de recombinación para las muestras B, C y D. La supresión de la emisión de tipo II puede entenderse como sigue. La inserción de un 20-Å en 0.15 Al 0,85 A medida que la capa aumenta la separación del portador entre los QD y GaAsSb QW, y como resultado, la superposición de la función de onda de los electrones y los huecos disminuye. Además, el hecho de que el contenido de Sb en el contenido de GaAsSb esté cerca del cruce de tipo I-tipo II, el In 0.15 Al 0,85 Como capa intermedia traerá el nivel confinado en el QW (H0 QW ) por debajo del primer nivel cuantificado en las QD (H0 QD ) como se muestra en la Fig. 3b y, por lo tanto, los agujeros capturados en el QW pueden hacer un túnel a través de la capa InAlAs haciendo menos probable la emisión de tipo II. Para un In 0.15 más grueso Al 0,85 Como capa intermedia (40 Å y 60 Å), la tunelización se reduce aún más, pero la superposición de la función de onda de electrones y huecos se reduce sustancialmente, lo que favorece la recombinación de electrones en GaAs con huecos en GaAsSb [13]. La transición óptica de los QD de InAs / GaAsSb se puede adaptar al tipo de aplicación que requiera una vida útil corta o larga. En nuestro estudio, hemos considerado un contenido de Sb del 13% en GaAsSb, que se acerca a la transición de tipo I a tipo II. La inserción de una capa intermedia de InAlAs suprimió la emisión de tipo II y aumentó la separación de energía entre el estado fundamental y el primer estado excitado, lo que es deseable para aplicaciones que requieren una vida útil corta de la portadora. El presente estudio también se puede adaptar para aplicaciones que requieran una larga vida útil. De hecho, se espera que la combinación de usar un mayor contenido de Sb en la capa de GaAsSb y la inserción de una capa intermedia de InAlAs mantenga la emisión de tipo II para las capas intermedias de InAlAs delgadas al tiempo que aumenta significativamente la vida útil de la portadora. Al mismo tiempo, la mayor separación de energía entre el estado fundamental y el primer estado excitado reducirá el escape térmico de la portadora.
Conclusión
InAs QDs limitados con compuesto In 0.15 Al 0,85 As / GaAs 0.85 Sb 0,15 SRL con diferentes In 0.15 Al 0,85 A medida que se cultivaron y caracterizaron espesores. Nuestro análisis muestra que la inserción de un In 0.15 Al 0,85 Como capa suprime la emisión de tipo II observada obtenida de InAs / GaAs 0.85 Sb 0.15 QDs. Además, la longitud de onda de emisión se desplaza al azul para t =20 Å y corrido al rojo para t ≥ 40 Å como resultado del aumento del potencial de confinamiento y del aumento de la tensión, respectivamente. Se obtuvo una gran separación de energía ΔE de 106 meV para la muestra con un In 0.15 de 60 Å de espesor. Al 0,85 Como capa intermedia. Además, la introducción de In 0.15 Al 0,85 Como capa intermedia reduce significativamente el FWHM de 52 meV alcanzando un mínimo de 35 meV.
Abreviaturas
- FWHM:
-
Ancho completo a la mitad del máximo
- HRXRD:
-
Difracción de rayos X de alta resolución
- PL:
-
Fotoluminiscencia
- QD:
-
Puntos cuánticos
- QW:
-
Pozo cuántico
- SRL:
-
Capas reductoras de tensión
Nanomateriales
- El reordenamiento atómico de múltiples pozos cuánticos basados en GaN en gas mixto H2 / NH3 para mejorar las propiedades estructurales y ópticas
- N, N-dimetilformamida reguladora de la fluorescencia de los puntos cuánticos de MXene para la determinación sensible de Fe3 +
- Detección de excitación espacialmente localizada en superredes de puntos cuánticos autoorganizadas InAs / InGaAs:una forma de mejorar la eficiencia fotovoltaica
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Síntesis ecológica de puntos cuánticos de núcleo / carcasa de InP / ZnS para su aplicación en diodos emisores de luz sin metales pesados
- Síntesis de puntos cuánticos de sulfuro de antimonio solubles en agua y sus propiedades fotoeléctricas
- Síntesis sonoquímica de un solo paso y propiedades fotocatalíticas fáciles de compuestos de puntos cuánticos de grafeno / Ag3PO4
- Eliminación del tamaño bimodal en puntos cuánticos de InAs / GaAs para la preparación de láseres de puntos cuánticos de 1,3 μm
- Fotoconductividad entre bandas de puntos cuánticos de InAs / InGaAs metamórficos en la ventana de 1,3 a 1,55 μm
- Material y propiedades ópticas de los puntos cuánticos de carbono fluorescente fabricados a partir de jugo de limón mediante una reacción hidrotermal
- Propiedades ópticas de películas de ZnO dopado con Al en la región infrarroja y sus aplicaciones de absorción



