Investigaciones sobre las propiedades ópticas de múltiples pozos cuánticos de InGaN / GaN con diferentes espesores de capa superior de GaN
Resumen
Se cultivaron tres muestras de MQW de InGaN / GaN con diferentes espesores de capa de cubierta de GaN mediante deposición de vapor químico metalorgánico (MOCVD) para investigar las propiedades ópticas. Descubrimos que una capa superior más gruesa es más eficaz para prevenir la evaporación de la composición de In en la capa de pozo cuántico de InGaN. Además, el efecto Stark confinado cuánticamente (QCSE) se mejora al aumentar el grosor de la capa superior de GaN. Además, en comparación con los resultados de la medición de electroluminiscencia, nos centramos en la diferencia de estados de localización y defectos en tres muestras inducidos por varios espesores de capa para explicar las anomalías en las mediciones de fotoluminiscencia a temperatura ambiente. Descubrimos que una capa superior de GaN demasiado delgada exacerba la falta de homogeneidad de los estados de localización en la capa QW de InGaN, y una capa superior de GaN demasiado gruesa generará más defectos en la capa superior de GaN.
Introducción
La estructura de múltiples pozos cuánticos (MQW) de InGaN / GaN se utiliza ampliamente en diodos emisores de luz visible (LED) y diodos láser (LD) como región activa, y ha logrado un gran éxito [1, 2, 3, 4]. Mejorar la calidad de los MQW de InGaN / GaN es tecnológicamente importante para lograr LED y LD de alto rendimiento basados en GaN. En investigaciones anteriores, se encontró que las barreras cuánticas (QB) de GaN (HT-GaN) crecidas a alta temperatura son beneficiosas para mejorar la calidad del cristal y la intensidad luminosa de los pozos cuánticos de InGaN / GaN [5, 6]. Debido a la fuerza de enlace débil de In-N, la temperatura de crecimiento de la capa de pozos cuánticos (QW) de InGaN es generalmente más baja que la de los QB de GaN para obtener un alto contenido de In. Esto puede hacer que los átomos de indio se evaporen de InGaN QW durante el crecimiento de GaN QB a temperaturas más altas. Se ha demostrado que la inserción de una capa de capa de GaN cultivada a baja temperatura (capa de LT-GaN) entre InGaN QW y GaN QB reduce eficazmente la desorción de la composición, lo que puede mejorar la uniformidad del espesor de la capa de InGaN QW y la distribución de la composición de In [7,8,9]. Sin embargo, cuando la temperatura de crecimiento de la capa superior de GaN disminuye, la capacidad de migración de los adatomos se debilita, lo que da como resultado el deterioro de los materiales de GaN. Además, se informa que el número de defectos aumenta con el aumento del espesor de la capa superior de GaN crecido a baja temperatura, lo que no favorece la mejora de la uniformidad de la distribución de átomos de indio y la intensidad luminosa de los pozos cuánticos de InGaN [10]. Muchos informes anteriores no se centraron en el efecto de los estados de localización en las propiedades de luminiscencia en la región activa con varios espesores de capa de GaN. En este trabajo, utilizamos difracción de rayos X (XRD), electroluminiscencia (EL) y fotoluminiscencia (PL) para informar la influencia del espesor de la capa de capa de GaN crecido a baja temperatura en la estructura y las propiedades de luminiscencia de InGaN / GaN. MQW, y describa en detalle el papel de los estados de localización en las características de luminiscencia mediante experimentos PL dependientes de la temperatura.
Métodos
Se cultivaron tres muestras de MQW de InGaN / GaN en el sustrato de zafiro plano c mediante deposición de vapor químico metalorgánico (MOCVD). Todas las muestras contienen las mismas estructuras, que constan de una capa tampón de GaN sin dopar (1,2 μm), una capa de n-GaN dopada con Si (1 μm), una región activa de MQW de InGaN / GaN de dos períodos y una p-GaN dopada con Mg capa (40 nm). En el proceso de crecimiento de la región activa de InGaN / GaN, las condiciones de crecimiento de los QW de InGaN eran idénticas entre sí; Se cultivó una fina capa superior de LT-GaN a la misma temperatura que InGaN QW (710 ° C) para evitar la evaporación del indio, y el tiempo de crecimiento de la capa superior de LT-GaN fue de 150 s, 300 sy 500 s para la muestra A, B y C, respectivamente; y luego la temperatura de crecimiento de GaN QB se elevó hasta 810 ° C para mejorar la calidad del material de GaN QB, y el tiempo de crecimiento de HT-GaN QB fue idéntico para estas muestras. Se utilizó difracción de rayos X (XRD) para determinar los parámetros estructurales de estas tres muestras. Se llevaron a cabo electroluminiscencia (EL) y fotoluminiscencia a temperatura ambiente (PL) para caracterizar las propiedades ópticas de las regiones activas.
Los espectros EL se midieron utilizando un espectrómetro de alta resolución Ocean Optics HR2000 en corriente continua (CC), donde la potencia de salida se detecta mediante un fotodiodo de Si, y la energía pico espectral EL y FWHM se detectan mediante un monocromador y un tubo fotomultiplicador. Para la medición PL, un λ =Se utilizó láser He-Cd de onda continua de 325 nm como fuente de excitación, con una potencia óptica incidente de 3 mW y un tamaño de punto de 0,5 mm 2 . Se registraron mediciones de PL dependientes de la temperatura de 30 K a 300 K para analizar el efecto de los estados de localización en las características de luminiscencia utilizando un láser semiconductor de GaN de 405 nm con una potencia de emisión de 5 mW como fuente de excitación. La muestra se enfrió con helio líquido de flujo libre y se utilizó un refrigerador de ciclo cerrado de CTI Cryogenics para las mediciones dependientes de la temperatura
Resultados y discusiones
La Figura 1a muestra los patrones de difracción del plano (0002) tomados por barrido ω-2θ para estas muestras. Los picos de satélite de estas muestras se pueden ver claramente, lo que indica que existen una estructura periódica fina y una interfaz nítida en estos MQW. Usamos SmartLab Studio II y el programa Global Fit (que ofrece un método de ajuste de base de templado paralelo avanzado para analizar los datos generados por el difractómetro SmartLab) para obtener la composición promedio de In, y el espesor QB y QW, como se muestra en la Tabla 1. Puede ser claramente visto que la composición de In en el QW aumenta con el aumento del espesor de la capa superior de LT-GaN, lo que indica que una capa superior más gruesa es más eficaz para prevenir la evaporación de la composición de In. La Figura 1b muestra el mapeo del espacio recíproco (RSM) de la muestra C. El pico principal de GaN y los picos satélites se encuentran en una línea, lo que sugiere que las capas QW con el contenido de In más alto en todas las muestras están completamente en tensión. Por lo tanto, debe tenerse en cuenta la influencia del campo piezoeléctrico en las propiedades luminosas.
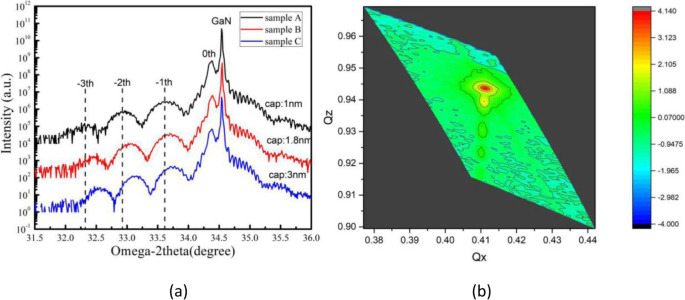
un Curvas de exploración XRD ω-2θ en el plan GaN (0002) para las muestras A, B y C. b Mapeo del espacio recíproco de la muestra C
La Figura 2 muestra los espectros EL de las muestras A, B y C con una corriente de 5 mA. La longitud de onda máxima es de 453,6 nm, 456,3 nm y 466,7 nm para las muestras A, B y C, respectivamente. A partir de los resultados de las mediciones de XRD, a medida que aumenta el grosor de la capa superior de LT-GaN, el aumento de la composición de In en los QW inducirá el desplazamiento hacia el rojo de la energía máxima de EL. También encontramos que la intensidad de EL disminuye con el aumento del espesor de la capa de cobertura de LT-GaN. Se sabe que una capa de barrera de GaN más gruesa (el espesor total de la capa superior de LT-GaN y HT-GaN QB) aumenta la distancia de los orificios desde p-GaN a la región activa, lo que da como resultado una reducción en la eficiencia de la inyección del orificio, lo que conduce a una disminución en la intensidad de EL [11, 12]. Además, el aumento de la composición de In mejorará el campo piezoeléctrico en la capa de InGaN QW, por lo que la inclinación de la banda de energía se agrava, lo que da como resultado un desplazamiento al rojo del pico de emisión y una eficiencia luminosa reducida, lo que se conoce como Stark confinado cuánticamente. efecto (QCSE) [13,14,15]. Para verificar la influencia de QCSE en EL, la energía pico y FWHM de EL cambiando con diferentes inyecciones se muestran en la Fig. 3. A medida que aumenta la corriente de inyección, el desplazamiento azul de la energía máxima de emisión se puede atribuir al efecto de relleno de banda y QCSE compensado por el efecto de selección de electrones [16, 17, 18]. Dado que la muestra C con la mayor composición de In tiene el pozo de potencial más profundo y el campo piezoeléctrico más fuerte, el efecto de relleno de banda y el efecto de filtrado de carga son los más significativos, por lo que la cantidad de cambio de azul de energía pico EL es la mayor para la muestra C (166 meV ). El efecto de relleno de banda y el efecto de filtrado de carga en la muestra A es el más débil, por lo que la contracción de la banda prohibida debido al efecto térmico es gradualmente dominante bajo una corriente de inyección alta (50 mA), lo que da como resultado un desplazamiento hacia el rojo de la energía máxima. Para la muestra A, el FWHM aumenta al aumentar la corriente de inyección como se muestra en la Fig. 3b, lo que indica que el ensanchamiento del espectro EL inducido por el efecto de relleno de banda es siempre dominante. Se ha informado que el filtrado de carga del campo eléctrico polarizado en los QW de InGaN provocará el estrechamiento del ancho de banda espectral EL con el aumento de la corriente de inyección [19]. Por lo tanto, para las muestras B y C, el efecto de relleno de banda es significativo a corrientes de inyección más bajas y el espectro EL se amplía. A medida que la corriente de inyección aumenta aún más, los portadores de detección del proceso de campo eléctrico polarizado se hacen cargo gradualmente, por lo que el FWHM disminuye. Además, también encontramos que la corriente correspondiente al punto de inflexión de FWHM de subir a bajar para las muestras B y C es de aproximadamente 10 mA y 20 mA respectivamente, lo que también implica que el campo piezoeléctrico en la muestra C es el más fuerte.
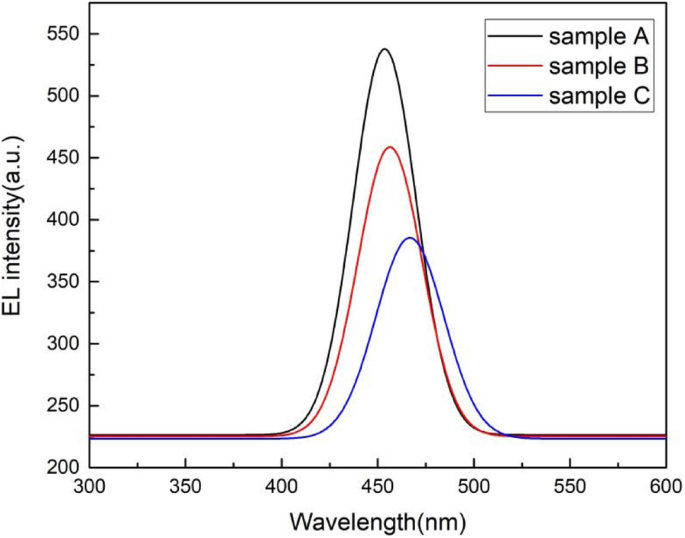
Espectros EL de las muestras A, B y C con una corriente de 5 mA
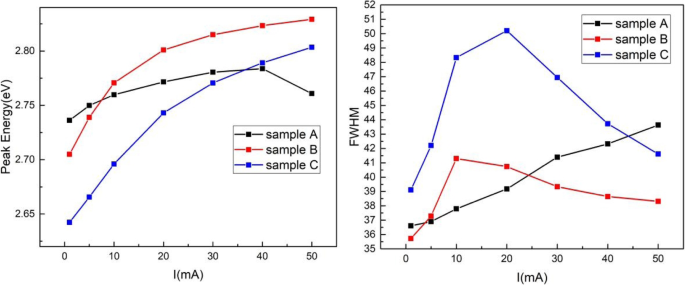
( a ) EL pico de energía y ( b ) EL ancho completo a la mitad del máximo (FWHM) en función de la corriente de inyección para las muestras A, B y C
La Figura 4a muestra los espectros PL a temperatura ambiente para las muestras A, B y C a una potencia de excitación del láser semiconductor de GaN de 5 mW 405 nm. La longitud de onda máxima es 473,1 nm, 472,9 nm y 478,2 nm para las muestras A, B y C, respectivamente. Dado que la intensidad PL de las muestras B y C en la Fig. 4a son relativamente débiles, también utilizamos láser He-Cd de 325 nm como fuente de excitación para ejecutar el experimento de fotoluminiscencia. Los resultados experimentales de PL en la Fig. 4a yb son consistentes entre sí, lo que elimina la incertidumbre de los resultados experimentales obtenidos en la Fig. 4a. En comparación con los resultados de la medición EL de la Fig. 2, encontramos algunas anomalías en la Fig. 4a:(1) La muestra A contiene menos composición de In que la muestra B, pero la longitud de onda máxima de la muestra A es ligeramente más larga que la muestra B; (2) la intensidad PL de la muestra B y C es similar entre sí, y la intensidad luminosa de la muestra A es mucho mayor que la de la muestra B y C. Para descubrir las razones relevantes para explicar estas anomalías, PL dependiente de la temperatura (TDPL ) se realizó para tres muestras, y la energía pico PL en función de la temperatura se muestra en la Fig. 5. Para la muestra B, la energía pico de emisión disminuye monótonamente al aumentar la temperatura. En términos generales, el aumento de la contracción de la banda prohibida inducida por la temperatura dará como resultado un desplazamiento hacia el rojo de la energía de emisión. Sin embargo, hay un cambio azul notable en la muestra A cuando la temperatura aumenta de 70 K a 190 K. Se ha introducido la redistribución térmica de excitones localizados para explicar el cambio azul de emisión anormal en TDPL:con el aumento de temperatura, los excitones localizados se activaron térmicamente y transferencia térmica desde los mínimos potenciales de los estados de localización a un estado de mayor energía [5, 20, 21]. Para la muestra C, la energía pico PL casi no cambia en el rango de 50 K a 175 K, lo que indica que el efecto de contracción de la brecha de banda y el efecto de localización de los excitones se compensan entre sí.
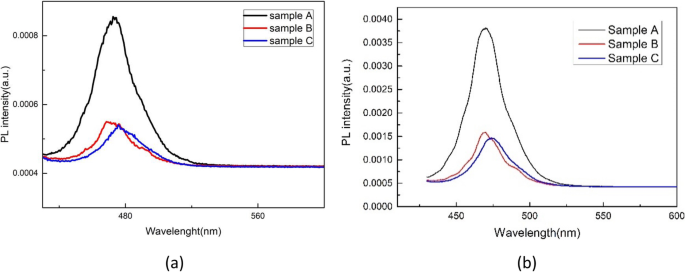
Espectros PL a temperatura ambiente para las muestras A, B y C mediante el uso de un láser semiconductor de GaN de 405 nm ( a ) y láser He-Cd de 325 nm ( b ). La longitud de onda máxima es 473,1 nm, 472,9 nm y 478,2 nm obtenida de ( a ) y 470,5 nm, 470,1 nm y 475,2 nm obtenidos de ( b ) para las muestras A, B y C, respectivamente
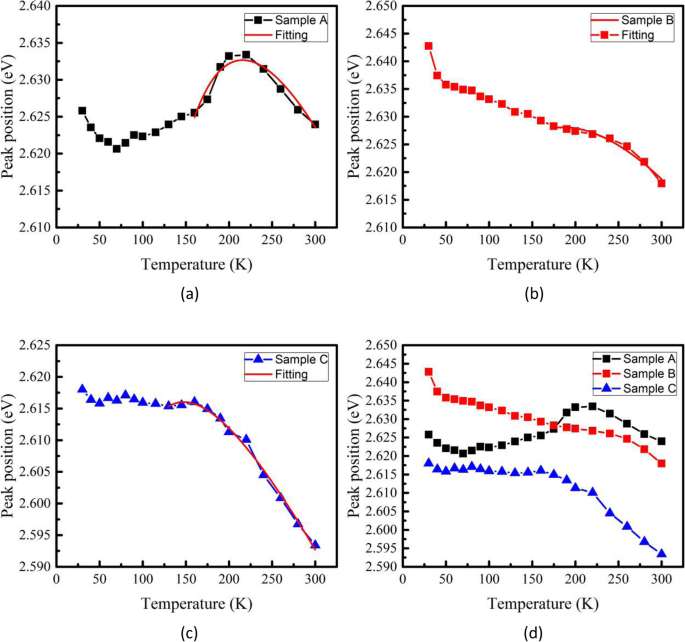
Las líneas rojas en ( a ), ( b ) y ( c ) son curvas de ajuste basadas en la ecuación. (1) y el parámetro de ajuste σ es 36,96 meV, 18,89 meV y 23,77 meV para las muestras A, B y C, respectivamente. ( d ) Muestra los datos experimentales de la energía pico PL en función de la temperatura
Teniendo en cuenta el efecto de localización del excitón, el modelo de cola de banda puede revisarse a la siguiente expresión para describir la energía máxima de emisión dependiente de la temperatura [22, 23]:
$$ {E} _0 (T) ={E} _0 (0) \ hbox {-} \ frac {\ alpha {T} ^ 2} {T + \ beta} \ hbox {-} \ frac {\ sigma ^ 2 } {{\ mathrm {k}} _ BT} $$ (1)donde E 0 (0) es la banda prohibida en T =0, α y β son los parámetros de Varshini, k B es la constante de Boltzmann. El tercer término σ es la desviación estándar de la distribución localizada y describe el grado de efecto de localización, es decir, un valor mayor de σ significa una falta de homogeneidad más fuerte de los estados de localización. La fluctuación de la composición de In en InGaN puede ser la razón principal de la formación de la cola de la banda. Los estados en las colas de las bandas se forman a la mínima energía potencial local, similar a los puntos cuánticos. La recombinación de pares de electrones y huecos en estos puntos cuánticos autoformados puede considerarse como recombinación de excitones localizada [24, 25]. El modelo no es aplicable a bajas temperaturas debido a una fuerte degeneración y una posible desviación del cuasi-equilibrio [20]. El parámetro de ajuste σ es 36,96 meV, 18,89 meV y 23,77 meV para las muestras A, B y C respectivamente, lo que implica que los estados de localización de la muestra A con la capa superior más fina son los menos homogéneos. En general, los estados de localización se originan a partir de grupos ricos en In con diferentes tamaños y la fluctuación del espesor QW en las aleaciones de InGaN. Por lo tanto, creemos razonablemente que una capa superior de LT-GaN más delgada no puede evitar eficazmente la evaporación del indio cuando se aumenta la temperatura a una capa de GaN QB desarrollada. El proceso de evaporación aleatoria de la composición de indio da como resultado una fluctuación del contenido de In y del espesor de InGaN QW. Para la muestra B, la capa superior de GaN de 1,8 nm de espesor es lo suficientemente gruesa para proteger al In de la desorción para formar una capa de InGaN QW más uniforme. Los estados de localización no homogéneos generalmente retienen un estado potencial más profundo y dan como resultado un desplazamiento hacia el rojo de la energía máxima de emisión. Es por eso que la longitud de onda máxima de la muestra A es más larga que la muestra B observada en la Fig. 4. Además, un aumento de la composición de In en la capa de InGaN QW también promoverá la formación de grupos de In de gran tamaño, lo que explica por qué el efecto de localización de excitones en la muestra C con el mayor contenido de indio es ligeramente más fuerte que la muestra B.
La Figura 6 muestra la intensidad PL integrada en función de la temperatura para las muestras A y C, que puede ajustarse bien mediante la siguiente expresión [5, 26]:
$$ I (T) =\ frac {1} {1 + {\ sum} _ {\ mathrm {i}} {C} _i \ exp \ left (- \ frac {E_i} {k_BT} \ right)} $ $ (2)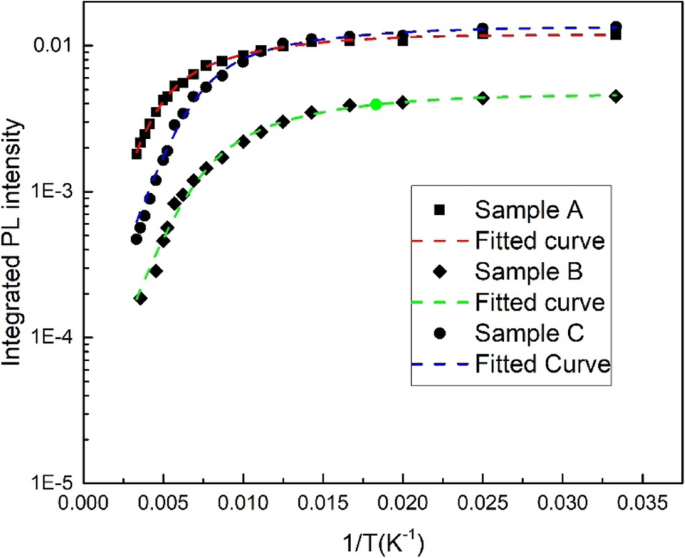
Intensidad PL integrada en función de la temperatura inversa para las muestras A, B y C
donde C i es una constante correspondiente a la densidad de los centros de recombinación no radiativos, y E i representa la energía de activación de los centros de recombinación no radiativa. El parámetro de ajuste C i y E i se muestran en la Tabla 2. Es notable que el voltaje del fotomultiplicador en el espectrómetro de rejilla para la muestra B se fijó más bajo que las muestras A y C durante las mediciones de PL dependientes de la temperatura; por lo tanto, la intensidad PL integrada de la muestra B es la más baja, pero no afecta los resultados del ajuste.
C 2 para las muestras B y C son más grandes que la muestra A, lo que indica que se forman más defectos en una capa superior de LT-GaN más gruesa. Se ha observado que los defectos en la capa LT-cap aumentan con el aumento del espesor de la capa LT-cap [6, 10]. La influencia de los defectos en la capa superior de LT-GaN junto al pozo cuántico sobre la intensidad de PL es significativa ya que las funciones de onda de electrones y huecos penetran en las barreras. La energía activa de 79,67 meV ( E a2 para la muestra A) está relacionada con la emisión de huecos de los QW seguidos de atrapamiento por defectos de barrera y recombinación no radiativa, que consta de los informes de Olaizola [6]. También comparamos las imágenes de micro-PL de las muestras A, B y C como se muestra en la Fig. 7. Las manchas oscuras en las imágenes de micro-PL pueden atribuirse a la recombinación no radiativa en la región activa de InGaN / GaN. En comparación con la muestra A, se pueden observar, obviamente, manchas oscuras de mayor tamaño en las muestras B y C, lo que indica que existen más defectos en una capa superior de LT-GaN más gruesa. En general, el recocido térmico se implementa después de la capa final de LT para reducir el grupo de indio en la capa de InGaN y mejorar la calidad del cristal. Si la capa superior es demasiado gruesa, el efecto del recocido térmico se debilitará y la formación de más precipitados de indio metálico obstaculizará la difusión de los adatomos de la capa superior de GaN e introducirá más defectos en la capa LT. La aparición de más defectos y QCSE más fuerte en MQW de InGaN / GaN con una capa superior de LT-GaN más gruesa es desventajosa para mejorar la intensidad de luminiscencia, entonces, ¿por qué la intensidad PL de C es comparable a B? De hecho, los estados de localización también juegan un papel importante en la mejora de la eficiencia luminosa. Los portadores pueden capturarse en estados localizados y recombinarse radiativamente. Cuanto más fuerte sea el efecto localizado de los excitones, más portadores no serán capturados en los defectos, lo que parece explicar que la intensidad PL de las muestras B y C es similar entre sí, y la intensidad luminosa de la muestra A es mucho mayor que la de las muestras B y C.
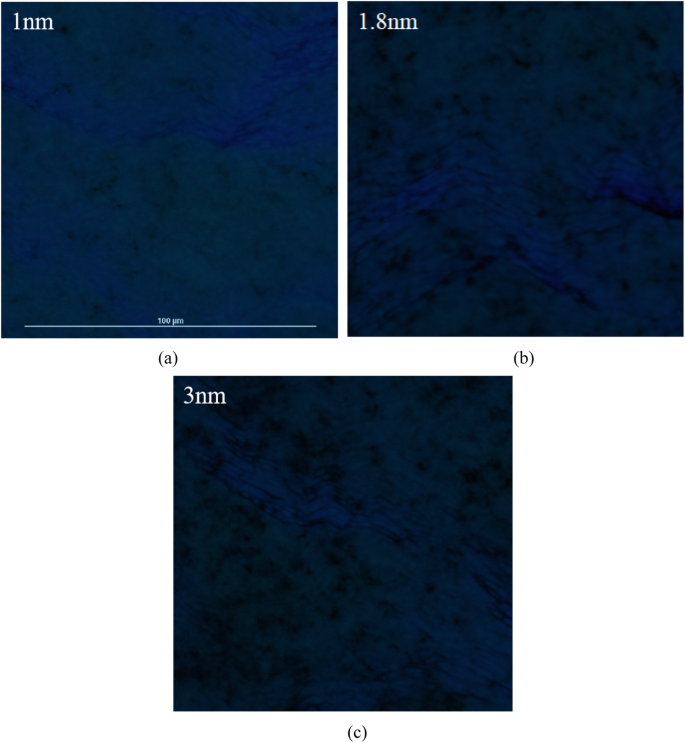
Imágenes Micro-PL de muestras A, B y C con varios espesores de capa de capa de LT-GaN ( a ) 1 nm, ( b ) 1.8 nm y ( c ) 3,0 nm
Conclusiones
En resumen, se investigó la influencia del espesor de la capa superior de GaN sobre las características ópticas. Los resultados obtenidos de las mediciones de XRD muestran que una capa superior más gruesa es más eficaz para proteger la composición de la desorción. El QCSE se mejora y la eficiencia de la inyección de los orificios se reduce al aumentar el espesor de la capa superior de GaN. Los diversos grados de efecto de localización de excitones inducidos por diferentes espesores de capa de capa de GaN explican las anomalías de la longitud de onda e intensidad del pico PL para tres muestras. Una capa de capa de LT demasiado fina exacerbará la falta de homogeneidad de los estados de localización en la capa de InGaN QW, y una capa de capa de LT demasiado gruesa generará más defectos en la capa de capa de GaN. Por lo tanto, optimizar el grosor de la capa superior de LT-GaN es un tema clave para promover la uniformidad y la intensidad de emisión de la capa activa de InGaN.
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados y / o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- MOCVD:
-
Deposición de vapor químico metalorgánico
- QCSE:
-
Efecto Stark confinado cuántico
- MQW:
-
Múltiples pozos cuánticos
- QB:
-
Barrera cuántica
- LED:
-
Diodos emisores de luz
- LD:
-
Diodos láser
- HT:
-
Alta temperatura
- LT:
-
Baja temperatura
- EL:
-
Electroluminiscencia
- TDPL:
-
Fotoluminiscencia dependiente de la temperatura
- XRD:
-
Difracción de rayos X
- FWHM:
-
Ancho completo a la mitad del máximo
Nanomateriales
- El reordenamiento atómico de múltiples pozos cuánticos basados en GaN en gas mixto H2 / NH3 para mejorar las propiedades estructurales y ópticas
- Emisión multicolor de una estructura de nanopiramida cuasicristalina fotónica ultravioleta basada en GaN con múltiples pozos cuánticos semipolares InxGa1 − xN / GaN
- Las propiedades eléctricas de los compuestos híbridos basados en nanotubos de carbono de paredes múltiples con nanoplaquetas de grafito
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- Propiedades ópticas de películas de ZnO dopado con Al en la región infrarroja y sus aplicaciones de absorción
- Ajuste de las propiedades ópticas de nanocristales CsPbBr3 mediante reacciones de intercambio aniónico con solución acuosa CsX



