Variación en la microestructura y las propiedades mecánicas de las películas de Ti-Al-N inducida por la atmósfera de plasma de nitrógeno reactivo mejorado de la fuente de iones RF-ICP
Resumen
La adquisición de las condiciones óptimas de crecimiento de las películas de Ti-Al-N, los efectos de la atmósfera de gas, especialmente el plasma reactivo sobre las microestructuras del material, y las propiedades mecánicas siguen siendo un tema fundamental e importante. En este estudio, las películas de Ti-Al-N se depositan de forma reactiva mediante un sistema de pulverización catódica mejorado con fuente de iones de plasma acoplada inductivamente por radiofrecuencia (RF-ICPIS). Se adoptan diferentes velocidades de flujo de gas nitrógeno al dejarlo entrar en la fuente de iones para obtener densidades de plasma de nitrógeno y alterar la atmósfera de deposición. Se encuentra que el contenido de elementos de nitrógeno en las películas está bastante influenciado por la densidad del plasma de nitrógeno, y el valor máximo puede alcanzar hasta el 67,8% en circunstancias de alto flujo de gas. Los espectros XRD y las imágenes FESEM indican que la baja densidad del plasma es beneficiosa para la cristalización de la película y la microestructura densa. Además, las propiedades mecánicas como la dureza y el rendimiento tribológico se mejoran mutuamente al ajustar la atmósfera de nitrógeno.
Introducción
Debido a las respetables propiedades mecánicas como alta dureza, anticorrosión y resistencia superior a la oxidación, Ti-Ai-N ha atraído mucha atracción en el corte seco y de alta velocidad como películas de protección de superficies para máquinas herramienta [1,2,3]. Hoy en día, se han desarrollado variedades de técnicas para la fabricación de películas de Ti-Al-N, incluida la deposición química en fase de vapor [4], la evaporación por arco [5], el recubrimiento iónico [6] y la pulverización catódica reactiva de CC / RF [7]. Durante el progreso de la deposición de la película de Ti-Al-N, la atmósfera de gas es bastante importante y compleja [8,9,10,11,12]. Por ejemplo, en la deposición de pulverización catódica reactiva, el plasma de nitrógeno en no equilibrio no solo depende de la concentración de iones de argón o nitrógeno, sino que también se ve afectado por la densidad de electrones secundarios o la presión total del gas que agravan las dificultades para comprender la atmósfera de nitrógeno reactivo inducida. la variación de las propiedades de la película de Ti-Al-N. Jeong y col. han informado de la morfología del crecimiento de las películas de Ti-Al-N que se vio influenciada por las tasas de flujo de nitrógeno [13]. Irudayaraj y col. han encontrado que la tasa de deposición, el tamaño de grano y la relación de concentración de Ti a Al de las películas de Ti-Al-N depositadas disminuyeron con el aumento de N 2 caudal [14]. Debido a la importancia de adquirir conocimientos valiosos para la selección de las condiciones óptimas de crecimiento, los efectos de la atmósfera de nitrógeno, especialmente la densidad del plasma reactivo sobre el contenido de los elementos del material y las microestructuras correspondientes y las propiedades mecánicas del Ti-Al-N, aún deben explorarse más. .
En nuestro trabajo anterior, se ha verificado que la fuente de iones de plasma acoplada inductivamente por radiofrecuencia (RF-ICPIS) mejora la deposición de Ti-Al-N al reducir la temperatura de ionización del gas argón y aumentar las tasas de ionización [15]. En este artículo, ionizamos directamente gas nitrógeno en una cavidad RF-ICPIS descargada, y un haz de plasma de nitrógeno denso se introduce directamente en la cámara reactiva para participar en la deposición reactiva. En comparación con el sistema de pulverización catódica tradicional de RF / DC, la densidad del plasma de nitrógeno proporcionada por RF-ICPIS se puede controlar fácilmente cambiando las potencias de RF o las tasas de flujo de gas. Se estudian y discuten las influencias de la variación del plasma de nitrógeno sobre el contenido de los elementos, las microestructuras, las morfologías de la superficie, así como las propiedades mecánicas de las películas de Ti-Al-N.
Método
Deposición de película
Las películas de Ti-Al-N se depositaron sobre Si (100) y acero inoxidable pulido a espejo mediante un sistema de pulverización catódica magnetrón mejorado con fuente de iones RF-ICP con una temperatura de crecimiento de 200 ° C. Los sustratos se colocaron en un portamuestras giratorio (20 rpm) que era perpendicular a un Ti 0.5 Al 0.5 objetivo compuesto con pureza del 99,9%. Después de bombear la cámara de pulverización catódica a una presión base inferior a 1,0 × 10 −4 Pa y limpieza de la superficie objetivo mediante iones de argón, la capa tampón de Ti-Al se depositó sobre los sustratos mediante pulverización catódica con CC. A continuación, el plasma de nitrógeno producido a partir de RF-ICPIS se introdujo cerca de los sustratos para asistir a la deposición reactiva de la película de Ti-Al-N. La potencia de RF-ICPIS se controló a 50 W, y las velocidades de flujo de gas nitrógeno en la entrada de la fuente de iones se variaron de 5 a 25 sccm para alterar las densidades del plasma de nitrógeno y obtener diferentes atmósferas de pulverización catódica y deposición. Mientras tanto, la corriente de pulverización catódica de CC se fijó en 0,4 Å y la presión total del gas de la cámara de pulverización catódica se mantuvo en 0,5 Pa. Los parámetros de crecimiento detallados se enumeran en la Tabla 1.
Caracterización
El contenido de los elementos se caracterizó por espectrómetro de dispersión de energía (EDS, Oxford X-Max 50) y las estructuras cristalinas de las películas de Ti-Al-N se revelaron por difracción de rayos X (XRD, Bruker D8 Advance) con una radiación Cu Kα ( λ =1,54056 Å). Las morfologías de la superficie y la microestructura transversal de las películas se midieron mediante microscopía electrónica de barrido por emisión de campo (FESEM, ZEISS Ultra 55). Se aplicó microscopía de fuerza atómica (AFM, Asylum Research) para medir la raíz cuadrada media de la superficie (RMS). Se adoptó una punta de diamante piramidal para la prueba de nano-indentación, y la dureza se midió con MTS Nano Indenter XP y se calculó mediante el método de indentación de Oliver-Pharr. Se tomaron cada muestra, diez mediciones puntuales separadas, para obtener un valor medio de dureza. Para medir el coeficiente de fricción se utilizó un aparato de desgaste convencional de bola sobre disco con una velocidad de deslizamiento de 0,2 m / s bajo una carga de 10 N.
Resultados y discusión
La Figura 1 muestra los contenidos de elementos de Ti, Al y N en películas de Ti-Al-N depositadas a diferentes velocidades de flujo de gas nitrógeno. El contenido de N en las películas de Ti-Al-N se mejora monótonamente con el aumento de los flujos de gas nitrógeno admitidos en la fuente de iones. Dentro de la región de flujo de gas nitrógeno bajo (5-15 sccm), los contenidos de N se mantienen en 45-50%, y las raciones (Ti + Al) / N son similares a la estructura de (Ti, Al) N. Cuando se mejoran aún más los caudales de gas nitrógeno de 15 a 25 sccm, los contenidos de N en las películas de Ti-Al-N aumentan rápidamente. El valor máximo del 67,8% se obtiene a 25 sccm, que supera el 50% en el (Ti, Al) N o Ti x común Al 1-x N microestructura, que indica que se producen transiciones de fase en S4 y S5. Los contenidos de Ti y Al en las películas de Ti-Al-N exhiben una tendencia opuesta al elemento N en función de las tasas de flujo del gas nitrógeno. Para todas las películas, los contenidos de Al son más altos que los de Ti, lo que es similar a los resultados de las películas de Ti-Al-N depositadas bajo una atmósfera de plasma mejorada. La diferencia de contenido entre los elementos de Al y Ti se puede atribuir a la diferencia de rendimiento de pulverización catódica entre el átomo de Al con calidad de luz y el átomo de Ti. Además, los átomos de Al rezuman fácilmente a las regiones de la superficie de las películas, lo que también podría llevar a que los contenidos de Al detectados sean ligeramente más altos que los valores reales en el interior de las películas [16].

Contenido de los elementos de las películas de Ti-Al-N fabricadas con varios índices de flujo de gas nitrógeno
La XRD se realiza para las muestras depositadas en obleas de Si (100). Como se muestra en la Fig. 2, S1-S5 exhiben la estructura cúbica centrada en la cara (fcc) de tipo NaCl típica con múltiples planes de difracción orientados en (111), (200), (220) y (311), excepto para (311 ) para muestras S4 y S5 depositadas con caudales de gas elevados [17]. Para la estructura f.c.c Ti-Al-N, (111) es el plano densamente empaquetado con una energía superficial más baja, mientras que (200) y (220) le siguen. En S1-S5, todos los Ti-Al-N depositados exhiben la orientación preferida (220) en lugar de (111). En nuestro estudio anterior, encontramos que las tasas de deposición de película mejoraron en el sistema de pulverización catódica mejorado RF-ICPIS. Esto conduce a la disminución del tiempo de migración de los adatomos sobre los sustratos y favorece el crecimiento de (220) cristales planos con mayor energía superficial, a expensas de otros debido a su mayor densidad de saliente y luego a una distancia de difusión más corta a los sitios de menor energía relativa [13 ]. Además, la distorsión de la red inducida por la incorporación de átomos de Al con una alta concentración también contribuye al crecimiento preferencial (220) en lugar de (111) [18]. Las intensidades y FWHM de (220) picos también revelan la dependencia de la cristalización de las velocidades de flujo del gas nitrógeno. En el rango de flujo de gas bajo (5-15 sccm), la intensidad y FWHM mejoran cuando se aumenta la tasa de flujo de nitrógeno, lo que indica los tamaños de granos cristalinos de Ti-Al-N en películas que disminuyen y las cualidades de cristalización de películas mejoran [ 19]. Para S4 y S5, las intensidades de pico reducidas y FWHM agrandado que pueden verificar altas tasas de flujo de gas (20-25 sccm) son adversas para las cualidades de las películas de Ti-Al-N.
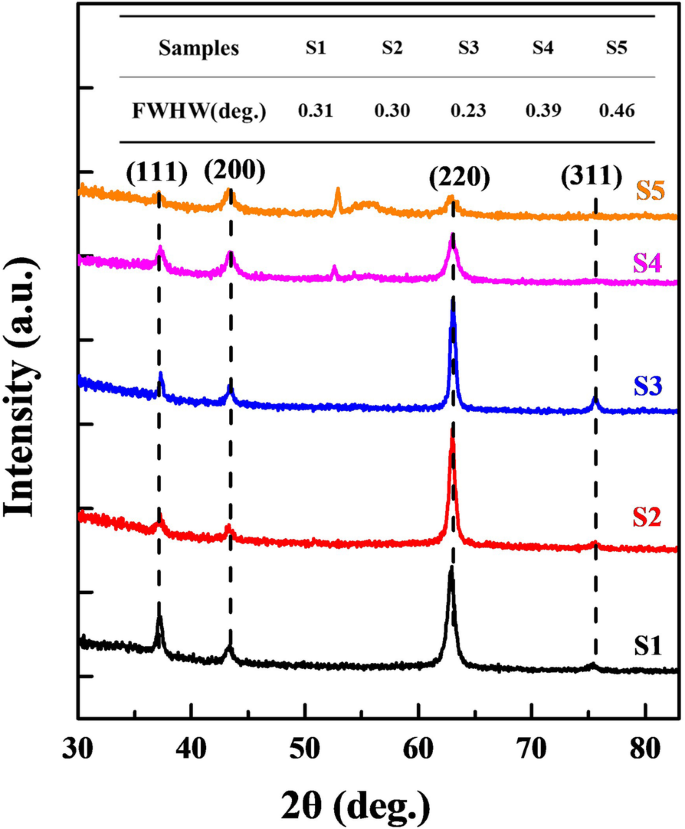
Espectros XRD de muestras S1 – S5. Insertar tabla es el valor FWHW de (220) para S1 – S5
La calidad del cristal de Ti-Al-N degenerado a altos índices de flujo de gas nitrógeno es el resultado de la variación del plasma de nitrógeno que se origina en RF-ICPIS. Se pueden ionizar más átomos de nitrógeno cuando se aumentan las velocidades de flujo de nitrógeno en la fuente de iones, y también se mejoran las densidades de plasma correspondientes en la cámara de pulverización catódica. Las concentraciones de electrones cerca de los sustratos se miden con la sonda de Langmuir. Los resultados calculados muestran que las concentraciones medias de electrones varían de 1,5 × 10 16 a 2,7 × 10 16 cm −3 con los caudales de gas nitrógeno aumentando de 5 a 25 sccm. Las concentraciones mejoradas de electrones indican que las densidades plasmáticas mejoran durante el progreso de la deposición. Además, los voltajes de la fuente de pulverización catódica con una corriente de pulverización catódica fija de 0,4 A durante la deposición son 482, 461, 443, 408 y 376 V para 5, 10, 15, 20 y 25 sccm respectivamente. La disminución de la impedancia entre los sustratos y el objetivo también refleja la atmósfera de plasma mejorada. La alta densidad del plasma mejora las colisiones entre los átomos que condujeron al camino libre medio de los átomos metálicos bombardeados y las tasas de deposición de la película disminuyen. Seguido, los átomos adsorbidos en los sustratos tienen más tiempo para migrar y nuclearse y contribuir a las cristalizaciones de la película. Cuando los caudales de nitrógeno superan un cierto umbral, aunque las densidades del plasma se mejoran aún más, no se ionizarían completamente más átomos de nitrógeno con una potencia de fuente de iones fija de 50 W [20]. En comparación con los átomos de nitrógeno completamente ionizados, esos átomos no completamente ionizados están más cerca del sustrato y participarían directamente en el crecimiento de la nucleación de las películas. Como resultado, el contenido de nitrógeno en las películas de Ti-Al-N está bastante más allá de la relación estequiométrica.
La Figura 3 muestra las micromorfologías planas y transversales de películas de Ti-Al-N observadas por FESEM. Las morfologías de la superficie Ti-Al-N exhiben los típicos granos cónicos tripartitos [21]. Comparando con las Fig. 3a, b, podemos encontrar que la película depositada a baja densidad de plasma de nitrógeno (S3) tiene tamaños de grano más pequeños y superficies más densas que S5 depositada a alta densidad de plasma, lo que también está de acuerdo con los resultados de XRD. En una atmósfera de baja densidad de plasma, los átomos de nitrógeno completamente ionizados y el tiempo de migración suficiente de los adatomos promueven el crecimiento y la cristalización de Ti-Al-N y contribuyen a la superficie más densa. También se estudian las microestructuras de la muestra comparativa CS3, que se deposita mediante el método tradicional de ionización del gas argón y tiene el mismo parámetro experimental que el S3 (ver material complementario). En comparación con S3, CS3 muestra una superficie plana más suelta y rugosa, y aparecen muchos vacíos entre los límites de los granos. Mientras tanto, el CS3 tiene el menor espesor de película que el S3. Las razones se atribuyen principalmente a las diferencias de atmósfera de deposición entre esos dos métodos de ionización de gas. Ionizando directamente el gas nitrógeno en RF-ICPIS, la temperatura de ionización del gas se puede reducir de manera eficiente y se puede obtener plasma de nitrógeno de alta densidad. En consecuencia, los adatomos sobre sustratos tendrían una alta energía de migración y serían beneficiosos para el crecimiento y cristalización de las películas de Ti-Al-N. En las imágenes transversales de FESEM, se observan claramente estructuras columnares para películas de Ti-Al-N depositadas a 15 y 25 sccm, y las películas revelan un espesor de 1,002 y 1,561 μm, respectivamente. En circunstancias de alta densidad de plasma, la tasa de deposición de la película aumenta en un 50%. Los resultados son diferentes de la dispersión de átomos mejorada inducida por una baja tasa de deposición y surgen principalmente del rápido crecimiento de nitruro débilmente enlazado asociado con esos átomos de nitrógeno no completamente ionizados. Mientras tanto, las estructuras columnares de S3 exhiben nanoestructuras granuladas y más densas, y la muestra de S5 revela las estructuras columnares con huecos y límites a lo largo de la película. Es además evidente que la alta densidad del plasma de nitrógeno es adversa a las cualidades de cristalización de las películas de Ti-Al-N.
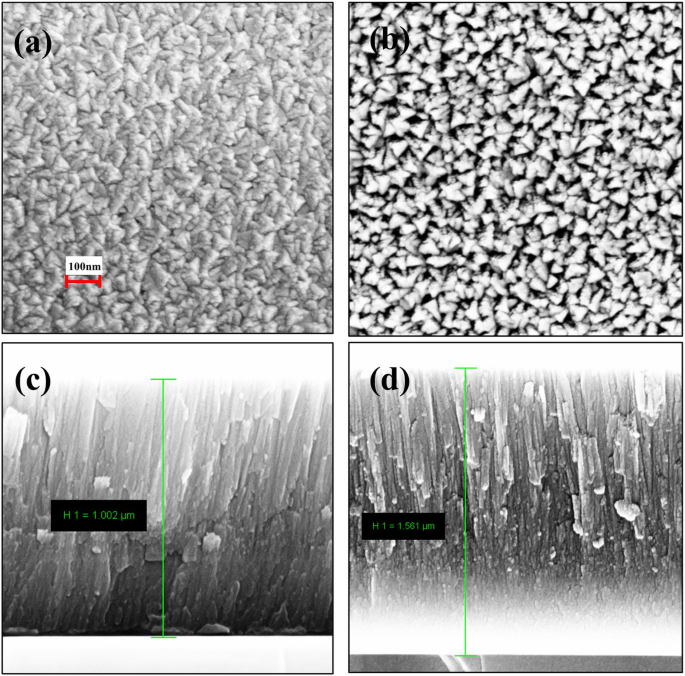
Imágenes FESEM planas y transversales de S3 ( a , c ; 15 sccm) y S5 ( b , d ; 25 sccm)
Además, AFM estudia la rugosidad de las películas de Ti-Al-N depositadas a varios caudales de gas nitrógeno, y los valores de rugosidad de la raíz cuadrada media (RMS) se representan en la Fig. 4. La rugosidad se reduce primero y luego se aumenta. con el aumento de los caudales de gas nitrógeno, y el valor mínimo de 3.932 nm se obtiene a 15 sccm. Mientras tanto, como se muestra en la Fig. 4c, podemos encontrar la superficie de la película de la muestra S5 que está llena de partículas hinchadas y el barranco entre partículas que son bastante profundas. Las superficies más rugosas de S5 se pueden atribuir a las malas cualidades del cristal y las superficies escasas. En la estructura cristalina de Ti-Al-N, la relación Al / Ti también es un factor importante de que los átomos de Al ocupan sitios de red de los átomos de Ti e introduce defectos de red para influir en la microestructura y las propiedades mecánicas [18, 22]. Las relaciones Al / Ti calculadas basadas en pruebas EDS son 1,66, 1,54, 1,43, 1,60 y 1,85 para S1 – S5, respectivamente. La excelente calidad del cristal y la baja relación Al / Ti contribuyen a la superficie más lisa de la muestra de Ti-Al-N depositada a 1 sccm. Las altas relaciones Al / Ti agravan los defectos de la estructura de distorsión de la red en las películas S5 y exacerban la rugosidad de la superficie.

un Valores de rugosidad RMS de películas de Ti – Al – N en función de los caudales de gas nitrógeno. Insertar tabla son los valores de las raciones de Al / Ti; b y c son las imágenes AFM de las muestras S3 y S5, respectivamente
La dureza de las películas de Ti-Al-N depositadas sobre sustratos de acero inoxidable bajo diferentes velocidades de flujo de gas nitrógeno se muestra en la Fig. 5. La dureza de las películas de Ti-Al-N obtenidas a 5, 10, 15, 20 y 25 sccm son 33,1, 33,3, 34,6, 29,1 y 26,4 GPa, respectivamente. En el rango de flujo de nitrógeno bajo, la dureza de las películas de Ti-Al-N es bastante más alta que la del material tradicional de Ti-N. La dureza mejorada de Ti-Al-N se origina principalmente a partir de la evolución de la microestructura a través de la introducción de contenidos de Al, que los átomos de Al que ocupan parte de los sitios de la red de los átomos de Ti provocan la derrota de la red y aumentan la tensión interna de las películas. Además, las relaciones Al / Ti de las muestras S1-S5 son más altas que las de los materiales Ti-Al-N fabricados con un sistema de pulverización catódica convencional, ya que la técnica RF-ICPIS puede reducir la temperatura de ionización del gas y aumentar la tasa de ionización durante la reacción de pulverización catódica, también convertir el rendimiento de pulverización catódica de partículas metálicas [23]. Las altas relaciones Al / Ti que inducen la distorsión de la red también causan la resistencia al movimiento de dislocación y el movimiento de deslizamiento difícil, que pueden contribuir conjuntamente al excelente rendimiento de dureza de las películas de Ti-Al-N depositadas a tasas de flujo de nitrógeno bajas. Mientras tanto, la cristalización optimizada y los tamaños de grano reducidos promueven aún más la dureza hasta el máximo de 34,6 GPa a 15 sccm.

Dureza de las películas de Ti-Al-N depositadas a diferentes velocidades de flujo de gas nitrógeno
Las propiedades de fricción de las películas de Ti-Al-N también se estudian mediante el aparato de desgaste de bola sobre disco, y el coeficiente de fricción medio de las películas de Ti-Al-N se representa en la Fig. 6. La variación de los coeficientes de fricción según el gas nitrógeno Los caudales son similares a la rugosidad RMS. Obviamente, las superficies lisas y las nanoestructuras densas en sección transversal de las películas de Ti-Al-N depositadas a velocidades de flujo de gas nitrógeno bajas son beneficiosas para el rendimiento tribológico de la superficie. Mientras tanto, el S1-S3 muestra un coeficiente de fricción medio más pequeño que el CS3 (ver material complementario).

Coeficiente de fricción medio de películas de Ti-Al-N depositadas a diferentes velocidades de flujo de gas nitrógeno. Los insertos son la curva del coeficiente de fricción de S3 y S5, respectivamente
Conclusión
En resumen, se estudian la microestructura y las propiedades mecánicas de las películas de Ti-Al-N depositadas en diferentes atmósferas de plasma de nitrógeno. Se encuentra que el contenido de elementos en las películas de Ti-Al-N está bastante influenciado por la densidad del plasma de nitrógeno. La baja densidad de plasma es beneficiosa para las cualidades de cristalización de la película y la microestructura, que está respaldada por los espectros XRD y FESEM. Además, la rugosidad de la superficie y las propiedades mecánicas como la dureza y el coeficiente de fricción se pueden optimizar aún más en el rango de densidad de plasma apropiado. A alta densidad de plasma, el contenido excesivo de nitrógeno en las películas puede inducir una fase de nitruro metaestable y ser responsable de la microestructura suelta y el rendimiento mecánico agravado. Nuestros resultados serían una forma eficiente de comprender mejor el mecanismo de crecimiento relacionado con la atmósfera de deposición de las películas de Ti-Al-N.
Disponibilidad de datos y materiales
Todos los datos están completamente disponibles sin restricciones.
Abreviaturas
- RF-ICPIS:
-
Fuente de iones de plasma acoplada inductivamente por radiofrecuencia
- DC:
-
Corriente continua
- EDS:
-
Espectrómetro de dispersión de energía
- XRD:
-
Difracción de rayos X
- FESEM:
-
Microscopía electrónica de barrido por emisión de campo
- AFM:
-
Microscopía de fuerza atómica
- FWHM:
-
Ancho completo a la mitad del máximo
- RMS:
-
Raíz cuadrada media
Nanomateriales
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Influencia del agua en la estructura y propiedades dieléctricas de la microcristalina y nanocelulosa
- Efectos del espesor de la bicapa en las propiedades morfológicas, ópticas y eléctricas de los nanolaminados de Al2O3 / ZnO
- Ajuste de las morfologías de la superficie y las propiedades de las películas de ZnO mediante el diseño de la capa interfacial
- Efecto sinérgico del grafeno y los MWCNT en la microestructura y las propiedades mecánicas de los nanocompuestos de Cu / Ti3SiC2 / C
- Síntesis fácil de óxido de estaño mesoporoso similar a un agujero de gusano a través del autoensamblaje inducido por evaporación y las propiedades mejoradas de detección de gas
- Estudio de la fuerza de adhesión y la transición vítrea de películas delgadas de poliestireno mediante microscopía de fuerza atómica
- Preparación y propiedades ópticas de las películas GeBi mediante el método de epitaxia de haz molecular
- Prueba de las propiedades estructurales, electrónicas y magnéticas de Ag n V (n =1–12) Clusters
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- Estudio comparativo de las propiedades electroquímicas, biomédicas y térmicas de nanomateriales naturales y sintéticos



