Fabricación de microdiscos GeSn de alta calidad y relajados a la tensión mediante la integración de crecimiento epitaxial selectivo y métodos selectivos de grabado en húmedo
Resumen
GeSn es un material prometedor para la fabricación de dispositivos fotónicos y nanoelectrónicos en chip. Por tanto, se han desarrollado técnicas de procesamiento dedicadas a GeSn, que incluyen epitaxia, recocido, implantación de iones y grabado. En este trabajo, los microdiscos GeSn suspendidos, relajados por tensión y de alta calidad se realizan mediante un nuevo enfoque sin ningún grabado en la aleación GeSn. La aleación GeSn se cultivó sobre un sustrato Ge (001) con patrón previo mediante epitaxia de haz molecular a bajas temperaturas. La microscopía electrónica de transmisión y la microscopía electrónica de barrido se llevaron a cabo para determinar las microestructuras de las muestras de GeSn. Los microdiscos con diferentes diámetros de pedestales Ge se fabricaron controlando el tiempo de grabado en húmedo selectivo, y los resultados de micro-Raman muestran que los microdiscos con diferentes dimensiones de los pedestales Ge restantes tienen diferentes grados de relajación de deformación. La tensión de compresión de los microdiscos se relaja casi por completo en las condiciones adecuadas. La tecnología de procesamiento de semiconductores presentada en este trabajo puede ser un método alternativo para fabricar micro / nanoestructuras innovadoras basadas en GeSn y otros materiales para una gama de fotónica, MOSFET 3D y aplicaciones de dispositivos microelectromecánicos compatibles con Si.
Introducción
Germanio-estaño (GeSn), un material del grupo IV compatible con semiconductores de óxido de metal complementario (CMOS), ha atraído una atención significativa en los últimos años por sus aplicaciones en electrónica y optoelectrónica. La asignación de más Sn en Ge puede mejorar la movilidad de la portadora, así como cambiar la banda prohibida de transición indirecta a directa [1, 2]. El trabajo teórico [3, 4, 5] y los estudios experimentales basados en fotoluminiscencia [6, 7, 8] muestran que la transición indirecta a directa para la aleación de GeSn relajada se produce con un contenido de Sn no inferior al 6,5%. Sin embargo, la baja solubilidad en equilibrio (1%) de Sn en Ge [9, 10] y el gran desajuste de la red (~ 15%) entre Ge y α-Sn presentan enormes desafíos para la realización de una aleación de GeSn libre de defectos con incluso un pocos% atómico de Sn sustitutivo. El uso de técnicas de crecimiento fuera del equilibrio, como la epitaxia de haz molecular a baja temperatura (MBE) [11,12,13,14,15], la deposición química de vapor (CVD) [16,17,18,19,20], y La epitaxia en fase sólida [21, 22] es muy necesaria.
En el caso de la aleación GeSn cultivada sobre un sustrato virtual Ge relajado por deformación o un sustrato Ge, se espera que se logre la más alta calidad de GeSn en la condición pseudomórfica o completamente deformada, lo que puede evitar la formación de desajustes y dislocaciones de roscado. Sin embargo, dicha aleación de GeSn se deforma por compresión (~ 0,15% por 1% de Sn) y esta deformación inducida por epitaxia niega el efecto de la aleación de Sn con Ge para la conversión de banda prohibida. Como resultado, se requiere un contenido mucho mayor de Sn del 17% para la capa epitaxica pseudomórfica de GeSn en Ge (001) [23] para lograr la banda prohibida directa, lo que genera desafíos extremadamente altos para la epitaxia y la baja calidad del material. Por lo tanto, la manipulación de la cepa sin sacrificar la calidad del cristal de las epi-capas GeSn se convierte en un tema muy importante. La eliminación selectiva del sustrato virtual de Ge inductor de estrés o del sustrato de Ge debajo de las epi-capas de GeSn para formar microestructuras parcialmente suspendidas es una técnica prometedora para superar la tensión de compresión en las películas de GeSn. Por ejemplo, se fabricaron microdiscos GeSn suspendidos con un pilar de soporte en el centro [24,25,26,27,28]. La estructura no solo puede relajar la tensión de compresión en la capa de GeSn a través de la deformación elástica en las superficies libres, sino que también puede confinar los modelos ópticos cerca del borde del microdisco debido al fuerte contraste del índice de refracción entre el GeSn y el medio circundante (aire), como susurros. -modo-galería [16, 25]. Hasta ahora, solo se ha informado de un método para preparar microdiscos GeSn a través de la litografía óptica posterior al crecimiento y el grabado de arriba hacia abajo de la película GeSn bidimensional [16, 24, 29, 30]. Sin embargo, el proceso puede sufrir efectos de desajuste térmico durante el proceso de grabado posterior al crecimiento, lo que conducirá a una calidad de material degradada de los microdiscos GeSn. Recientemente, P. Ponath et al. informó el crecimiento de área selectiva de c altamente cristalino -BTO orientado al eje [31], que nos inspiró para la fabricación de microestructuras GeSn. Al depositar directamente microdiscos GeSn en el último paso sobre un SiO 2 con patrón previo / Ge y luego grabar selectivamente el sustrato Ge siguiendo el SiO 2 de sacrificio Eliminación de capas, los microdiscos GeSn suspendidos se pueden fabricar sin el proceso convencional y complejo de grabado posterior al crecimiento. Un método de este tipo, si es factible, puede evitar los problemas antes mencionados y así obtener una microestructura de GeSn de mayor calidad y relajada por deformación. Además, también es un método muy prometedor que puede lograr patrones arbitrarios con alta precisión y una buena relación de aspecto, especialmente para la integración tridimensional de estructuras de dispositivos complejas que necesitan un control exacto del espesor de las capas.
En este artículo, las estructuras de microdiscos GeSn se fabricaron con éxito mediante un nuevo método. Es la primera vez que se preparan microdiscos GeSn combinando el crecimiento epitaxial selectivo con un simple paso de grabado en húmedo selectivo. El espesor, la concentración de Sn y la calidad del cristal de la epi-capa GeSn se caracterizaron mediante microscopía electrónica de transmisión de alta resolución (HRTEM) y espectrometría de masas de iones secundarios (SIMS). Se utilizaron microscopía electrónica de barrido (SEM) y espectroscopía micro-Raman (μ-Raman) para obtener información sobre las microestructuras de los microdiscos GeSn fabricados. Los resultados de μ-Raman a temperatura ambiente (RT) muestran que los microdiscos con diferentes dimensiones de los pedestales de Ge restantes tienen diferentes grados de relajación de la deformación. La tensión de compresión de los microdiscos se relaja casi por completo en las condiciones adecuadas. Este método para fabricar microdiscos sin la necesidad de grabar el propio GeSn es beneficioso para obtener nanoestructuras de GeSn y otros materiales relajados y de alta calidad.
Métodos
Materiales
Las obleas Ge se compraron a la empresa AXT. Sinopharm Chemical Reagent (China) suministró acetona, alcohol isopropílico, ácido fluorhídrico, alcohol etílico, peróxido de hidrógeno, amoníaco acuoso e hidróxido de potasio. H 2 desionizado Se obtuvo O (18,2 MΩ · cm) a partir de un sistema de ultrafiltración (Milli-Q, Millipore, Marlborough, MA).
Preparación del sustrato de Ge modelado
Las obleas de Ge (001) (tipo n, 0.025–0.031 Ωcm) se sumergieron primero en acetona y alcohol isopropílico durante 3 minutos y luego se limpiaron químicamente con una solución diluida de ácido fluorhídrico (HF:H 2 O =1:20) durante 20 sa TA. Esto fue seguido por un enjuague con H 2 desionizado O (DI – H 2 O). El procedimiento de limpieza es de importancia, especialmente el tratamiento de HF para despegar la capa de óxido nativo y para asegurar que la superficie de Ge esté limpia y en estrecho contacto con el siguiente SiO 2 capa. En este caso, el perfil de despegue se logra mediante la deposición de un Si / SiO 2 capa compuesta. Luego, las obleas se secaron soplando N 2 seco y se cargó rápidamente en la cámara de ultra alto vacío (UHV) de deposición química en fase de vapor mejorada con plasma (PECVD) y se recoció a 300 ° C durante 20 minutos para eliminar el gas por completo. Luego, un SiO 2 de 300 nm La capa se depositó a la misma temperatura mediante PECVD seguido de una deposición de Si policristalino sin dopar a 50 nm mediante pulverización catódica con magnetrón a temperatura ambiente, como se muestra en la Fig. 1a. Aberturas circulares en el Si / SiO 2 La capa compuesta se modela utilizando una técnica de fotolitografía estándar (Fig. 1b) y procesos de grabado en dos pasos (Fig. 1c, d).
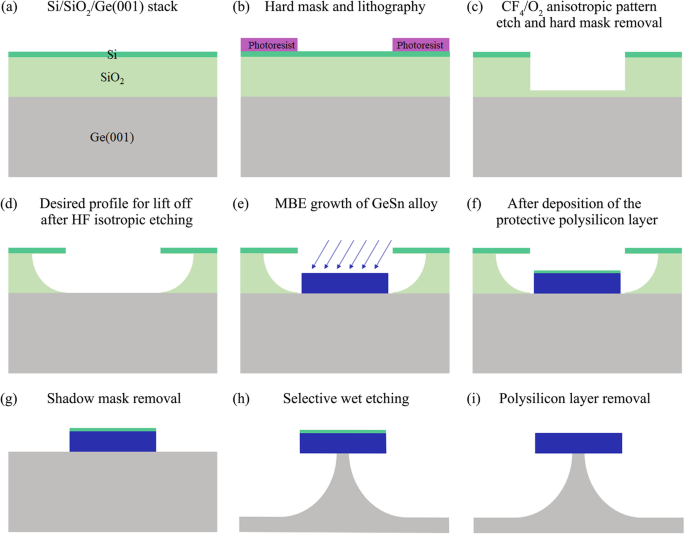
La ilustración esquemática en sección transversal para la fabricación de los microdiscos GeSn suspendidos
En detalle, antes de modelar el Si / SiO 2 / Ge oblea, la oblea se limpió con acetona, alcohol etílico y DI-H 2 O, luego secar con secador con N 2 y precocido en horno a 90 ° C. Posteriormente, se revistió por centrifugación mediante fotorresistente AZ5214 usando un revestidor por centrifugación a una velocidad de 4000 r / min durante 30 sy luego se colocó en una placa calefactora para horneado suave a 90 ° C durante 2 min. La máquina para fabricar placas (Heidelberg, uPG501) se utilizó luego para crear matrices de patrones en forma de círculo en el Si / SiO 2 / Ge pilas. Los patrones circulares se fijan a 5 μm de distancia entre sí, mientras que el diámetro varía de 3 a 5 μm. Luego, los patrones se transfirieron al SiO 2 inferior capa por grabado en dos pasos. El grabado en seco anisotrópico mediante grabado de iones reactivos con una mezcla de gas de CF 4 y O 2 se utilizó por primera vez para grabar Si / SiO 2 capas y se detuvo con aproximadamente 20 nm SiO 2 izquierda. Luego se contrató la disolución del fotorresistente y el grabado en húmedo con HF diluido a temperatura ambiente para eliminar el SiO 2 izquierdo. capa para exponer el germanio en las aberturas circulares y también para grabar lateralmente debajo del borde definido de polisilicio para crear un voladizo que es el perfil deseado para el despegue.
Crecimiento de GeSn y fabricación de microdiscos
Para la deposición de película delgada GeSn, un sistema MBE de fuente sólida (Riber SSC) con una presión base de 2 × 10 −10 Se utilizó Torr [32]. Un evaporador de haz de electrones y una celda de efusión pirolítica de BN que utilizan fuentes sólidas de alta pureza están equipados para la evaporación de Ge y Sn en el sistema MBE. Se utilizó un monitor de cristal de cuarzo para calibrar la tasa de deposición. Antes de cargar los sustratos estampados en el sistema UHV, los sustratos se limpiaron con O 2 plasma para eliminar cualquier residuo orgánico inducido por el grabado en seco. Seguido de enjuague con acetona, alcohol isopropílico y HF diluido, los sustratos se transfirieron a la cámara de MBE para el crecimiento de GeSn. Después de la desorción térmica a 450 ° C durante 15 min, los sustratos se enfriaron in situ a 150 ° C para el crecimiento de la capa de aleación GeSn con una tasa de crecimiento de Ge de 0,5 Å s −1 y un flujo de Sn controlado como fuente de dopante. Esta temperatura de crecimiento es lo suficientemente baja como para restringir eficazmente la segregación de la superficie de Sn. Para evitar la oxidación, finalmente se depositó una capa de Ge de 10 nm a la misma temperatura.
Después del crecimiento, las aleaciones GeSn con una concentración nominal de Sn del 4% y el 10% se utilizarán para la fabricación de microdiscos. A continuación, se depositó una capa adicional de polisilicio de 30 nm de espesor en la parte superior de las muestras a temperatura ambiente utilizando pulverización catódica con magnetrón para proteger la capa de GeSn del siguiente ataque. Luego, el SiO 2 de sacrificio La capa se eliminó utilizando HF diluido (1:1), lo que también conduce a la eliminación de la capa de polisilicio superpuesta y la película de GeSn depositada sobre ella. Como se puede ver en la Fig.2, se revelaron mesas GeSn circulares aisladas después del SiO 2 se eliminó la capa. Sin embargo, la periferia de la mesa circular no es tan suave, lo que es malo para los efectos de confinamiento óptico. La situación inesperada es causada por la deposición de GeSn en el borde del SiO 2 inferior capa que surge del insuficiente grabado lateral del SiO 2 inferior y la deposición de ángulo anormal (30 °). Posteriormente, un simple paso de grabado en húmedo selectivo socava las mesas circulares en RT, lo que resulta en estructuras de microdiscos GeSn suspendidas. El grabador selectivo (APM) se compone de H 2 O 2 (31% en peso), NH 4 OH (28% en peso) y DI-H 2 O con una relación de volumen de 2:0,5:80 [30]. Finalmente, la capa protectora superior de polisilicio se eliminó con KOH. En la Fig. 1e – i se muestra un esquema de los pasos del proceso.
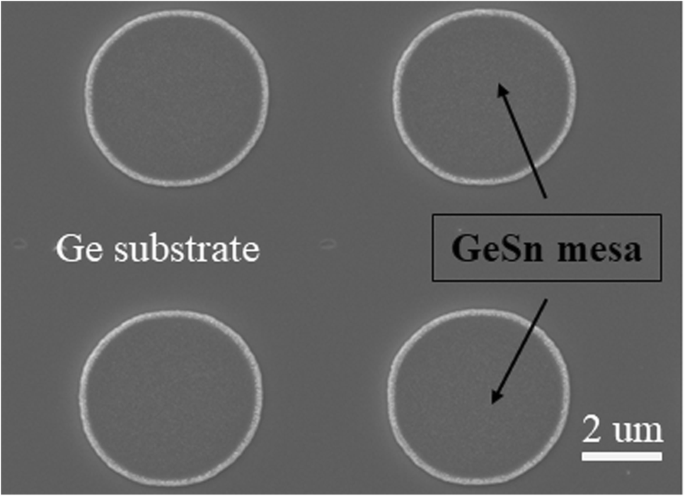
Imagen SEM de vista superior de mesas circulares GeSn de 5 μm de diámetro aisladas después de la eliminación de la máscara de sombra
En nuestro método para fabricar microdiscos GeSn, el grabado húmedo selectivo final es importante debido a las diferentes velocidades de grabado para los materiales GeSn con diferentes concentraciones de Sn. La selectividad de grabado de Ge sobre Ge 1 − x Sn x también variará con la concentración de Sn. Cuanto mayor sea la concentración de Sn en GeSn, mayor será la cobertura de superficie de SnO y se desarrollará [33]. Reducirá la tasa de grabado en húmedo de GeSn y dará lugar a una mayor selectividad de grabado de Ge sobre GeSn. El estudio anterior informó que el H 2 O 2 grabado en húmedo a base de agua (H 2 O 2 :NH 4 OH:H 2 O =2:0.5:80), lo mismo con este trabajo, logra una selectividad de grabado de Ge sobre Ge 0.928 Sn 0.072 de 9:1 [30].
Resultados y discusión
La Figura 3a muestra la micrografía TEM en sección transversal de la mesa circular GeSn de 5 μm de diámetro sin la capa superior de polisilicio. Las figuras 3b, c son las micrografías de TEM de alta resolución (HRTEM) para las regiones A y B, correspondientes a la interfaz GeSn / Ge y la región media de la capa GeSn, respectivamente. El grosor de la película de la capa GeSn es de aproximadamente 250 nm (Fig. 3a) por debajo del grosor de la máscara de sombra. Como puede verse en la Fig. 3b, los defectos se localizan principalmente en la interfaz GeSn / Ge de 30 nm de espesor, lo que da como resultado el siguiente crecimiento de GeSn monocristalino. La imagen HRTEM de la región B muestra franjas reticulares claras de la capa GeSn, lo que indica que la aleación es altamente cristalina y el patrón de transformación rápida de Fourier (FFT) de la región B coincide con el patrón de difracción de GeSn como se muestra en la Fig. 3c. Además, para confirmar la concentración de Sn de la aleación GeSn, se completó la medición SIMS como se muestra en el recuadro de la Figura 3a. La concentración de Sn es del 9,8 ± 0,5%, de acuerdo con el valor nominal de aproximadamente el 10%. Aparte de eso, la distribución de los átomos de Sn es muy uniforme en el perfil de profundidad de la película de GeSn recién desarrollada.
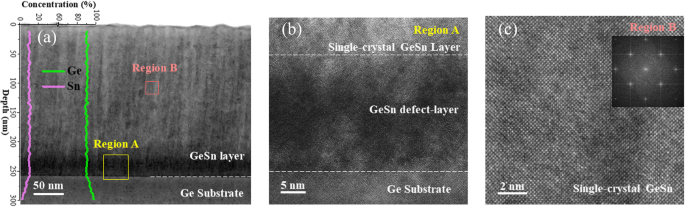
un Imagen TEM de sección transversal de la mesa circular GeSn de 5 μm de diámetro sin capa superior de polisilicio. Recuadro:perfil de profundidad SIMS de la capa GeSn. b Imagen TEM de alta resolución de la interfaz GeSn / Ge (región A). c Imagen TEM de alta resolución para la región media de la capa GeSn (región B). Recuadro:patrón FFT de la región B
La estructura superficial de las muestras fue estudiada por SEM. La figura 4a muestra la imagen SEM de la vista superior del diámetro Ge 0.96 de 5 μm Sn 0.04 mesas circulares después de 510 s de grabado húmedo selectivo por solución APM a temperatura ambiente. Cabe mencionar que los agentes decapantes se preparan justo antes de los experimentos para evitar los efectos del envejecimiento químico. La imagen SEM indica que no solo el sustrato de Ge sino también una parte de la mesa GeSn están grabados. La falla al formar una estructura de disco para Ge 0.96 Sn 0.04 La aleación se debe a la baja concentración de Sn que da como resultado la baja selectividad de grabado de Ge sobre GeSn. En contraste con Ge 0.96 Sn 0.04 muestras, la muestra de mesa circular GeSn de 5 μm de diámetro con una concentración superior de Sn del 9,8% también se grabó con APM a temperatura ambiente. Como se muestra en la Fig. 4b, c. c, las estructuras de microdiscos se formaron con éxito para Ge 0.902 Sn 0.098 aleación después de 510 s de grabado en húmedo. Anteriormente, Han et al. [30] informó que fabricaron Ge 0.928 parcialmente suspendido Sn 0.072 microdiscos (de 5 μm de dimensión) con una muesca de aproximadamente 1,2 μm utilizando el H 2 O 2 grabado en húmedo a base de agua con una selectividad de 7:1. Sin embargo, después del grabado en húmedo selectivo, los bordes de su disco se doblan y fracturan debido a las fuertes fuerzas capilares atractivas que se desarrollan entre la estructura suspendida y el sustrato a medida que se elimina el líquido grabador, lo que hace que la estructura del microdiscos liberada entre en contacto con el sustrato [ 24]. Pero este fenómeno no ocurre en nuestros experimentos ni siquiera prolongando el grabado selectivo para eliminar casi por completo el pedestal de Ge debajo. Podría explicarse por la mayor selectividad de grabado y la capa de GeSn más gruesa de aproximadamente 250 nm. Curiosamente, los pedestales muestran facetas inesperadas con diferentes orientaciones que pueden ser causadas por la velocidad de grabado lateral dependiente de la orientación durante el proceso de grabado en húmedo selectivo.
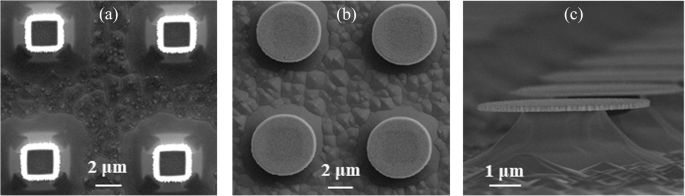
Imágenes SEM después de un grabado húmedo selectivo. un 5 μm de diámetro Ge 0,96 Sn 0.04 mesas circulares después de 510 s de grabado. b , c 5 μm de diámetro Ge 0.902 Sn 0.098 mesas circulares después de 510 s de grabado
Además, los microdiscos con pedestales de Ge de diferentes diámetros se fabricaron controlando el tiempo de grabado selectivo. La Figura 5a muestra el diámetro del pedestal de Ge restante en función del tiempo de grabado en APM. Las barras de error representan la desviación estándar de los datos de cinco microdiscos diferentes en la misma muestra. La tendencia de línea similar indica que la tasa de grabado de Ge es aproximadamente igual para Ge 0.902 Sn 0.098 discos con diferentes diámetros de 3 μm y 5 μm, y está de acuerdo con el valor de la tasa de grabado de la Ref. [30]. Además, el diámetro mínimo del pedestal de Ge para el microdisco GeSn de pie es de unos 300 nm. Los microdiscos GeSn suspendidos serán derribados por las fuertes fuerzas capilares de atracción si los pedestales Ge se vuelven más pequeños.
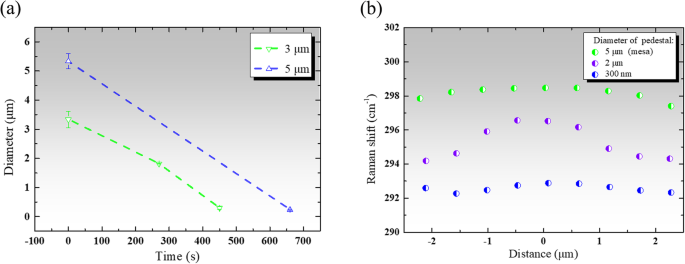
un El diámetro del pedestal Ge en función del tiempo de grabado en húmedo selectivo para diámetros de 3 μm (línea discontinua verde) y 5 μm (línea discontinua azul) Ge 0.902 Sn 0.098 discos. b Mediciones de escaneo de línea de desplazamiento Raman realizadas a lo largo del diámetro de 5 μm Ge 0.902 Sn 0.098 mesa (punto verde) y microdiscos con pedestal Ge (punto morado) de 2 μm de diámetro y pedestal Ge (punto azul) de 300 nm de diámetro
Para investigar la distribución de deformación elástica de los microdiscos GeSn, se realizó μ-Raman a temperatura ambiente en discos de 5 μm de diámetro, utilizando un láser de 633 nm para excitación con un tamaño de punto de aproximadamente 600 nm. La potencia del láser es sólo el 1% de la potencia máxima (15 mw) para minimizar los efectos térmicos [34], y la profundidad de penetración del láser de excitación en las películas GeSn es de aproximadamente 50 nm [26]. El cambio Raman se midió ajustando los espectros con funciones de Lorentz.
La Figura 5b muestra los escaneos de línea Raman unidimensionales para Ge 0.902 Sn 0.098 microestructuras. Se observa claramente (1) para la mesa de 5 μm de diámetro sin socavación, el pico Raman asociado con el modo de fonón Ge-Ge LO se desplaza de manera no obvia hacia números de onda más bajos desde el centro hasta el borde de la mesa, y el gran cambio Raman indica que hay una gran tensión compresiva en la mesa GeSn; (2) para el microdisco de 5 μm de diámetro con pedestal de Ge de 2 μm de diámetro, el pico Raman asociado con el modo de fonón Ge-Ge LO se desplaza obviamente hacia números de onda más bajos desde el centro hasta el borde del disco, revelando un gradiente de deformación debido al anclaje al pedestal de Ge comparativamente grande. Y el microdisco GeSn de 5 µm con pedestal de 2 µm de diámetro todavía mantiene en su periferia una cierta cantidad de tensión compresiva; (3) las posiciones de los picos Ge-Ge medidas a lo largo del diámetro del Ge 0.902 de 5 μm Sn 0.098 Los microdiscos con pedestal Ge de 300 nm de diámetro permanecen consistentes y tienen un desplazamiento Raman reducido obviamente. Por lo tanto, se espera que los discos con pedestales de Ge estrechos (de aproximadamente 300 nm de diámetro) estén completamente relajados.
En la Fig. 6, presentamos el espectro de dispersión Raman típico de 5 μm de diámetro Ge 0.902 Sn 0.098 microdisco con pedestal Ge de 300 nm de diámetro. Para los discos, los espectros Raman muestran un pico asimétrico a una frecuencia de 292,4 cm −1 correspondiente al modo Ge-Ge LO. Los espectros Raman registrados para la mesa de 5 µm de diámetro y el sustrato de Ge (001) a granel de referencia también se representan para comparación. Tenga en cuenta que después de socavar, elimine el cambio Raman (- 6,3 cm −1 ) del pico Ge-Ge se puede observar para microdiscos de Sn al 9,8%, ya que el cambio de frecuencia Raman en las aleaciones de semiconductores está influenciado principalmente por la deformación y la composición. Estudios Raman anteriores [33, 35,36,37] han demostrado que el cambio Raman del modo fonón Ge-Ge LO en GeSn se puede expresar como una función de la concentración de Sn x Sn y la deformación biaxial en el plano ε ∥ siguiendo la Ec. (1):

Comparación de los espectros Raman de 5 μm Ge 0.902 Sn 0.098 microdisco con pedestal Ge de 300 nm de diámetro, Ge 0.902 de 5 μm Sn 0.098 mesa de diámetro y un sustrato de Ge a granel como referencia. Recuadro:vista ampliada de los espectros Raman. Los picos de Ge-Sn también se pueden observar alrededor de 260 cm −1 y cambio hacia abajo con la disminución del diámetro de los pedestales Ge
$$ \ Delta \ omega ={\ omega} _ {\ mathrm {Ge} \ mathrm {Sn}} - {\ omega} _ {\ mathrm {Ge}} =\ mathrm {A} \ cdotp {x} _ { \ mathrm {Sn}} + \ mathrm {B} \ cdotp {\ varepsilon} _ {\ paralelo} $$ (1)donde ω GeSn y ω Ge son la posición máxima del modo de fonón Ge-Ge LO en GeSn y en Ge a granel, respectivamente, mientras que A y B son coeficientes.
Los picos Ge-Ge LO Raman para la mesa y los discos muestran el desplazamiento de - 1,4 cm −1 y - 7,7 cm −1 en comparación con el pico de Ge a granel (300,1 cm −1 ). Tomando los coeficientes de resultados experimentales previos [37], el valor de la tinción biaxial en el plano ε ∥ se calcula que es - 1,18% para la mesa GeSn recién desarrollada. Para los microdiscos fabricados, la tinción biaxial en el plano ε ∥ es aproximadamente igual a 0, lo que confirma la relajación de deformación casi completa de los microdiscos. Según el cálculo teórico reciente de Ge 1- x Sn x estructura de banda electrónica [38], la Ge 0.902 tal como creció Sn 0.098 La capa es un material de banda prohibida indirecta con una energía de banda prohibida de aproximadamente 0,56 eV, mientras que la Ge 0.902 completamente relajada Sn 0.098 microdisk es un material de banda prohibida directa con una energía de banda prohibida de 0,50 eV.
Conclusiones
En conclusión, los microdiscos GeSn se fabricaron con éxito combinando el crecimiento epitaxial selectivo con el proceso de grabado en húmedo selectivo. Se realizaron HRTEM y SEM para confirmar que la aleación GeSn es altamente cristalina y que la estructura del microdiscos GeSn se forma fácilmente mediante un simple grabado selectivo en húmedo. Las mediciones de μ-Raman revelan que la relajación de la deformación del microdisco GeSn será mayor al disminuir el diámetro del pedestal Ge debido a la restricción mecánica simultáneamente decreciente del pedestal Ge más pequeño. Y finalmente, los microdiscos GeSn de alta calidad y relajación total de la tensión se lograron mediante este método más rentable. El proceso de fabricación también es un método muy prometedor para lograr un tamaño de mesa de GeSn más pequeño hasta que el efecto de tamaño cuántico lateral se vuelva importante, y para obtener otras nanoestructuras de GeSn, como puntos cuánticos de GeSn, nanomechas de GeSn y nanocables de GeSn para futuros fotónicos y electrónicos compatibles con Si. aplicaciones del dispositivo.
Disponibilidad de datos y materiales
Los datos que respaldan los hallazgos de este trabajo están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- APM:
-
Mezcla de peróxido de amoníaco (grabador húmedo)
- FFT:
-
Transformación rápida de Fourier
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- MBE:
-
Epitaxia de haz molecular
- PECVD:
-
Deposición de vapor químico mejorada con plasma
- RT:
-
Temperatura ambiente
- SEM:
-
Microscopía electrónica de barrido
- SIMS:
-
Espectrometría de masas de iones secundarios
- μ-Raman:
-
Espectroscopía Micro-Raman
Nanomateriales
- Clase abstracta de Java y métodos abstractos
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Fabricación de películas delgadas de SrGe2 en sustratos Ge (100), (110) y (111)
- Fabricación, caracterización y actividad biológica de sistemas de nanoportación de avermectina con diferentes tamaños de partículas
- Avances recientes en métodos sintéticos y aplicaciones de nanoestructuras de plata
- Fabricación y caracterización de nanoclips de ZnO mediante el proceso mediado por poliol
- Fabricación de nanofibras helicoidales CA / TPU y análisis de su mecanismo
- Fabricación y propiedad fotocatalítica de nuevos nanocompuestos SrTiO3 / Bi5O7I
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente
- Fabricación controlable de matrices de nanopartículas coloidales no compactas mediante grabado con haz de iones
- Grabado láser y grabado láser



