Crecimiento y grabado selectivo de estructuras de múltiples capas de silicio / silicio-germanio dopado con fósforo para transistores verticales Aplicación
Resumen
Los transistores de efecto de campo de puerta vertical todo alrededor (vGAAFET) se consideran los candidatos potenciales para reemplazar los FinFET para la tecnología avanzada de fabricación de circuitos integrados en / más allá del nodo de tecnología de 3 nm. Una multicapa (ML) de Si / SiGe / Si se cultiva y procesa comúnmente para formar transistores verticales. En este trabajo, se ha estudiado la incorporación de P en Si / SiGe / Si y el grabado vertical de estos ML seguido de un grabado selectivo de SiGe en dirección lateral para formar estructuras para vGAAFET. Se propusieron varias estrategias para la epitaxia, como la purga de hidrógeno para agotar el acceso de átomos de P en la superficie de Si, y / o insertar un Si o Si 0.93 Ge 0.07 espaciadores en ambos lados de las capas de Si dopadas con P, y sustituyendo SiH 4 por SiH 2 Cl 2 (DCS). Los resultados experimentales mostraron que la segregación y el autodopaje también podrían aliviarse agregando un 7% de Ge al Si dopado con P. La estructura tenía una buena calidad de celosía y casi no presentaba relajación por tensión. El grabado selectivo entre Si dopado con P (o Si dopado con P 0.93 Ge 0.07 ) y SiGe también se discutió mediante el uso de grabado en húmedo y en seco. También se compararon el rendimiento y la selectividad de diferentes métodos de grabado. Este documento proporciona conocimientos sobre cómo lidiar con los desafíos o dificultades de la epitaxia y el grabado de capas de tipo n en la estructura vertical GAAFET.
Introducción
A medida que la escala del semiconductor de óxido de metal complementario (CMOS) alcanza su limitación física, los efectos de canal corto debilitan significativamente el rendimiento del transistor. Una solución a estos problemas son los nuevos diseños de transistores, por ejemplo, GAAFET (transistores de efecto de campo de puerta alrededor), que también se considera como el candidato más prometedor para transistores de nanoescala hasta el nodo de tecnología de 3 nm [1,2,3 , 4, 5, 6]. Los nanocables / nanohojas laterales y verticales son estructuras principales de acuerdo con la Hoja de ruta internacional para dispositivos y sistemas (IRDS) 2020 para reemplazar a los FinFET [7]. Los GAAFET verticales (o vGAAFET) tienen un diseño de flexibilidad libre en la longitud de la puerta y tienen un gran potencial para aumentar la densidad integrada [4, 8]. Hay dos categorías principales para implementar estructuras verticales de nanocables:de abajo hacia arriba y de arriba hacia abajo. El método ascendente introdujo el catalizador metálico, que puede traer problemas de compatibilidad del proceso [9, 10]. El método de arriba hacia abajo es el principal en la industria debido a su mejor control de la configuración de nanocables y su compatibilidad con FinFET [4, 11,12,13,14]. El método de arriba hacia abajo para fabricar GAAFET verticales atrae mucha atención. La puerta de autoalineación con un control preciso de la longitud de la puerta fue un tema crucial [15, 16]. Para lograr un mejor control efectivo de la longitud de la puerta o reducir la variación, la longitud de la puerta podría determinarse principalmente por el grosor del material del canal que creció epitaxialmente en una superficie plana inferior, como Si / SiGe / Si, y SiGe era el material del canal [17, 18,19,20]. Además, otro desafío crítico de la integración radica en el dopaje entre el canal y las regiones S / D [16, 20, 21], especialmente con el control de uniones nítidas [20]. En comparación con el proceso tradicional de implantación de fuente / drenaje, el proceso de epitaxia simplifica el proceso de fabricación, reduce el daño de la superficie y logra un perfil de dopaje uniforme. Sin embargo, la estructura sándwich de Si / SiGe / Si dopado con P es difícil de crecer epitaxialmente debido a los fenómenos de segregación, autodopaje y difusión externa de los dopantes de tipo n más comunes, el fósforo [22, 23], arsénico [24, 25] y / o antimonio [26, 27] en la interfaz Si / SiGe en sistemas de deposición química de vapor (CVD). Por lo tanto, los átomos donantes segregados reunidos en la interfaz Si / SiGe y la capa SiGe serían dopados, lo que podría degradar el rendimiento del transistor con una alta fuga.
Una estrategia para impedir la segregación de dopantes es aplicar una temperatura de crecimiento muy baja. Hay una serie de informes para hacer muchos esfuerzos para aumentar el dopaje de tipo n mediante epitaxia de haz molecular (MBE) [28]; mientras tanto, este método no se ha aplicado para las ECV. El equipo MBE tiene principalmente un diseño de un solo chip, lo que requiere un alto vacío y un rendimiento lento. Además, el equipo MBE no es compatible con tamaños de obleas superiores a 8 pulgadas en la industria. Por lo tanto, la tecnología MBE no es adecuada para aplicaciones industriales de producción en masa. Sin embargo, el sistema RPCVD tiene una gran capacidad de producción y una estructura de equipo simple, que es adecuada para la industria de CI [29]. La primera idea para el crecimiento de RPCVD es regular el flujo de hidrógeno en la cámara, ya que el hidrógeno es el gas portador y puede afectar la cinética de los gases precursores. Li y otros . [23] informó que el hidrógeno cambió la estructura de enlace de los átomos del huésped en la superficie y redujo la energía de segregación aplicando una temperatura de crecimiento baja en un sistema de CVD térmico rápido (RTCVD). Sin embargo, el efecto del hidrógeno no se ha explorado en la interfaz Si / SiGe en el sistema CVD de presión reducida (RPCVD). Suvar y otros . [30] insertó capas espaciadoras de Si sin dopar de 30 nm entre Si y SiGe dopado con P para reducir la concentración de P en la interfaz en un factor de 4 (de 8 × 10 19 cm −3 hasta 2 × 10 19 cm −3 ), pero el pico de dopaje P no puede eliminarse. Bennett y otros . [31] han estudiado el efecto de la deformación sobre el dopaje de tipo n en Si. La solubilidad sólida del dopaje se incrementó mediante la introducción de deformación por tracción en Si. Christensen y otros . [32] no han encontrado una dependencia significativa de la difusividad P del contenido de Ge en Si 1-x Ge x (0 ≤ x ≤ 0,22). Y los coeficientes de difusión de P tenían poca diferencia entre el Si relajado y el SiGe deformado biaxialmente por compresión. Zangenberg y otros . [33] observó una mejora del coeficiente de difusión en un factor de 2 a 825 ° C para el Si relajado 0.88 Ge 0.12 .
En este trabajo, se han propuesto varios métodos para mejorar la incorporación de P en Si en una multicapa de Si / SiGe / Si usando RPCVD. En los experimentos, diferentes estrategias como la purga de hidrógeno, la inserción de capas espaciadoras sin dopar, el cambio del precursor de Si de SiH 4 a SiH 2 Cl 2 (DCS) y modulando el perfil de deformación introduciendo Si 0.93 Ge 0.07 Se ha presentado una capa de sacrificio en ambos lados de la capa de SiGe. Además, se discutió el grabado selectivo de SiGe para formar una capa delgada de SiGe (pensada como capa de canal) [6, 34]. También se compararon las características de grabado de las herramientas de grabado en húmedo y en seco. La estructura final está destinada a ser utilizada para vGAAFET para el nodo de tecnología sub-10-nm en el futuro.
Métodos
Se cultivaron multicapas (ML) de Si / SiGe / Si en obleas de Si100 de 200 mm con equipo RPCVD (ASM Epsilon 2000). Los sustratos de Si se limpiaron con una solución de mezcla de H 2 SO 4 y H 2 O 2 , seguido de HF diluido para eliminar el óxido nativo antes de insertarlo en las trabas de carga de la cámara de epitaxia. Las muestras se limpiaron in situ mediante recocido a 1050 ° C para eliminar el óxido nativo y obtener una superficie de Si de alta calidad. Los precursores de Si, Ge y P fueron SiH 4 (o SiH 2 Cl 2 ), 10% GeH 4 en H 2 y 2% PH 3 en H 2 . La temperatura de crecimiento fue de 650 ° C, mientras que la presión de la cámara se mantuvo a 80 Torr durante la epitaxia. En algunos experimentos, la presión de la cámara se redujo a 10 Torr para hacer crecer Si dopado con P 0.93 Ge 0.07 capa en las regiones de origen / drenaje (S / D). El contenido de Ge en el canal de SiGe se mantuvo constante en 0,22. Para estudiar las características de grabado selectivo, se depositó nitruro de 50 nm / óxido de 30 nm como máscara dura para proteger los NM inferiores. Se realizaron litografía y grabado vertical anisotrópico seco para formar patrones cuboides separados. Los experimentos de grabado selectivo se llevaron a cabo con una herramienta de grabado en húmedo de HF (6%):H 2 O 2 (30%):CH 3 COOH (99,8%) =1:2:4 y herramienta de grabado en seco de CF 4 :O 2 :Él =4:1:5 [35].
Los Si / SiGe / Si ML se caracterizaron por las técnicas de microscopía electrónica de transmisión de alta resolución (Thermo Scientific Talos F200) (HRTEM), espectroscopía de rayos X de dispersión de energía (EDX), difracción de rayos X de alta resolución (HRXRD) y mapa de celosía recíproca de alta resolución (HRRLM) de Bruker JV Delta-x, microscopía electrónica de barrido (SEM) de Hitachi (Japón) y espectroscopía de masas de iones secundarios (SIMS).
Resultados y discusión
Epitaxia de ML Si / SiGe / Si dopado con P
En este estudio, se exploró inicialmente la incorporación de P en Si y SiGe. Las estructuras ML se muestran en la Fig. 1a. Un ML de Si dopado con P / Si sin dopar con PH 3 en aumento Se hizo crecer el flujo y los perfiles de las capas fueron examinados por SIMS en la Fig. 1b. La figura muestra que la concentración de P aumenta y alcanza el nivel más alto de 2.6 × 10 19 cm −3 . Dos muestras más con perfil de 'Si / Si dopado con P 0,72 Ge 0.28 / Si dopado con P 'y' Si / Si dopado con P 0,72 Ge 0.28 Se diseñaron / Si ’, y el perfil P se muestra en la Fig. 1c, d, respectivamente. En la Fig. 1c, se observa una acumulación de P en las interfaces de Si / Si dopado con P 0,72 Ge 0.28 multicapas. La acumulación de P interfacial aumenta al aumentar la concentración de P desde la parte inferior hacia la parte superior en las multicapas, y la concentración más alta es 1,6 × 10 20 cm −3 , que es 6 veces más que la concentración en la Fig. 1b (2.6 × 10 19 cm −3 ). En Si dopado 0,72 Ge 0.28 capas (Fig. 1d), las concentraciones de P son notablemente más altas y no hay picos en la interfaz. Debido al dopaje, el porcentaje de Ge aumenta ligeramente. Este comportamiento está relacionado con la adsorción mejorada de SiH 4 y GeH 4 en presencia de PH 3 . Además, debido al dopaje, los espesores de capa son diferentes entre las Fig. 1c, d, que tienen el mismo tiempo de crecimiento. Significa que el dopaje P mejora la tasa de crecimiento de Si 0,72 Ge 0.28 capas y la absorción de GeH 4 , mientras que la tasa de crecimiento de Si se retrasa debido a la adsorción de P. Estos fenómenos son consistentes con el resultado informado en las Refs. [36,37,38]. De lo anterior, la segregación de P y el fenómeno de auto-dopaje son serios en la interfaz Si / SiGe. El pico de dopaje P en la interfaz Si / SiGe produce un dopaje involuntario en la capa de SiGe. Dado que SiGe está destinado a ser la capa de canal en los transistores, el perfil de dopaje no homogéneo o los altos niveles de dopaje de fondo limitarían las aplicaciones del dispositivo [39]. A continuación se analizarán varios métodos para eliminar el pico P. Para una mejor comparación, todas las capas de SiGe están tensas y la relación de flujo de SiH 4 (SiH 2 Cl 2 ) y GeH 4 para la capa de SiGe no se alteró a lo largo de todos los experimentos.
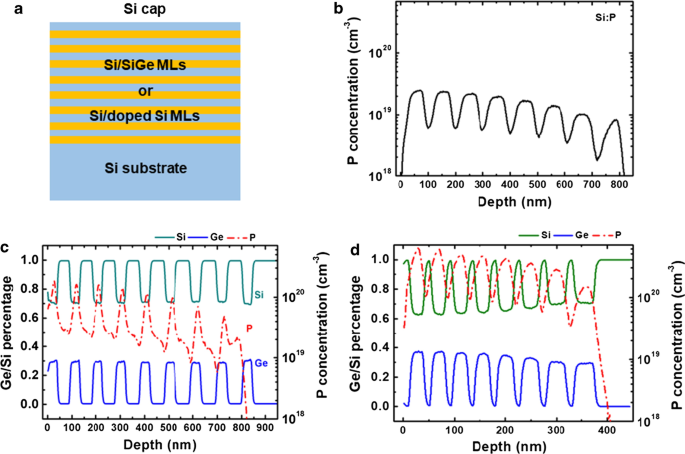
un Diagrama esquemático de los ML de Si / SiGe / Si dopados con P. b Concentración de dopaje P de ML sin dopar con Si / Si dopado con P. Porcentaje de Ge / Si y concentración de P de c Si sin dopar 0,72 Ge 0.28 / Si dopado con P, d Si no dopado / Si dopado P 0,72 Ge 0.28 ML. No se consideró una capa espaciadora de purga y sin dopar
Impacto de las capas espaciadoras
Se insertaron capas espaciadoras de Si sin dopar entre la capa de Si dopada en el fondo y la capa de SiGe sin dopar para absorber el exceso de átomos de P. La Figura 2a muestra el diagrama esquemático de la estructura diseñada, y la Figura 2b – d demuestra los resultados del perfil de los espaciadores de Si integrados con espesores de (b) 3 nm, (c) 5 nm y (d) 10 nm. Los picos de acumulación de P se reducen, mientras que el porcentaje de Si / Ge y la concentración de P en las capas de Si se mantienen constantes como en la Fig. 2b – d. El nivel de acumulación de P se reduce en un 82%, de 4 × 10 19 cm −3 en la Fig. 2b a 7 × 10 18 cm −3 en la Fig. 2d, cuando el espesor del espaciador X b aumentado de 3 a 10 nm. El aumento del espesor de las capas espaciadoras de Si sin dopar aumenta la absorción de átomos de P excesivos. En la Fig. 2d, la pendiente del perfil P en Si 0.86 Ge 0,14 / Si la superficie es de 15,9 nm / dec, mientras que en Si / Si 0,86 Ge 0,14 interfaz la pendiente es 31,3 nm / dec. Mientras tanto, una capa espaciadora de Si demasiado gruesa no es una solución adecuada ya que aumenta la resistencia de la hoja. Por lo tanto, para los transistores se debe hacer un compromiso entre la resistencia de la hoja y el perfil P incontrolado. La Figura 2 también revela el impacto de la capa espaciadora entre Si / Si 0.86 Ge 0,14 capas ( X b ) era diferente de la capa entre el Si 0.86 Ge 0,14 / Si ( X t ). En la Fig. 2b, c, los espesores del espaciador entre el Si 0.86 Ge 0,14 / Si eran 3 nm y 5 nm, mientras que en la Fig. 2d, no se insertó ninguna capa espaciadora. Sin embargo, la pendiente del perfil P en el Si 0.86 Ge 0,14 / Si es el mismo (aproximadamente 15,9 nm / dec), aunque en la Fig. 2d se eliminó la capa espaciadora superior pero no se observó influencia sobre el perfil de dopaje. De los resultados anteriores, el pico P estaba solo en Si / Si 0.86 Ge 0,14 interfaz, que posiblemente se deba al límite de solubilidad; el exceso de átomos de P puede formar dímeros P – P en la superficie y ser incorporados en la capa superior de SiGe. Además, hay un autodopado de P durante el crecimiento de SiGe después del Si dopado con P. Por lo tanto, se han buscado métodos para eliminar el exceso de átomos de P o mejorar la solubilidad del Si.
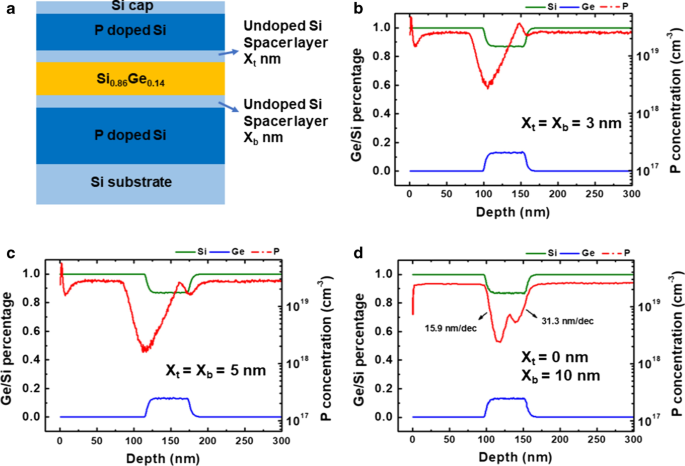
un El esquema de muestras experimentales con diferentes capas espaciadoras sin dopar. Y perfiles de Ge, Si y P de Si / Si dopado con P 0.86 Ge 0,14 / ML de Si dopado con P con capas espaciadoras de Si sin dopar de b 3 nm, en ambas interfaces, c 5 nm, en ambas interfaces, d 10 nm, solo en una interfaz con Si 0.86 Ge 0,14
Impacto de la purga de hidrógeno en la interfaz de Si / SiGe / Si MLs
En esta sección, la capa espaciadora de Si se fijó a 5 nm y se introdujo una purga de hidrógeno para eliminar el exceso de átomos de P después del crecimiento de Si dopado con P. Puede verse en la Fig. 3c, d que el aumento del flujo de hidrógeno de 20 a 60 sccm y el tiempo de purga de 2 a 10 min no tiene un efecto obvio sobre el pico de P. La concentración de dopaje en Si es 3 × 10 19 cm −3 , que es el mismo que se discutió en la sección "Impacto de las capas espaciadoras". La concentración máxima de P en la interfaz es la misma que la concentración en Si de la Fig. 3d. Los espesores de capa son los mismos en diferentes condiciones de purga. Los átomos de P no pueden ser eliminados por hidrógeno; esto puede explicarse por la formación de complejos P estables en la superficie. Al cambiar parámetros como la temperatura, la presión, el tiempo de purga sería útil [24, 40], pero un tiempo de purga demasiado largo no es adecuado debido al costo del tiempo, y la alta temperatura (> 950 ° C) causa la interdifusión de Si-Ge [41] .
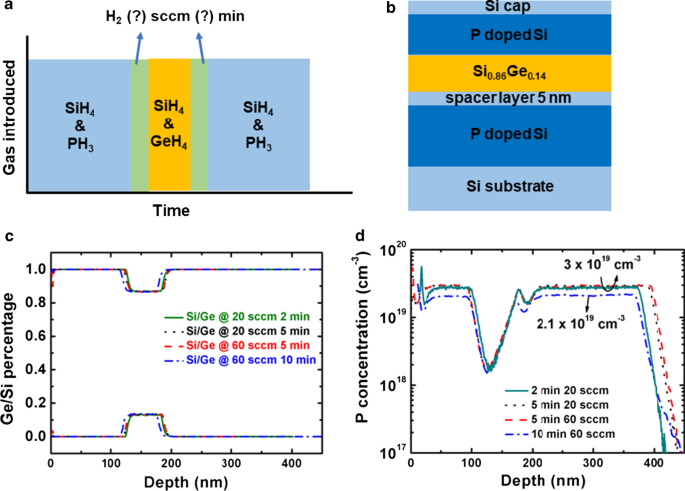
Diagramas esquemáticos de a estrategia de dopaje de H 2 condiciones de purga y b estructura experimental de ML de Si / SiGe / Si. c Perfil Ge / Si y d Concentración de P de Si / Si dopado con P 0.86 Ge 0,14 / ML Si dopado con P
Impacto de la química del crecimiento en la incorporación de P
En estos experimentos, el precursor de Si, SiH 4 , ha sido reemplazado por SiH 2 Cl 2 (DCS). En estas muestras, los parámetros de crecimiento fueron los mismos que antes, y las estructuras contienen una capa espaciadora de Si de 5 nm y el tiempo de purga es de 5 min con un flujo de 60 sccm. La idea detrás es investigar si la química basada en Cl podría eliminar el exceso de átomos de P por la superficie de Si y podrían ocurrir reacciones de P-Cl, Si-Cl o Ge-Cl [42]. De la Fig.4, la concentración máxima de P se reduce en un factor de 2 (de 2.6 × 10 19 cm −3 a 1,3 × 10 19 cm −3 ), y las concentraciones de P en las capas de Si son 2.6 × 10 19 cm −3 . El contenido estimado de Ge es del 30%, que es más alto que SiGe con SiH 4 . El mayor contenido de Ge demuestra que el Cl eliminó preferiblemente los átomos de Si en las reacciones superficiales. Este resultado también puede explicarse por la diferente relación de la relación de flujo de gas y la concentración de Ge con SiH 4 y SiH 2 Cl 2 precursores gaseosos [32, 43]. Otra explicación fue que los átomos de Ge aumentaron la desorción de hidrógeno y luego aumentaron los sitios de nucleación libres [44]. La pendiente de concentración de P del Si 0.7 Ge 0.3 / Si la interfaz era de 13,2 nm / dec, que era un poco más nítida que Si 0,86 Ge 0,14 / Si interfaz (15,9 nm / dec). La pendiente del perfil P en el Si / Si 0.7 Ge 0.3 la interfaz fue de 20 nm / dec. Por lo tanto, al introducir más HCl o aumentar la proporción de gas de SiH 2 Cl 2 y GeH 4 , los átomos de P segregados en la superficie de Si dopada pueden ser atacados por HCl para formar dímeros de P-Cl y la concentración máxima de P en Si / SiGe podría ser menor [38, 45].
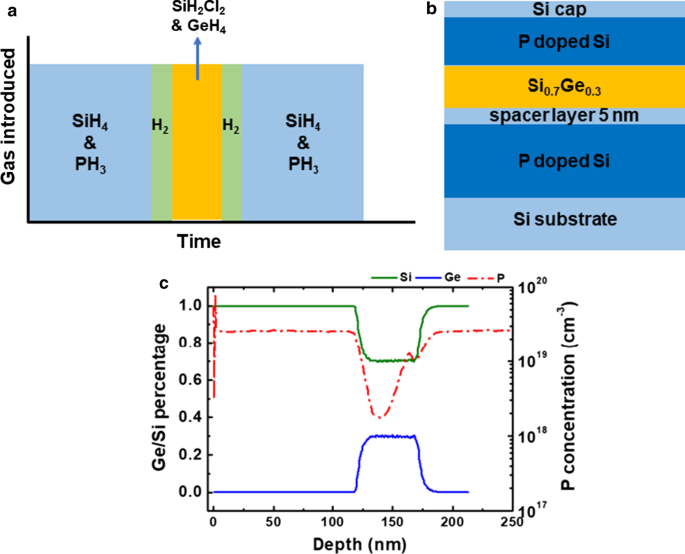
Diagramas esquemáticos de a estrategia de dopaje para cambiar la química del crecimiento, b estructura experimental de ML de Si / SiGe / Si. La capa de SiGe se hizo crecer con DCS. El tiempo de purga fue de 5 min con un flujo de 60 sccm después de Si dopado. La capa espaciadora de Si sin dopar estaba a 5 nm entre el Si dopado en el fondo y el SiGe sin dopar. c Perfil de Ge / Si y concentración de P de Si / Si dopado con P 0,7 Ge 0.3 / ML Si dopado con P
Impacto del contenido de Ge en el perfil P
Como comentamos antes, la incorporación de P en SiGe fue notablemente mayor que en Si. Por tanto, esto puede plantear la idea de que añadir unos pocos porcentajes de Ge (7%) en espaciadores de Si (5 nm) podría mejorar la incorporación de P en Si. Vale la pena mencionar aquí que nuestro propósito no es cambiar significativamente el carácter del Si dopado con P, sino impedir la segregación de P en Si. En estas muestras, la presión de la cámara se redujo a 10 Torr durante el crecimiento de las capas espaciadoras. La tasa de crecimiento dependiente del dopaje y el porcentaje de Ge serían importantes en esta condición. De la Fig. 5b, las capas superior e inferior eran 110 nm Si 0.93 Ge 0.07 con concentración de P de 1 × 10 20 cm −3 , la capa intermedia eran 40 nm Si 0,78 Ge 0.22 con una concentración de P de 3,5 × 10 19 cm −3 . La pendiente de la concentración de P del Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 fue de aproximadamente 33 nm / dec. La pendiente no era pronunciada porque la diferencia porcentual de Ge entre las dos capas no era lo suficientemente grande. En la Fig. 5d, tres capas de Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 Se cultivó ML para verificar la uniformidad del dopaje, y su diagrama de estructura se muestra en la Fig. 5c. Se puede ver, de la capa inferior a la superior, la concentración de P estaba disminuyendo, lo que puede explicarse por el efecto memoria de P. Los átomos de P residuales en la cámara o los átomos de P difusos se acumulan en la superficie de la película y bloquean los sitios activos libres en la superficie [38, 39]. Aunque se eliminó el pico P, la segregación entre Si 0,78 Ge 0.22 y Si 0.93 Ge 0.07 todavía estaba en serio.
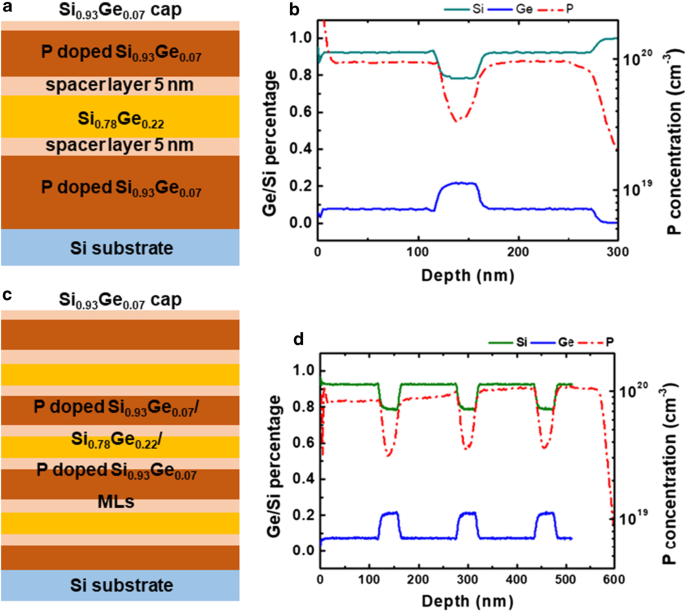
un Diagrama esquemático, b Perfil Ge / Si y P en una capa de Si dopado con P 0,93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 ML. c Diagrama esquemático, d Perfil Ge / Si y P en tres capas de Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 ML
Características de grabado selectivo de Si / SiGe / Si MLs
Cuando la estructura ML crece con éxito (utilizando las estrategias de crecimiento anteriores), los NW se han formado mediante grabado vertical utilizando SiO 2 / SiN como máscara dura. Posteriormente, la capa de SiGe tiene que ser atacada selectivamente a Si en la dirección lateral para formar la capa de canal con un ancho diseñado. En estos experimentos, se han elegido dos tipos de estructuras ML:Si dopado con P / SiGe / Si dopado con P (muestra-1, en la Fig. 2c) y Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 (muestra-2, en la Fig. 5b). Estas elecciones se realizan de acuerdo con las discusiones anteriores donde la difusión externa de P se ha suprimido (parcialmente), así como también se consideran las perspectivas de la aplicación del dispositivo.
El grabado en dirección vertical se realizó mediante grabado en seco, mientras que para el grabado lateral se aplicó un grabado selectivo en seco o húmedo. Los perfiles de grabado de la muestra 1 se muestran en la Fig. 6a, b. Y la imagen TEM y el mapeo EDS de la Fig. 6a se han mostrado en la Fig. 7. En estos experimentos, la máscara dura es óxido / nitruro. La Figura 6a muestra después de 11,5 s de grabado en seco de CF 4 / O 2 /Él. La selectividad de grabado de Si 0.86 Ge 0,14 y Si dopado con P es 5,8. La Figura 6b muestra que después de 20 minutos de grabado en húmedo de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%). El grabado en húmedo ha eliminado la máscara dura (SiO 2 / SiN), y como resultado, la capa superior de Si también se atacó a ~ 10 nm. Como se discutió en la sección "Impacto de las capas espaciadoras", hay una acumulación de P en el Si / Si dopado con P 0.86 Ge 0,14 interfaz. El grabado en húmedo es sensible al nivel de dopaje; por lo tanto, la primera interfaz se grabó más rápido. Como resultado, la interfaz de grabado frontal no es vertical y está facetada o en ángulo. La selectividad media fue inferior a 4,2. Comparando los dos métodos de grabado, el grabado en seco es sensible al porcentaje de Ge con una mejor selectividad de SiGe, mientras que el grabado en húmedo es sensible a la concentración de dopante. Los grabados de la muestra-2 también se estudian en la Fig. 6c, d. Se observaron fenómenos similares en esta muestra, mientras que las profundidades de grabado selectivo de SiGe fueron más profundas (Fig. 6a, c) debido a un mayor porcentaje de Ge. En el grabado en seco, la selectividad de Si 0,78 Ge 0.22 y Si dopado con P 0.93 Ge 0.07 fue de 6,3, mientras que en el grabado en húmedo, la selectividad media fue inferior a 2,5. Por lo tanto, el grabado en seco fue una mejor opción teniendo en cuenta la uniformidad y selectividad del grabado.
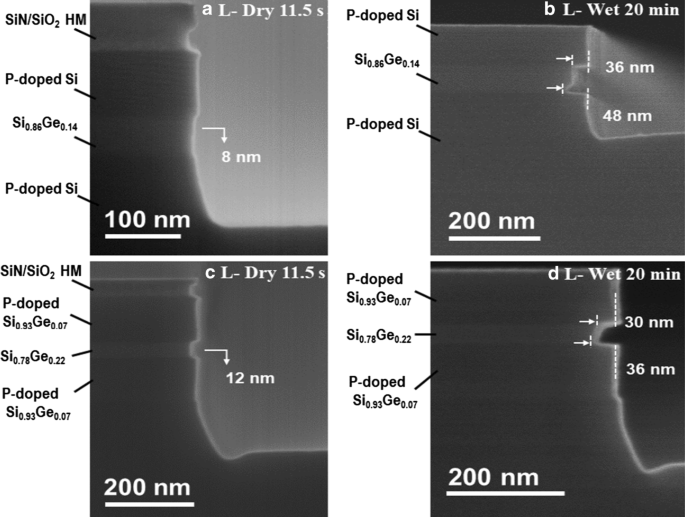
Imágenes SEM de Si / Si dopado con P 0.86 Ge 0,14 / Si dopado con P en la Fig. 2c con a Grabado en seco de 11,5 s, b Grabado en húmedo durante 20 minutos y Si dopado con P 0,93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 ML con c Grabado en seco de 11,5 s, d Grabado húmedo de 20 min. El grabado en seco fue CF 4 :O 2 :He =4:1:5, y el grabado en húmedo fue HF (6%):H 2 O 2 (30%):CH 3 COOH (99,8%) =1:2:4
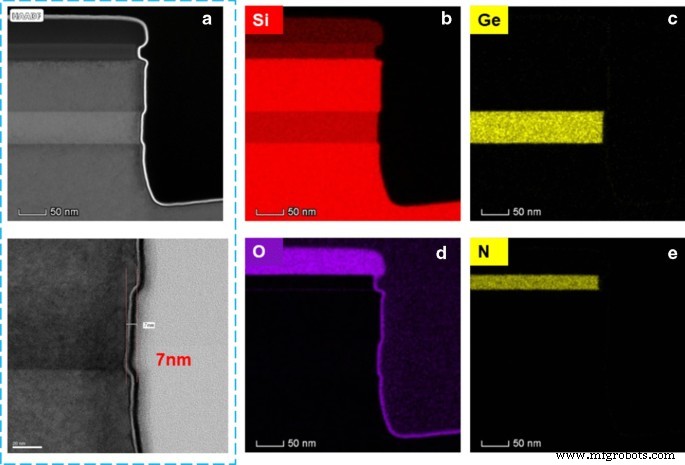
un Imágenes TEM, b - e Mapeo EDS de Si / Si dopado con P 0.86 Ge 0,14 / Si dopado con P en la Fig. 6a con grabado en seco de 11,5 s. Los elementos en b es Si, en c es Ge, en d es O, y en e es N
Se realizaron más análisis para investigar la cepa después de los pasos de grabado en muestra-1 y muestra-2. La Figura 8a-h muestra (004) curvas de balanceo (RC) de estas muestras de la siguiente manera:tal como crecen, después del grabado vertical, y grabado lateral SiGe usando grabado húmedo y seco. En el análisis de RC, el ensanchamiento (ancho completo-medio máximo o FWHM) es un indicador de la densidad del defecto, y la posición del pico de SiGe en comparación con Si determina la cantidad de deformación en la capa. Enfatizamos aquí que el ensanchamiento del pico también puede deberse al grosor delgado de la capa. Por lo tanto, será difícil distinguir del análisis RC la contribución de la densidad de defectos, pero solo podemos comparar FWHM en algunas extensiones de estos análisis. En estos RC, la muestra-1 (Fig. 8a-d) tiene una sola capa de SiGe; mientras tanto, la muestra-2 (Fig. 8e-h) muestra dos picos que representan el 7% y el 22% de Ge. Para las muestras recién desarrolladas, se observa una interferencia del haz de rayos X, lo que provoca franjas de capa de espesor. La aparición de estas franjas muestra una interfaz SiGe / Si de alta calidad. En los RC, de muestra-1 y muestra-2, el pico de Ge se ha desplazado hacia el pico del sustrato de Si, lo que indica la relajación de la deformación. No se ha detectado ningún cambio adicional del pico de Ge después del grabado lateral en seco de SiGe. Este es un resultado prometedor para el rendimiento del transistor, ya que la movilidad de la portadora en la región del canal depende de la deformación. Mientras tanto, la deformación se ha relajado más para el SiGe grabado en húmedo y se ha observado un mayor desplazamiento hacia el pico del sustrato. Esto muestra que el grabado en húmedo no es adecuado para el grabado lateral de SiGe, que forma la capa del canal.
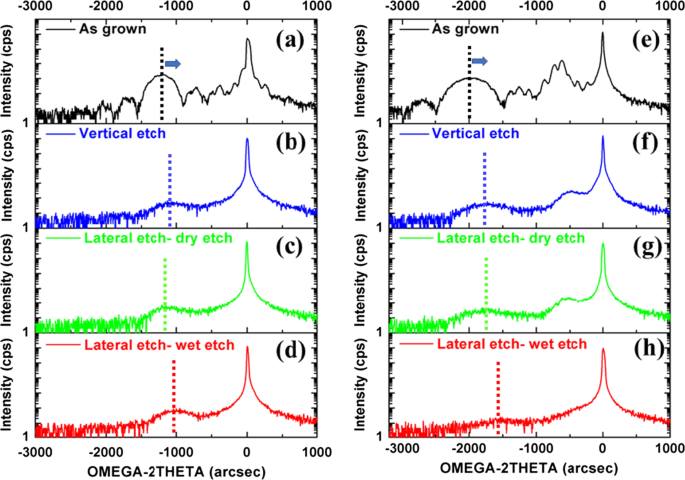
Curva de oscilación HRXRD alrededor de (004) reflexión de muestra-1, Si / Si dopado con P 0.86 Ge 0,14 / ML de Si dopado con P con una capa espaciadora de 5 nm en a - d , y muestra-2, Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 ML en e - h . Ambas dos muestras tienen cuatro paneles:tal como han crecido, después del grabado vertical, grabado lateral húmedo de SiGe de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%) 20 min y grabado lateral en seco de CF 4 / O 2 / Él 11,5 s
Se realizaron más análisis de rayos X para encontrar más información sobre la densidad de defectos en las muestras de la Fig. 9a – h. Los HRRLM, que se basan en mediciones bidimensionales, se realizaron aquí como se muestra en la Fig. 9a – h. El indicador de la densidad de defectos en los HRRLM es la ampliación de la capa de SiGe a lo largo de la dirección ω (ω es el ángulo del haz incidente). La posición de los picos de Si y SiGe proporciona los componentes de deformación en paralelo y perpendicular a la dirección de crecimiento. En la muestra-1 y la muestra-2, las capas de SiGe recién desarrolladas muestran un ensanchamiento ω menor, y la capa está alineada con el Si mostrando capas de SiGe completamente deformadas (ver Fig. 9a, e). La Figura 9b muestra la muestra después del grabado vertical, el pico de SiGe se ha desplazado hacia el sustrato de Si de una manera similar en los resultados de RC de la Figura 8b, lo que indica relajación de la deformación. Pero sorprendentemente, la muestra lateral grabada en seco (Fig. 9c) muestra un claro ensanchamiento ω del pico SiGe junto con un cambio en el espacio recíproco, que está en dirección fuera de la alineación con el pico Si. Sin embargo, la muestra grabada en húmedo (en la Fig. 9d) está completamente alineada por deformación y tiene una intensidad de capa más baja que la muestra grabada en seco (en la Fig. 9c). En este caso, se espera que los defectos generados tengan diferentes orígenes en estas muestras ya que la naturaleza del proceso de grabado es diferente. La Muestra-2 contiene dos capas de SiGe; el Si 0.93 Ge 0.07 sobrevive al pico después del grabado tanto en dirección vertical como lateral, mientras que Si 0,78 Ge 0.22 desaparece después del grabado vertical que muestra una relajación total de la deformación (fig. 8f-h). La escasa estabilidad del proceso de la muestra-2 podría deberse al dopaje P, que promueve la formación de dislocaciones inadaptadas.

HRRLM de Si / Si dopado con P 0.86 Ge 0,14 / ML de Si dopado con P con capa espaciadora de 5 nm (muestra-1) en a - d y Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0.93 Ge 0.07 ML (muestra-2) en e - h . Los dos mapeos tienen cuatro paneles:como crecido, después del grabado vertical, grabado lateral en húmedo de HF (6%) / H 2 O 2 (30%) / CH 3 COOH (99,8%) 20 min y grabado lateral en seco de CF 4 / O 2 / Él 11,5 s
Conclusiones
En este trabajo, se ha investigado la epitaxia de las ML de Si / SiGe / Si dopadas con P y el grabado de estas ML como estructuras iniciales para vGAAFET. En primer lugar, se estudió la incorporación de P en Si / SiGe / Si MLs. Se han propuesto diferentes estrategias para la epitaxia y la estructura ML para eliminar el pico P-segregado en la interfaz de la heteroestructura Si / SiGe. A partir de los experimentos, la inserción de una capa espaciadora sin dopar podría disminuir el pico de P. La purga de hidrógeno para eliminar el exceso de átomos de P no fue muy útil y los dímeros P-P estables no pudieron eliminarse por completo. Sustituyendo SiH 4 con SiH 2 Cl 2 como precursor de Si para introducir Cl, la química durante el crecimiento disminuyó notablemente el pico de P segregado debido a las reacciones de superficie activa del Cl. El impacto del Si 0.93 Ge 0.07 También se investigaron las capas espaciadoras después de Si dopado con P. Los resultados mostraron que el pico P en la interfaz SiGe desapareció, mientras que la incorporación de P en estas capas mejoró en una magnitud de orden. En la segunda parte de este estudio, se realizó el grabado vertical de Si / SiGe / Si ML para formar NW, y posteriormente, en estos NW, el SiGe fue grabado selectivamente en húmedo o en seco. El grabado en húmedo fue sensible a la concentración de dopante; mientras tanto, el grabado en seco fue sensible al contenido de Ge. El grabado en seco fue más apropiado para estructuras de tipo n con perfil de grabado uniforme y mayor selectividad. Para Si / Si dopado con P 0.86 Ge 0,14 / ML de Si dopado con P, la selectividad fue de 5,8 con el grabado en seco y de 4,2 con el grabado en húmedo. La selectividad del Si dopado con P 0.93 Ge 0.07 /Si0.78 Ge 0.22 / Si dopado con P 0,93 Ge 0.07 MLs was 6.3 with dry etch and 2.5 with wet etch. The strain in SiGe was mostly preserved in Si/SiGe/Si after vertical and lateral etch; meanwhile, this strain in MLs with introduced Si0.93 Ge0.07 spacer layer had poor stability after etch process.
Disponibilidad de datos y materiales
The authors declare that the data supporting the findings of this study are available within the article.
Abreviaturas
- vGAAFET:
-
Vertical gate-all-around field-effect transistors
- ML:
-
Multilayer
- CMOS:
-
Complementary metal oxide semiconductor
- MBE:
-
Epitaxia de haz molecular
- RPCVD:
-
Reduced pressure chemical vapor deposition
- RTCVD:
-
Rapid thermal chemical vapor deposition
- S / D:
-
Fuente / drenaje
- HRTEM:
-
Microscopía electrónica de transmisión de alta resolución
- HRXRD:
-
Difracción de rayos X de alta resolución
- HRRLM:
-
High-resolution reciprocal lattice map
- SEM:
-
Microscopía electrónica de barrido
- SIMS:
-
Espectroscopía de masas de iones secundarios
- RC:
-
Rocking curve
- FWHM:
-
Full-width-half-maximum
- HM:
-
Hardmask
Nanomateriales
- Mejorar el rendimiento de las aplicaciones para los usuarios y clientes en CyrusOne
- Separadores de aire para chips de 10 nm
- Crecimiento directo de estructuras de ZnO similares a plumas mediante una técnica de solución fácil para la aplicación de fotodetección
- Evaluación de estructuras de grafeno / WO3 y grafeno / ceO x como electrodos para aplicaciones de supercondensadores
- Una sonda fluorescente reanudable BHN-Fe3O4 @ SiO2 Nanoestructura híbrida para Fe3 + y su aplicación en bioimagen
- Nanoestructuras de superficie formadas por separación de fases de película de nanocompuesto de polímero y sal metálica para aplicaciones antirreflectantes y superhidrofóbicas
- Elección de un tipo de proceso y equipo de soldadura robótica para su aplicación
- Las empresas se preparan para los grandes cambios y desafíos tecnológicos de 2019
- Torno vertical para aplicaciones de fundición, forja y torneado
- Torno vertical para aplicaciones de fundición, forja y torneado(2)
- Maquinaria VMC para producción y eficiencia



