Pasivación de Si mejorada y eficiencia de células solares PERC mediante óxido de aluminio depositado en capa atómica con recocido posterior en dos pasos
Resumen
En este estudio, el óxido de aluminio (Al 2 O 3 ) se prepararon películas mediante una deposición de capa atómica espacial utilizando agua desionizada y trimetilaluminio, seguido de oxígeno (O 2 ), formación de gas (FG) o recocido en dos etapas. La vida útil de los portadores minoritarios de las muestras se midió mediante Sinton WCT-120. La pasivación por efecto de campo y la pasivación química se evaluaron mediante una carga de óxido fija ( Q f ) y densidad de defectos de interfaz ( D eso ), respectivamente, utilizando la medición de capacitancia-voltaje. Los resultados muestran que O 2 el recocido da un alto Q f de - 3,9 × 10 12 cm −2 , mientras que el recocido FG conduce a una excelente hidrogenación de la interfaz de Si con un bajo D eso de 3,7 × 10 11 eV −1 cm −2 . Sobre la base de la consideración de la mejor pasivación de efecto de campo aportada por el recocido con oxígeno y la mejor pasivación química aportada por la formación de gas, se optimizó el proceso de recocido en dos pasos. Se verifica que el Al 2 O 3 película recocida secuencialmente en oxígeno y luego en gas de formación exhibe un alto Q f (2,4 × 10 12 cm −2 ) y una D baja eso (3,1 × 10 11 eV −1 cm −2 ), lo que arroja la mejor vida útil de la portadora minoritaria de 1097 μs. El SiN x / Al 2 O 3 La pila de pasivación con recocido en dos pasos tiene una vida útil de 2072 μs, cerca del límite de vida útil intrínseco. Finalmente, el emisor pasivado y la eficiencia de conversión de la celda trasera se mejoró del 21,61% mediante un proceso de recocido industrial al 21,97% mediante el proceso de recocido de dos pasos.
Introducción
Los emisores pasivados y las celdas traseras (PERC) han surgido como una tecnología prometedora por su alta eficiencia y costo competitivo en los últimos años. La mayor diferencia entre el PERC y la celda solar de silicio de campo de superficie trasera de aluminio tradicional es la pasivación trasera de las obleas. Se han realizado esfuerzos considerables para mejorar la pasivación de la superficie de la oblea. Se ha informado de una vida útil de los portadores minoritarios de 0,8 a 8 ms para las obleas de zona flotante de tipo p pasivadas por vacío [1,2,3,4] o por deposición de capa atómica espacial (ALD) óxido de aluminio (Al 2 O 3 ) [5,6,7]. La calidad de pasivación para las obleas de Czochralski de tipo p es menor, en el rango de 0,1 a 2 ms [8, 9]. ALD espacial Al 2 O 3 han sido ampliamente estudiados y aplicados a la industria en los últimos años debido a su mayor tasa de deposición (0.03-1.2 nm / s) en comparación con la de un ALD convencional de tipo vacío (<0.03 nm / s) [10, 11]. Trimetilaluminio (TMA) y H 2 O son los precursores más utilizados, ya que son líquidos volátiles económicos y fáciles de manipular. Algunos grupos de investigación utilizan otros precursores como AlCl 3 o O 3 [12,13,14]. Al 2 O 3 Actualmente se considera el mejor material de pasivación debido a su efecto de campo y pasivación química [15]. Se encuentra que el H 2 El proceso de ALD basado en O conduce principalmente a un óxido de silicio (SiO x ) capa en el Al 2 O 3 / Si interfaz, y esta capa interfacial puede aparecer después de la deposición o recocido [16]. Post recocido para Al 2 O 3 Se ha demostrado que las películas en nitrógeno o gas de formación (FG) aumentan significativamente la vida útil de la oblea [12, 17]. Hidrógeno en FG o Al 2 O 3 provocan la hidrogenación de la interfaz de Si durante el recocido. La temperatura de recocido es típicamente inferior a 500 ° C, más allá de la cual se produce la deshidrogenación. Sin embargo, rara vez se informan otros procesos de recocido para mejorar aún más la calidad de pasivación.
En este estudio, Al 2 O 3 las películas se preparan en Si mediante ALD espacial con TMA y H 2 O como precursores. Efectos del oxígeno (O 2 ) y el recocido posterior de FG en la pasivación de obleas de Si se investigan y analizan. Un recocido de dos pasos como una combinación de O 2 y el recocido FG se propone y demuestra una mayor vida útil de la oblea en comparación con el proceso de recocido de gas individual. Por último, el rendimiento fotovoltaico de los PERC fabricados con el estándar de la industria, O 2 , FG y recocido en dos pasos.
Métodos
Como sustratos se utilizaron obleas de silicio Czochralski tipo P (100) con resistividad de 1 Ω-cm y espesor de 200 μm. Las obleas se limpiaron utilizando un proceso RCA estándar, seguido de una inmersión de HF de 30 s para eliminar el óxido nativo de las obleas. El Al 2 O 3 Se depositaron películas delgadas con un espesor de 18 nm utilizando un sistema ALD espacial, con H 2 O y TMA como oxidante y fuente de aluminio, respectivamente. El espacio entre los cabezales de inyección de gas y el soporte móvil del sustrato era de aproximadamente 1 mm. Los parámetros de deposición detallados se resumen en la Tabla 1. La temperatura de las tuberías fue de 70 ° C para evitar la condensación de precursores. Algunas de las obleas se pasivaron con nitruro de silicio (SiN x , 120 nm) / Al 2 O 3 (18 nm) pila, donde el SiN x La capa se depositó usando una deposición de vapor de plasma acoplada inductivamente a 13,56 MHz a 120 ° C con una mezcla gaseosa de amoníaco (NH 3 ) y tetrametilsilano (TMS). Otros parámetros para SiN x La deposición se enumera en la Tabla 2. El proceso de recocido de oxígeno, FG o de dos pasos se realizó en las muestras, y los parámetros de recocido se enumeran en la Tabla 3. La vida útil de las muestras se midió mediante Sinton WCT-120. La capacitancia-voltaje ( C - V ) la medición se llevó a cabo en muestras de semiconductores de óxido de metal (MOS) mediante un medidor de condensador (HP 4284a) a 1 MHz a temperatura ambiente. Para la fabricación de MOS, las obleas se depositaron con un Al 2 de 18 nm de espesor O 3 capa y recocido. Se evaporaron películas de aluminio con un espesor de 500 nm en ambos lados de las muestras como electrodos. El área de las muestras MOS fue de 1 mm 2 . Las imágenes transversales de las muestras se obtuvieron utilizando un microscopio electrónico de transmisión (TEM). Para la fabricación de PERC, se muestra un esquema de los dispositivos en la Fig. 1, donde la pasivación ALD está solo en la parte posterior. Las obleas se texturizaron usando una solución alcalina para generar pirámides aleatorias. El emisor fue formado por POCl 3 difusión en un horno térmico de tubo estándar con una resistencia de hoja de 100 ohmios / cuadrado. A SiN x de 85 nm de espesor se depositó en el lado frontal de la oblea como una capa antirreflectante por deposición de vapor de plasma acoplado inductivamente (ICPCVD). El reverso de la oblea se pulió con una solución de KOH durante 3 min a 70 ° C. El Al 2 O 3 Se depositaron películas de 18 nm de espesor utilizando ALD espacial. Un ICPCVD SiN x de 120 nm de espesor se depositó sobre Al 2 O 3 . Las muestras se recocieron con diferentes procesos de recocido. Las aberturas locales traseras con un diámetro de 40 μm y un paso de 260 μm se crearon mediante trazado con láser de 532 nm. Finalmente, se imprimió una rejilla plateada en el frente y aluminio en el dieléctrico trasero, seguido de co-combustión a una temperatura máxima de 850 ° C. La densidad-voltaje de corriente ( J - V ) las curvas se midieron mediante un simulador solar de tipo fuente de luz dual (Wacom Co., Japón) utilizando una lámpara de xenón y una lámpara halógena con un espectro de luz simulado clase A AM 1.5G calibrado.
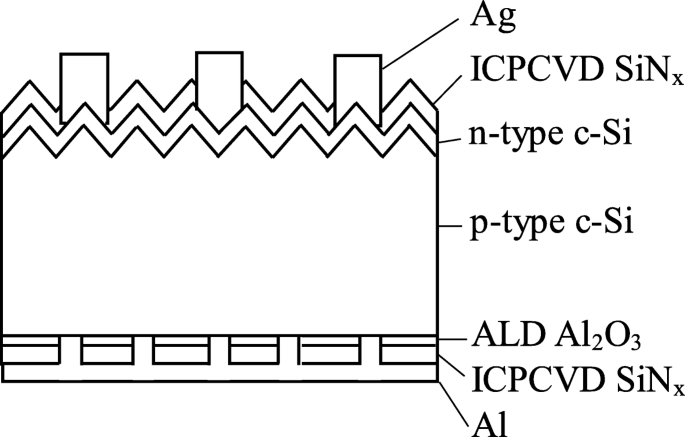
Esquema de células solares PERC con SiN x / ALD Al 2 O 3 pasivación trasera
Resultados y discusión
La Figura 2a muestra la vida útil de los portadores minoritarios dependientes del nivel de inyección del Al 2 O 3 / Si / Al 2 O 3 muestras sin y con diferentes procesos de recocido. Antes del recocido, la vida útil del portador minoritario es tan baja como por debajo de 100 μs en todo el rango de niveles de inyección. La vida útil mejora enormemente después del proceso de recocido como consecuencia de la pasivación química y la pasivación por efecto de campo aportada por el Al 2 recocido. O 3 . Sin embargo, los valores de vida útil son diferentes en estas tres condiciones de recocido, en las que el recocido con oxígeno tiene la curva más baja, el recocido FG tiene la intermedia y el recocido de dos pasos tiene la más alta. Los valores de vida útil en el nivel de inyección de 3 × 10 15 cm −3 se extraen como se muestra en la Fig. 2b. El O 2 -, FG y las muestras recocidas en dos pasos tienen una vida útil de 818, 934 y 1098 μs, respectivamente. Tenga en cuenta que el recocido de dos pasos puede obtener la mayor vida útil solo con la secuencia de recocido del primer paso en O 2 y el segundo paso en FG. La secuencia inversa da como resultado una vida útil similar a la de la muestra con O 2 recocido solo. Esto podría deberse a que si se realizó primero el recocido FG, el siguiente O 2 el recocido puede causar deshidrogenación. Niwano y col. informó que para una oblea terminada por Si – H o Si – H 2 enlaces, la exposición al oxígeno da como resultado el reemplazo de los enlaces de hidrógeno con los enlaces Si – O [18].

un Vida útil del portador minoritario dependiente del nivel de inyección. b Vida útil a un nivel de inyección de 3 × 10 15 cm −3 para Al 2 O 3 / Si / Al 2 O 3 muestras con O 2 , FG y recocido en dos pasos
Como la pasivación general se rige por el efecto de campo y la pasivación química, la C - V La medición es útil para aclarar qué pasivación domina en los casos de O 2 , FG y recocido en dos pasos. La figura 3a muestra la C normalizada - V curvas para las muestras sin y con diferentes procesos de recocido. La magnitud de la pendiente de las curvas en la región de agotamiento se puede utilizar como indicador de la densidad de defectos de la interfaz ( D eso ), ya que la existencia de trampas de interfaz provoca C - V estiramiento de la curva [19]. El recocido de dos pasos da la pendiente más grande entre las demás y, por lo tanto, la D más baja eso se espera. Para obtener más información, los valores de la densidad de carga de óxido fija ( Q f ) y D eso se extraen de la C - V curvas como se traza en la Fig. 3b. El Q f es útil para evaluar la pasivación del efecto de campo y se calcula mediante [20]
$$ {Q} _f =\ frac {C _ {\ mathrm {ox}} \ left ({W} _ {\ mathrm {ms}} - {V} _ {\ mathrm {fb}} \ right)} {q \ A} $$ (1)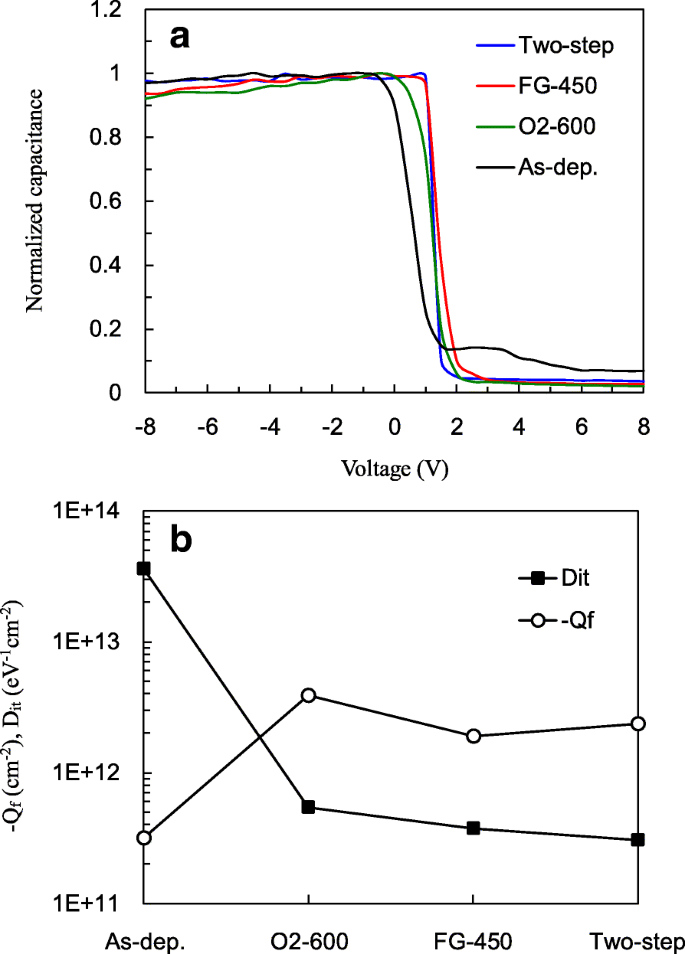
un C normalizado - V curvas. b D eso y Q f para muestras con O 2 , FG y recocido en dos pasos
donde C buey es la capacitancia de óxido de acumulación, W ms es la diferencia de función de trabajo entre el semiconductor y el electrodo (en este caso, 0,9 V), V fb es el voltaje de banda plana, q es la carga del electrón, y A es el área de los dispositivos MOS. El Q f es - 3,2 × 10 −11 cm −2 para la muestra depositada. Q f a este nivel conduce a una pasivación por efecto de campo débil [21]. Todas las muestras recocidas elevan Q f al nivel de 10 12 cm −2 . Se ve que el O 2 el recocido da el Q más alto f de 3.9 × 10 12 cm −2 , el recocido de dos pasos da el intermedio Q f , y el recocido FG da el menor Q f . Por otro lado, D eso También se muestra el valor estimado por el método Terman [22] para evaluar la pasivación química. La muestra depositada tiene una D eso de más de 10 13 eV −1 cm −2 . Se reduce a 5,4 × 10 11 eV −1 cm −2 para O 2 recocido, 3,7 × 10 11 eV −1 cm −2 para recocido FG y 3,1 × 10 11 eV −1 cm −2 para recocido en dos pasos. Por lo tanto, al comparar O 2 y recocido FG, se encuentra que O 2 el recocido tiene la mejor pasivación por efecto de campo, mientras que FG tiene la mejor pasivación química. El primero podría estar relacionado con el SiO interfacial x crecimiento. A diferencia del recocido FG que se realiza a una temperatura relativamente baja y con falta de oxígeno, O 2 Se espera que el recocido tenga un SiO x mejorado crecimiento de la capa interfacial. Esto podría aumentar la posibilidad de sustitución de Al por Si en el Al 2 O 3 / SiO 2 interfaz, que se considera un posible origen de cargas fijas negativas [23]. Teniendo en cuenta el recocido de dos pasos, el Q intermedio f es razonable como una combinación de O 2 y recocido FG. Sin embargo, su D eso El valor es menor que el del recocido FG. Esto se explica por la contribución adicional de la mayor calidad de la capa de óxido interfacial debido al primer paso O 2 recocido. Algunos estudios también informaron que un SiO x más denso da como resultado una mejor pasivación [24]. La D inferior eso en la muestra de recocido de dos pasos también se puede atribuir a la mejora de la hidrogenación de la superficie del silicio inducida por el hidrógeno en Al 2 O 3 película.
La Figura 4 muestra las imágenes TEM en sección transversal de las muestras sin y con diferentes procesos de recocido. Antes del recocido, un SiO x capa interfacial entre Si y Al 2 O 3 Se observa aunque la interfaz no es clara. Esto podría deberse a que H 2 Se utilizó O en la primera mitad del ciclo de ALD. Para O 2 recocido, el espesor de la capa interfacial aumenta a 5,6 nm, debido al recocido a una temperatura alta (600 ° C) y en ambiente de oxígeno. Se ha informado que el oxígeno tiene un coeficiente de difusión muy pequeño en Al 2 O 3 (~ 10 −38 cm −1 a 600 ° C) [25], y por lo tanto, es poco probable que el oxígeno se difunda a través del Al 2 O 3 capa para alcanzar la interfaz de Si. En cambio, el oxígeno ambiental se intercambia con el oxígeno en Al 2 O 3 , creando un oxígeno móvil que puede repetir el proceso de intercambio en el Al 2 más profundo O 3 región hasta que el oxígeno alcanza la interfaz de Si [26]. La muestra recocida en FG muestra una interfaz más clara con un SiO x muy delgado capa interfacial de 1.4 nm, que es similar a otros grupos de investigación que realizan el proceso de recocido en N 2 o FG [16]. Esto evidencia que el recocido FG limita el crecimiento de la capa interfacial. El recocido de dos pasos muestra un SiO x intermedio espesor de la capa interfacial de aproximadamente 4 nm, como consecuencia del tiempo reducido de O 2 recocido.
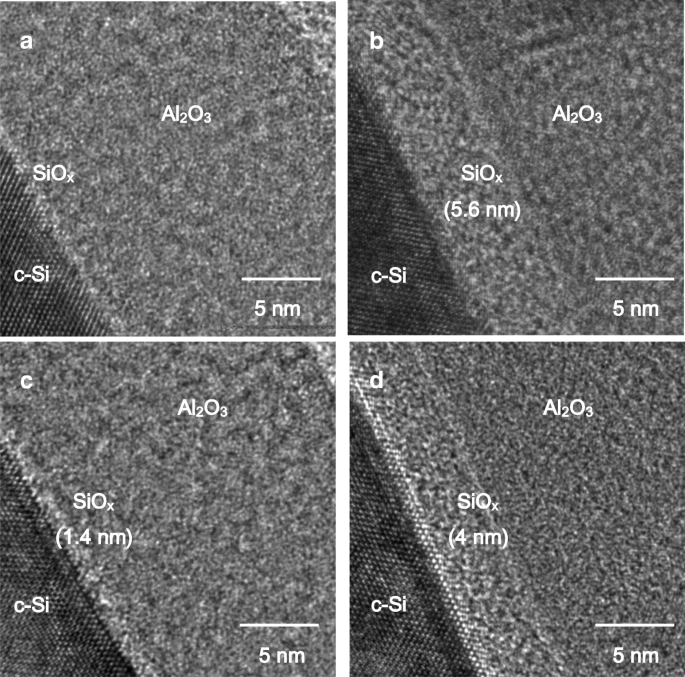
Imágenes TEM transversales para muestras a sin recocido y con b O 2 , c FG y d recocido en dos pasos
La Figura 5a muestra la vida útil del portador minoritario dependiente del nivel de inyección del SiN x / Al 2 O 3 -Obleas pasivadas sin y con diferentes procesos de recocido. La vida útil al nivel de inyección de 3 × 10 15 cm −3 son 1569, 1579 y 2072 μs para O 2 , FG y recocido en dos pasos, respectivamente. Las mejoras están relacionadas con que el SiN x depositado en fase de vapor de la sustancia química plasmática las películas pueden contener ciertas cantidades de hidrógeno dependiendo de los parámetros del proceso de deposición. Durante el proceso de recocido, parte del hidrógeno se movería hacia la interfaz de Si, y esto mejora la hidrogenación de la interfaz de Si [27]. Como se informa en la literatura [6, 28,29,30], la vida útil de SiN x / Al 2 O 3 -Las obleas CZ de tipo p pasivadas se encuentran en el rango de 0,1 a 2 ms. La temperatura óptima de recocido posterior a la deposición, ya sea en nitrógeno o en FG, es de unos 400 a 500 ° C. En este trabajo, el SiN x / Al 2 O 3 La oblea de CZ pasivada recocida en FG muestra una vida útil de 1579 μs y una temperatura de recocido óptima de 450 ° C, que están de acuerdo con los valores informados. Sin embargo, esta temperatura óptima está limitada por la hidrogenación de la interfaz de silicio. Desde el punto de vista de la capa interfacial de óxido de silicio, esta capa puede tener una temperatura óptima diferente, ya que las altas temperaturas generalmente mejoran las cualidades de las películas de óxido de silicio. Por lo tanto, el recocido de dos pasos podría optimizar tanto la calidad del óxido interfacial como la hidrogenación de la interfaz de silicio, y conduce a una vida útil más alta de 2072 μs en comparación con el caso del recocido de un solo paso de gas de formación. Para investigar la reproducibilidad, se prepararon 50 muestras con recocido en dos pasos, y su vida de portadora minoritaria se muestra en la Fig. 5b. Las muestras tienen valores de vida útil que oscilan entre 1939 y 2224 μs. El valor promedio es 2075 μs y el error está dentro de ± 7%. El límite de vida intrínseco de la oblea utilizada en este estudio es de aproximadamente 2300 μs, calculado mediante la parametrización de Richter [31]. Por lo tanto, el recocido de dos pasos produce una vida útil cercana a la limitación de la vida útil y demuestra una excelente pasivación de la interfaz. Para otros ALD, una capa interfacial de óxido de silicio entre Al 2 O 3 También se encuentra / Si, y el recocido en dos pasos debería poder mejorar la calidad de pasivación de las obleas de Si. AlO x / SiN x es necesario ya que el nitruro de silicio no solo mejora la pasivación sino que también aumenta la reflectancia trasera y protege AlO x a partir de un proceso de cocción a alta temperatura para la fabricación de PERC.

un Vida útil del portador minoritario dependiente del nivel de inyección de SiN x / Al 2 O 3 -muestras pasivadas con O 2 , FG y recocido en dos pasos. b Vida útil a un nivel de inyección de 3 × 10 15 cm −3 para 50 muestras con recocido en dos pasos
La Figura 6 muestra el voltaje de circuito abierto implícito ( V oc) para el SiN x / Al 2 O 3 -muestras pasivadas con diferentes procesos de recocido. Para obleas de tipo p y longitudes de difusión largas, la V implícita oc se puede escribir como
$$ \ mathrm {implícita} \ {V} _ {\ mathrm {oc}} =\ frac {kT} {q} \ ln \ left (\ frac {\ Delta n \ \ left ({N} _A + \ Delta n \ right)} {{n_i} ^ 2} \ right) $$ (2)
V implícito oc del SiN x / Al 2 O 3 -muestras pasivadas con O 2 , FG y recocido en dos pasos
donde k es la constante de Boltzmann, T es la temperatura absoluta, n i es la concentración de portador intrínseco, N A es la concentración de aceptor, y ∆ n es el exceso de concentración de portador medido a la intensidad de luz de un sol por el comprobador de vida útil WCT-120 Sinton. Se puede ver que el O 2 - y las muestras recocidas con FG tienen V implícito similar oc valores, que son 696 y 697 mV, respectivamente. El recocido de dos pasos tiene un V implícito oc de 706 mV.
La figura 7 muestra la J - V características y parámetros fotovoltaicos como V oc , densidad de corriente de cortocircuito ( J sc ), factor de relleno (FF) y eficiencia de conversión ( η ) de los PERC fabricados con diferentes procesos de recocido. El rendimiento de un PERC industrial también se muestra con fines comparativos. El PERC industrial se fabricó en condiciones idénticas pero no se utilizó ningún proceso de recocido adicional, ya que el Al 2 O 3 La capa se recoció durante el SiN x deposición a 400 ° C. Tenga en cuenta que en este estudio, durante los procesos de recocido, la parte frontal se colocó hacia abajo y se puso en contacto con un soporte de obleas. El SiN x frontal La capa no estuvo expuesta a los gases de recocido y, por lo tanto, la influencia del SiN x frontal La capa puede ser insignificante. El PERC de la industria muestra el V más bajo oc de 665,4 mV entre los demás. Esto podría atribuirse a su menor vida útil de la oblea de 797 μs al nivel de inyección de 3 × 10 15 cm −3 . La V oc el valor mejora a 671,3 mV para O 2 recocido y 672,3 mV para recocido FG. El recocido de dos pasos aumenta aún más V oc a 675,5 mV, lo que supone una mejora de aproximadamente un 0,6% en comparación con el recocido en un solo paso, o un 1,5% en comparación con el de la industria. No hay mucha diferencia en J sc y FF entre los PERC. El recocido de dos pasos presenta las mejores eficiencias de conversión del 21,97%, que es un 0,36% más alto que el PERC industrial. Finalmente, se fabricaron cinco PERC para cada proceso de recocido. El valor medio y el rango de distribución de V oc y FF se muestran en la Fig. 8a yb, respectivamente. Los PERC con el recocido de dos pasos muestran V oc de 675 a 677,5 mV con un valor medio de 676 mV y FF de 0,813 a 0,819 con un valor medio de 0,816.

Curvas de tensión-densidad de corriente y rendimiento fotovoltaico de PERC con fabricación estándar de la industria, O 2 recocido, recocido FG y recocido en dos pasos

Valor medio y rango de distribución de a V oc y b FF para PERC con diferentes procesos de recocido
Conclusión
El Al 2 O 3 Las películas se preparan mediante deposición de capa atómica, seguida de O 2 , FG o recocido en dos pasos. Comparando O 2 recocido con recocido FG, el primero produce un SiO x más espeso capa interfacial y el Q superior f densidad de - 3,9 × 10 12 cm −2 , lo que indica una pasivación de efecto de campo superior. El recocido FG muestra la D inferior eso de 3,7 × 10 11 eV −1 cm −2 resultante de la hidrogenación de la interfaz de Si. El recocido de dos pasos combina las ventajas de estos dos procesos de recocido y tiene un Q intermedio f y la D más baja eso de 3,1 × 10 11 eV −1 cm 2 . El SiN x / Al 2 O 3 Las muestras pasivadas con el recocido en dos pasos demuestran una vida útil de portadora minoritaria de 2072 μs, cerca del límite de vida útil intrínseco. Para el PERC fabricado con el recocido de dos pasos, V oc de 675,5 mV y una eficiencia de conversión del 21,97%, que tienen incrementos de 10 mV y 0,36% abs respectivamente respecto a los de la industria PERC.
Abreviaturas
- Al 2 O 3 :
-
Óxido de aluminio
- ALD:
-
Deposición de la capa atómica
- C - V :
-
Capacitancia-voltaje
- D eso :
-
Densidad de defectos de interfaz
- FF:
-
Factor de relleno
- FG:
-
Formación de gas
- J sc :
-
Densidad de corriente de cortocircuito
- J - V :
-
Densidad-voltaje de corriente
- MOS:
-
Semiconductor de óxido de metal
- NH 3 :
-
Amoníaco
- O 2 :
-
Oxígeno
- PERC:
-
Emisor pasivado y celda trasera
- Q f :
-
Carga de óxido fija
- SiN x :
-
Nitruro de silicio
- SiO x :
-
Óxido de silicio
- TEM:
-
Microscopio electrónico de transmisión
- TMA:
-
Trimetilaluminio
- TMS:
-
Tetrametilsilano
- V oc :
-
Voltaje de circuito abierto
- η :
-
Eficiencia de conversión
Nanomateriales
- Tecnologías avanzadas de deposición de capas atómicas para micro-LED y VCSEL
- Características de alineación interfacial, eléctrica y de banda de pilas de HfO2 / Ge con capa intermedia de SiO2 formada in situ mediante deposición de capa atómica mejorada por plasma
- Una investigación sobre una célula solar de silicio cristalino con una capa de silicio negro en la parte posterior
- Fabricación de una célula solar de silicio monocristalino eficiente al 20,19% con microestructura piramidal invertida
- Eficiencia de conversión de energía mejorada de células solares de perovskita con un material de conversión ascendente de Er3 + -Yb3 + -Li + TiO2 tri-dopado
- Influencia de nanopartículas de agricultura con diferentes tamaños y concentraciones incrustadas en una capa compacta de TiO2 en la eficiencia de conversión de las células solares de perovskita
- Propiedades fotovoltaicas mejoradas en la celda solar de heterounión plana Sb2S3 con un enfoque de selección rápida
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- Células solares sensibilizadas por colorante:fundamentos y estado actual
- Transistor semiconductor de óxido metálico de doble difusión lateral de resistencia específica ultrabaja con doble puerta mejorada y capa parcialmente enterrada en P
- Memristor flexible basado en Hf0.5Zr0.5O2 depositado en capa atómica con plasticidad sináptica a corto / largo plazo



