Análisis comparativo de defectos en capas de GaN implantadas con Mg y dopadas con Mg en sustratos de GaN independientes
Resumen
El dopaje ineficiente de tipo p inducido por Mg sigue siendo un obstáculo importante en el desarrollo de dispositivos electrónicos basados en GaN para aplicaciones de iluminación y energía de estado sólido. Este estudio reporta un análisis estructural comparativo de defectos en capas de GaN en sustratos de GaN independientes donde la incorporación de Mg se lleva a cabo a través de dos enfoques:implantación de iones y dopaje epitaxial. La microscopía electrónica de transmisión de barrido reveló la existencia de defectos piramidales y lineales solo en la muestra implantada con Mg, mientras que la muestra dopada con Mg no mostró la presencia de estos defectos, lo que sugiere que la naturaleza de los defectos depende del método de incorporación. A partir de la espectrometría de masas de iones secundarios, se observa una correspondencia directa entre las concentraciones de Mg y la ubicación y tipo de estos defectos. Nuestras investigaciones sugieren que estos defectos piramidales y lineales son especies ricas en Mg y su formación puede conducir a densidades reducidas de agujeros libres, lo que sigue siendo una preocupación importante para los materiales y dispositivos basados en p-GaN. Dado que los sustratos de GaN independientes ofrecen una plataforma para la realización de dispositivos verticales basados en uniones pn, es probable que la investigación estructural comparativa de defectos originados debido a diferentes procesos de incorporación de Mg en capas de GaN en dichos sustratos brinde más información para comprender los mecanismos de autocompensación de Mg y luego optimizar el proceso de dopaje y / o implantación de Mg para el avance de la tecnología de dispositivos basados en GaN.
Introducción
Durante las últimas tres décadas, GaN se ha convertido en uno de los semiconductores compuestos más investigados en todo el mundo. Esto se debe principalmente a su tremendo potencial no solo en aplicaciones de iluminación de estado sólido, sino también en operaciones de alta potencia, alta frecuencia y alta temperatura [1, 2, 3, 4, 5, 6, 7, 8]. Para el empleo exitoso de dispositivos basados en GaN y heteroestructuras relacionadas en tales aplicaciones y operaciones, el dopaje controlable tipo ny tipo p es el requisito clave. En este aspecto, lograr y controlar el dopaje de tipo n en depiladoras de GaN o monocristales ahora está optimizado en gran medida en comparación con su contraparte de tipo p, que sigue siendo un cuello de botella para la academia y la industria. Hasta ahora, el Mg ha demostrado ser el dopante de tipo p más eficiente a pesar de su alta energía de activación que requiere una gran cantidad de concentraciones de Mg (alrededor de 10 19 cm −3 o más) que se incorporarán para lograr concentraciones razonables de huecos libres cercanas a 10 18 cm −3 . Cualquier aumento en las concentraciones atómicas de Mg más allá de 10 19 cm −3 conducir a una disminución en la concentración del agujero libre [9,10,11]. Este fenómeno se atribuye principalmente a la creación de N vacantes [12,13,14], defectos puntuales relacionados con el Mg [10, 15] o complejos cargados o neutrales relacionados con las vacantes que reducen el nivel de Fermi y saturan el hueco libre. concentraciones [16, 17]. Sobre la base de las mediciones de fotoluminiscencia que dan lugar a un pico de 2,9 eV, un complejo de defecto del donante profundo Mg-V N También se creía que era una de las razones principales del mecanismo de autocompensación. [17,18,19]. Por lo tanto, a pesar del número de intentos de investigación significativos realizados para comprender la incorporación de Mg en GaN, este problema aún no está claro y es necesario realizar más análisis.
La mayoría de los informes anteriores sobre análisis de defectos mediante estudios microscópicos a escala atómica se basan en capas de GaN dopadas con Mg cultivadas en zafiro mediante deposición de vapor químico orgánico metálico (MOCVD) o epitaxia de haz molecular (MBE). Hasta donde sabemos, existen pocos informes sobre análisis de defectos en sustratos de GaN independientes dopados con Mg y no hay ningún informe sobre análisis de defectos basados en microscopía electrónica de transmisión en sustratos de GaN independientes en los que el Mg se incorpora mediante implantación de iones. Ahora está bien aceptado que los sustratos de GaN independientes tienen varias ventajas sobre las capas de GaN cultivadas con MOCVD / MBE sobre sustratos extraños debido al nivel reducido de densidades de dislocación y sus aplicaciones en dispositivos verticales eficientes. Es necesario explorar el logro de suficiente actividad de dopantes de tipo p en dichos sustratos mediante la implantación de iones para la comercialización y el desarrollo de dispositivos de iluminación de estado sólido y de alta potencia basados en GaN. Manteniendo todas estas cuestiones como objetivo principal, hemos llevado a cabo un análisis estructural detallado de los defectos de Mg incorporado en las capas independientes de GaN donde la incorporación de Mg se logra mediante el dopaje y la implantación de iones.
Métodos experimentales
En nuestro estudio se utilizan sustratos de n-GaN independientes cultivados mediante epitaxia en fase de vapor de hidruro. A partir de entonces, las capas epitaxiales se cultivan mediante MOCVD sobre estos sustratos. La incorporación de Mg se lleva a cabo mediante dos enfoques:implantación de iones y dopaje epitaxial. En el primer caso, el Mg se implanta en la capa epitaxial de GaN sin dopar de 4 μm de espesor sin depositar ninguna capa de protección sobre las capas de GaN no dopadas, mientras que en el segundo caso, el GaN dopado con Mg de 1 μm de espesor se hace crecer epitaxialmente en 4 μm -capas gruesas de GaN sin dopar continuamente. Para una comparación confiable, el nivel de incorporación de Mg se mantiene igual que 4 × 10 19 cm −3 en ambos casos. La implantación de Mg se lleva a cabo a 500 ° C seguido de un recocido a 1350 ° C para la activación de los dopantes. Las energías de implantación se toman como 15, 30, 55, 95 y 180 keV con dosis respectivas de 3.0 × 10 13 , 5,5 × 10 15 , 1,1 × 10 14 , 1,9 × 10 14 y 8 × 10 14 cm −2 , para obtener un perfil de caja de 200 nm de profundidad. Las mediciones de Hall se llevan a cabo para evaluar las propiedades eléctricas de las muestras de GaN tanto dopadas con Mg como implantadas con Mg. Para la muestra de GaN dopada con Mg, la concentración y la movilidad del orificio son 3,4 × 10 17 cm −3 y 9,5 cm 2 / V-s. Por otro lado, las propiedades eléctricas de la muestra implantada con Mg no pudieron evaluarse adecuadamente debido a su naturaleza altamente resistiva. La distribución de Mg en función de la profundidad se investiga usando espectrometría de masas de iones secundarios (SIMS) mientras que el análisis de microscopía electrónica de transmisión de barrido (STEM) se usa para investigaciones estructurales de defectos inducidos por Mg. Para ello, JEOL JEM-ARM200F ha llevado a cabo STEM y espectroscopia de rayos X dispersiva de energía electrónica (EDS) operada a 200 y 80 kV. Para estos estudios, las muestras de TEM se prepararon mediante molienda con haz de iones enfocado utilizando haces de Ga seguido de una molienda de iones de Ar de baja energía enfriada con nitrógeno líquido.
Resultados y discusión
Análisis de defectos en la capa de GaN implantada con Mg
La Figura 1 (a) muestra la imagen de campo brillante (BF) -STEM de GaN implantado con Mg, mientras que (b) muestra el perfil SIMS correspondiente. La flecha que se muestra en la Fig. 1 (a) representa la dirección positiva [0001], y las imágenes se ven a lo largo del eje de la zona [11 \ (\ overline {2} \) 0]. Se puede observar que los defectos no se distribuyen uniformemente en función de la profundidad, de hecho se observa una correlación directa entre las concentraciones de Mg y los defectos. La mayoría de los defectos se acumulan a unos 150 nm de la superficie donde la concentración de Mg es superior a 10 19 cm −3 como se observa en las mediciones de SIMS. Para comprender mejor los defectos y sus visualizaciones debido a la implantación de Mg en GaN, las imágenes se llevan a cabo en una condición de eje fuera de la zona inclinando la muestra 10 ° alrededor del eje c desde el eje [11 \ (\ overline {2} \) 0] . Esta condición debilita el contraste de difracción debido al cristal perfecto y mejora el contraste de los defectos, lo que permite una mejor visualización de los defectos en comparación con el entorno circundante. La imagen BF-STEM de una muestra de GaN implantada con Mg tomada bajo estas condiciones de eje fuera de la zona se muestra en la Fig. 1 (c) donde se ven algunos defectos de línea a una profundidad de aproximadamente 200 nm desde la superficie. El correspondiente perfil de Mg SIMS se presenta en (d) en escala lineal donde se observa una correspondencia directa entre la existencia de estos defectos lineales y la concentración de Mg. Estos defectos se encuentran ubicados en una región estrecha donde la concentración de Mg es aproximadamente de 10 19 cm −3 rango.
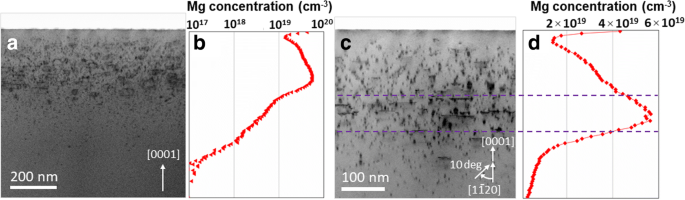
un Imagen STEM de campo brillante en sección transversal de una muestra de GaN implantada con Mg obtenida a lo largo del eje [11 \ (\ overline {2} \) 0] y b correspondiente perfil de profundidad de Mg obtenido usando SIMS. Para una mejor visualización de los defectos y su relación con la concentración de Mg, las imágenes se llevan a cabo en condiciones de eje fuera de la zona como se muestra en c . Perfil de mg correspondiente a c se muestra en d en escala lineal donde se observan defectos de línea en una región estrecha que tiene la concentración más alta de Mg
Además, la formación de imágenes BF-STEM de gran aumento se lleva a cabo en una condición de eje fuera de la zona como se muestra en la figura 2 (a), mostrando (b) la región seleccionada de (a) con un aumento mayor. Como se muestra en (b), se observan cuatro tipos de estructuras etiquetadas como A, B, C y D. Los defectos etiquetados como "A" tienen forma piramidal, mientras que "B" aparecen como defectos de línea.

un Imagen STEM de campo brillante en sección transversal de una muestra de GaN implantada con Mg obtenida en una condición de eje fuera de la zona para fortalecer los contrastes de los defectos. Vista ampliada de la región marcada en ( a ) se presenta en ( b ) donde se observan cuatro tipos diferentes de defectos etiquetados como A, B, C y D. Imagen TEM de alta resolución de los dominios piramidales etiquetados como A en ( b ) se muestra en ( c ) con representación esquemática en la parte inferior derecha. La celosía distorsionada en el dominio piramidal se representa apretando ( c ) como se muestra en ( d ). La imagen TEM de alta resolución de un defecto típico de tipo C o D se presenta en ( e ) con imagen comprimida en ( f ), que muestra el contraste del campo de deformación alrededor del defecto
Las observaciones estructurales de estos defectos son importantes desde el punto de vista de la comprensión de los mecanismos de compensación de Mg, y las siguientes secciones del manuscrito se dedican principalmente al análisis estructural de los defectos de tipo “A” y “B”. Las estructuras que se muestran como "A" son defectos piramidales con dirección positiva [0001] apuntando hacia su cabeza, su base en el plano [0001] con seis paredes en [11 \ (\ overline {2} \) 3] planos inclinados como se muestra por Imagen TEM de alta resolución de uno de estos defectos en la Fig. 2 (c). La representación esquemática de tal dominio piramidal también se muestra en la Fig. 2 (c). La figura 2 (c) se aprieta perpendicular a la dirección [0001] como se muestra en (d) donde la celosía parece estar distorsionada en el dominio piramidal en comparación con la matriz de GaN circundante, lo que indica un desplazamiento entre las subredes de Ga y N dentro y fuera de estos dominios piramidales. . Esto es consistente con los hallazgos de Vennegues et al. [20] donde se observa un tipo similar de dominios piramidales. Los defectos de forma piramidal similares se observaron anteriormente en películas de GaN dopadas con Mg y su existencia generalmente se explica por la modificación en la estructura atómica de GaN debido a la introducción de Mg [19,20,21,22,23,24]. Liliental-Weber y col. [25, 26] propuso que tales defectos piramidales se originan en grupos ricos en Mg presentes cerca de la cabeza de estas pirámides. La estructura de GaN en la fase de wurtzita se describe generalmente mediante el apilamiento hexagonal de N planos con la mitad de los N sitios de tetraedros de la subred llena por átomos de Ga. Vennegues y col. [27] sobre la base de sus investigaciones propusieron que la introducción de un nivel más alto de Mg en GaN da como resultado la sustitución de Ga por Mg, formando Mg 3 N 2 , un compuesto de Mg-N del que se ha informado que tiene estructura antibixbyita. La estructura antibixbyte de Mg 3 N 2 corresponde al llenado de los sitios de tetraedros de la subred N con Mg, que ocupa tres de cada cuatro sitios. Según el modelo propuesto por Vennegues et al. [27], un dominio piramidal puede considerarse como dos cristales de GaN de polaridad opuesta separados por una monocapa de Mg 3 N 2 . Esto está respaldado además por las investigaciones de Hansen et al. [28] donde se propuso que estos dominios piramidales fueran Mg 3 N 2 inclusiones. Vennegues y col. [27] y Leroux et al. [23] también informó que la formación de tales dominios piramidales que tienen un tamaño nanométrico también requiere una incorporación de Mg de bajo a medio 10 19 cm −3 rango. Esto es consistente con nuestros hallazgos donde los defectos de la forma piramidal se observan en valores inferiores a medios de 10 19 cm −3 Concentraciones de Mg como se ve a partir de la correlación entre la imagen STEM (Fig. 1 (c)) y el perfil SIMS correspondiente (Fig. 1 (d)). Por lo tanto, se cree que los defectos de forma piramidal etiquetados como estructuras "A" en la Fig. 2 (b) de nuestro estudio son dominios piramidales ricos en Mg y su formación puede estar directamente relacionada con el mecanismo de compensación de Mg en las capas de p-GaN. Otros tipos de defectos como se muestra en la Fig. 2 (b) son defectos de tipo "C" y "D" que son estructuras esencialmente similares con variaciones en sus dimensiones. Es probable que el contraste que parece alargarse a lo largo de la dirección [0001] cuando se ve desde el eje [11 \ (\ overline {2} \) 0] se origine en la deformación. Para aclarar aún más esto, en la figura 2 (e) se presenta una imagen TEM de alta resolución de tal defecto similar con (f) que muestra la misma imagen comprimida perpendicular a la dirección [0001]. La rejilla distorsionada a lo largo de la dirección sugiere una constante de rejilla diferente debido a un campo de deformación diferente a lo largo de esta dirección. Dado que el tamaño del Mg es más pequeño en comparación con el Ga, se espera que su incorporación en los sitios de Ga produzca tensión en la red que puede conducir a este contraste alrededor de estos defectos.
Otro tipo de defectos, etiquetados como “B” en la Fig. 2 (b), parecen ser defectos de línea perpendiculares a la dirección [0001], cuando se ven desde el eje [11 \ (\ overline {2} \) 0]. Es importante señalar que este tipo de defectos parecen acumularse en una región estrecha que tiene concentraciones más altas de Mg (como se observa en la correspondencia entre la imagen BF-STEM y el perfil Mg SIMS que se muestra en la Fig.1 (c) y (d)) que sugiere que su formación está asociada con la incorporación excesiva de Mg. Otra observación es la presencia de dominios piramidales en los bordes de estos defectos de línea que indican que la acumulación de estos dominios puede resultar en su formación. Sin embargo, no se debe descartar que podría ser simplemente una superposición aleatoria de defectos piramidales y lineales y se necesitan más investigaciones en esta dirección. La imagen BF-STEM que muestra este tipo de defectos se presenta en la Fig. 3 (a). Para una mejor comprensión de estos defectos, la muestra se inclina aproximadamente 10 ° alrededor del eje perpendicular a la dirección [0001] y la imagen BF-STEM obtenida se muestra en la Fig. 3 (b). Esta inclinación de la muestra excita fuertemente los puntos de difracción a lo largo de la dirección 1-100, lo que da como resultado un mayor contraste del campo de deformación en la dirección que rodea al defecto. A partir de este contraste de campo de deformación, el defecto que apareció como la línea (ver Fig. 2 (a) y (b)) en realidad consiste en un par de líneas separadas por unos pocos nm, más profundas en la dirección [0001].

un Imagen STEM de campo brillante en sección transversal de una muestra de GaN a granel implantada con Mg para analizar defectos de tipo B que aparecen como pirámides truncadas o forma trapezoidal. b representa la imagen tomada inclinando la muestra 10 ° alrededor del eje perpendicular a c -Eje donde se observa un contraste diferente en los bordes de estos defectos
Podría haber una posibilidad de presencia de Mg en estos defectos, ya que aparecen en la región más estrecha donde la concentración de Mg es superior a 10 19 cm −3 como se observa en la correspondencia entre la imagen STEM (Fig. 1 (c)) y el perfil de Mg SIMS (Fig. 1 (d)). Para validar esta creencia de que estos tipos de defectos tienen Mg, llevamos a cabo mediciones de microscopía electrónica de transmisión de barrido-espectroscopía de dispersión de energía (STEM-EDS) con un diámetro de sonda EDS menor de 0.2 nm, en dos regiones diferentes:"lejos del defecto" y "En el defecto" etiquetado como los puntos 1 y 2, respectivamente, como se muestra en la Fig. 4 (a). Los espectros EDS comparativos de los puntos 1 y 2 en el rango de energía de 1,19 keV a 1,35 keV donde se espera el pico de Mg se representan en la Fig. 4 (b) con un recuadro que muestra los espectros EDS completos. La presencia de Mg se ve claramente en el defecto (punto 2). Para justificar aún más esto, hemos llevado a cabo el mapeo STEM-EDS en una muestra de GaN implantada con Mg similar. La Figura 4 (c) presenta una imagen STEM de una muestra de GaN implantada con Mg con flechas hacia abajo que muestran estos defectos de línea, y el mapa EDS correspondiente de Mg se muestra en la Figura 4 (d). La presencia de Mg se ve claramente en estos defectos. Por tanto, estos defectos contienen Mg y su formación a concentraciones de Mg superiores a 10 19 cm −3 es probable que sea otra causa de compensación de Mg.

un Imagen STEM de corte transversal de una muestra de GaN implantada con Mg que muestra un defecto individual de tipo "B". Los puntos 1 y 2 representan las regiones donde se llevan a cabo las mediciones de EDS y los espectros de EDS resultantes se muestran en b . Los espectros EDS en el rango de energía de 1,19-1,40 keV se representan en b con un recuadro que muestra los espectros EDS completos con picos de Ga y N. c y d presentar la imagen STEM y el mapa de Mg correspondiente de una muestra a granel implantada con Mg similar que muestra la presencia de Mg en este tipo de defectos
Análisis de defectos en la capa de GaN dopada con Mg
A continuación, hemos llevado a cabo investigaciones estructurales en la muestra de GaN donde una capa de GaN dopado con Mg de 1 μm de espesor se hace crecer epitaxialmente en una capa epitaxial de GaN sin dopar de 4 μm de espesor. Vale la pena mencionar nuevamente que el nivel de Mg se mantiene igual, es decir, 4 × 10 19 cm −3 para una comparación significativa entre dos enfoques de incorporación de Mg:dopado epitaxialmente e implantación de iones. La Figura 5 (a) muestra una imagen BF-STEM de GaN dopado con Mg que crece epitaxialmente en sustratos de GaN independientes, visto a lo largo de [11 \ (\ overline {2} \) 0] mientras que (b) muestra el perfil de Mg en función de la profundidad de GaN obtenido usando SIMS. Tenga en cuenta que la concentración de Mg permanece casi constante en aproximadamente 4 × 10 19 cm −3 dentro del campo de visión de la Fig.5 (a) (hasta 700 nm) a diferencia del caso anterior de GaN implantado con Mg, donde se encontró que la concentración de Mg era una función de la profundidad de GaN (ver Figs.1 (a) - (d )).
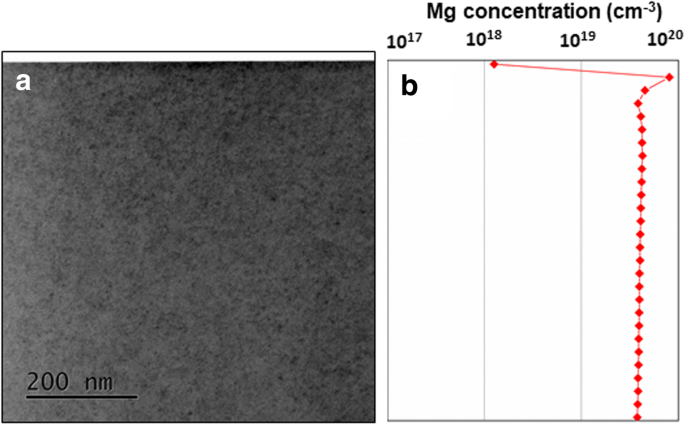
un Imagen STEM de campo claro en sección transversal de una muestra de GaN a granel dopada con Mg obtenida a lo largo del eje [112 ̅0] y b correspondiente perfil de profundidad de Mg obtenido usando SIMS. Los defectos en forma de puntos se distribuyen uniformemente en la muestra
Para llevar a cabo un análisis de defectos en una muestra de GaN dopada con Mg, imágenes STEM en condición de eje fuera de la zona inclinando la muestra a 10 ° alrededor de c -eje del eje [11 \ (\ overline {2} \) 0]. Las Figuras 6 (a) y (b) representan las imágenes BF-STEM y DF-STEM donde se observa que los defectos en forma de puntos que tienen un tamaño de aproximadamente 5 nm se distribuyen uniformemente a través de la muestra. Tenga en cuenta aquí que el perfil de Mg también parece ser uniforme en este caso, como se observa en el perfil SIMS (consulte la Fig. 5 (b)). La distribución uniforme de Mg y estos defectos en la muestra de GaN sugiere una correlación directa entre estos defectos y la incorporación de Mg. Es probable que estos defectos en forma de puntos de aproximadamente 5 nm sean precipitados de Mg (y posiblemente fallas de apilamiento inducidas por él). Debido a su pequeño tamaño, la precipitación de Mg en sí no pudo ser confirmada directamente por las mediciones de EDS (los picos de Ga y Mg se encuentran muy cerca uno del otro, lo que hace que el mapeo de pequeñas diferencias de concentración sea extremadamente difícil).
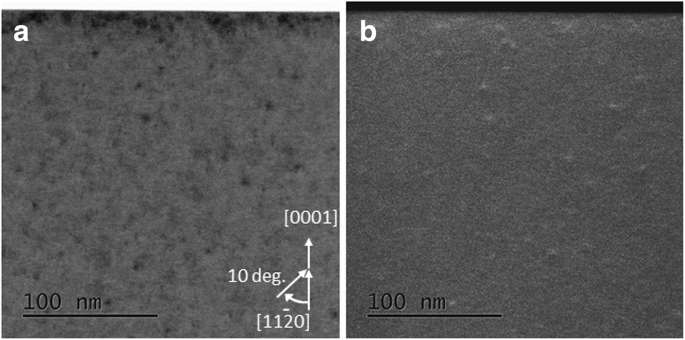
a transversal STEM-BF y b Imágenes STEM-ADF de una muestra de GaN a granel dopada con Mg obtenida en una condición de eje fuera de la zona para fortalecer los contrastes de defectos
Esta observación es completamente diferente del caso anterior de muestra implantada con Mg donde se encuentra que los defectos se acumulan a 200 nm de la superficie donde la concentración de Mg era máxima. Además, a diferencia de la muestra implantada con Mg, no observamos ningún defecto piramidal o de dos líneas (etiquetado como A y B en la Fig. 2 (b)) en la muestra de GaN dopada con Mg. Curiosamente, también se informan defectos piramidales y lineales en las muestras de GaN en las que el Mg se incorpora mediante técnicas distintas de la implantación de iones. Por ejemplo, Khromov et al. [29] informó de la existencia de defectos piramidales en muestras de GaN dopadas con Mg cultivadas por MOCVD. Sin embargo, observaron tales defectos solo en una muestra de GaN dopada más alta donde la concentración de Mg era aproximadamente ~ 5 × 10 19 cm −3 . Sin embargo, en muestras con Mg ~ 2 × 10 18 cm −3 , estos dominios piramidales no se observaron. Vennegues y col. [27] también observaron tales dominios piramidales en muestras de GaN dopadas con Mg cultivadas con MOCVD con concentraciones de Mg que se encuentran en la mitad de los 10 19 cm −3 rango. No observaron tales defectos en muestras con concentraciones de Mg inferiores a 10 19 cm −3 . En nuestro trabajo, nivel similar de Mg ~ 4 × 10 19 cm −3 se incorpora mediante implantación de iones y dopaje epitaxial para analizar la presencia de estos defectos. Estos defectos solo se observan en la muestra implantada con Mg, no en la muestra dopada con Mg, lo que sugiere que la distribución de Mg también debe considerarse para explicar su existencia. A partir de las mediciones de SIMS, se encuentra que el Mg no se distribuye uniformemente en la muestra implantada con Mg (Figuras 1 (b) y (d)) mientras que la muestra dopada con Mg mostró una distribución uniforme de Mg (Figura 5 (b)). Además, en la muestra implantada con Mg, se encontró que estos defectos existían solo en una ventana estrecha con una concentración de Mg más alta en comparación con la matriz circundante. Por lo tanto, la formación de estos defectos está relacionada con el nivel de Mg incorporado y la distribución de Mg y es probable que se formen en las regiones donde el Mg se encuentra en el rango de 10 19 cm −3 . Parece que el perfil de Mg no uniforme en la muestra implantada con Mg conduce a una distribución no uniforme de los defectos. Sin embargo, no se deben negar las posibilidades como defectos distribuidos de manera no uniforme que causan una distribución de Mg no uniforme o la dependencia del perfil de implantación de Mg de la existencia de tales defectos; por lo tanto, se necesitan más investigaciones en esta dirección. Nuestro análisis comparativo de defectos en GaN incorporado con Mg sugiere que la naturaleza y el tipo de los defectos depende del método de incorporación.
Conclusiones
Para resumir, las investigaciones estructurales basadas en microscopía electrónica de transmisión de barrido de defectos en epi-capas implantadas con Mg y dopadas con Mg en sustratos independientes de GaN revelaron que la naturaleza de los defectos depende en gran medida del método de incorporación de Mg. GaN implantado con Mg mostró la presencia de dominios piramidales apuntando hacia la dirección [0001] y defectos de dos líneas con características separadas por unos pocos nanómetros más profundas en la dirección [0001]. Se cree que los dominios piramidales son Mg 3 N 2 -basadas en estructuras, mientras que los defectos de línea también tienen Mg como se observa en la espectroscopia de dispersión de energía. Estos defectos de línea se encuentran ubicados a una profundidad de aproximadamente 200 nm de la superficie, en una región estrecha que tiene una concentración de Mg de aproximadamente 10 19 cm −3 lo que sugiere que su formación está ligada al nivel de concentración de Mg implantado. Se espera que la formación de estos defectos en GaN sobre la implantación de Mg contribuya significativamente a los mecanismos de autocompensación de Mg que conducen a un dopaje de tipo p ineficaz. Por el contrario, la muestra de GaN dopada con Mg solo mostró la presencia de defectos en forma de puntos que se encuentran distribuidos uniformemente por toda la muestra. El presente estudio que destaca la dependencia del método de incorporación de Mg y sus concentraciones en la naturaleza y el tipo de defectos puede resultar útil para elegir la cantidad apropiada de Mg que se incorporará para lograr una alta conductividad de tipo p en materiales basados en GaN para un funcionamiento eficiente del dispositivo.
Abreviaturas
- ADF:
-
Campo oscuro anular
- BF:
-
Campo brillante
- EDS:
-
Espectroscopía de dispersión de energía
- MBE:
-
Epitaxia de haz molecular
- MOCVD:
-
Deposición de vapor químico metalorgánico
- SIMS:
-
Espectrometría de masas de iones secundarios
- STEM:
-
Microscopía electrónica de transmisión de barrido
Nanomateriales
- Ejemplos de circuitos y listas de red
- Método y análisis de la corriente de malla
- 5G y GaN:el cambio de LDMOS a GaN
- 5G y GaN:innovaciones futuras
- Análisis de actina y organización de la adhesión focal en células U2OS en nanoestructuras poliméricas
- Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
- Electrohilado sobre sustratos aislantes controlando la mojabilidad y la humedad de la superficie
- Fabricación de películas delgadas de SrGe2 en sustratos Ge (100), (110) y (111)
- Un estudio de nanofibras de carbono y carbón activo como supercondensador simétrico en un electrolito acuoso:un estudio comparativo
- Morfología, estructura y propiedades ópticas de películas semiconductoras con nanoislinas GeSiSn y capas tensas
- Estudio comparativo de las propiedades electroquímicas, biomédicas y térmicas de nanomateriales naturales y sintéticos



