Grabador in situ de división de carga (CSIR) para el examen en tiempo real del efecto de carga de plasma en procesos FinFET BEOL
Resumen
Se propone y demuestra por primera vez un dispositivo novedoso para monitorear el daño inducido por el plasma en el proceso de back-end-of-line (BEOL) con capacidad de división de carga. Este nuevo registrador in situ con división de carga (CSIR) puede rastrear de forma independiente la cantidad y la polaridad de los efectos de carga de plasma durante el proceso de fabricación de circuitos avanzados de transistores de efecto de campo de aletas (FinFET). No solo revela los niveles de carga de plasma en tiempo real e in situ en las antenas, sino que también separa el efecto de carga positivo y negativo y proporciona dos lecturas independientes. A medida que las tecnologías CMOS presionan por líneas de metal más finas en el futuro, el nuevo esquema de separación de carga proporciona una herramienta poderosa para la optimización del proceso BEOL y más mejoras en la confiabilidad del dispositivo.
Antecedentes
Los procesos mejorados con plasma se utilizan ampliamente en la formación de circuitos de transistores de efecto de campo de aletas (FinFET), que se componen de muchas estructuras de alta relación de aspecto y finas líneas metálicas [1]. Durante la fabricación, el grabado y el paso de deposición para realizar estas composiciones 3D pueden provocar un estrés significativo inducido por el plasma en los dispositivos FinFET [2, 3, 4]. A medida que avanza la tecnología CMOS FinFET, el ancho de línea y el paso del metal se reducen de manera más agresiva que su altura, lo que impulsa la necesidad de formar trincheras de alta relación de aspecto definidas por líneas extremadamente finas. Inevitablemente, esto promueve la gravedad del daño inducido por plasma (PID) en los transistores, y su efecto correspondiente sobre la confiabilidad del circuito se convierte en una de las preocupaciones clave en el desarrollo de tecnologías FinFET [5, 6, 7]. En la formación de pequeños contactos, vías y líneas finas de metal, generalmente se aplica plasma de alta selectividad y potencia fuerte [8]. Además, al grabar la aleta general, la pulverización catódica de iones reactivos en la superficie de la aleta puede provocar defectos en la aleta general, críticos para las características de los transistores [9]. Con el fin de permitir puertas metálicas con aletas y estructuras densas de interconexión, las pilas metálicas complejas se utilizan con mayor frecuencia en tecnologías avanzadas de FinFET [10, 11]. Además, alta- k El dieléctrico de puerta utilizado en tecnología avanzada generalmente conduce a un mejor atrapamiento inducido por estrés después del proceso de plasma [12,13,14]. Durante la carga de plasma, la trayectoria de descarga a través de aletas estrechas y hacia el sustrato puede conducir a niveles de tensión más no uniformes en toda la oblea [15]. Se sabe que la tensión inducida por el plasma en el óxido de la puerta del transistor da como resultado una mayor degradación de la integridad dieléctrica de la puerta [16, 17].
El daño inducido por plasma en la película dieléctrica de la compuerta puede conducir a una degradación del rendimiento en escenarios de carga altamente no uniformes, incluso pérdida de rendimiento [18, 19, 20], como resultado de fallas de confiabilidad [21, 22]. Por lo tanto, en las tecnologías avanzadas de FinFET, los dispositivos de prueba con estructuras de antena agrandadas se utilizan generalmente para monitorear los efectos PID, que brindan retroalimentación para una mayor optimización del proceso.
La medida de PID más común y ampliamente utilizada es la característica de tiempo de ruptura de las muestras de prueba con grandes estructuras de antena. El daño latente en estos patrones PID se refleja típicamente midiendo la degradación dependiente del tiempo de las capas dieléctricas de la puerta, por lo tanto, no brinda la retroalimentación en tiempo real de los procesos del plasma [23]. Además, los dispositivos de prueba convencionales no pueden indicar las fuentes y la polaridad de la velocidad de carga inducida por plasma o la acumulación de potencial máxima en la antena. En nuestro estudio anterior se propuso un registrador PID con una puerta flotante acoplada por una estructura de antena con capacidad de detección in situ [24, 25]. En este trabajo, propusimos un registrador PID revisado con una función de división de carga. A través de un diodo de avance y un diodo de retroceso conectados a una estructura de antena común, el nuevo diseño proporciona rutas separadas para cargas positivas y negativas. Por lo tanto, los niveles de carga de ambas polaridades se pueden registrar de forma independiente. Este nuevo registrador in situ con división de carga (CSIR) que solo requiere antenas pequeñas permite el estudio futuro del efecto de carga de plasma en los procesos del extremo medio de la línea (MEOL).
Métodos
Polaridad de carga de plasma
Estudios anteriores informaron que, durante el proceso de grabado en la formación de capas de poli o metal, la falta de homogeneidad del plasma, así como las variaciones del potencial de la antena, pueden provocar una diferencia drástica en la velocidad de carga o incluso las polaridades pueden cambiar en diferentes ubicaciones [24, 25]. El macroambiente en la cámara de plasma y los micropatrones pueden afectar la distribución de las tasas de carga en una oblea [26]. Es decir, la velocidad de carga de plasma en el grabado de final de línea (BEOL) varía espacialmente y en el momento oportuno. Durante los procesos de plasma de radiofrecuencia (RF), la superficie de la oblea recoge la corriente de carga, J p , que se compone de una corriente de iones J i y una corriente de electrones J e [26]. La corriente de iones es casi constante con el tiempo y está determinada por la densidad de iones J i y la velocidad de Bohm [26]. Dado que el potencial plasmático V p ( t ) es mayor que el potencial de la puerta V G durante la mayor parte del tiempo, la corriente de electrones fluye solo durante los períodos cortos en los que el potencial de plasma está cerca de su mínimo. Durante Q FG proceso, el voltaje de la compuerta puede aumentar o disminuir durante muchos ciclos de RF, dependiendo de qué componente de las corrientes sea mayor, hasta que se alcance un voltaje de compuerta de estado estable cuando la corriente de túnel equilibre J p en la antena. Como se muestra en la Fig. 1, la distribución de la tasa de carga de plasma, J P ( x , años , t ), a lo largo de la oblea durante el proceso de grabado en diferentes etapas, cambios tanto en magnitud como en polaridades, donde se puede expresar como en la Ec. (1) donde J e representa la densidad de corriente de electrones y J i representa la densidad de corriente de iones.
$$ {J} _ {\ mathrm {p}} ={J} _ {\ mathrm {e}} + {J} _ {\ mathrm {i}} \ dots $$ (1)
Distribución de la velocidad de carga inducida por plasma en la línea central de la oblea durante el proceso de grabado en diferentes momentos. La polaridad de carga de plasma en una ubicación particular puede cambiar con el tiempo
Las diferentes polaridades de carga de plasma dan como resultado una carga de antena positiva o negativa, Q P , acumulados en un momento y lugar diferentes. Para aclarar, en el momento t 1 , un J negativo p conduce a una carga de antena negativa Q -. En t 2 , un J positivo p induce una carga de antena positiva Q + en la misma ubicación de la oblea, como se ilustra en la Fig. 1. Por lo tanto, la carga positiva o negativa puede acumularse en una misma antena en diferentes momentos durante el proceso de grabado. Según informes anteriores [27], los niveles máximos de J e y J i son alrededor de - 0,15 y 0,35 mA / cm 2 , respectivamente. Se ha encontrado [28, 29] que la tensión de CC y CA / compuerta bidireccional en el FinFET de canal ny canal p da como resultado diferentes daños latentes en la película dieléctrica de compuerta. Se aplican tensiones de alto voltaje con polarización de CC positiva o negativa y voltaje de CA con una frecuencia de conmutación de 0,1 Hz a las muestras de prueba FinFET convencionales, respectivamente. Como se muestra en la Fig.2, el tiempo de avería ( T BD ) de un transistor tensionado por tensión positiva, negativa y de puerta en ambas direcciones se comparan. Los resultados indican que la tensión de la puerta de CC causará un daño peor en las muestras, mientras que la tensión de la puerta de CA da como resultado un daño menos severo a estos transistores, como sugiere el T más largo. BD para muestras sometidas a estrés bidireccional. La Figura 2 también muestra que la degradación del óxido depende no solo de la polaridad de carga, sino también del tipo de pozos debajo de los transistores de canal n y canal p, lo cual se espera que sea causado por la diferencia en las rutas de descarga de estas pruebas. dispositivos durante el proceso. Por lo tanto, el detector PID convencional, que utiliza T BD ya que el indicador de la gravedad del daño no puede reflejar el nivel de carga de plasma durante el proceso. Por otro lado, el registrador de carga de plasma propuesto en nuestro trabajo anterior registra el nivel de estrés inyectando o expulsando electrones hacia / desde una puerta flotante (FG) acoplada por una antena recolectora de carga. Los datos registrados, carga de puerta flotante ( Q FG ), se lee posteriormente después de la fabricación [24, 25]. Luego, la grabación se mide mediante el cambio de voltaje de umbral en el transistor de lectura, cuyo canal es controlado y dirigido por la misma puerta flotante. El potencial elevado en la antena con Q P de la carga de plasma puede inducir un voltaje de antena tanto positivo como negativo durante la formación de una sola capa de metal. Además, para diferentes capas de metal, se utilizan diferentes parámetros de fabricación. Por ejemplo, el tiempo de grabado, el producto químico utilizado y las temperaturas de la cámara pueden variar. Estos parámetros pueden afectar la distribución de la carga de la antena a través de una oblea durante el grabado. En otros casos, un transistor con conexiones a múltiples capas de metal sujeto a secuencias de carga de plasma aún más complejas, como se ilustra en la Fig. 3a.
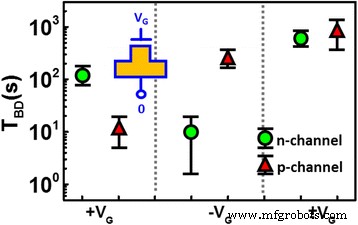
Tiempo de avería ( T BD ) de FinFET de canal ny canal p estresados por carga positiva, negativa y positiva + negativa en los electrodos de puerta. T BD de dispositivos bajo diferentes tensiones de polaridad sugiere que el daño acumulado en el dieléctrico de la puerta depende no solo de la polaridad de carga, sino también de los pozos bajo los correspondientes FinFET
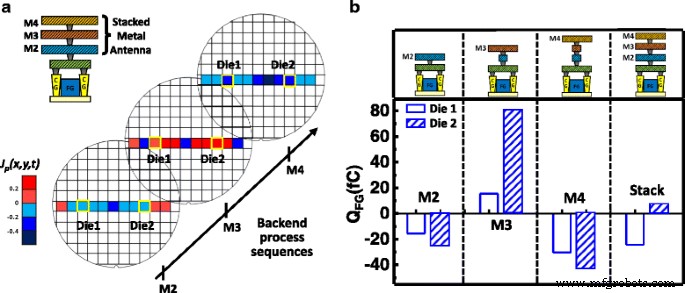
un El efecto de carga de plasma para las diferentes capas de metal varía en diferentes lugares de la oblea. b Las cargas positivas y negativas pueden compensarse entre sí en las capas de metal apiladas
En diferentes etapas del proceso BEOL, la corriente de carga de plasma en una antena particular puede cambiar entre corriente de iones y electrones, es decir, la red Q P también puede pasar de positivo a negativo. Las grabaciones de muestras con antena que constan de metal 2, metal 3, metal 4 y múltiples capas de metal se resumen en la Fig. 3b. Los datos sugieren la carga neta de una sola capa de metal [24] en un cambio de polaridad particular de una capa a otra. Además, el efecto de promedio encontrado en el Q FG de las muestras con estructuras de antena de múltiples capas metálicas está respaldado además por los datos medidos en la Fig. 3b. Con V positivo y negativo G en la antena, el Q final FG luego se promediará mediante inyección de electrones y expulsión hacia / desde la FG, lo que puede ocurrir secuencialmente. Este efecto de compensación limitará el registrador para revelar las condiciones de estrés reales que experimenta un dispositivo durante los procesos de plasma. El CSIR revisado está diseñado para abordar el problema de cómo registrar individualmente los efectos de carga positivos y negativos sin interferencias y para proporcionar datos más detallados sobre la situación de carga en la cámara de plasma.
Patrón de prueba para separación de cargas
En esta investigación, la carga de iones positivos y la carga de electrones negativos en la antena se pueden separar con un nuevo registrador in situ de división de carga (CSIR) propuesto, como se ilustra en la Fig. 4a. Un CSIR consta de dos puertas flotantes, FG 1 y FG 2 que registran los diferentes tipos de efecto de carga por separado. La estructura de la antena se conecta a las dos puertas de acoplamiento a través de un diodo de avance (D1) y un diodo de retroceso (D2), respectivamente. En la mitad izquierda de la estructura, las cargas positivas fluirán hacia la puerta de acoplamiento 1 (CG 1 ) hasta D1. Cuando CG 1 tiene carga positiva, el voltaje se acopla a la puerta flotante a través de las ranuras de contacto en ambos lados. La puerta flotante se cargará negativamente a medida que los electrones se inyectan desde el sustrato. La mitad derecha de la estructura, por otro lado, es la ruta de carga negativa, lo que permite que la corriente fluya desde la antena hacia la puerta de acoplamiento 2 (CG 2 ) a D2, lo que resulta en Q positivo FG . La Figura 4b muestra además la vista en sección transversal del CSIR con diodos pn en el chip, dirigiendo las rutas de carga positiva y negativa a las puertas de acoplamiento separadas, CG 1 y CG 2 , que acoplan el potencial de la antena al FG 1 y el FG 2 , respectivamente.
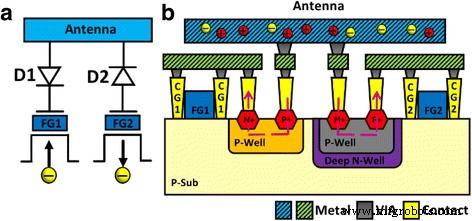
un Cargue el registrador in situ con división de carga con dos compuertas flotantes separadas mediante la conexión a un diodo de avance (D1) y un diodo de retroceso (D2) para detectar la carga de electrones / iones, respectivamente. b Ilustración de la sección transversal del nuevo registrador in situ de división de carga con diodos pn en el chip, que dirige la carga positiva y negativa a las puertas de acoplamiento separadas, CG 1 y CG 2
Cuando la mitad izquierda de la grabadora está habilitada en el CSIR bajo una antena cargada positivamente, la mitad derecha está inactiva ya que la carga está bloqueada por el diodo inverso y viceversa. Ambos diodos en chip están compuestos por n + / p-well. Para D2, para mantener un voltaje negativo en su pocillo p, la región p debe estar rodeada por un pozo n profundo, bloqueando la ruta de carga directamente al sustrato. La distribución de potencial simulada en la sección transversal en un CSIR bajo períodos de carga positivos y negativos de la antena se muestra en la Fig. 5a yb, respectivamente. Suponiendo que el potencial en una antena alcanza los 5 V, a través del diodo de la izquierda, la carga positiva fluye hacia la puerta de control de la izquierda, lo que da como resultado un voltaje positivo alto ( V CG1 ). Al mismo tiempo, la carga positiva es bloqueada por el diodo de la derecha, lo que resulta en un V cercano a cero. CG2 . La diferencia de potencial en las dos puertas de control se verifica mediante los contornos de potencial simulados en la Fig. 5a. El efecto de la carga negativa en la antena se muestra en la Fig. 5b. Los perfiles de potencial simulados verifican que los diodos pn en el chip pueden dirigir y bloquear de manera efectiva el potencial a CG 1 y CG 2 , complementariamente, como se diseñó. De esta manera, los efectos de carga positivos y negativos correspondientes a diferentes fuentes en los tratamientos con plasma se pueden obtener de forma independiente, evitando la compensación de carga y problemas de interferencia en el detector.

Distribución de potencial simulada en CSIR con voltaje de puerta de antena positivo y negativo. Los diodos pn de avance y retroceso separan con éxito la polaridad de carga de la antena
Resultados y discusión
El cambio de voltaje de umbral medido (Δ V T ) en el dispositivo controlado por FG 1 con diodo delantero y el de FG 2 con diodo inverso y las muestras sin diodo se comparan en la Fig. 6. Los datos a lo largo de la línea central de una oblea revelan que un registrador con una sola puerta flotante está sujeto a neutralización de carga incluso dentro del procesamiento de una sola capa de metal. El efecto promedio de una grabadora sin diodo demuestra que las tasas de carga máximas no se reflejarán de manera veraz. Por otro lado, las lecturas del nuevo CSIR pueden proporcionar niveles de carga positivos y negativos, de forma independiente. Para investigar más a fondo el efecto de carga de plasma en la formación del metal 2 (M2), la carga recolectada en FG 1 y FG 2 del CSIR de cada matriz se puede calcular de forma independiente mediante la Ec. (2),
$$ {Q} _ {\ mathrm {FG}} ={C} _ {\ mathrm {T}} \ times \ Delta {V} _ {\ mathrm {T}} \ times {\ alpha} _ {\ mathrm {RG}} \ puntos $$ (2)donde Q FG es la carga en la puerta flotante. C T es la capacitancia total de la puerta flotante, como se ilustra en la Fig. 7. Δ V T es el cambio de voltaje de umbral detectado en la puerta de lectura del registrador, mientras que α RG es la relación de acoplamiento de la puerta de lectura.
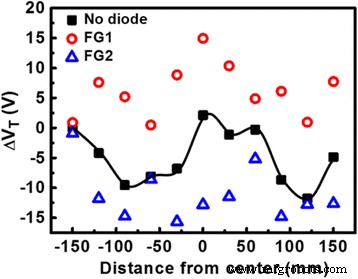
Distribución de delta V T en FG 1 con diodo directo y FG 2 con diodo inverso y FG sin diodo a lo largo de la línea central de una oblea
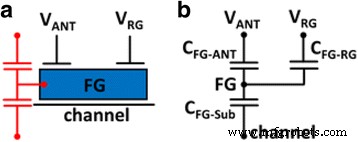
un El diagrama esquemático de un modelo de red de capacitancia en un dispositivo CSIR. b La capacitancia total de la puerta flotante son todas las capacitancias mencionadas en serie más las que están en paralelo
Cuando la carga de la puerta flotante es inicialmente cero y Q FG alcanza el nivel saturado cuando el campo eléctrico a través de la capa dieléctrica de la puerta se reduce a cero, el potencial final de la puerta de la antena al final de un proceso de plasma se puede expresar de la siguiente manera,
$$ {V} _ {\ mathrm {ANT}} =\ frac {V _ {\ mathrm {FB}} - \ frac {Q _ {\ mathrm {FG}}} {C _ {\ mathrm {T}}}} { \ alpha _ {\ mathrm {ANT}}} \ dots $$ (3)en el cual, V HORMIGA es el potencial de puerta de antena por carga de plasma y α HORMIGA representa la relación de acoplamiento a la puerta flotante desde la puerta de la antena. V FB es el voltaje de banda plana desde la puerta de metal hasta el sustrato de la aleta. Bajo un tiempo de proceso dado, la densidad de corriente de carga de plasma promedio, J p luego se puede proyectar mediante la ecuación. (4).
$$ {J} _ {\ mathrm {p}} =\ frac {V _ {\ mathrm {ANT}} \ times {C} _ {\ mathrm {ANT}}} {A _ {\ mathrm {ANT}} \ times \ Delta t} \ dots $$ (4)donde Δ t es la duración de un proceso de plasma [28, 29] y C HORMIGA es la capacitancia total de la antena metálica, mientras que A HORMIGA es el área de carga de una antena. Todos los parámetros utilizados en los cálculos anteriores se resumen en la Tabla 1.
La distribución de las tasas de carga positivas y negativas a través de una oblea durante el procesamiento de las capas superior (metal 9) e inferior (metal 2) se compara con más detalle en la Fig. 8. Implica que la carga en la estructura de la antena es más prominente en la parte superior del metal. niveles (metal 9), porque en el metal 9, su mayor energía plasmática provoca J p ser mayor que J p del metal 2 en términos de magnitud. Además, los datos sugieren que las tasas de carga de electrones e iones alcanzan un pico alrededor del centro en ambos casos. Como era de esperar, las matrices cerradas en el centro de la oblea experimentan un alto nivel de carga, lo que puede atribuirse a la ruta de descarga más larga durante el tratamiento con plasma. Se encuentra que este efecto de ubicación es idéntico para condiciones dominantes de carga de más electrones e iones. La tasa de carga de plasma proyectada, J P ( x, y ), promediado sobre la formación de una sola capa de metal, metal 2 (M2) y metal 9 (M9), se comparan más en la Fig. 9. Estos mapas de obleas revelan que la tasa de carga de electrones parece estar en una meseta excepto en el borde , mientras que las tasas de carga de iones mostraron una mayor variación en la sección media de la oblea. En el futuro, se espera que estos mapas de obleas en diferentes condiciones de procesamiento proporcionen información sobre la cámara de plasma o pautas de optimización adicionales al compensar mejor los efectos de carga.

Comparación de la tasa de carga positiva y negativa en la línea central de una oblea para procesos de metal 2 y metal 9. Las tasas de carga alcanzan su punto máximo alrededor del centro, lo que significa que el daño inducido por el plasma es más severo en el centro de la oblea

La tasa de carga de iones y electrones proyectada, J e ( x , años ) y J i ( x , años ) se obtienen mediante los registradores de división de carga a través de la superficie de grabado durante la formación de metal 2 metal 9
Efecto de relación de antena
Los dispositivos de monitoreo de PID tradicionales generalmente están diseñados para amplificar el efecto PID conectando las puertas del transistor directamente a una antena grande, evaluando los niveles de estrés mediante el aumento del Q total. P se espera que se descargue a través de una pequeña región de canal [30, 31]. La relación de antena (AR) es proporcional a la densidad de corriente de tensión a través del dieléctrico de la puerta durante los procesos de plasma [32]. Grande Q P en la antena se sabe que induce daños latentes y / o trampas en la capa dieléctrica, que en última instancia conducen a una degradación de la fiabilidad [33]. Como se esperaba, una AR más alta en los FinFET convencionales eleva significativamente los niveles de estrés, lo que provoca una T BD más severa degradación, es decir, falla del dispositivo dentro de un período de funcionamiento más corto, ver Fig. 10. Por otro lado, en un CSIR, el nivel de carga de plasma registrado como la carga de la puerta flotante, Q FG , muestra muy poco efecto de antena. Es decir, no responde al aumento del área de la antena, como lo revelan los datos resumidos en la Fig. 11.

un Las características del tiempo de avería I G en comparación con el tiempo de los detectores PID convencionales con el aumento del tamaño de la antena. b T BD disminuye drásticamente cuando AR excede 1000
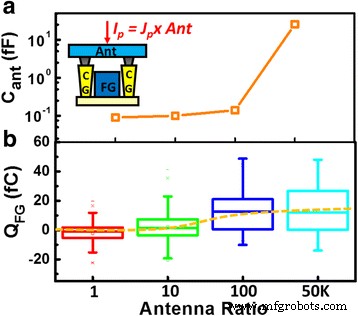
un A medida que aumenta la capacitancia de la antena, V CG se vuelve independiente del AR. b Q FG se satura cuando el AR excede 100 ×
En el nuevo CSIR basado en puertas flotantes, la relación de antena (AR) afectará el potencial máximo en las puertas de acoplamiento durante la carga de plasma. En tecnologías escaladas, se espera que las capacitancias parásitas en la estructura de conexión y acoplamiento se reduzcan, lo que lleva a una menor sensibilidad AR en los resultados de la grabación. Las razones para llevar a una diferencia tan obvia en el efecto AR entre CSIR y detectores convencionales son las siguientes. En estos registradores de puerta flotante, la carga acumulada en la antena, Q P no se descargará a través del área del canal. Aumento de Q P eleva V CG , lo que lleva a la inyección o expulsión de electrones hacia / desde las compuertas flotantes. Como se muestra en la capacitancia simulada en la Fig. 11a, la capacitancia de la antena, C hormiga , aumenta proporcionalmente al área de la antena, A hormiga . Con la corriente de carga total directamente proporcional al área de la antena, el aumento de AR en un CSIR no afectará el potencial de la antena. Los datos de medición revelan que el Q FG el nivel sigue siendo aproximadamente el mismo para SCIR con AR superior a 100 ×.
Esta función no solo guarda el área del patrón de prueba, sino que también permite encontrar J P ( x , años ) con mayor resolución espacial para estudiar el efecto de patrón en PID. Además, un detector con antena pequeña puede facilitar el diseño de patrones de prueba para comprender el PID en el extremo medio de la línea (MEOL) y los procesos de contacto.
Finalmente, el resumen del rendimiento del nuevo CSIR para monitorear PID en el proceso BEOL FinFET avanzado se resume en la Tabla 2. El rango de detección del detector tradicional es AR, mientras que el rango de detección del nuevo registrador in situ se basa en la longitud de la puerta flotante. Además, el área del nuevo registrador in situ puede ser muy pequeña. Más importante aún, el nuevo CSIR puede proporcionar la retroalimentación en tiempo real del proceso de plasma y niveles separados de carga de iones y velocidad de carga de electrones, de forma independiente.
Conclusiones
Se propone y demuestra por primera vez un nuevo registrador in situ de división de carga (CSIR) para monitorear el daño inducido por el plasma. El CSIR proporciona una herramienta poderosa para comprender la carga de electrones y las tasas de carga de iones en una cámara de plasma simultáneamente. Los mapas de obleas pueden facilitar el estudio adicional entre la correlación con la confiabilidad del dispositivo y estos efectos de carga individuales.
Historial de cambios
Nanomateriales
- Pez cebra:un sistema modelo en tiempo real prometedor para la administración de fármacos neuroespecíficos mediada por nanotecnología
- Dopaje sustitutivo para aluminosilicato mineral y rendimiento superior de separación de agua
- Nanopartículas de quitosano cargadas con genisteína y bioflavonoides dirigidas al receptor de folato para un efecto anticancerígeno mejorado en los cánceres de cuello uterino
- El efecto del plasma de no equilibrio por contacto sobre las propiedades estructurales y magnéticas de Mn Х Fe3 - X О4 Espinelas
- Efecto del tratamiento de recocido in situ sobre la movilidad y morfología de transistores de efecto de campo orgánico basados en TIPS-pentaceno
- Síntesis in situ de nanopartículas bimetálicas de tungsteno-cobre mediante plasma térmico de radiofrecuencia (RF) reactiva
- Deposición precisa in situ asistida por campo eléctrico de nanofibras de γ-Fe2O3 / poliuretano electrohiladas para hipertermia magnética
- Mallas fibrosas a base de yodo con electrohilado in situ para apósitos antibacterianos para heridas
- Un nanogenerador triboeléctrico portátil para el monitoreo de la respiración en tiempo real
- Dispositivo sináptico de captura de carga ReS2 para la aplicación de reconocimiento facial
- Diseño de patrón de prueba para daño inducido por plasma en dieléctrico inter-metálico en procesos FinFET Cu BEOL



