Análisis de reflectancia infrarroja de capas de GaN dopadas de tipo n epitaxiales cultivadas en zafiro
Resumen
La espectroscopia de reflectancia infrarroja (IR) se aplica para estudiar la multicapa dopada con Si n + / n 0 / n + -Estructura de GaN cultivada en tampón de GaN con plantilla de GaN / sustrato de zafiro. El análisis de la estructura investigada mediante métodos de fotograbado, SEM y SIMS mostró la existencia de la capa adicional con la diferencia drástica en los niveles de dopaje de Si y O y ubicada entre el tampón de GaN epitaxial y la plantilla. La simulación de los espectros de reflectividad experimental se realizó en una amplia gama de frecuencias. Se muestra que el modelado del espectro de reflectancia IR utilizando el método de matriz de transferencia 2 × 2 y la inclusión en el análisis de la capa adicional permiten obtener el mejor ajuste del espectro experimental, que sigue en la evaluación de los espesores de capa de GaN que están en buen estado. acuerdo con los datos SEM y SIMS. La dependencia espectral de los modos acoplados plasmón-LO-fonón para cada capa de GaN se obtiene a partir de la dependencia espectral del dieléctrico de la impureza de dopaje de Si, que se atribuye a los efectos de compensación de los estados aceptores.
Antecedentes
En los últimos años, ha habido un gran interés en los materiales de nitruro III, en particular en GaN [1, 2]. Debido al avance en las técnicas de crecimiento, las películas epitaxiales de GaN han encontrado una amplia aplicación en dispositivos optoelectrónicos como diodos emisores de luz azul y ultravioleta (LED) [3], láseres [4] y dispositivos microelectrónicos, p. por ejemplo, transistores de efecto de campo de alta potencia y alta frecuencia [5, 6]. La concentración y la movilidad de los portadores libres son los parámetros clave que determinan el rendimiento del dispositivo en las aplicaciones. La medición Hall de la concentración y la movilidad de los portadores libres en estructuras de dispositivos multicapa basadas en GaN no es una tarea tecnológica trivial y que requiere mucho tiempo que requiere contactos óhmicos conectados a cada capa de medición y procedimientos de medición dedicados.
La espectroscopia de reflectancia infrarroja (IR) por transformada de Fourier y la espectroscopia Raman son métodos sin contacto y no destructivos que permiten estudiar no solo las vibraciones del fonón sino también caracterizar las propiedades del portador [7]. Sin embargo, el problema conocido de la espectroscopia confocal micro-Raman es un deterioro en la resolución espacial profunda debido a la refracción de la luz [8]. Se mostró en la ref. [6] que en el barrido en profundidad de la estructura de GaN multicapa con una longitud de onda de excitación de 488,0 nm, la resolución en profundidad es de solo 1,8 μm, mientras que la resolución lateral es de 210 nm. La espectroscopia IR supera este problema debido a la alta sensibilidad al grosor de la capa debido a los efectos de interferencia y al impacto de la dispersión del índice de refracción en un amplio rango espectral.
Los espectros de reflectancia IR de películas delgadas de GaN fueron investigados ya en 1973 por A.S. Baker [9], pero la falta de homogeneidad espacial y la baja calidad estructural general de tales películas limitaron significativamente la aplicación práctica de los resultados obtenidos. No obstante, se demostró la posibilidad de determinar los parámetros de los fonones ópticos y la absorción de portadores libres en películas delgadas de GaN. Los estudios detallados del fonón óptico longitudinal - Perlin et al. [10] utilizando espectroscopía Raman y por Shubert et al. [11] utilizando elipsometría de infrarrojos. El efecto de diferentes sustratos sobre las propiedades ópticas de las películas de GaN cúbico y de wurtzita también se ha estudiado en detalle [12, 13]. Teniendo en cuenta la falta de sustratos de GaN nativos, se demostró que el uso de sustratos de zafiro para el crecimiento epitaxial de la película de GaN es óptimo para su explotación en dispositivos que operan a altas temperaturas. Los estudios de espectroscopía de reflexión IR de zafiro hexagonal [14] mostraron un espectro complejo, cuya forma depende en gran medida de la polarización y el ángulo de incidencia. Esto complica enormemente las mediciones y la determinación de las características espectrales de los modos de fonón y las propiedades de los portadores libres en una película delgada de GaN cultivada en sustratos de zafiro.
Por lo tanto, la selección adecuada del algoritmo de análisis espectral y la forma de la función dieléctrica son de gran importancia para el análisis de los espectros de reflectancia IR de estructuras multicapa de GaN sobre zafiro [15,16,17]. Este artículo muestra una posibilidad de aplicación de la espectroscopia de reflectancia IR y el método de matriz de transferencia 2 × 2 para el análisis de estructuras planas multicapa basadas en GaN con profundidad no uniforme y perfiles de dopaje, que en la práctica pueden ser de diferente tipo de semiconductor III-nitruro- estructuras de dispositivos basadas en diseño vertical, como diodos rectificadores y emisores de luz, diodos Gunn, transistores de alta movilidad de electrones (HEMT), etc.
Métodos
Experimental
Los n + investigados / n 0 / n + -Las estructuras de GaN se cultivaron en plantillas de MOCVD GaN en Al 2 O 3 (0001) sustratos a una temperatura de 800 ° C mediante epitaxia de haz molecular asistida por plasma utilizando un N 2 caudal de 0,5 sccm y una potencia de plasma de RF de 350 W (Fig. 1). Esto da como resultado una tasa de crecimiento de ∼ 0,27 ML s −1 . En primer lugar, se cultivó un tampón de GaN de 0,3 μm de espesor en una plantilla de GaN de MOCVD. Una capa de GaN dopado con Si de 0,8 μm de espesor fue seguida por una capa de GaN sin dopar de 1,75 μm de espesor y una capa de GaN dopado con Si de 0,4 μm de espesor (Fig. 1). La concentración nominal de dopaje de Si del n + -GaN capas era ∼ 10 19 cm −3 .
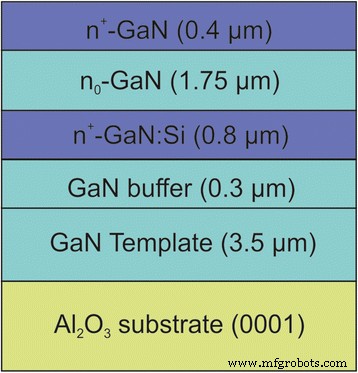
Esquema del n + investigado / n 0 / n + -Estructura de GaN cultivada en plantilla de GaN / sustrato de zafiro (0001)
Para examinar las áreas de diferente concentración de portador, el borde cortado de la estructura investigada se examinó mediante el método de fotograbado en una configuración sin electricidad utilizando K 2 S 2 O 8 –Solución acuosa de KOH (sistema de grabado KSO-D) [18]. Este método permite revelar las áreas de diferente concentración de portador y visualizar las diferencias relativas de concentración de portador midiendo la tasa de grabado utilizando perfiles de superficie [19, 20]. Se fotograbó la sección transversal de la muestra investigada durante 3 min. Posteriormente, las muestras se examinaron mediante microscopía electrónica de barrido (SEM).
Los estudios de espectroscopía de masas de iones secundarios (SIMS) de las muestras se realizaron en un sistema CAMECA IMS6F utilizando un cesio (Cs + ) haz primario, con la corriente mantenida a 400 nA para encontrar el perfil de concentración de impurezas. El tamaño del ráster era de aproximadamente 50 × 50 μm 2 , y los iones secundarios se recolectaron de una región central de 30 µm de diámetro. Para H, C, O y Si, las concentraciones se derivaron de las especies H–, O–, C–, Si–, respectivamente, y la señal de la matriz Ga– se tomó como referencia.
Las mediciones de espectroscopía de reflectancia infrarroja en el rango espectral de 300 a 4000 cm −1 con la resolución espectral de 1 cm −1 se realizaron a temperatura ambiente utilizando un espectrómetro Bruker Vertex 70 V FTIR equipado con una fuente Globar y un detector de sulfato de triglicina deuterado (DLaTGS) con ventana de polietileno. El ángulo de incidencia fue de 11 °. S Los espectros polarizados se midieron utilizando un polarizador KRS-5. Se utilizó como referencia el espectro de reflectancia de un espejo dorado.
Descripción del modelo de análisis óptico
La reflectancia del sistema de capas / sustrato se calculó utilizando el método de matriz de transferencia 2 × 2 [17, 21] en el que se puede incluir un número arbitrario de capas y los efectos de interferencia dentro de las películas se consideran automáticamente. El método de matriz de transferencia 2 × 2 para sistemas de capas isotrópicas permite un cálculo independiente de s - y p -espectros de reflexión y transmitancia polarizados en el caso de sistemas estratificados constituidos por placas isotrópicas biaxiales o uniaxiales homogéneas que tienen su eje c alineado con el eje z de las coordenadas de laboratorio. En este caso, la matriz de transferencia del sistema de 2 × 2 capas se puede representar en la siguiente vista [21]:
$$ {\ left (\ begin {array} {c} \ hfill {E} _0 ^ {+} \ hfill \\ {} \ hfill {E} _0 ^ {-} \ hfill \ end {array} \ right) } _ {s / p} =\ frac {1} {t_ {0,1} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill 1 \ hfill &\ hfill - {r} _ {1,0} ^ {s / p} \ hfill \\ {} \ hfill {r} _ {1,0} ^ {s / p} \ hfill &\ hfill 1 \ hfill \ end {array} \ right ) {\ Displaystyle \ prod_ {l =1} ^ N {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} {\ left (\ begin {array} {c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {matriz } \ right)} _ {s / p}} ={\ left (\ begin {array} {cc} \ hfill {T} _ {11} \ hfill &\ hfill {T} _ {12} \ hfill \\ {} \ hfill {T} _ {21} \ hfill &\ hfill {T} _ {22} \ hfill \ end {array} \ right)} _ {s / p} {\ left (\ begin {array} { c} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {+} \ hfill \\ {} \ hfill {E ^ {\ prime}} _ {N + 1} ^ {-} \ hfill \ end {matriz} \ right)} _ {s / p}. $$ (1)Los asteriscos en los índices superiores de amplitud de campo en el medio de salida se utilizan en Eq. (1) para tener en cuenta los valores de los componentes del campo eléctrico justo en el lado derecho de la N / N + 1 interfaz.
La matriz de transferencia \ (2 \ times 2 \ kern0.24em {T} _ {l, \ left (l + 1 \ right)} ^ {s / p} \) explica la propagación de ondas planas desde l -ésima capa, múltiples reflejos dentro de esta capa e influencia de l / (l + 1) interfaz. Dicha matriz se puede determinar como [17]:
$$ {T} _ {l / \ left (l + 1 \ right)} ^ {s / p} =\ frac {1} {t_ {l / \ left (l + 1 \ right)} ^ {s / p}} \ left (\ begin {array} {cc} \ hfill \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill - {r} _ {l + 1 , l} ^ {s / p} \ exp \ left (i {\ delta} _l ^ {s / p} \ right) \ hfill \\ {} \ hfill {r} _ {l, l + 1} ^ { s / p} \ exp \ left (-i {\ delta} _l ^ {s / p} \ right) \ hfill &\ hfill \ exp \ left (-i {\ delta} _l ^ {s / p} \ right ) \ hfill \ end {matriz} \ right), $$ (2)donde \ ({r} _ {l, l + 1} ^ {s / p} \) y \ ({t} _ {l, l + 1} ^ {s / p} \) denotan coeficientes de transmisión y reflexión parcial para l / (l + 1) interfaz, \ ({\ delta} _l ^ {s / p} \) es el cambio de fase, impuesto a la luz después de la propagación por l- la capa para s - y p -luz polarizada.
Cambio de fase para s - y p -luz polarizada después de pasar por el l- La capa se puede determinar como [17]:
$$ {\ delta} _l ^ {s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _ {l, s / p} \ cos {\ theta} _ {l, s / p} =\ frac {2 \ pi {d} _l} {\ lambda} {n} _l \ sqrt {1 - {\ left (\ frac {1} {n_ {l, s / p}} \ sin \ theta \ right)} ^ 2}, $$ (3)donde n l es el índice de refracción complejo para el l- a capa, d l es el grosor del l- la capa y θ es el ángulo de incidencia.
Coeficientes de reflexión y transmisión parciales para s - y p -Las polarizaciones se pueden calcular utilizando ecuaciones de Fresnel. Por ejemplo, coeficientes de transmisión y reflexión parcial para s -polarización tiene la siguiente forma [21]:
$$ \ begin {array} {l} {r} _ {l, l + 1} ^ s =\ frac {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ left ( l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} {n_ {ls} \ cos {\ theta} _ {ls} - {n} _ {\ izquierda (l + 1 \ derecha) s} \ cos {\ theta} _ {\ izquierda (l + 1 \ derecha) s}} \\ {} {t} _ {l, l + 1} ^ s =\ frac {2 {n} _ {ls} \ cos {\ theta} _ {ls}} {n_ {ls} \ cos {\ theta} _ {ls} + {n} _ {\ left (l + 1 \ right) s} \ cos {\ theta} _ {\ left (l + 1 \ right) s}} \ end {matriz} $$ (4)Las relaciones complejas de reflectancia de la pila multicapa se pueden obtener sustituyendo los coeficientes de transmisión y reflexión parcial por N + 1 interfaz (ecuaciones (4)) en la ecuación. (1) y cambios de fase de todos los N capas (ecuación (3)):
$$ {R} _ {s / p} ={\ left | {r} _ {0, N + 1} ^ {s / p} \ right |} ^ 2 ={\ left | \ frac {T_ {21 }} {T_ {11}} \ right |} ^ 2. $$Modelo de función dieléctrica de infrarrojos
El índice de refracción depende de la función dieléctrica compleja ε ( ω ), que se puede escribir como:
$$ \ varepsilon \ left (\ omega \ right) ={\ varepsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) + {\ varepsilon} ^ {\ mathrm {fc}} \ left (\ omega \ derecha). $$ (5)El primer término corresponde a la contribución de la dispersión en modo reticular y el segundo a las excitaciones de portadora libre.
La contribución de los modos de celosía a la respuesta IR ε lat ( ω ) en phonon energy ℏω se puede describir usando un modelo factorizado con ampliación Lorentziana [22]:
$$ {\ varepsilon} ^ {\ mathrm {lat}} \ left (\ omega \ right) ={\ varepsilon} _ {\ infty} {\ displaystyle \ prod_ {k =1} ^ M \ frac {\ omega_ { \ mathrm {LO} k} ^ 2 - {\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {LO} k}} {\ omega _ {\ mathrm {TO} k} ^ 2 - {\ omega} ^ 2-i \ omega {\ gamma} _ {\ mathrm {TO} k}}}, $$ (6)donde M es el número de modos de fonones polares activos por infrarrojos para s - o p -polarizaciones al c- eje; ω LOk y ω TOk son la frecuencia (cm −1 ) del k- th LO y TO phonon; γ LOk y γ TOk son sus constantes de amortiguación (cm −1 ). Para GaN, los parámetros ω LOk y ω TOk cuenta para el E 1 (LO), A 1 (LO) y E 1 (TO) y A 1 (TO) modos vibracionales [23].
La contribución de las especies portadoras libres ε fc ( ω ) a la función dieléctrica se puede describir utilizando la aproximación clásica de Drude [15]:
$$ {\ varepsilon} ^ {\ mathrm {fc}} \ left (\ omega \ right) =- {\ varepsilon} _ {\ infty} \ frac {\ omega_p ^ 2} {\ omega \ left (\ omega + i {\ gamma} _p \ right)}, $$ (7)con
$$ {\ omega} _p ={\ left (\ frac {N {e} ^ 2} {\ varepsilon _ {\ infty} {\ varepsilon} _0 {m} ^ {\ ast}} \ right)} ^ {1 / 2} $$ (8) $$ {\ gamma} _p =\ frac {e} {m ^ {\ ast} \ mu} $$ (9)Las frecuencias de plasma examinadas ω p (Ec. (8)) dependen de la concentración de portador libre N , permitividad dieléctrica de alta frecuencia ε ∞ y la masa efectiva m ∗ de los transportistas gratuitos ( ε 0 es la permitividad del vacío y e es la carga unitaria eléctrica). El parámetro de amortiguación de plasmón γ p depende de la movilidad del portador óptico μ (Ecuación (9)) [24].
Parámetros de ω LO y los modos LOPC se pueden determinar a partir de la parte imaginaria de la función de pérdida de energía - \ (\ mathrm {I} \ mathrm {m} \ left (- \ frac {1} {\ varepsilon \ left (\ omega \ right)} \ derecha) \) [7], donde ε ( ω ) es la función dieléctrica compleja, obtenida de la Ec. (5).
Resultados y discusión
La imagen SEM (Fig.2) muestra la sección transversal fotograbada de n + / n 0 / n + -Estructura de GaN cultivada en tampón de GaN / plantilla de GaN / sustrato de zafiro, donde seis capas distintas son claramente visibles, que son cinco capas de GaN con diferente concentración de portador y sustrato de zafiro. Cabe señalar que el espesor total de la estructura de GaN investigada medida por SEM concuerda con el tecnológico, y las capas de GaN observadas de acuerdo con la Fig.1 pueden atribuirse tentativamente a la parte superior nominal dopada con Si n + región (capa 1), sin dopar n 0 región (capa 2), parte inferior dopada con Si n + región (capa 3), búfer de GaN sin dopar (capa 4) y plantilla de GaN.
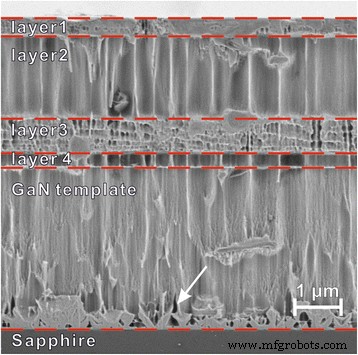
Imagen SEM de la sección transversal de los n + investigados / n 0 / n + -Estructura de GaN. El patrón irregular de líneas verticales se formó durante el corte (es decir, antes del fotograbado) y es característico de los cortes no pulidos de Al 2 O 3 / Heteroestructuras de GaN. Capa piramidal rugosa ( poros ) en la plantilla de zafiro / GaN indicada por la flecha fue revelado por fotograbado
Además, para tener una visión más profunda del nivel de impurezas / dopaje de las muestras investigadas, se realizaron mediciones SIMS. Los perfiles SIMS obtenidos (Fig. 3) están en buena correlación con el espesor nominal de las capas de GaN y el espesor total de la estructura multicapa estudiada. Todos los elementos examinados (H, C, O, Si) estaban por encima del límite de detección (3 a 5 × 10 16 a / cm 3 ) de la técnica SIMS.
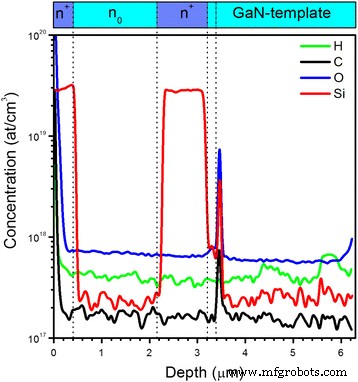
Perfiles de elementos de impureza de los n + investigados / n 0 / n + -Estructura de GaN medida por SIMS desde la superficie de la muestra
El perfil de dopaje intencional con Si, en general, concuerda con el perfil de dopaje nominal con una concentración de aproximadamente 2,8 × 10 19 cm −3 en la parte superior e inferior dopada n + regiones y de aproximadamente 2,3 × 10 17 cm −3 en el n 0 no dopado región. Sin embargo, como se puede ver en los datos de SIMS, también hay una capa delgada (<50 nm) -delta con una concentración de Si de 1.1 × 10 19 cm −3 entre el búfer de GaN y la plantilla de GaN. Cabe señalar que la capa delta dopada con Si también contiene concentraciones más altas de impurezas no intencionales de oxígeno y carbono de 2,4 × 10 19 cm −3 y 1,4 × 10 18 cm −3 , correspondientemente. Esta capa delta está relacionada con la interfaz de recrecimiento homoepitaxial, que normalmente surge de la contaminación de la plantilla de GaN con impurezas de O, Si y C, absorbidas de la atmósfera en el proceso tecnológico de carga o al comienzo del recrecimiento [25, 26].
Como se discutió anteriormente, la sección transversal SEM y el análisis SIMS dan la estructura de las capas de GaN, que difiere de los parámetros nominales al excitar la región de GaN adicional, pero con el espesor total de acuerdo con el nominal. Para aclarar la influencia de la capa delta de GaN adicional encontrada anteriormente en el espectro de reflectancia IR de la estructura investigada, la simulación del espectro experimental se realizó mediante la construcción de modelos que constan de seis capas, que corresponden a parámetros tecnológicos nominales, imágenes SEM ( Fig.1) y siete capas según SIMS. Los espectros calculados basados en los modelos descritos anteriormente se dan en la Fig. 4.

Simulaciones de los espectros de reflectancia IR con diferente número de capas. El espectro experimental de los n + investigados / n 0 / n + -La estructura de GaN se muestra mediante línea continua . un Región de Reststrahlen. b Los espectros ampliados en el rango por encima de 750 cm −1
Como puede verse en la Fig. 4, basado en el modelo de siete capas del perfil SIMS proporciona la mejor aproximación del espectro de reflectancia IR experimental. Por lo tanto, se realizan más simulaciones y análisis utilizando este modelo que tiene parámetros modificados, en comparación con los tecnológicos nominales (Fig.1), y que da cuenta de la capa adicional entre la capa tampón tecnológica de GaN y la plantilla de GaN (Fig.5).
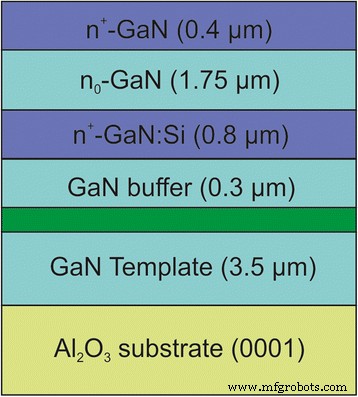
El modelo de 7 capas utilizado para simular los espectros de reflectancia IR de los n + investigados / n 0 / n + -Estructura de GaN. Una capa adicional ( verde ) es una capa de interfaz delgada entre la plantilla de GaN y las capas de GaN investigadas
La Figura 6 muestra s teóricas experimentales y ajustadas espectros de reflectancia polarizados de la estructura investigada en el ángulo de incidencia de 11 °. El espectro calculado se basa en el modelo descrito anteriormente (Fig. 5). La dispersión del índice de refracción complejo para las capas de GaN y el sustrato de zafiro se determinó usando la Ec. (5). El sustrato de zafiro fue considerado como semi-infinito, lo que permitió descuidar los reflejos internos dentro del sustrato y desde la parte trasera no pulida. La complicada estructura observada en la región reststrahlen del espectro se debe a una combinación de la superposición de GaN y Al 2 O 3 bandas reststrahlen junto con efectos de interferencia. La comparación de estos datos con los espectros calculados no solo puede proporcionar información sobre el espesor de las diversas capas de las muestras, sino que también puede ayudar a interpretar la complicada estructura de la región de reststrahlen en términos de las contribuciones de los diversos materiales.

Experimental ( línea continua ) y el mejor ajuste calculado ( línea de puntos y guiones ) Espectros de reflectancia IR de n + / n 0 / n + -Estructura de GaN desarrollada en plantilla de GaN / Al 2 O 3 . un Región de Reststrahlen. b Región de interferencia
La determinación de los espesores de capa a partir de la comparación de los datos de reflectancia con el espectro calculado es un proceso de dos pasos [27]. Primero, las franjas en la región transparente encima de las bandas reststrahlen (ω> 1200 cm −1 ) se deben a los efectos de interferencia en las capas de la estructura multicapa. De esta manera, se puede estimar el espesor total de la estructura investigada, que es una suma de todas las capas.
Una vez que se conoce el espesor de la pila, los espesores individuales de cada capa se pueden determinar ajustando los espectros calculados a los efectos de interferencia en la región reststrahlen del espectro. Los espesores de las capas se variaron teniendo en cuenta el espesor total previamente determinado. Bajo esta restricción, la reflectancia por encima de 1200 cm −1 no cambia significativamente. Los efectos de interferencia en la región de reststrahlen pueden distinguirse de otras características como los modos vibratorios TO y LO basados en el hecho de que las franjas de interferencia cambian de posición a medida que se varían los espesores de capa [28].
Durante la aproximación del espectro experimental en la región de reststrahlen, se variaron los siguientes parámetros del modelo:parámetros de amortiguación γ LO y γ TO para E 1 (LO) y E 1 (TO) modos de teléfono; frecuencia de plasma ω p ; parámetro de amortiguación de plasmón γ p ; y espesores de capa. Cabe señalar que solo E 1 Los fonones de simetría son IR activos en s -polarización [9]. Frecuencias iniciales de E 1 (LO) y E 1 (TO) fonones para GaN y sustrato de zafiro se tomaron de los experimentos de reflectancia IR [29] y dispersión Raman [6, 14]. Los valores típicos de la frecuencia de fonones de GaN son ω TO =560 cm −1 y ω LO =740 cm −1 . Las frecuencias de fonones para cada capa se refinaron en el proceso de ajuste. Los parámetros de mejor ajuste obtenidos con las barras de error se dan en la Tabla 1. Cabe señalar que los espesores de capa obtenidos en el proceso de ajuste están en buen acuerdo con los datos SEM.
Con referencia a la Fig. 6a, el pico de reflectancia a ~ 450 cm −1 puede atribuirse al sustrato de zafiro. Las características observadas en el rango de 500 a 740 cm −1 se deben a una combinación de características superpuestas de capas de GaN y bandas de zafiro reststrahlen. Para un análisis más profundo, los espectros de reflectancia IR de la capa de GaN a granel y de GaN de 6,78 μm de espesor en zafiro, con el espesor de GaN correspondiente al espesor total de la estructura investigada, se simularon en la región de la banda reststrahlen (Fig.7) . Como puede verse en la Fig. 7, los espectros de reflectancia de la capa de GaN de 6,78 de espesor en zafiro y GaN a granel en el rango de 500 a 740 cm −1 son similares al espectro experimental. La pequeña característica a ~ 511 cm −1 está asociado con el sustrato de zafiro. Cabe mencionar que a ~ 736 cm −1 , hay una caída débil que corresponde a A 1 Modo (LO) de la plantilla de GaN. Según las reglas de selección, A 1 El modo (LO) está prohibido en s espectros de infrarrojos polarizados [9]. La posible razón para el registro de este modo prohibido podría ser una fuga de polarización debido a la apertura del accesorio de reflectancia, así como microinhomogeneidades de la estructura cristalina de GaN. Específicamente, esto puede ser causado por la inclinación del c eje de la estructura de wurtzita en forma de columna de GaN desde la dirección perpendicular al plano de crecimiento de la película. Este modo no se tuvo en cuenta en nuestro modelo debido a su débil impacto en el espectro resultante. Las características en el rango de 750-1200 cm −1 se deben a la superposición de bandas GaN:Si y zafiro reststrahlen y efectos de interfaz. La caída a ~ 775 cm −1 está relacionado con el efecto de interfaz en el borde de la banda reststrahlen de capas de GaN y zafiro. El amplio hueco de ~ 825 cm −1 está asociado con la superposición de la rama de alta frecuencia del modo acoplado plasmón-LO-fonón (LPP + ) de los n + capas.
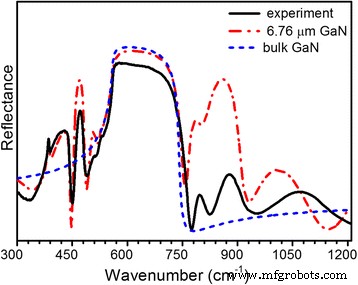
Experimental ( línea continua ) Espectros de reflectancia IR de los n + investigados / n 0 / n + -Estructura de GaN y espectros de reflectancia calculados de una capa de GaN de 6,78 μm de espesor en zafiro ( línea de puntos y guiones ) y GaN a granel ( línea de guiones )
La Figura 8 muestra las partes imaginarias calculadas de la función de pérdida de energía para cada capa de acuerdo con los parámetros del oscilador dados en la Tabla 1 para la estimación de E 1 -Modos LOPC. Como puede verse, la rama de alta frecuencia de los modos LOPC (LPP + ) a concentraciones de portador inferiores a 10 17 cm −3 (n 0 capa y plantilla) casi coinciden con E 1 (LO) modo de teléfono. El aumento de la concentración de portadores en el rango de 2 × 10 17 –3 × 10 18 cm −3 (Fig. 5) conduce a un cambio significativo de alta frecuencia y una ampliación del LPP + rama, que indica el aumento de la interacción entre el fonón LO y el plasmón y la disminución de la movilidad de los portadores de carga. Este comportamiento de LPP + branch concuerda bien con los datos experimentales sobre reflectancia IR de películas de GaN dopadas con Si cultivadas en zafiro por Z.F. Li y col. [30], y medición Raman en GaN a granel [10] y capas epitaxiales [31]. Cabe señalar que el LPP de baja frecuencia - rama de la LOPC no se puede definir de forma fiable en nuestro caso, ya que s -Los espectros de reflectancia IR polarizados no se midieron en un rango de baja frecuencia por debajo de 300 cm −1 .

Parte imaginaria calculada de la función dieléctrica obtenida para cada capa de GaN analizada a partir del análisis de datos de mejor ajuste
Los valores de concentración y movilidad del portador enumerados en la Tabla 2 se calcularon usando las Ecs. (8) y (9) con masa efectiva de electrones m * de 0,2 m 0 [32]. Se puede ver que el perfil de concentración de portador calculado es similar al perfil de concentración de impurezas de Si obtenido por las mediciones SIMS (Fig. 3), pero con concentraciones de portador del orden de magnitud más bajas en comparación con la concentración de impurezas de Si. Tal discrepancia en las concentraciones de portadores e impurezas de dopaje fue observada anteriormente por M. Bockowski et al. [33], y se relacionó con los efectos de compensación por los estados aceptores (probablemente por las vacantes de galio), cuya energía de formación disminuye con el aumento del dopaje de tipo n [34]. Cabe mencionar que la concentración de portador para el n + capas del orden de ~ 10 18 cm −3 está de acuerdo con los resultados de nuestros estudios Raman de estructuras de GaN similares basados en el análisis de los modos LOPC [6]. La disminución obtenida de la movilidad del portador μ con la concentración del portador también está de acuerdo con los experimentos de Hall en GaN [35] y el modelado teórico [36].
Los valores de la permitividad dieléctrica de alta frecuencia ε ∞ se encontraron en el rango de 4,99 a 5,35 (Tabla 1). El aumento de ε ∞ para los n + dopados capas en comparación con n 0 Las capas pueden estar relacionadas con el desplazamiento hacia el rojo de la banda prohibida de α-GaN [37]. Cabe señalar que los valores de ε ∞ se puede determinar con un error relativamente pequeño solo para películas de baja conductividad. Precisión en la determinación de ε ∞ Disminuye con la concentración del portador, lo cual está relacionado con el hecho de que el ε ∞ El parámetro representa el límite de “alta frecuencia” cuando la función del modelo dieléctrico se extrapola a números de onda más cortos que los estudiados aquí [11]. El amplio rango espectral de 300 a 4000 cm −1 fue analizado con el fin de disminuir el error en la determinación de ε ∞ y otros parámetros involucrados en el modelado de los espectros de reflectancia IR de n + capas.
Conclusiones
Se midieron y analizaron en detalle los espectros de reflectancia IR de la estructura multicapa que constaba de capas de GaN cultivadas sobre un sustrato de zafiro y dopadas con diferentes concentraciones de impureza de Si. El análisis de la estructura investigada por SEM de la sección transversal fotograbada mostró una buena correlación con los parámetros tecnológicos de las capas de GaN. El análisis SIMS también reveló la presencia de una capa delta delgada cerca de la interfaz del tampón de GaN / plantilla de GaN con un mayor contenido de impurezas de Si y O, que está relacionada con la interfaz de recrecimiento homoepitaxial. El modelado del espectro de reflectancia IR de la estructura multicapa estudiada mediante la inclusión en el análisis de la capa adicional permitió obtener el mejor ajuste del espectro experimental. Los espesores obtenidos de las capas de GaN están de acuerdo con los datos de SEM y SIMS. Calculated from the spectral dependence of dielectric permittivity LOPC modes for each GaN layer showed high-frequency shift and broadening of LPP + branch with the increase in carrier concentration. Concentration and mobility of charge carrier for each GaN layer were calculated from the plasmon frequency and damping parameter. Obtained carrier concentration profile is similar to those obtained by SIMS, but with values of carrier concentration one order of magnitude less than the concentration of Si doping impurity, which can be attributed to compensation effects by the defect acceptor states. Thus, it is demonstrated that IR reflectance spectroscopy and 2 × 2 transfer matrix method can be successfully used for analysis of epitaxial multilayer GaN structures with non-uniform doping profiles, and allow for the determination of the fundamental electron and phonon parameters of each GaN layer.
Change history
Abreviaturas
- IR:
-
Infrared
- FTIR:
-
Fourier transform infrared spectroscopy
- SEM:
-
Scanning electron microscopy
- SIMS:
-
Secondary ion mass spectrometry
- LOPC:
-
Longitudinal optical phonon– plasmon coupled
Nanomateriales
- Estructura y propiedades electrónicas de la nanoarcilla de caolinita dopada con metal de transición
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- Nuevos nanocompuestos de poliestireno con polianilina dopado con ácido lauril sulfúrico
- Dependencia de la temperatura de la banda prohibida en MoSe2 crecido por epitaxia de haz molecular
- Nanocables de silicio amorfo cultivados en película de óxido de silicio mediante recocido
- Dirigirse a las células endoteliales con nanopartículas multifuncionales de GaN / Fe
- Análisis de mapeo Raman de resonadores de microanillos de silicio integrados con grafeno
- Capas óptimas de dopaje de silicio de barreras cuánticas en la secuencia de crecimiento que forman el potencial de confinamiento suave de ocho períodos In0.2Ga0.8N / GaN Pozos cuánticos de azul LE…
- Desplazamiento de la estructura de GaN entre la red de nanowall, la nanocolumna y la película compacta cultivada en Si (111) por MBE
- Comprensión del mecanismo de crecimiento de las capas epitaxiales de GaN en grafito exfoliado mecánicamente
- Análisis de distribución Bi en GaAsBi epitaxial mediante HAADF-STEM con corrección de aberraciones



