Transistores de efecto de campo InSe bidimensionales de alto rendimiento con nuevo contacto óhmico intercalado para nodos de menos de 10 nm:un estudio teórico
Resumen
El transistor de efecto de campo (FET) bidimensional (2D) basado en InSe ha mostrado una notable movilidad de portadora y una alta relación de encendido y apagado en informes experimentales. Las investigaciones teóricas también afirmaron que el alto rendimiento se puede conservar bien en nodos de menos de 10 nm en el límite balístico. Sin embargo, tanto la experiencia experimental como los cálculos teóricos indicaron que lograr una resistencia óhmica de alta calidad se ha convertido en el principal factor limitante para el FET 2D de alto rendimiento. En este trabajo, propusimos un nuevo contacto óhmico intercalado con indio para InSe FET y evaluamos exhaustivamente su rendimiento a partir de vistas de material y dispositivo basados en métodos ab initio. Las propiedades del material denotan que todos los aspectos fundamentales del contacto óhmico, incluida la barrera de túnel, la barrera de Schottky y el dopaje efectivo, están bien relacionados con la introducción de la estructura intercalada, y se logró una excelente resistencia al contacto. A nivel de rendimiento del dispositivo, se investigaron los dispositivos con una longitud de puerta de 7, 5 y 3 nm. Todas las métricas de los dispositivos en contacto intercalados superan con creces los requisitos de la Hoja de ruta tecnológica internacional para semiconductores (ITRS) y exhiben una promoción obvia en comparación con las estructuras convencionales. Se logra un aumento máximo de corriente con 69,4%, 50% y 49% para dispositivos con una longitud de puerta de 7, 5 y 3 nm, respectivamente. Mientras tanto, se alcanza la máxima reducción del retardo intrínseco con 20,4%, 16,7% y 18,9%. Además, se presenta un punto de referencia del producto de retardo de energía (EDP) frente a otros FET 2D. Todos los FET de InSe con contacto óhmico intercalado superan al MoS 2 FET, así como el requisito de ITRS 2024. El mejor resultado se acerca al límite superior del FET de BP ideal, lo que denota una preponderancia superior de estructuras intercaladas para FET de InSe en la próxima generación de tecnología de semiconductores de óxido de metal complementario (CMOS).
Introducción
Los semiconductores bidimensionales (2D) han atraído mucho interés en los dispositivos electrónicos debido a sus atractivas aplicaciones para la próxima generación de tecnología de semiconductores complementarios de óxido de metal (CMOS) [1, 2]. Su grosor ultrafino y su buena propiedad dieléctrica pueden proporcionar un excelente control de puerta electrostática para suprimir los conocidos efectos de canal corto [3]. Además, como pocas capas de materiales 2D suelen poseer una superficie lisa con falta de enlaces colgantes, la movilidad de los portadores de superioridad de los materiales 2D se puede conservar bien en sistemas de cuerpo ultradelgado en comparación con los semiconductores convencionales [4]. Excepto por el grafeno sin espacios, la mayoría de los semiconductores 2D sintetizados, como los dicalcogenuros de metales de transición (TMD), el fósforo negro (BP) y el seleniuro de indio (InSe) poseen una banda prohibida de cero y se ha demostrado que son adecuados para transistores de efecto de campo (FET). ). Los FET basados en TMD han mostrado una alta relación de activación y desactivación de hasta 10 8 y baja corriente de fuga en dispositivos de canal corto, beneficiándose de la gran masa efectiva [5]. Los FET basados en BP han presentado características de conmutación y corriente sobresalientes [6], debido a la alta movilidad de ~ 1000 cm 2 / V sy propiedad de transporte anisotrópico [7]. Recientemente, se demostró que InSe presenta una movilidad de superioridad de ~ 2000 cm 2 / V sa temperatura ambiente [8, 9], y FET basado en InSe revelaron una alta relación de encendido y apagado de 10 8 [10]. Los cálculos del primer principio también identificaron que InSe FET se puede escalar bien a menos de 10 nm en el límite balístico [11, 12]. Sin embargo, debido al descuido de la resistencia de contacto y la hipótesis de un fuerte dopaje, acercarse al límite teórico sigue siendo un desafío en aplicaciones reales. De hecho, como todavía falta un método de dopaje confiable y una forma de contacto óhmico de alta calidad, los FET basados en materiales 2D que incluyen InSe suelen ser FET de barrera Schottky (SB) [13,14,15,16]. El SB en las regiones activas produce una gran resistencia de contacto y el bajo nivel de dopaje degrada aún más la densidad de corriente. Lograr una baja resistencia de contacto con regiones activas suficientemente dopadas se ha convertido en el principal factor limitante para que el FET basado en materiales 2D (2D FET) logre un alto rendimiento [17,18,19].
Con el objetivo de abordar los problemas anteriores, propusimos un nuevo contacto óhmico intercalado para InSe FET. El indio fue seleccionado como el electrodo metálico, ya que estudios experimentales y teóricos recientes sugieren que el indio puede ser un candidato prometedor para que InSe FET logre un buen rendimiento [20, 21, 22]. En teoría, evaluamos la calidad de contacto óhmico y el rendimiento de dispositivos con una longitud de puerta de 7, 5 y 3 nm siguiendo el marco de la Hoja de ruta tecnológica internacional para semiconductores 2013 (ITRS) [23]. Cabe señalar que aunque ITRS ha sido reemplazado por la Hoja de ruta internacional para dispositivos y sistemas (IRDS) [24], ITRS2013 presenta una clara tendencia de escalado para transistores y aún se ha adoptado en estudios recientes [25, 26]. Este manuscrito está organizado de la siguiente manera:primero, se investigan las propiedades eléctricas de los contactos intercalados y convencionales (superiores). En segundo lugar, las métricas de rendimiento del dispositivo, como la corriente en estado y el retardo intrínseco, se evalúan y comparan con los requisitos de ITRS. Por último, se presenta el punto de referencia del producto de retardo de energía frente al retardo intrínseco para compararlo con otros dispositivos 2D basados en materiales.
Métodos
Todas las estructuras atómicas fueron optimizadas por VASP [27]; Se empleó un corte de energía de 335 eV durante todos los cálculos. La celda unitaria de InSe se relajó con un criterio de estrés de 0,01 eV / Å en el marco de MetaGGA de SCAN [28]. Los parámetros de celosía del indio metálico se obtuvieron del manual de química y física [29]. Como se muestra en la Fig. 1, la constante de celosía de InSe es 4.029 Å, que está muy de acuerdo con los informes experimentales [30, 31].

Vista superior de la celda unitaria para InSe ( a ) e indio ( b ), respectivamente
La estructura inicial del indio en InSe se construyó con 4 × 1 × 1 y 5 × 2 × 1 celdas unitarias de superficie de InSe e indio (001), respectivamente. La deformación absoluta media fue del 1,32%, suficiente para preservar las propiedades intrínsecas del material. Como se muestra en la Fig. 2a, b, la estructura intercalada se construyó con capas de indio / InSe / indio, el indio de los lados inferior y superior tiene simetría de espejo con el centro de InSe. Ambas estructuras híbridas se relajaron con van der Waals (vdW) funcional de optb88 con un criterio de fuerza en cada átomo inferior a 0,02 eV / Å [32, 33]. El área de contacto final es 16,19 Å × 6,41 Å. A continuación, se evaluó la resistencia del contacto óhmico mediante un dispositivo de dos sondas como se muestra en la Fig. 2a, b. Al deshacerse de la resistencia innecesaria de los semiconductores fuera de las regiones de contacto, InSe en el cátodo se dopó fuertemente con 1 × 10 14 e / cm 2 tanto para contactos superiores como intercalados.
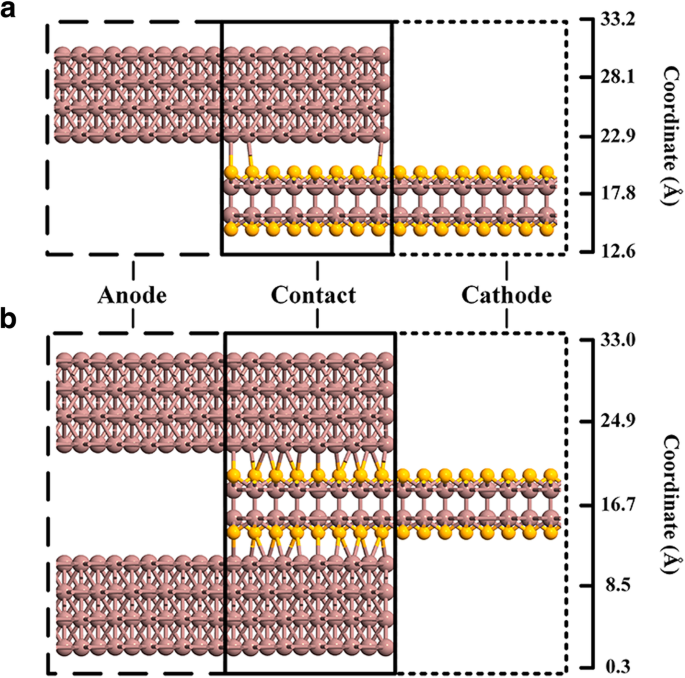
Estructuras atómicas de contacto y dispositivo de dos sondas relacionado utilizado para evaluar la resistencia de contacto. un , b son para contactos superiores e intercalados, respectivamente . Las coordenadas denotan la ubicación de los átomos en la dirección del plano exterior
En cuanto a la evaluación del rendimiento del dispositivo, la geometría de InSe FET con contactos óhmicos intercalados y superiores se muestra en la Fig. 3a, b, respectivamente. Todos los nombres de dispositivos y nodos siguen los requisitos de ITRS e IRDS, respectivamente. Los parámetros del dispositivo se enumeran en la Tabla 1. Para suprimir la tunelización intrabanda, se aplicó un solapamiento (UL) de 1 nm a una longitud de puerta de 3 nm. A diferencia del modelado de contacto óhmico, ninguna de las partes de los dispositivos fue dopada intencionalmente. Los dispositivos se construyeron fusionando la fuente, el drenaje y el canal a lo largo de la dirección de transporte. El canal y sus dos interfaces con regiones activas se relajaron adicionalmente con fuente y drenaje fijos. Todas las simulaciones se basaron en la teoría de la función de Green sin equilibrio (NEGF) y fueron realizadas por QuantumATK con un cálculo totalmente autoconsistente [34,35,36], que generalmente se empleaba para diseñar e investigar transistores en nodos de menos de 10 nm [17 , 37,38,39]. Se emplearon conjuntos de base polarizados de doble zeta con corte mecánico de 90 Rydberg. Se muestreó la malla de puntos k del paquete Monkhorst con una densidad de 8 / Å −1 × 11 / Å −1 × 180 / Å −1 . El solucionador de gradiente conjugado paralelo se elige como el solucionador de Poisson en aras de la eficiencia. La corriente de todos los dispositivos se puede obtener resolviendo la fórmula de Landauer-Büttiker [40]:
$$ I \ left ({V} _ {\ mathrm {Bias}} \ right) =\ frac {2e} {h} \ int T \ left (E, {V} _L, {V} _R \ right) \ izquierda [{f} _ {\ mathrm {R}} \ izquierda (E, {V} _R \ derecha) - {f} _L \ izquierda (E, {V} _L \ derecha) \ derecha] dE $$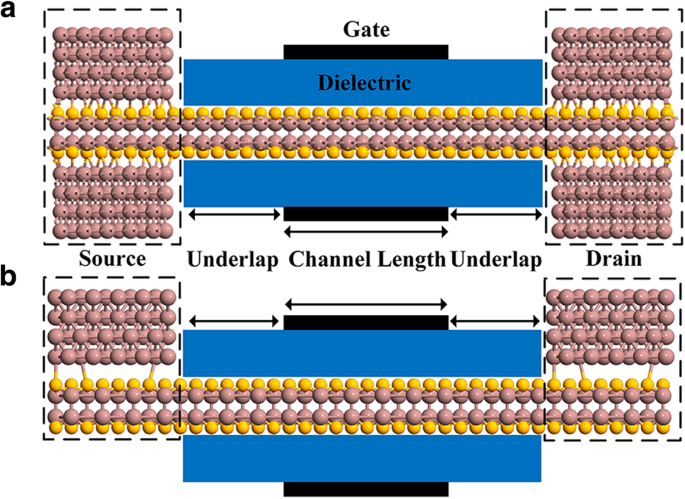
Geometrías de los FET de InSe con intercalado ( a ) y arriba ( b ) contactos
Dónde, V Sesgo es el sesgo y se puede lograr mediante: V Sesgo = V R - V L , T ( E , V L , V R ) es el coeficiente de transmisión de las portadoras, f R ( E , V R ) y f L ( E , V L ) son la función de distribución de Fermi-Dirac para cátodo (drenaje) y ánodo (fuente), respectivamente.
Resultados y discusión
En general, hay tres factores clave correlacionados con la calidad de contacto óhmico en materiales 2D [18], es decir, la barrera de túnel y la distancia que se deriva de la brecha vdW, la superposición orbital entre el electrodo y el semiconductor, y también la altura de SB. En primer lugar, la barrera y la distancia de la tunelización se describieron mediante el potencial efectivo que se muestra en la Fig. 4a. En comparación con el contacto superior, la introducción del contacto intercalado no solo proporciona una ruta de transporte adicional en el lado inferior, sino que también da lugar a una disminución de la barrera de túnel de 5,48 a 2,38 eV, lo que lleva a una reducción del 56,6%. Mientras tanto, la distancia interfacial también se reduce ligeramente con 0,66 Å, lo que indica que el ancho de la barrera de túnel también se reduce. En segundo lugar, la superposición orbital se puede evaluar a partir de la distribución de carga de la cenefa en la Fig. 4b. Se puede notar que el contacto intercalado posee más electrones de cenefa en la región interfacial en comparación con el contacto superior, lo que indica una superposición orbital más fuerte entre el indio y el InSe. Esta característica también ayuda a introducir el efecto de dopaje en InSe, y el número de electrones en exceso se puede calcular utilizando la población de Mulliken. Extrajimos el número total de electrones en InSe de estructuras intercaladas y en contacto con la parte superior, respectivamente. Entonces, el nivel de dopaje se puede obtener dividiendo el número de electrones por el área de la región de contacto, ya que la carga neta de InSe aislada siempre debe ser cero. Como se muestra en el panel derecho de la Fig. 4b, el contacto intercalado produce un nivel de dopaje muy alto de 1,6 × 10 13 e / cm 2 , que es casi 2,8 veces mayor que el del contacto superior. Un nivel tan alto se ha acercado a la hipótesis en las simulaciones de FET de tunelización 2D, que generalmente afirma un nivel de dopaje mucho más pesado que el FET de semiconductor de óxido metálico. En tercer lugar, la densidad de estados (DOS) de InSe en estructuras prístinas, intercaladas y en contacto con la parte superior se muestra en la Fig. 4c. La superposición orbital entre el indio y el InSe en la región interfacial metalizó la banda prohibida de InSe, y el emparedado de uno da como resultado un nivel más alto. Esta característica mejora en gran medida la inyección de portadores a través de la barrera de tunelización vdW en la región interfacial, ya que los estados metalizados en la banda prohibida ofrecen canales de tunelización adicionales. Además, los niveles de Fermi están por encima del mínimo de la banda de conducción, lo que resulta en una degeneración de energía de ~ 0.07 y 0.27 eV para los contactos superiores e intercalados, respectivamente. Por lo tanto, los SB entre indio e InSe se eliminan por completo. En cuarto lugar, la resistencia de contacto óhmica se calculó basándose en la curva de corriente de polarización obtenida de los dispositivos de dos sondas, y todos los resultados se muestran en la Fig. 4d. Podemos notar que ambos contactos son óhmicos debido a las evoluciones lineales. A nivel teórico, es decir, despreciando la rugosidad de la superficie, las impurezas interfaciales, etc., la estructura intercalada conduce a un valor de contacto muy bajo de 0.032 ± 0.002 Ω mm, lo que reduce más de la mitad de la resistencia del contacto superior. Con base en las discusiones anteriores, es interesante notar que el doble de la región de contacto siempre conduce a una mejora de más del doble del contacto óhmico. Debido a que recientemente se confirmó experimentalmente que el contacto superior con indio es efectivo para aumentar el rendimiento de los dispositivos basados en InSe [21, 22], la estructura intercalada puede ser una solución de contacto óhmico atractiva para los FET de InSe.

un Potencial efectivo normal a la dirección de transporte. La coordenada corresponde a la ubicación de los átomos y se define en la Fig. 1. Las regiones oscuras corresponden a la brecha vdW. b Distribución de electrones promediada en el plano normal a la dirección de transporte. El panel de la derecha es el nivel de dopaje. La coordenada corresponde a la ubicación de los átomos y se define en la Fig. 1. c DOS de InSe. El verde corresponde a InSe prístino. d Sesgo dependiente de la corriente de los dos dispositivos de sonda. Todo el rojo y el azul corresponden a los contactos superiores e intercalados, respectivamente
Luego, se evaluó el rendimiento del dispositivo y las características de transferencia de InSe FET en los nodos de 2019, 2021 y 2024 se mostraron en la Fig. 5. Se puede observar que la oscilación del subumbral (SS) de todos los nodos está por debajo de 100 mV / dec. , y SS en el nodo 2019 muestra características de conmutación casi ideales de 61,8 y 64,4 mV / dec para dispositivos con contacto superior e intercalado, respectivamente, lo que indica un control electrostático sobresaliente en los FET de InSe. Además, los dispositivos con contacto intercalado conducen a una mejora evidente de I DS en comparación con los principales con un aumento máximo del 69,4%, 50% y 49% alcanzado en los nodos de 2019, 2021 y 2024, respectivamente. Además, ON se extrajo siguiendo el requisito de alto rendimiento (HP) en el ITRS. Como se muestra en la Fig. 5d, ENCENDIDO de todos los sistemas está muy por encima del requisito de HP. En comparación con los principales dispositivos contactados, los sistemas intercalados todavía presentan una promoción del 38,2%, 27,3% y 20,5% para los nodos de 2019, 2021 y 2024, respectivamente.
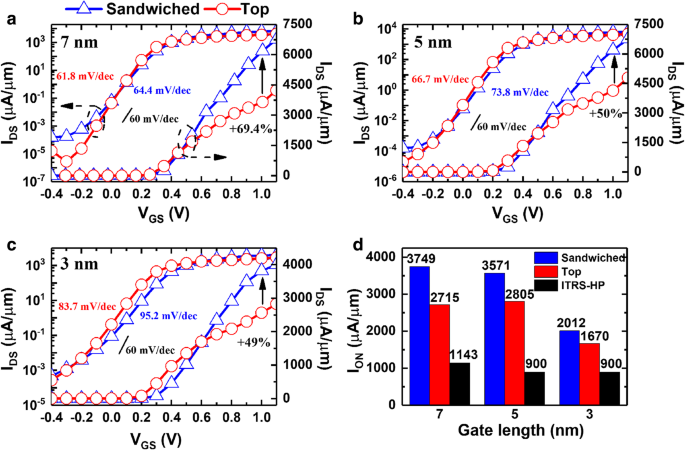
Transferir características de InSe FET en el nodo. un 2019, b 2021 y c 2024 nodos, respectivamente. d Comparaciones de I ON siguiendo los requisitos de HP de ITRS
Otra métrica esencial de FET es el retardo intrínseco (τ), que significa el límite superior de la velocidad de conmutación en el circuito lógico. El τ fue obtenido por τ =(Q ACTIVADO - Q APAGADO ) / I ACTIVADO , donde Q ON y Q APAGADO son cargos en los estados de encendido y apagado, respectivamente. Los estados de encendido y apagado están restringidos en | V DS | =0,68, 0,64 y 0,64 V para los nodos 2019, 2021 y 2024, respectivamente. El retardo intrínseco como una función de la relación de encendido-apagado se muestra en la Fig. 6. A pesar de la evolución no monótona a un gran retardo que se deriva de la tunelización bajo voltajes de puerta bajos [41], todos los retardos están por debajo de 0,15 ps y suficientemente reducidos que el requisito de ITRS de 0,44-0,46 ps. Además, los dispositivos con contacto intercalado dan lugar a una reducción de más del 30% en las regiones de I ON / I APAGADO ≤ 10 7 , 10 6 , 10 5 para los nodos 2019, 2021 y 2024, respectivamente. Sobre la base de los requisitos de HP que se muestran en la Fig. 6d, los dispositivos con contacto intercalado aún pueden promover la velocidad de conmutación con un 20,4%, un 16,7% y un 18,9% para los nodos de 2019, 2021 y 2024, respectivamente.
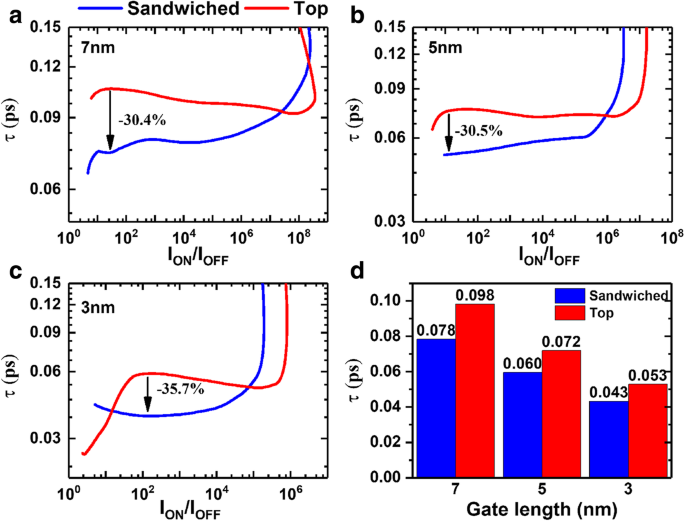
Retraso intrínseco en función de la relación de encendido-apagado en el nodo. un 2019, b 2021 y c 2024 nodos, respectivamente. d Comparaciones de retardo intrínseco siguiendo el requisito de HP de ITRS
Para evaluar el rendimiento del dispositivo de forma más intuitiva, se extrae el producto de retardo de potencia (PDP) frente al retardo intrínseco. PDP corresponde al consumo de energía en un solo evento de conmutación y está definido por PDP =(Q ON - Q APAGADO ) V DS con todos los parámetros derivados de los requisitos de HP de ITRS. Los resultados y la comparación con otros FET 2D se muestran en la Fig. 7. En primer lugar, todos los FET 2D se seleccionaron basándose en la regla de que se han verificado preliminarmente como transistores en informes experimentales, lo que va un paso más allá para la tecnología CMOS. En segundo lugar, excepto para InSe y MoS 2 [42], todos los demás dispositivos se simularon con mucho dopaje en regiones activas y desprecio de la resistencia de contacto óhmica [43, 44], por lo que los resultados corresponden al límite superior de rendimiento. Como puede verse, todos los productos de retardo de energía (EDP) están por debajo del requisito de ITRS 2024, lo que indica el atractivo futuro de los FET 2D. El máximo de EDP pertenece a MoS 2 FET a 9,9 nm, y lo mejor es de BP FET. En cuanto a los FET de InSe, los dispositivos de contacto intercalado siempre funcionan mejor que los de contacto superior en todos los nodos. El EDP más alto de los dispositivos con contacto intercalado tiene una longitud de puerta de 7 nm (nodo de 2019) y supera todos los MoS 2 FET. El más bajo tiene una longitud de puerta de 3 nm (nodo 2024) e incluso se acerca al límite superior de BP FET en la dirección del sillón, que es bien conocido por sus excelentes propiedades de transporte. En consecuencia, el EDP de InSe FET significa que los dispositivos con contacto intercalado exhiben suficiente competitividad entre los FET 2D.
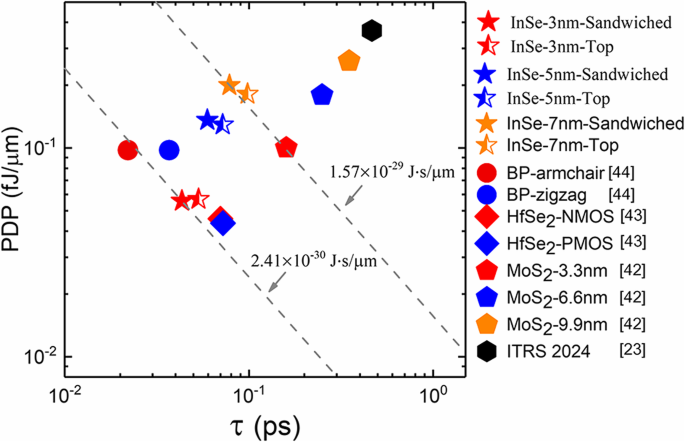
Producto de retardo de potencia versus retardo intrínseco compuesto por InSe y otros FET 2D. Las pautas de guiones grises corresponden a PDE específico
Conclusiones
En este trabajo, se propuso un nuevo contacto óhmico intercalado con indio para InSe FET. El contacto óhmico intercalado no solo duplica la región de contacto, sino que también promueve la calidad del contacto más del doble, lo que conduce a una excelente resistencia de contacto. En el nivel de rendimiento del dispositivo con una longitud de puerta de 7, 5 y 3 nm, los FET InSe con contacto óhmico intercalado presentan una promoción de rendimiento universal en comparación con los dispositivos convencionales con contacto superior. Bajo el requisito de HP de ITRS, la corriente en estado y el retardo intrínseco se mejoran con 38.2 ~ 20.5% y 20.4 ~ 16.7%, respectivamente. Un punto de referencia de EDP frente a otros FET 2D también revela que los FET InSe con contacto óhmico intercalado tienen ventajas sobre otros FET 2D. Nuestro estudio ofrece una nueva ruta hacia los FET InSe de alto rendimiento.
Disponibilidad de datos y materiales
Los conjuntos de datos utilizados y / o analizados durante el estudio actual están disponibles del autor correspondiente a solicitud razonable.
Abreviaturas
- 2D:
-
Bidimensional
- CMOS:
-
Semiconductor complementario de óxido de metal
- TMD:
-
Dicalcogenuros de metales de transición
- BP:
-
Fósforo negro
- InSe:
-
Seleniuro de indio
- FET:
-
Transistores de efecto de campo
- SB:
-
Barrera de Schottky
- 2D FET:
-
FET basado en materiales 2D
- ITRS:
-
Hoja de ruta tecnológica internacional para semiconductores
- vdW:
-
van der Waals
- UL:
-
Superposición
- NEGF:
-
Función de Green fuera de equilibrio
- DOS:
-
La densidad de estados
- SS:
-
Oscilación del subumbral
- HP:
-
Alto rendimiento
- τ:
-
Retraso intrínseco
- PDP:
-
Producto de retardo de energía
- EDP:
-
Producto retardador de energía
Nanomateriales
- Separadores de aire para chips de 10 nm
- Nexam suministrará a Diab Nexamite que mejora las propiedades para la espuma de PET de alto rendimiento
- Fibras de carbón activado con nanoestructura jerárquica derivada de guantes de algodón usados como electrodos de alto rendimiento para supercondensadores
- Transistores de efecto de campo de nanoflake SnSe multicapa con contactos au óhmicos de baja resistencia
- El estudio de un nuevo sistema micelar similar a un gusano mejorado con nanopartículas
- Evolución del área de contacto con carga normal para superficies rugosas:de escalas atómicas a macroscópicas
- Deposición de capa atómica de nanopelículas de óxido de indio para transistores de película delgada
- Microarreglos mesoporosos de VO2 bidimensionales para supercondensadores de alto rendimiento
- Transistores de efecto de campo ferroeléctricos basados en patrones de banda de micrones dominados por nanotubos de carbono de pared simple con capa de control de defectos de HfO2
- Una nueva microestructura de racimo de nanoconas con propiedades antirreflectantes y superhidrofóbicas para dispositivos fotovoltaicos
- Un nuevo nanobiosensor magnetoelástico para la detección altamente sensible de atrazina



