Un Memristor multinivel basado en película delgada de HfO2 dopado con Al
Resumen
La memoria no volátil (NVM) jugará un papel muy importante en las tecnologías digitales de próxima generación, incluida la Internet de las cosas. Los memristores de óxido metálico, especialmente basados en HfO 2 , han sido favorecidos por muchos investigadores debido a su estructura simple, alta integración, alta velocidad de operación, bajo consumo de energía y alta compatibilidad con tecnologías CMOS avanzadas (óxido de silicio metálico complementario). En este artículo, una resistencia estable de 20 niveles indica HfO 2 dopado con Al -se presenta memristor basado en. La resistencia de sus ciclos, el tiempo de retención de datos y la relación de resistencia son superiores a 10 3 ,> 10 4 s, y> 10, respectivamente.
Antecedentes
Aunque el fenómeno de resistencia negativa fue descubierto por primera vez por Hickmott en un Al / Al 2 O 3 / Estructura de Au en 1962 [1], y Chua propuso el concepto de memristor en 1971 [2]. No fue hasta que Strukov et al prepararon el TiO 2 memristor basado en 2008 [3] que la gente comenzó a prestar atención al estudio sobre memristors. En la actualidad, los investigadores han preparado memristores con más de docenas de materiales resistivos activos, incluidos múltiples óxidos complejos [4, 5], óxidos metálicos como ZnO [6], TiO x [7], TaO x [8] y materiales bidimensionales [9, 10]. HfO 2 se ha utilizado como dieléctrico de puerta de alto k en dispositivos CMOS debido a su alta confiabilidad, alta velocidad de operación y bajo consumo de energía [11, 12]. También es preferido por los investigadores como material memristivo [13,14,15].
El memristor multinivel se puede utilizar ampliamente como almacenamiento de datos [16,17,18], cálculo lógico [19], dispositivo sináptico electrónico [20,21,22,23], etc. Wang Y. [16] y Gao B. et al. [24] preparó memristores multinivel dopando HfO 2 con Cu y Gd, respectivamente, pero solo pueden crear un estado de almacenamiento de 4 niveles, lo que es difícil de satisfacer las demandas de las aplicaciones. Por tanto, el estudio sobre HfO 2 memristores multinivel es de gran importancia.
Métodos
Ti / Al:HfO 2 / El dispositivo Pt se fabricó como se muestra en la Fig. 1a. El área de la celda activa fue definida por el electrodo superior de Ti de forma cuadrada (TE). Se depositó una capa adhesiva de Ti de 20 nm mediante pulverización catódica de corriente continua (CC) sobre un sustrato de silicio, luego se depositó una película de Pt de 100 nm como electrodo de fondo (BE). El HfO 2 dopado con Al de 20 nm La capa funcional fue depositada por el reactor de deposición de capa atómica (ALD) (R-150, Picosun, Espoo, Finlandia) a 300 ° C con MeCp 2 HfMe (OMe) (denotado como HfD-04) como precursor de Hf y H 2 O como fuente de oxígeno [25]. Los precursores fueron transportados por N 2 de alta pureza (> 99,999%) en la cámara del reactor. Las películas dopadas con Al se obtuvieron depositando un ciclo de Al 2 O 3 cada 8 ciclos de HfO 2 con el trimetilaluminio (TMA) como fuente de Al y H 2 O como fuente de oxígeno. La concentración atómica de Al del 6,2% se detecta mediante espectroscopia de fotoelectrones de rayos X (XPS, Axis Ultra DLD, Kratos Analytical, Manchester, Reino Unido) en un sistema Theta 300 XPS de Thermo Fisher. Una película de Ti de 50 nm como TE y Pt de 100 nm como capa de cobertura se depositaron mediante pulverización catódica con CC. Los dispositivos se obtienen modelando el TE mediante litografía óptica y proceso de despegue. La figura 1b es la micrografía óptica de los dispositivos. Hemos preparado dispositivos con diferentes áreas que van desde 5 μm × 5 μm hasta 500 μm × 500 μm.
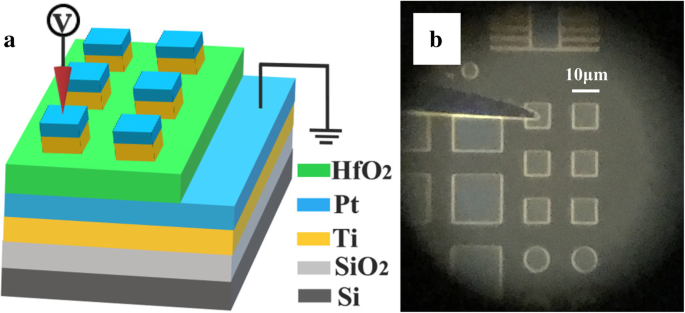
La estructura de los dispositivos. un Modelo 3D de los memristores. b Microscopía óptica de los dispositivos
Resultados y discusión
La Figura 2 muestra el XPS de los dispositivos dopados y no dopados con Al. En comparación con los espectrogramas de dispositivos no dopados, los dispositivos dopados con Al muestran un pico distintivo de 74,1 eV de Al 2p en la figura 2a, y la energía de enlace de Hf 4f tiene un cierto aumento en la figura 2b. La relación de Hf 4f 5/2 a Hf 4f 7/2 también aumentó para los dispositivos dopados. Es coherente con los otros informes [14, 26, 27]. Los átomos de Al se unen a la estructura de HfO2 para formar Hf-Al-O, lo que da como resultado enlaces Hf-O más débiles y más fáciles de romper.

El XPS de dispositivos dopados y no dopados con Al. un Al 2p y b Se comparan Hf 4f
Para todas las mediciones eléctricas, el Ti TE se polarizó mientras que el Pt BE estaba conectado a tierra. Los barridos de CC se realizaron utilizando un analizador de parámetros B1500A (Santa Clara, CA, EE. UU.) Con una fuente / unidad de medida, y también se utilizan medidas eléctricas de pulso con un generador de forma de onda / unidad de medida rápida. Todos los dispositivos muestran estado de alta resistencia (HRS) antes de un proceso de conformado eléctrico necesario. La Figura 3a muestra la característica de formación de los dispositivos dopados y no dopados con Al de 10 µm × 10 µm. Es necesario un cumplimiento actual durante el conformado para proteger los dispositivos de daños. La resistencia inicial y el voltaje de formación del dispositivo no dopado son mayores. La oscilación en la región de bajo voltaje del dispositivo no dopado se debe a que la corriente es menor que el límite de medición del instrumento. El proceso de reinicio después de la etapa de formación se motiva aplicando un voltaje negativo, como se muestra en la Fig. 3a, y luego se motiva el primer proceso de configuración. A medida que aumenta la amplitud de voltaje de reinicio, la corriente de ambos dispositivos aumenta a un máximo mayor que la corriente limitada de formación y luego disminuye. Las corrientes HRS de ambos dispositivos son varios órdenes mayores que las del estado inicial al mismo voltaje. Sugiere que todavía hay filamento conductor que no se puede fusionar por completo después de reiniciar. Las curvas I – V típicas de activación / desactivación de la Fig. 3b muestran que la tipología de estos dos dispositivos es el modo de funcionamiento bipolar [28]. La relación de conmutación y el voltaje de ajuste / reinicio del dispositivo dopado con Al son más pequeños que los del dispositivo no dopado, pero su proceso de transformación del estado de resistencia es más suave, adecuado como dispositivo de almacenamiento de valores múltiples.
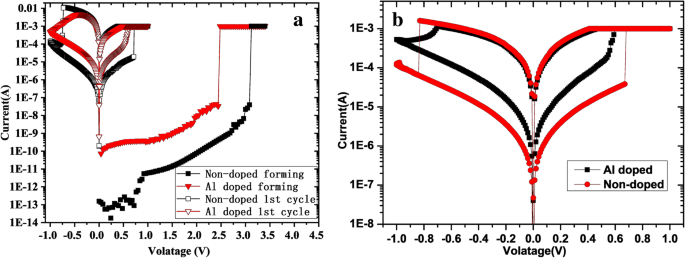
Las características I / V de los dispositivos. un El proceso de formación y primer ciclo. b El proceso típico de configuración / reinicio
Para aclarar los mecanismos de conmutación de los dispositivos, las curvas I – V se vuelven a trazar en doble escala logarítmica en la Fig. 4. Para ambos tipos de dispositivos, la curva de baja resistencia exhibe un comportamiento óhmico lineal, lo que indica la formación de filamentos conductores en HfO 2 películas durante su ambientación [29, 30]. Sin embargo, las curvas de alta resistencia son bastante diferentes entre estos dos tipos de dispositivos. Para el dispositivo dopado, se compone de tres regiones:la región óhmica (I∝V), la región de la ley del niño (I∝V 2 ), y la región de fuerte aumento de la corriente, que se corresponde con la característica I – V típica de la corriente limitada de carga espacial controlada por trampa (SCLC) [31, 32]. La curva de alta resistencia del dispositivo no dopado se compone de dos regiones:la conducción óhmica (I∝V) en la región de bajo voltaje y el ajuste lineal de lnI-V 1/2 en la región de alto voltaje (el recuadro de la Fig. 4), lo que confirma el mecanismo de emisión de Schottky [15, 33].
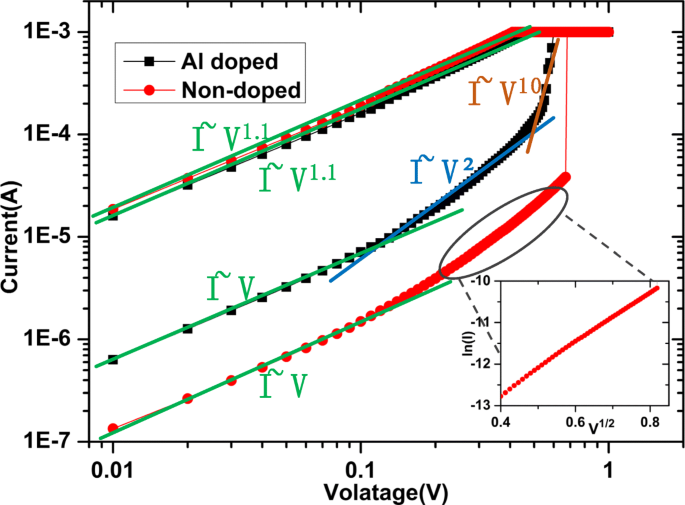
El ajuste de la curva del proceso SET en las coordenadas logarítmicas dobles
De acuerdo con las características anteriores, los mecanismos microscópicos de los memristores se resumen a continuación. Para dispositivos sin dopar, a medida que aumenta el voltaje positivo aplicado al electrodo de titanio, se generan más y más iones de oxígeno en el HfO 2 y moverse hacia el electrodo de titanio [34], produciendo óxido de titanio [35]. Al mismo tiempo, las vacantes de oxígeno se acumulan en la interfaz entre el electrodo de platino y el HfO 2 , formando filamentos conductores gradualmente [36]. Por tanto, la corriente aumenta gradualmente con el voltaje. Los dispositivos pasan al estado de baja resistencia (LRS) cuando las vacantes de oxígeno que conducen los filamentos conectan el TE y el BE. Mientras que el electrodo de titanio se aplica con un voltaje negativo, los iones de oxígeno se combinan con las vacantes de oxígeno en el HfO 2 / Pt interfaz [37], que conduce a una menor concentración de vacantes de oxígeno y una mayor barrera de Schottky. Cuando se alcanza el voltaje de reinicio, el filamento conductor se rompe y el dispositivo se cambia a HRS.
Para los dispositivos dopados con Al, los átomos de Al se unen a la estructura de HfO2 para formar Hf-Al-O, lo que da como resultado enlaces Hf-O más débiles y más fáciles de romper. Se reduce la energía de formación de vacantes de oxígeno. Por lo tanto, los dispositivos de dopaje tienen una resistencia más pequeña y un voltaje de transición más bajo. En las películas sin dopar, las vacantes de oxígeno tienden a acumularse a lo largo de los límites de los granos [38, 39]. Como resultado, los filamentos conductores son pocos y gruesos. La resistencia de los dispositivos varía mucho con la conducción y rotura de los filamentos conductores. En las películas dopadas, las vacantes de oxígeno se forman fácilmente cerca de los átomos de impurezas [35, 40, 41]. La distribución uniforme de una gran cantidad de impurezas en la película delgada hace que los filamentos conductores estén formados por vacantes de oxígeno más controlables. Por lo tanto, es más fácil lograr múltiples valores de resistencia.
Los dispositivos se pueden configurar en diferentes estados de resistencia estable cambiando el cumplimiento actual del proceso configurado. Se obtienen veinte estados de resistencia estable estableciendo la conformidad de corriente formando 0.5 mA a 10 mA con un paso de 0.5 mA en la Fig. 5a. Como los estados de resistencia establecidos por el barrido de CC, el consumo de energía es grande y la operación es complicada. Por otro lado, los valores de resistencia se bloquean fácilmente en LRS cuando se usa una gran conformidad de corriente. Este método tampoco puede ajustar el HRS. Estados de resistencia de veinte niveles logrados cambiando la amplitud de voltaje del pulso de ajuste y reinicio. Para evitar la posibilidad de que la corriente se sobrepase y falle en el ajuste / reinicio, la amplitud del voltaje se limita entre 1 V ~ 1,9 V para el ajuste y - 1 V ~ - 1,9 V para el reinicio. Puede verse en el diagrama de caja (Fig. 5b) que el rango de voltaje permitido se divide en 20 valores y el rendimiento del dispositivo supera con creces el nivel de 3 σ (99,73%). Este es un requisito común en la producción. La desventaja de este método es que los dispositivos no se pueden configurar directamente de un HRS (LRS) a otro HRS (LRS), sino que primero deben restablecerse (configurar) a LRS (HRS) y luego configurar el HRS objetivo (LRS) . Esto aumenta la complejidad y el consumo de energía de la operación.

El almacenamiento multivalor de los dispositivos. un Transforme los estados de resistencia estableciendo corrientes de cumplimiento. b 20 estados de resistencia estables obtenidos al establecer la amplitud del voltaje del pulso El ancho y el intervalo del pulso son ambos de 500 μs
En la Fig. 6 se muestra un mejor enfoque. La conductancia del dispositivo aumenta o disminuye gradualmente mediante pulsos consecutivos. La duración y el intervalo del pulso son ambos de 10 μs. La conductancia se mide mediante un pulso de lectura de 0,1 V después de cada pulso de ajuste / reinicio. Como se ve en la Fig. 6, el número de pulsos necesarios para configurar / reiniciar los dispositivos a diferentes niveles depende del voltaje aplicado. Las diferentes estatuas resistentes con 20 niveles se obtienen mediante set y reset seleccionando 0.5 V como voltaje SET y - 0.7 V como voltaje reset respectivamente (Fig. 7). El dispositivo se restablece a HRS con 10 pulsos consecutivos de 0,9 V cada vez antes de establecer el estado objetivo o se establece en LRS con 10 pulsos consecutivos de 0,8 V antes del ajuste. Considerando el mismo estado presente tanto en el proceso de armado como en el de reinicio, hay 35 estados diferentes obtenidos en su totalidad. La desviación del número de pulsos necesaria para los dos estados de resistencia adyacentes de conjunto (reinicio) excede el nivel de 3 σ. La desventaja es que si los valores de resistencia de los dispositivos cambian mucho, el número de pulsos necesario será grande y la velocidad de operación será lenta.
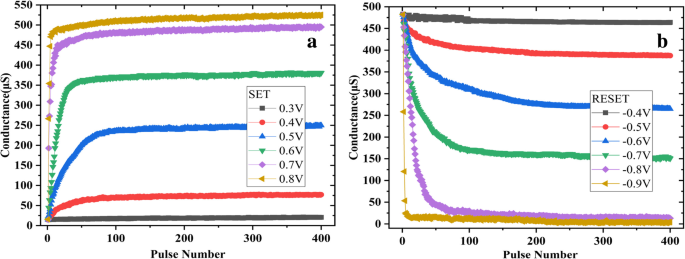
La resistencia ajustada por pulsos consecutivos. un Establecer proceso y b proceso de reinicio

Número de pulso necesario para configurar ( a ) o restablecer ( b ) los dispositivos a 20 niveles diferentes
Para probar la retención de datos de los dispositivos, 20 dispositivos se configuran / restablecen a una serie de valores de resistencia diferentes y se mantienen en una mesa de calentamiento a 85 ° C [42]. Los valores de resistencia se midieron con una tensión de 0,1 V cada 100 s. Puede verse en la Fig. 8a que la resistencia de los dispositivos se mantiene estable después de 10 4 s. Para probar la confiabilidad del ciclo del dispositivo, repetimos la operación de ajuste y reinicio con un pulso de ajuste de 1.8 V / 500 μs y un pulso de reinicio de - 1.8 V / 500 μs. Después de 10 3 ciclos, la relación de conmutación del dispositivo sigue siendo superior a 10 en la Fig. 8b.
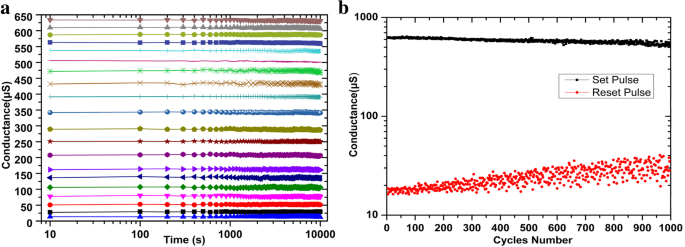
Las pruebas de fiabilidad de los dispositivos. un Características de retención de datos después de las operaciones de activación / desactivación de impulsos. b Ciclos de curvas de resistencia para operaciones de pulso de ajuste / reinicio
Conclusiones
La propuesta HfO dopada con Al 2 el memristor muestra un rendimiento de ajuste / reinicio gradual y estable. Al ajustar la curva del proceso de ajuste de los dispositivos dopados y no dopados con Al, se encuentra que, en HRS, el dispositivo no dopado sigue el mecanismo de emisión de Schottky, mientras que el dispositivo dopado con Al sigue el mecanismo conductor de SCLC. También se analiza el mecanismo físico microscópico del cambio de resistencia. Además, el almacenamiento de valores múltiples del dispositivo se confirmó cambiando la corriente de cumplimiento, ajustando la amplitud del voltaje del pulso de activación / desactivación y utilizando los pulsos cortos consecutivos. Finalmente, probamos la confiabilidad de los dispositivos para demostrar que tienen una retención de datos de más de 10 4 s (85 ° C) y una relación de conmutación superior a 10 después de 10 3 ciclos.
Disponibilidad de datos y materiales
Todos los datos generados o analizados durante este estudio se incluyen en este artículo publicado.
Abreviaturas
- ALD:
-
Deposición de la capa atómica
- BE:
-
Electrodo inferior
- CMOS:
-
Silicio de óxido de metal complementario
- HfD-04:
-
MeCp 2 HfMe (OMe) Hf
- HRS:
-
Estado de alta resistencia
- LRS:
-
Estado de baja resistencia
- NVM:
-
Memoria no volátil
- SCLC:
-
Corriente limitada por carga espacial
- TE:
-
Electrodo superior
- TMA:
-
Trimetilaluminio
- XPS:
-
Espectroscopia de fotoelectrones de rayos X
Nanomateriales
- Autenticación de dispositivo basada en X.509 en Eclipse Hono
- Nano grafema, memoria transparente flexible basada en silicio
- Características de conmutación resistiva bipolar de dispositivos RRAM con estructura de tres capas de HfO2 / TiO2 / HfO2 en sustratos recubiertos de Pt y TiN fabricados por deposición de capa atóm…
- Fabricación de pozos a nanoescala con alto rendimiento en película delgada de polímero utilizando litografía de arado dinámico basada en puntas AFM
- Preparación y características termoeléctricas de ITO / PtRh:termopar de película fina PtRh
- Sensor de deformación ultrasensible basado en una película piezoeléctrica de poli (fluoruro de vinilideno) flexible
- Rendimiento energético mejorado basado en la integración con los nanolaminados de Al / PTFE
- Diseño de sensor acústico de membrana basilar coclear biónica para selectividad de frecuencia basado en nanogenerador triboeléctrico de película
- Fotodetector ultravioleta de alto rendimiento basado en puntos cuánticos de grafeno decorados Nanorods de ZnO / Heterojunciones de isotipo de película de GaN
- Ambarella, Lumentum y ON Semiconductor colaboran en la detección 3D basada en procesamiento de IA para dispositivos AIoT de próxima generación
- Revestimiento de película fina de nitruro de titanio y niobio



