Crecimiento propio de MOCVD y fotoluminiscencia mejorada espectacularmente de nanocables de núcleo-carcasa de InGaAs / InP
Resumen
Informamos sobre el crecimiento y la caracterización de nanocables núcleo-capa de InGaAs / InP en sustratos de Si– (111) por deposición de vapor químico metal-orgánico (MOCVD). La tensión en la interfaz núcleo-capa inducida por el gran desajuste de la red entre el núcleo de InGaAs y los materiales de la capa de InP tiene una fuerte influencia en el comportamiento de crecimiento de la capa de InP, lo que lleva al crecimiento asimétrico de la capa de InP alrededor del núcleo de InGaAs e incluso a la flexión de los nanocables. Las mediciones de microscopía electrónica de transmisión (TEM) revelan que la capa de InP es coherente con el núcleo de InGaAs sin dislocaciones de ajuste. Además, las mediciones de fotoluminiscencia (PL) a 77 K muestran que la intensidad máxima de PL de los nanocables de núcleo-capa de InGaAs / InP muestra una mejora de ∼ 100 veces en comparación con la única muestra de núcleo de InGaAs sin capa de InP debido a la pasivación de los estados de superficie y confinamiento del portador resultante de la capa de capa de InP. Los resultados obtenidos aquí amplían nuestra comprensión del comportamiento de crecimiento de nanocables de heteroestructura núcleo-capa tensos y pueden abrir nuevas posibilidades para aplicaciones en dispositivos optoelectrónicos basados en nanocables de heteroestructura InGaAs / InP en la plataforma de Si.
Antecedentes
Los nanocables semiconductores III-V han sido reconocidos como candidatos prometedores para dispositivos a nanoescala de próxima generación debido a sus propiedades electrónicas, ópticas y geométricas únicas [1, 2, 3, 4]. Entre los materiales semiconductores III – V, el nanoalambre ternario InGaAs es extremadamente atractivo para aplicaciones fotónicas y optoelectrónicas debido a sus excelentes propiedades físicas, tales como un amplio rango controlable de banda prohibida directa, masa efectiva de portadora pequeña y alta movilidad de portadora. Además, se ha estudiado intensamente la integración de materiales III-V con una plataforma de Si, que permite combinar las ventajas de las propiedades físicas únicas de los materiales III-V con la tecnología madura de semiconductores de óxido metálico complementario (CMOS). Debido a la pequeña huella, los nanocables brindan una oportunidad para la integración de materiales III-V con Si ignorando la gran diferencia en los parámetros de la red entre los materiales [5, 6]. Hasta ahora, se han fabricado varios dispositivos basados en nanocables ternarios de InGaAs sobre sustratos de Si, incluidos transistores de baja potencia y alta velocidad [7, 8], dispositivos basados en túneles [9, 10], diodos emisores de luz (LED) [11 ], dispositivos fotónicos [12, 13] y células solares [14, 15].
Sin embargo, debido a la alta relación superficie-volumen del nanoalambre unidimensional, los numerosos estados de la superficie se han convertido en una limitación principal para lograr dispositivos optoelectrónicos basados en nanocables de alto rendimiento. Por un lado, estos estados de la superficie pueden degradar en gran medida las propiedades electrónicas y ópticas de los materiales III-V mediante la dispersión y un proceso de recombinación no radiativa [16,17,18,19,20]. Por otro lado, para los nanocables de algunos materiales de brecha estrecha (como InAs, In-rich InGaAs), la alta densidad de los estados de la superficie puede conducir a una curvatura de la estructura de la banda electrónica cerca de la superficie del nanocable (efecto de clavija de nivel de Fermi en la superficie ). Una estructura de banda no plana de este tipo provocará además una redistribución del portador de carga, lo que puede obstaculizar considerablemente el rendimiento de los dispositivos ópticos basados en nanocables [21]. Por lo tanto, eliminar estos estados superficiales es muy necesario. Para nanocables ternarios de InGaAs con mayor composición, InP es una capa pasivante de superficie deseable, ya que el sistema de material forma una alineación de banda prohibida de tipo I, que puede confinar los portadores en InGaAs de manera efectiva. Además, para el sistema de material InGaAs / InP, que ha sido ampliamente investigado en estructuras planas, su longitud de onda de emisión se puede sintonizar en el rango de 1,31-1,55 μm, lo que tiene una perspectiva prometedora en la comunicación por fibra óptica.
En este trabajo, llevamos a cabo el crecimiento y caracterización de nanocables núcleo-capa de InGaAs / InP sobre sustratos de Si– (111) utilizando deposición química de vapor orgánico metálico (MOCVD). Se encuentra que la deformación en la interfaz núcleo-capa que resulta de un gran desajuste de la red entre los materiales del núcleo y la capa tiene una fuerte influencia en el comportamiento de crecimiento de la capa de InP. El gran desajuste de la red entre el núcleo y los materiales de la cubierta puede conducir a una nucleación no uniforme de la capa de revestimiento de InP alrededor de los nanocables del núcleo de InGaAs e incluso a la flexión de los nanocables. Optimizando las condiciones de crecimiento, se pueden lograr los nanocables núcleo-capa de InGaAs / InP con una buena morfología. Además, las mediciones de fotoluminiscencia (PL) a 77 K muestran que la intensidad máxima de PL de los nanocables núcleo-capa de InGaAs / InP muestra una mejora de aproximadamente 100 veces en comparación con los nanocables de InGaAs desnudos debido a la pasivación de los estados de la superficie y el confinamiento efectivo del portador a través del revestimiento de InP capa.
Métodos / Experimental
Crecimiento de nanocables
Los nanocables núcleo-capa de InGaAs / InP se cultivaron mediante un sistema MOCVD de cabezal de ducha de acoplamiento cerrado (AIXTRON Ltd., Alemania) a 133 mbar. Se utilizaron trimetilindio (TMIn) y trimetilgalio (TMGa) como precursores del grupo III, y arsina (AsH 3 ) y fosfina (PH 3 ) se utilizaron como precursores del grupo V. Hidrógeno de pureza ultra alta (H 2 ) se utilizó como gas portador, y el caudal total de H 2 fue 12 slm. Antes del crecimiento, los sustratos de Si– (111) se calentaron a 635 ° C para el recocido y luego se enfriaron a 400 ° C bajo AsH 3 fundente para formar (111) superficies similares a B [22]. Los nanocables del núcleo de InGaAs se cultivaron a 565 ° C durante 15 min. Durante el proceso de crecimiento, TMIn y AsH 3 los caudales son de 0,8 × 10 - 6 mol / min y 1.0 × 10 - 4 mol / min, mientras que se varía el caudal de TMGa. La composición en fase de vapor de TMGa, Xv, que se definió como la relación de los caudales TMGa / (TMGa + TMIn), se varió de 30 a 40%. La cáscara de InP se cultivó a 565 ° C durante 10 min con TMIn y PH 3 caudales de 2 × 10 - 6 mol / min y 8.0 × 10 - 4 mol / min, respectivamente. Después del crecimiento, las muestras se enfriaron a temperatura ambiente usando PH 3 como agente protector.
Métodos de caracterización
La morfología de los nanocables se caracterizó por microscopía electrónica de barrido (SEM) (Nova Nano SEM 650) y microscopía electrónica de transmisión (TEM) (JEM2010F TEM; 200 kV) junto con espectroscopía de dispersión de energía de rayos X (EDS). investigar la estructura y composición cristalinas, respectivamente. Para las observaciones de TEM, los nanocables se transfirieron mecánicamente de las muestras a rejillas de cobre recubiertas con una película de carbono. Para investigar las propiedades ópticas de los nanocables desarrollados, se realizaron mediciones de fotoluminiscencia (PL) utilizando un láser de longitud de onda de 532 nm como fuente de excitación. Las muestras se excitaron con una potencia de láser de ~ 100 mW sobre un tamaño de punto con un diámetro de aproximadamente 150 μm. La señal PL se alimentó directamente a un espectrómetro de infrarrojos por transformada de Fourier (FTIR) y se registró mediante un detector InSb enfriado con nitrógeno líquido. El espejo móvil en el espectrómetro FTIR funcionó en un modo de escaneo rápido [23], a diferencia de las mediciones PL moduladas por escaneo escalonado en nanocables InAs en la región del infrarrojo medio [24].
Resultados y discusión
La Figura 1 muestra una ilustración esquemática del crecimiento de nanocables núcleo-capa de InGaAs / InP en un sustrato Si– (111) y las secuencias de fuente-suministro para el crecimiento de los nanocables. Los nanocables de InGaAs crecen mediante un mecanismo autocatalizado [25]. Tenga en cuenta que, en gotas se consumirá bajo un AsH 3 atmósfera (mostrada en la región 3 en la Fig. 1). El crecimiento excesivo del shell InP se inició al cambiar el AsH 3 a PH 3 flux y abriendo el TMIn flux simultáneamente.
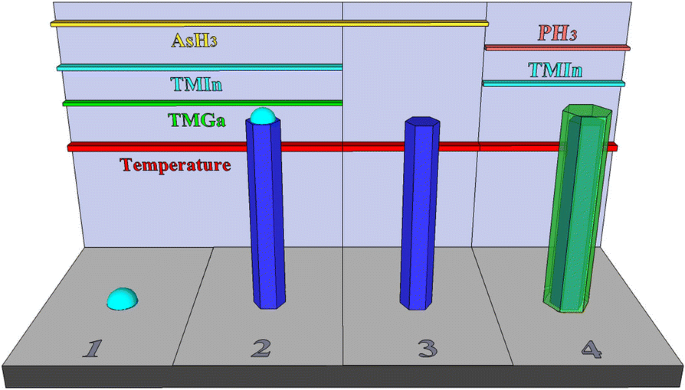
Ilustración esquemática del crecimiento de nanocables núcleo-capa de InGaAs / InP y las secuencias de fuente-suministro para el crecimiento de nanocables
La Figura 2a, b muestra imágenes típicas de SEM de nanocables núcleo-capa de InGaAs e InGaAs / InP desnudos con Xv =30%, respectivamente. Todos los nanocables de InGaAs están alineados verticalmente sobre el sustrato de Si con un diámetro uniforme a lo largo de toda la longitud. Después del crecimiento posterior de la capa de InP, los nanocables todavía tienen facetas laterales lisas, lo que indica la optimización de los parámetros de crecimiento. A partir de las distribuciones estadísticas de los diámetros de los nanocables núcleo-capa de InGaAs e InGaAs / InP desnudos, el diámetro promedio de los nanocables aumenta de ∼ 65 a ∼ 95 nm después del crecimiento de la capa de InP, lo que indica el grosor promedio de la capa de InP de aproximadamente 15 Nuevo Méjico. Sin embargo, los nanocables núcleo-capa de InGaAs / InP en la Fig. 2b están visiblemente doblados, lo que es inducido por la tensión en el nanoalambre del núcleo de InGaAs causada por la capa de InP debido al gran desajuste de la red entre el núcleo y los materiales de la cubierta. La Figura 2c, d muestra imágenes SEM de los nanocables núcleo-capa de InGaAs / InP con Xv de 35% y 40%, respectivamente. En comparación con los nanocables de la Fig. 2b, la flexión de los nanocables núcleo-capa de InGaAs / InP con Xv de 35% se redujo considerablemente (Fig. 2c). Aumentando aún más el Xv al 40%, los nanocables son rectos sin flexión visible (Fig. 2d). Este fenómeno se puede atribuir a la reducción del desajuste de la red entre el núcleo de InGaAs y los materiales de la cubierta de InP con el aumento de la composición de Ga. Además, a partir de las distribuciones estadísticas de los diámetros de los nanocables núcleo-capa de InGaAs / InP, a medida que aumenta la composición de Ga, el diámetro del nanocable aumenta al mismo tiempo, lo que también puede impedir que los nanocables del núcleo de InGaAs se doblen después del recubrimiento de InP.

un Imágenes SEM inclinadas a 30 ° de los nanocables InGaAs y nanocables núcleo-shell InGaAs / InP con Xv, de b 30%, c 35% y d 40%
Para investigar la estructura cristalina de los nanocables desarrollados y confirmar la existencia de la estructura núcleo-capa después de hacer crecer la capa de InP, se llevaron a cabo mediciones TEM detalladas. Como se muestra en la Fig.3a, la estructura cristalina del nanoalambre InGaAs con Xv de 35% está compuesta por un politipo de estructuras de wurtzita (WZ) y zinc-blenda (ZB) con un gran número de fallas de apilamiento (SF) a lo largo de su crecimiento. dirección, y debido a la coexistencia de estructuras WZ y ZB junto con defectos estructurales, los puntos correspondientes de difracción de electrones de área seleccionada (SAED) se dividen y se alargan ligeramente a lo largo de la dirección de crecimiento (recuadro en la Fig. 3a). Estos defectos planos se observan comúnmente en el crecimiento de nanocables de InAs o InGaAs sin catalizador extraño por MOCVD [26, 27, 28]. La Figura 3b muestra una imagen TEM de campo claro (BF) de baja resolución de un nanocable núcleo-capa de InGaAs / InP típico con Xv del 35% (como se muestra en la Fig. 2c). Después del recubrimiento de InP, el nanoalambre sigue siendo bastante recto sin ahusarse. En la Fig. 3c se muestra una imagen TEM de alta resolución (HR) correspondiente. Se puede observar una interfaz clara entre el núcleo de InGaAs y el shell de InP. Además, no se encontraron dislocaciones inadaptadas siguiendo los planos {111} en la interfaz core-shell. Por lo tanto, el shell de InP recién desarrollado es coherente con el núcleo de InGaAs. Además, debido al crecimiento epitaxial coherente de la capa de revestimiento de InP, la estructura cristalina de la capa de InP heredará completamente la del nanoalambre del núcleo de InGaAs, como lo confirma la estructura mixta WZ / ZB del nanoalambre de núcleo-capa de InGaAs / InP en la Fig. .3c. Este fenómeno se ha observado en nanocables núcleo-capa de otros sistemas de materiales [29,30,31], y el comportamiento destaca la necesidad de mejorar la calidad del cristal de los nanocables de InGaAs autocatalizados.
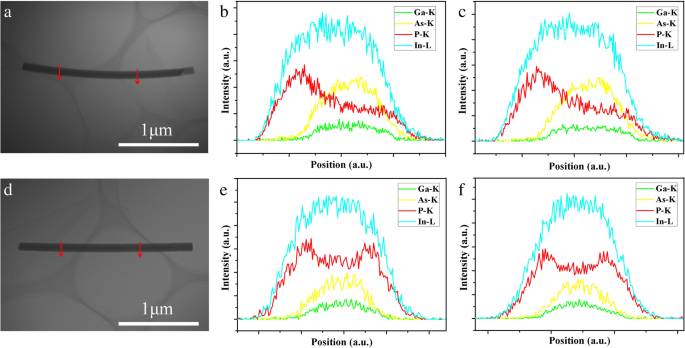
un Imagen HRTEM del nanoalambre InGaAs desnudo (Xv =35%) adquirido del eje de la zona <110>. El recuadro es el correspondiente patrón de difracción de electrones de área seleccionada (SAED). b Imagen TEM de bajo aumento de un nanoalambre núcleo-capa de InGaAs / InP (Xv =35%). c Imagen HRTEM del nanoalambre visto desde el eje de la zona <110>. La línea punteada roja indica la interfaz entre el núcleo y el caparazón
La Figura 4a-c muestra una imagen TEM de bajo aumento y análisis EDS de un nanoalambre núcleo-capa de InGaAs / InP típico que se muestra en la Figura 2b. De acuerdo con los escaneos de la línea EDS a través del nanoalambre, la señal P puede identificarse obviamente en los espectros, lo que indica la existencia de una capa de InP alrededor del núcleo de InGaAs. Considerando que, el espectro EDS de la señal P es asimétrico, lo que implica que el crecimiento excesivo de la capa de InP no es uniforme alrededor del nanoalambre del núcleo de InGaAs. Especulamos que este fenómeno puede ser inducido principalmente por el desajuste relativamente grande de la red entre los materiales del núcleo y de la capa, y tal nucleación no uniforme de la capa de InP dará lugar a la flexión de los nanocables. Por el contrario, para el nanoalambre núcleo-capa de InGaAs / InP (Xv =35%) recto en la Fig. 2c, los análisis EDS en la Fig. 4e-f muestran distribuciones simétricas de la señal P en todo el nanoalambre, lo que indica la uniformidad mejorada de la capa de InP alrededor el núcleo de InGaAs con el aumento del contenido de Ga aquí.
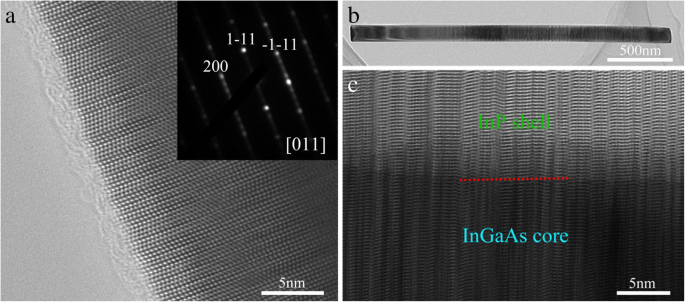
un Una imagen TEM de bajo aumento de un nanoalambre núcleo-capa de InGaAs / InP (Xv =30%). b , c La línea EDS escanea a lo largo de las dos líneas rojas marcadas en a . d Una imagen TEM de bajo aumento de un nanoalambre núcleo-capa de InGaAs / InP (Xv =35%). e , f La línea EDS escanea a lo largo de las dos líneas rojas marcadas en ( d )
Para investigar las propiedades ópticas de los nanocables desarrollados, se realizaron mediciones de fotoluminiscencia (PL). La Figura 5 compara los espectros PL típicos de los nanocables núcleo-capa de InGaAs e InGaAs / InP (Xv =30%) desnudos a 77 K. El espectro PL de los nanocables InGaAs desnudos muestra una emisión mucho más débil con un pico de ∼ 0,73 eV (línea azul en Fig.5), mientras que el espectro PL de los nanocables núcleo-capa de InGaAs / InP exhibe una emisión muy fuerte con un pico de ∼ 0,78 eV (línea roja en la Fig.5) y la intensidad máxima de PL muestra una mejora de ∼ 100 veces en comparación a los nanocables desnudos de InGaAs. Debido a que las densidades de nanocables de diferentes muestras son comparables, consideramos que una mejora tan dramática de la emisión de PL de los nanocables núcleo-capa de InGaAs / InP es causada por la supresión efectiva de los estados de la superficie y el confinamiento del portador por la capa de revestimiento de InP.
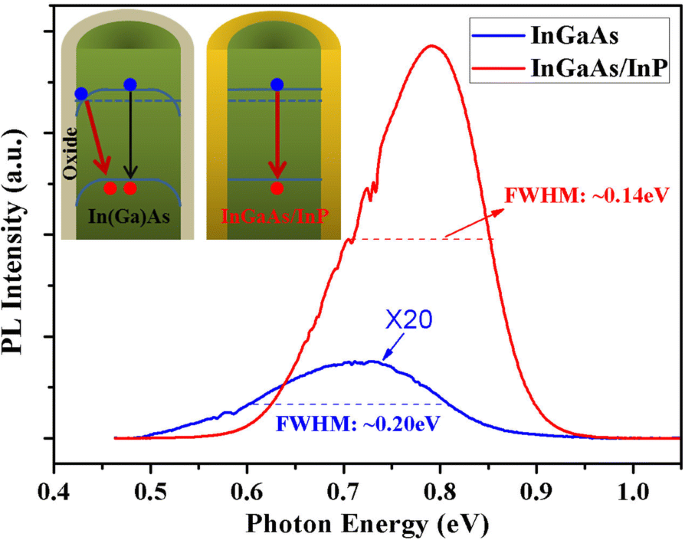
Espectros PL de nanocables núcleo-capa de InGaAs e InGaAs / InP (Xv =30%) desnudos a 77 K. El recuadro es una ilustración esquemática de las estructuras de bandas de nanocables InGaAs desnudos ricos en InGaAs e InGaAs / InP núcleo-caparazón
Otra característica interesante es el ligero desplazamiento hacia el azul del pico InGaAs / InP PL (∼ 50 meV) en comparación con los nanocables InGaAs desnudos. Primero, atribuimos este comportamiento diferente a un cambio en la ruta de recombinación del portador dominante cuando el núcleo de InGaAs está recubierto con una capa de InP. Por lo general, para los nanocables desnudos de InAs o InGaAs ricos en In con superficies cubiertas de óxido nativo, el nivel de Fermi de la superficie se fija en la banda de conducción inducida por los numerosos estados de la superficie, lo que provocará una flexión de la banda hacia abajo cerca de la superficie del nanoalambre. Entonces, esta estructura de banda no plana conducirá a la redistribución del portador donde los electrones se acumulan cerca de la superficie del nanoalambre, mientras que los agujeros permanecen en el centro del nanoalambre. Bajo iluminación, se preferirá la transición de par electrón-hueco espacialmente indirecta con menor energía, como se muestra en el recuadro de la Fig. 5. Para nanocables InAs desnudos, se ha informado que la diferencia de energía entre la emisión cerca del borde de la banda y la relacionada con la superficie la emisión es de aproximadamente ~ 35-45 meV [21]. Sin embargo, para los nanocables de InGaAs, debido a que la flexión de la banda de la superficie se reduce significativamente con el aumento de la composición de Ga, esta diferencia de energía disminuiría simultáneamente, y entonces los electrones están menos confinados cerca de la superficie del nanoalambre y los agujeros están menos localizados en el centro del nanoalambre. Por lo tanto, consideramos que el espectro PL de los nanocables InGaAs desnudos es una mezcla de emisión relacionada con la superficie y emisión cercana al borde de la banda. Debido a la separación espacial, la probabilidad de transición mediada por la superficie es muy baja. Además, los numerosos estados de la superficie pueden consumir pares de agujeros de electrones adicionales a través del proceso de recombinación no radiativa. Por lo tanto, la intensidad PL de los nanocables InGaAs desnudos es extremadamente débil.
Sin embargo, la situación cambiaría cuando los nanocables del núcleo de InGaAs se recubren con una capa de InP. Debido a que los estados de la superficie de los nanocables del núcleo se eliminan de manera efectiva y la capa de InP actúa como una barrera de energía que confina efectivamente los portadores a los nanocables de InGaAs, la transición directa cerca del borde de la banda con mayor probabilidad de transición se vuelve dominante, como lo confirma la mejora significativa de la emisión de PL. Además, debido a la eliminación de la emisión relacionada con la superficie, el espectro PL de los nanocables núcleo-capa de InGaAs / InP muestra un ancho completo más estrecho a la mitad del máximo (FWHM) en comparación con los nanocables InGaAs desnudos. Como se mencionó anteriormente, debido a la flexión de la banda de superficie aliviada para los nanocables de InGaAs obtenidos aquí, la diferencia de energía entre la emisión cerca del borde de la banda y la emisión relacionada con la superficie debería ser mucho menor que ~ 50 meV obtenido aquí. Por lo tanto, aparte de este efecto, especulamos que la deformación es el origen principal del desplazamiento al azul observado. Debido a que el caparazón de InP creció de manera coherente en el núcleo de InGaAs sin dislocaciones de ajuste en la interfaz, el núcleo de InGaAs está bajo tensión de compresión, lo que puede inducir la ampliación de la banda prohibida del nanocable del núcleo de InGaAs y explicar el desplazamiento hacia el azul de la emisión máxima de PL [ 32, 33]. Por lo tanto, al aumentar la capa de recubrimiento de InP, la energía máxima de PL de los nanocables de InGaAs debería mostrar un desplazamiento hacia el azul y su intensidad de emisión de PL se puede mejorar en gran medida.
La figura 6a muestra los espectros PL normalizados de nanocables núcleo-capa de InGaAs / InP con diferente Xv a 77 K. La energía máxima de PL muestra un desplazamiento azul continuo (de ~ 0,78 eV a ~ 0,86 eV) con el aumento de Xv en el rango de 30 a 40 %. Además, a partir de las mediciones de PL a temperatura ambiente, la emisión de los nanocables núcleo-capa de InGaAs / InP alcanza un pico en el rango de longitud de onda de 1,49 a 1,68 μm, que tiene una atenuación de potencia mínima en la comunicación de fibra óptica (región de ~ 1,55 μm). La Figura 6b muestra los espectros PL dependientes de la temperatura para la muestra de nanocables núcleo-capa de InGaAs / InP con Xv =40%, y el recuadro muestra el correspondiente cambio dependiente de la temperatura en la energía pico PL. Por lo general, en el material a granel monocristalino, la dependencia de la temperatura de la luminiscencia muestra un desplazamiento hacia el rojo continuo con el aumento de temperatura de acuerdo con la ecuación de Varshni. Curiosamente, desde el recuadro de la figura 6b, el desplazamiento hacia el rojo solo se puede observar en el rango de temperatura de 60 a 290 K. Cuando la temperatura está por debajo de 60 K, la energía máxima de PL se mantiene casi sin cambios. Teniendo en cuenta la alta densidad de defectos estructurales en los nanocables desarrollados, especulamos que este fenómeno probablemente sea causado por estados de trampa localizados cerca del borde de la banda [34]. A baja temperatura, la emisión está dominada por trampas asistidas. Con el aumento de temperatura, los portadores atrapados se excitan desde los estados de trampa de menor energía hasta el borde de la banda. Por lo tanto, la energía pico PL en la región de baja temperatura no sigue el corrimiento al rojo continuo comúnmente observado con la temperatura y tiende a subestimarse en comparación con el borde de la banda precisa.
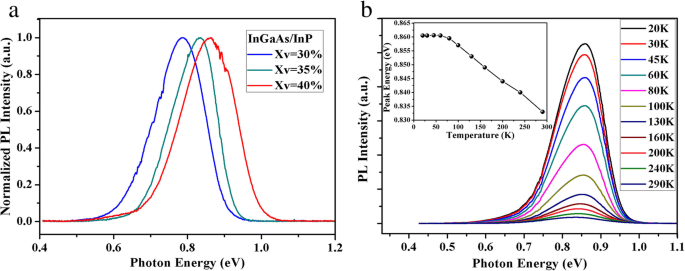
un Espectros PL normalizados de nanocables núcleo-capa de InGaAs / InP con diferente Xv (Xv =30%, 35% y 40%) a 77 K. b Espectros PL dependientes de la temperatura de nanocables núcleo-capa de InGaAs / InP con Xv =40%. Insertar en b muestra el correspondiente cambio dependiente de la temperatura en la energía pico PL
Conclusiones
En resumen, hemos presentado el crecimiento y la caracterización de nanocables núcleo-capa de InGaAs / InP en sustratos de Si– (111) utilizando MOCVD. La tensión en la interfaz núcleo-capa causada por el gran desajuste de la red entre los materiales del núcleo y la capa tiene una gran influencia en el comportamiento de crecimiento de la capa de InP, lo que lleva al crecimiento asimétrico de la capa de InP alrededor del núcleo de InGaAs e incluso a la flexión de los nanocables. Las mediciones de TEM revelaron que el caparazón de InP creció de manera coherente en el núcleo de InGaAs sin dislocaciones inadaptadas. A partir de las mediciones de PL a 77 K, la intensidad máxima de PL de los nanocables núcleo-capa de InGaAs / InP muestra una mejora de ∼ 100 veces en comparación con los nanocables de InGaAs desnudos debido a la pasivación de los estados de la superficie y el confinamiento efectivo del portador por la capa de revestimiento de InP. Esta mejora significativa de las emisiones de los nanocables con capa de InP nos permite observar la emisión incluso a temperatura ambiente. En general, los resultados obtenidos aquí amplían nuestra comprensión del comportamiento de crecimiento de los nanocables de heteroestructura de núcleo-capa deformados y pueden sentar las bases para la fabricación de los dispositivos optoelectrónicos basados en nanocables de InGaAs.
Abreviaturas
- BF:
-
Campo claro
- CMOS:
-
Semiconductor de óxido de metal complementario
- EDS:
-
Espectroscopía de energía dispersiva
- FTIR:
-
Infrarrojos por transformada de Fourier
- FWHM:
-
Ancho completo a la mitad del máximo
- LED:
-
Diodo emisor de luz
- MOCVD:
-
Deposición de vapor químico metalorgánico
- PL:
-
Fotoluminiscencia
- SAED:
-
Difracción de electrones de área seleccionada
- SEM:
-
Microscopía electrónica de barrido
- TEM:
-
Microscopía electrónica de transmisión
- TMGa:
-
Trimetilgalio
- TMIn:
-
Trimetilindio
- ZB:
-
Mezcla de zinc
Nanomateriales
- Los científicos de materiales enseñan a los nanocables cómo 'bailar'
- Nanofibras y filamentos para una mejor administración de fármacos
- Preparación y actividad de hidrogenación catalítica mejorada de nanopartículas de Sb / Palygorskita (PAL)
- Crecimiento autocatalizado de nanocables verticales de GaSb en vástagos de InAs mediante deposición de vapor químico metalorgánico
- Características ópticas y eléctricas de los nanocables de silicio preparados por grabado electrolítico
- Propiedades de síntesis y luminiscencia de nanopartículas de α-NaGdF4 / β-NaYF4:Yb, Er Core-Shell solubles en agua
- Un diseño eficiente y eficaz de nanocables de InP para la máxima captación de energía solar
- Efecto de la estabilidad térmica mejorada de la capa de soporte de alúmina sobre el crecimiento de nanotubos de carbono de pared simple alineados verticalmente y su aplicación en membranas de nanof…
- Mecanismos de formación de nanocables de InGaAs producidos por una deposición de vapor químico de dos pasos de fuente sólida
- Influencia del dopaje de Mg en nanopartículas de ZnO para una evaluación fotocatalítica mejorada y análisis antibacteriano
- 5G y el desafío del crecimiento exponencial de datos



