Alto voltaje de ruptura y baja resistencia dinámica a la activación de AlGaN / GaN HEMT con implantación de iones de flúor en la capa de pasivación de SiNx
Resumen
En este estudio, propusimos y demostramos experimentalmente un alto voltaje de ruptura (BV) y una baja resistencia dinámica ON ( R ENCENDIDO, D ) Transistor de alta movilidad de electrones (HEMT) AlGaN / GaN mediante la implantación de iones de flúor en el SiN x espeso capa de pasivación entre la puerta y los electrodos de drenaje. En lugar de la implantación de iones de flúor en la capa delgada de barrera de AlGaN, la posición de los picos y las distribuciones de vacantes están lejos del canal de gas de electrones bidimensionales (2DEG) en el caso de la implantación de iones de flúor en la capa de pasivación gruesa, que suprime eficazmente la Degradación característica estática y dinámica pulsada de corriente (CC). Los iones de flúor en la capa de pasivación también extienden la región de agotamiento y aumentan la fuerza del campo eléctrico promedio (campo E) entre la puerta y el drenaje, lo que conduce a un BV mejorado. El BV del HEMT propuesto aumenta a 803 V desde 680 V del HEMT convencional de AlGaN / GaN (Conv. HEMT) con los mismos parámetros dimensionales. La R medida ENCENDIDO, D del HEMT propuesto solo se incrementa en un 23% con un sesgo de reposo de alto drenaje de 100 V, mientras que el R ENCENDIDO, D del HEMT con implantación de iones flúor en la fina capa de barrera de AlGaN aumenta en un 98%.
Antecedentes
En las últimas décadas, se han estudiado ampliamente materiales semiconductores novedosos, como GaN, óxidos metálicos y materiales 2D, para mejorar aún más la conversión de energía y la eficiencia de almacenamiento, debido a sus propiedades superiores de material y dispositivo [1,2,3,4, 5,6,7,8]. Entre ellos, los transistores de alta movilidad de electrones (HEMT) AlGaN / GaN basados en GaN son buenos candidatos para aplicaciones de alta potencia, alta frecuencia y baja pérdida debido al alto campo de ruptura crítica y la alta movilidad de electrones [9,10,11,12,13 , 14]. La tensión de ruptura (BV) es uno de los objetivos de diseño más importantes, y los valores informados todavía están muy por debajo del límite teórico [15, 16]. Por lo tanto, es de gran importancia mejorar aún más el BV, especialmente no a costa de aumentar el tamaño del dispositivo. Se han propuesto varias técnicas de terminación para mejorar la VB, como la placa de campo [17, 18, 19], la implantación de iones de flúor [20, 21, 22] y la terminación del borde de la puerta empotrada [23, 24]. Los iones de flúor implantados en la delgada capa de barrera de AlGaN (FBL) [22] tienen un proceso de fabricación simple sin inducir una capacitancia parásita adicional; sin embargo, la posición máxima del perfil de flúor y las distribuciones de vacantes está cerca del canal bidimensional de electrones gaseosos (2DEG), lo que inevitablemente causaría una degradación significativa de las características estáticas y dinámicas.
En este trabajo, un voltaje de ruptura alto y una resistencia ON dinámica baja ( R ENCENDIDO, D ) AlGaN / GaN HEMT con implantación de iones flúor en el SiN x La capa de pasivación (FPL HEMT) se investiga experimentalmente. A diferencia del caso de la implantación de iones de flúor en la capa delgada de barrera de AlGaN, la implantación de iones de flúor en la capa de pasivación gruesa podría mantener la posición máxima de las distribuciones de flúor y vacantes lejos del canal 2DEG, suprimiendo así eficazmente la degradación característica estática y dinámica . Los iones de flúor en la capa de pasivación como técnica de terminación también se utilizan para optimizar la distribución del campo eléctrico de la superficie (campo E), logrando así una VB mejorada. En conclusión, el FPL HEMT demuestra excelentes características estáticas y características dinámicas.
Métodos de fabricación
La Figura 1 es el esquema tridimensional de FPL HEMT, FBL HEMT y Conv. HEMT, respectivamente. Todos los dispositivos tienen una longitud de puerta L G de 2,5 μm, una distancia puerta-fuente L GS de 1,5 μm y una distancia entre la puerta y el drenaje L GD de 10 μm. La heteroestructura epitaxial de AlGaN / GaN usada para fabricar el FPL HEMT se cultivó en un sustrato de silicio de 6 pulgadas (111) mediante deposición de vapor químico orgánico metálico (MOCVD). Las capas epitaxiales consisten en una capa de GaN de 2 nm, Al 0.25 de 23 nm Ga 0,75 Barrera N, capa intermedia de AlN de 1 nm, canal de GaN de 150 nm y tampón de GaN de 3,5 μm. La densidad y la movilidad medidas del efecto Hall del 2DEG fueron 9,5 × 10
12
cm
−2
y 1500 cm
2
/ V s, respectivamente. El FPL HEMT propuesto comenzó con el aislamiento mesa que fue implementado por un Cl 2 de alta potencia / BCl 3 grabado con plasma acoplado inductivamente (ICP). Luego, una deposición de vapor químico a baja presión de 40 nm de espesor (LPCVD) SiN x capa se depositó a 780 ° C / 300 mTorr con un NH 3 flujo de 280 sccm y un SiH 2 Cl 2 flujo de 70 sccm, produciendo una tasa de deposición de 3.7 nm / min. El índice de refracción se mide con un elipsómetro como 1.978 y la relación N / Si de SiN x es 1,31 [25]. La cristalinidad de LPCVD SiN x es amorfo, lo que se confirma mediante una micrografía de microscopio electrónico de transmisión de alta resolución (HR-TEM) (ver el recuadro de la Fig. 1a). Después de abrir las ventanas de contacto de fuente y drenaje con SF 6 grabado en seco con plasma, el contacto óhmico Ti / Al / Ni / Au (20/150/45/55 nm) se depositó y se recoció a 890 ° C durante 30 s en N 2 ambiente. La resistencia de contacto de 1 Ω mm y la resistencia de la hoja de 400 Ω / cuadrado se extrajeron mediante el método de línea de transmisión lineal. A continuación, el electrodo de puerta de metal se forma mediante un proceso de deposición y despegue de Ni / Au (50 nm / 150 nm). Luego, la ventana de implantación de iones de flúor (longitud de la ventana =3 μm) está formada por el fotorresistente AZ5214, y los iones de flúor fueron implantados por el implantador de iones SEN NV-GSD-HE a una energía de 10 keV a una dosis de 1 × 10
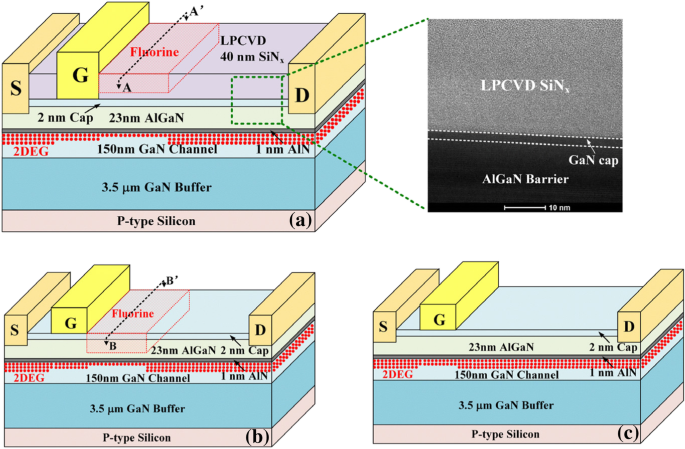
Esquema tridimensional de a FPL HEMT (recuadro:micrografía HR-TEM de LPCVD SiN x ), b FBL HEMT y c Conv. HEMT
Resultados y discusión
La Figura 2 muestra el perfil de espectroscopía de masas de iones secundarios (SIMS) medido de la concentración de iones flúor y la concentración de vacantes simulada por TRIM a lo largo de las líneas de corte:(a) A-A ′ de FPL HEMT y (b) B-B ′ de FBL HEMT, respectivamente. Con la misma energía y dosis de implantación de iones de flúor, la posición del pico medida desde la superficie y la concentración máxima del perfil de flúor es casi la misma para las dos estructuras. En el caso de la implantación de iones flúor en la fina capa de barrera de AlGaN, las vacantes inducidas por flúor se extienden a la región del canal 2DEG. La distribución de la concentración de vacantes es discontinua en cada interfaz porque la energía de enlace de cada material es diferente [27]. Sin embargo, en el caso de la implantación de iones flúor en el SiN x grueso capa de pasivación, la distribución de vacantes se ubica dentro del SiN x capa de pasivación y lejos del canal 2DEG. Las vacantes inducidas por la implantación de iones atraparían el canal 2DEG, y 2DEG podría quedar fácilmente atrapado si la distribución de vacantes se acercara a la 2DEG [28]. En conclusión, la implantación de iones de flúor en el SiN x grueso La capa de pasivación podría reducir significativamente la influencia de la implantación de iones en el canal 2DEG y suprimir la degradación característica estática y dinámica de manera efectiva.

Perfil SIMS medido de concentración de iones de flúor y concentración de vacantes simulada por TRIM a lo largo de las líneas de corte. un A-A ′. b B-B ′
La Figura 3 ilumina el I-V medido características de transferencia y características de salida de corriente continua (CC). Comparado con Conv. HEMT, tanto el FPL HEMT como el FBL HEMT muestran una disminución en I DS y un aumento en la resistencia estática ON ( R ACTIVADO ), porque los iones de flúor provocan el agotamiento asistido del 2DEG en la región de deriva y, por lo tanto, disminuyen la densidad del 2DEG [29]. Además, la implantación de iones también disminuye la movilidad 2DEG. Las movilidades 2DEG medidas por efecto Hall de los HEMT FPL y FBL son 228 cm 2 / V sy 203 cm 2 / V s después de la implantación de iones, respectivamente. Debido a la misma dosis de iones flúor, las características de salida y R ACTIVADO de FPL HEMT y FBL HEMT son casi iguales a un voltaje de drenaje bajo (por ejemplo, V DS <3 V). Sin embargo, cuando V DS > 3 V, el colapso de la corriente de drenaje de saturación ocurre en el FBL HEMT, porque el perfil de vacantes del flúor se extiende a la región del canal 2DEG, y el 2DEG podría quedar atrapado fácilmente por estas vacantes de nivel profundo inducidas por el flúor cuando el voltaje de drenaje es mayor que el crítico voltaje de drenaje (por ejemplo, V DS > 3 V) [30], disminuyendo así la corriente de drenaje. La distribución de vacantes de FPL HEMT está lejos del canal 2DEG, lo que suprime eficazmente el colapso de la corriente de drenaje de saturación.

Medido a I-V características de transferencia y b Características de salida de CC para tres HEMT
La Figura 4 muestra el I-V medido características y distribuciones de campo E de superficie simuladas en el estado de bloqueo. Los BV del FPL / FBL / Conv. Los HEMT son 803/746/680 V, respectivamente. El BV se define como el voltaje de drenaje-fuente a la corriente de drenaje ( I DS ) de 1 μA / mm con V GS =- 4 V. Los iones de flúor entre la puerta y el drenaje como técnica de terminación reducen el pico del campo E en el borde de la puerta y provocan un nuevo pico del campo E al final de la región de implantación de iones y, por lo tanto, FPL HEMT y FBL HEMT logra una distribución de campo E de superficie más uniforme y un BV más alto que el de Conv. HEMT. En comparación con FPL HEMT, FBL HEMT tiene un efecto de modulación de campo eléctrico mejorado, porque el perfil de iones de flúor está cerca del canal 2DEG. Sin embargo, para el FBL HEMT, la implantación de iones inevitablemente induciría daños adicionales en la barrera AlGaN [31, 32], lo que conduciría a una ruta de corriente de fuga de puerta continua de capa barrera de puerta-2DEG ; por lo tanto, el BV de FBL HMET es ligeramente más pequeño que el de FPL HEMT.

un Medido fuera de estado I-V características con un voltaje de puerta de -4 V, manteniendo el sustrato flotando. b Distribuciones de campo E de superficie simuladas en V DS =150 V
I pulsada DS - V DS Se realizaron mediciones [33] bajo conmutación lenta para caracterizar el comportamiento de la resistencia dinámica ON ( R ENCENDIDO, D ) de los HEMT de AlGaN / GaN fabricados. La figura 5a es el esquema que muestra la aplicación de tensión de tensión durante la I pulsada. DS - V DS mediciones. En I-V pulsado mediciones, los electrodos de puerta y drenaje de los HEMT de GaN se sometieron a pulsos de voltaje cortos antes de cada I-V medición para asegurarse de que los dispositivos estuvieran apagados. El ancho del pulso es de 3 ms y el período es de 5 ms. La Figura 5 b – d muestra la comparación de las características de salida pulsada de los dispositivos bajo ( V GS0 , V DS0 ) de (0 V, 0 V) y (0 V, 100 V). Se puede ver que hay una mínima degradación (12,3%) de la resistencia dinámica ON para el Conv. HEMT, debido a la ausencia de proceso de implantación de iones flúor. En comparación con FBL HEMT, FPL HEMT tiene una baja degradación de la resistencia dinámica ON. Debido a la capa de pasivación, la distribución de vacantes está lejos del canal 2DEG y se encuentra dentro de la capa de pasivación, que suprime la captura de carga en el FPL HEMT. La Figura 6 resume los valores de razón de R ENCENDIDO, D / R ACTIVADO para los tres HEMT bajo ( V GS0 , V DS0 ) de (0 V, 0 V) y (0 V, 100 V) en un paso de 20 V. Para el FBL HEMT, el R medido ENCENDIDO, D ya se ha incrementado en un 98% de la estática en ( V GS0 , V DS0 ) de (0 V, 0 V) y (0 V, 100 V), mientras que R ENCENDIDO, D del FPL HEMT se incrementa solo en un 23% con un sesgo de reposo de alto drenaje de 100 V.
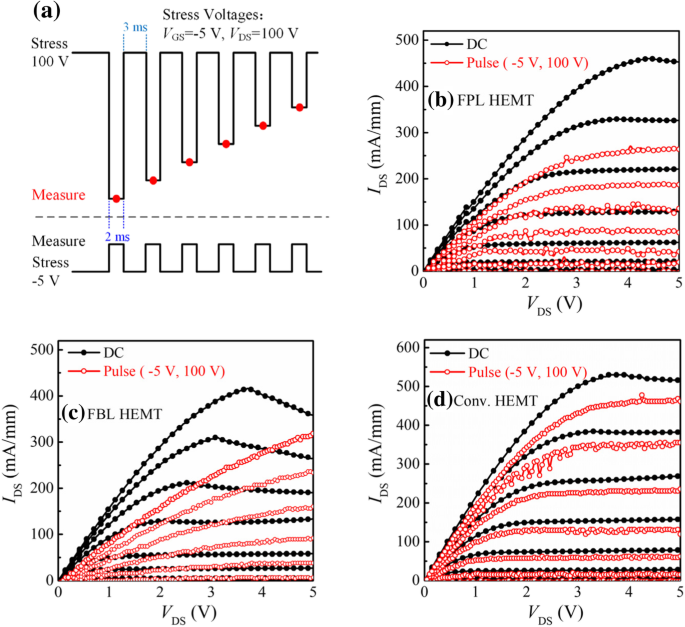
un Esquema que representa la aplicación de tensión de tensión durante el I pulsado DS - V DS mediciones. I pulsada DS - V DS características de los HEMT de AlGaN / GaN fabricados con b FPL HEMT, c FBL HEMT y d Conv. HEMT ( V GS =- 4 ~ 0 V; paso:0,5 V)
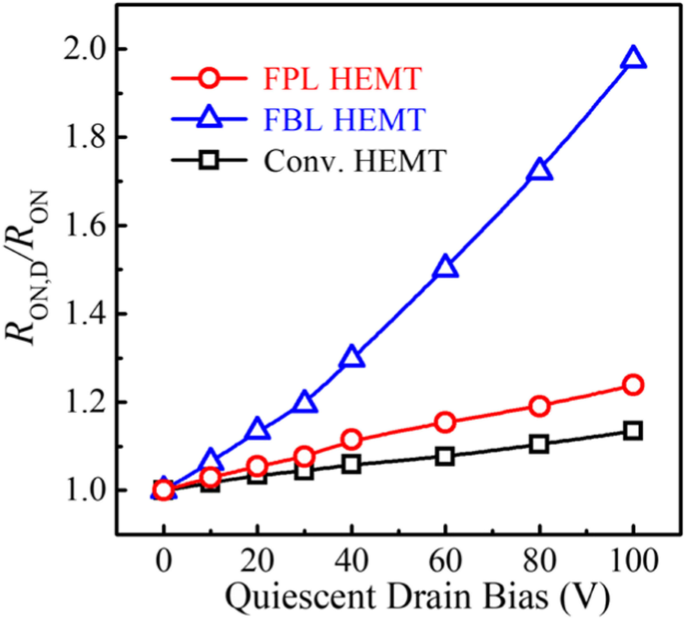
Relación de R ENCENDIDO, D / R ACTIVADO para los HEMT fabricados en diferentes puntos de desviación de drenaje en reposo. El ancho y el período del pulso son 3 ms y 5 ms, respectivamente
Conclusiones
En conclusión, propusimos un nuevo HEMT de AlGaN / GaN con un alto voltaje de ruptura y una baja resistencia dinámica de encendido. Cuenta con implantación de iones de flúor en el grueso SiN x capa de pasivación. La implantación de iones de flúor en la capa de pasivación podría suprimir eficazmente la degradación de las características eléctricas. La resistencia dinámica de ENCENDIDO es solo 1,23 veces más grande que la resistencia estática de ENCENDIDO después del estado de apagado V DS tensión de 100 V, mientras que es 1,98 veces para el FBL HEMT. Además, los iones de flúor en la capa de pasivación también modulan la distribución del campo E y extienden la región de agotamiento; por lo tanto, el BV del HEMT propuesto aumenta a 803 V desde 680 V del HEMT convencional de AlGaN / GaN.
Disponibilidad de datos y materiales
Todos los datos generados o analizados durante este estudio se incluyen en este artículo publicado.
Abreviaturas
- 2DEG:
-
Gas de electrones bidimensionales
- HEMT:
-
Transistor de alta movilidad de electrones
- ICP:
-
Plasma acoplado inductivamente
- LPCVD:
-
Deposición de vapor químico a baja presión
- MOCVD:
-
Deposición de vapor químico orgánico metálico
- SIMS:
-
Espectroscopía de masas de iones secundarios
- TEM:
-
Microscopio electrónico de transmisión
Nanomateriales
- Qué es el mantenimiento de averías y cómo solucionarlo
- Impacto de los estados de la superficie y la fracción molar de aluminio en el potencial de la superficie y 2DEG en los HEMT de AlGaN / GaN
- Investigación sobre la polarización de la superficie de la heteroestructura de GaN / AlGaN / GaN con cubierta de Al2O3 mediante espectroscopia de fotoelectrones de rayos X de ángulo resuelto
- RGO y redes de grafeno tridimensionales co-modificadas TIM con alto rendimiento
- Aerogel de grafeno / polianilina con superelasticidad y alta capacitancia como electrodo supercondensador altamente tolerante a la compresión
- Dependencia del espesor de las propiedades interfaces y eléctricas en la capa atómica depositada AlN en el plano c GaN
- RRAM basado en HfAlOx depositado en capa atómica con bajo voltaje de funcionamiento para aplicaciones informáticas en memoria
- Transistor semiconductor de óxido metálico de doble difusión lateral de resistencia específica ultrabaja con doble puerta mejorada y capa parcialmente enterrada en P
- Una referencia de voltaje sin resistencia de baja potencia a nanoescala con PSRR alto
- Un CRD de bloqueo inverso AlGaN / GaN de alta precisión (RB-CRD) con cátodo de trinchera híbrido
- Materiales y diseño de PCB para alta tensión



